��Ƶ�ſؽ������ITO��Ĥ���ܼ��������
������, ��ѧ��, �½���
(���пƼ���ѧ ģ���������ص�ʵ����, �人 430074)
ժ Ҫ: ��In2O3��SnO2��ĩ��������1��1��ѹ�ս��Ƴɰв�, ������Ƶ�ſؽ����Ʊ��˸����ܵ�ITO��Ĥ�� ʵ��������: ���ѹǿ�Ա�Ĥ�ĵ����ʡ� �ɼ�������TVIL������Ҫ��Ӱ��, �����ֵΪ0.2Pa�� ITOĤ�ķ��衢 TVIL����ɫ��Ĥ���������еĹ�ϵ�� ������¶�ts���Ը��Ʊ�Ĥ������, ��tsΪ200��ʱ, ITO��Ĥ��TVIL�ﵽ90%����(����������), ����Ϊ13.1��/���� ���ݱ�Ĥ������3��������, �����˱�Ĥ���������ʵĹ�ϵ: ��ITO��Ĥ����������, ���γ����ȷ��������ЧӦ�� ��©�����Լ�Cotteyģ�͵�������� ��ʵ����������ٽ���dcԼΪ48~54nm, AFM���������һ������ITO��Ĥ���ź�����ӱ��ֳ���ͬ�ĵ�������ͳߴ�ЧӦ��
�ؼ���: ITO��Ĥ; �ſؽ���; ���ѹǿ; �����¶�; ������� ��ͼ�����: TN304.0255; O484.4
���ױ�ʶ��: A
Properties and conductivity mechanism of ITO films prepared by r.f. magnetron sputtering
LI Shi-tao, QIAO Xue-liang, CHEN Jian-guo
(State Key Laboratory of Die and Mould Technology,Huazhong University of Science and Technology, Wuhan 430074, China)
Abstract: The high quality ITO thin films were prepared at different temperatures by r.f. magnetron sputtering. The results show that Ar partial pressure (p(Ar)) has an important influence on the conductance and transmission in visible range (TVIL). The optimal p(Ar) is 0.2Pa ascertained by experiments. The sheet resistance, TVIL and color of ITO films depend on the film thickness. The film properties can be improved by elevating substrate temperature (ts). For instance the films with TVIL larger than 90% and sheet resistance 13.1��/�� are obtained when ts is 200��. Based on the growth theory of ITO thin films during the three steps, the relations between the conductivity and the film thickness are established according to thermionic emission and tunneling, percolative form of film conductivity and Cottey model of conductivity mechanism. The critical thickness dc, which is about 48-54nm, is confirmed by the experiment data. The validity of conductivity mechanism and dimensional effect are confirmed by analysis of AFM for ITO surface.
Key words: ITO thin film; magnetron sputtering; argon partial pressure; substrate temperature; conductivity mechanism
ITOĤ�Ľ�������Ϊ3.75~4.0eV, ��һ���ڿɼ�����(��=400~780nm)���ԽϺõIJ��ϡ� ���Ƿ���ITOĤ���ڡ����ơ�����[1], һ�����Ų��ӱ�����, �����ձ߽�ġ����ơ�����Խ���ԡ� ͼ1��ʾΪITO��Ĥ������-�ɼ�-�������/����/�������ͼ, �������������ա� �ɼ������� ����߷��������, �䷴����Ҫ�����ڱ�Ĥ�е������������, �������������ɵ�������ġ� ����������In2O3ͨ���������γ�����λת��Ϊ��ITO��Ĥ���й㷺��Ӧ�÷�Χ[2-4]�� ��������ϡȱ��Դ, 1995�깫���������索����ֻ��2600t, ����ÿ�����ĵ���������169t[5], ���Խ�Լԭ���ϳ�Ϊ�����о��߱����ע�Ŀ���[6, 7]�� ���ںܶ��о��߰�ZnO��Al��Ϊ�������ITO�Ŀ����Բ���, �������ڻ����кܶ�����û�н��, ��ʹ��ZnO��Alһֱû�����㹤ҵӦ�õ�Ҫ��[1]�� �������߲�����Ƶ�ſؽ��䷨�Ʊ��˺������ϵ͵�ITO��Ĥ, ǰ�ڹ����Ѿ�������ITO(������Ϊw(In2O3)��w(SnO2)=1��1)��Ĥ�����뽦�����ѹǿ�� �����¶Ⱥͱ�Ĥ���������Ҫ��ϵ[5], �ڴ˽���һ���о����ղ�����ITO��Ĥ������ܵ�Ӱ��, ͨ���۲챡Ĥ����������̽���䵼�������

ͼ1 ITO��Ĥ��������
Fig.1 Spectra curves of ITO thin films
1 ʵ��
�����豸Ϊ����JPG-450�ſؽ�����, ����ƽ�潦�䷽ʽ, ����Һ���ͭ�缫��ѭ����ȴˮ����ȴ�� ��Ƭ��Բ�ΰб���ƽ��, �л������Ϊ65mm�� �������ٵƼ��Ȼ�Ƭ, ���¶�tsΪ����~300�档 ���ղ�������: ������2.4mL/s, ���书��30~50W, ��ƫѹ-60~-120V, ������ն�Ϊ4��10-3 Pa�� ͨ��XPS�вĺͱ�Ĥ�����˳ɷַ���, �������߱��ֲ���, ˵����������в�������Ĥ�ɷֵı仯��
�ô���Ϊ99.99%���������ĩIn2O3�� SnO2����������Ϊ1��1�ı������г�ֻ��, ��������ѹ�ս�(HIP)����, �����и��d86mm��8mm�İвġ� ��ƬΪ��ͨ�Ƹƹ����β����͵�����ĵ�����Ƭ�� �����������Ʊ�����ITO��Ĥ�û����(�����Ϊ��(HCl)�æ�(HNO3)�æ�(H2O)=50��3��50)��ʴ�����Ե�̨��, Ȼ���æ�-Step̨����(����Ϊ0.5nm)������Ĥ��ȡ� �ñ���̽��ϵͳ���Ա�Ĥ���衣 ��UV-2550������ֹ��ȼ�(Shimadzu�ձ�)�������ʡ� ��ԭ��������(AFM)��Tappingģʽ�¶�ITO��Ĥ��������ò���б�����
2 ���������
2.1 �������ѹǿ��ITO��Ĥ���ܵĹ�ϵ
����ITO��Ĥ��Ʒ���Ϊ60nm(���ݲⶨ�ij������ʿ��Ƴ���ʱ�䱣֤��Ĥ���), ���书�ʱ���50W����(�����ѹUa=250V, ����Ia=0.21A, ��ƫѹΪV=-120V), tsΪ����, �ı佦�����ѹǿ(p(Ar)), Ȼ����Ա�Ĥ�ɼ�������TVIL, �����ͼ2(a)��ʾ�� p(Ar)�Ա�ĤTVIL��Ӱ�������, ��p(Ar)Ϊ0.4~3Pa��Χ��, ����ѹǿ���ӱ�Ĥ��TVIL����, ������p(Ar)=0.2Paʱ��Ĥ��TVIL�Ƚϸ�, �ұ�����[5]�б�����Ҫ�ߡ� ��ͼ2(b)�п��Կ���, ��Ĥ�ĵ���������p(Ar)���������, ������Ϊ����Ա�������İв����ӵ���ײ���ʴ������, ���Ӳ���������С, �����Ƭ������ɢ�����˶��ܼ���, Ӱ���˱�Ĥ�Ľᾧ��, ����[5]����ϸ�ط�������ԭ�� �ڲ�ͬ�¶������(10-3 Pa)�˻�30min��, ��Ĥ���������Խ���; �˻��¶�Խ��, �������ܸ���Խ����, ���統�˻��¶ȴﵽ400��ʱ, ��ͬ���ѹǿ���Ʊ��ı�Ĥ�ĵ����ʽӽ�5��10-4 ����cm�� ����Ҫ�������ȴ�����Ĥ�ᾧ��֡� �ṹȱ�ݼ���ʹ�������ӵ�Ǩ�Ʊ�ø�����Щ��
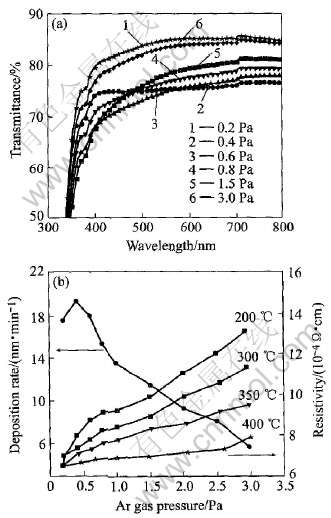
ͼ2 p(Ar)��ITO��Ĥ���� (a)���������ʺ͵����ʵ�Ӱ��(b)
Fig.2 Effects of p(Ar) on ITO film transmission (a), deposition rate and resistivity of ITO films(b)
��ͼ2(a)��(b)���Կ���, Ϊ�˱�֤��Ĥ������(���ʡ� �����ʺͱ���ֲڶ�)����߳�������, Ӧ����������������ѹǿ�� ����[6, 7]����0.1~1Pa�����ѹǿ, ���ͼ2�����Ľ��, ʵ�齦�����ѹǿΪ0.2Pa�� �������ѹǿ��, �������, ����ʵ���в���3Pa�������, �ȶ����ٵ�����0.2Pa�� �ڽ�������з��ֵ����书��P�ﵽ��50W��, ���ڳ�ʱ�佦��������Ӧ�����ж����°вľֲ�����, ���Բ��˲��ù���Ľ��书��, ����[6]����40W����, ��ʵ�����30W���书�ʡ� ��Ԥ�������������30W(P�����ٶ�Ϊ2.5W/min)����Ա���в����¹��졣 Ԥ����IJ��ﱻ���ε��ˡ� �������ѹǿp(Ar)=0.2Pa, ���书��P=30W(Ua=200V, Ia=0.16A, V=-60V), tsΪ����, ��̨���Dz��Բ�ͬ����ʱ��(1~20min)��ITO��Ĥ���d, ƽ����������v=d/t�� ͼ3��ʾ����v�ڲ�ͬ�ij���ʱ���ֵ����û�б仯(v��12nm/min) �� ��˵����һ���Ĺ���������ͨ�����Ʊ�Ĥ�ij���ʱ����Ա�֤��Ĥ���, ���������Ժ��ԡ�
2.2 ��ȶ�ITO���ܵ�Ӱ��͵�������о�
Ĥ���뱡Ĥ���ܵĹ�ϵ���1���С� ���乤����ͼ3��ʾ��ͬ, ��������Ϊ12nm/min�� �ɱ�1�ɼ�, ������ʱ��Ϊ9min(Ĥ��Ϊ118nm)ʱ, ��ĤTVIL��ߡ� ���ű�Ĥ��ȵĸı�, ��Ĥ����ɫ���ź����Եĸı�, �����ɱ�Ĥ�ĸ���ЧӦ����ġ� Ĥ�����Ӷ�TVIL��Ӱ�����������, һ����ɼ�������պͽ���ɢ��[3]��ǿ(��ͼ1), ��һ�������ڱ�Ĥ������Ե�������淴�����TVIL�� �ӱ�1���Կ���, ���ű�Ĥ��ȵ������䷽��Rs����,
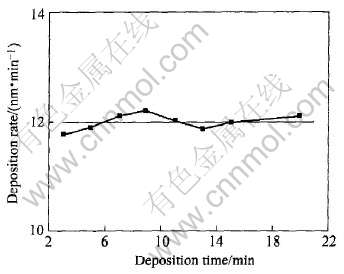
ͼ3 ITO��Ĥ��ƽ�����������뽦��ʱ��Ĺ�ϵ����
Fig.3 Curves of sputtering deposition rate of ITO film vs sputtering time(P=30W, p(Ar)=0.2Pa)
��1 ����ʱ���뱡Ĥ���ܵĹ�ϵ
Table 1 Dependence of ITO films on deposition time

������ΪĤ���������γɵ���ͨ�����Խ���������ʦ�, �����۹�ʽRs=��/d[8]��֪��Ĥ�ķ���Rs�½��� �ɴ˿ɼ�, ITO��Ĥ��ȶ�TVIL�ͷ���Rs������Ҫ��Ӱ�졣
��Ĥ����ļ��㹫ʽ��˵����Ĥ����뱡Ĥ�����ʵ����ڹ�ϵ�� Ϊ�˸��ݱ�Ĥ����������������[9-11], ����Ĥ���������(����ʱ��t)�Ĺ�ϵ, �о��䵼������� ��Ĥ���(����ʱ��)�뱡Ĥ�����ʵĹ�ϵ��ͼ4(a)��ʾ, ����Ȼ�����ʵı仯���Եض�Ӧ��3�ֻ���, ��������:
1) ��������������, ��Ĥ�dz���, �������Լ����������������ߴ�ʹµ�״�ֲ��ڲ�����
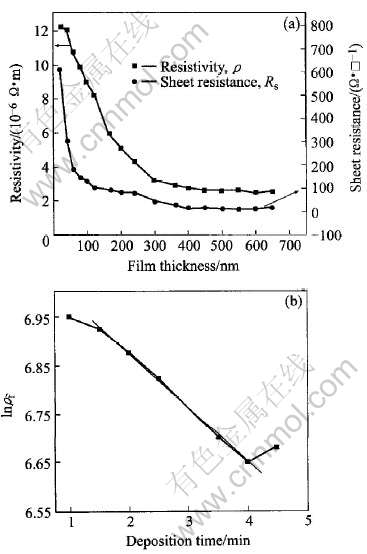
ͼ4 �������뱡Ĥ��ȵĹ�ϵ����
Fig.4 Curves of resistivity vs film thickness(Deposited at 200��, oxygen flow rate 2.4mL/s and Ar gas pressure 0.2Pa)
����, ��ʱ�ĵ��������Ҫ���ȷ��������ЧӦ(thermionic emission and tunneling)[9, 10]�� ��Ĥ�����ʦ�f���Ա�ʾΪ

ʽ�� dΪ��Ĥ���; vΪ��Ĥ������(v=12nm/min)�� ��ʽ(1)��������Ȼ�����õ��Ĺ�ϵ��ͼ4(b)��ʾ, ͨ���Ը����߽�����ϵõ�ln��f��t�����Թ�ϵ, ���ߵ�б��Ϊ-0.106�� ����

2) ��Ĥ��������, �µ�������γ�����ṹ, ����������ͨ�����γ���, ���γ�������Һ��Ĺ����Ϳ�, ��ʱ���������Ҫ����©����(percolative

ʽ�� dc�DZ�Ĥ�γ�����������ٽ���; �DZ�ʾ��©ָ���� ��ͼ4(a)�������뱡Ĥ��Ƚ��Ƴɷ�������ϵ��֪, ʽ(2)�����ĵ����������ʵ����һ�µ�, ����æ�=4/35�� ��ͼ4(b)���Կ���, ����Ĥ����ʱ�䳬��4minʱ, ʽ(1)�Ͳ��ٳ�����, ����dcΪ48~54nm���ҡ� ͼ5��ʾΪ��ͬ����ʱ����ITO��Ĥ��AFM��Ƭ�� ��ͼ�Ͽ��Կ���, ����ʱ��Ϊ3minʱ, ��Ĥ��û���γ�����״̬, ����ṹ�ո��γ�; ������ʱ��Ϊ5minʱ, ��Ĥ�Ѿ��γ��������� ���ܵı�Ĥ, ��ʱ��Ĥ�ı���ֲڶ�Ϊ6nm���ҡ� ����AFM������һ��֤ʵ������������Ƶ���ȷ��, Ҳ˵���˴�ͼ4(b)����õ�dcֵ����ȷ�ġ�
3) ��Ĥ��ȵļ�������, �����Ϳ������ʧ��, �γ���������Ĥ, ����Cotteyģ��[12, 13]��ʱ�ĵ����ʿɱ�ʾΪ

ʽ�� ��=[SX(]d[]��0(1-p)[SX)], (1-p)��1; ��0Ϊ���ӵ����ɳ�; ��bΪ������ϵĵ�����; pΪCotteyģ���еķ����� ��˵�����������ű�Ĥ������Ӷ���Сֱ���ӽ�������ϵĵ����ʡ� ��ͼ4(a)���Կ���, ����Ĥ��ȴﵽ400nmʱ, ��Ĥ�ĵ����ʼ����������ű�Ĥ��ȵı仯���ı䡣
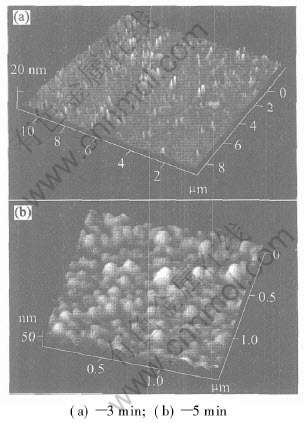
ͼ5 ��ͬ����ʱ���ITO��Ĥ��AFM 3Dͼ
Fig.5 AFM 3D images of films after different deposition time
2.3 �����¶ȶ�ITO��Ĥ���ܵ�Ӱ��
�ڲ�ͬ��Ƭ�¶�(0#Ϊ����, 1#Ϊ100��, 2#Ϊ150��, 3#Ϊ200��, 4#Ϊ300��)���Ʊ�ITOĤ, Ĥ��118nm, �����ͼ6��ʾ�� ��ͼ�ɼ�, ��Ƭ�¶�ts�Ա�Ĥ�����������Ե�Ӱ��, ��ts����200���, ��Ĥ���������Խ��͡� ����ͬ����������ʯӢ�����ϳ���ITO��Ĥ, ��ts>200��ʱ, �����ʻ������䡣 �������������ԭ���������Ϊts����, ������Ƭ�еļ��Խ���������ɢ��Ĥ/�������Ӷ����±�Ĥ�����½�, �������Ҫ��һ��ʵ��̽�֡� ������Ա���, ���ts���Ը����䵼������, ���1������6���, �������ts�ܰѷ��轵��һ�����������ϡ�

ͼ6 ��Ƭ�¶Ⱥ����ʵĹ�ϵ����
Fig.6 Curves of substrate temperature vs transmission of ITO films
ͼ7��ʾΪ��Ĥ�ķ��������ʵĹ�ϵ���ߡ� ��ͼ�п��Կ���, ���ű�Ĥ����ļ�С, һ���污Ĥ�����ʼ�С, ��һ���污Ĥ�����ս������ŷ���ļ�С��ʼ��UV�����ƶ�, ����Ĥ�����ˡ��������� ����Ҫ�����ڡ�Burstin-Moss effect��(��B-M��ЧӦ)[14-16]�����, �����ڵ����ײ���������̬�������ѱ�����ռ��, �ʴ��еĵ�����ֱ��ԾǨ��������, ��������ո������������ԾǨ�������нϸߵĿ�λ��, ����ͬ�������ȱ���ˡ� ��ͼ1�п��Կ���, ITO��Ĥ�ڿɼ��������������ɱ�Ĥ�е�������Ũ�������, ���Ա�Ĥ�����С��Ȼ��������յ���ǿ�� �ɡ�B-M��ЧӦ����Ŀ����ܴ����Ա�ʾΪ

ʽ�� m*v�� m*c�� Ne�ֱ��ʾ�۴��п�Ѩ��Ч������ �����е��ӵ���Ч�����͵���Ũ�ȡ� �������ν�ġ�Burstein-Moss���ƶ��� ʽ(4)������Ĥ�е�������Ũ�������±�Ĥ�����Ŀ����� ͬʱͼ7��ʾҲ˵����������¶�, ������߱�Ĥ��������Ũ�ȡ�
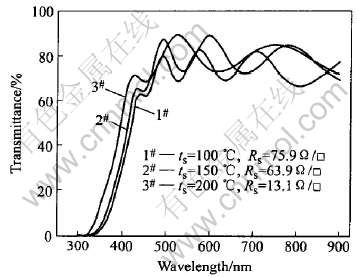
ͼ7 ITOĤ���ʺͷ���Ĺ�ϵ����
Fig.7 Curves of transmission vs ITO film sheet resistance
��2 �˻�����ITO��Ĥ���ܵĹ�ϵ
Table 2 Relationship between sheet resistance and properties after hot-treatment
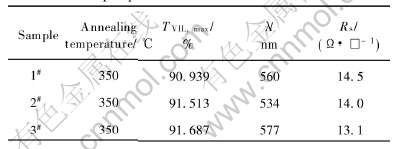
��ͼ7��1#~3#�����ڿ����н����˻���, ������2���С� �ɱ�2���Կ���, �˻���Խ�һ�����Ʊ�Ĥ�Ĺ�����ܡ� �Ƚϱ�2��ͼ7�ɷ���, 1#~3#�����Ʊ�ʱ�����¶Ƚϸ�, �����˽ᾧ�� ������ȱ��, ����û���˻���֮ǰ�������õĹ�������ˡ� ��˵��ѡ����������¶�, �ɸ��Ʊ�Ĥ���ܶ������˻�����
3 ����
1) �������ѹǿ��ITOĤ����������Ҫ��Ӱ��, ѡ��ѹǿΪ0.2Pa���������, ��ø�����ITO��Ĥ��
2) ��Ĥ�����ʡ� �����ʺ���ɫ�뱡Ĥ���(����ʱ��)�йء� ������¶�ts������߱�Ĥ������, �����䷽��, ���ջ�������tsΪ200�档 ���ts��, �˻�����ITO��Ĥ����������ߡ�
3) ���ű�Ĥ�����С, ���ձ߽���UV������ƫ��, ����B-M��ЧӦ����Ĥ��ѧ�������Ա����
4) ��Ĥ�������ű�Ĥ���������С������һ������(�������)�� ���ݱ�Ĥ������������˲�ͬ�ĵ���������ó���3���εĵ������뱡Ĥ��ȵĹ�ϵʽ�� ͨ��ʵ���AFM������һ��֤ʵ�˱�Ĥ�������������ų���ʱ��(��ȵ�����)���ֳ�3�ֲ�ͬ�ĵ������, ��ITO��Ĥ�ĵ����ʱ��ֳ����Եijߴ�ЧӦ��
��л:
��л�й���ѧԺ�뵼�������о����������Բ�ʿ��ITO��Ĥ�����ʵIJ�����
REFERENCES
[1]Miyata T, Suzuki S, Lshii M, et al. New transparent conducting thin films using multicomponent oxides composed of ZnO and V2O5 prepared by magnetron sputtering[J]. Thin Solid Films, 2002, 411: 76-79.
[2]YANG Zhi-wei, HAN Sheng-hao, YAN Tian-lin, et al. Preparation of ITO films on water-cooled flexible substrate by bias R.F. magnetron sputtering[J]. Phys, 2000, 6(49): 1196-1201.
[3]Tariq Bhatti M, Manzoor Rana A, Faheem Khan A. Characterization of rf-sputtered indium tin oxide thin films[J]. Materials Chemistry and Physics, 2004, 84: 126-130.
[4]Choi K H, ITO/Ag/ITO multiplayer films for the application of a very low resistance transparent electrode[J]. Thin Solid Films, 1999, 341(1-2): 152-155.
[5]������, ��ѧ��, �½���. �ſؽ����Ʊ�In2O3-SnO2��Ĥ�����[J]. �й���ɫ����ѧ��, 2005, 15(8): 1214-1218.
LI Shi-tao, QIAO Xue-liang, CHEN Jian-guo. The preparation and study of In2O3-SnO2 thin films deposited by magnetic sputtering[J]. The Chinese Journal of Nonferrous Metals, 2005, 15(8): 1214-1218.
[6]Minami T, Takeda Y, Takata S, et al. Preparation oftransparent conducting In4Sn3O12 thin films by DC magnetron sputtering[J]. Thin Solid Films, 1997, 308-309: 13-18.
[7]Minami T, Kakumu T, Takeda Y, et al. Highly transparent and conductive ZnO-In2O3 thin films prepared by d.c. magnetron sputtering[J]. Thin Solid Films, 1996, 290-291: 1-5.
[8]Smits F M. A history of science and engineering in the bell system: electronics technology[J]. Bell System Tech, 1958, 37: 711.
[9]Lourens J A J, Arajs S, Helberg H F, et al. Critical behavior of the electrical resistance of very thin Cr films[J]. Phys Rev B, 1988, 37: 5423.
[10]Korobov V, Leibovitch M, Shapira Y. Structure and conductance evolution of very thin indium oxide films[J]. Appl Phys Lett, 1994, 65: 2290.
[11]Coutts T J. Thin Film Devices[M]. London, New York: San Francisco Acad Press, 1978. 57.
[12]������, ���鷨. YBa2Cu3O6+x���³�������ٽ��¶�����������ϵ���������۷���[J]. �й���ѧ������ѧѧ��, 1994, 24(2): 149-151.
XIN Hou-wen, YANG Ling-fa. Percolation-theory analyses of the relation between critical temperature and oxygen content in high-Tc superconductor YBa2Cu3O6+x system[J]. Journal of China University of Science and Technology, 1994, 24(2): 149-151.
[13]Gorjanc T C, Leong D, Py C, et al. Room temperature deposition of ITO using r.f. magnetron sputtering[J]. Solid Thin Films, 2002, 413: 181-185.
[14]Roth A P, Webb J B, Williams D F. Absorption-edge shift in ZnO thin-films at high carrier densities[J]. Solid State Comm, 198, 39(12): 1269-1271.
[15]LI Shi-tao, QIAO Xue-liang, CHEN Jian-guo. Effects of oxygen flow on the properties of indium tin oxide film[J]. Materials Chemistry & Physics, 2006, 97(4): 603-607.
[16]������, ��ѧ��, �½���, ��. �ſؽ����Ʊ���ITO��Ĥ���������о�[J]. ��繤��, 2005, 32(11): 20-24.
LI Shi-tao, QIAO Xue-liang, CHEN Jian-guo, et al. Study on preparation and properties of the antireflective ITO thin films by magnetron sputtering[J]. Opto-Electric Engineering, 2005, 32(11): 20-24.
(�༭��ѧ��)
������Ŀ: ����Ԥ�п���ҵ����������Ŀ(51410020401JW0504); ���пƼ���ѧ���㲩ʿ���Ļ���������Ŀ(200439)
�ո�����: 2005-08-08; ������: 2005-12-14
ͨѶ����: ��ѧ��,����; �绰: 027-87541540; E-mail: chuyun027@163.com