DOI: 10.11817/j.issn.1672-7207.2016.04.017
�Գ�˫դ��˹����Ӧ��Si����������뵼�峡ЧӦ�ܵĶ�ά����ģ��
�����Ц�壬ϯ�ڷ������˸գ���Ŀ
(���ϿƼ���ѧ ��Ϣ���������ѧԺ������ ��̶��411201)
ժҪ��������ɢ����ֵ����������ע��ȹ��չ��̵��������Ĺ������IJ��ӷֲ������ȣ�����Գ�˫դ��˹����Ӧ���MOSFET������������������Խ����о���ͨ���Թ�����ά���ɷ�����⽨���������ṹ�ı����ƺ���ֵ��ѹģ�ͣ�������ԥSiGe���Ge��ֺͲ���ƫ���n�Ա����ƺ���ֵ��ѹ��Ӱ�졣���⣬���Աȷ�����˹���ӶԳ�˫դӦ���MOSFET�����;��Ȳ��ӶԳ�˫դӦ���MOSFET�����ı����ƺ���ֵ��ѹ���о������������ֵ��ѹ��Ӧ��SiĤ��Ge��ֵ����Ӷ����ͣ������ƺ���ֵ��ѹ��ƫ���n�����Ӷ���С����˹���ӶԳ�˫դӦ���MOSFET�����;��Ȳ��ӶԳ�˫դӦ���MOSFET�����ı����ƺ���ֵ��ѹ���ϴ����Ǿ��Ȳ��Ӷ����������ƺ���ֵ��ѹ��Ӱ��ϴ�
�ؼ��ʣ���˹���ӣ�Ӧ��Si�� ��ֵ��ѹ
��ͼ����ţ�TN302 ���ױ�־�룺A ���±�ţ�1672-7207(2016)04-1203-06
Two-dimensional analytical models for double-gate (DG) strained-Si metal-oxide-semiconductor field transistor with vertical gaussian doping profile
LI Jin, WU Xiaofeng, XI Zaifang, HU Shigang, LI Mu
(School of Information and Electrical Engineering, Hunan University of Science and Technology, Xiangtan 411201, China)
Abstract: Considering that diffusion, threshold voltage adjustment and ion implantation process cause the device channel doping distribution to be uneven, a symmetrical double-gate strained-Si metal-oxide-semiconductor field transistor (MOSFET) with a vertical Gaussian doping profile was proposed, and the two-dimensional surface potential model and threshold voltage model for this MOSFET were studied to solve Poisson��s equation. The effects of Gaussian doping straggle parameter ��n on surface potential and threshold voltage were investigated. The influence of Ge fraction in the relaxed layer on the surface potential and threshold voltage models was analyzed. Both models of DG MOSFET with Gaussian doping and uniform doping were compared, respectively. SCEs (short-channel effect) and (Drain-Induced-Barrier- lowering) DIBL were analyzed. The results show that the doping distribution has great influence on the device such as surface potential and threshold voltage.
Key words: Gaussian doping; strained Si; threshold voltage
��ʮ������������MOSFET�����ijߴ粻����С���������������׳߶ȣ��̹���ЧӦ��©�����ݽ���ЧӦ�͵���������������������ܵ�Ӱ������������������˫դMOSFET������һ�ּ���Ӧ��ǰ����������˫դ�����������Ժܺõ����ƶ̹���ЧӦ��DIBLЧӦ����������ֵ©�������������������ֵб�ʣ����Ҳ���Ҫ���ýϸߵĹ�������Ũ�ȾͿ������������Ǩ���ʣ����Ͳ������估ƫ����������ܵ�Ӱ�죬��������߹����������������������������������դ������[1-3]��Ӧ��輼�������óĵײ��Ϻ����Ӳ��ϵľ���ʧ���������Ӧ���ѹӦ��ЧӦ��þ����������ܵ�Ӧ����ϣ�ʹӦ��Si �еĵ��ӺͿ�Ѩ��Ǩ���ʵõ�������ߣ��Ӷ����MOS������������ԡ�ͬʱ��Ӧ��輼�����볣�湤�������õļ�����, �ѵõ��㷺�о���Ӧ��[4-6]��MAHATO��[7-10]��˫դӦ���SOI MOSFET�����������о��� Ȼ������Щ�о��������������Ȳ��ӣ���ʵ�����ڲ��ӹ��չ�������ɢ����ֵ�������������Ĺ������IJ��ӷֲ������ȡ����ر�ָ�����ǣ�����ע�뼼���ṩ��������IJ��ӵIJ�����ΧRn�Ͳ��ӵ�ƫ���n�ĸ�˹�ֲ�[6, 11]�����ֲ����Ȳ��ӷֲ�ʹ���������Ժ;��Ȳ��������������нϴ��𣬱������߶ԶԳ�˫դ��˹����Ӧ��Si MOSFET�����о������õĹ������������߽��Ʋ�ͨ�ñ߽���������ά���ɷ��̣�����ȫ�ľ������¶Գ�˫դ��˹����Ӧ��Si MOSFET�ı����ƺ���ֵ��ѹ��άģ�͡����ø�ģ�ͷ�����ԥSiGe ����Ge ��֡�ƫ���n��Ӱ��, �Ա�Ϊ��������ṩ�ο������, �Ը�˹����Ӧ��Si MOSFET��������Ȳ���SOI MOSFET�����ı����ƺ���ֵ��ѹ���жԱ��о�����ģ�����ý������ֵ��������Ƚϡ�
1 ������ģ��
ͼ1��ʾΪ�Գ�˫դ��˹����Ӧ���MOSFET�Ľṹʾ��ͼ�����蹵����ˮƽ������Ȳ��ӣ���ֱ�����˹���ӣ�����Ũ��ΪNA(x)�������ʽΪ[6]
 (1)
(1)
���У�NAΪ����Ũ�ȷ�ֵ�����Ӳ�����ΧRn����ƫ���n��
���Թ̶��������ɶԹ������Ƶ�Ӱ�죬���Ƕ̹�������������ʱ�������Ʒֲ������ö�ά���ɷ��̱�ʾΪ[12-15]

0��x��ts-Si��0��y��L (2)
���У���SiΪ��Ľ�糣����ts-SiΪӦ���Ĥ��ȣ�LΪ�����Ĺ������ȡ�
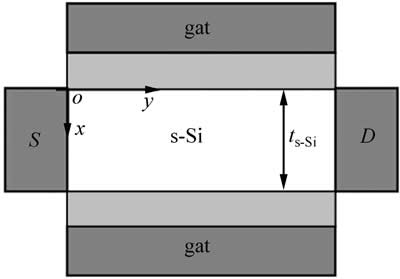
ͼ1 �Գ�˫դ��˹����Ӧ���MOSFET�Ľṹʾ��ͼ
Fig. 1 Schematic structure of DG MOSFET with vertical Gaussian doping profile
1) ����Ӧ������ǰդ���ʲ�ĵ�ͨ������, ��
 (3)
(3)
���У���oxΪդ���ʵĽ�糣����toxΪդ���ʺ�ȡ�����Ӧ�����������������Ӧ�IJ����õ�����[17-18]��
 ��
��
 ��
��







 ��������
Ϊ�������� Ϊ����դ�Ĺ�������VTΪ�ȵ��ƣ�VFB,fΪƽ����ѹ��VgsΪդԴ��ѹ,
Ϊ����դ�Ĺ�������VTΪ�ȵ��ƣ�VFB,fΪƽ����ѹ��VgsΪդԴ��ѹ,  Ϊƽ����ѹ������ֵ��
Ϊƽ����ѹ������ֵ�� ΪӦ����ƽ����ѹ��
ΪӦ����ƽ����ѹ�� ΪGe��ּ�Ӧ������
ΪGe��ּ�Ӧ������
2) ����Ӧ�����뱳դ�ʲ�ĵ�ͨ������, ��
 (4)
(4)
3)�����ڹ������洦�������������ơ�
 (5)
(5)
���У� Ϊ�����ı����ơ������µı����ӣ�
Ϊ�����ı����ơ������µı����ӣ� ������(1) �ͱ߽�����(3)~(5) ����Ϊ��
������(1) �ͱ߽�����(3)~(5) ����Ϊ��

B�ܦӡ�A��0��y��L (6)
 (7)
(7)
 (8)
(8)
 (9)
(9)
���� ��
�� �����òο�����[8��16]�еķ���,
�����òο�����[8��16]�еķ���,  ���Ա�ʾΪ
���Ա�ʾΪ
 (10)
(10)
���У�c0(y)��c1(y)��c2(y)����y�ĺ�������ֵ�������ı߽�����(7)~(9)������
 (11)
(11)
������
ͨ���߽�����(7)��(8)���ɵ�c0(y)��c1(y)��c2(y)�ı���ʽ���������ʽ(10) ���ٴ���ʽ(6)����y=0���ɵñ����Ʒ��̣�
 (12)
(12)
���� ��
��
 ��
��
����(12)�ǼĶ��׳��ַ��̣�������ʽ���£�

 (13)
(13)
���У�K1��K2Ϊ���ⳣ����
1) Դ���ı߽�����Ϊ
 (14)
(14)
���ǵ�Ӧ����Ӧ�IJ����õ�����[13-14] ��



2) ©���ı߽�����Ϊ
 (15)
(15)
���У�VDSΪ©Դ��ѹ��ͨ��Դ����©���߽���������ȷ��ʽ(6)�е�K1��K2�ֱ�Ϊ��
 (16)
(16)
 (17)
(17)
����





���У� ΪӦ�����ڽ�����
ΪӦ�����ڽ����� ������Ũ��
������Ũ�� �йص���������
�йص��������� ��
�� ��
�� ��
�� ��դ��L�йص���������
��դ��L�йص��������� ��
�� Ϊ��դ��L�йص���������
Ϊ��դ��L�йص���������
�ع����ĵ糡�����˵��ӵ�ͨ�������������ٶ�,����դ�µĵ糡Ϊ
 (18)
(18)
2 ��ֵ��ѹģ��
�����Ƶ���Сֵ����������������ֵ��ѹVth����ʽ(13)��

�õ�������С�����Ƽ���λ�ã�
 (19)
(19)
 (20)
(20)
��ֵ��ѹ����Ϊ ���ڹ����з����Ƶ�2������
���ڹ����з����Ƶ�2������ ʱ��դԴ��ѹ�����ǵ�Ӧ�䣬�����Ƶ���Сֵ����Ϊ[13-14]
ʱ��դԴ��ѹ�����ǵ�Ӧ�䣬�����Ƶ���Сֵ����Ϊ[13-14]
 (21)
(21)
���� ��
��
��ʽ(21)����ʽ(19)�õ���ֵ��ѹ��
 (22)
(22)
���� ��
�� ��
�� ��
�� ��
��
3 �������������
�������в���������������ģ�ͺ���ֵ��ѹģ�ͽ��з�������֤��դ�����ù����� =4.77 eV�Ľ�������(��TiN),դ����� tox=3 nm��Ӧ���Ĥ���ts-Si=10 nm������Ũ��
=4.77 eV�Ľ�������(��TiN),դ����� tox=3 nm��Ӧ���Ĥ���ts-Si=10 nm������Ũ�� =1��1018 cm-3, ���Ӳ���ΪRp=5 nm������ƫ���nΪ2��3��5 nm��Ӧ����
=1��1018 cm-3, ���Ӳ���ΪRp=5 nm������ƫ���nΪ2��3��5 nm��Ӧ���� Ϊ0��0.2��0.4��դ��L=70 nm��
Ϊ0��0.2��0.4��դ��L=70 nm��
ͼ2 ��ʾΪ��ԥ���Ge ���  ��ͬʱӦ��������ع�������ı����Ʒֲ��������ͼ2���Կ�������Դ�˺�©�˱��������ԥ����Ge ��ֵ����Ӷ���С��Ge ���Խ���������ԽС���ڹ����м�Σ�������������Ge ��ֵ����Ӷ����ӣ�Ge ���Խ���������Խ����ζ������ֵ��ѹ�ϵ͡���ͼ2 �������Կ�����ֱ������������Ʒֲ�����������״��֤ʵ�������߷ֲ��������ȷ�ԡ�
��ͬʱӦ��������ع�������ı����Ʒֲ��������ͼ2���Կ�������Դ�˺�©�˱��������ԥ����Ge ��ֵ����Ӷ���С��Ge ���Խ���������ԽС���ڹ����м�Σ�������������Ge ��ֵ����Ӷ����ӣ�Ge ���Խ���������Խ����ζ������ֵ��ѹ�ϵ͡���ͼ2 �������Կ�����ֱ������������Ʒֲ�����������״��֤ʵ�������߷ֲ��������ȷ�ԡ�
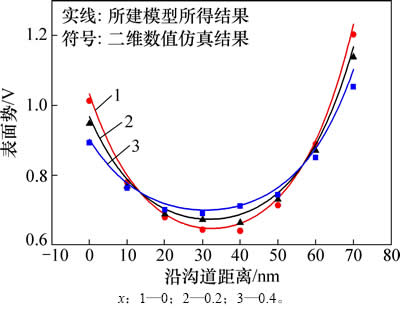
ͼ2 ��ͬGe ������ع�������ı�����
Fig. 2 Surface potential with horizontal distance along channel for different effective Ge mole fractions
ͼ3��ʾΪ��ͬ����ƫ���n���ع�������ı����Ʒֲ�����ͼ3�ɿ���������ƫ���n���±����Ƶ������̶ȷ����˱仯����nԽС������ԽС������������Ŧ�n�����Ӷ���С����ֱ��������ı����Ʒֲ�����������״����һ��֤ʵ�������߷ֲ��������ȷ�ԡ�
ͼ4 ��ʾΪ��˹���Ӻ;��Ȳ���DG MOSFET �ṹ���������ƶԱȡ���ͼ4���Կ�������˹���ӵ�DG MOSFET �ṹ�����ı����ƽϾ��Ȳ��ӵ�DG MOSFET �ṹ�����ı�����Ҫ����ˣ����뽨����˹���ӵ�DG MOSFET �ṹ���������ģ�͡�
ͼ5 ��ʾΪ��ͬGe ��� ʱ��˹����Ӧ���DG MOSFET������ֵ��ѹ�仯��������ض����������£�Ӧ�乵����Ӧ����Խ������ֵ��ѹԽС���������ڳ�ԥ����Ge ������ӣ�Ӧ��Si Ӧ���ǿ���������Ƚ�һ����С����Ec������������Ũ�Ⱥ����������ܶȾ���ߣ��Ӷ�������ֵ��ѹ��С��ͬʱ�����Ź����IJ�����С����������ֵ��ѹ����Ƚ����ԣ�����������С��40 nmʱ����ֵ��ѹ�湵�����ȼ�С�̶����Խ��͡�
ʱ��˹����Ӧ���DG MOSFET������ֵ��ѹ�仯��������ض����������£�Ӧ�乵����Ӧ����Խ������ֵ��ѹԽС���������ڳ�ԥ����Ge ������ӣ�Ӧ��Si Ӧ���ǿ���������Ƚ�һ����С����Ec������������Ũ�Ⱥ����������ܶȾ���ߣ��Ӷ�������ֵ��ѹ��С��ͬʱ�����Ź����IJ�����С����������ֵ��ѹ����Ƚ����ԣ�����������С��40 nmʱ����ֵ��ѹ�湵�����ȼ�С�̶����Խ��͡�
ͼ6��ʾΪ��ͬƫ���n�¸�˹����Ӧ���DG MOSFET������ֵ��ѹ�仯�������ͼ6���Կ���������ƫ���n�����ӣ���˹����Ӧ���DG MOSFET������ֵ��ѹ�����ӣ�������ƫ���n�����ӣ��ڹ������Ƚ϶̵��������ֵ��ѹ�Ľ������Լ��١�

ͼ3 ��ͬƫ���n���ع�������ı�����
Fig. 3 Surface potential with horizontal distance along channel for different straggle ��n
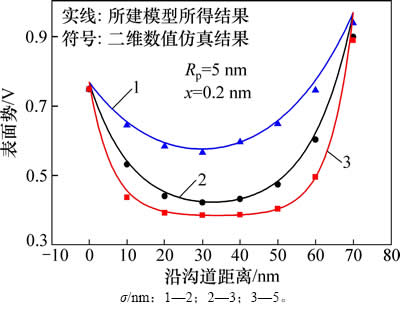
ͼ4 ��˹���Ӻ;��Ȳ���DG MOSFET �ṹ���������ƶԱ�
Fig. 4 Comparison of surface potential of DG MOSFE with Gaussian doping and with uniform doping
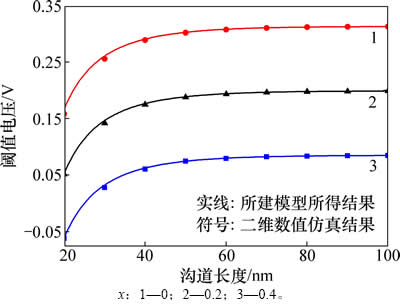
ͼ5 ��ͬGe ����¸�˹����Ӧ���DG MOSFET������ֵ��ѹ
Fig. 5 Threshold voltage of DG MOSFE for different effective Ge mole fractions

ͼ6 ��ͬƫ���n�¸�˹����Ӧ���DG MOSFET������ֵ��ѹ
Fig. 6 Threshold voltage with horizontal distance along channel for different straggle ��n
ͼ7 ��ʾΪ��˹���Ӻ;��Ȳ���DG MOSFET�ṹ������ֵ��ѹ�Աȡ���ͼ7 ���Կ�������˹���ӵ�DG MOSFET �ṹ��������ֵ��ѹ�Ͼ��Ȳ��ӵ�DG MOSFET �ṹ��������ֵ��ѹ�������ڹ����϶�ʱ��ֵ��ѹ����Ͼ��Ȳ���DG MOSFET������ֵ��ѹ�������ԡ�
ͼ8 ��ʾΪGe ���x=0.2 ʱ���ڲ�ͬƫ���n�£�DIBL�湵������L�ı仯���ߡ���ͼ8���Կ�������˹����DG MOSFET������©�����ݽ���ЧӦDIBL���Ź������ȵ�����Ѹ��������0����������ƫ���n�����ӣ���˹����DG MOSFET������DIBL����������0��

ͼ7 ��˹���Ӻ;��Ȳ���DG MOSFET �ṹ������ֵ��ѹ�Ա�
Fig. 7 Comparison of threshold voltage of DG MOSFET with Gaussian doping and with uniform doping
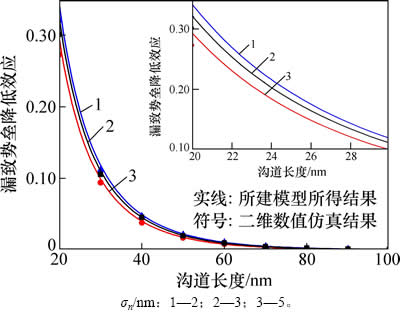
ͼ8 ��ͬƫ���n��DIBL �湵�����ȱ仯����
Fig. 8 Relationship between DIBL and channel length L for different straggle ��n
4 ����
1) �����˶Գ�˫դ��˹����Ӧ���SOI MOSFET�����и�˹���ӵĹ����Ķ�ά���ɷ��̣�ͨ������ά���ɷ���, �õ��˱����ƺ���ֵ��ѹ�Ľ���ģ�͡�
2) ����ƫ���n�����ӣ������Ʋ��Ͻ��ͣ�����ֵ��ѹ�Ľ��ͷ���Ҳ���ϼ�С��DIBLЧӦҲ��ø�С�����ض��Ĺ�����������£�Ӧ�乵����Ӧ����Խ������ֵ��ѹԽС��
3) ��˹���Ӷ�MOS��������ֵ��ѹ��Ӱ��ȶԾ��Ȳ���MOS������ֵ��ѹ��Ӱ���
�ο����ף�
[1] HE Jin, LIU Feng, ZHANG Jian, et al. A carrier-based approach for compact modeling of the long-channel undoped symmetric double-gate MOSFETs[J]. IEEE Transactions Electron Devices, 2007, 54(5): 1203-1207.
[2] CHIAGE T K, CHEN M L. A new analytical threshold voltage model for symmetric double-gate MOSFETs with high-k gate dielectrics[J]. Solid State Electron, 2007, 51(1): 387-390.
[3] ORTIZ-CONDE A,  F A, MUCI J, et al. A review of core compact models for undoped double-gate SOI MOSFETs[J]. IEEE Transactions Electron Devices, 2007, 54(1): 131-135.
F A, MUCI J, et al. A review of core compact models for undoped double-gate SOI MOSFETs[J]. IEEE Transactions Electron Devices, 2007, 54(1): 131-135.
[4] BANNA S R, CHAN PH C H, KO P K, et al. Threshold voltage model for deep-submicrometer fully depleted SOI MOSFET��s[J]. IEEE Transactions Electron Devices, 1995, 42(11): 1949-1952.
[5] JOACHIM H O, YAMAGUCHI Y, ISHIKAWA K, et al. Simulation and two-dimensional analytical modeling of subthreshold slope in ultrathin-film SOI MOSFET��s down to 0.1 ��m gate length[J]. IEEE Transactions Electron Devices, 1993, 40(10): 1812-1819.
[6] ZHANG G H, SHAO Z B, ZHOU K. Threshold voltage model of short-channel FD SOI MOSFETs with vertical Gaussian profile[J]. IEEE Transactions Electron Devices, 2008, 55(3): 803-808.
[7] MAHATO S S, CHAKRABORTY P, MAITI T K, et al. DIBL in short channel strained-Si n-MOSFET[C]//IEEE Proceedings 15th International Symposium on the Physical and Failure Analysis of Integrated Circuits (IPFA). Singapore, 2008: 1-5.
[8] KUMAR M J, VENKATARAMAN V, NAWAL S. A simple analytical threshold voltage model of nanoscale single-layer fully depleted strained-silicon-on-insulator MOSFETs 2006[J]. IEEE Transactions Electron Devices, 2006, 53(3): 2500-2505.
[9] KUMAR M, DUBEY S, TIWARI P K, et al. Analytical modeling and simulation of subthreshold characteristics of back-gated SSGOI and SSOI MOSFETs: a comparative study[J]. Current Applied Physics, 2013, 13(8): 1778-1783.
[10] MUKHOPADHYAY B, BISWAS A, BASU P K, et al. Modelling of threshold voltage and subthreshold slope of strained-Si MOSFETs including quantum effects[J]. Semiconductor Science Technology, 2008, 23(9): 095017-095021.
[11] ZHANG G H, SHAO, ZH B, ZHOU K. Threshold voltage model of short-channel FD-SOI MOSFETs with vertical gaussian profile[J]. IEEE Transactions Electron Devices, 2008, 55(4): 803.
[12] WANG Min, KE Daoming, XU Chunxia, et al. A 2-D��semi-analytical model of parasitic capacitances for MOSFETs with high k gate dielectric in short channel[J]. Solid-State Electronics, 2014, 92(5): 35.
[13] LU C C, KUEI-SHU CH L, CHE-HAO T, et al. Profiling of channel-hot-camer stress-induced trap distributions along channel and gate dielectric in high-k gated MOSFETs by a modified charge pumping technique[J]. IEEE Transactions Electron Devices, 2014, 61(4): 93.
[14] ������, �µ���. ��dz����45 nm MOSFET����ֵ����ά����ģ��[J]. ����ѧ��, 2015, 43(1): 94-98.
HAN Mingjun KE Daoming. A 2-D potential sub-threshold model for sub-45 nm MOSFETs with ultra shallow junctions[J]. Chinese J Electron, 2015, 43(1): 94.
[15] TRIPATHI S. A two-dimensional analytical model for channel��potential and threshold voltage of short channel dual material gate lightly doped drain MOSFET[J]. Chin Phys B, 2014, 23(11): 8505-8510.
[16] KUMAR P, WARI T, JIT S. Threshold voltage model for symmetric double-gate (DG) MOSFETs with non-uniform doping profile[J]. Journal of Electron Devices, 2010, 7(6): 241-247.
[17] DJEFFAL F, MEGUELLATI M, BENHAYA A. A two�Cdimensional analytical analysis of subthreshold behavior to study the scaling capability of nanoscale graded channel gate stack DG MOSFETs[J]. Physica E, 2009, 41(8): 1872-1878.
[18] KUMAR M, DUBEY S, TIWARI P K, et al. Two-dimensional modeling of subthreshold current and subthreshold swing of double material-gate(DMG) strained-Si (s-Si) on SGOI MOSFETs[J]. Journal of Computational Electronics, 2013, 12(2): 275-278.
(�༭ �²ӻ�)
�ո����ڣ�2015-05-10�������ڣ�2015-07-22
������Ŀ(Foundation item)��������Ȼ��ѧ����������Ŀ(61474042��61404049��61376076)������ʡ�Ƽ��ƻ���Ŀ(2013FJ2011��2014FJ2017)������ʡ������������Ŀ(14B060��13C321)(Projects (61474042, 61404049, 61376076) supported by the National Natural Science Foundation of China; Projects (2013FJ2011, 2014FJ2017) supported by the Science and Technology Plan of Hunan province; Projects (14B060, 13c321) supported by Education Department of Hunan Province)
ͨ�����ߣ������ʿ����ʦ�����°뵼����������ɿ����о���E-mail��lijinpower@126.com