文章编号:1004-0609(2011)06-1422-07
溅射沉积Cu-Mo薄膜的结构和性能
郭中正,孙 勇,周 铖,沈 黎,殷国祥
(昆明理工大学 云南省新材料制备与加工重点实验室,昆明 650093)
摘 要:用磁控溅射法制备含钼2.19%~35.15%(摩尔分数)的Cu-Mo合金薄膜,运用能谱仪(EDX)、X射线衍射仪(XRD)、透射电镜(TEM)、扫描电镜(SEM)、显微硬度仪和电阻计对薄膜成分、结构和性能进行研究。结果表明:Mo添加使Cu-Mo薄膜晶粒显著细化,Cu-Mo膜呈纳米晶结构,存在Mo在Cu中的FCC Cu(Mo)非平衡亚稳过饱和固溶体;随Mo含量的增加,Mo固溶度逐渐增加,而薄膜微晶体尺寸则逐渐减小,Mo的最大固溶度为30.6%。与纯Cu膜对比表明,Cu-Mo膜的显微硬度和电阻率随Mo含量的上升而持续增加。经200、400和650 ℃热处理1 h后,Cu-Mo膜的显微硬度和电阻率均降低,降幅与热处理温度呈正相关;经650 ℃退火后,Cu-Mo膜基体相晶粒长大,并出现亚微米-微米级富Cu第二相。在Cu-Mo膜的XRD谱中观察到Mo(110)特征峰,Cu-Mo薄膜结构和性能形成及演变的主要原因是添加Mo引起的晶粒细化效应以及热处理中基体相晶粒的生长。
关键词:Cu-Mo合金薄膜;纳米晶结构;热处理;显微硬度;电阻率
中图分类号:TB43;TG146.4+11 文献标志码:A
Structures and properties of Cu-Mo thin films deposited by magnetron sputtering
GUO Zhong-zheng, SUN Yong, ZHOU Cheng, SHEN Li, YING Guo-xiang
(Key Laboratory of Advanced Materials of Yunnan Province, Kunming University of Science and Technology,
Kunming 650093, China)
Abstract: The Cu-Mo alloy thin films with Mo content of 2.19%-35.15% (mole fraction) were prepared by magnetron sputtering. The compositions, structures and properties of thin films were investigated by EDX, XRD, TEM, SEM, microhardness instrument and resistivity meter. The results show that Mo addition refines the grain of Cu-Mo thin films significantly. Cu-Mo thin films possess nanocrystalline structure with the presence of FCC Cu(Mo) nonequilibrium metastable supersaturated solid solution, the Mo solubility gradually increases and the microcrystal size of thin films decreases comparatively with increasing Mo content, and the maximum Mo solubility is 30.6%. The comparison with pure Cu films reveals that both the microhardness and electrical resistivity of Cu-Mo thin films continuously increase with increasing Mo content. After heat-treated at 200, 400 and 650 ℃ for 1 h, the microhardness and resistivity of Cu-Mo coating decrease. The descending range of the microhardness and resistivity are correlated positively with heat treatment temperature. Moreover, the grain of matrix phase grows continuously, and the appearance of submicron-micron Cu-rich second-phase in Cu-Mo films is found, the Mo(110) characteristic peak is observed in Cu-Mo films after annealed at 650 ℃. The formation and evolution of structures and properties of Cu-Mo thin films are mainly contributed to the grain refinement effect caused by Mo addition as well as the growth of matrix phase grain during annealing.
Key words: Cu-Mo alloy thin films; nanocrystalline structure; heat treatment; microhardness; electrical resistivity
电子和航空航天等领域的发展要求材料兼具高导电、导热性和高温应力疲劳抗性,铜-难熔金属(如Mo、W、Nb和Ta等)合金因具备此类性能而受重视[1]。Cu/Mo/Cu层状材料的热膨胀系数和弹性模量可调,导热、导电性和加工性能优异[2]。Cu-Mo合金将高熔点、高强度的钼与高导电、导热性的铜复合[3],通常钼弥散分布于铜基体,显著提高合金强度,导电、导热性和应力疲劳抗性优异,在微电子、航空、热交换、低散热发动机领域前景广阔。研究发现,Cu-Mo薄膜电信号延迟小、电阻率低(<103 μΩ・cm)、电迁移抗性(>106 A・cm-2)高于Al基膜,可避免Cu/Si间反应生成硅化铜,可用于ULSI器件作无阻挡层互联[4-5]。PVD法制备的Cu-Mo膜呈纳米晶结构,力学性能优良,可用于光伏装置增加粘附性[6]。Cu-Mo涂层耐磨损,可作为高温固体润滑膜[7]。虽Cu-Mo呈正生成焓(28 kJ/mol),属难混溶体系,但实验表明,因远离平衡态,溅射沉积的Cu-Mo[8]和Cu-Nb[9]等薄膜中存在固溶度延展、亚稳相形成、缺陷密度急剧变化、导电性及硬度增强[10]等现象,与机械合金化的Cu-Mo[11-12]材料相似,具有重要意义而受关注。本文作者采用磁控共溅射工艺制备Cu-Mo薄膜,探讨Mo含量及热处理对Cu-Mo薄膜结构和性能的影响规律和内在原因。
1 实验
采用FJL520型高真空磁控与离子束联合溅射仪制样,在d 50 mm圆片型Cu靶(纯度99.99%)的环状溅射刻蚀区制备均匀分布的d 6 mm坑孔,等径Mo圆柱靶(纯度99.95%)嵌于孔中构成Cu-Mo复合靶,改变Mo嵌入靶数量以调整Mo靶在该区的面积比,从而控制膜成分,直流磁控溅射成膜。玻璃衬底依次以丙酮、乙醇和去离子水超声清洗作预处理,沉积前再经1 keV Ar+束轰击10 min以进一步清洗。本底真空3.5×10-4 Pa,工作气体为分析纯Ar(纯度优于99.99%),溅射气压2.0 Pa,衬底与靶材平面平行,靶基距135 mm,基片以10 r/min的转速旋转以提高膜均匀性。衬底水冷,靶功率密度较小(6.8~9.8 W/cm2)以减小二次电子和离子轰击引起衬底温升,衬底温度为20~50 ℃。石英晶振仪实时监控膜厚,膜厚为850~960 nm,预沉积一层30 nm Ti膜作缓冲层,以增加粘附性并降低膜基热应力。制备等厚纯Cu膜作对比。用于透射电镜测试的薄膜厚度约150 nm,衬底为PVF膜。真空炉中进行热处理,升温速率为10~15 ℃/min,保温时间为1 h,随炉冷却。
用PHOENIX能谱仪(EDX)测定薄膜成分,结构分析采用D8-Advance型X射线衍射仪,Cu Kα线,波长0.154 06 nm,管压30 kV,管流20 mA,石墨单色滤波,扫描步长0.02°。采用TECNAI G2透射电镜进行结构测试,加速电压200 kV;采用Philips XL30ESEM扫描电镜观察表面形貌,加速电压20 kV。采用HX-1型显微硬度计测试力学性能,136°四菱锥形金刚石压头,负载98 mN,压入深度250~350 nm,保压时间10~15 s,采样点5~10个,舍去极值点,结果取均值。采用北京华创D41-11D/ZM型微控四探针(FPP)仪测试电性能,恒流100 mA自动测试,探针负载1.96 N。测试在常温下 进行。
2 结果与讨论
2.1 Cu-Mo薄膜成分、沉积率与Mo靶面积分数的 关系
表1所列为不同Mo靶面积比时Cu-Mo薄膜的沉积参数、Mo含量和膜厚。由表1可看出,随Mo靶面积比增加,薄膜Mo含量渐增,沉积率则从11.4 nm/min渐减至5.5 nm/min。当Mo靶面积比小于16%时,薄膜Mo浓度缓慢增加,这是因为在相同Ar+入射能量下,Mo溅射产额约比Cu的低1.96倍,铜择优溅射明显。但当Mo靶面积比增至24%时,薄膜Mo含量迅速达到20.26%,这可能是因提高Mo靶面积比须在溅射刻蚀区制备更多坑孔以供嵌入,坑孔的增多改变刻蚀区的结构几何,使成分自动补偿效应趋于明显。
表1 不同Mo靶面积分数的Cu-Mo薄膜钼含量、沉积参数及膜厚
Table 1 Mo content, deposition parameters and thickness of Cu-Mo thin films with different area fractions of Mo target

2.2 Cu-Mo合金薄膜结构
2.2.1 Cu-Mo合金薄膜XRD分析
图1所示为8种成分Cu-Mo薄膜沉积态和热处理后的XRD谱。由图1可看出,沉积态Cu-Mo膜仅有Cu特征峰,呈强Cu(111)择优取向,这是由于主基体FCC Cu(111)面的表面自由能最低。相对JCPDS衍射数据(卡号04-0836),Cu(111)等峰位向低角度方向偏移(Cu(111)标准峰位为43.317°)。随Mo含量增加, Cu(111)峰偏移量渐增,而峰宽化渐趋显著,表明薄膜晶粒趋于细化。用MDI Jade 5.0 XRD分析软件,选重心法测定图1中Cu(111)主峰峰位,结果见表2。薄膜XRD谱峰偏移的主因是晶格常数变化和应力因素,沉积Ti膜作缓冲层显著降低了铜钼膜与衬底间因热膨胀系数差引起的热应力;同时,薄膜生长时间长,持续受等离子体轰击获得能量,有充足时间调整结构并释放生长内应力,因此,峰偏移应考虑晶格常数因素。由Bragg方程,Cu峰偏移显示其点阵常数增加,Mo和Cu原子半径分别为0.136 3 nm和0.127 8 nm,推测Mo在Cu中形成FCC Cu(Mo)亚稳过饱和置换式固溶体,使铜晶格常数增大,Cu-Mo薄膜存在固溶度扩展。配位数为12时,Mo原子半径为0.139 nm,用Vegard定律[13]估算铜钼膜中FCC Cu(Mo)过饱和固溶度,结果显示,随钼含量增加,Cu(Mo)固溶度渐增,Cu-35.15%Mo膜Mo的固溶度达30.6%(摩尔分数)。对主峰Cu(111)进行粒度分析表明,随Mo含量上升,Cu基体相晶粒尺寸逐渐小(见表2)。因此,添加Mo促进薄膜中Cu(Mo)固溶度扩展并细化晶粒,Cu-Mo膜呈纳米晶结构,与ZHAO等[14]报道的相似。Mo形核自由能很低,沉积中近原位附着倾向高,提供更多形核位置,随后约束Cu基体晶粒生长,产生细晶效应[4]。沉积原子扩散距离也影响相结构[15],Cu迁移激活能较高,在基片上长程扩散几率低,不易聚集生长,以致形成粗晶粒,因此,Cu-Mo膜呈纳米晶结构。同时,较低的溅射功率降低沉积能量,而较高的溅射气压增加原子碰撞几率、进一步降低动能,减弱随后的扩散迁移,促进固溶扩展和纳米晶结构的形成。如图1(b)及表2所示,经650 ℃退火1 h后,薄膜Cu(111)峰向高角度方向移动,低Mo含量膜的Cu(111)峰已与标准峰位一致,部分样品新出现Cu(200)、Cu(220)、Cu(311)及Mo(110)峰,说明Cu(111)择优取向度减弱,FCC Cu(Mo)固溶度降低,显示该亚稳固溶体的脱溶析出以及退火后高分散富Mo相某种程度的聚集。同时,退火后Cu峰宽化减弱,显示基体相的晶粒生长,高Mo含量薄膜增幅更明显。

图1 Cu-Mo薄膜样品的XRD谱
Fig.1 XRD patterns of Cu-Mo thin films: (a) As-deposited; (b) Post-annealed
2.2.2 沉积态Cu-Mo合金薄膜的TEM分析
图2所示为沉积态Cu-Mo薄膜TEM明场像及电子衍射(SAD)谱(选区范围d 100~200 nm)。可见,薄膜呈多晶态,晶粒度为纳米级,Cu-7.84%Mo膜晶界较明显(见图2(a))。随Mo含量增加,薄膜晶粒度逐渐减小(见图2(b)和(c)),与XRD分析结果相同。图2中的明场像衬度源于存在一些分散富Mo相,以及薄膜微观厚度起伏和膜中存在孔洞等缺陷。图2显示,Cu-Mo膜均存在Cu和Mo衍射谱,Mo元素衍射谱出现于较高指数晶面,这表明沉积态Cu-Mo膜XRD谱中Mo峰的缺失不能简单认为是因钼完全溶于铜中形成超饱和固溶体,而应考虑钼以高弥散态存在、铜钼衍射能力差异等因素。表3所列为由SAD谱得出的晶面间距d和点阵参数a,Cu100-xMox(x=7.84, 20.26, 35.15)膜中Cu点阵参数均值分别为0.364 nm、0.366 nm和0.371 nm,Vegard定律估算FCC Cu(Mo)固溶度分别为6.5%, 15%和29%,与XRD分析相近,SAD谱分析误差主要源于电镜相机常数及衍射环半径测差。
表2 Cu-Mo薄膜XRD谱分析结果
Table 2 XRD patterns analysis of Cu-Mo thin films


图2 沉积态Cu-Mo薄膜的TEM像
Fig.2 TEM images of as-deposited Cu-Mo thin films: (a) Cu92.16Mo7.84; (b) Cu79.74Mo20.26; (c) Cu64.85Mo35.15
2.2.3 Cu-Mo合金薄膜的SEM分析
图3和4所示分别为Cu-Mo沉积态及退火态薄膜的背散射电子(BSE)像。图3(a)为沉积态纯Cu膜BSE像。与其相较,图3(b)~(e)表示Cu100-xMox(x=2.32, 7.84, 20.26, 35.15)膜的BSE像无明显衬度,无明显聚集的富Mo相,薄膜晶粒尺寸小,说明添加Mo有显著细晶化效应,且Cu和Mo以较小尺度均匀混合,与XRD和TEM分析一致。图4所示为经650 ℃热退火1 h后,Cu-Mo膜基体相晶粒长大,其中较明亮的粒子是第二相,粒度为亚微米-微米级,粒度与Mo含量无明显关系,但第二相的量却有随Mo含量增加而增多的趋势。EDX显示,第二相并非富Mo,而存在Cu富集,这可能是由于Cu熔点较低,再结晶温度也低,在650 ℃的温度下发生再结晶生长所致,也可能兼因退火中FCC Cu(Nb)亚稳固溶体发生脱溶,从而残留富Cu相。
2.3 Cu-Mo合金薄膜性能及热处理的影响
图5(a)所示为Cu-Mo膜沉积态及不同温度热处理后的显微硬度值,图5(b)所示为薄膜电阻率值,等厚Cu膜测值用于对比。由图5(a)和(b)可以看出,添加少量Mo能显著提高膜硬度。这主要由Mo添加的细晶效应引起。沉积态Cu-Mo膜硬度值随Mo浓度增加而持续提高,退火后Cu-Mo膜硬度均有所下降,但总体上硬度仍与Mo含量呈正相关,且硬度随退火温度升高而进一步降低。热处理后,薄膜硬度下降主要归因于退火中薄膜基体晶粒的生长,高Mo含量Cu-Mo膜退火后硬度降幅较大,显然与其退火中晶粒长幅较大有关(见图 5(a)和表2)。沉积态Cu-Mo膜的电阻率也随Mo含量增加而持续增大,这是因Mo添加的细晶作用使薄膜晶界密度增加,晶界电子散射效应增 强[16],以及Mo的杂质散射效应等,使电阻率增加(见图5(b))。热处理后,薄膜的电阻率下降,并随热处理温度提高而进一步降低,电导性得以增强,这主要是因热处理中Cu-Mo膜基体晶粒的长大降低了晶界和界面密度,减弱了界面电子散射效应。图5还表明,含2.19%~20.26%Mo的Cu-Mo膜经200 ℃热处理1 h后,硬度和电阻率变化较小,400 ℃热处理1 h后,硬度仍较高,电导率进一步增加,说明该成分范围的Cu-Mo薄膜具有一定的温度稳定性。
表3 Cu-Mo薄膜的SAD谱分析
Table 3 SAD pattern analysis of Cu-Mo thin films
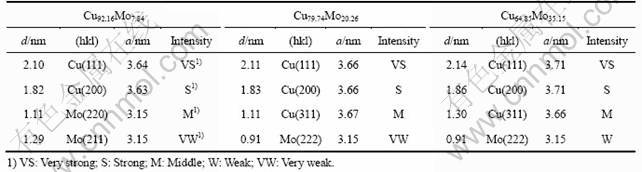
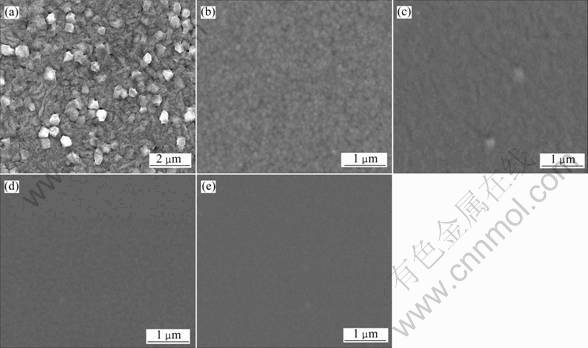
图3 沉积态薄膜BSE像
Fig.3 BSE images of as- deposited thin films: (a) Pure Cu; (b) Cu97.68Mo2.32; (c) Cu92.16Mo7.84; (d) Cu79.74Mo20.26; (e) Cu64.85Mo35.15

图4 退火态Cu-Mo薄膜的BSE像
Fig.4 BSE images of post- annealed Cu-Mo thin films: (a) Cu97.68Mo2.32; (b) Cu92.16Mo7.84; (c) Cu84.85Mo15.15; (d) Cu79.74Mo20.26; (e) Cu64.85Mo35.15

图5 Cu-Mo合金薄膜性能
Fig.5 Properties of Cu-Mo alloy thin films: (a) Microhardness; (b) Electrical resistivity
3 结 论
1) Mo添加具有细晶化作用,含2.19%~35.15%Mo (摩尔分数)的Cu-Mo薄膜呈纳米晶结构,薄膜晶粒度随Mo含量增加而持续减小。Cu-Mo薄膜中出现Mo在Cu中的固溶度扩展,存在FCC Cu(Mo)亚稳非平衡过饱和固溶体,Mo在Cu中固溶度随薄膜中Mo浓度增加而上升,最高为30.6%Mo。热处理使Cu-Mo薄膜基体相晶粒生长,出现FCC Cu(Mo)固溶体的脱溶现象,使固溶度下降。经650 ℃退火1 h后,Cu-Mo薄膜基体相的晶粒度增大但仍处于纳米级,薄膜微结构中出现亚微米-微米级富Cu第二相。
2) 添加Mo显著提高Cu-Mo薄膜的显微硬度和电阻率,沉积态Cu-Mo薄膜显微硬度和电阻率与Mo含量呈正相关。热处理降低Cu-Mo薄膜的硬度及电阻率,且随退火温度升高,降幅增大,退火中薄膜基体相晶粒发生长大是出现上述现象的主要原因。
REFERENCES
[1] WANG Hong, ZALUZEC M J, RIGSBEE J M. Microstructure and mechanical properties of sputter-deposited Cu1-xTax alloys[J]. Metallurgical and Materials Transactions, 1997, 28(3): 917-925.
[2] 杨 杨, 李正华, 程信林, 朱筱北, 裴大荣, 高文柱. Cu/Mo/Cu爆炸复合界面组织特征[J]. 稀有金属材料与工程, 2001, 30(5): 339-341.
YANG Yang, LI Zheng-hua, CHENG Xin-lin, ZHU Xiao-bei, PEI Da-rong, GAO Wen-zhu. Microstructure of Cu/Mo/Cu explosive clad interface[J]. Rare Metal Materials and Engineering, 2001, 30(5): 339-341.
[3] 韩胜利, 宋月清, 崔 舜. 烧结参数对钼-铜合金组织和性能的影响[J]. 稀有金属, 2009, 33(5): 666-669.
HAN Sheng-li, SONG Yue-qing, CUI Shun. Effect of sintering parameters on properties and microstructure of Mo-Cu alloys[J]. Chinese Journal of Rare Metals, 2009, 33(5): 666-669.
[4] LIN C H, CHU J P, MAHALINGAM T, LIN T N, WANG S F. Sputtered copper films with insoluble Mo for Cu metallization: A thermal annealing study[J]. Journal of Electronic Materials, 2003, 32(11): 1235-1239.
[5] CHU J P, LIN C H. Thermal stability of Cu(W) and Cu(Mo) films for advanced barrierless Cu metallization: Effects of annealing time[J]. Journal of Electronic Materials, 2006, 35(11): 1933-1936.
[6] GOUDEAU P, MIMAULT J, GIRARDEAU T, REKLAOUI K, PROUX O, BRANGER V. Residual stresses influence on the structural evolution of Cu-Mo solid solutions studied by X-ray diffraction[J]. Thin Solid Films, 1996, 275: 25-28.
[7] WAHL K J, SEITZMAN L E, BOLSTER R N, SINGER I L, PETERSON M B. Ion-beam deposited Cu-Mo coatings as high temperature solid lubricants[J]. Surface and Coatings Technology, 1997, 89: 245-251.
[8] XIAO H Z, CHUNG Y L, LAI S L, MA Z, ROCKETT A. Structural properties of metestable Cu-Mo solid solution thin films synthesized by magnetron sputtering[J]. Scripta Metallurgica et Materialia, 1995, 32(3): 353-358.
[9] MAHALINGAM T, LIN C H, WANG L T, CHU J P. Preparation and characterization of sputtered Cu films containing insoluble Nb[J]. Materials Chemistry and Physics, 2006, 100: 490-495.
[10] ZONG R L, WEN S P, ZENG F, GAO Y, PAN F. Nanoindentation studies of Cu-W alloy films prepared by magnetron sputtering[J]. Journal of Alloys and Compounds, 2008, 464: 544-549.
[11] AGUILAR C, ORD??EZ S, MAR?N J, CASTRO F, MART?NEZ V. Study and methods of analysis of mechanically alloyed Cu-Mo powders[J]. Materials Science and Engineering A, 2007, 464: 288-294.
[12] XI Sheng-qi, ZUO Ke-sheng, LI Xiao-gang, RAN Guang, ZHOU Jin-gen. Study on the solid solubility extension of Mo in Cu by mechanical alloying Cu with amorphous Cr(Mo)[J]. Acta Materialia, 2008, 56: 6050-6060.
[13] 潘金生, 仝健民, 田民波. 材料科学基础[M]. 北京: 清华大学出版社, 1998: 91-102.
PAN Jin-sheng, TONG Jian-min, TIAN Min-bo. Fundamentals of materials science[M]. Beijing: Tsinghua University Press, 1998: 91-102.
[14] ZHAO B, LI D M, ZENG F, PAN F. Ion beam induced formation of metastable alloy phases in Cu-Mo system during ion beam assisted deposition[J]. Applied Surface Science, 2003, 207: 334-340.
[15] SAUNDERS N, MIODONBNIK A P. Phase formation in co-deposited metallic alloy thin films[J]. Journal of Materials Science, 1987, 22: 629-637.
[16] QIU Hong, WANG Feng-ping, WU Ping. Effect of deposition rate on structural and electrical properties of Al films deposited on glass by electron beam evaporation[J]. Thin Solid Films, 2002, 414: 150-153.
(编辑 李艳红)
基金项目: 国家自然科学基金资助项目(50871049);云南省自然科学基金重点资助项目(2004E0004Z);云南省教育厅科学研究基金资助项目(09Y0091)
收稿日期:2010-06-28;修订日期:2010-09-20
通信作者:孙 勇,教授,博士;电话:0871-5334093;E-mail: xbysun@sina.com