DOI: 10.11817/j.ysxb.1004.0609.2021-36589
���ͭ�����洦�����������Ӽ��о���չ
ʦ�۾�1��½����2����Сΰ1�����˫2��֣Сΰ2���� ҫ1��̷����1������־1
(1. ����������ѧ ����ұ��ѧѧ�������� 341000��
2. ����ͭ��ͭ������˾������ 247100)
ժ Ҫ��
����5GͨѶ������Դ�����ȸ߶˲�ҵ�ķ�չ���Ե��ͭ����Ʒ����������ߵ�Ҫ���洦��������ͭ�������м�Ϊ��Ҫ��һ��ռ������ǽ��ͭ����ɫ���������ͻ�ø����ܵ��ͭ������Ҫ;�������Ĵӹ�����ͭ���о���״�����������˰����ֻ����̻����Ͻ��ۻ������黯�ȹ������̵ı��洦������������ÿ�������е��Һ�ijɷ��Լ��������Ӱ�����ؽ��з����ܽᣬ�����˴ֻ����������Ӽ��ķ��༰�о���״�뼼����չ���ص�����˰�������ϸ��������ƽ������������������Լ������εȸ����Ӽ������û��������ͭ����֯��ò�����ܱ仯��Ӱ����ɣ�չ�����ҹ�ͭ���ķ�չ����Ϊ�ҹ���������������ͭ�����������ṩ�ο���
�ؼ��ʣ�
���ͭ�������洦�������Ӽ������û�������֯��������
���±�ţ�1004-0609(2021)-05-1270-15���� ��ͼ����ţ�TG178���� ���ױ�־�룺A
���ĸ�ʽ��ʦ�۾�, ½����, ��Сΰ, ��. ���ͭ�����洦�����������Ӽ��о���չ[J]. �й���ɫ����ѧ��, 2021, 31(5): 1270-1284. DOI: 10.11817/j.ysxb.1004.0609.2021-36589
SHI Hui-juan, LU Bing-hu, FAN Xiao-wei, et al. Research progress of electrolytic copper foil surface treatment technology and additives[J]. The Chinese Journal of Nonferrous Metals, 2021, 31(5): 1270-1284. DOI: 10.11817/j.ysxb.1004.0609.2021-36589
���ͭ����Ϊ����ӡ����·�������ӵ�صĻ�������ԭ���ϣ��Ǹ��ֵ���Ԫ�������װ������[1-3]�������������Ź�������Ӽ������ƶ�ͨѶ�ĸ��»�����������·��������������ȫ�������ܶ�������������ٻ�����չ����Ӧ���ͭ����������Ӧ��Ҳ����ϸ������������Ƶ����չ�����ڵ�����Ʊ�������Ϊ������¶��ͭ�ᾧ�������ڸ�������������֬����ѹ�ϳɸ�ͭ��Ŀ�����ǿ�ȵͣ������ѱ��ϣ�ͬʱ������������������׳���ͭ��ɢ��ɺ���ӡ����·���·���գ�ֱ��������ʴ����·Ҳ��������ʴ��ɶ�·���ա���˵��ͭ����ӡ����·���ʵ������Ӧ���У���Ҫ����һϵ�еı��洦����ͨ������£�����Ԥ�������ֻ����̻����Ͻ��ۻ����黯�ȹ��չ��̣��������������Ԫ������Ӧ��Ҫ��������ͭ���������գ�ͨ����Ҫ�ڶ�Һ�м����������Ӽ����Ը��ƴ�����Ľṹ��ò����֯���ܣ����Ӽ���ͭ������ֲڶȡ�����ǿ�ȡ�����ǿ�ȡ��쳤�ʡ����������������Źؼ����á�Ŀǰ��Ӧ����ͭ�������Ӽ�����࣬���ܸ��죬������һЩ����������õ����Ӽ����ҹ���ͭ�����洦�������Ӽ��о�ȡ���˽Ͽ�ķ�չ����������һЩ���⣺1) һЩ���Ӽ����ڲ�ͬ���������µ�����ѡ�������ã���ʹ�ṹ���Ƶ�����Ҳ���������Ч��������������Ӽ����û���������ȷ������������ָ������ʵ����2) ���ڸ���ҵ�г�������ϵ�����о������Ӽ�����Ǽ������ܲ�Ʒ��ͨ���Ա����ʽ���棬ͬʱ�������ҹ���ͭ����ҵ�ı��洦��������ʹ�ú����衢�顢�����ж��к����Ӽ��������ڻ���������ҹ����ͭ�����Ʊ��ͱ��洦��������������˸��ߵ�Ҫ��3) ����5G�õ��ͭ����﮵��ͭ�����²�Ʒ�Ŀ������ҹ�����Щ���ߵ����ͭ�����о���û�и��Ϲ��ʲ�����������ձ���������¬ɭ���������ȷ�����ң������������ӹ�������������������⣬�б�Ҫ�������е������о�������ۺϵ�ǰ��������ͭ�������ı��洦���������й������ܽᣬ���������������ͭ�����������⣬������ش��������������Ӽ�������Ч����Ϊ�ҹ�ͭ����ҵ���·�չ�ṩһЩ�ο���
1 ���ͭ�����洦������
���ͭ���������ἰ����ͭ��Һ���绹�����������ͭ�ᾧ��֯���������ݷ����ڵ�һ���ɿɶ���ͨ������ʱ���������۳�������ʵ�ʳ������ĵ����Ч�ʣ�ͨ������Ч����98%���ϡ���ҵ�������Ժ�ѹ�����ʽ�ﵽ�ȶ��ĺ�������ģʽ��ͨ������������ת�ٿ��Ʊ������6~105 ��m�Ķ����Ե��ͭ�������Ͳ���Ƴ������Ϊ���棬�����γɵ���Ϊë�棬��������ɵ��DZ������ܽ���������������Ӧ�û��辭��һϵ�б��洦�����Ը���ͭ����֯���ܣ�����������Ӧ��Ҫ��Matsuda��[4]��UNO��[5]��ϸ�����˵��ͭ�����洦���Ĺ������̣������ı��洦�������дֻ����̻����Ͻ��ۻ������黯�ȹ�������ͼ1��ʾ��
1.1 �ֻ����̻�����
�ֻ���������ͭ������Ļ���λ�㣬ͨ�����ڸ����ͭ���Һ���Լ������ܶȽ��е��������þ��ȸ��ǵ�ϸС����ͭ���㣬ȡ���⻬�������������棬��������֬���������[6-9]���̻�������ֻ����в�ͬ����Ҫ��Ϊ�˽�һ�������ͼӹ����õ���֦��״�Ĵֻ����㣬�����������䣬���ڴֻ���ɢ��ͭ�����Ͻ���һ��ͭ����������֬����Ŀ�����ǿ�ȣ�����Ч����ͼ2�����⣬�ֻ���Ҫ�����Ӽ�������ã��̻���Ϊ��ͭ��Һ������ϵ��ڼ������ܶȳ�����
���ͭ���ֻ����̻��Ļ�����ͼ3��ʾ����Ӧ�������£�1) �ڵ糡�������£�ͭ������������˫����ƶ���2) ����������ͭ���ӵ�ˮ�ϳ̶����ͣ�3) ͭ���ӱ���ԭΪͭ���ʣ���������ͭ�����ϣ�4) ����̬��ͭ������ɢ��ͭ�����Ļ���λ�㣬�γ��µľ��˲����о��˵�������
��ͳ�ֻ����ղ��õ��Һ�����Ӻ��黯���Ŀ��������ı�ۻ�ԭ��λ�ӽ�Cu2+�Ļ�ԭ��λ���Ӷ��γɾ������ƣ����Ƴ���ͭ�ڼ������ܶ��µĹ���ᾧ�γ���֦״ͭ������ֱ��������ʹ��ᾧ��֯ƽ���ڱ�����ͣ��õ�������չ�IJ���״ͭ�����ֻ����ɵ������ڼ���֦����ͬʱά�ֽϵ͵Ĵֲڶ�ֵ����ô�ıȱ������������߰���ǿ�ȡ����黯�ﺬ�綾�������ڵ�ǰ���洦������Ҫ���Ŷ���[10]��ȡֱ�������γ������ն�ͭ��������еʹֻ����������ù��մ�����ͭ������ֲڶ�Rz��3 ��m�����18 ��m��ͭ��������ǿ�� ��12.74 N/cm�����12 ��m��ͭ��������ǿ��
��12.74 N/cm�����12 ��m��ͭ��������ǿ�� ��11.76 N/cm�����ڸù��ղ��������Ӽ����������ʹֻ����������У���������顢�����ж����ʣ�ʵ�����������Ĺ��ջ��������������������ɱ�����������ʵ�ֿɳ�����չ�������յ�[11]���öಽ�ֻ����գ��������Ӽ���ϵ����30 g/L Cu2+��110~150 g/L H2SO4Ϊ��ѹ������������35 ��m��ͭ�����ù��մֻ���ֲڶ�Rz��δ�ֻ�ǰ��7.0 ��m��ߵ�8.4 ��m���ϣ�������ǿ��
��11.76 N/cm�����ڸù��ղ��������Ӽ����������ʹֻ����������У���������顢�����ж����ʣ�ʵ�����������Ĺ��ջ��������������������ɱ�����������ʵ�ֿɳ�����չ�������յ�[11]���öಽ�ֻ����գ��������Ӽ���ϵ����30 g/L Cu2+��110~150 g/L H2SO4Ϊ��ѹ������������35 ��m��ͭ�����ù��մֻ���ֲڶ�Rz��δ�ֻ�ǰ��7.0 ��m��ߵ�8.4 ��m���ϣ�������ǿ�� ��20.97 N/cm����ǿ��[12]�������ͭ��ë��ֲڶȸߺͿ����������Բ�����һ�ֵ��ͭ������ϸ�ֻ��������գ��ù�����ǿ�ֻ���̻����ٽ���һ�����ֻ�������ǿ���ֻ�������Mo12Na3O40PΪ���ͻ������Ӽ�������ͭ��ë��ֲڶȵͣ�ͭ�������¡����������Ժá��γ�Ⱥ��[13]�ڲ����κ����Ӽ��������½�ͭ�����洦�������ɴֻ����ֻ����̻����̻�����Ϊ�ֻ����̻����ֻ����̻��Ķ༶ѭ�����������ù��մ�����18 ��m��ͭ������ֲڶ�Rz��6.5 ��m��������ǿ��
��20.97 N/cm����ǿ��[12]�������ͭ��ë��ֲڶȸߺͿ����������Բ�����һ�ֵ��ͭ������ϸ�ֻ��������գ��ù�����ǿ�ֻ���̻����ٽ���һ�����ֻ�������ǿ���ֻ�������Mo12Na3O40PΪ���ͻ������Ӽ�������ͭ��ë��ֲڶȵͣ�ͭ�������¡����������Ժá��γ�Ⱥ��[13]�ڲ����κ����Ӽ��������½�ͭ�����洦�������ɴֻ����ֻ����̻����̻�����Ϊ�ֻ����̻����ֻ����̻��Ķ༶ѭ�����������ù��մ�����18 ��m��ͭ������ֲڶ�Rz��6.5 ��m��������ǿ�� ��14.01 N/cm��35 ��m��ͭ������ֲڶ�Rz��8.5 ��m��������ǿ��
��14.01 N/cm��35 ��m��ͭ������ֲڶ�Rz��8.5 ��m��������ǿ�� ��19.01 N/cm�����öƲ���ò���Դﵽ�ͺ��黯������洦�����յ�ͬ��Ч��������˺������Ӽ���Ⱦ���������⣬���� IPC��4562����
��19.01 N/cm�����öƲ���ò���Դﵽ�ͺ��黯������洦�����յ�ͬ��Ч��������˺������Ӽ���Ⱦ���������⣬���� IPC��4562����

ͼ1 ���ͭ�����洦����������ͼ
Fig. 1 Flow chart of electrolytic copper foil surface treatment technology

ͼ2 ���ͭ����SME��
Fig. 2 SEM image of electrolytic copper foil
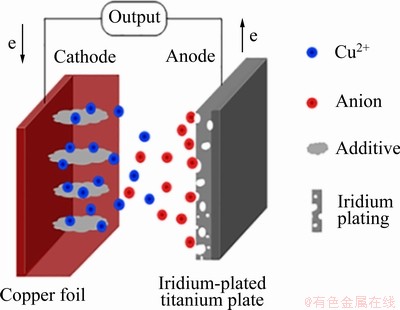
ͼ3 ���ͭ���ֻ����̻�����ʾ��ͼ
Fig. 3 Schematic diagram of coarsening and curing mechanism of electrolytic copper foil
1.2 �Ͻ���
�Ͻ���ͨ�����ڴֻ����̻�����Ļ������ٶ�һ��������ֽ������ɺϽ�ƹ��ɵĶƲ�һ��������˸�ͭ����������Լ�������ǿ�ȣ���ֹͭ������֬�����ѹʱͭ����֬������ɢ���ڿ�ʴ�����з�����©[14-15]][����һ���棬���Ȳ���ͭ����������������ԭ��أ�һ��������ʴ�����Ȳ������Ϊ��������ʴ��������ͭ�������ܵ�����(��������������������)����������ʴ���ܡ�
Ŀǰ������ӡ����·����ʵ��35 ��m�߿����������գ�Ҫ����洦��������ѹ�Ƴɸ�ͭ���ҲҪ��֤ʴ�����ܣ����Ʋ����ʴ�Թ�ǿ�����ܳ���ʴ�̲����׳��ֶ�·���������Ʋ����ʴ�Թ�����ʴ�̵�����·�Ŀ�����0.1 mm����ʱ����ֲ�ʴ�����ܳ��ֶ�·�������Ҫ����洦������к��ʵ���ʴ�ԡ�Ϊ����ߵ��ͭ���������ԺͿ�����ǿ�ȣ���Ӧ����[16]�Խ�����ء�������������п�����Ӽ�A(A��������ΪK+��Zn2+��Co2+�е�����һ��)Ϊ��Һ��������һ�־��нϸ߰���ǿ�ȵ����Ȳ㹤�գ��ù���ʹ12 ��mͭ���Ŀ����°���ǿ�� ��11.96 N/cm������ϼ��[17]��ͭ����������Ԫ�Ͻ�Zn-Ni-Sn��ȡ����ͳ�ж����۸��ۻ����գ�������Ϊ�Ʋ��е�Sn�����ͭ������ʴ�ԣ�Ni����Ч��ֹͭ��������ɫ�����⣬�ӻ��ʽ�Ϊ1.38%��������ǿ�ȸߴ�21.46 N/cm��̷���۵�[18]�����һ��Zn-Ni-P-La�Ͻ��գ��ù���ͨ���ڶƲ�������ϡ���磬�����������������ʹ�Ʋ�Ľᾧ���Ӿ���ϸ�£�����Ч��ֹ����ʱ�����������п��ɢ�����⡣Albalat��[19]���֣���Zn-Ni��Һ�м����������������Ӽ�����ʹ�ڵ�Ni����ʱ��Ҳ���Ի�þ�����С��һ������������ٵĶƲ���ò�����ҿ���ʴ������Ʋ��������������Ӷ����ӡ�Abedini��[20]�ڼ�����Һ�м��������Σ�����õ�Zn-Ni-Mn���Ȳ㼫�������Zn-Ni������7�����Ҹ�ʴ�����ܶ��������ͣ����ֳ���������ḯʴ���ܣ���ʴ�̵�����·���ܹ�ʴ�̸ɾ�����ʴ�������������ӻ��ʣ��Ȳ������·��ϸ����ơ�
��11.96 N/cm������ϼ��[17]��ͭ����������Ԫ�Ͻ�Zn-Ni-Sn��ȡ����ͳ�ж����۸��ۻ����գ�������Ϊ�Ʋ��е�Sn�����ͭ������ʴ�ԣ�Ni����Ч��ֹͭ��������ɫ�����⣬�ӻ��ʽ�Ϊ1.38%��������ǿ�ȸߴ�21.46 N/cm��̷���۵�[18]�����һ��Zn-Ni-P-La�Ͻ��գ��ù���ͨ���ڶƲ�������ϡ���磬�����������������ʹ�Ʋ�Ľᾧ���Ӿ���ϸ�£�����Ч��ֹ����ʱ�����������п��ɢ�����⡣Albalat��[19]���֣���Zn-Ni��Һ�м����������������Ӽ�����ʹ�ڵ�Ni����ʱ��Ҳ���Ի�þ�����С��һ������������ٵĶƲ���ò�����ҿ���ʴ������Ʋ��������������Ӷ����ӡ�Abedini��[20]�ڼ�����Һ�м��������Σ�����õ�Zn-Ni-Mn���Ȳ㼫�������Zn-Ni������7�����Ҹ�ʴ�����ܶ��������ͣ����ֳ���������ḯʴ���ܣ���ʴ�̵�����·���ܹ�ʴ�̸ɾ�����ʴ�������������ӻ��ʣ��Ȳ������·��ϸ����ơ�
1.3 �ۻ�����
���ڸ���Ӳ�����ĵ��ʽ�������˴�ͳ�ۻ����������ø����ζۻ����ڶۻ������н������ı������������ܵļ�ʽ����������Ĥ��������Ч���ͭ������������е���ĥ�ԺͿ������ԣ��ӳ�ͭ���Ĵ���ʱ�䡣������2006��7��1�����й����ڵĵ��ӵ�����Ʒ��ʼ��ŷ�������ƶ��ġ����������ڵ��ӵ����豸��ʹ��ijЩ�к��ɷֵ�ָ�(���ROHSָ��)���м�⣬ָ����ȷ�涨��Ǧ���ӡ��������۸����к����ʵ����������������ҹ����Ӽ��������ǰ��δ�е���ս������ȫ����ʶ�IJ�����ߣ��з�������ɫ����Ⱦ�Ķۻ�������ȡ�������ε���Ǹ�ͭ����ҵ��������Ա�о����ȵ㣬Ŀǰ�����Ρ������Ρ�ϡ���Ρ����Ρ������κ��л��εȶۻ���������������Σ��д��ڹ�ҵ���ƹ�Ӧ�á�
��Ӧ����[21]����ֲ���ζۻ������Ʊ���6~12 ��m���ͭ���ں��º����п�ʵ��140 �桢15 min��������ɫ�����º�ʪ���������������¶�80 ���ʪ��90%�������£���ʵ��72 h����������ɫ�������ּұ�[22]������һ�ֻ����͵��ͭ���������ۻ�����Һ���ô���Һ����50%ֲ�ᡢ40%�����ƺ�40%˫��ˮ(�������)��6~8����λ������ϼ���18 ��m��35 ��mͭ��ʹ�øô���Һ����ʪ�ȡ�85%���¶ȡ�60�������±���72 h��ʵ����������ɫ������ͬʱ3.3 mm�߿���18 ��mͭ����18%HCl�о���92%�Ŀ���ʴ�ԣ�3.3 mm�߿���35 ��mͭ����18%HCl����85%�Ŀ���ʴ�ԡ��ù��ձ����˴�ͳ���ղ������۸������۸��Ի����������Σ����������ROSHָ��Ҫ�����Զ��ε�������ȡ����ͳ�Ƹ���ʵ���������������������������ɱ���Ϊ���οͻ���Լ���ϳɱ���������[23]��Zn-Ni���ȺϽ��Ļ����ϲ��������ζۻ����գ��乤���䷽Ϊ������(8 g/L)������п(3 g/L)��������(4 g/L)��ֲ��(2 mL/L)�����öۻ�Ĥ����ƽ������ɫ���ȣ���ʵ��280 �桢2 h��������ɫ�����ӳ���ͭ���ı������ޡ�
1.4 ���黯����
ͭ������֬��ѹ�ϵĸ�ͭ�壬����Ҫָ������߿�����ǿ�ȡ����ڵ�����С�����ЧӦ��������Ƶ��Խ���ź�Խ����ͭ�����㣬����1 GHzʱ�������Ϊ2 ��m��10 GHzʱ�������ֻ��0.66 ��m����ˣ�����ı�����������ɵ����źŵ�ʧ����ӳ٣�Ϊ�˽��ʹ�����ʧ����Ҫͭ�����еʹֲڶȣ������ź���ʧ�����ʹֲڶ��ֽ���������֬���������������ߵķ���Ҫ�������˴ֻ��������Ѷȡ���ˣ�������Ҫͨ����ǿ��ѧ��������߿�����ǿ��ά�ֵʹֲ�ֵ���Դ�Ѱ�Һ��ʵĹ���ż����[24-25]Ϳ�����Ϊ��һ�о�����Ĺ�ͬĿ�ꡣ����ż������ˮ�����贼�ǻ������ͭ��������������ǻ��γ�Si��O��Me����Ļ�ѧ��[26-28]�����������֬������ͭ�����Ľ����������ż����������ͭ���������������ϵļ�����ͼ4��ʾ��
�����յ�[29]��5~35 �������£���ȥ����ˮ����- (2, 3-��������)����������������(KH-560)����-������������������(KH-550)�����Ϊ1:1:1���ҺΪ���Ϲ���ż������Һ��������Ϳ���ø��Ϲ���ż������ͭ��������ǿ��Ϊ21.76 N /cm����2 h�����ǿ��Ϊ21.56 N/cm����ʧ��Ϊ0.92%����288 �溸��20 s������ǿ�� Ϊ21.76 N/cm����ʧ��Ϊ0���뵥��ʹ��KH-550��HK-560��ȿɴ������ͭ������֬����Ŀ�����ǿ�ȡ�Li��[30]������������������(TMPS)��˫(������������)����(BTMSE)Ϊ�����ϼ��������ܽ��������ͽ��շ���Al��Cu����Sn�ı�����и��ԣ�֤ʵ��TMPSĤ��ͭ�������Me��O���ۼ�������ͳ����ż������ͭ�����γɵ�Me��O��������Ϊ����߽������������ż������������Ϳ���ʴ�ԣ��ڶ��о��߳�����Me��S��ȡ��Me��O����Tani��[31]����ͨ�����������Ὣƽ���ֲڶȽ�Ϊ0.5 ��m��ͭ�����湦�ܻ���Ȼ�����ú��ϻ��Ĺ���ż����Ϳ��ͭ�����棬��170 ��ѹ��1 h����ͭ������֬����Ŀ�����ǿ��Ϊ
Ϊ21.76 N/cm����ʧ��Ϊ0���뵥��ʹ��KH-550��HK-560��ȿɴ������ͭ������֬����Ŀ�����ǿ�ȡ�Li��[30]������������������(TMPS)��˫(������������)����(BTMSE)Ϊ�����ϼ��������ܽ��������ͽ��շ���Al��Cu����Sn�ı�����и��ԣ�֤ʵ��TMPSĤ��ͭ�������Me��O���ۼ�������ͳ����ż������ͭ�����γɵ�Me��O��������Ϊ����߽������������ż������������Ϳ���ʴ�ԣ��ڶ��о��߳�����Me��S��ȡ��Me��O����Tani��[31]����ͨ�����������Ὣƽ���ֲڶȽ�Ϊ0.5 ��m��ͭ�����湦�ܻ���Ȼ�����ú��ϻ��Ĺ���ż����Ϳ��ͭ�����棬��170 ��ѹ��1 h����ͭ������֬����Ŀ�����ǿ��Ϊ =10 N/cm�����ֻ�����������ᴦ��ͭ������ʱ�Ŀ�����ǿ�ȿ����25.9%��Balaji��[32]ͨ��ˮ������Ϸ�Ӧ�Ʊ��˲�ͬŨ�ȶ�����Ӳ��ӵ�3-����������������������������ܽ�-��������(PATP-GPTMS)������Ҷ�任�������X���߹������������������0.1 mol/L PATP-GPTMS/CuͿ���У�ͭ�����ϵ�PATP�����������ӣ���ǿ��ͭ����֬��Ļ�ѧ������Tafel�������߱�����PAPT-GPTMS/CuͿ�����95.52%����ʴ�ԣ���ͼ5��ʾ��
=10 N/cm�����ֻ�����������ᴦ��ͭ������ʱ�Ŀ�����ǿ�ȿ����25.9%��Balaji��[32]ͨ��ˮ������Ϸ�Ӧ�Ʊ��˲�ͬŨ�ȶ�����Ӳ��ӵ�3-����������������������������ܽ�-��������(PATP-GPTMS)������Ҷ�任�������X���߹������������������0.1 mol/L PATP-GPTMS/CuͿ���У�ͭ�����ϵ�PATP�����������ӣ���ǿ��ͭ����֬��Ļ�ѧ������Tafel�������߱�����PAPT-GPTMS/CuͿ�����95.52%����ʴ�ԣ���ͼ5��ʾ��

ͼ4 ��ˮ����ǰ���������ʾ��ͼ
Fig. 4 Schematic diagram of hydrogen bonding surface before(a) and after(b) dehydration and condensation

ͼ5 PATP-GPTMS/CuͿ��Ľṹʾ��ͼ��Tafel���������Լ�AFM��[32]
Fig. 5 Schematic diagram of structure(a), Tafel polarization curves(b) and AFM image(c) of PATP-GPTMS/Cu layer[32]
2 �ֻ����������Ӽ��ķ���
�ֻ��ڵ��ͭ�����洦������Ϊ�ؼ�����ʹͭ���������һ��֦״��ͭ��������ͭ����������ͭ���ıȱ��������߰���ǿ�ȣ�ȷ����ͭ��ѹ�ϵ������Ʊ���Ϊ���Ƴ���ͭ��������������Ч�������ѷ�������Ҫ���Ӽ����ó������̣�������ͭ��������֯���ܡ�
2.1 ����ϸ����
���ͭ���ֻ��ᾧ�����κ˺������������̣��κ��ٶȺ������ٶȶԶƲ�Ľṹ����ò���ŷdz���Ҫ������[33]���ִ�����Ӿ�Ʋ�������䣬ʹ�Ʋ����ģ����������Ӱ�����ۣ�����Ҫ���Ǵִ��������γ�ͭ�ۣ������븲ͭ������Ľ������������Ҫϸ���������ƶƲ���֯�����õľ���ϸ����ΪһЩ�������������л�ԭ�Ե����ʣ�ͨ������������ѧ����[34]����ʹ����λ��С�Ľ�������ת��Ϊ����λ�ϴ��������ӣ����������������Ӷ��ﵽϸ���������ʹֲڶ�ֵ������ȱ���������á�
ֵ��ע����ǣ�����Һ�в����κ����Ӽ�ʱ��ͭ������ˮ��ͭ���ӵ���ʽ���ڣ������뺬��������Ӽ�ʱ��ͭ���ӻ����������γɹ���λ���������֣�Žܵ�[35]�ڶ��ζ�ͭ��ϵ��̽������ϼ��Ե�����ٶȵ�Ӱ�죬�о������������Ҵ�����Ϊ����ϼ�ʱ������������EDTA��2Na�κ�a,a��-����व�Ũ���������С��������Ϊ��ϼ��������������λ�����ͳ������ʣ�ʹ�Ʋ�ϸ�¾�һ����Lin��[36]�ڻ�ѧ��ͭ��Һ�в��ü�ȩ��Ϊ��ԭ�����о����Ҷ��������������(EDTA)�����Ҵ���(TEA)���Ҷ���(En)��Ϊ��ϼ���ԭ����ͭ�Ʋ���ò���ֲڶȡ�����ȡ��ȵ�Ӱ�졣���������EDTA��һ�ֺܺõ���ϼ�������ʹ����������С���ھ��Ȼ���ͬʱ��TEA��ʹ����ȡ���(111)����ת��(220)���棬En��Ϊ����ϸ����������ͭ������ɽ��ͶƲ�Ĵֲڶȡ�
2.2 ��ƽ����������
������Ľṹ��������ò�ɻ��ĵ����ֲ�����[37]���ڵ���������У����ƽ���Ļ��������³��ְ���ƽ�Ĵ��ƻ��ױ�����һ����ɢ�㣬���氼�ݴ���ɢ��ĺ�ȴ��������߶ȣ���ƽ��ͨ����ɢ�㵽�ﰼ�ݴ���ʱ����������������������ƽ�������࣬�����˵缫��Ӧ�ļ��������ƾ����������Ӷ����ӱ����ƽ���ԡ���ƹ����г�������ƽ����2-�ϻ���������2-����������ͪ�����һ����塢�ҳ�����ͽ����̵�Ⱦ�ϡ�
Ф����[38]ͨ������2 mg/L����������ͭ(H1)��ƽ�����Ʊ�����Ӳ��Ϊ187 HV����������ֵΪ97.4 mV�Ķ�ͭ�㣬���Ҹ�Ӳ�ȿ�ά��14 d���ϣ�������ӵ�̵�Ҫ���л�Ⱦ���Ƕ�ͭ�����н�����õ���ƽ���͵ڶ������Ӽ������õ��л�Ⱦ��Ʒ�ֽ϶࣬��Ҫ�з��Ⱦ�ϡ����Ⱦ�ϡ���������Ⱦ�ϡ���������Ⱦ�ϡ����Ⱦ�ϡ�̪ݼȾ�ϺͷӺ�Ⱦ�ϵȡ�LIN��[39]�о����֣���60 LPM���������£���Һ�в����κ����Ӽ��Ʊ���ͭ�����溬�д������壬������ʹ�ý�������Ϊ������ɵ��������ʱ��ͭ���������������Լ��ٲ��ұ���Rzֵ��2.256 ��m������1.456 ��m���������̡�3-�ϻ�-1-��������ƺ;��Ҷ���(20000)���ʹ��ʱ���Ʊ���ͭ������dz��⻬���ȣ��ұ���Rzֵ��Ϊ0.132 ��m��
���༰����������ṹ�к��в����ͼ�����ԭ�ӿ������ڵ缫��������������������˼�����ƽ�����ǵ͵����ܶ����Ĺ�����[40-41]][��Fabian��[42]�þ۱�ϩ����ȡ���϶����ɻ�ø��ߵijɺ˺;�����ά�������ʣ�ʹ������������Ⱥʹֲڶȸ��͡�����SCHARIFKER��HILLS�������ά����ģ�ͣ��й�˲ʱ�ɺ˺������ɺ˻������㷺Ӧ���ڽ���������о��С������ǵ�[43]�о�����ƽ��TS-L (�����ӻ�������ļ�����)��ͭ������λ���ɺ˷�ʽ����ѧ���ܵ�Ӱ�죬���������������ƽ��TS-LŨ�ȵ����ӣ�ͭ������λ���ƣ�������ΪTS-L�ṹʽ�д�����Ļ�����Cu2+������������Ļ���λ���谭ͭ�ij��������ڶƲ㾧����ϸ������һ������ʱ��������������ת��Ϊ��������ߣ�����������ڲ���TS-L�Ķ�Һ��ͭ�ijɺ�ģ��Ϊ˲ʱ�ɺˣ�����Һ�к���20 mg/L TS-Lʱ��ͭ������ij�ʼ��Ϊ˲ʱ�ɺˣ�������TS-LŨ�ȵ����Ӽ�����ʱ����ӳ���תΪ�����ɺ˷�ʽ��ͭ����ѧ���ܲ��Ա������������Ŀ���ǿ�ȴ���290 MPa���쳤�ʸߴ�20.99%������IPC-TM-650��ӡ�Ƶ�·Э�����鷽��ָ�ϡ��������Ҫ��Varvara��[44-46]�о����֣���Ȳ������������������һ��л��Ȼ�刺����谭ͭ���Ӵ���Һ������˫���Ĵ��ʣ��дٽ�ͭ�ɺ����ƾ����������̵����ã�������ʹͭ�Ʋ��֯����δ�����Ӽ�ʱ��(111)����ת��Ϊ������ϸ��(110)���棻����Ȳ��������������������һ��л��Ȼ����15:1���(IT-85)ʱ��ϸ�����������ý���һ����ǿ���������յ����뻺���ɺ��йء�
���ں������Ӽ�һ��ɼ���ͭ���������ֳ���Ӧ�Ĺ�������ƽ���ã�������У�һ����Щ���Ӽ������Ʋ���û��ٽ���ͭ���ӽӽ��缫���棬����˳������ʣ�����ͨ��Cu+����ֱ�Ӵ�Cu2+��ԭΪCu+��������ͭ�����Ĺ�����Cu2+��ԭΪCu+�����������е��ٿز����ɼ���ͭ�ij�����Chen��[47]�о��˲�ͬ����������ƽ����ȥ����Ч����ͨ����3�����Ӽ�(3-�ϻ�-1-���������(MPS)��3-S-����f���������(UPS)��3-(������ ��-2-�ϻ�)-1-���������(ZPS)[48])�ĺ�������ԶԱ�(��ͼ6)�������������û�м���3����ƽ����������ʱ����ѹ�ȶ���-0.7 V���ң����ֱ����25 mg/L MPS��100 mg/L UPS��20 mg/L ZPSʱ��λ�������ƣ����ֳ����Ե�ȥ������������UPS��ZPS��ȥ����������MPS����ͬʱ���߾��ɽ��ͶƲ�ֲڶȡ�
�ɴ˿ɼ�����ƽ���������Ǹ��ƶ��ε����ֲ���ͨ����ɢ�����ڵ缫�ϲ��ڵ缫�����ġ���ƽ��������û�����Ե����ֽ��ޣ���������һ����ͬ�㣬���ڷ��ӽṹ�к���̼̼˫��(��C=C��)��̼̼����(��C��C��)������˫��(��N=N��)����м��Ȳ����ͼ���
2.3 ������Լ�
������Լ��ڵ�ƹ���������������Ҫ�����á���Ҫ����������[49-50]��1) ���ͶƲ�ı���������ʹ���������ⷴӦ����������2) ʹ���ױ�������۷�ɢ���ﵽȥ�����۵�Ŀ�ģ�3) ������Լ�����˫���ӣ������ڻ��ױ����γ�˫��㣬���ӹ���λ����ϸ���Ʋ㾧�������õı�����Լ��о��Ҷ���(PEG)��ʮ����������ơ��۶������������ơ�������ѻ����εȡ�
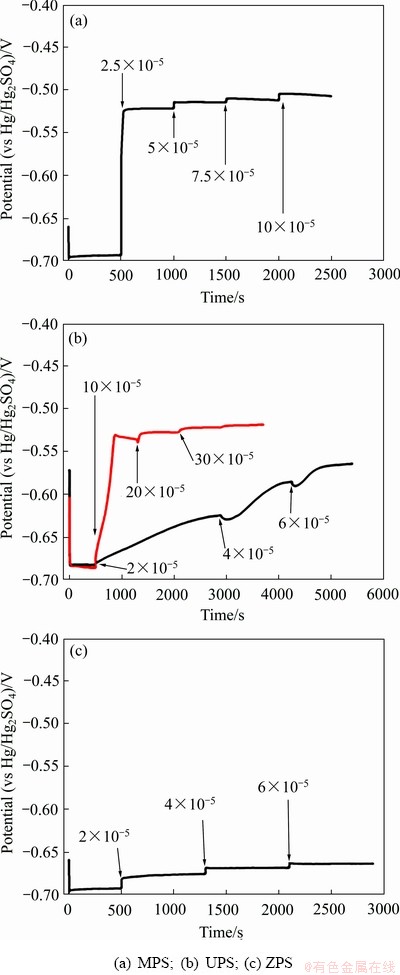
ͼ6 ���ֹ������ĺ��������ͼ[47]
Fig. 6 Schematic diagram of constant current of three brighteners analyzed at 1000 r/min[47]
Xue��[51]��ͭΪ������ǦΪ�������о��˱�����Լ���ͭ����ɡ����ȷֲ��Լ�����Ч�ʵ�Ӱ�졣���������������ϩ������ͪ(PVP)Ũ��Ϊ5 g/Lʱ������Ч����ߣ������ֲ���Χ��խ�����ǵ�����ϩ������ͪ(PVP)�;�����ϩ����ӻ�����(APES)���ʱ�������������ֲ�ʹ���öƲ�ͭ��������С�����������ߣ����Դﵽʵ����������Yi��[52]�о����������һ���ά��(HEC)�����ڼ�����ף����⾧����쳣����(��ͼ7��ʾ)��HEC�ٽ������Χͭ(220)����������ά������(111)������ȶ����������ٽ���������������߶Ʋ����ѧ���ܡ�������ά��֮������Ӽ��绯ѧ�Խϲ��ʱ���������Һ���׳��ֻ��ǡ���״�������Ӱ��ͭ�����洦��Ч����

ͼ7 ͭ�������XRD��[52]
Fig. 7 XRD patterns of copper foil surface[52]
�̼��յ�[53]��Healy��[54]][��Ϊ���Ҷ�����Ϊһ�ַ������ͱ�����Լ������������͵��Һ�ı������������ӵ��Һ�ķ�ɢ���������Ҿ��Ҷ�����������ˮ������������ڵ缫���棬ռ�ݵ缫����Ļ���λ�㣬������������������ͭ�ij������ʣ�������������Ҷ���ʱ������Ч�������ԣ���Cl-����Ҷ�����ϼ���ʱ������ PEG-Cl--Cu+�ۻ�Ĥ���γɣ�ͭ�������ʵĽ��ͽ������ԣ����Ҷ��������Զ�ͭ��Һ�е����û�����ͼ8��ʾ[33]��

ͼ8 ���Ҷ�����������Һ�еĶ�ͭ����[33]
Fig. 8 Copper plating mechanism of polyethylene glycol in acidic solution[33]
����[55-56]���ɶ��ְ�������ˮ�����γɵĸ߷��ӻ������һ�ֵ��͵ı�����Լ����ڵ糡�������£����������������������������������沢��Cu2+����γ��������������������������¾��˵��γɣ��谭Cu2+�ij�����Chang��[57]���ô�����תԲ�̵缫���Ա��о������Ե��Һ������������ͭ����ò��������С������ȡ���Ӱ�죬ͭ������ı�ɢ���������(EBSD)ͼ��������ڵ�������ڣ�������ƽ���ڱ���IJ�����������ͭ��������������ϸ����������ͭ����е���ܵ����ã���ͼ9��ʾ[57]��������[58]�о����֣���������С��20 mg/Lʱ����������������������������λ����Һ�ķ�ɢ������֮���ӣ�������Ϊ������һ�������������ڵ缫������γ�һ������Ĥ��Cu2+���봩���������Ĥ�������ڵ缫�ϵõ��ӻ�ԭ����������������30 mg/Lʱ��ͭ������ǿ�����Խ��ͣ��������ڸ�Ũ�ȵ��������ӷ����ž۲�����ͭ���������С�
2.4 �����Ӽ�
2.4.1 ������
Cl-��Ӱ��ͭ���������Ҫ���Ӽ�[59]������ͭ������Ӱ���������[60]��1) ������ͨ����ɢ���������������Ļ���λ���ϣ���ͭ���ӳ����Ļ���λ�㾺�����Ӷ�����ͭ�����Ĺ���λ���ﵽ����ͭ���ӷŵ�����ã�2) ͭ�ĵ�������������У�����Cu2+����ԭΪCu+��Ȼ��������Cu+��������ԭΪCu��Cu+����Cl-�γɲ����Եij���������������������ֹͭ�Ľ�һ��������3) ����Cl-�ġ����������ã�������һЩ���Ӽ���Cu2+�γ�����������������������ͭ�ij������ﵽϸ��������Ŀ�ġ�

ͼ9 ͭ��������ľ����仯ͼ[57]
Fig. 9 EBSD grain maps for copper foils electro- deposited[57]
���о�����[61-67]����PEG��Cl-���ʹ��ʱ������PEG-Cl--Cu+�ۻ�Ĥ���γ�ʹ��ͭ�������ʽ�����������������SPS-PEG-Cl-��ͬ����ʱ��SPSͨ������ȡ��PEG�γɵĶۻ�Ĥ����PEG���ھ�����ϵ��ʹͭ�ɺ����ʺͺ����ܶȴ�����ӣ������û�����ͼ10��ʾ[61]��
Gabrielli��[68]�ں��Ȼ��������ͭ��Һ��ͨ���绯ѧ�迹�������һ�ֻ��ƣ��û��Ʊ���ͭ���������������������ޣ���Ҫ�������ڵ缫���γ��˲����Ե�CuClĤ�㣬�谭�˵�ɵĴ������ʡ�Shao��[69]�о����֣���Ũ�ȵ�������������Һ�ĵ絼�ʣ�������ȥ���������ã�����Ũ�ȵ������������γ��������������ã�����Ҫ�����ڲ�ͬŨ�ȵ������Ӷ�˫���ṹ��Ӱ�첻ͬ��

ͼ10 SPS-PEG-Cl-��ϵ�����û���ʾ��ͼ[61]
Fig. 10 Schematic diagram of action mechanism of SPS-PEG-Cl- system[61]
2.4.2 ϡ�����Ӽ�
ϡ��Ԫ�ؾ���δ������4f���Ӻͽ�ǿ�Ľ�����[70]�������Ч������ϡ��Ԫ�ص���Щ���ԣ����Ը��ƶƲ�����ܣ�����ϡ��Ԫ�صı��缫��λ�ϸ�������ͭ����һ�㲻��ϡ���������ó������̣�����ͭ����֯�ṹ���ܡ�
Maharana��[71]����ֱ�����������ַ�ʽ������������ͭ��Һ���Ʊ���ͭ�������Cu-Y2O3���϶Ʋ㡣Ϊ����ȷ��ͭ��Cu-Y2O3���϶Ʋ㿹�������ܵIJ��죬ʵ��ֱ���540 ���675 �������¶Դ�ͭ������Ϳ�����20 h�������������������Ϳ��Ŀ������������ڴ�ͭ�ģ���540 ��������10 kHzƵ�ʳ����ĸ��϶Ʋ��������ӱ仯��С������Ϳ��Ϻõ�������Ӧ���������������ܵ���֯�ṹ����ͼ11��ʾ[71]��
��ʤ���[72-73]�о����֣�����ϡ��CA����ͭ��Һ������߲�Ʒ�Ŀ���ɫ������ʴ���������Ͷ�ͭ��Ŀ�϶��ʹ�Ʋ�����������һ�����ն��۵�Ʊ�������ϡ���Ķ�Һ�����ӳ���Ʒ����������ɫ��ʱ�䣬�ں���Ⱦ���������ĵ��Һ�м���ϡ��������ߵ͵���������λ�������ں�Ⱦ���������ĵ��Һ�м���ϡ���������������Χ���о����ֺ���ϡ���Ĺ������Զ�ͭҺ��ʹ�������ӳ��������Ӧ�óɱ��������[74]�ڶ�ͭ��ϵ�м���ϡ��������Ϻͷ�ɢ��(ϡ�������������������)�����������¹۲쵽��⣬����ϡ��Ԫ�صļ�����Դٽ��������������õ����϶Ʋ㡣�����[75] �о������Ӳ�ͬ����ϡ��RE�Ե��ͭ������֯�������ܵ�Ӱ�죬�������ϡ��RE�ļ������ϸ��������ʹ�������Ӿ������ܣ�ͬʱ�����ܸ���ͭ������ѧ���ܣ�������3��10-5 REʱ����ѧ���ܺ;���ϸ��Ч�����š�

ͼ11 ��ͭ��Cu-Y2O3 ���϶Ʋ������仯�ͱ�����ò[71]
Fig. 11 Mass change(a) and surface morphologies((b), (c)) of pure copper and Cu-Y2O3 composite coating[71]
2.4.3 ��������
��������[76]�о��������Ƽ�����������ͭ�����澧����ò��Ӱ�죬�о�������������Ʋ����״���κ��ٶ��йأ�������Ũ��Խ�ߣ��κ��ٶ�Խ�죬������Խ�ܼ��������������γɴ����Ķ༶֦�������������·��ʴ�̲���ȫ��ʹ��·����ֲ�ͭ��������ʹ�ֻ��������٣�����ͭ��������ǿ�ȣ���������ֻ��Ʋ㾧���Ĵ�С�йأ����������ƺ��������ӣ�������С��ͨ���÷����õ��Ĵֻ�ͭ������ֲڶ�Ra�����Դﵽ0.18 ��m����δ�ֻ��������200%���������[77]ͨ���ڴֻ������м����������ƣ�ʹ����ͭ��������γ��Ӷ����Σ��ı�ͭ���ӵĵ绯ѧ������λ���γɵ�ͭ��Ͻ��ڡ�ɽ�塱�����ܵ����軯���ú���ɽ�ȡ��ƶ���ʹ�ֻ�������ͭ��״�����ڷ嶥�ͷ�Ⱦ��ȷֲ������־�����״�ṹ��70 ��m��HTEͭ������Tg175�İ���Ͻ�������ǿ�ȴ���ͨͭ����11.47 N/cm������ߵ�15.98 N/cm���ϣ���ͳ���մ���ͭ����ù��մ���ͭ��������ò��ͼ12��ʾ��
��������[78]���������ƺ��������������ͻ����������Ӽ���������һ������ֻ����գ�ͨ���ڶ�Һ�м�����������Ч��ֹ���Ӽ�Sn2+���������ʣ��ﵽ�뺬��ֻ���ͬ��Ч�������ܱ��[79]���ڴֻ������У������������Ϊ�����Ӽ����о��˴ֻ�ǰ��ͭ�������ܲ����ı仯��SEM���������ܲ��������ʾ���ֻ���ͭ�ᾧ��Ģ��״�������ҳɺ������ӣ�ͬʱ�ֻ���ͭ����ʵ���������δ����ͭ����2��������ǿ�ȿ���δ����ʱ��0.62 MPa��ߵ�1.41 MPa��������[80]�����������ѡ������Ѻ���������Ϊ�ֻ����Ӽ��������������ѿ���ǿ���Һ����������������ѿɿ��ƾ��˵��γ��ٶȣ��������������Կ��ƾ����������ٶȣ����������Ũ����Ҫ�����ں��ʵķ�Χ�ڣ���Ũ�ȹ������׳��־������������18 ��mͭ�����ù��մ�������ֲڶ�ֵ��Ȼ�ܱ���Rz��3 ��m�����ҿ�����ǿ���ܱ�֤9.8 N/cm���ϣ����㳬������ͭ����Ҫ��

ͼ12 �˷����봫ͳ���մ���ͭ������Ա�ͼ
Fig. 12 Comparison of traditional copper foil surface treatment
3 ������չ��
���ͭ�����洦������������ͭ��������֯���ܵ���Ч������ͨ�����洦���γ�һ������Ĺ��ܲ㣬�ܹ���һ������ͭ���Ŀ�����ǿ�ȡ��������ԡ�����ʴ���Լ��źŴ�������ܡ����ļ�Ҫ�ܽ��˵�ǰ���ͭ�����漼�����о���չ�������˸��������������Ӽ��ijɷ������Ӱ��������Դ�Ϊ��������ϵ��Ӳ�ҵδ���ķ�չ������Ϊ���ͭ�����洦���������ص�۽����¼������档
1) ������Ч�ʡ����ܺĺͶ����̵��������գ�������е��ͭ�����洦���������̳��ɱ��ߣ����ղ�Ʒ���ܵ�Ҫ����ݸ�Ч���������գ����ܹ����������ɱ���ͬʱ��ߵ��ͭ�������ܡ�
2) ������������ͭ�����洦��������Ŀǰ�������о��ϳ������18 ��m��35 ��m���ͭ�����洦�����գ����Ǹù��ղ��ʺ�Ӧ���ڶ�㻯��·����ڲ���·��ϸ����ƣ���ˣ���������ͭ���ı��洦�����ս���δ�����о�����
3) ����������������߿�����ǿ�Ⱥ߿������Եļ���﮵�ͭ�����洦���������Լ�С����ӵ��ͭ�����ռ�ȣ�������������������
4) ̽������Ͻ��մ����ĵ���ĺͷ�������ķ�����Ŀǰ�����ͭ�����洦�������еĺϽ�����Ҫ̽���Ͻ���ͭ�������Ե�Ӱ�죬����ԸߺϽ���Ӱ����ͭ�������Ե����غ��ɴ˴����ĵ���ĺͷ��������о����١�
REFERENCES
[1] ����. ӡ�Ƶ�·�弼�������·�չ����[J]. ӡ�Ƶ�·��Ϣ, 2015(10): 10-15.
TIAN Min-bo. Recent development trend of PCB technologies[J]. Printed Circult Information, 2015(10): 10-15.
[2] ������, ������, ��ά��, ��. ���ͭ���Ļ�ɫ���洦������: �й�, 1962944A[P]. 2009-12-09.
XU Shu-min, HU Xu-ri, WANG Wei-he, et al. The gray surface treatment technology of electrolytic copper foil: China, CN1962944A[P]. 2009-12-09.
[3] ������. ���ͭ����ҵ��չ�����[J]. ӡ�Ƶ�·��Ϣ, 2004(12): 17-20.
JIN Rong-tao. Development and analyse of electrodeposited copper foil industry[J]. Printed Circult Information, 2004(12): 17-20.
[4] MATSUDA M, SAKAI H, TOMONAGA S, et al. Electrodeposited copper foil, its manufacturing method, surface-treated electrodeposited copper foil using the electrodeposited copper foil, and copper- clad laminate and printed wiring board using the surface-treated electrodeposited copper foil: US, 8722199B2[P]. 2014-05-13.
[5] UNO T, OKUNO Y, TSURUTA T, et al. Surface-treated copper foil, and copper-clad laminate and printed wiring board using same: US, 20200029444A1[P]. 2020-01-23.
[6] BARD A J, FAULKNER L R. �绯ѧ����-ԭ����Ӧ ��[M]. 2��. ��Ԫ��, �����, ����, ��, ��. ����: ��ѧ��ҵ������, 2005: 38-40.
BARD A J, FAULKNER L R. Electrochemical methods fundamentals and applications[M]. 2nd ed. SHAO Yuan-hua, ZHU Guo-yi, DONG Xian-dui, et al, transl. Beijing: Chemical Industry Press, 2005: 38-40.
[7] ������. ���ͭ������[M]. ��ɳ: ���ϴ�ѧ������, 2010: 158-160.
JIN Rong-tao. Production of electrolytic copper foil[M]. Changsha: Central South University Press, 2010: 158-160.
[8] YAMAMOTO T, KATAOKA T, HIRASAWA Y, et al. Surface treated copper foil, electrodeposited copper foil with carrier, manufacture method for the electrodeposited copper foil with carrier, and copper clad laminate: US, 20030148136A1[P]. 2003-08-07.
[9] ��־��, ������. ����PCB����ĸ������Ե��ͭ���ı��洦��[J].��ɫ��������, 2015, 5(2): 20-22.
JIAN Zhi-chao, PENG Yong-zhong. Surface treatment of high heat resistance electrolytic copper foil used for PCB[J]. Nonferrous Metals Engineering, 2015, 5(2): 20-22.
[10] �� ��, ʯ ��, ������, ��. ���ͭ������ʹֻ���������: �й�, 101067212A[P]. 2007-11-07.
ZHANG Dong, SHI Chen, ZHANG Xiao-he, et al. Electrolytic copper foil surface low coarsening treatment method: China, CN101067212A[P]. 2007-11-07.
[11] ������, ������, ���ǿ, ��. �����Ӽ���ϵ�е��ͭ���Ķಽ�ֻ�[J]. �����Ϳ��, 2015, 34(1): 20-24.
HU Xu-ri, WANG Hai-zhen, XU Hao-qiang, et al. Multistep roughening of electrolytic copper foil in additive-free bath[J]. Electroplating & Finishing, 2015, 34(1): 20-24.
[12] �� ǿ, �� ��, �ź���. һ�ֵ��ͭ�������ϸ�ֻ���������: �й�, CN110205656A[P]. 2019-09-06.
FU Qiang, FU Yi, ZHANG Hong-yang. The invention relates to a micro-coarsening process for the surface of electrolytic copper foil: China, CN110205656A[P]. 2019-09-06.
[13] �γ�Ⱥ, ��ԭɭ, �� ��, ��. һ�ֵ��ͭ�������еı��洦������: �й�, CN103088379A[P]. 2013-05-08.
HE Cheng-qun, ZHAO Yuan-sen, CHAI Yun, et al. The invention relates to a surface treatment process in the production of electrolytic copper foil: China, CN103088379A[P]. 2013-05-08.
[14] IZ��MI A, KAKARA T, OTSUKI M W, et al. In situ residual stress analysis in a phenolic resin and copper composite material during curing[J]. Polymer, 2019, 182: 121857.
[15] ֣����. ���ͭ�����洦��������ᾧ��̬[J]. ӡ�Ƶ�·��Ϣ, 2004(10): 14-16.
ZHENG Yan-nian. Copper foil surface treatment and crystalline forms[J]. Printed Circult Information, 2004(10): 14-16.
[16] ��Ӧ��, �����, ������, ��. һ����ߵ��ͭ�����¿����������洦������: �й�, CN105018978A[P]. 2015-11-04.
LI Ying-en, FAN Bin-feng, WANG Jian-zhi, et al. The invention relates to a surface treatment process for improving the stripping resistance of electrolytic copper foil at high temperature: China, CN105018978[P]. 2015-11-04.
[17] ����ϼ, ��ï��, ������, ��. ӡ�ư��õ��ͭ���������յ��о�[J]. �����Ϳ��, 2005, 24(8): 42-45.
YANG Pei-xia, AN Mao-zhong, HU Xu-ri, et al. A post-treatment technics on electrolytic copper foil used for printed board[J]. Electroplating & Finishing, 2005, 24(8): 42-45.
[18] ̷����, �� ��, �� ��, ��. ���ͭ����������Zn-Ni-P-La�Ͻ���[J]. Ӧ�û�ѧ, 2015, 32(4): 458-463.
TAN Yu-hui, WANG Yan, ZHANG Meng, et al. Electrodeposited Zn-Ni-P-La alloys coating for electrolytic copper foil[J]. Chinese Journal of Applied Chemistry, 2015, 32(4): 458-463.
[19] ALBALAT R, G��MEZ E, M��LLER C, et al. Electrodeposition of zinc-nickel alloy coatings: influence of a phenolic derivative[J]. Journal of Applied Electrochemistry, 1990, 20(4): 635-639.
[20] ABEDINI B, PARVINI A N, YAZDANI S, et al. Electrodeposition and corrosion behavior of Zn-Ni-Mn alloy coatings deposited from alkaline solution[J]. Transactions of Nonferrous Metals Society of China, 2020, 30(2): 548-558.
[21] ��Ӧ��, �����, ������, ��. ﮵����ͭ�����������������о�[J]. ������ҵ��, 2016(18): 131-132.
LI Ying-en, FAN Bin-feng, WANG Jian-zhi, et al. Research on chromium-free oxidation prevention technology of copper foil for lithium batteries[J]. Chinese and Foreign Entrepreneurs, 2016(18): 131-132.
[22] �ּұ�. һ�ֻ����͵��ͭ�����ۻ�����Һ�ʹ�������: �й�, CN107151809A[P]. 2017-09-12.
LIN Jia-bao. The invention relates to an environmentally friendly electrolytic copper foil chromium-free passivation solution and a treatment method: China, CN107151809A[P]. 2017-09-12.
[23] ������. ���ͻ���ͭ������ۻ����������о�[J]. ����, 2013(3): 189-190.
YANG Shao-kun. Study on passivation treatment technology of new environmentally-friendly copper foil surface[J].The Earth, 2013(3): 189-190.
[24] �Ž���, ������, �ż���, ��. ����ͿװԤ�����¼�����Ϳ�������о�������չ[J]. ���漼��, 2005, 34(1): 1-4.
ZHANG Jin-tao, HU Ji-ming, ZHANG Jian-qing, et al. Progress in novel surface pretreatment and studying method of origanic coated metals[J]. Surface technology, 2005, 34(1): 1-4.
[25] BORGES J N, BELMONTE T, GUILLOT J, et al. Functionalization of copper surfaces by plasma treatments to improve adhesion of epoxy resins[J]. Plasma Processes and Polymers, 2009, 6(S1): s490-s495.
[26] PALANIVEL V, ZHU D, VAN OOIJ W J. Nanoparticle- filled silane films as chromate replacements for aluminum alloys[J]. Progress in Organic Coatings, 2003, 47(3/4): 384-392.
[27] TSUCHIDA K, K��MAGAI M, AKASE F. Surface treatment for copper foil: US, 6835241B2[P]. 2004-12-28.
[28] VAN OOIJ W J, ZHU D Q, PRASAD G, et al. Silane based chromate replacements for corrosion control, paint adhesion, and rubber bonding[J]. Surface Engineering, 2000, 16(5): 386-396.
[29] ������, ��ά��, ������, ��. һ�ֵ��ͭ�����洦�������Ʊ�����: �й�, CN104099061A[P]. 2014-10-15.
HU Xu-ri, WANG Wei-he, WANG Hai-zhen, et al. Preparation method of electrolytic copper foil surface treatment agent: China, CN104099061A[P]. 2014-10-15.
[30] LI Y S, TRAN T, XU Y, et al. Spectroscopic studies of trimetoxypropylsilane and bis(trimethoxysilyl)ethane sol-gel coatings on aluminum and copper[J]. Spectrochimica Acta Part A: Molecular and Biomolecular Spectroscopy, 2006, 65(3/4): 779-786.
[31] Tani M, Sasaki S, Uenishi K. Adhesion improvement on smooth Cu wiring surfaces of printed circuit boards[J]. Transactions of The Japan Institute of Electronics Packaging, 2011, 4(1): 24-30.
[32] BALAJI J, ROH S H, EDISON T N J I, et al. Sol-gel based hybrid silane coatings for enhanced corrosion protection of copper in aqueous sodium chloride[J]. Journal of Molecular Liquids, 2020, 302: 112551.
[33] ������, ������, Ԭ��ΰ, ��. ʵ�õ�����Ӽ�[M]. ����: ��ѧ��ҵ������, 2007.
ZHANG Li-ming, FANG Jing-li, YUAN Guo-wei, et al. Practical plating additive[M]. Beijing: Chemical Industry Press, 2007.
[34] XIONG S, LIANG D, BA Z, et al. Adsorption behavior of thiadiazole derivatives as anticorrosion additives on copper oxide surface: Computational and experimental studies[J]. Applied Surface Science, 2019, 492: 399-406.
[35] ֣�Ž�, ���, ��ΰ��. ���Ҵ�����EDTA��2Na��˫�����ϵ���ٻ�ѧ��ͭ�����о�[J]. ���ϵ���, 2006, 20(10): 159-162.
ZHENG Ya-jie, LI Chun-hua, ZOU Wei-hong. Study on electroless copper plating technology of high plating rate in triethanolamine and EDTA��2Na dual-chelating-agent system[J]. Materials Reports, 2006, 20(10): 159-162.
[36] LIN Y M, YEN S C. Effects of additives and chelating agents on electroless copper plating[J]. Applied Surface Science, 2001, 178(1/4): 116-126.
[37] LEE C Y, LIN P C, YANG C H, et al. Significantly improving the etching characteristics of electroplated Cu films through microstructure modification[J]. Surface and Coatings Technology, 2020, 386: 125471.
[38] Ф ��, ��־��, ������, ��. ��ƽ�������Ե��Ӳͭ��Ӱ��[J]. �����Ϳ��, 2015, 34(19): 1082-1087.
XIAO Ning, DENG Zhi-jiang, TENG Yan-na, et al. Effects of different leveling agents on hard copper electroplating in acidic sulfate electrolyte[J]. Electroplating & Finishing, 2015, 34(19): 1082-1087.
[39] LIN C C, YEN C H, LIN S C, et al. Interactive effects of additives and electrolyte flow rate on the microstructure of electrodeposited copper foils[J]. Journal of The Electrochemical Society, 2017, 164(13): D810-D817.
[40] DAHMS W, JONAT M, SENGE G, et al. Water bath and method for electrolytic deposition of copper coatings: US, 6425996[P]. 2002-07-30.
[41] K��magai M, Hanafusa M. Copper electrolytic solution containing amine compound having specific skeleton and organosulfur compound as additives, and electrolytic copper foil produced using the same: US, 7005055B2[P]. 2006-02-28.
[42] FABIAN C P, RIDD M J, SHEEHAN M E. Assessment of activated polyacrylamide and guar as organic additives in copper electrodeposition[J]. Hydrometallurgy , 2007, 86(1/2): 44-55.
[43] ������, ������, ������, ��. ������ƽ��TS-L��ͭ�������Ӱ��[J]. �����Ϳ��, 2016, 35(11): 556-559.
DING Xin-cheng, PENG Dai-ming, CHEN Zi-xia, et al. Effect of novel leveling agent TS-L on electrodeposition of copper[J]. Electroplating & Finishing, 2016, 35(11): 556-559.
[44] VARVARA S, MURESAN L, NICOARA A, et al. Kinetic and morphological investigation of copper electrodeposition from sulfate electrolytes in the presence of an additive based on ethoxyacetic alcohol and triethyl-benzyl-ammonium chloride[J]. Materials Chemistry and Physics, 2001, 72(3): 332-336.
[45] VARVARA S, MURESAN L, POPESCU I C, et al. Comparative study of copper electrodeposition from sulphate acidic electrolytes in the presence of IT-85 and of its components[J]. Journal of Applied Electrochemistry, 2005, 35(1): 69-76.
[46] VARVARA S, MURESAN L, POPESCU I C, et al. Copper electrodeposition from sulfate electrolytes in the presence of hydroxyethylated 2-butyne-1,4-diol[J]. Hydrometallurgy, 2004, 75(1/4): 147-156.
[47] CHEN T C, TSAI Y L, HSU C F, et al. Effects of brighteners in a copper plating bath on throwing power and thermal reliability of plated through holes[J]. Electrochimica Acta, 2016, 212: 572-582.
[48] LEE H, TSAI S T, WU P H, et al. Influence of additives on electroplated copper films and their solder joints[J]. Materials Characterization, 2019, 147: 57-63.
[49] ������. ������Լ��ڵ���е�Ӧ��[J]. ���������, 2014, 24(4): 40-46.
XU Wen-zhu. The application of surfactants in electroplating[J]. Journal of Filtration & Separation, 2014, 24(4): 40-46.
[50] ������. ������Լ��ڵ���е�Ӧ��[J]. ����뻷��, 2006, 26(3): 15-16.
GUO Guo-cai. Application of surfactant in electroplating[J]. Electroplating & Pollution Control, 2006, 26(3): 15-16.
[51] XUE J Q, WU Q, WANG Z Q, et al. Function of additives in electrolytic preparation of copper powder[J]. Hydro- metallurgy, 2006, 82(3/4): 154-156.
[52] YI G, CAI F, PENG W, et al. Experimental an analysis of pinholes on electrolytic copper foil and their prevention[J]. Engineering Failure Analysis, 2012, 23: 76-81.
[53] �̼���, �Ű�ǿ, ������. ���Ҷ����ۺ϶ȶ����������軯Cu2+�ŵ��Ӱ��[J]. �ߵ�ѧУ��ѧѧ��, 1988, 9(1): 57-61.
CAI Jia-le, ZHANG Ai-qiang, ZHOU Shao-min. Effects of polymerization degree of polyglycols on their adsorption and inhibition of Cu2+ discharge[J]. Chemical Journal of Chinese Universities, 1988, 9(1): 57-61.
[54] HEALY J P, PLETCHER D, GOODENOUGH M. The chemistry of the additives in an acid copper electroplating bath[J]. Journal of Electroanalytical Chemistry, 1992, 338(1/2): 179-187.
[55] ZHANG D, YANG H. Gelatin-stabilized copper nanoparticles: Synthesis, morphology, and their surface- enhanced Raman scattering properties[J]. Physica B: Condensed Matter, 2013, 415: 44-48.
[56] ���ĺ�, �¿���. ������ұ���е�Ӧ��[J]. ������ѧ�뼼��, 1983(1): 1-10.
ZHANG Wen-hai, CHEN Jun-min. Application of gelatin in metallurgy[J]. The Science and Technology of Gelatin, 1983(1): 1-10.
[57] CHANG T, JIN Y, WEN L, et al. Synergistic effects of gelatin and convection on copper foil electrodeposition[J]. Electrochimica Acta, 2016, 211: 245-254.
[58] ������. �Ե��ͭ�������������뷽��������[J]. ӡ�Ƶ�·��Ϣ, 2002(10): 24-25.
REN Zhong-wen. The method of adding gelatin from electrolytic copper foil was discussed[J]. Printed Circult Information, 2002(10): 24-25.
[59] KONDO K, MURAKAMI H. Crystal growth of electrolytic Cu foil[J]. Journal of the Electrochemical Society, 2004, 151(7): C514-C518.
[60] KOH L T, YOU G Z, LI C Y, FOO P D. Investigation of the effects of byproduct components in Cu plating for advanced interconnect metallization[J]. Microelectronics Journal, 2002, 33(3): 229-234.
[61] YOON Y, KIM H, KIM T Y, et al. Selective determination of PEG-PPG concentration in Cu plating bath with cyclic voltammetry stripping using iodide ion[J]. Electrochimica Acta, 2020, 339: 135916.
[62] SHEN H, KIM H C, SUNG M, et al. Thermodynamic aspects of bis(3-sulfopropyl) disulfide and 3-mercapto-1- propanesulfonic acid in Cu electrodeposition[J]. Journal of Electroanalytical Chemistry, 2018, 816: 132-137.
[63] LEE A, KIM M J, CHOS S, et al. High strength Cu foil without self-annealing prepared by 2M5S-PEG-SPS[J]. Korean Journal of Chemical Engineering, 2019, 36(6): 981-987.
[64] ZHENG M, WILLEY M, WEST A C. Electrochemical nucleation of copper on ruthenium[J]. Electrochemical and Solid-State Letters, 2005, 8(10): C151-C154.
[65] MOFFAT T P, WHEELER D, JOSELL D. Electrodeposition of copper in the SPS-PEG-Cl additive system[J]. Journal of The Electrochemical Society, 2004, 151(4): C262-C271.
[66] �� ��, �� ǿ, ������, ��. PEG-Cl�����Ӽ������µ�ͭ��ᾧ�����о�[J]. ��ѧѧ��, 2007, 65(10): 881-886.
GU Min, LI Qiang, XIAN Xiao-hong, et al. Electrocrystallization of copper in the presence of PEG-Cl- additive[J]. Acta Chimica Sinica, 2007, 65(10): 881-886.
[67] HUANG L, YANG F Z, XU S K, et al. Electrochemical nucleation and growth of copper on HOPG in presence of PEG and chloride ions as additives[J]. Transactions of the IMF, 2006, 84(1): 47-51.
[68] GABRIELLI C, MOCOTEGUY P, PERROT H, et al. Mechanism of copper deposition in a sulphate bath containing chlorides[J]. Journal of Electroanalytical Chemistry, 2004, 572 (2): 367-375.
[69] SHAO W B, PATTANAIK G, ZANGARI G. Influence of chloride anions on the mechanism of copper electrodeposition from acidic sulfate electrolytes[J]. Journal of the Electrochemical Society, 2007, 154(4): D201-D207.
[70] LIU G, HUANG Z, WANG L, et al. Effects of Ce4+ on the structure and corrosion resistance of electroless deposited Ni-Cu-P coating[J]. Surface and Coatings Technology, 2013, 222: 25-30.
[71] MAHARANA H S, BASU A. Surface-mechanical and oxidation behavior of electro-co-deposited Cu-Y2O3 composite coating[J]. Surface and Coatings Technology, 2016, 304: 348-358.
[72] ��ʤ��. ϡ���ڽ������洦�������е�Ӧ�ü���(3)���� ϡ�������������ͭ�Ʋ������λ�Ϳ���ɫ������Ӱ��[J]. ���ϱ���, 2008, 41(5): 81-83.
YANG Sheng-qi. Application of rare earth in surface treatment of metal(3)��Effects of rare earth on improving the low zone orientation and resistance to discoloration of acid brigh copper coating[J]. Materials Protection, 2008, 41(5): 81-83.
[73] ��ʤ��, �ź�ΰ, ������. ϡ�����Ӽ��ڹ������Զ�ͭ�е�Ӧ��[J].���ϱ���, 2003, 36(4): 67-67.
YANG Sheng-qi, ZHANG Hong-wei, WANG Jian-zhong. Application of rare earth additives in bright acid copper plating[J]. Materials Protection, 2003, 36(4): 67-67.
[74] ����, �ƻ���, ������, ��. ϡ����������ڻ�ѧ���϶���Ӧ�õ��о�[J]. ϡ��, 2002, 23(4): 43-45.
KONG Fan-qing, YAN Hui-zhong, ZHAO Zeng-qi, et al. Composite electroless plating of the copper and rare earth luminescent material[J]. Chinese Rare Earths, 2002, 23(4): 43-45.
[75] �� ��, ���, �̷���, ��. ����RE�Ե��ͭ����֯�����ܵ�Ӱ��[J]. �������켰��ɫ�Ͻ�, 2010, 30(7): 658-660.
HE Tian, YI Guang-bin, CAI Fen-min, et al. Effect of additive RE on microstructure and properties of electrolytic copper foil[J]. Special-cast and Non-ferrous Alloys, 2010, 30(7): 658-660.
[76] ������, ʯΰ��, ������. ͭ������ֻ����յ��о�[J]. ����뾫��, 2005, 27(5): 1-3.
ZHANG Shi-chao, SHI Wei-yu, BAI Zhi-ming. Study on copper foil surface roughening technology[J]. Electroplating & Finishing, 2005, 27(5): 1-3.
[77] �����, ������, ��ά��, ��. һ�ֵ��ͭ�������ϸ�ֻ���������: �й�, CN106011965A[P]. 2016-10-12.
YANG Xiang-kui, XU Shu-min, WANG Wei-he, et al. A invention relates to a fine and coarsening process for the surface of electrolytic copper foil: China, CN106011965A[P]. 2016-10-12.
[78] ������, �� ƽ, ����־, ��. һ�����͵��ͭ������ֻ������о�[J]. ��ɫ������ѧ�빤��, 2012, 3(2): 1-4.
HUANG Yong-fa, WANG Ping, TANG Yun-zhi, et al. A research on the arsenic-free coarsening technology of copper foil[J]. Nonferrous Metals Science and Engineering, 2012, 3(2): 1-4.
[79] ���ܱ�, ������, ������, ��. ͭ��������ͭ�ֻ�����[J].���ϱ���, 2010, 43(7): 24-26.
FENG Shao-bin, LI Zhen-xing, HU Fang-hong, et al. Coarsening process of copper plating on copper foil surface[J]. Materials Protection, 2010, 43(7): 24-26.
[80] ������, ֣�ݾ�, �ƹ�ƽ, ��. һ�ֵ��ͭ�������Ӽ��������������ͭ�����洦������: �й�, CN102560584A[P]. 2012-07-11.
ZHOU Qi-lun, ZHENG Hui-jun, HUANG Guo-ping, et al. A invention relates to an additive for electrolytic copper foil and a surface treatment process for very low profile electrolytic copper foil: China, CN102560584A[P]. 2012-07-11.
Research progress of electrolytic copper foil surface treatment technology and additives
SHI Hui-juan1, LU Bing-hu2, FAN Xiao-wei1, LI Da-shuang2, ZHENG Xiao-wei2, LIU Yao1, TAN Yu-hui1, TANG Yun-zhi1
(1.Faculty of Materials Metallurgy and Chemistry, Jiangxi University of Science and Technology, Ganzhou 341000, China;
2.Anhui Tongguan Copper Foil Co., Ltd., Chizhou 247100, China)
Abstract: With the development of high-end industries, such as 5G communications and new-energy vehicles, the higher requirements for the capabilities of electrolytic copper foil products were put forward. Using an extremely important technology, the electrolyticcopper foil surface treatment is regarded as a primary way for solving copper foil green production problem and obtaining high performance coating copper foil. Here, the present domestic and foreign research status of copper foil surface treatment including coarsing process, curing process, alloying process, passivation process, silanization process, etc, were documented and summarized. Especially, the composition of the electrolyte in each process and the influencing factors of electrodeposition were presented and analyzed, respectively. Moreover, we reviewed the research status and classification of additives in coarsening progress, and emphasized the mechanism of each additives including grain refiner, leveling agent, brightener, surfactant and inorganic additive, as well as the effects of additives on morphology and properties of copper foil. Finally, the future development direction of copper foil in China was pointed out. We believe that this review will provide a reference for our country independent development of high-performance copper foil production technology.
Key words: electrolytic copper foil; surface treatment; additive; function mechanism; structure; performance
Foundation item: Projects(21671086, No. 21761013) supported by the National Natural Science Foundation of China; Project(Ganshikefa��2019��60) supported by Ganzhou Key Research and Development Program, China
Received date: 2020-06-30; Accepted date: 2021-03-16
Corresponding author: TANG Yun-zhi; Tel: +86-15879731367; Email: 9120060053@jxust.edu.con
(�༭ ����)
������Ŀ��������Ȼ��ѧ����������Ŀ(21671086��21761013)���������ص��з��ƻ�������Ŀ(���пƷ���2019��60��)
�ո����ڣ�2020-06-30�������ڣ�2021-03-16
ͨ�����ߣ�����־�����ڣ���ʿ���绰��15879731367��E-mail��9120060053@jxust.edu.cn
ժ Ҫ������5GͨѶ������Դ�����ȸ߶˲�ҵ�ķ�չ���Ե��ͭ����Ʒ����������ߵ�Ҫ���洦��������ͭ�������м�Ϊ��Ҫ��һ��ռ������ǽ��ͭ����ɫ���������ͻ�ø����ܵ��ͭ������Ҫ;�������Ĵӹ�����ͭ���о���״�����������˰����ֻ����̻����Ͻ��ۻ������黯�ȹ������̵ı��洦������������ÿ�������е��Һ�ijɷ��Լ��������Ӱ�����ؽ��з����ܽᣬ�����˴ֻ����������Ӽ��ķ��༰�о���״�뼼����չ���ص�����˰�������ϸ��������ƽ������������������Լ������εȸ����Ӽ������û��������ͭ����֯��ò�����ܱ仯��Ӱ����ɣ�չ�����ҹ�ͭ���ķ�չ����Ϊ�ҹ���������������ͭ�����������ṩ�ο���
[1] ����. ӡ�Ƶ�·�弼�������·�չ����[J]. ӡ�Ƶ�·��Ϣ, 2015(10): 10-15.
[2] ������, ������, ��ά��, ��. ���ͭ���Ļ�ɫ���洦������: �й�, 1962944A[P]. 2009-12-09.
[3] ������. ���ͭ����ҵ��չ�����[J]. ӡ�Ƶ�·��Ϣ, 2004(12): 17-20.
[7] ������. ���ͭ������[M]. ��ɳ: ���ϴ�ѧ������, 2010: 158-160.
[9] ��־��, ������. ����PCB����ĸ������Ե��ͭ���ı��洦��[J].��ɫ��������, 2015, 5(2): 20-22.
[10] �� ��, ʯ ��, ������, ��. ���ͭ������ʹֻ���������: �й�, 101067212A[P]. 2007-11-07.
[11] ������, ������, ���ǿ, ��. �����Ӽ���ϵ�е��ͭ���Ķಽ�ֻ�[J]. �����Ϳ��, 2015, 34(1): 20-24.
[12] �� ǿ, �� ��, �ź���. һ�ֵ��ͭ�������ϸ�ֻ���������: �й�, CN110205656A[P]. 2019-09-06.
[13] �γ�Ⱥ, ��ԭɭ, �� ��, ��. һ�ֵ��ͭ�������еı��洦������: �й�, CN103088379A[P]. 2013-05-08.
[15] ֣����. ���ͭ�����洦��������ᾧ��̬[J]. ӡ�Ƶ�·��Ϣ, 2004(10): 14-16.
[16] ��Ӧ��, �����, ������, ��. һ����ߵ��ͭ�����¿����������洦������: �й�, CN105018978A[P]. 2015-11-04.
[17] ����ϼ, ��ï��, ������, ��. ӡ�ư��õ��ͭ���������յ��о�[J]. �����Ϳ��, 2005, 24(8): 42-45.
[18] ̷����, �� ��, �� ��, ��. ���ͭ����������Zn-Ni-P-La�Ͻ���[J]. Ӧ�û�ѧ, 2015, 32(4): 458-463.
[21] ��Ӧ��, �����, ������, ��. ﮵����ͭ�����������������о�[J]. ������ҵ��, 2016(18): 131-132.
[22] �ּұ�. һ�ֻ����͵��ͭ�����ۻ�����Һ�ʹ�������: �й�, CN107151809A[P]. 2017-09-12.
[23] ������. ���ͻ���ͭ������ۻ����������о�[J]. ����, 2013(3): 189-190.
[24] �Ž���, ������, �ż���, ��. ����ͿװԤ�����¼�����Ϳ�������о�������չ[J]. ���漼��, 2005, 34(1): 1-4.
[29] ������, ��ά��, ������, ��. һ�ֵ��ͭ�����洦�������Ʊ�����: �й�, CN104099061A[P]. 2014-10-15.
[33] ������, ������, Ԭ��ΰ, ��. ʵ�õ�����Ӽ�[M]. ����: ��ѧ��ҵ������, 2007.
[38] Ф ��, ��־��, ������, ��. ��ƽ�������Ե��Ӳͭ��Ӱ��[J]. �����Ϳ��, 2015, 34(19): 1082-1087.
[43] ������, ������, ������, ��. ������ƽ��TS-L��ͭ�������Ӱ��[J]. �����Ϳ��, 2016, 35(11): 556-559.
[49] ������. ������Լ��ڵ���е�Ӧ��[J]. ���������, 2014, 24(4): 40-46.
[50] ������. ������Լ��ڵ���е�Ӧ��[J]. ����뻷��, 2006, 26(3): 15-16.
[53] �̼���, �Ű�ǿ, ������. ���Ҷ����ۺ϶ȶ����������軯Cu2+�ŵ��Ӱ��[J]. �ߵ�ѧУ��ѧѧ��, 1988, 9(1): 57-61.
[56] ���ĺ�, �¿���. ������ұ���е�Ӧ��[J]. ������ѧ�뼼��, 1983(1): 1-10.
[58] ������. �Ե��ͭ�������������뷽��������[J]. ӡ�Ƶ�·��Ϣ, 2002(10): 24-25.
[66] �� ��, �� ǿ, ������, ��. PEG-Cl�����Ӽ������µ�ͭ��ᾧ�����о�[J]. ��ѧѧ��, 2007, 65(10): 881-886.
[73] ��ʤ��, �ź�ΰ, ������. ϡ�����Ӽ��ڹ������Զ�ͭ�е�Ӧ��[J].���ϱ���, 2003, 36(4): 67-67.
[74] ����, �ƻ���, ������, ��. ϡ����������ڻ�ѧ���϶���Ӧ�õ��о�[J]. ϡ��, 2002, 23(4): 43-45.
[75] �� ��, ���, �̷���, ��. ����RE�Ե��ͭ����֯�����ܵ�Ӱ��[J]. �������켰��ɫ�Ͻ�, 2010, 30(7): 658-660.
[76] ������, ʯΰ��, ������. ͭ������ֻ����յ��о�[J]. ����뾫��, 2005, 27(5): 1-3.
[77] �����, ������, ��ά��, ��. һ�ֵ��ͭ�������ϸ�ֻ���������: �й�, CN106011965A[P]. 2016-10-12.
[78] ������, �� ƽ, ����־, ��. һ�����͵��ͭ������ֻ������о�[J]. ��ɫ������ѧ�빤��, 2012, 3(2): 1-4.
[79] ���ܱ�, ������, ������, ��. ͭ��������ͭ�ֻ�����[J].���ϱ���, 2010, 43(7): 24-26.


