��ͭ�Ͻ�вĵ��۽ṹ�Խ���������ܵ�Ӱ��
������ɫ�����о���Ժ�����ڽ��²��Ϲɷ�����˾
ժ Ҫ��
�ſؽ����и߳������������ڻ�øߴ��ȱ�Ĥ,��ʡ��Ĥʱ��;�߳���Ч�ʵİвĿ��Ʊ���������Ŀ�ľ�Բ��ͨ������ƽ��еĽ���ģ���о���Al-Cu�Ͻ�еľ���ȡ��;����ߴ�Խ������ʡ��������ʺͳ���Ч�ʵ�Ӱ�졣ʵ������ʾ,����������вĵ�ԭ�����Ŷȳ����ȹ�ϵ,�вĵ�ԭ�����Ŷ��ܾ���ȡ��;����ߴ��Ӱ��,���ض��ı仯��Χ,��˽�������Ҳֻ��һ����Χ�ڱ仯���������ʺͳ���Ч���ܰвı���ռ���ԭ�����ŷ���ֲ���Ӱ��,ԭ�����ŷ���ֲ����ɰвĵľ���ȡ��;����ߴ������
�ؼ��ʣ�
��ͭ�Ͻ�в�;�۽ṹ;��������;����Ч��;
��ͼ����ţ� TB43
����飺����(1983-),��,ɽ���ij���,˶ʿ�о���;�о�����:�����øߴ���Ĥ����(E-mail:lihonbn@126.com);
�ո����ڣ�2007-11-19
���������пƼ��ƻ���Ŀ(D0405001040431)����;
Effects of Target Microstructure on Al-Cu Alloy Sputtering and Depositing Performance
Abstract��
In magnetron sputtering,higher deposition rate could be helpful to deposit metal films of higher purity within shorter deposition time.Target with higher deposition efficiency could deposit more wafers.A sputtering model was developed.The effects of grain orientation and grain size of planar targets on sputtering rate,deposition rate and deposition efficiency were also investigated.The results of experiments showed that sputtering rates increased with the increase of the free atom surface density(FASD) of targets,but sputtering rates could not be too high or too low for FASD of targets changed only in a limit range.Deposition efficiency and deposition rate were influenced by proportion of grain planes of targets because atomic dense directions above grain planes determined how many atoms could deposit on the substrate.
Keyword��
Al-Cu alloy target;microstructure;deposition rate;deposition efficiency;
Received�� 2007-11-19
�ſؽ��似���Ǽ��ɵ�·�����г�����Ĥ�ij��÷���, �����ĵ�Դ���ϳ�Ϊ�вġ� ����Ļ����Ƕ���ת��, ���������ӵĶ���ת�Ƶ��б����ԭ����, ʹ֮������ܵ����������
1 �ྦྷƽ��еĽ���ģ�ͺ�ʵ��
�����о�ȷ���˵����вĵ��۽ṹ�Խ���������ܵ�Ӱ�����, ������֮Ϊ�����������¼������о��ྦྷ�еĽ������: (1) ֻ������вĽ������ƽ�еĵ�ָ������, �Ҿ��������ϵ�ڽ������������Сƽ���ڶ���ͬ; (2) ����ԭ����Դ�ڰвı���, ԭ���ذвı����ռ��ڵ����ŷ������ȷ���, ������������ԭ���ܶȳ�����; (3) ����ԭ�ӳ������������������ײ��
���ߴ�Al-0.5%Cu(��������)�Ͻ��Ǽ��ɵ�·�����й㷺Ӧ�õĽ�������
ʽ��, VhklΪ(hkl)������ռ�ı���, I
ʹ���п������������λ�ſؽ���̨���ж�Ĥ, �����������1��
ʹ�þ���Ϊ10-4 g�ij����dz����вĽ���ǰ�������, ͨ��HITACHI S-4800 �䳡����ɨ��羵�۲챡Ĥ�����, �����˱�Ĥ��ȡ� ���������ðе���ʧ�����뽦��ʱ��֮�ȱ�ʾ, ���������ñ�Ĥ��������ʱ��֮�ȱ�ʾ, ����Ч���ó��������뽦������֮�ȱ�ʾ�� �������ʸ߲������Խ�ʡ��Ĥʱ��, �����������ų����������Ӱ���øߴ���AlĤ
��1 �Ʊ���Ĥ�Ľ�������
Table 1 Typical film preparation conditions
Vacuum |
Pressure of Ar | Power of DC | Silicon wafer |
2��10-7 Torr |
1 Pa | 100 W | 2 inches |
2 ���������
Al-0.5%Cu(��������)�Ͻ���Cuԭ��Ħ���ٷֱ�Ϊ0.21%, ���ԭ������Ϊ27.06 g��mol-1, ����ṹΪ��������, X��������ɷ������ĵ�ָ��������Ҫ��(111), (200), (220)��(311)�� ���ݼ���(1), �����б���ֻ������4�־�����ɽ����о���
2.1 ����ȡ��;����ߴ�Խ������ʵ�Ӱ��
ʹ�ñ�������ԭ���ܶ�(free atom surface density, FASD)
�ྦྷ�еı�������ԭ���ܶ��ɹ�ʽ(3)����:
FASD=��A(hkl)��FASD(hkl) (3)
A(hkl)Ϊ�б����Ͼ���ȡ��Ϊ(hkl)�ľ�����ռ�ı���, FASD(hkl)Ϊ(hkl)���������ԭ���ܶȡ� ������淢��һ��ԭ�Ӻ�, �в���ʧ������Ϊ
ʽ��, SΪ�����������, MΪ�е����ԭ������, NAΪ����٤��������
ͼ1��Al-Cu�еĽ���������FASD�Ĺ�ϵ, ���Կ������߳�����������ϵ��, ��������������ƽ��ֵ6.9��10-4 g��min-1���²���, �������������С��������֮��Ϊ1��10-4 g��min-1��
�ɼ���(2), �в�����ͬʱ���ڽ�������ͬ��Ŀ��ԭ�Ӳ㡣 �Խ������ʺ�FASD��ȡƽ��ֵ, ��Ϲ�ʽ(4)������з����ƽ��ԭ�Ӳ���ĿΪ1891 min-1�� ��ʵ����FASD���Ϊ10.8 atom��nm-2�İ���FASD��СΪ9.2 atom��nm-2�İ�, �佦������֮��Ϊ7��10-5 g��min-1, ����1891 min-1���빫ʽ(4)����������۽�������֮��Ϊ1.1��10-4 g��min-1, ��ʵ��ֵ����һ�¡�
���ڱ����жྦྷ�еı�������ԭ���ܶ�ֻ��7.4��14.2 atom��nm-2��Χ�ڱ仯, ��˽�������Ҳֻ����һ����Χ�ڱ仯��
ͼ2�����˾����ߴ��뽦�����ʵĹ�ϵ, �����������ž����ߴ����Ӷ����ӡ� ���ڱ�ʵ���авľ����ߴ���40 ��m����, ������ռ�ı����dz�С, ��˾���Խ������ʵ�Ӱ�������ȫ���ԡ� ���������澧���ߴ�����вĵ�FASD������, ��˱�����ΪӰ�콦�����ʵ���Ҫ����Ϊ�вĵı�������ԭ���ܶȡ�
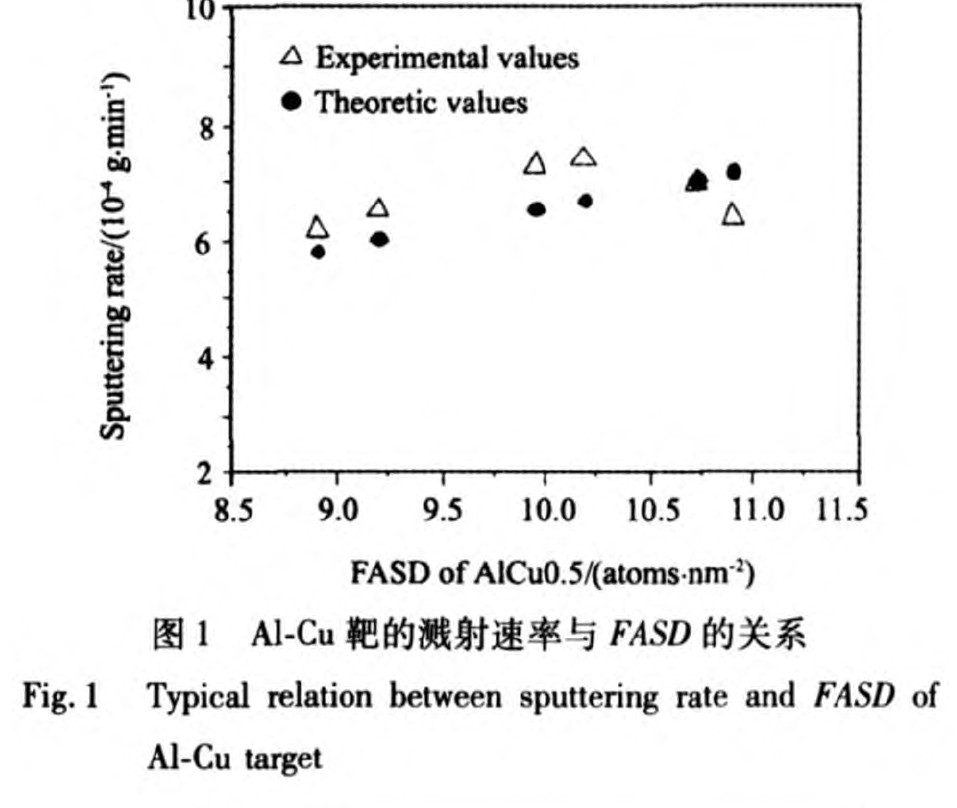
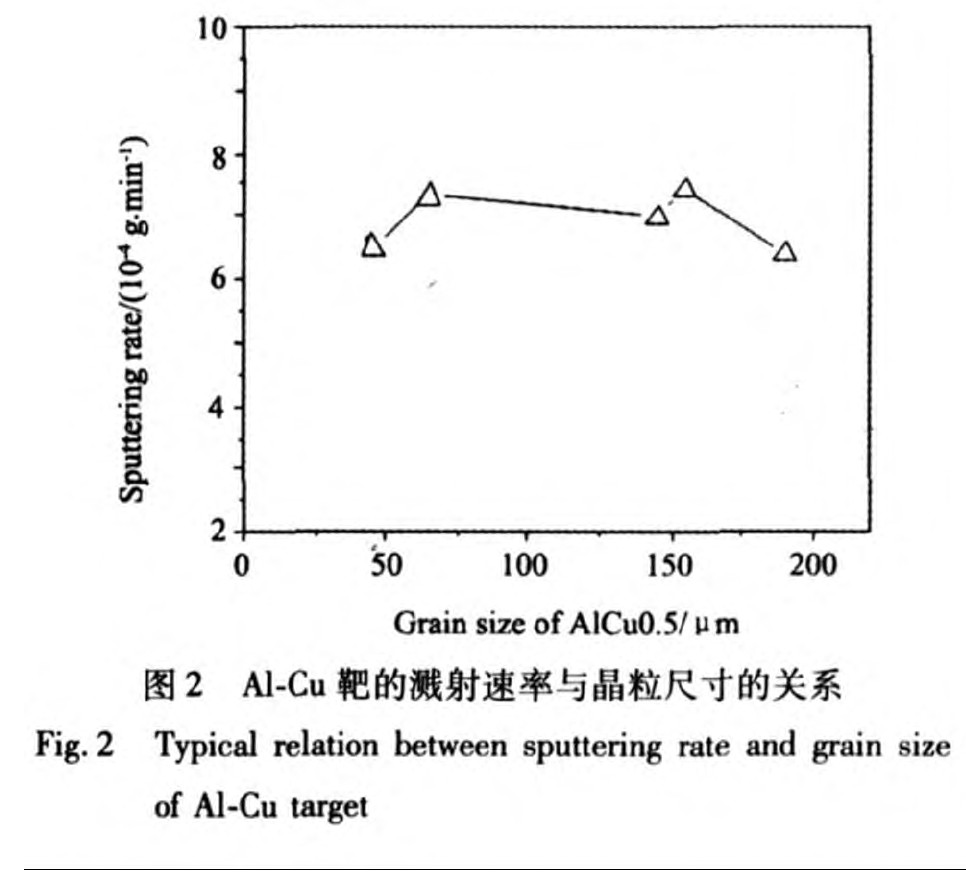
2.2 ����ȡ��;����ߴ�Գ������ʵ�Ӱ��
���ݼ���(3), �����������ʵ������ав�ԭ�ӵķ�����Ŀ�ͷ��� ԭ�ӵ����ȷ��䷽���������ŷ���
a=arcos
��ʽ��, h1k1l1����ͬһ����������ŷ���ľ���ָ��, h2k2l2�������淨�ߵľ���ָ���� �ܽ����ó�, ��(111), (200), (220)��(311)����İ�ռ���, ָ���Ƭ�����ŷ���<110>����Ŀ�ֱ�Ϊ3, 4, 5��5��
��ʵ���еİвı������Ƭƽ��, ���潦���������Ƭ�ĽǶȹ�ϵ��ͼ3��ʾ�� ���Կ���, ֻ�а�ԭ�������������淨�ߵļн���0��39�㷶Χ��, ԭ�Ӳ��п��ܳ�������Ƭ���γɱ�Ĥ��
Ϊ���о�����Գ������ܵ�Ӱ��, ����ԭ���������ŷ�����ֻ�ֲ�����tan��Ϊ�뾶��Բ���ϡ� ͼ4�DZ�ʵ���ап�ʴ����ϵIJ�ͬ����ķ���ԭ���ڻ�Ƭ�ϵķֲ�λ��, �ɼ���(200)��ľ��涼��ԭ�ӳ�������Ƭ�й��ס� �����淢��ԭ���ڻ�Ƭ�ϵķֲ��ܶȿ��ù�ʽ(6)���㡣
ʽ��N��ʾ��ԭ�ӳ�������Ƭ���й������ŷ�����ռ�ı���, ?Ϊ�ڻ�Ƭ�ϵ�Բ��ռ����Բ���ĽǶ�(ͼ4)�� ��2�г��������صĸ������ݡ�
ͼ3 ʵ���акͻ�Ƭ�����λ��
Fig.3 Arrangement of substrate relative to target
ͼ5�Ǿ����ߴ���������ʵĹ�ϵ����, �����������ž����ߴ����Ӷ����ӡ� �����������ž����ߴ������, ����ȡ��Ϊ(220)��(311) �ľ�����������, ����ȡ��Ϊ(111)��(200)�ľ����������ӡ� ��˾����ߴ�Գ������ʵ�Ӱ��ɹ����ھ�������ı仯��
��2 Al-Cu�вĸ�������������
Table 2 Data relate with grain planes of Al-Cu targets
Grain planes |
(111) | (200) | (220) | (311) |
? |
71�� | 0�� | 360�� | 95�� |
��??360 |
0.197 | 0 | 0.2 | 0.106 |
Nd |
2.797 | 0 | 1.74 | 0.784 |


3 �� ��
1. ����ͬ�Ľ����������ղ�����, Al-Cu�еĽ���������ԭ�����Ŷȵ����������, �������ȶ���һ����Χ�ڡ� �����ߴ�Խ������ʵ�Ӱ��Դ��ԭ�����Ŷ��澧���ߴ�仯�������ı仯��
2. ����������Ҫ��Al-Cu�о���ȡ���Ӱ��, (111), (220)��(311)�����������ʹ������������ �����ߴ�Գ������ʵ�Ӱ��ҲԴ�ھ�������澧���ߴ�仯���仯��
�����
[1] Wehner G K.Sputtering of metal single crystals by ion bom-bardment[J].J.Appl.Phys.,1955,26:1056.
[6] Peter Van Zant��;������,���֪,��������.оƬ����-�뵼�幤���Ƴ�ʵ�ý̳�[M].����:���ӹ�ҵ������,2004.266.
[8] ţ����,����Ⱥ.����ʵ�����������Լ����ʴ�[M].����:��е��ҵ������,1992.149.
[9] ��ϲ��,��,���ڼ�,�Ż���.���ӱ�Ĥ����[M].����:��ѧ������,1996.35.
[10] Vossen J L,Kern W.Thin Film Processes II[M].NewYork:Academic Press,1991.
[1] Wehner G K.Sputtering of metal single crystals by ion bom-bardment[J].J.Appl.Phys.,1955,26:1056.
[6] Peter Van Zant��;������,���֪,��������.оƬ����-�뵼�幤���Ƴ�ʵ�ý̳�[M].����:���ӹ�ҵ������,2004.266.
[8] ţ����,����Ⱥ.����ʵ�����������Լ����ʴ�[M].����:��е��ҵ������,1992.149.
[9] ��ϲ��,��,���ڼ�,�Ż���.���ӱ�Ĥ����[M].����:��ѧ������,1996.35.
[10] Vossen J L,Kern W.Thin Film Processes II[M].NewYork:Academic Press,1991.



