���±�ţ�1004-0609(2016)-11-2340-13
��Ԫ�ضԺ���ǥ�����ܵ�Ӱ��
�� �̣�Ѧ�ɰأ��� ˪
(�Ͼ����պ����ѧ ���Ͽ�ѧ�뼼��ѧԺ���Ͼ� 210016)
ժ Ҫ��
�ֱ�ѡȡ3�ֵ��͵ĺ�����ǥ��(Sn-Ag-Cu��Sn-Zn��Sn-Bi)��Ӳǥ��(Ag-Cu-Zn��Cu-P��Zn-Al)��Ϊ�������в����������˹����⺬��ǥ���о��������о��ɹ������ɷ�����Ԫ�ض���ǥ����Ӳǥ�ϵ��������ܡ�����֯����ѧ���ܵ�Ӱ����ɣ��������ǥ�����о���Ӧ�ù����д��ڵ����⼰��Ӧ�Ľ����ʩ��չ������ǥ�ϵ��о��ͷ�չ���ơ�
�ؼ��ʣ�
��Ԫ��������ǥ������ʪ������ǥ����ͷ����ǥ����Ӳǥ����
��ͼ����ţ�TG425���� ���ױ�־�룺A
���ŵ��ӹ�ҵ�����似���ķ�չ��Խ��Խ����˿�ʼ��עǥ�ϵ�ʹ�ð�ȫ������������ŷ��WEEE��RoHS����ָ����й�������ط���İ䲼��ʵʩ����ͳ�ĺ�Ǧ����ǥ�ϵ�ʹ���ܵ��ܴ����ƣ�ȫ��ǥ�Ϲ����߶���Ѱ����ʵ������Ʒ�����У�����ǥ�����ھ����������ۺ����ܶ��ܵ��㷺�Ĺ�ע������ǥ���У�Sn-Ag-Cuǥ�Ͼ������õ���ʪ�ԣ�Sn-Znǥ�ϵ��۵���Ϊ�ӽ�Sn-Pbǥ�ϣ�Sn-Biǥ�Ͼ��нϵ͵��۵㣬��ˣ���3��ǥ�ϱ���Ϊ������ʵ������ͳ��Sn-Pb��ǥ�ϡ���Ӳǥ������������ǥ���ѹ㷺Ӧ���ں��պ��졢�������Ӽ����õ�������ҵ��������ߴ����Ե���Ag-Cu-Zn��Ag-Cu-Zn-Snǥ�ϡ�Ȼ������������Դ�Ķ�ȱ��ʹ������ǥ�ϵĵijɱ��ܸߣ���ˣ�Ŀǰ��Ϊ���˵�Cu-P��Zn-Alǥ�϶���Ӳǥ���о����ȵ㡣
����ǥ����һ��dz���Ҫ��ǥ�����ϣ����Һ�����¶ȷ�Χ���ڵ�������ʪ�Ժ͵����Ժá���ѧ����������������ǥ���������е���ɫ��������ɫ�����������Ͻ�Ķ��ֺ���ǥ�ϻ�������ǥ��̼����մɡ�ʯī�������Ȳ���[1]�����⣬����ǥ�ϻ����������ļӹ����ܣ����ڼӹ���˿��Ƭ����������������״��ʹ��ʮ�ַ��㡣����ǥ������࣬������ҵ����һ��ɻ�ȱ��������Ҫ�����Ӳ���[2]����ǥ�������ķ�չ����������ʮ����Ҫ�����á�
��������ͨ�����������⺬��ǥ���о��������о��ɹ������ɷ�����Ԫ�ض���ǥ����Ӳǥ�ϵ�������
�ܡ�����֯����ѧ���ܵ�Ӱ����ɣ��������ǥ�����о���Ӧ�ù����д��ڵ����⼰��Ӧ�Ľ����ʩ��չ������ǥ�ϵ��о�����չ���ƣ���ͼΪ������ǥ�ϵ�Ӧ�ú����ͺ���ǥ�ϵ��з��ṩ��������۲ο���
1 ����������ǥ�ϵ�Ӱ�����
1.1 ��ǥ�ϵ��ۻ�����
��1 Sn-xAg-0.5Cuǥ�ϺϽ�DSC���߽��ͳ��
Table 1 DSC statistical results of Sn-xAg-Cu solders

������֪��ǥ���¶ȵ���450���ǥ�ϳ�Ϊ��ǥ�ϣ�ĿǰSnAgCuϵ�Ͻ���Ӧ����㷺����ǥ��֮һ����1����Ϊ��ͬ������Sn-Ag-Cuǥ�ϵ��ۻ�����[3]��������ۻ��¶�(�������¶�)ԼΪ217�棬����ȫ�ۻ��¶�(Һ�����¶�)����ǥ������Ԫ�غ�����������������ͣ���ǥ���ۻ���ʼ�¶����ۻ������¶�֮����¶�������խ��
Sn-Znǥ����������Ԫ��ͬ�������ǥ����ʼ�ۻ��¶ȣ������ۻ��¶�����[4]����2����ΪSn-9Zn-xAg���ۻ��¶ȡ��ӱ�2���Կ���������1%(��������)�ĺͲ�����ǥ��[5]��ȣ��ۻ��¶����併�ͷ��ȿɴ�56.2%�����ۻ��¶������խʱ��ǥ�����ۻ�ʱ�����Ը��ã��ɱ��ⲿ��ǥ����ͷ��֯�Ķ���ԺͲ������ԡ�
��3����ΪSn-Bi-xAg���ۻ����[6]���ɱ�3�ɿ�����Sn-Biǥ������Ԫ�ص���������0���ӵ�0.5%ʱ��ǥ�ϵ��۵��193.0 �潵��190.8 �棻����������Ԫ����1%���۵����ߵ�193.6 �档��������������������ǥ���۵����½������������������ڼ��������γɵ�Ag3Sn����ǥ�ϻ����Ϊ���ӵĽ�������[7]������ġ�
��2 Sn-9Zn-xAg���ۻ��¶�
Table 2 Melting temperature of Sn-9Zn-xAg solders

��3 Sn-Bi-xAg���ۻ��¶�
Table 3 Melting temperature of Sn-Bi-xAg solders

1.2 ��ǥ�ϵ�����֯�ͽ���ṹ
��ǥ�������У�ǥ��������ڽ��洦�γ�IMC(�����仯����)�㣬IMC����γ�һ�������ǥ�������֮�������õ�ұ���ϣ���һ���棬��IMC��̫�ή�ͺ���Ŀɿ��ԡ����ϵ���֯�����˲��ϵ����ܺͼӹ����գ���ˣ��б�Ҫ�о���Ԫ�ؼ�����ǥ���жԻ���ͽ�����֯��Ӱ�졣
Sn-Ag-Cuǥ�ϻ�������Ҫ�ɦ�-Sn�ࡢAg3Sn���Cu6Sn5����ɣ���֯����Ϊ��֦״�������Ԫ����Ԫ������֯��ǥ���д���Cu6Sn5�����Ӳ���࣬��������Ϊ��-Sn�������κ˵㣬ʹ��ǥ����֯�ִ���ǥ����������Ԫ�أ�ǥ�ϻ�����Cu6Sn5����١�Ag3Sn�����ࡣǥ������Ԫ�غ�������1%ʱ��Ag3Sn�����״�ֲ��ڻ����У���������ϸ������ͼ1��ʾ����ͼ1�ɿ������������ļ������ӣ���-Sn���������ߴ��С�������ļ�����ϸ�����������ã����紦IMC�ߴ�Ҳ��ϸС���ܶȱ��Χ��-Sn��������״�����ṹ�ijߴ����������ļ���Ҳ��ʹ���徧���������[8]��һ����Ϊ�����������ϵ�ʱ����֯ϸ�����������ã����������������ӣ�����ǿ��������֮��ǿ��IMC������Ҳ��֮���ӣ��Ͻ�Ԫ��ǿ������ռ��������λ��ǥ��ǿ��Ҳ���ӡ�
ͼ2��ʾΪSn-9Zn-xAg������֯��Sn-Znǥ���ɸ����������֯��п�����״��֯���[9](��ͼ2(a))������ǥ����������Ԫ��ʱ��������ϸ����֯�����ã������ܼ�����״��֯�������������ӹ�����ǥ���л��γɿ���״Ag3Sn������������۵����пIMC��Ҳ�������࣬����ǥ�ϵ�ճ���ԣ���������ʪ[10]����ˣ�Sn-Znǥ������������һ�����������������������Sn-9Znǥ���м���0.3%(��������)����Ԫ��ʱ��Sn-9Zn/Cu���洦ƽ̹��Cu5Zn8����������ֿ���״��AgZn3�࣬��֯��ѣ�Ȼ���������������ļ������ӣ�����״AgZn3��ۼ���������ȱ�״������㣬ʹǥ�����ܽ��͡�
ͼ3��ʾΪSn-57Bi-xAg������֯����ͼ3���Կ�����Sn-57Biǥ�ϻ�����Ag3Sn������������������߶�����[11]������������1%(��������)����ʱ��Ag3Sn����ɢ�ֲ�ʹǥ����֯ϸ�������ǥ��ǿ�ȣ�������������1%ʱ��Ag3Sn�ʼ�ֲ�ƫ�ۣ�����ǥ��ǿ�ȡ�����[12]������������������Sn-Biǥ���м�����������˸��������֦���ֻ���ʹ����ϸ����ͬʱҲ�����ǥ��ǿ�ȣ���������ʱ���ɽ϶��IMC����ʹ��֯��
1.3 ��ǥ�ϵ���ʪ��
Sn-Ag-Cuǥ�ϵ���չ������[13]����������������1%(��������)����ʱ�����������������ӣ�ǥ������ͭ���ϵ���չ���Ѹ�����ӣ�������������1%����ʱ����ʹ���������ӣ�ǥ����չ����ı仯Ҳ����
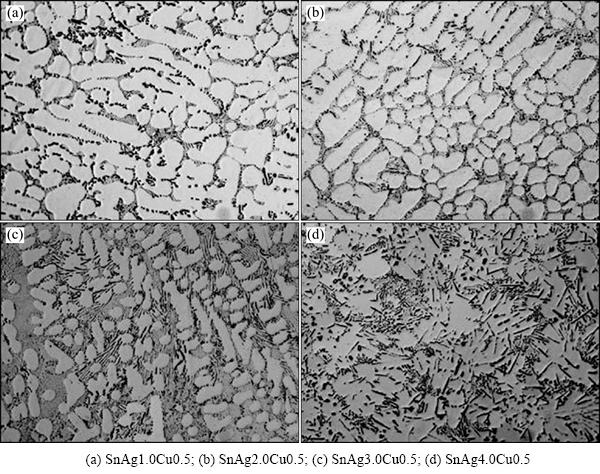
ͼ1 Sn-xAg-0.5Cu������֯
Fig. 1 Microstructures of Sn-xAg-0.5Cu solders

ͼ2 Sn-9Zn-xAg������֯
Fig. 2 Microstructures of Sn-9Zn-xAg solders
ͼ4��ʾΪSn-xAg-Cu����ʪ���ܡ���ͼ4���Կ�����ǥ�ϵ���ʪ������ʪʱ��Ҳ���ǿ�ʼ�仯�����������ƽ�������ߡ�����������С��1%��Χ������ʱ��ǥ�ϺϽ����ʪ���ܵõ��������ơ�
������Sn-Znǥ����ʪʵ����[14]��ͼ5��ʾ����ͼ5���Կ�������������Ϊ0.3%ʱ��ǥ�Ͼ���������ʪ������̵���ʪʱ�䣬��ʱ��ǥ�ϵ���ʪ���ܸ�����Ϊ���ԡ�WANG��[15]��Ϊ��ǥ��ʱǥ�ϱ��������γɵ�����п������Ӱ��Sn-9Znǥ����ʪ���ܵ���Ҫ���أ���Sn-9Zn-0.3Agǥ����ǥ��ʱ����ȴ�������ֹ�����˵������0.3%(��������)������ǥ�Ͽ���������ǿ����ʪ����������ߡ���һ���棬������������0.5%(��������)ʱ��ǥ���л��γ�AgZn3�����仯�������Һ̬ǥ�������ԣ�����������ǥ�ϵ���ʪ�ԡ�

ͼ3 Sn-57Bi-xAg������֯
Fig. 3 Microstructures of Sn-57Bi-xAg solders
Sn-Biǥ���м�����Ԫ���ܼӿ�ǥ��ʱǥ�ϵ���ɢ�ٶȣ�������ʪ���ܣ�Ȼ�����������ߣ����γɺܶ�����仯����Ag3Sn�࣬��ǥ�ϵ���ɢ�γ��谭��������ʪ���ܽ���[16]������[17]�б�������Sn-Bi-Agǥ���У���С����ʪ�Ǵ���Ӧ����������һ���м�ֵ��
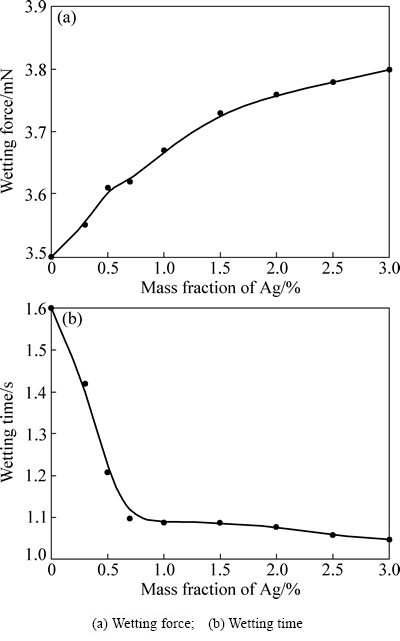
ͼ4 Sn-xAg-Cu����ʪ����
Fig. 4 Wettability of Sn-xAg-0.5Cu solders

ͼ5 Sn-Zn-xAg����ʪ����
Fig. 5 Wettability of Sn-xAg-0.5Cu solders
1.4 ��ǥ�ϵ���ѧ����
��ǥ����ʹ���У�ǥ�����ڷ����ڼ������нϸߵ���ѧ���ܲ��ܱ�֤ʹ�õĿɿ��ԡ���ǥ�ϵ���ѧ���ܲ�����Ҫ�����ڿ���ǿ�ȡ�����ǿ���ϣ������к����ǥ����ͷ������ʽ[18-19]��
Sn-Ag-Cuǥ�ϵ�BGA���������������¼���4���С��ɱ�4�ɿ�����������������0.5%ʱ���������������ӣ�ǥ�ϵĿ���ǿ�������Ӻ��½�����һ����������ͷ��֯��IMC��ķֲ�����й�[20]����������������0.5%ʱ������ǿ�������ӡ�����ǥ�Ϻ����ǿ�ȸߡ��ֿ���������ǿ��������ǥ�Ϻ�����������죬�������α����ƣ�Ͳ�������������ƣ������Ҳ�Ϻá�
��4 Sn-Ag-Cuǥ�ϵ���������
Table 4 Tensile strength of Sn-Ag-Cu solders

Sn-Znǥ�Ϻ���Ŀ���ǿ�Ȼ�������Ԫ�صļ������������½�[21]���粻����Ԫ��Sn-9Znǥ�Ϻ���[22]�Ŀ���ǿ��Ϊ34.4 MPa����������Ϊ0.3%�ĺ��㣬����ǿ�ȴﵽ���ֵ35.4 MPa������Ԫ�غ����������ӵ�1%ʱ������ǿ�ȷ��������½���
Sn-Biǥ�ϵ�ǥ����ͷ������չ�Բ���ҿ���ǿ��Ҳ�Ƚϵͣ�������Ԫ�غ���������ֲ���Щ���㡣����2%����Sn-57Biǥ��ǥ����ͷ�Ŀ���ǿ�ȱȲ�������ͷ�Ŀ���ǿ�ȸߺܶ�[23-24]��������������ǥ�ϵĿ���ǿ�ȷ������͡������������ļ���һ�������ʹӲ���Bi���ɢ����һ����Ag3Sn����ɢ�ֲ�Ҳ����ǿ��Ч���������������࣬Ag3Sn���ή��ǥ����ͷ�Ŀ���ǿ�ȡ�
1.5 ��������ǥ����ͷ�ɿ��Ե�Ӱ��
�ڵ�����װ�����У�����ͬʱ�е���Ԫ���������֮��������Ӻͻ�е���ӵ�˫��ʹ�������ŵ���������ϸ�����ܶȷ���չ��Ԫ��������Ҫǥ���ĵط����࣬ijһ������������⣬����Ԫ�������������ˣ��о�����Ŀɿ�����ʮ�ֱ�Ҫ�ģ�����ϵ�����ɵ�·��Ԫ���������������Ӳ�Ʒ������������[25]��
�о�[26]���֣�Sn-Pbǥ�ϵĿ�������ܿ�����Ϊ�о�����ɿ��Ե�һ��ָ�꣬ǥ�ϵĿ��������Խ�ã���Ӧ�ĺ���ǿ��Խ�ߡ�ʹ������ҲԽ����Sn-Pbǥ���м����������Ե����ǥ�ϵĿ�������ܣ�����Sn-Pbǥ��ʧЧʱ�������Ÿ������Ǧ����ѣ����ļ�����ھ��紦�γ�Ag3Sn�࣬��ǥ�ϻ���������ԵĶ������á�Ȼ�����������������о�[27-28]ָ����ϡ��Ԫ����������ʹ��ǥ�ϵĿ����������߽�9����ԶԶ��������������ߵij̶ȣ����⣬ŷ��Ҳ��ʩ�е��ӹ�ҵ��Ʒ����Ǧ���������о���ͳ��Ǧǥ�ϵ��ȶ����ͣ�����Ŀ��й����߿�ʼ��ע��������������Ǧǥ�Ͽ�������ܵ�Ӱ�졣
��ǥ�ϵ��۵�ϵͣ������������¹����¶�Ҳ�����۵��0.3�����ڸ��¶ȷ�Χ�ڣ����������Ҫ�ı��λ���֮һ��Ӧ����Ӧ�����ı�������Ч������ɳڣ��Ա�֤����Ŀɿ��ԡ���Ǧǥ�ϵ��͵����������ͼ6��ʾ���������ں��غ��������������ʱ����������·�3���Σ���ʼ��䡢��̬���ͼ�����䡣�����̵ĵڶ����μ���̬���������С������λ��������˵�����źܴ�Ĺ������塣��ˣ���̬������ʳ��������������ϵĿ������ε��������������ڶ�����Ҫ������Dorn���̡�Wongģ�͡�Garofalo-Arrheninusģ�͡�Darveaux���̡�Nortonģ�͵�[29]��
�Խ�Ϊ����Dorn����Ϊ����
 (1)
(1)
ʽ�У�A1Ϊ���ϲ�����D0Ϊ����ɢϵ����GΪ�б�ģ����bΪ����ʸ����dΪ�����ࣻ��Ϊ����ǿ�ȣ�nΪӦ��ָ����RΪ���峣����TΪ�����¶ȣ�QΪ��ɢ�����ܡ�
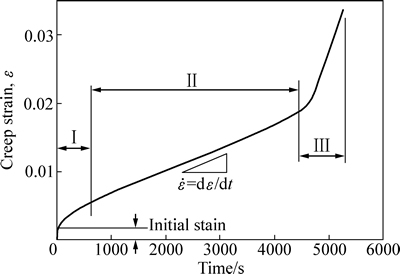
ͼ6 ��Ǧǥ�ϵĵ����������
Fig. 6 Typical creep curve of solders
WIESE��[30]ͨ������������SnAg3.0Cu0.5ǥ�ϵ�Dorn���̣��õ�n=12.1��Q=61.1 kJ/mol������SnAg4.0Cu0.5ǥ�ϣ��õ�n=18��Q=83.1 kJ/mol���ɼ�������Խ�ߣ��������ԽС�����������ҲԽ�á�
�������ܵ��غ�ʱ������һ�㷢���ڴ���IMC�㡣ͼ7��ʾΪSnAgCu/Cu����Ľ�����ò��ͨ��ͼ7�۲�Sn-Ag-Cuǥ�Ϻ���Ľ�����ò���������������������ӣ��������IMC����ò���˽ϴ�ĸı䣬�����Թ⻬ƽ̹[31]����������Ag3Sn��Ĵ��ڲ�������ϸ��Cu6Sn5�࣬ʹ���ܶ����ӣ����������ƽ����Ĺ��ȷ�Ӧ���Ӷ������˺��������ò��IMC��ԽϸС����ĿԽ�࣬�Ծ�����ƶ����Բ���������������Ӷ���ߺ����ǿ�ȡ�
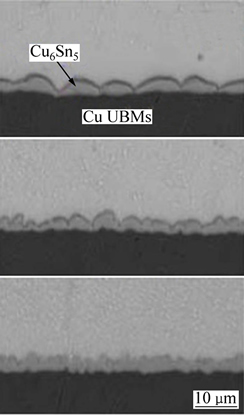
ͼ7 SnAgCu/Cu����Ľ�����ò
Fig. 7 Interface morphologies of SnAgCu/Cu joints
2 ��������Ӳǥ�ϵ�Ӱ�����
2.1 Ӳǥ�ϵ��ۻ�����
����Ӳǥ�ϵ�����ࡢӦ�ü��㡣���õĺ���Ӳǥ�ϼ���������ͭ��Ϊ�����۵�ͼ�����������ͨ��������п�������ӵȺϽ�Ԫ�أ�������Ԫ���Ԫ�Ͻ𡣱�5����Ϊ�����г���Ӧ�ý϶�ļ���Ag-Cu-Znǥ�ϵ��ۻ��¶ȡ��ɱ�5���Կ�������Ag-Cu-Zn��Ag-Cu-Zn-Snǥ���У��������������ӣ�ǥ�ϵĹ����ߺ�Һ�����¶ȴ�������½�����[1]��
Cu-Pǥ�����ھ��нϺõ��������Լ�ǥ���¶Ƚӽ�����ǥ�ϵ��ص㣬��500~800���¶ȷ�Χ�ڣ�ǥ��ͭ��ͭ�Ͻ��Ӧ���б���Ϊ��ȡ������ǥ�ϵ�������ϡ���6����Ϊ�г���Ӧ�ý϶�ļ���Cu-P-Agǥ��[1]���ɱ�6���Կ�����ǥ���ɵ�����������������仯��ǥ�ϵ�Һ�����½��������������䣬�ۻ��¶������С��
Zn-Alǥ����������Ԫ�أ�ǥ�ϵ�Һ���ߺ����߾���������ߡ�FENG��[32]���������85Zn-15Alǥ��������4%������ǥ�Ϲ������¶ȿɴ�390 �棬Һ���ߴ�435 �棬�벻������ʱ��ȷֱ����5 ���9 �档���۵�ϸߵ���Ԫ�ؼ���Zn-Al��ʱ����Ԫ����ǥ���е�п���������γɹ����壬�Ӷ��������ǥ���۵㡣
��5 Ag-Cu-Znǥ�ϵ��ۻ��¶�
Table 5 Melting temperature of Ag-Cu-Zn(-Sn) brazing filler metals
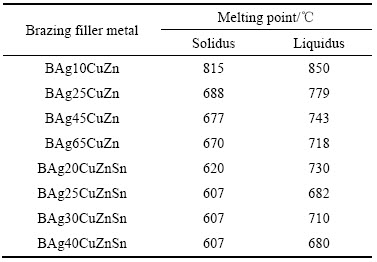
2.2 Ӳǥ�ϵ�����֯
Ag-Cu-Znǥ�����Ц�-(Cu-Zn)����-(Ag-Zn)���¡��á��ġ��š��ǵ��ࡣ��-Ag����-Cu��Ϊ��������ǿ�Ⱥ����Ե��࣬�������и�ǿ���е����Ե��࣬���Ϊ�����࣬��ˣ�Ҫ����������ܵ�ǥ�ϣ�ǥ�ϵijɷִ�ѡ����δ���֦���ķ�Χ[33]���ѱ�֤ʵ���ǣ�����������50%���ϣ�ǥ����Ҫ�ɦ�-Ag�����壬��-Cu�����壬Ag-Cu��������������������ɣ����������� 50%����ʱ�����������࣬��-Ag�������Ag-Cu�������٣��Ҵ�ʱǥ�ϳɷ��������ڴ��Ե�Ag5Zn8������Cu5Zn8������ʹ�Ͻ���Ѽӹ�(��ͼ8)����ˣ�һ����Ϊ���ijɷ���40%~50%ʱ��ǥ�ϵ��ۺ�������ѣ����ͺ�ΪBAg45CuZn��ǥ����һ�ֱ��㷺ʹ�á����ܽ��������ǥ�ϡ�
Ag-Cu-Zn-Cdǥ��������ǥ����������õ�һ��ǥ�ϡ�������2007��ŷ�˹涨���ӹ�ҵ��Ʒ�в��ܺ��ӣ�ѧ������ʼ��ע����ǥ����������ӵ�Ԫ�أ�����ֻ����Ԫ�ؿ��������[34]����������Ԫ�ؼ���Ag-Cu-Znǥ���п��Ը���ǥ����֯����Ҳ�����˶Բ�ͬ��������Ag-Cu-Zn-Snǥ����֯���о��� ��[35]����֪��������Խ��ʱ��Ag-Cu-Zn-Snǥ����Ҳ���и�������Ը��������ͭ����������(��ͼ9)��������������ǥ�ϵļӹ����ܺ�ǥ����ͷ�ĵ������ܼ���ѧ���ܵȡ�
Ŀǰ���ձ���ΪCu-Pǥ����ͭ�����Cu3P����������������������ܡ��о�����[36]��ǥ����������Խ�٣�������֯��Բ�ε�ƶ����֯����ͻ״�ĸ�����֯Խ�࣬������15%��ǥ������֯������֦״��ͭ�������塢���������弰ͭ��������֯���(��ͼ10)�����������Ӳ����ܼ���ǥ�ϻ����д���Cu3P�࣬ͬʱʹ�������������������࣬������ǥ�ϵ������Ժͼӹ����ܡ�

ͼ9 Ag-Cu-15Zn-5Sn������֯
Fig. 9 Microstructures of Ag-Cu-15Zn-5Sn brazing filler metals
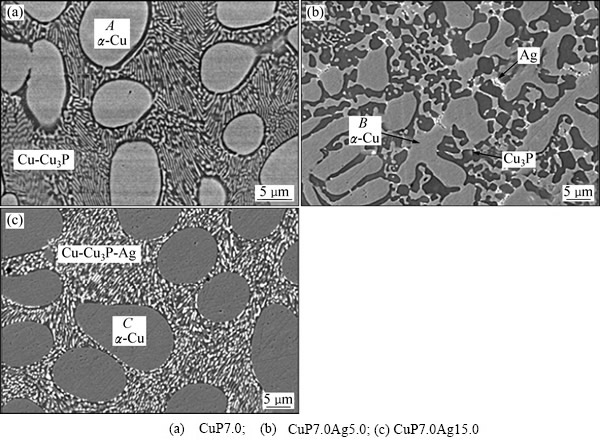
ͼ10 Cu-P-xAg������֯
Fig. 10 Microstructures of Cu-P-xAg brazing filler metals
Zn-Alǥ����֯��ͼ11��ʾ������Ҫ�Թ�������ʽ���ڣ�ǥ����֯��пԭ�ӡ���ԭ�Ӻ���ԭ�ӻ���ɢ�Ľ���������������������ӣ�Zn-Alǥ�ϵ���֯����ϸ����������ǥ����ѧ���ܵ���ߡ�����������Ԫ�صĵ縺������Ԫ�ء�пԪ�صĵ縺�Բ������Ԫ����пԪ�صĵ縺�Բ����[32]����ˣ���Zn-Alǥ��������������ԭ����пԭ�ӡ���ԭ�ӵ������ϴ�����пԭ������ԭ�ӵĻ���ɢ�ٶȣ�ʹ���γɵĹ�������ߴ��С��
2.3 Ӳǥ�ϵ���ʪ����

ͼ11 Zn-Al-xAg������֯
Fig. 11 Microstructures of Zn-Al-xAg brazing filler metals
Ag-Cu-Znǥ�ϵ���ʪ�Ժ�ǥ���е����������ڽ�Ϊ���Ե����Թ�ϵ������ǥ���ֲ�[1]��BAgl0CuZn��Ҫ����ǥ��ͭ��ͭ�Ͻ𡢸ּ�Ӳ�ʺϽ�ȣ��京�����͡���չ�Բ��Ӧ�ò����㷺��BAg25CuZn��ǰ����ȣ����ĺ��������15%����������Ч����ʹ����չ���ܵõ��˸��ƣ�ǥ��Ҳ�ȽϹ�ࡣ����ǥ�ϳ�����ǥ��ͭ��ͭ�Ͻ𡢸ּ�����ֵȣ�BAg45CuZn����õ���ǥ��֮һ���������õ���չ���ܺ��������������ǥ��ı����ࣻBAg50CuZnҲ�������õ���չ�������������������ǥ�ϳ��Ƴɲ�Ƭ״ʹ�ã�������ͭ����Ͻ�ֵȵ�ǥ����BAg70CuZn�ĺ������ϸߣ���չ�ԽϺã�ǥ���࣬�������ڵ�����Ҫ��ߵIJ�Ʒ��ǥ�������Ƶأ���Ag-Cu-Zn-Snǥ����[37]�����������������ӣ�ǥ����ͭ��������չ��������ӣ�����ǥ�ϵ����������ӣ���ʪ������ǿ��
����������߸�����Cu-Pǥ�ϵ���ʪ��չ���ܣ�ԭ�����������ܹ��ӿ�ĸ��ͭ��Һ̬ǥ�����ܽⷴӦ�ٶȡ�Ȼ��������[38]���ڶԼ��ֵ��͵�Cu-Pǥ����ʪ���ܽ����˲������о�֮�����������������Ӱ����ʪ���ܵ���Ҫ���أ�������������ҪӰ�����ء�Ŀǰ��Cu-Pǥ����ͭԪ�ء���Ԫ�غ�������ʱ����������Ԫ�غ������Ƿ���Ը���ǥ����ʪ���ܵ��о����١�
��������ͭǥ����Zn-Alǥ���ǽ�����Ѹ�ٷ�չ������һ������ǥ��[39]����Zn-Alǥ���м�����Ԫ���ܹ����������ǥ����ͷ����ʪ���ܺ���ѧ����(��ͼ12)��ͼ12(a)��ʾ����Zn-15Alǥ���м�����Ԫ��֮��Zn-Alǥ����չ���ܵı仯������[32]��������������ǥ����չ�����С��ԭ��������пԪ����ͭ��������ĸ�ľ��������ٶ��൱�죬�谭ǥ�ϵ���չ��������������չ���������������Ԫ����пԪ������������ǥ����п��ĸ�ĵ���ɢ�ٶȣ��ʶ���չ���ܵõ���ߡ�ͬʱ��ǥ����ʪ���ܵĸ���Ҳ���Դٽ���ѧ���ܵ���ߡ�
2.4 Ӳǥ��ǥ����ͷ����ѧ����
Ag-Cu-Zn��Ag-Cu-Zn-Snǥ��ǥ������ֽ�ͷ�Ŀ���ǿ�Ⱦ�����300 MPa���Ѿ����������µ�ʹ��Ҫ��[40]��������ǥ���������������ӣ�����ǿ�Ƚ��ͣ�����������ߡ�����ʱ��ǥ�������������ͣ��ͻᵼ�½�ͷ�Ĵ�������ʹ�ý�ͷ���������ѣ���ͷ��ʹ������Ҳ��֮���͡�
Cu-Pǥ��ǥ����ͷ��������Cu3P�����P�����������������ֲ�����Ǿ�������ѧ���ܵ���Ҫ���ء��������[38]��BCuPAg5ǥ��ǥ����ͷ�������ԡ�����ǿ�Ⱦ�ǿ������Cu-Pǥ�ϵģ�����ͷ��Ӳ��ȴ����ǰ�ߣ���һ�����鷢�֣�ǥ����ͷ��Ӳ����Ҫȡ�����������ijɷ֣�������Խ�ߣ���ͷ������Խ�á�ͬʱ������Щ��������Cu-Pǥ���У�������Ԫ�����Cu-P-Agǥ��ʱ��ǥ�Ϻ�ǥ����ͷ�����Բ�δ��������[41]����Ҳ��ʹ�о����Ƕ�Cu-P-Agǥ��������������Ҫ���и�������ط�����

ͼ12 �����Ӷ�Zn-Alǥ�����ܵ�Ӱ��
Fig. 12 Effect of Ag addition on properties of Zn-Al brazing filler metals
Zn-Alǥ�Ͻ�ͷ��ѧ���ܲμ�ͼ12(b)[42]��ǥ�������������ӣ���ʹǥ����֯�к����������������ӣ�����ǿ��������ǿ��ͭ-����ͷ�Ŀ���ǿ�ȺͿ���ǿ�Ⱦ����������ƣ���������Ԫ�ص�һ������ʱ������ǿ�������Ѿ����ͣ���ͷǿ�ȴﵽ��ߣ�����������ǥ����ͷ����ѧ���������ȶ���
2.5 ��������ǥ����ͷ�������ܵ�Ӱ��
�����һ��Ӧ�ù㷺������Ҫ��ߵĶ����豸, �������������ǥ���ṹ����ˮ�������������豸������Ȧ���²㡢ת�Ӵż���Ȧ������ת�ӵ�����˻���ֱ�����������������Ƭ�뻻��Ƭ�����ӵȡ���ͬ������ǥ�϶Ե��ǥ����ͷ����ֵ��Ӱ���������꾡���о�����[43-45] �������ǥ������ǥ������Ҫ��Ag-Cu-Znǥ�Ϻ�Cu-P-Agǥ��Ϊ��[46-47]�������豸��ǥ����ͷ�ĵ�������������ߣ����ܵ���Ľ���ͣ���ͷ��ʹ������Ҳ��֮��ߡ���ˣ��о�����ǥ��ǥ����ͷ�ĵ���������������Ҫ�ġ����ڵ����ͭ���ߵ�ǥ����ͷ��˵�����ںϽ����DZȽ������ʵĵ����ʸߺܶ࣬��ˣ�ǥ�촦����ֵ����������Ȧ�ĵ���������ʮ����Ҫ��Ӱ�졣��������֪�ĵ�������С�Ľ�����ǥ���е�������Խ�ߣ�����ֵһ��ҲԽ��(����6)����ǥ����ͷ�ĵ�������ҲԽ�ã���Ҳ�ǵ��¸�������ǥ��һֱ���ѱ�ȡ����ԭ��֮һ��
3 ����ǥ�ϵķ�չ����
�����Ǻ�������ǥ�ϻ���Ӳǥ�ϣ�����ʹ��������㷺��ǥ�ϡ����������������Ĺ������ܡ����˵��۵㡢���õ���ʪ��չ���ܣ���ǥ�Ϻ�ǥ���ǿ�ȡ������Ժ���ʴ��������ϵ���ŵ㣬������ǥ�ϵ��о��ͷ�չ��Ȼ�кܳ���·Ҫ��[48-49]������ǥ�ϵ��о�����һ�������������е���Ҫ����������ĵ���ǥ�ϣ��Խ��ͳɱ������Ӿ����ԣ���һ���棬����ǥ���Ѿ�ͻ���˴�ͳ����Ԫ����Ԫ�Ͻ𣬺ܶ���о������Ѿ���ʼת���о���Ԫ����ǥ����������Ԫ����ǥ�ϣ�������Σ�����ǥ���о��ij��������Ǽ�Ҫ�뷽�跨������������Ҫ��ø�����������ʪ���ܺ���ѧ���ܡ���ˣ�δ����ǥ�Ͽ��ܵ��о��������¡�
1) ���ͳɱ����о�������һ�ֹ�����������۸�����Դ���ޡ�һֱ�����о��߶����ڱ�֤ǥ�����ܵ�ǰ���£�������Ԫ�غ����������Ծ�����ΪĿ�ĵĵ�����ǥ�ϣ����������Sn-Pbǥ�Ϻ���������ǥ�ϣ�Ŀǰ��������Ե���Sn-Ag-Cuǥ�ϵ��о���һ���ȵ㡣ͬ�������ں���Ӳǥ�ϣ���Ag-Cu-Znǥ����˵���䷽�е��������ܽ�ʡ10%���ɱ��Ѿ���ʡԼ40%������ʮ�ֿɹ۵ľ���Ч�档
2) ����ǥ���н�ֹʹ��Ǧ�ӵ�6���к����ʣ�����ǥ�����ܵĸ����������µõ����ӡ����⣬����ǥ�����ܵĸĽ�Ҳ��Ŀǰ�о����ȵ㣬�����Ӳ���ϡ��Ԫ�ػ�ϡ��Ԫ������Ϊ��Ч�İ취֮һ��������SnAgCuǥ��������������ܺܺõ�����Cu6Sn5��IJ���[50-51]�����������ʪ�ԡ���Ӳǥ��������ǥ���������غ���Ҳ����������ǥ����֯[52]���������ֺ�����ǥ���������ܳ����˴�ͳ������ǥ�ϣ�������ǥ�ϵ�����ϡ��Ԫ�ص��о��Խ����ص㷢չ����֮һ������ǥ�ϡ�����ǥ����ϡ��Ԫ��֮������û����о��������Ը���ͻ����
4 ����
1) ͨ���ܽ�����������Ժ���ǥ�ϺϽ���ۻ��¶ȡ���ʪ���ܡ���֯����ѧ���ܵ���Ϊ��Ӱ�죬������Ԫ�صĺ���һ��ʱ���������Ը���ǥ�ϵ���ʪ���ܣ�ϸ��ǥ����֯�ͼ�С�����仯��������ߴ磬�������������������ǥ�ϵ��ۺ����ܡ�
2) ����ǥ�������������ӣ�ǥ�����ܷ����½���������������ǥ�ϵ���֯�ṹ�йء�
3) ���İ���۸���Լ�Ÿ�������ǥ�ϵ��о����ƹ㣬��ˣ�ѧ�߸���ذ�Ŀ���������������ܵĵ���ǥ�ϣ��Ӷ���չ������ϡ��Ԫ�ص���Ԫ����ǥ�ϣ���������Ԫ����ǥ�ϡ�
4) ��������ǥ�ϵ��о��ͷ�չ���ƣ��������ǥ�����о���Ӧ�ù����д��ڵ����⼰��Ӧ�Ľ����ʩ��Ϊ��һ���о��ṩ����֧�š�
REFERENCES
[1] ׯ����, ������. ǥ���ֲ�[M]. ����: ��е��ҵ������, 1998.
ZHUANG Hong-shou�� ZHANG Qi-yun. Manual for brazing and soldering[J]. Beijing: China Machine Press, 1998.
[2] HANDBOOK A S M. Welding, brazing and soldering[J]. ASM International, 1993, 6: 416-418.
[3] SHNAWAH D A A, SABRI M F B M, BADRYDDIN I A, SAID S. A review on effect of minor alloying elements on thermal cycling and drop impact reliability of low-Ag Sn-Ag-Cu solder joints[J]. Microelectronics International, 2012, 29(1): 47-57.
[4] HUNG Fei-yi, WANG Chih-jung, HUANG Sung-min, CHEN Li-hui, LUI Truan-sheng. Thermoelectric characteristics and tensile properties of Sn-9Zn-xAg lead-free solders[J]. Journal of Alloys and Compounds, 2006, 420(1): 193-198.
[5] LIN Kwang-lung, SHIH Chia-ling. Microstructure and thermal behavior of Sn-Zn-Ag solders[J]. Journal of Electronic Materials, 2003, 32(12): 1496-1500.
[6] MIAO Hui-wei, DUH Jenq-gong, CHIOU Bi-shiou. Thermal cycling test in Sn-Bi and Sn-Bi-Cu solder joints[J]. Journal of Materials Science: Materials in Electronics, 2000, 11(8): 609-618.
[7] VIANCO P T, REJENT J A. Properties of ternary Sn-Ag-Bi solder alloys: Part I��Thermal properties and microstructural analysis[J]. Journal of Electronic Materials, 1999, 28(10): 1127-1137.
[8] REID M, PUNCH J, COLLINS M, RYAN C. Effect of Ag content on the microstructure of Sn-Ag-Cu based solder alloys[J]. Soldering & Surface Mount Technology, 2008, 20(4): 3-8.
[9] SONG J M, LAN G F, LUI T S, CHEN L H. Microstructure and tensile properties of Sn-9Zn-xAg lead-free solder alloys[J]. Scripta Materialia, 2003, 48(8): 1047-1051.
[10] ������, ��С��, ����ǿ, ���ǫ, ������. Bi, Ag �� Sn-Zn ��Ǧǥ����������֯��Ӱ��[J]. �й���ɫ����ѧ��, 2006, 16(1): 158-163.
WU Wen-yun, QIU Xiao-ming, YIN Shi-qiang, SUN Da-qian, LI Ming-gao. Influence of Bi, Ag on microstructure and properties of Sn-Zn lead-free solder[J]. The Chinese Journal of Nonferrous Metals,2006, 16(1): 158-163.
[11] �� ��, ������, �ű��, �� ��, Ǯ����. �Ͻ�Ԫ�ض� Sn-57Bi ��Ǧǥ����֯�����Ե�Ӱ��[J]. ���Ϲ���, 2010, 10(5): 13-17.
HE Peng, LU Xiao-chun, ZHANG Bin-bin, MA Xin, QIAN Yi-yu. Effect of alloy element on microstructure and impact toughness of Sn-57Bi led-free solders[J]. Journal of Materials Engineering,2010, 10(5): 13-17.
[12] CHEN Chih-ming, HUANG Chih-chieh. Effects of silver doping on electromigration of eutectic SnBi solder[J]. Journal of Alloys and Compounds, 2008, 461(1): 235-241.
[13] BURKE C, PUNCH J. A Comparison of the creep behavior of joint-scale SAC105 and SAC305 solder alloys[J]. IEEE Transactions on Components Packaging and Manufacturing Technology, 2014, 4(3): 516-527.
[14] LIN Kwang-lung, SHIH Chia-ling. Wetting interaction between Sn-Zn-Ag solders and Cu[J]. Journal of Electronic Materials, 2003, 32(2): 95-100.
[15] WANG Hui, XUE Song-bai, ZHAO Feng, CHEN Wen-xue. Effects of Ga, Al, Ag, and Ce multi-additions on the properties of Sn-9Zn lead-free solder[J]. Journal of Materials Science Materials in Electronics, 2010, 21(2): 111-119.
[16] SHIUE Ren-kae, TSAY Leu-wen, LIN Chun-lun, OU Jia-lin. A study of Sn-Bi-Ag-(In) lead-free solders[J]. Journal of Materials Science, 2003, 38(6): 1269-1279.
[17] VIANCO P T, REJENT J A. Properties of ternary Sn-Ag-Bi solder alloys: Part II��Wettability and mechanical properties analysis[J]. Journal of Electronic Materials, 1999, 28(10): 1138-1143.
[18] MA Hong-tao, SUHLING Jeffrey-C. A review of mechanical properties of lead-free solders for electronic packaging[J]. Journal of Materials Science, 2009, 44(5): 1141-1158.
[19] ���ュ, Ǯ����, �� ��. ��ѹ�۷����� Sn-Ag-Cu ϵ��Ǧǥ�ϵ���ѧ����[J]. �й���ɫ����ѧ��, 2005, 15(5): 688-693.
WANG Feng-Jiang, QIAN Yi-Yu, MA Xin. Measurement of mechanical properties of Sn-Ag-Cu series lead-free solder alloy by using micro-indentation[J]. The Chinese Journal of Nonferrous Metals, 2005, 15(5): 688-693.
[20] ZENG Guang, XUE Song-bai, ZHANG Liang, GAO Li-li, DAI Wei, LUO Jia-dong. A review on the interfacial intermetallic compounds between Sn-Ag-Cu based solders and substrates[J]. Journal of Materials Science (Materials in Electronics), 2010, 21(5): 421-440.
[21] SONG J M, LUI T S, LAN G F, CHEN L H. Resonant vibration behavior of Sn-Zn-Ag solder alloys[J]. Journal of Alloys and Compounds, 2004, 379(1): 233-239.
[22] CHEN Wen-xue, XUE Song-bai, WANG Hui, WANG Jian-xin, HAN Zong-jie. Effects of Ag on microstructures, wettabilities of Sn-9Zn-xAg solders as well as mechanical properties of soldered joints[J]. Journal of Materials Science (Materials in Electronics), 2010, 21(5): 461-467.
[23] SHALABY R M. Effect of silver and indium addition on mechanical properties and indentation creep behavior of rapidly solidified Bi-Sn based lead-free solder alloys[J]. Materials Science and Engineering A, 2013, 560: 86-95.
[24] �� ��, ������, Ǯ����. Sn-Bi-Ag-Cu ǥ�ϲ��庸����İ�������[J]. �й���ɫ����ѧ��, 2005, 15(7): 993-999.
HE Peng, ZHAO Zhi-li, QIAN Yi-yu. Fillet-lifting phenomenon of wave soldering with Sn-Bi-Ag-Cu solder[J]. The Chinese Journal of Nonferrous Metals,2005, 15(7): 993-999.
[25] RIDOUT S, BAILEY C. Review of methods to predict solder joint reliability under thermo-mechanical cycling[J]. Fatigue & Fracture of Engineering Materials & Structures, 2007, 30(5): 400-412.
[26] KANCHANOMAI C, MIYASHITA Y, MUTOH Y. Low cycle fatigue behavior and mechanisms of a eutectic Sn-Pb solder 63Sn/37Pb[J]. International Journal of Fatigue, 2002, 24(6): 671-683.
[27] ZHANG Liang, XUE Song-bai, GAO Li-li, ZENG Guang, SHENG Zhong, CHEN Yan, YU Sheng-lin. Effects of rare earths on properties and microstructures of lead-free solder alloys[J]. Journal of Materials Science (Materials in Electronics), 2009, 20(8): 685-694.
[28] �� ��, ���̹�, �γ���, ������, Ѧ�ɰ�, ������, Ҷ ��. ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ��[J]. �й���ɫ����ѧ��, 2012, 22(6): 1680-1696.
ZHANG Liang, HAN Ji-guang, HE Cheng-wen. GUO Yong-huan, XUE Song-bai, GAO Li-li, YE Huan. Effects of rare earths on properties and microstructures of lead-free solder alloys[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(6): 1680-1696.
[29] LALL P, GUPTE S, CHOUDHARY P, SUHLING J. Solder-joint reliability in electronics under shock and vibration using explicit finite-element sub-modeling[C]//Electronic Components and Technology Conference, 2006. Proceedings. 56th. IEEE, 2006: 8.
[30] WIESE S, SCHUBERT A, WALTER H, DUKEK R, FEUSTEL F, MEUSEL E, MICHEL B. Constitutive behavior of lead-free solders vs lead-containing solders-experiments on bulk specimens and flip-chip joints[C]//Electronic Components and Technology Conference, 2001. IEEE, 2001: 890-902.
[31] CHO M G, PARK Y S, SEO S K, PAIK K W LEE H M. Effect of Ag addition on the ripening growth of grains at the Interface of Sn-xAg-0.5 Cu/Cu during a reflow[J]. Components, Packaging and Manufacturing Technology, IEEE Transactions on Components, 2011, 1(12): 1939-1946.
[32] FENG Ji, XUE Song-bai, LOU Ji-yuan, LOU Yin-bin, WANG Shui-qing. Microstructure and properties of Cu/Al joints brazed with Zn-Al filler metals[J]. Transactions of Nonferrous Metals Society of China, 2012, 22(2): 281-287.
[33] MURAKAMI Y, NAKANISHI N, KACHI S. Superlattice formation in the ternary �� phase alloys��I. AuxCu55-xZn and AgxCu53-xZn alloys[J]. Acta Metallurgica, 1971, 19(2): 93-96.
[34] XUE Song-bai. Effect of tin and indmium in silver filler metal and its mechanism[J]. Welding & Joining, 1998, 11(12): 28-31.
[35] LI Zhou-ran, JIAO Ning, FENG Ji-cai, LU Cheng-hong. Effect of alloying elements on microstructure and property of AgCuZuSn brazing alloy[J]. Transactions of the China Welding Institution, 2008, 29(3): 65-68.
[36] LI Yi-nan, WANG Chang-wen, PENG Zi-long, YAN Jiu-chun, LIU Xue-song. Dissolution behavior of Cu in Cu-Ag and Cu-P brazing alloys using weld brazing[J]. Transactions of Nonferrous Metals Society of China, 2011, 21(2): 394-399.
[37] SHIUE R K, WU S K, CHAN C H. The interfacial reactions of infrared brazing Cu and Ti with two silver-based braze alloys[J]. Journal of Alloys and Compounds, 2004, 372(1): 148-157.
[38] KARAMIS M B, TASDEMIRCI A, NAIR F. Microstructural analysis and discontinuities in the brazed zone of copper tubes[J]. Journal of Materials Processing Technology, 2003, 141(3): 302-312.
[39] NAKA M, HAFEZ K M. Applying of ultrasonic waves on brazing of alumina to copper using Zn-Al filler alloy[J]. Journal of Materials Science, 2003, 38(16): 3491-3494.
[40] ARENAS M F, ACOFF V L, REDDY R G. Physical properties of selected brazing filler metals[J]. Science and Technology of Welding & Joining, 2004, 9(5): 423-429.
[41] HASAP A, NORAPHAIPHIPAKSA N, KANCHANOMAI C. The microstructure and strength of copper alloy brazing[J]. Welding Journal, 2014, 93(4): 116-123.
[42] �� ��, Ѧ�ɰ�, �� ��, ¦����, ��ˮ��. AgԪ�ض�Zn-Alǥ�����ܵ�Ӱ��[J]. ����ѧ��, 2010, 21(10): 73-76.
ZHANG Man, XUE Song-bai, DAI Wei, LOU Yin-bin, WANG Shui-qing. Effect of Ag on properties of Zn-Al brazing filler metal[J]. Transactions of the China Welding Institution, 2010, 21(10): 73-76.
[43] ������. ��ͬ������ǥ�϶Ե��ǥ����ͷ����ֵ��Ӱ��[J]. ��������, 1997(3): 30-32.
LIU Yong-an. The influence on soldering connection resistance of solder with different silver content in electric machined[J]. Large Electric Machine and Hydraulic Turbine, 1997(3): 30-32.
[44] ����־. �Ե綯�������ͷ���ӷ��ĸĽ��о�[J]. ��������ѧ, 2014, 5(6): 227.
GAO Xian-zhi. Improvement on the welding method of motor winding joints[J]. Heilongjiang Science, 2004, 5(6): 227.
[45] MAMUNYA Ye P, ZOIS H, APEKIS L, LEBEDEV E V. Influence of pressure on the electrical conductivity of metal powders used as fillers in polymer composites[J]. Powder Technology, 2004, 140(1): 49-55.
[46] ������, ʷ����, ����ͨ, �� ��. ��ֱ�����ת��ͭ����˻���Ƶ��Ӧǥ�����շ������о�[J]. ��������, 2003, 1(1): 5-7.
WANG Yong-dong, SHI Wen-qing��HU Yi-tong, XU Bo. Making an investigation in the technological method of the medium-frequency induction braze welding of the rotor copper bar and end-ring for the AC and DC motor[J]. Large Electric Machine and Hydraulic Turbine, 2003, 1(1): 5-7.
[47] MORSE R S. Electronic circuit package and method of brazing: US Patent 3941916[P]. 1976-03-02.
[48] RANJIT P T. Effect of silver in common lead-free alloy[C]//Proceedings of the SMTA International Conference. Florida: IEEE, 2008.
[49] ������, Ѧ�ɰ�, ������, ���Ļ�, ������. ������ǥ���о���״�뷢չ����[J]. ����, 2007(6): 19-23.
HAN Xian-peng, XUE Song-bai, LAI Zhong-min, GU Wen-hua, GU Li-yong. Research progress and development of cadmium-free silver brazing solder[J]. Weiding & Joining, 2007(6): 19-23.
[50] ZHANG Liang, XUE Song-bai, GAO Li-li, YU Sheng-lin, SHENG Zhong, ZENG Guang. Microstructure and creep properties of Sn-Ag-Cu lead-free solders bearing minor amounts of the rare earth cerium[J]. Soldering & Surface Mount Technology, 2010, 22(2): 30-36.
[51] YU D Q, ZHAO J, WANG L. Improvement on the microstructure stability, mechanical and wetting properties of Sn-Ag-Cu lead-free solder with the addition of rare earth elements[J]. Journal of Alloys and Compounds, 2004, 376(1): 170-175.
[52] LAI Zhong-min, XUE Song-bai, HAN Xian-peng, GU Li-yong, GU Wen-hua. Study on microstructure and property of brazed joint of AgCuZn-X (Ga, Sn, In, Ni) brazing alloy[J]. Rare Metal Materials and Engineering, 2010, 39(3): 397-400.
Effect of Ag on properties of Ag-contained filler metals
WANG He, XUE Song-bai, LIU Shuang
(College of Materials Science and Technology,
Nanjing University of Aeronautics and Astronautics, Nanjing 210016, China)
Abstract: Ag is used as a beneficial alloy element in no matter solders or brazing filler metals. Obviously, the addition of Ag has a positive function on melting temperature, wettability, mechanical property and conductivity of filler metals. Therefore, Ag is still widely used in many researches and production in spite that Ag is very expensive. Respectively, three kinds of typical solders (Sn-Zn, Sn-Bi, Zn-Al) and brazing filler metals (Ag-Cu-Zn, Cu-P, Zn-Al) were selected as the representative. The research status on the Ag-contained filler metals and the influence rules of Ag addition on the change of filler metals physical property and microstructure as well as mechanical property were reviewed. Moreover, the problems and difficulties in the process of studying Ag-contained solders and brazing filler metals were presented. Synchronously, some suggestions were put forward to solve the problems and difficulties mentioned above, which provides theory guide for the follow-up study of Ag-contained solders and brazing filler metals, and their prospects were also prospected.
Key words: Ag; Ag-contained alloy; wettability; solder joint; solder; brazing filler metal
Foundation item: Project(kfjj20150604) supported by Foundation of Graduated Innovation Center in NUAA, China; Project supported by Priority Academic Program Development of Jiangsu Higher Education Institutions, China
Received date: 2015-07-22; Accepted date: 2016-02-28
Corresponding author: XUE Song-bai; Tel: +86-25-84896070; E-mail: xuesb@nuaa.edu.cn
(�༭ ����)
������Ŀ���Ϻ��о������»��ؿ��Ż���������Ŀ(kfjj20150604)�����ո�У����ѧ�ƽ��蹤��������Ŀ
�ո����ڣ�2015-07-22�������ڣ�2016-02-28
ͨ�����ߣ�Ѧ�ɰأ����ڣ���ʿ���绰��025-84896070��E-mail��xuesb@nuaa.edu.cn
ժ Ҫ���ֱ�ѡȡ3�ֵ��͵ĺ�����ǥ��(Sn-Ag-Cu��Sn-Zn��Sn-Bi)��Ӳǥ��(Ag-Cu-Zn��Cu-P��Zn-Al)��Ϊ�������в����������˹����⺬��ǥ���о��������о��ɹ������ɷ�����Ԫ�ض���ǥ����Ӳǥ�ϵ��������ܡ�����֯����ѧ���ܵ�Ӱ����ɣ��������ǥ�����о���Ӧ�ù����д��ڵ����⼰��Ӧ�Ľ����ʩ��չ������ǥ�ϵ��о��ͷ�չ���ơ�
[1] ׯ����, ������. ǥ���ֲ�[M]. ����: ��е��ҵ������, 1998.
[2] HANDBOOK A S M. Welding, brazing and soldering[J]. ASM International, 1993, 6: 416-418.
[24] �� ��, ������, Ǯ����. Sn-Bi-Ag-Cu ǥ�ϲ��庸����İ�������[J]. �й���ɫ����ѧ��, 2005, 15(7): 993-999.
[42] �� ��, Ѧ�ɰ�, �� ��, ¦����, ��ˮ��. AgԪ�ض�Zn-Alǥ�����ܵ�Ӱ��[J]. ����ѧ��, 2010, 21(10): 73-76.
[43] ������. ��ͬ������ǥ�϶Ե��ǥ����ͷ����ֵ��Ӱ��[J]. ��������, 1997(3): 30-32.
[44] ����־. �Ե綯�������ͷ���ӷ��ĸĽ��о�[J]. ��������ѧ, 2014, 5(6): 227.
[47] MORSE R S. Electronic circuit package and method of brazing: US Patent 3941916[P]. 1976-03-02.
[49] ������, Ѧ�ɰ�, ������, ���Ļ�, ������. ������ǥ���о���״�뷢չ����[J]. ����, 2007(6): 19-23.


