CVD���ʯĤ��Ӧ�������ѧ�������о���չ
��ϣ��1�����1������Ȩ2�������1��������1
(1. ������ѧ ������ұ��ѧԺ������ ������110004��
2. �����Ƽ���ѧ ���Ͽ�ѧ�빤��ѧԺ��������100083)
ժ Ҫ��
ժ Ҫ������CVD���ʯĤ���������з�Ӧ�������ѧ�������о���չ��������ͬ�����·�Ӧ���ڵ����ѧ��Ӧģ�͡���Ӧ������������ֵ���淽�����ܽ���Щ���෴Ӧ��ѡȡ������Ӧ�Ķ���ѧ�������о����������CVD���ʯĤ��Ӧ���ڵ����ѧ��һ��ʮ�ָ��ӵĹ��̣���˫̼��Ԫ��ȣ���̼��Ԫ��Ĥ�����Ĺ��ϴ�����ԪC2H2��C2��CH3��C��CH�У�����Ĥ��������Ԫ�ɾ������������������CVD���ʯĤ��Ӧ�������ѧ���о������������Ϊ̽��Ĥ���������ı��滯ѧ�ṩȷ���룬����Ϊ��Ч������Ĥ�Ļ���ṩ�������ݡ�
�ؼ��ʣ�
���ʯĤ����ѧ������������ѧ��
��ͼ����ţ�TB34��TN304��O484 ���ױ�־�룺A ���±�ţ�1672-7207(2010)03-0896-10
Theoretical study progress of gas phase chemistry in
CVD diamond film reactor
AN Xi-zhong1, LI Chang-xing1, LIU Guo-quan2, SHEN Feng-man1, LI You-qing1
(1. School of Materials and Metallurgy, Northeastern University, Shenyang 110004, China;
2. School of Materials Science and Engineering, University of Science and Technology Beijing, Beijing 100083, China)
Abstract: The theoretical progress of gas phase chemistry in chemical vapor deposition (CVD) diamond film growth reactor was reviewed. The gas phase reaction model, reaction mechanism and all kinds of numerical simulation methods in different types of reactors and conditions were presented. Meanwhile, the choice of these gas reactions and the corresponding reaction kinetics were summarized as well. The results indicate that the gas phase chemistry in CVD diamond film reactor is a rather complicated process, compared with double-carbon species, single-carbon species create larger contributions on film growth. However, species such as C2H2, C2, CH3, C and CH play a dominant role on film growth depending on detailed processing conditions. On the whole, the research on gas phase chemistry in CVD diamond film reactor can not only provide accurate input for the surface chemistry of film growth mechanism, but also provide theoretical reference for the efficient acquisition of CVD diamond film with high quality.
Key words: diamond film; chemical vapor deposition (CVD); gas phase chemistry
��ѧ�������(CVD)���ʯĤ����������ѧ����ѧ����ѧ��ѧ�ȷ���[1-2]��������������ܡ���20����80������������Ƕ�����CVD���ʯĤ�ĺϳɽ����˴����о�����ȡ���˺ܴ��չ[1-6]�����У�Ĥ������ѧ���ȶ������е��κ��Լ�����������Ϊ�о��ȵ�[1, 7]���Բ�ͬȡ��Ĥ�����ı�����������ǽ����˴��������ۺ�ʵ���о�[8-21]����Ҫ�У��Լ�(CH3)Ϊ ��Ҫ������Ԫ�ı��������������Լ�(CH3)����Ȳ(C2H2)Ϊ��Ҫ������Ԫ������������������C��C2��CHΪ��Ҫ������Ԫ�Ļ���[22-23]�����ڸ��ֲ�ͬ�������������������Ĥʵ�����������еIJ�ȷ�����Լ�ʵ���о����Ѷȣ� ���ǶԽ��ʯĤ��������������û��ɹ�ʶ��
Ϊ��̽��CVD���ʯĤ��������������ԭ�ӳ߶Ƚ���һ���ܹ���ʵ��ӳĤ�����ı��淴Ӧ����ѧʮ����Ҫ[24]����CVD���ʯĤ���������У���Ӧ���ڵ����෴Ӧ������Ҫ���á���Ϊ��Ĥ���������У���ԭ��������������Ԫ�ͳĵױ��洦�ڶ�̬ƽ�⣬����̼����ŵ��γɻ�����Ĥ������[25]�����ܹ�ȷ������Ӧ���������������෴Ӧ������ѧ����ɽ���Ĥ������������Ȼ����������ÿ����Ӧ�����ʺ���ͨ��ʵ��ԭλȷ������Ϊ��ѧ����ѧʵ��ͨ�����ýϸ��Һ��Ѳ��������ҷ�Ӧ���м�������ʱ��̡�Ũ�ȵͣ���ʹ���������ñ��Ľ������������[26]��Ϊ�ˣ�Goodwin��[27]��һ�������̼����Ԫ�еķ�Ӧģ�������������̣��ĵ��Ϸ�����ɷֿ�Ϊ̽��Ĥ�����Ķ���ѧ�����ṩ���ݡ��������������ѧ������������CVD���ʯĤ��Ӧ�������ѧ���о�[3, 8, 28-33]����ͼΪʵ��Ĥ���������еı��淴Ӧ�ṩȷ����ʵ�����ݡ�CVD���ʯĤ��Ӧ�������ѧ��ȷ�����ڴ�ԭ�ӳ߶Ⱥ�������Ĥ�����ı��淴Ӧ���������۳߶��о�����Ĥ����֯�仯�Լ��Ӻ����ȷ����Ӧ���ն�Ĥ�����ٶȺ�������Ӱ���������Ҫ�����ۺ���ʵ���塣���ڴˣ��������߶Խ�20����CVD���ʯĤ���������з�Ӧ�������ѧ�������о������������ص�Բ�ͬ�����·�Ӧ���ڵ����෴Ӧģ�ͼ����������ܽᡣ
1 CVD���ʯĤ��Ӧ�������ѧ���о���״
��������ʵ�鼰�������Ѷȣ����Ƕ�CVD���ʯĤ��Ӧ�������ѧ���о������ü����������ֵģ�����档�����þ���Ļ�ѧ����ѧģ��������̼�����������ѧ�Ŀ�����Kline��[34]�����Ǽ���(����ʵ����ȷ��)���ڼ���������巴Ӧ����C2Hx̼����ŵ�Ũ�ȱ�CH3������̼����ŵ�Ũ�ȸߵöࡣ�������DZ���CH3�ǡ�����ܵ�Ĥ������Ԫ�����������������ʾC2H2Ӧ���Ǽ�����������е���Ҫ��Ԫ��
Goodwin��[27]������һ��һάģ��ģ����ʯ����������������а������ٶȡ��¶ȼ���ԪŨ�ȷֲ��ļ��㡣����ʹ�ø�ģ��ģ����Celii��[7-8]����˿(HF)��Ӧ���������еĽ��ʯĤ��ѧ�������������ʵ�飬���������ԪŨ����ʵ���õ�Ũ��һ�¡�Ȼ�����������ģ����Ҫ���IJ�ֻ���ٶȡ��¶ȼ�Ũ�ȳ�����Ҫ������������ɢ�����Լ�����ķ�Ӧ���ơ�Ϊ��ģ�ǰ���õķ�Ӧ����������Ҫ���ö�άģ��[35]���ڴ������²�����άģ�ͣ�����һάģ�ͻ���ںܶ���Լ���ء�
Frenklach[36]ģ����������˿��Ӧ���ڽ��ʯĤ������ϡ�͵ļ������������������ѧ��ģ���мٶ����ڲ�ͬ��Ӧ�¶ȣ���Ӧ���ڵ�ѹ�����������ʲ��䡣��ԭ�е�112����Ӧ��39����Ԫ�Ļ����ϣ���������19����Ӧ��6������Ԫ�������˼�����·ֽ��γ�CH3��CH2���ŵij�ʼ�Σ������Ӧ����C2H6��C2H5��C2H4��C2H3��C2H4��C2H3��Ϊ�γ�C2H2��ǰ�����塣�ڻ�������(��Ħ������0.3% CH4-H2�Ļ�����壬ѹ��Ϊ2.666 kPa����ʼ��Ӧ�¶�Ϊ2 600 K�����¶���1 400 K/s��������ʱ���ֱ���½�)�µ�ģ�����������ڽ��ʯ�ij����¶��£�C2H2����Ҫ��̼����Ԫ��Ȼ��������¶��½����ʴ�1.4��103 K/s��Ϊ1.4��106 K/s��CH4��CH3�ͳ�Ϊ��Ҫ��������Ԫ����ͼ1��ʾ[36]��
Ϊ���о�CVD���ʯĤ������������Frenklach��[3]�ֽ�һ���о���CH4-H2��CH4-Ar�Լ�CH4-O2-H2������������˿��Ӧ���ڵ����ѧ�����õ��������ද��ѧ�Ļ�ѧ��Ӧ�����ǻ���������ʵ����������ȼ�պͻ��滷����2�ֻ�����ǰ���ǰ���125����Ӧ��31����Ԫ�����ѧ����Ҫ���ڼ���ĸ��·ֽ�������������Ż����������ָ��ֵ��ͻ���ʵ�飻���ߵĻ�������342����Ӧ��70����Ԫ����Ҫ�Ƕ����������������Ȳ����ϩ�����е��γɺ������������2�ֻ�������ȥ���������¶�Ĥ��������Ч�������Եķ�Ӧ��Frenklach��[3]�����158����Ӧ��50����Ԫ�����ѧ�����������������Ĥ��������������У�����Ԥ��Ĺؼ��������������ʷ���ⲻ�����������ں��˿����������ǰ������˿����
ǰ����о���༯������˿ϵͳ������������˿��ʵ�����ܷḻ��ֱ���绡�Ľ�����١�Coltrin ��[37]�����о��˵�ѹֱ���绡�����������䷴Ӧ����CVD���ʯĤ������������Ӧ�������ѧ����ѧ���������������������ģ�⣬���滯ѧ�����й�������ԪŨ�ȵı߽��������ڸ÷�Ӧ���ڵ�����ǹ������ֱ�ڳĵױ���[12]���ɵ�����ǹ����ĸ���������ײ���ĵ�ʱ��������ԳƵ�������ͼ2��ʾΪ������ǹ/�ĵ������ǵķ�Ӧ������ʾ��ͼ[37]�����У�ͼ2(a)�����������ǵĵ�����ǹ��Ӧ�������ͣ����ܴ��������������ֱ����С����ͨ����չ������ѹ�����ᵼ����������Ѹ�����ӡ����Ǽٶ�����ǹ���ڴ����������ںܴ��ֱ����Χ�ڣ��������ٶȷ����Ǿ��ȵģ����������κε��������Ӱ�졣�о��е����෴Ӧ��������34����Ӧ��������[37]�еı�1�����У���Ӧ���¶��������ɸĽ���Arrhenius��ʽ��ʾ��ki=AiT��iexp[-Ei/(RT)](���У�kiΪ��Ӧi�ķ�Ӧ���ʳ�����AiΪָǰ���ӣ���iΪ�¶�ָ����EiΪ�����ܣ�RΪĦ�����峣����TΪ����ѧ�¶�)��ģ���е�ÿ����Ӧ���ǿ���ģ�ͨ����Ӧƽ�ⳣ�����Ի���淴Ӧ���ʡ���Ӧ�����п����˶����Ӧ�����ʳ�����ѹ�������ԵĹ�ϵ�����е����ʱ���ʽ��ƽ�ⳣ���Լ�����ѧ���ܵȶ���CHEMKIN���������[38]��

��������Ϊ��Ħ������0.3% CH4-H2�������, ѹ��Ϊ2 666 Pa, ��ʼ��Ӧ�¶�Ϊ2 600 K�����¶���1 400 K/s�����������½�
ͼ1 CVD���ʯĤ�ڻ��������³���ʱ��Ӧ������Ҫ��Ӧ��Ԫ��Ũ�ȷֲ�[36]
Fig.1 Concentration distributions of major reaction species for CVD diamond film under base condition
�����ڼ����п����˵�������ǹ�������ֽ�ȶ�����ɷּ����ʯĤ�������ʵ�Ӱ�죬���������õ��������Ϊ���¶�T=2 500 K��CH4��Ħ������x0(CH4)= 0.005��������ԭ��4�ֲ�ͬ��Ħ���������ֱ�Ϊ0.05��0.30��0.60��0.95����ڴ���ƽ����Ϊ������ͼ3��ʾΪ��ڴ���ԭ�ӵ�Ũ�ȶ�������Ԫ�ֲ���Ӱ��[37]����ͼ3�ɼ������ڴ�CH4����ڴ������룬�ڷ�Ӧ����ʵ���ϴ���2��Ũ�ȱ߽�㣬һ������ڴ�����һ���ڳĵס����ڳ����ı������3���߽�㼴���������ȼ�Ũ�ȱ߽�㡣̼����Ԫ�ķֲ���Ҫ��������ڴ���ԭ�ӵ�Ũ��x0(H)����ȡ��Сֵx0(H)=0.05ʱ����ԭ��Ѹ��ͨ����ӦCH4+H![]() CH3+H2��CH4����ȡ1����ԭ�ӣ�ֱ�������㹻CH3ʹ��Ӧ�ﵽ�ֲ�ƽ�⡣���û�����Ե���ԭ�ӵ���ȡ��ֻ������CH��C���ɡ�����ԭ�ӵ�Ũ��x0(H)=0.30ʱ������ȡ��Ӧ�õ����㹻���������ڴֵļ���������C����Ҫ��Ԫ������ڴ���x0(H)�ﵽ0.95ʱ��C��Ħ��������������ĵ�̼��Ԫ��Ħ��������4�������������ұ�C2H2��1����������ͼ3������[39-40]������C�ǿ��ܵ�������Ԫ����ˣ�C�����ǵ����淴Ӧ������ȥ�����ǻ���CH2��CH��C2H����Ҳ�������о������ǣ���Щ���ŵ�Ħ��������C��C2H2��CH3��Ħ��������ȵ�2������������ˣ���Suzuki��[39-40]���о��У���������ͨ�������ԣ�������Ϊ������Ԫ���������������������ǹ��ֻ�н��ٵ�H2�ֽ�ʱ��CH3Ϊ��Ҫ��������Ԫ�����ڽϸߵķֽ�ˮƽʱ��C��Ϊ��Ҫ��������Ԫ�������������е�CH4����С��1%ʱ������Щ�����µĽ��ʯ������������Ϊ��3��������Ԫ��C2H2�������á�
CH3+H2��CH4����ȡ1����ԭ�ӣ�ֱ�������㹻CH3ʹ��Ӧ�ﵽ�ֲ�ƽ�⡣���û�����Ե���ԭ�ӵ���ȡ��ֻ������CH��C���ɡ�����ԭ�ӵ�Ũ��x0(H)=0.30ʱ������ȡ��Ӧ�õ����㹻���������ڴֵļ���������C����Ҫ��Ԫ������ڴ���x0(H)�ﵽ0.95ʱ��C��Ħ��������������ĵ�̼��Ԫ��Ħ��������4�������������ұ�C2H2��1����������ͼ3������[39-40]������C�ǿ��ܵ�������Ԫ����ˣ�C�����ǵ����淴Ӧ������ȥ�����ǻ���CH2��CH��C2H����Ҳ�������о������ǣ���Щ���ŵ�Ħ��������C��C2H2��CH3��Ħ��������ȵ�2������������ˣ���Suzuki��[39-40]���о��У���������ͨ�������ԣ�������Ϊ������Ԫ���������������������ǹ��ֻ�н��ٵ�H2�ֽ�ʱ��CH3Ϊ��Ҫ��������Ԫ�����ڽϸߵķֽ�ˮƽʱ��C��Ϊ��Ҫ��������Ԫ�������������е�CH4����С��1%ʱ������Щ�����µĽ��ʯ������������Ϊ��3��������Ԫ��C2H2�������á�
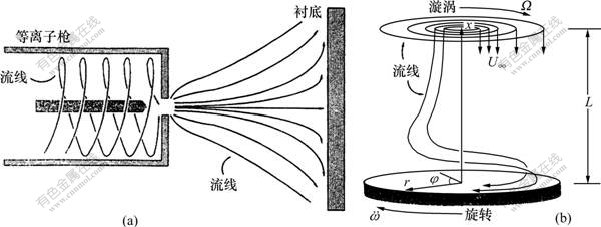
(a) ������ǹ/�ĵIJ���ͼ��(b) ��Ӧ������ʾ��ͼ(ͼ�е�ϵͳ��Բ������������(r, ��, x))
ͼ2 ֱ���绡�������巴Ӧ�����伸��ʾ��ͼ[37]
Fig.2 DC arc plasma jet reactor and its geometry

��ڴ�4�ֲ�ͬ��ԭ�ӵ�Ħ��������(a) 0.05; (b) 0.30; (c) 0.60; (d) 0.95
ͼ3 ����¶�Ϊ2 500 K����ڴ�����Ũ��Ϊ0.5%���ĵ��¶�Ϊ1 200 Kʱ��������Ԫ�ֲ�[37]
Fig.3 Gas-phase species distributions for inlet temperature 2 500 K, and inlet CH4 concentration 0.5%,
and substrate temperature 1 200 K[37]
Mankelevich��[35]����������CVD���ʯĤ��Ӧ���������������ȴ��ݼ����ѧ��һ�¼���Ķ�άģ�ͣ�ѡ�õ�����ʵ�����е�ֱ���绡�ŵ練Ӧ������ʹ�õ�CHER����������ද��ѧģ�顢��ѧ����ѧģ���Լ���ƽ����Ӷ���ѧ����ѧģ�飬������������������������ѧ��Ԫ�غ㷽�̶�Բ���μ��ν�����ֵ��⡣���෴Ӧ������������78����Ӧ��15����Ԫ��ͨ��������[37, 41]�����õ������¶������Լ�H2�ķֽ�ˮƽ����á�ͨ����һ�¼������˻�ѧ��Ԫ�Ŀռ�ֲ��������Լ�����������������������е�һЩ������ʵ������˶Աȣ�������֣��ڳĵ��ϵĶ������䱻���ƣ���ѧ��Ԫ�Ĵ�����Ҫ��ͨ����ɢ���������С�Ȼ�������뿼�Ƿ�Ӧ���ڵĶ������ʡ��������෴Ӧ���������෴Ӧ�¶ȷֲ�ʮ�ֹؼ���ģ������¶ȳ����ڷŵ������������ؾ���͵缫���͡���������ɢ(�ڷŵ�������)�ͱ��淴Ӧ(�ĵ���)����ѡ����Ԫ������ķֲ��������ܵĺ�̼���������½���
Schmidt��[42]����˿CVD���ʯĤ���������е�����ɷֽ������о������������ΪH2��CH4��O2�Ļ�����ֻ�ı�O2�ĺ������ڸ������������£���˿��Ӧ��������Ũ�ȵı仯�����ļ�������(QMS)ȷ�����ɵ�˿��Ӧ����ɢ������������ɵ�����ɷֵı仯����ͨ��QMS����ڵ�˿�ڴ�ֱ�����ϵ�λ�����ⶨ������QMS���ܲ����Ļ���Ũ�ȣ�����ͨ��CHEMKIN����������á��ڲ������������£����ǵ�ʵ���������ۼ�����пɱ��ԡ���H2-CH4-O2ϵͳ��Frenklach��[3]�������Լ����ѧ��Ӧ���ƣ��û��ư���31����Ӧ��18����Ԫ[42]�����Ǽ������ڵ�˿λ�ø����������ֵ����Сֵ����Ҫ������Ԫ������Ũ�ȷֲ�����Щ��Ԫ����CH4��CH3��C2H2���������[3, 43]���ڳĵ�����CH3��Ħ�������dz��ͣ�����������������̵�CHx���ű����ڱ��洦�γɣ����⣬��ʹ��ȲŨ�ȵĽ��ͳ̶ȱ�ʹ����Ũ�ȵĽ��ͳ̶ȸ���������������½���Ĥ������ߡ���HFCVD��CH3������Ҫ��������Ԫ����C2H2�ɵ���ʯī���ӵ��γɣ�O2��CHx��Ӧ�γ��ȶ���CO��CO2��Cԭ�ӿ��ܲ�����ʯ�ij������̣���������O2Ũ�ȵ����ӣ�Ĥ���������ʽ��͡��ڳĵ�λ�ô�CH2�ź�ǿ������ʯ���������ʳ����ȡ�����ָ�����ĵױ��渽���ķ�ӦCH4+H��CH3+H2�dz���Ҫ��
Goodwin��[43]�о��˽��ʯ��Ĥ�ڵ�ѹ����̼ ��/��ȼ�ջ����еĺϳɡ�����Ȳ�����ֵģ���У�����ʹ����Miller��[44]����ĸ��������(218����Ӧ)�����ڱ�ϩ�ͱ�����棬������������16����Ӧ[43]������C3H8��C3H6����������Щ��Ӧ��������[45]�������Ƕ����ʳ��������˸��£�������ֵ������������ʵ������˶Աȣ������кܺõ�һ���ԡ�
���Coltrin[46]��Goodwin��[27]���о���Kassmann��[47]������һ�����ڽ��ʯĤCVD������ģ�͡���ģ���ǻ�����̬�·�Ӧ��������������������������ƽ�⡣ͬʱ��ʹ������Evans��[48]���Ƶı任��ģ�ͷ���ת��Ϊһ����ͨ�IJ�ַ��̡�����[47]�еı�1�����˹���ģ�ͷ�����ѡ��һ����ʵ������ٱ�����Ĥ�γɵ����෴Ӧȡ��Coltrin��[37]��ֱ���绡���䷴Ӧ��ģ�͡�����ķ�Ӧ�����������ȶԽ��ʯ������Ӱ�졣����[47]�еı�2�г�����������41�����෴Ӧ���������������ȷ�Ӧ����ѧ�IJ���������[47]�еı�3�ͱ�4��ͨ����Sandia ����ʵ���ҵ�Spin����[49]���иĽ�����IBM��RISC/6000����վ����ֵ������ģ�ͷ��̡������ĵ��������Σ��������˶���˿��ֱ���绡���估�ȼ���ϵͳ����⡣���������ͨ��ԭ���Ȼ�ѧ�ֽ������������Խ����ܺģ��ӳĵ�����������ʹ�������λ���γɣ����պ��ڳĵ��Ϸ��γɣ��ⲻ������˶�̼�IJ��������������������ʸ��ߣ�ͨ��ʹ���ȼ�����ڳĵ����������Ż��ķ�Ӧ���ܹ���1 200 mm/h����������������ʯĤ�������õ�����Ҳ�ȴ�ͳ��ֱ���绡������������С1����������
Mankelevich��[50]��������˿CVD��Ӧ������άģ�ͣ��о����ʯ����������ͱ�����̡�����ֵ���Ĵ��䷽���У�����������ͱ��淴Ӧ������������ɢ������ɢ����˿���Ĵ���ֽ��Լ��ĵ״��ı��涯��ѧ����3��ģ����ɵ�ģ���ܹ������������(���Ⱥʹ��ʡ���ѧ����ѧ)���ĵ״�������-�������(���ʯ����������)�Լ���Ӧ����D��Ĺ���(��˿����������ȼ���Ĵ��ֽ�)���ڵ�1��ģ���У���ֵ�����һ�������������������������ԪŨ�ȵ��غ㷽�̣���ֱ������ϵ�У����Ʒ��̵ľ�����ѧ��ʽ������[51]�������ѧ���Ȼ�ѧ��ģ����ʹ�õ�������C-H-O������GRI-Mech1.2����ķ�Ӧ�� ��[52]����2��ģ�鿼����̼����Ԫ��ԭ�Ӻͷ����������ķ�Ӧ������˿��Ӧ���ڻ���D�����ҪӰ��ٶ�Ϊ��˿����������ȼ�H2�ķǾ��ȷֽ⡣������¶ȷֲ���Ҫ�ɵ�˿���ȴ��ݾ���������Wahl��[53]������ʵ������Mnakelevich ��[51]���������άģ�ͽ�������֤����Ҫ�DZȽ�CH3��Ũ�ȣ�������������нϺõ�һ���ԡ�
Mankelevich��[54]����������˿����ĵ�CH4-N2- H2��CH4-NH3-H2���������б��淴Ӧ�����ѧ�����ۺ�ʵ���о���Ŀ���ǽ�������˿��Ӧ����ͨ�����Ƶ��ļ�����(��N2��NH3����ʽ����)��CH4-H2���������Ӱ�졣������ģ�Ͱ�������3�����棺(1) ��Ӧ�����ļ���(������ļ��ȼ�����˿�������ԭ�ӵ�����)��(2) �������(���Ⱥʹ��ʼ���ѧ����ѧ)��(3) �ڳĵ״������������̡�������ģ�������û�гĵף����ԣ����һ������û�б����ǡ��о����������N2�ǷǷ�Ӧ�Եģ�������NH3�����ѧ�ͳɷֲ�����ҪӰ�죬������������һϵ�е�H�滻��Ӧ����Щ��Ӧ���뵽��CH3����ת����HCN�IJ����淴Ӧ��ȥ����ˣ������˲�����ʯ����������̼����Ԫ��������������[55]�еĽ��һ�¡�
Ϊ�о�CVD���ʯĤ���������н����洦�����ѧ��Larson��[56]���������ڴ���ѹ����Ƶ(RF)�������巴Ӧ������ֵģ�͡�ģ�������෴Ӧ������ ���IJ��������ڼ���ȼ�յ�GRI�����е�̼�ⷴ Ӧ[52]�����м�������ԭ��̼�ķ�Ӧ����Ϊ��4 000 K��1��105 Pa��������������£���������Ϊ90%��̼��ԭ��̼����ʽ���ڡ��о������õ����෴Ӧ��������Ӧ������Դ������[56]�еı�2�����а���46�����෴Ӧ��������Щ�����еķ�ֵ�¶���4 000 K���� �ԣ����෴Ӧ�����ʳ�����ͨ���ڽϵ��¶��µIJ�������������Ƶõ����������˷�Ӧ���ʵIJ�ȷ�� �ԡ�Ȼ������ϵͳ�е����෴Ӧ�ڷ�Ӧ���ڵĴ����ӽ�ƽ��״̬�����������¶���ߵ�λ�ã����ʳ���ͨ�����Ƚ��ȶ�����Ӧƽ��ͨ������CHEMKIN����ѧ���ݿ���Ȼ�ѧ������ȷ��[38]����ģ��Ԥ����CH4��C2H2��C2H4��C2H6����Ԫ��Ħ�������ںܿ���Χ�ڶ�����ɫ���IJ����������һ�¡�ͬʱ����ģ��ҲԤ����H��CH3��C2H2��C�ڽ��ʯĤ�������洦��Ũ�ȣ�������֣���RF�������巴Ӧ���ڣ�CH3��C2H2��ԭ��C������Ĥ�ij�������Ҫ���á��Դ���ѹRF����������ʯCVD��Ӧ���ڽ����洦�����ѧ�����뼸��������CVD���ʯ�Ļ������жԱȷ��֣�Ԥ��õ����ȵ������嵼�±����и��ߵ�H-CH3��C2H2-CH3��Ũ�ȱȡ�
ʹ��CHEMKIN�����[11]��Tsang��[57]��ֵģ����CVD���ʯĤ������������˿��Ӧ���ڳ��ֵIJ�̼ͬ����Ԫ��Ũ�ȷֲ������������ֵ��ʹ�÷���������ֱ��ԭλ�����õ��Ľ�����жԱȡ�����ͬ��̼������(CH4��C2H2��C2H4����C2H6)��Ϊ�������������̼Դ��ȷ��C��H2�����ʵ����ȱ�����1%����C2H6������ӦԴ��ʱ���ﵽ��ƽ���ͨ�����㷢�ִ�δ���͵�C2��Ԫ��C1��Ԫ��ת�䲻��ֱ�ӵ����෴Ӧ���̣����ڷ�Ӧ������1�������м䷴Ӧ����������Щ��Ӧ�ڱ���̼�ⷴӦģ���в�û�г��֡�������Ϊ����Щ�����Եķ�Ӧ���ܻ������������⻯���ã�����������£������������ڵ�˿�ı��档�й��ⷽ�������д��ڽ�һ���о���������ֵģ���ȶ���̼����Ԫ�⣬Tsang��[58]ʹ��ͬ���ķ������Ե���CVD�����м�CH3����ԭ�ӵ�Ũ����Ϊ��˿�¶ȵĺ���������ģ�⣬����֮������ʵ��Ľ�������˶Աȡ�
Riccardi��[59]��ֵ�о������ڳ������ʯ������ʯ̼Ĥ�ĵ�����Ƶ��Ӧ���ڡ���ѹCH4-Ar������������ѧ�����õ���ֵģ�ⷽ������ͨ�������ڵ��������еĸ��ӻ�ѧ����ѧ��ȷ��������Ԫ���о�����������ڴ�����ŵ������£�CH3�������ĺ�̼���ţ���̼�Ķ�����C2��CH4�ķŵ��б��߶�ϡ�͡���ˣ�������Ϊ����CH4���������У�Ĥ���������෴ӦԴ��ΪCH3������CH4-Ar���������У�C2��ΪĤ���������෴ӦԴ����
Li��[60]������������ʯĤ���������ѧģ�ͣ���ģ���а�����10��̼����Ԫ��8����Ӧ�����ڸ�ģ�ͣ��ٶ��ɴ�ͷ������ӹ������Ԥ��õ��ķ��Ӻ���̬�����Լ���ͳ����ѧ����õ�������ѧ��������ѧƽ��ģ����Ǽ����˻�ѧ��Ԫ������ɷ֡����ܸ�ģ��Ԥ��ľ��Գɷ��������л�õ�ʵ�����ݽϷ��ϣ�����ģ��ֻ�Ƕ��Եؽ�����ʵ�������۲쵽�ĸ���������Ԫ��Ũ������������м���Ũ�����Ӷ������ı仯��
Dong��[61]ʹ�����ؿ���(MC)����ģ����CH4/H2���������ڵ��Ӹ�����ѧ�������(EACVD)�еķֽ���̣������˵����ٶȷֲ���H2�ֽ�ı仯��ͬʱ���о��˼���ķֽ��淴ӦԴ���м���Ũ�ȵı仯���о������������Ҫ�Ľ��ʯ������ԪΪCH3��CH3+��
ʹ��GRI-Mech3.0[52]���ݿ⣬��ѧ���[62]�Ը�����������CVD���ʯĤ��Ӧ����C-H-O��C-H-N��ϵ�е��������ѧ�����˼��㣬�����о������ǿ��ܵĵ�����ײ�ֽ�����ӷ�Ӧ��������Դת��Ϊ���Ի��ŵĹ��̴���Ϊ�Ȼ�ѧ���̣�����ѹ���йصķ�Ӧ����ȡѹ���ϵ�ʱ���ٶȡ���������������ϵ�ڷ�Ӧ�������Ǻ��º�ѹ�Ҿ��ȵģ���������ƽ��Ũ����Ϊ�����¶��µ�������ɡ��������������CVD���ʯĤ����Ҫ������Ԫ����Ȳ���·ǽ��ʯ̼��������ԭ�ӿ�ʴ�ǽ��ʯ̼��������һ����Ҫ������ͨ�����෴Ӧ�ı���Щ��Ԫ��Ũ�ȣ����ӵ��ڸı���Щ��ԪŨ�ȵ�ͬʱ��CN�Ⱥ�����Ԫ��ǿ�ҵز�����Ĥ�ɺ˺������ı�����̡�
��ֱ���绡�������巴Ӧ���ڣ�Huang��[63]����������ʵ������ϵķ�����ֵģ���˽��ʯĤ���������г��ֵ�C��C2H2��C2H��C2��Ԫ��Ħ��������ģ����ʹ�õ���������ѧ������ѧģ�͡������п�����3�����壬��CH4��H2��Ar������ij�ʼ�ٶȸ�����������ټ����ֱ�������㡣���õ�ģ���н��������¼��裺(1) CH4�ķֽ�������ת���أ���ΪCH4�����������еĺ����ϵͣ�(2) ��ʼ������¶ȶ�Ϊ50 �棻(3) �������崦�ھֲ�����ѧƽ�⣬����ζ�������ھ��ж���ѧ�ͻ�ѧƽ�⣻(4) ���������״̬���ȶ��ġ�������������C��C2��C2H��C2H2��Ԫ��Ħ���������ųĵľ�����뷢���仯������Ҫ����Ϊ�ڸþ����ϲ�ͬ�ĵ��������¶��£�����������Ԫ�ķֽ���ٽ�ϵ����ʲ�ͬ��ͨ�������ųĵ����������ӣ�C2��ԭ��C��Ħ���������ͣ�C2H2��Ħ����������C2H��Ħ����������һ���м�����ϳ��ַ�ֵ������ֱ���绡������������CVD��Ӧ����CH��C2��H����Ҫ��Ԫ�Ĵ��ڣ���Chen��[64]������ʵ����Ҳ�õ���֤ʵ��
Petherbridge��[65]�������x%H2S-1%CH4-H2 (xΪ0~1)��1%CS2-H2��������CVD���ʯϵͳ��C-S��ϵĻ�����������Ԫ��Ӧ��ѧ����ֵ���㣬���������õ���SENKIN���룬����CHEMKIN��������һ����[38]�������ڼ����е����к�̼����Ԫ�ķ�Ӧ���������¶ȵ����ʳ�����������GRI-Mech3.0��Ӧ�������ݿ�[62]��������Ԫ�ķ�Ӧ���ݴ��й������л�ã��������ʣ����������û�У����ú�����Ԫ�����������ơ������еĻ�ѧ��Ӧ������[65]�еı�1��������������������弰��˿����CVD������һ����һ���ԣ���ˣ�����֤����ǰ����Ļ���[66]�����⣬���������Եķ�Ӧ(������Щ�ڽ��ʯ���������������ķ�Ӧ)�ƺ�������ϵ��ྦྷCVD���ʯĤ�ij̶ȼ����Բ��������Ӱ�졣���Rennick��[67] ���ö�άģ��ģ����ֱ���绡�ŵ�CVD��Ӧ���ڵ����෴Ӧ��ѧ�����õ��Ȼ�ѧ���ݼ��Ļ�ѧ��Ӧ������ȡ������[68]�����а���23����Ԫ��76�����淴Ӧ����ģ�͵�������������¶ȵĿռ�ֲ��������Լ���Ϊ����H2��CH4�������ʼ����빦�ʵȲ��������ĸ�����Ԫ�������ܶȡ�
�����������Ƕ���˿[69]��ֱ���绡����[70]�����������巴Ӧ���ڽ��ʯĤ�������������������������ѧ�������о���������֣�����˿��Ӧ����(��������ΪAr-CH4-H2)������˿�¶Ƚϸ�ʱ(��TfilΪ2 700 K)����Ĥ�������渽������C1��Ԫ��Ũ��������Cԭ��Ũ�Ƚϴ����ǻ���Ĥ�������洦�����Ҽ�������Ӧ���ٽ�Ĥ������[69]����ֱ���绡���䷴Ӧ���ڣ�Mankelevich��[70-71]���ö�ά�����ģ��ģ���˷�Ӧ����25��������Ԫ��14��������Ԫ�����ѧ����Է�Ӧ���ڲ���������H2��CH4�����������빦�ʵ������ԡ����������ʵ���й۲쵽�Ľϴ��Ҳ����ȵ�����������Ҫ��Cԭ�Ӻ�CH��Ԫ�ķֲ�(�ڴ���Bristol��Ӧ����)��CHy(y=0~3)��Ԫ�ķֲ�(��С���ʵ�SRI��Ӧ����)������[70]�������������巴Ӧ���ڣ���������������Ҫ����C���뵽��������λ�þ�����CH3��Ԫ�ļ����Ĥ�����Ĺ���С���������Ե�����λ�õĹ��ܴ�������������Ȼ��Ҫ��CH3��˫���ŵ�λ�õ�����������֧�䣬��ˣ����������ʱȳ��������������ʸߵöࡣ
2 ���ۼ�չ��
������ֵ����ķ�����CVD���ʯĤ��Ӧ���ڵ����ѧ�������о���չ���������������ѧ���о���������ǶԻ��������Ĥ�����ı��淴Ӧ���������ǻ��ʵ�ʸ�Ч������Ĥ��������Ҫ�����ۺ�ʵ�����塣����֮������ʵ��Ĥ������Ӧ���ڵ����ѧ��������Ҫ�ġ�����ÿ�ַ�Ӧ���ڵ����ѧģ�Ͷ������źܶ���裬���ܶ�����Ļ����ͨ���������ȫ�ٶ���ʵ�ֵģ�ͬʱ����ʹ����ͬ��Ӧ����ʵ��CVD���ʯĤ���������ѧҲ����ͬ����ˣ�Ҫ��ʵ������CVD���ʯĤ��Ӧ���ڵ����ѧ��������о�������ʵ�飬������Ϊ���ѧ��Ӧ�ṩ����Ķ���ѧ��Ϣ������ʵ�鼼���IJ��Ϸ�չ����Щʵ�����ؽ�Ϊ��Ӧ�������ѧ�������о��ṩǿ���������ݣ��Ӷ�Ϊ̽��CVD���ʯĤ�����ı��滯ѧ��Ӧ����(Ĥ����������)���¼�ʵ�Ļ�����
�ο����ף�
[1] Lee S T, Lin Z D, Jiang X. CVD diamond films: Nucleation and growth[J]. Materials Science and Engineering: R: Reports, 1999, 25: 123-154.
[2] Gicquel A, Hassouni K, Silva F, et al. CVD diamond films: From growth to applications[J]. Current Applied Physics, 2001, 1(6): 479-496.
[3] Frenklach M, Wang H. Detailed surface and gas-phase chemical kinetics of diamond deposition[J]. Phys Rev B, 1991, 43(2): 1520-1545.
[4] Ф����, ���, ������, ��. �˻�Է�������ʯĤ�ṹ����ѧ���ܵ�Ӱ��[J]. ���ϴ�ѧѧ��: ��Ȼ��ѧ��, 2007, 38(4): 669-673.
XIAO Jian-rong, XU Hui, WANG Huan-you, et al. Effects of annealing on structural and electric property of fluorinated diamond-like carbon thin films[J]. Journal of Central South University: Science and Technology, 2007, 38(4): 669-673.
[5] MA Ying, WANG Lin-jun, LIU Jian-min, et al. Characterization of (100)-orientated diamond film grown by HFCVD method with a positive DC bias voltage[J]. Trans Nonferrous Mer Soc China, 2006, 16(s1): s313-s316.
[6] May P W. Materials science: the new diamond age?[J]. Science, 2008, 319(5869): 1490-1491.
[7] Celii F G, Pehrsson P E, Wang H T, et al. Infrared detection of gaseous species during the filament-assisted growth of diamond[J]. Appl Phys Lett, 1988, 52(24): 2043-2045.
[8] Harris S J, Weiner A M, Perry T A. Measurement of stable species present during filament-assisted diamond growth[J]. Appl Phys Lett, 1988, 53(17): 1605-1607.
[9] Harris S J. Mechanism for diamond growth from methyl radicals[J]. Appl Phys Lett, 1990, 56(23): 2298-2300.
[10] Chu C J, D��Evelyn M P, Hague R H, et al. Mechanism of diamond growth by chemical vapor deposition on diamond (100), (111), and (110) surfaces: Carbon-13 studies[J]. J Appl Phys, 1991, 70(3): 1695-1705.
[11] Matsui Y, Yabe H, Hirose Y. The growth mechanism of diamond crystals in acetylene flames[J]. Jpn J Appl Phys, 1990, 29(8): 1552-1560.
[12] Goodwin D G. Simulations of high-rate diamond synthesis: Methyl as growth species[J]. Appl Phys Lett, 1991, 59(3): 277-284.
[13] Loh K P, Foord J S, Jackman R B. Reactive chemistry of C2Hx species on CVD diamond[J]. Diamond and Relat Mater, 1998, 7(2/5): 243-246.
[14] Hsu W L. Mole fractions of H, CH3, and other species during filament-assisted diamond growth[J]. Appl Phys Lett, 1991, 59(12): 1427-1429.
[15] Frenklach M. Monte Carlo simulation of diamond growth by methyl and acetylene reactions[J]. J Chem Phys, 1992, 97(8): 5794-5802.
[16] Battaile C C, Srolovitz D J, Butler J E. Molecular view of diamond CVD growth[J]. Journal of Electronic Materials, 1997, 26(9): 960-965.
[17] Okkerse M, De Croon M H J M, Kleijn C R, et al. A surface and a gas-phase mechanism for the description of growth on the diamond(100) surface in an oxy-acetylene torch reactor[J]. J Appl Phys, 1998, 84(11): 6387-6398.
[18] Grujicic M, Lai S G. Atomistic simulation of chemical vapor deposition of (111)-oriented diamond film using a kinetic Monte Carlo method[J]. Journal of Materials Science, 1999, 34(1): 7-20.
[19] ��ϣ��, ����, ����Ȩ, ��. CVD���ʯĤ{100}ȡ���ڸĽ���ѧ��Ӧģ����������ԭ�ӳ߶�ģ��[J]. ϡ�н��������빤��, 2002, 31(5): 349-352.
AN Xi-zhong, ZHANG Yu, LIU Guo-quan, et al. An atomic scale simulation on {100} oriented CVD diamond film grown under modified chemical reaction model[J]. Rare Metal Materials and Engineering, 2002, 31(5): 349-352.
[20] AN Xi-zhong, ZHANG Yu, LIU Guo-quan, et al. Atomic-scale kinetic monte carlo simulation of {100}-oriented diamond film growth in C-H and C-H-Cl systems by chemical vapor deposition[J]. Chin Phys Lett, 2002, 19(7): 1019-1020.
[21] AN Xi-zhong, LIU Guo-quan, WANG Fu-zhong, et al. Electronic structure study of growth species adsorption and reaction on cluster models for the diamond surface using LDA method[J]. Diamond and Relat Mater, 2003, 12(12): 2169-2174.
[22] Gomez-Aleixandre C, Sanchez O, Castro A, et al. Optical emission characterization of CH4+H2 discharges for diamond deposition[J]. J Appl Phys, 1993, 74(6): 3752-3757.
[23] Gruen D M, Zuiker C D, Krauss A R, et al. Carbon dimer, C2, as a growth species for diamond films from methane/hydrogen/ argon microwave plasmas[J]. J Vac Sci Technol A, 1995, 13(3): 1628-1632.
[24] Brenner D W. Empirical potential for hydrocarbons for use in simulating the chemical vapor deposition of diamond films[J]. Phys Rev B, 1990, 42(15): 9458-9471.
[25] Dawnkaski E J, Srivastava D, Garrison B J. Time dependent monte carlo simulations of H reactions on the diamond {001}(2?1) surface under chemical vapor deposition conditions[J]. J Chem Phys, 1995, 102(23): 9401-9411.
[26] Jensen K F, Rodgers S T, Venkataramani R. Multiscale modeling of thin film growth[J]. Current Opinion in Solid State and Materials Science, 1998, 3(6): 562-569.
[27] Goodwin D G, Gavillet G G. Numerical modeling of the filament-assisted diamond growth environment[J]. J Appl Phys, 1990, 68(12): 6393-6490.
[28] Frenklach M. Monte Carlo simulation of hydrogen reactions with the diamond surface[J]. Phys Rev B, 1992, 45: 9455-9461.
[29] Zhao X G, Carmer C S, Weiner B, et al. Molecular dynamics with the AM1 potential: Reactions on diamond surfaces[J]. J Phys Chem, 1993, 97(8): 1639-1648.
[30] Harris S J. Gas-phase kinetics during diamond growth: CH4 as-growth species[J]. J Appl Phys, 1989, 65(8): 3044-3048.
[31] Harris S J, Weiner A M. Methyl radical and H-atom concentrations during diamond growth[J]. J Appl Phys, 1990, 67(10): 6520-6526.
[32] Harris S J, Weiner A M, Perry T A. Filament-assisted diamond growth kinetics[J]. J Appl Phys, 1991, 70(3): 1385-1391.
[33] Bigelow L K, D��Evelyn M P. Role of surface and interface science in chemical vapor deposition diamond technology[J]. Surface Science, 2002, 500(1/3): 986-1004.
[34] Kline L E, Partlow W D, Bies W E. Electron and chemical kinetics in methane RF glow-discharge deposition plasmas[J]. J Appl Phys, 1989, 65(1): 70-77.
[35] Mankelevich Y A, Rakhimov A T, Suetin N V. Two-dimensional model of reactive gas flow in a diamond film CVD reactor[J]. Diamond and Relat Mater, 1995, 4(8): 1065-1068.
[36] Frenklach M. The role of hydrogen in vapor deposition of diamond[J]. J Appl Phys, 1989, 65(12): 5142-5149.
[37] Coltrin M E, Dandy D S. Analysis of diamond growth in subatmospheric DC plasma-gun reactors[J]. J Appl Phys, 1993, 74 (9): 5803-5820.
[38] Kee R J, Rupley F M, Miller J A. Sandia National Laboratories Report[R]. New Mexico: Sandia National Laboratories, 1989.
[39] Suzuki K, Sawabe A, Inuzuka T. Growth of diamond thin films by dc plasma chemical vapor deposition and characteristics of the plasma[J]. Jpn J Appl Phys, 1990, 29(1): 153-157.
[40] Suzuki K, Sawabe A, Inuzuka T. Characterizations of the dc discharge plasma during chemical vapor deposition for diamond growth[J]. Appl Phys Lett, 1988, 53(19): 1818-1819.
[41] Yu B W, Girshick S L. Atomic carbon vapor as a diamond growth precursor in thermal plasmas[J]. J Appl Phys, 1994, 75(8): 3914-3923.
[42] Schmidt I, Benndorf C, Joeris P. Gas phase composition and film properties of hot filament diamond synthesis from CH4-H2-O2 gas mixtures[J]. Diamond and Relat Mater, 1995, 4(5/6): 725-729.
[43] Goodwin D G, Glumac N G, Shin H S. Diamond thin film deposition in low-pressure premixed flames[C]//Proceedings of Twenty-Sixth Symposium (International) on Combustion. Pittsburgh, PA: The Combustion Institute, 1996: 1817-1824.
[44] Miller J A, Mellius C F. Kinetic and thermodynamic issues in the formation of aromatic compounds in flames of aliphatic fuels[J]. Combust Flame, 1992, 91(1): 21-39.
[45] Warnatz J. The structure of laminar alkane-, alkene-, and acetylene flames[C]//Proceedings of Eighteenth Symposium (International) on Combustion. Pittsburgh, PA: The Combustion Institute, 1981: 369-384.
[46] Coltrin M E, Kee R J, Evans G H. A mathematical model of the fluid mechanics and gas-phase chemistry in a rotating disk chemical vapor deposition reactor[J]. J Electrochem Soc, 1989, 136(3): 819-829.
[47] Kassmann D E, Badgwell T A. Modeling diamond chemical vapor deposition in a rotating disk reactor[J]. Diamond and Relat Mater, 1996, 5(3/5): 221-225.
[48] Evans G H, Greif R, Forced flow near a heated rotating disk: A similarity solution[J]. Numerical Heat Transfer, 1988, 14(3): 373-387.
[49] Coltrin M E, Kee R J, Evans G H, et al. Spin (version 3.83): A fortran program for modeling one-dimensional rotating-disk/ Stagnation-flow chemical vapor deposition reactors[R]. Livermore, California: Sandia National Laboratories, 1991: 1-25.
[50] Mankelevich Y A, Rakhimov A T, Suetin N V. Three- dimensional simulation of a HFCVD reactor[J]. Diamond and Relat Mater, 1998, 7(8): 1133-1137.
[51] Mankelevich Y A, Rakhimov A T, Suetin N V. Two-dimensional simulation of a hot-filament chemical vapor deposition reactor[J]. Diamond and Relat Mater, 1996, 5(9): 888-894.
[52] Bowman C T, Hanson R K, Davidson D F, et al. Reaction rate coefficients and thermodynamic data[EB/OL]. [1999]. http://www.me.berkeley.edu/gri_mech/.
[53] Wahl E H, Owano T G, Kruger C H, et al. Measurement of absolute CH3 concentration in a hot-filament reactor using cavity ring-down spectroscopy[J]. Diamond and Relat Mater, 1996, 5(3/5): 373-377.
[54] Mankelevich Y A, Suetin N V, Smith J A, et al. Investigations of the gas phase chemistry in a hot filament CVD reactor operating with CH4/N2/H2 and CH4/NH3/H2 gas mixtures[J]. Diamond and Relat Mater, 2002, 11(3/6): 567-572.
[55] May P W, Burridge P R, Rego C A, et al. Investigation of the addition of nitrogen-containing gases to a hot filament diamond chemical vapor deposition reactor[J]. Diamond and Relat Mater, 1996, 5(3/5): 354-358.
[56] Larson J M, Swihart M T, Girshick S L. Characterization of the near-surface gas-phase chemical environment in atmospheric- pressure plasma chemical vapor deposition of diamond[J]. Diamond and Relat Mater, 1999, 8(10): 1863-1874.
[57] Tsang R S, May P W, Ashfold M N R. Modeling of the gas phase chemistry during diamond CVD: the role of different hydrocarbon species[J]. Diamond and Relat Mater, 1999, 8(2/5): 242-245.
[58] Tsang R S, May P W, Cole J, et al. Simulations of the hot-filament diamond CVD gas-phase environment: Direct comparison with experimental measurements[J]. Diamond and Relat Mater, 1999, 8(8/9): 1388-1392.
[59] Riccardi C, Barni R, Sindoni E, et al. Gaseous precursors of diamond-like carbon films: chemical composition of CH4/Ar plasmas[J]. Vacuum, 2001, 61: 211-215.
[60] Li Y X, Brenner D W, Dong X L, et al. First principles prediction of gas-phase composition and substrate temperature for diamond film growth[J]. Molecular Simulation, 2000, 25 (1/2): 41-51.
[61] Dong L F, Chen J Y, Li X W, et al. Dissociation process of CH4/H2 gas mixture during EACVD[J]. Thin Solid Films, 2001, 390(1/2): 93-97.
[62] ��ѧ��, ������, ������, ��. C-H-O��C-H-N��ϵ�������ʯĤ�����ѧģ��[J]. ������ѧ��, 2004, 19(2): 404-410.
QI Xue-gui, CHEN Ze-shao, WANG Guan-zhong, et al. Simulation of gas phase chemistry in C-H-O and C-H-N systems for chemical vapor deposition diamond films[J]. Journal of Inorganic Materials, 2004, 19(2): 404-410.
[63] Huang T B, Tang W Z, L�� F X, et al. Influence of plasma power over growth rate and grain size during diamond deposition using DC arc plasma jet CVD[J]. Thin Solid Films, 2003, 429(1/2): 108-113.
[64] Chen G C, Li B, Lan H, et al. Gas phase study and oriented self-standing diamond film fabrication in high power DC arc plasma jet CVD[J]. Diamond and Relat Mater, 2007, 16(3): 477-480.
[65] Petherbridge J R, May P W, Shallcross D E, et al. Simulation of H-C-S containing gas mixtures relevant to diamond chemical vapor deposition[J]. Diamond and Relat Mater, 2003, 12(12): 2178-2185.
[66] Petherbridge J R, May P W, Fuge G M, et al. Sulfur doping of diamond films: spectroscopic, electronic, and gas-phase studies[J]. J Appl Phys, 2002, 91(6): 3605-3613.
[67] Rennick C J, Smith A G, Smith J A, et al. Improved characterization of C2 and CH radical number density distributions in a DC arc jet used for diamond chemical vapor deposition[J]. Diamond and Relat Mater, 2004, 13(4/8): 561-568.
[68] Manklevich Y A, Suetin N V, Ashfold M N R, et al. Chemical kinetics in carbon depositing D. C. arc jet CVD reactors[J]. Diamond and Relat Mater, 2003, 12(3/7): 383-390.
[69] May P W, Mankelevich Y A. The mechanism for ultrananocrystalline diamond growth: Experimental and theoretical studies[J]. Mater Res Soc Symp Proc, 2007, 956: 127-134.
[70] Mankelevich Y A, Ashfold M N, Orr-Ewing A J. Measurement and modeling of Ar/H2/CH4 arc jet discharge chemical vapor deposition reactors ��: Modeling of the spatial dependence of expanded plasma parameters and species number densities[J]. J Appl Phys, 2007, 102(6): 063310-1-11.
[71] May P W, Mankelevich Y A. From ultrananocrystalline diamond to single crystal diamond growth in hot filament and microwave plasma-enhanced CVD reactors: a unified model for growth rates and grain sizes[J]. J Phys Chem C, 2008, 112(32): 12432-12441.
�ո����ڣ�2009-06-05�������ڣ�2009-08-19
������Ŀ��������Ȼ��ѧ����������Ŀ(59872003)
ͨ�����ߣ���ϣ��(1973-)���У����������ˣ���ʿ�������ڣ����·���Ϳ�������Ĥ���ϵ���ֵ���漰����ʵ���о����绰��024-83686465��E-mail: anxz@mail.neu.edu.cn


