���±�ţ�1004-0609(2011)08-1980-08
����TEA��EDTA��2Na˫�����ϵ��
���Զ�ͭ���ռ��Ʋ�����
�� ���� ��
(����������ѧ ��ѧ�뻯��ѧԺ �㶫ʡ�ߵ�ѧУ����Դ�����ص�ʵ����, ���� 510640)
ժ Ҫ��
����ӵ���ø���������ͭ������Ŀǰ��Ҫ���õ�������Ʊ���Ϊ�Ʊ����õĵ��ͭ�������ò�ͬ��ƹ��ղ������ڻ������Ҵ���(TEA)���Ҷ������������(EDTA��2Na)˫�����ϵ��CuSO4/H2SO4��Һ�н��ж�ͭ�����о���ͨ������ɨ�衢ѭ��������SEM ��XRD�ֶζԶ�Һ���ʡ��Ʋ�����ò�ͽṹ���вⶨ�ͱ����������жƲ������ظ���ʵ�顣���������ѡ��P 0.1%����ͭ��Ϊ��������ȡ��е�����Һ�ķ�ʽ����CuSO4��5H2OΪ300 g/L��H2SO4Ϊ90 g/L��Cl-Ϊ40~80 mg/L��TEAΪ3.5 g/L��EDTA��2NaΪ5 g/L���������Ӽ�P�Ķ�Һ�У��Ե����ܶ�Ϊ490 mA/cm2����Һ�¶�Ϊ40~60 �棬ʩ��5~10 min�ܵõ����öƲ㣻���Ӽ����Խ���ѭ�����������������Cu2+�Ļ�ԭ�ٶȼ��������Ӽ���߶Ʋ����Ľᾧϸ���̶ȣ�ʹ���������С����������ߣ��Ʋ�������ã���ƽ�������ԣ�Cu�Ʋ����(111)��������ȡ���ٿɴ�19.4 mg/min���Ʋ������кܺõ������ԡ�
�ؼ��ʣ�
���ͭ����TEA��EDTA��2Na���������۵�ѹ������ȡ����
��ͼ����ţ�TQ153.1���� ���ױ�־�룺A
Acid copper electrodepositing process and
coating properties based on system of TEA and EDTA��2Na
ZHANG Zhen, LI Jun
(Key Laboratory of New Energy Technology for Guangdong Universities, School of Chemistry and Chemical Engineering,
South China University of Technology, Guangzhou 510640, China)
Abstract: The copper foils for the anode current collectors of lithium-ion battery were prepared by electrodeposition. In order to obtain better electrodeposited copper foils, considering different electroplating technology parameters, the copper electrodepositing process based on the system of TEA and EDTA��2Na was studied in CuSO4/H2SO4 electrolytes. The morphology and structure of coating were characterized by SEM and XRD, and the property of electrolyte was tested by linear sweep voltammetry and cyclic voltammetry. The reproducibility of coating was also tested. The results show that a good coating can be got in the better condition that is as follows: 0.1% phosphor bronze as the anode, mechanical stirring, CuSO4��5H2O (300 g/L), H2SO4(90 g/L), Cl-(40-80 mg/L), TEA(3.5 g/L), EDTA��2Na (5 g/L), appropriate amount of additive P, current density (490 mA/cm2), bath temperature(40-60 ��) and deposition time(5-10 min). The additives remarkably decrease the cathode peak current of cyclic voltammetry and slow down the reduction rate of copper ions. The additives can improve the crystallization refinement of the coating, reduce crystal particles and raise the compactness, owing to its significantly leveling effect. The copper coating has an orientation along (111) crystal plane. The deposition rate reaches up 19.4 mg/min, and the coating quality has good reproducibility.
Key words: electrodeposited copper foil; TEA; EDTA��2Na; deposition rate; bath voltage; preferred orientation
������ӵ���У�����ͭ�����������ܵ���Ҫ������������н������������ϡ���ͭ�����һ���������£��������俹��ǿ�ȡ��쳤�ʡ������ԡ����Ʊ���ֲڶȡ���Ⱦ����Լ���������ȶ��ڻ�ø����ܵ�����ӵ��������Ҫ��Ŀǰ�����ͭ����ҵ�������ձ������������ҹ����з�����������������ҵ��������������ʹ���ҹ��ߵ�ͭ���������������ڹ���[1-2]����ˣ���չ���������߸���ֵ������ӵ��ר�õ��ͭ����������ϵ��о����Խ����ҹ�﮵������ɱ�����ߵ���ۺ����ܺͲ�ҵ����ˮƽ������Ҫ���塣
������֪�����ͭ�������������Զ�ͭ�ĵ�������̣�Ӱ�������ܵ������кܶ࣬�����Ӽ���������Ũ�ȡ���Һ����ɡ�������ĸ��ֲ�����[3]��һ����˵������ڶ��ٽϿ��ǰ���»�����õ�ͭ�Ʋ㣬�ұ��ֶ�Һ���нϺõ��ȶ��ԣ����Ӽ���������Ϊ���ԡ���������������ѧ��[4-7]�о��ڻ�ѧ��ͭҺ��������ϼ�TEA��EDTA��2Naʱ���֣�һ��Ũ�ȵ�TEA����߶��٣��������ή�Ͷ��٣�EDTA��2Na������߶�Һ���ȶ��ԡ������о���[8-9]Ҳ�ӵ绯ѧ�ǶȾ�TEA��EDTA��2Na�Ի�ѧ��ͭ�����е缫��Ӧ��Ӱ������о�����������Щ�о���Ϊ��TEA��EDTA��2Na�Ի�ѧ��ͭ���̼��Ʋ�������������Ӱ�졣��Ŀǰ������Ϊ˫�����ϵ�������Ե��ͭ���յ��о����ʼ���������ˣ��������߲���ֱ��������������ڻ���TEA��EDTA��2Na˫�����ϵ��CuSO4/H2SO4��Һ�н��ж�ͭ���ռ��Ʋ������о���ͨ���о���Һ��ɡ������ܶȡ���Һ�¶ȡ�TEA��EDTA��2NaŨ�ȵ����ضԶ��ٺͶƲ������Լ��۵�ѹ��Ӱ�죬�Ż����ղ�����ȷ������TEA��EDTA��2Na˫�����ϵ�Ľϼѹ��������Ͷ�Һ��ɣ��õ������ٶȽϿ졢�����ϺõĶƲ㣬�������öƲ��������ȡ�����������̽��Cu��ᾧ�Ļ���������о����ͭ�����Ӽ���һ���Ľ�����á�
1 ʵ��
CuSO4��5H2O��̨ɽ�������Լ���������˾��H2SO4���㶫�⻪��ѧ�Լ�������˾��NaCl��̨ɽ�����������Ҵ���(TEA)���㶫�⻪��ѧ�Լ�������˾���Ҷ������������(EDTA��2Na)�����ݻ�ѧ�Լ�����
�ù�ҵ�������������������Ϊ1 cm2����2000#ɰֽ��ĥ��ˮϴ����ˮ�Ҵ����͡���ϴ��ϡ���ḯʴҺȥ����������Ĥ������ˮ��ϴ�����ﴦ�����Ժ�����Ϊ0.1%����ͭΪ����������ֱ���������������һ�������ܶȡ���Һ�¶Ⱥͻ�е�����Һ�����¶�ͭ���Ʋ㾭����ˮ��ϴ������Ƶ�ͭ����Ʒ��ѡ����������Χ����Һ�¶�Ϊ30~70 �棬�����ܶ�Ϊ25~490 mA/cm2������ѡ��Ķ�Һ��ɼ�Ũ�ȷ�Χ����1��CuSO4/H2SO4��ҺԤ�Ⱦ�����̿���ˡ�
���������ӳ������ⶨ�������ʡ����㹫ʽ���£�v=��m/t��ʽ�У�vΪ�������ʣ�������(mg/min)����mΪ�ƺ���������(mg)��tΪʩ��ʱ��(min)��
1) �绯ѧ���ԣ������Ϻ�����������˾������CHI660C�绯ѧ����վ�����о��缫ΪCu�缫(d= 2 mm)�������缫ΪPt�缫���αȵ缫Ϊ���ʹ��缫�����缫��ϵ���в��ԡ��о��缫�����ڽ���ɰֽ��������������ĩ�ij�ʪϸ���������������������ߵ���ɨ�跶Χ -0.75~0 V��ѭ���������Ե���ɨ�跶Χ-0.75~0.8 V��ɨ�����ʾ�Ϊ10 mV/s��
2) �ظ���ʵ�飺�ڽϼѶ�Һ��ɺ��������£������ظ���ͭʵ�飬�ⶨ���ٲ�Ŀ��Ʋ��������Ʋ�ƽ�������һ�����ȱ��Ϊ�ã�ƽ�����м�����ȱ��Ϊ�Ϻã��н϶�ȱ��Ϊ�
1) ɨ��羵(SEM)��������������S-3000H��ɨ�����������ͭ�Ʋ������ò���й۲죬������Ʒ��������̶ܳȡ���ȱ���Լ�������С��������
2) X��������(XRD)������ʵ������Ϊ�ձ�����XD-3A��X���������ǣ�Cu�У�NiƬ�˲����ܵ�ѹ35 kV���ܵ���30 mA��ɨ���ٶ�Ϊ8 (��)/min���Ծ���(hkl)��֯��ϵ��TC(Texture coefficient)������ͭ�Ʋ㾧������ų̶�[10]��
 (1)
(1)
ʽ�У�I(hkl)��I0(hkl)�ֱ��ʾ�Ʋ������ͱ�Cu��ĩ��(hkl)�����������ǿ�ȣ�nΪ����������Ϊ����ƽ�����Ӱ�죬nȡֵΪ4����ȡ(111)��(200)��(220)��(311)������м��㡣
��1 ������Һ��ɼ�Ũ�ȷ�Χ
Table 1 Composition of bath for electrodeposition of copper

3) �Ʋ���ʴ��ʵ�飺���ڽϼ��������ƵõĶƲ������ֱ����25% NH3��H2O��3% HCl��3.5% NaCl��Һ3 h���ⶨ������ʴǰ�������仯���Դ�˵���Ʋ����ʴ�ԡ�
2 ���������
2.1.1 ���κ���Ũ�ȶԶ��ٺͲ۵�ѹ��Ӱ��
��50 �桢490 mA/cm2��80 mg/L Cl-��90 g/L H2SO4�����£���CuSO4��5H2OŨ�ȴ�100 g/L������400 g/Lʱ���۵�ѹ��1.8 V����0.7 V��������17.8 mg/min������19.5 mg/min������ͬ�¶ȡ������ܶȡ�Cl-Ũ�ȼ�300 g/L CuSO4��H2O�����£���H2SO4Ũ�ȴ�30 g/L������120 g/Lʱ���۵�ѹ��1.8 V����0.7 V�����ٴ�17.8 mg/min������19.5 mg/min����������CuSO4��5H2O��H2SO4Ũ�ȵ����ӣ��۵�ѹ��С���������ӡ���CuSO4��5H2O��H2SO4Ũ�ȳ���һ����Χʱ��ͭ�ij����ٶ�������������ͼ1��ʾ�ĵ��Һ�����������߿ɼ�����CuSO4��5H2O��H2SO4Ũ�ȵ�����Cu2+������ɢ�������ߡ���������CuSO4��H2SO4Ũ��������������߶��٣���Cu2+Ũ�ȹ��ߣ�����Ӧ��ǿ����Һ���ײ���ͭ�ۣ���ɶƲ����ɴֲڡ�H2SO4��ǿ����ʣ��ʵ��������Ũ�ȿ�����߶�Һ�ĵ��������ͷ�ɢ������ʹ�����ϵĵ����ֲ����ȣ������ߵ�����Ũ�Ȼή��CuSO4�ڶ�Һ�е��ܽ�ȣ�������ԶƲ۵ĸ�ʴ�ԡ����⣬����������Ũ�ȵ����ӣ���������������������ʱ��������࣬��������Ũ�Ȳ���̫�ߡ�ʵ���������ҺΪCuSO4��5H2O 300 g/L�Լ�H2SO4 90 g/Lʱ�����ٽϿ죬��ѹ�ϵͣ��������⣬�ҶƲ���ȣ���۽Ϻá�
2.1.2 Cl-�Զ��ٺͲ۵�ѹ��Ӱ��
�ڶ�ҺΪCuSO4��5H2O 300 g/L��H2SO4 90 g/L�������ܶ�Ϊ490 mA/cm2��ʩ���¶�Ϊ50 ������£�Cl-Ũ����20 mg/L������80 mg/Lʱ���۵�ѹ��1.3 V����1.1 V��������18.7 mg/min������19.4 mg/min����ΪCl-��ٽ��������ã��ӿ���ͭ�ij����ٶ�[11]����Cl-Ũ������100 mg/Lʱ�����ټ�СΪ18.8 mg/min��ͭ�Ʋ����������������Ϊ������Cl-����߶Ʋ�Ĺ����Ⱥ���ƽ��[11-12]��ʹ�Ʋ�ᾧϸ�����ͶƲ��Ӧ�����������Cl-��ʹ�Ʋ�ʧȥ��������֦״�����ơ���ˣ�����Cl-Ũ����40~80 mg/L��ΧΪ�ˡ�
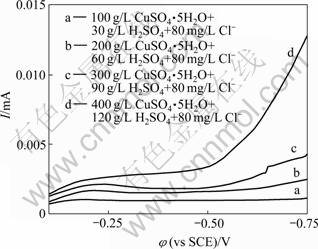
ͼ1 ��ͬ����Ũ�ȵ��Һ��������������
Fig.1 Cathode polarization curves of different concentrations of main salt for electrolyte
2.1.3 ��Һ�¶ȶԶ��ٵ�Ӱ��
�ڶ�ҺΪCl- 80 mg/L��H2SO4 90 g/L��CuSO4��H2O 300 g/L�������ܶ�Ϊ490 mA/cm2�����£���Һ�¶ȴ�30 ����������60 ��ʱ�����ٴ�17.8 mg/min������19.4 mg/min����Ϊ�����˶��������¶������ӿ죬������������Ե��������࣬�Ӷ��ٽ��������ӵij������ʼӿ졣���¶ȼ���������70 �棬���ٱ�Ϊ19.6 mg/minʱ�������˶����ʽ�һ���ӿ죬�����ڱ���ͣ��ʱ�����̣������ڶƲ���γɼ������Ľ�ϣ����¶Ʋ��״ӻ���������䣬�Ʋ�Ľ�������Ʋ������½���ʵ�������ʩ���¶Ƚϼѷ�ΧΪ40~60 �档
2.1.4 �����ܶȶԶ��ٺͲ۵�ѹ��Ӱ��
�ڶ�ҺΪCl- 80 mg/L��H2SO4 90 g/L��CuSO4��H2O 300 g/L��ʩ���¶�Ϊ50 ������£������ܶȴ�25 mA/cm2������490 mA/cm2ʱ���۵�ѹ��0.1 V������1.2 V������Ҳ��0.9 mg/min������19.2 mg/min��������Ϊһ��������ܶ�Խ������������Խ�ɺ��ٶȾ�Խ������㾧��Խϸ����϶�ʡ�ȱ�ݺ����Ƽ��٣�����Ʋ������⻬����һ���棬�ϸߵĶ��ٿ��������Ч�ʡ���Ȼ�ϴ�����ܶ��ܹ�ϸ�������ͭ���������ǣ����ߵĵ����ܶȻ�ʹ�Ʋ��ս��䰵���ۺϿ��ǣ�ѡ������ܶ�Ϊ490 mA/cm2��
2.1.5 TEA��EDTA��2Na�Զ��ٺͲ۵�ѹ��Ӱ��
ͼ2��ʾΪ��ҺΪCl- 80 mg/L��CuSO4��5H2O 300 g/L��H2SO4 90 g/L�������ܶ�Ϊ490 mA/cm2��ʩ���¶�Ϊ50 ��ʱTEA��EDTA��2Na�Զ��ٺͲ۵�ѹ��Ӱ�졣��ͼ2(a)֪��������TEAŨ����������ߡ�������ǵ�TEAŨ�Ƚϴ�ʱ�������Ϊ��ͭ�ļ��ټ��������Ľ��[8-9]����TEAŨ�ȹ�������ٹ�����ɶ�Һ���ȶ�����ͼ2(b)֪�����ٺͲ۵�ѹ��EDTA��2NaŨ�ȵ���������ͣ�����Ҫԭ�����������Cu2+��EDTA�γ������֮���������谭��Cu2+�ӽ��缫������з�Ӧ�����Ļ��Ե㣬ʹ���ٽ��ͣ�Ҳ������������ϼ�Ũ�����ӣ��϶��Cu2+��������ϣ���Һ�������Cu2+���٣��Ӷ�����ͭ�ij������ʡ����⣬��EDTA��2NaΪ1 g/Lʱ���Ʋ���۽ϲ����ֲڲ���������EDTA��2NaΪ2 g/Lʱ���Ʋ���۱�ã������ƽ����������������EDTA��2NaΪ5 g/L��7.5 g/Lʱ���Ʋ���۽Ϻã�����ƽ��������ʵ������ȷ��TEA������Ũ��Ϊ3.5 g/L��EDTA��2Na������Ũ��Ϊ5 g/L��

ͼ2 TEA��EDTA��2Na�Զ��ٺͲ۵�ѹ��Ӱ��
Fig.2 Effects of TEA (a) and EDTA��2Na (b) concentrations on deposition rate and bath voltage
2.1.6 ����Զ��ٺͲ۵�ѹ��Ӱ��
��2����ΪCuSO4��5H2O 300 g/L��H2SO4 90 g/L��Cl- 80 mg/L��Һ�н�������ٺͲ�ѹ�Ĺ�ϵ���ɱ�2��֪������ԶƲ�����Ӱ��ϴ���Ϊ����������¼������ã�1) ʹ�Ӵ������������ҺŨ�Ⱦ������뱾��Ũ��һ�£��Ա�֤���㹻��Cu2+���ӷ�����Ӧ���Ӷ���߳�ͭ�ٶȣ�2) ʹͣ�����������������Ѹ�������ݳ�Һ�棬�Լ��ٶƲ���ף���߶Ʋ����������⣬���軹����ʹ�Ʋ��Ⱦ��ȡ���ˣ������ܹ����Ͷ�Һ��Ũ��������Ͳ۵�ѹ����ߵ����ܶȣ��ӿ�����ٶȣ�ϸ��������������������ٿ�϶�ʡ�ȱ�ݺ����ƣ���߶Ʋ�ľ����ԣ��Ӷ����ƶƲ����������
��2 ����Զ��ٺͲ۵�ѹ��Ӱ��
Table 2 Effect of stirring on deposition rate and bath voltage
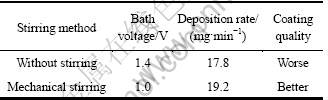
2.1.7 �����Զ��ٺͶƲ�������Ӱ��
�ɱ�3��֪���ڶ�ҺΪCuSO4��5H2O 300 g/L��H2SO4 90 g/L��Cl- 80 mg/L��TEA 3.5 g/L��EDTA��2Na 5 g/L���������Ӽ�P�������ܶ�Ϊ490 mA/cm2��ʩ���¶�Ϊ50 ������£�ʹ�ú�������ͭ�����Զ���Ӱ���С����ʹ�Ʋ��á�ֻҪ���н��貢��������Ũ�Ȳ����ڹ��ͣ������ܶ��Ը�Щ���Ʋ�Ƭ���IJ���������ɰ״���ɿ˷����Ӷ��õ��ϺõĶƲ㡣ʹ����ͭ���γ����ܺ�ɫ��Ĥ����ֹCu+�����Һ�γɳ�����ͬʱ��Cu+ת��ΪCu2+����ˣ�ѡ����0.1%����ͭ��Ϊ����Ч���Ϻá�
2.1.8 ����ʱ��Զ��ٺͲ۵�ѹ��Ӱ��
�����3��ͬʵ�������£�����ʱ��Զ��ٺͲ�ѹ��Ӱ�����ͼ3��ʾ����ͼ3�ɿ���������ʩ��ʱ����ӳ��������½����۵�ѹ�������ߣ������������ʩ��ʱ����ӳ���������ɫ��Ĥ����¶ۻ���ǿ����ˣ����˳���ʱ��Ϊ5~10 min��
��3 �����Զ��ٺͶƲ�������Ӱ��
Table 3 Effect of anode on deposition rate and coating quality


ͼ3 ����ʱ��Զ��ٺͲ۵�ѹ��Ӱ��
Fig.3 Effect of deposition time on deposition rate and bath voltage
2.1.9 �ϼѹ�����������Һ��ɵ�ȷ��
ͨ����TEA��EDTA��2Na˫�����ϵ�����Զ�ͭ���ս����Ż����ۺϿ�����������ȷ���ϼѹ�����������Һ�¶�Ϊ40~60 �棬�����ܶ�Ϊ490 mA/cm2���Ժ�P��Ϊ0.1%����ͭ����������е�����Һ���ϼѶ�Һ��ɼ���4��
��4 �ϼѶ�Һ���
Table 4 Better composition of bath
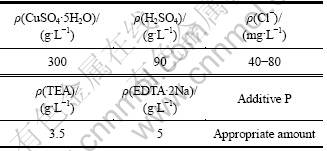
2.1.10 �ظ���ʵ��
Ϊ�˽�һ����֤�����ϼѹ�����������Һ��ɵĿ����ԣ����ϼѹ��������Ͷ�Һ��ɣ��Զ��ٺͶƲ����������ظ���ʵ�飬��������5�������Ʋ������Ͷ��������Ժã���Һ��Ϊ�ȶ���
2.1.11 �Ʋ���ʴ��ʵ��
���ڽϼѹ�����������Һ����µõ��ĶƲ������ֱ����25% NH3.H2O��3% HCl��3.5% NaCl��Һ 3 h������ʴ��ʵ�飬���벻���κ����Ӽ��õ����������жԱȣ��������6���У�����m1Ϊ��ʴǰ������m2Ϊ��ʴ����������m=m1-m2��
��5 �ظ���ʵ������
Table 5 Experimental data of reproducibility
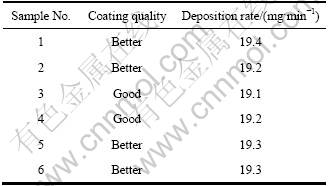
��6 �Ʋ��ڲ�ͬ���ʵ���ʴ�Բ���ʵ��
Table 6 Testing results of coating corrosion resistance in different media

�ɱ�6��֪����Ʒ��ʴǰ�������仯����С��˵���ڽϼѹ�����������Һ����£����Ӽ���3 h�ڲ�������öƲ���������ʴ�����еĸ�ʴ�ٶȲ����ϴ�Ӱ�졣
2.2.1 ��Һѭ���������߷���
�Ա�4�ϼ���ɵĶ�Һ����ѭ������ɨ�裬���������Ӽ�ʱ���жԱȣ�������ͼ4��ʾ������a��b�ֱ��ʾ���κ����Ӽ��ĺͽϼ���ɶ�Һ��ѭ���������ߡ�������b��֪��������������������ֵ��Խϵ͡�������������Ϳ��������Ӽ�����������ģ���������������Ӽ���Ϻ�������ͬ����ġ��л����Ӽ������ڵ缫���棬�Խ������ӵĻ�ԭ���������ã�������ԭ�����ܵ�һ���̶����ƣ���ʱ�Ʋ�ᾧϸ�����ﵽ������Ч�����ɴ˿��ƶ�ͭ�ij����ɷ��������ֱ�Ϊ�����Ľᾧ�ɺ���ɳ����䷴Ӧʽ���£�
Cu2++e��Cu+ (2)
Cu++e��Cu (3)
�������л����Ӽ��Ժ�ʽ(2)���н������������������Ľ����ٶȣ���ʱ�����ᾧ�ijɺ������Ӷ��ɳ��ٶȼ������Ϳ��Եõ��ᾧϸ���������ĶƲ�[13-14]������a�ڽϸ����ƴ����־�ݲ������������ڵ缫������������ġ�
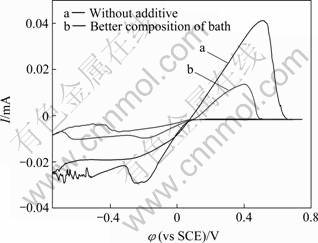
ͼ4 ��Һѭ����������
Fig.4 Cyclic voltammetry curves of bath
2.2.2 �Ʋ�SEM����
ͼ5(a)��ʾΪ�����Ӽ�ʱ���öƲ��SEM����ͼ5(a)�ɼ����Ʋ���氼��ƽ�������ϴ��ҿ����ֲ������ȣ������Խϵͣ�����֮����ڴ����ķ�϶��ͼ5(b)��(c)��ʾ��ֱ�Ϊ3.5 g/L TEA��5 g/L EDTA��2Na������Ϊ���Ӽ��ɷ�ʱ�Ʋ�ı��������TEA���Ը��ƶƲ��������Ʋ��������ֲ��Ͼ��ȣ�������ϸ��EDTA��2Na�Ծ���ϸ����һ�����ã��������Ծ�����TEA��ͼ5(d)��ʾΪ�ϼ���ɶ�Һʱ���öƲ��SEM�Ʋ������������ĸ��ƣ������ᾧϸ���̶��нϴ���ߣ���������һ����С���������������ƣ��ҿ����ֲ����Ӿ��ȣ�������С�ȽϾ�һ���ɴ˿�֪������TEA��EDTA��2Na˫�����ϵ�Ľϼ���ɶ�Һ�е����Ӽ��ԶƲ�����������Ż�����Ӱ�죬����һ���Ĺ�������ƽ���ã�TEA��EDTA��2Na��Ϊ˫�����ϵ��ͭ�Ʋ���нϺõ�Эͬ���á����Ʋ�Ĺ�������Ȼ�������룬��Ϊ���������ĶƲ㣬��û�����ԵĽᾧ���������Ƿdz�ϸ�Ľᾧ�Ʋ㡣���������������ڽ������ӻ�õ��ӻ�ԭʱ�������ᾧ�ɳ��ij����ǿ����������ϵػ�ԭΪ����ԭ�Ӳ���ɹ����Ľ����Ʋ�[15]��
2.2.3 �Ʋ�XRD����
ͼ6��ʾ�ֱ�Ϊ�ѻ��塢�����Ӽ����ϼ���ɶ�Һʱ���öƲ��XRD�ס���7����Ϊ��Ӧ��ͼ6ͭ�Ʋ�XRD�����������������������TCֵ��ͬʱ������ȡ��������ģ����ij��(hkl)��TCֵ����ƽ��ֵ(25%)����þ����������ȡ��TCֵԽ��˵������ȡ��̶�Խ�ߡ��ɱ�7֪����Ʒ�ľ�������������������Ա仯�������Ӽ�ʱ��(220)��������ȡ��̶����TC(220)ֵ��31.9%�����ڽϼ���ɶ�Һ�£�(111)��������������ȡ��TC(111)ֵ�ߴ�39.5%��Ŀǰ�����͵�������γɾ�������ȡ���������Ҫ�����֣�����ά�������ۺͼ���ѡ������[16]����Cu�ĵ���������У���Ϊ����Cu�ϵ������Ⱥܵͣ����Կɲ�������ԭ�������ϵ�����[17]�����Cu�ĵ�ᾧ���̽���ȡ����������������������������Ԥ�⣬���������������Cu��ȡ�����������༴����ܶѻ���ԭ��ƽ��ƽ���ڻ��壬Cu�Ʋ����(111)��������ȡ�Ʋ��ƽ��������ȡ�����������༴����ܶѻ���ԭ��ƽ�洹ֱ�ڻ��壬Cu�Ʋ����(220)��������ȡ�Ʋ�ᾧ������Խϴ�ƽ���������Ӽ���TC(220)= 31.9%���������Ӽ�ʱ��TC(220)=22.8%��TC(111)=39.5%��(220)����������ȡ��(111)������ֽϴ�����ȡ�Ӷ�˵���ڽϼ���ɶ�Һ�����öƲ�����Ƚ�ƽ������SEMʵ���������

ͼ5 �Ʋ��SEM��
Fig.5 SEM images of copper electrodeposits: (a) Without additive; (b) 3.5 g/L TEA; (c) 5 g/L EDTA��2Na; (d) Better composition of bath
���⣬����������ϵ�еõ���Cu���������������ȡ����(220)��(111)�����ٹ۲쵽��������ȡ����[18-20]�����������Ϊ���Ӽ�һ�㶼�������ڵ缫���棬���ڲ�ͬ�����IJ�ͬ�����Ͻ���ѡ��������������ԭ�����Ƚᾧ�ľ���[21]�����ڻ���TEA��EDTA��2Na˫�����ϵ�Ľϼ���ɶ�Һ�����Ӽ������������£������������γɺ��������ͭ�缫�����ǿ���������ã��ı�Cu��ᾧ�Ļ�����������ͼ6��(111)��(200)��(220)��(311) 4����������岻ͬ�̶ȵ���ǿ��

ͼ6 ��ͬ�Ʋ��XRD��
Fig.6 XRD patterns of different electrodeposits: (a) Titanium matrix; (b) Without additive; (c) Better composition of bath
��7 ��Ӧ��ͼ6ͭ�Ʋ�XRD���
Table 7 XRD results of Cu electrodeposits corresponding to Fig.6

3 ����
1) ѡ��P 0.1%����ͭ��Ϊ��������ȡ��е�����Һ�ķ�ʽ����CuSO4��5H2OΪ300 g/L��H2SO4Ϊ90 g/L��Cl-Ϊ40~80 mg/L��TEAΪ3.5 g/L��EDTA��2NaΪ5 g/L�����������Ӽ�P�Ķ�Һ�У��Ե����ܶ�Ϊ490 mA/cm2����Һ�¶�Ϊ40~60 �桢ʩ��5~10 min�ܵõ����öƲ㡣���ٿɴ�19.4 mg/min�����ٺͶƲ����������кܺõ������ԡ�
2) ���Ӽ����Խ���ѭ�����������������Cu2+�Ļ�ԭ�ٶȼ�����
3) ����TEA��EDTA��2Na˫�����ϵ�Ľϼ���ɶ�Һ�е����Ӽ���ʹ�Ʋ����ᾧϸ���̶���ߣ�ʹ���������С����������ߣ��Ʋ�������ã���ƽ�������ԣ�Cu�Ʋ����(111)��������ȡ��
REFERENCES
[1] ����Ƽ. ��ּ�������, ������չ�ҹ��ߵ����ͭ��[J]. ������ɫ����, 2002(4): 8-11.
LI Yu-ping. Persisting in advanced tech preference and strenuously developing domestic high-class electrolytic copper foils[J]. World Nonferrous Metals, 2002(4): 8-11.
[2] �� ��. ͭ����������������չ����[J]. ͭҵ����, 2003(2): 83-84.
HUANG Jie. Technology of copper foil manufacturing and its development tendency[J]. Copper Engineering, 2003(2): 83-84.
[3] ������, Ҷ ��, �� ��. ���ͭ����ѧ���ܵ���ҪӰ������[J]. �й���ɫ����ѧ��, 2005, 15(S1): 167-173.
ZHANG Shi-chao, YE Fan, JIANG Tao. Influential factors for main mechanical properties of electrolytic copper foil[J]. The Chinese Journal of Nonferrous Metals, 2005, 15(S1): 167-173.
[4] WANG X, LI N, YANG Z F, WANG Z L. Effects of triethanolamine and K4[Fe(CN)6] upon electroless copper plating[J]. Journal of The Electrochemical Society, 2010, 157(9): D500-D502.
[5] ֣�Ž�, ���, ��ΰ��. ���Ҵ�����EDTA��2Na��˫�����ϵ���ٻ�ѧ��ͭ�����о�[J]. ���ϵ���, 2006, 20(10): 159-162.
ZHENG Ya-jie, LI Chun-hua, ZOU Wei-hong. Study on electroless copper plating technology of high plating rate in triethanolamine and EDTA��2Na dual-chelating-agent system[J]. Materials Review, 2006, 20(10): 159-162.
[6] ֣�Ž�, ��ΰ��, ����, ������, ���º�. ���DZ����Ҷ�����EDTA��2Na�λ�ѧ��ͭ��ϵ�о�[J]. ���ϱ���, 2006, 39(2): 20-24.
ZHENG Ya-jie, ZOU Wei-hong, YI Dan-qing, GONG Zhu-qing, LI Xin-hai. Electroless copper plating in the presence of THPED and EDTA��2Na as the dual-chelating agent[J]. Materials Protection, 2006, 39(2): 20-24.
[7] ���. ���Ҵ�����EDTA?2Na˫�����ϵ���ٻ�ѧ��ͭ�о�[D]. ��ɳ: ���ϴ�ѧ, 2007.
LI Chun-hua. Study on electroless copper plating technology of high plating rate in triethanolamine and EDTA��2Na dual-chelating-agent system[D]. Changsha: Central South University, 2007.
[8] KONDO K, MURAKAWA K, ISHIDA N, ISHIKAWA J, NOMOTO K, ISHIKAWA F. Process for electrolessly plating copper and plating solution therefor: US4935267[P]. 1990-06-19.
[9] KONDO K, AMAKUSA S, MURAKAWA K, KOJIMA K, ISHIDA N, ISHIKAWA J, ISHIKAWA F. Electroless copper plating solution and process for formation of copper film: US 5039338[P]. 1991-08-13.
[10] ֣����, ��÷��, �� ��, ����ǿ, ʢ��ΰ, �� ��. CO32-���ǻ��Ҳ������ͭҺ��Ӱ��[J]. ������ѧѧ��, 2008, 24(9): 1733-1738.
ZHENG Jing-wu, JIANG Mei-yan, QIAO Liang, JIANG Li-qiang, SHENG Jia-wei, ZHANG Cheng. Influence of CO32- on copper electrodeposition from 1-Hydroxyethylidene-1,1- diphosphonic acid baths[J]. Acta Physical Chimica Sinica, 2008, 24(9): 1733-1738.
[11] �� ��, �� ǿ, ������, ��ʤ��, ������. PEG-Cl-���Ӽ������µ�ͭ��ᾧ�����о�[J]. ��ѧѧ��, 2006, 65(10): 881-886.
GU Min, LI Qiang, XIAN Xiao-hong, QING Sheng-lan, LIU Ke-wan. Electrocrystallization of copper in the presence of PEG-Cl- additive[J]. Acta Chimica Sinica, 2006, 65(10): 881-886.
[12] YOKOI M, KONISHI S. Interaction of Cl- and brightener components in copper plating from an acid sulphate bath[J]. Metal Finishing, 1983, 34(8): 434-439.
[13] ������. ��ƹ������豸[M]. ����: ��ѧ��ҵ������, 2005.
FENG Li-ming. Electroplating technology and equipment[M]. Beijing: Chemical Industry Press, 2005.
[14] YU R L, LIU Q M, QIU G Z, FANG Z , TAN J X, YANG P. Inhibition behavior of some new mixed additives upon copper electrowinning[J]. Transactions of Nonferrous Metals Society of China, 2008, 18(5): 1280-1284.
[15] ����־. ������Ӽ������ʴ�[M]. ����: ��ѧ��ҵ������, 2009.
LIU Ren-zhi. Technology question and answer of electroplating additives[M]. Beijing: Chemical Industry Press, 2009.
[16] ������. ���������-ԭ�����о�����[M]. �Ϻ�: �Ϻ���ѧ����������, 1987: 242.
ZHOU Shao-min. Metal electrodeposition-principle and research method[M]. Shanghai: Shanghai Science and Technology Press, 1987: 242.
[17] �� ��, �����, �� ��, Ҧʿ��, ������. ������ȡ��ͭ�Ʋ�ĵ绯ѧ�γɼ��������ò[J]. ������ѧѧ��, 2002, 18(11): 973-978.
GU Min, YANG Fang-zu, HUANG Ling, YAO Shi-bing, ZHOU Shao-min. The formation of copper electrodeposits with highly preferred orientation and their surface morphology[J]. Acta Physical Chimica Sinica, 2002, 18(11): 973-978.
[18] ZHU Z W, ZHU D, QU N S. Synthesis of smooth copper deposits by simultaneous electroforming and polishing process[J]. Materials Letters, 2008, 62(8/9): 1283-1286.
[19] ZHAO H J , LIU L, WU Y T, HU W B. Investigation on wear and corrosion behavior of Cu-graphite composites prepared by electroforming[J]. Composites Science and Technology, 2007, 67(6): 1210-1217.
[20] DUDIN P V, REVA O V, VOROBYOVA T N. High rate of copper electrodeposition from the hexafluorosilicate bath[J]. Surface and Coatings Technology, 2010, 204(20): 3141-3146.
[21] �� ��, ������. (110)����ȫ����ȡ��Cu�Ʋ���Ʊ����������Ż�[J]. ������ѧѧ��, 2006, 22(3): 378-382.
GU Min, XIAN Xiao-hong. The preparation of copper electrodeposits with (110) lattice plane fully preferred orientation[J]. Acta Physical Chimica Sinica, 2006, 22(3): 378-382.
(�༭ ����)
������Ŀ���㶫ʡ��������ѧ�к�����Ŀ(2009B090200036)���㶫ʡ�Ƽ��ƻ����¼�����ҵ����Ŀ(2009A010100009)
�ո����ڣ�2010-08-12�������ڣ�2011-03-28
ͨ�����ߣ��� �𣬽��ڣ��绰��13533408053��E-mail: chzzhang@scut.edu.cn


