���дſؽ���Cu1-xCrx(x=1.19~2.37)��Ĥ���Ʊ�
���½�, ������, ������, �� ��
(�Ϻ���ͨ��ѧ ���Ͽ�ѧ�빤��ѧԺ ���²��ϼ����Խ������ص�ʵ����, �Ϻ� 200030)
ժ Ҫ��
���ü��Ͻ�в���Si(100)�����ϵ��дſؽ����Ʊ�Cu1-xCrx(x=1.19~2.37, Ħ������, %)��Ĥ�� �о���ͬ����ɷֵĺϽ�вĵõ��Ľ���̬��Ĥ�ijɷ֡� ��ѧ���ܡ� ��֯�ṹ������״̬�� �о��������: ���ü��Ͻ�в��Ʊ���Cu1-xCrx��Ĥ�ɷֿɿء� Cr�ļ�����ǿ�˽���̬��Ĥ��(111)֯��, �����ű�Ĥ��ȵ�����, (111)֯����ǿ; 855nm���Cu-2.37%Cr��Ĥ��(111)��(200)�ķ�ǿ�ȸߴ�8.48; �Ͻ�Ԫ��Cr����Ӱ�콦��̬��Ĥ�ı���״̬(ƽ���Ժ����ܶ�)�͵�����; ����Cr����������, ǰ�߳��������ߺ��½�������, ����Ĥ��������; Cu-2.18%Cr��Ĥ����Ӧ�����Ӿֲ���������, ��Ĥ�������½��� ���ӱ�Ĥ��������ѧ�Լ������ܵĽǶȶ�������������˳����IJ�����
�ؼ���: Cu1-xCrx��Ĥ; �ſؽ���; ����̬; ֯�� ��ͼ�����: TM241.1
���ױ�ʶ��: A
Preparation of Cu1-xCrx(x=1.19-2.37) films by magnetron sputtering single target
WANG Xin-jian, JIANG Chuan-hai, WANG Jia-min, HONG Bo
(Key Laboratory of Ministry of Education for High Temperature Materials and Testing,School of Materials Science and Engineering, Shanghai Jiao Tong University,Shanghai 200030, China)
Abstract: Cu1-xCrx films(x=1.19-2.37, mole fraction, %) were deposited on the Si (100) substrate by magnetron sputtering using a single alloy target. The concentration, electrical resistivity, microstructure and morphology of films deposited by targets with different nominal Cr concentration were investigated. The results show that the concentrations of films are predictably. Cr intensifies the (111) texture which increases with increasing thickness of films. The peak strength ratio of (111) to (200) of Cu-2.37%Cr film with thickness of 855nm is 8.48. As the concentration of Cr increases, the smoothness and compactness of films increase firstly whereas then decrease subsequently, while the electrical resistivity keeps on increasing. The continuity of Cu-2.18%Cr film decreases due to the formation of micro-crack.. These results are explained in the view of the dynamics of film growth and energy.
Key words: Cu1-xCrx films; magnetron sputtering; as-deposited; texture
������, �������ͨ��ͭ�ķǻ������γ�Ԫ�صĺϽ�������ͭ��Ĥ���ṹ[1-4], ���������������(��H>0)���Ҳ��γ��м仯���������CuCr�Ͻ�ϵͳ���������ǵ�ע��[5-6]�� ��������Cu��Cr������, �ر�Cr����(Ħ������)��1.5%~40%֮��ʱ, �Ͻ��ɸ��µ�������ȴ����Һ��������ʱ, Һ���н����������͵�Cr�� ��������������, �ܶȽ�С�Ĺ�̬Cr��Ѹ���ϸ�, ����Cu/Cr�����۷��롣 �������߲�����յ绡������Cr����Ϊ3.5%��CuCr�Ͻ�е������Ʊ����Ҳ֤������һ�㡣 �ſؽ���Ͻ�Ĥ���Ʊ�һ�㶼�Dz��õ��Ͻ�н������˫�н���ķ�ʽ�� ���ͨ��ͭ���Ͻ���������Ʊ���ͬCr������Cu1-xCrx��Ȼ�Ǻ����ѵġ� ��˫�дſؽ�����Ȼ����������Ʊ�Ĥ�ɷ�, ���ǰвķ��ýϴ�, ���乤�ձȽϸ���, �豸Ҫ��ϸߡ�
Barmak��[3]���������˫�еĵ���������������������SiO2�Ĺ�ĵ����Ʊ�CuCr�Ͻ�Ĥ, ���ҶԱ�Ĥ�ĵ������֯�ṹ�������о��� Ȼ���˷����Ʊ��ĺϽ�Ĥ�ijɷֲ�����, ���ҹ��ո���, ���豸Ҫ��ϸߡ�
�����������ü��Ͻ�вĵ��дſؽ��䲻ͬCr������Cu1-xCrx(x=1.19~2.37, Ħ������, %)�Ͻ�Ĥ, �����һ�־������õ������ܵĵ��Ӳ�����ͭ���Ͻ�Ĥ���Ʊ������� �������������, �÷������б�Ĥ���ȸߡ� �Ʊ����ռ��ص�, �ܹ���ʱ���ںϽ���, �������Ч�ʡ�
1 ʵ��
1.1 ���дſؽ���Cu1-xCrx��Ĥ�вĵ��Ʊ�
��ͭ��(99.99%)�ӹ�����ͼ1��ʾ�İв�(�вĺ��Ϊ5mm)��һ��ͭ��Ƭ(���Ϊ1.5mm)�� С�ķֲ����ս����ǵĽ������������ ������Ϊ99.9%�ĸ��ӹ�����Ӧ�ߴ��Բ��С��(С���ߴ�������ﵽ�������Ϊ)�� �вľ�����ϴ��, ���ɴ��á�

ͼ1 ���дſؽ�����Cu1-xCrx�в�ʾ��ͼ
Fig.1 Sketch of magnetron sputtering Cu1-xCrx target
1.2 ��Ĥ���Ʊ�
����CEVP Gamma 1000c �Ͷ�дſؽ�����, ������Ƶ�ſؽ���ķ�ʽ��(100)�赥��Ƭ�������Ʊ�CuCr�Ͻ�Ĥ�� �赥��Ƭ�ھ�����ϴ��, ��ͭ��Ƭ, ͭ�в�����װ�뽦�����С� ͭ��Ƭ�����þ��Ƿ�ֹ��������������ͭ�����С��֮��ļ�϶�����䵽�����ϡ� ��������������б��15�㡣 �������ڽ����������ת�ٶ�Ϊ10r/min�� �����ǵı�����ն�Ϊ0.439~0.598mPa, ��������ΪAr, ������ѹΪ0.665Pa, �ƾ�Ϊ27cm, �����¶�Ϊ���¡�
��ʵ��������ֳɷֵİв�, ������ɷֱַ�ΪCu-2.06%Cr��Cu-4.04%Cr�� ��Ƶ�ſؽ���Ľ��书��Ϊ100W, ����ʱ��ֱ�Ϊ50�� 30��120min��
Ϊ���жԱ�, ʵ�黹��ͬ���Ľ����������Ʊ��˴�ͭ��Ĥ, ���书��Ϊ100W, ����ʱ��Ϊ50min��
��Dektak 6M��̨���ǵIJⶨ, 3�ֽ���ʱ���¶�Ӧ�Ľ���̬��Ĥ��ȷֱ�Ϊ234�� 326��855nm��
1.3 ��Ĥ���ܵIJⶨ
����������ɢX��������(EDX), SDY-5��˫�����̽������ǶԽ���̬Cu-Cr��Ĥ�ijɷ֡� ��������˲��ԡ� ����X�����������(XRD)�� Sirion 200�ͳ�����ɨ���������(FESEM)�� ԭ��������(AFM)�Խ���̬��Ĥ�ij�ʼ�ṹ�� ������ò�����˷�����
2 ���������
2.1 ��Ĥ�ɷּ���
����������ɢX��������(EDX)�ԺϽ�Ĥ�ijɷֽ��вⶨ�� �������, Cu-2.06%Cr�Ͻ���ڽ���ʱ��Ϊ50min�Ʊ��ĺϽ�Ĥ��ʵ�ʳɷ�ΪCu-1.19%Cr; Cu-4.04%Cr�Ͻ���ڽ���ʱ��Ϊ30min��120min�Ʊ��ĺϽ�Ĥ��ʵ�ʳɷֱַ�ΪCu-2.18%Cr��Cu-2.37%Cr�� ����100W���书����, 3�������µĸ��� ͭԪ�صĽ������֮���ʷֱ�Ϊ0.55�� 0.53��0.57, �������������ֲ��䡣 ����Ĥ�ijɷ��ǿ��Կ��Ƶġ� ������̬��Ĥ���ܲ������1��ʾ��
��1 ���дſؽ���Cu1-xCrx(x=1.19~2.37, Ħ������, %) ����̬��Ĥ����
Table 1 Properties of as-deposited Cu1-xCrx(x=1.19~2.37, mole fraction, %) deposited by magnetron sputtering single target

2.2 ��Ĥ����IJⶨ
��̽������ǵIJ��Խ������, ��ʵ���������Ʊ��Ľ���̬��Cu-1.19%Cr�� Cu-2.18%Cr��Cu-2.37%Cr��Ĥ�����ʷֱ�Ϊ17.77�� 30.22��20.43�̦���cm�� ��Ҳ������[3, 5]�ı���һ�¡� ����̬��Ĥ�����ʽϸ�, �����뱡Ĥ�����ijɷ��й�֮��, �뱡Ĥ������֯״̬(�羧������ȫ, ���ܶ��Լ���ȵIJ������Ե�)�� �����������Ҳ�йء� ����̬��Ĥ�ھ����ʵ����˻������պ�, �����������½��� ʵ�����, 326nm���Cu-1.19%Cr��Ĥ�ھ���400���˻�30min��, �������Ϊ3.72�̦���cm�� ���, Cu-Cr�Ͻ�Ĥ�ھ������ʵ��˻��պ�������ܹ�������ͭ�������е�Ӧ�á�
2.3 ����̬��Ĥ�ij�ʼ�ṹ����
ͼ2��ʾΪ��ͭĤ�� Cu-1.19%Cr�� Cu-2.18%Cr��Cu-2.37%Cr����̬��Ĥ��XRD�ס� ��ͼ�п��Կ���������̬��Ĥ�ij�ʼ�ṹ��ҪΪCu(111)��Cu(200)�塣 ��ʵ���Ʊ��Ľ���̬��ͭĤ��Cu(111)��Cu(200)�ķ�ǿ��ԼΪ2, ������ʱ��ĤΪ��̬�ĶྦྷĤ�� ������ͭ��Ĥ�ľ��������뱡Ĥ�е����ʺ���, ����Ӧ���ܺͽ������й�[4]�� ��Detavernier��[7]���о�����, ���ʡ� Ӧ�����Լ������ܵ�Ӱ�첢���ǵ��½���̬ͭ��Ĥ���¾�������Ҫԭ��, ��Ĥ�и��ָ��ܶȵ�ȱ��(��λ�� λ����)���Ǵ�ʹ��Ĥ�����������Ҫ�������� ����̬Cu-1.19%Cr�� Cu-2.18%Cr��Cu-2.37%Cr��Ĥ��(111)��(200)�ķ�ǿ�ȷֱ�Ϊ4.68�� 3.91�Լ�8.48, �뽦��̬�Ĵ�ͭĤ�����������, �ҷ�λ�ͷ���������Եı仯�� �����Ͻ�Ĥ���н�ǿ��(111)ȡ��֯����CrԪ�ػ�����Cu��Ĥ�С� �������ű�Ĥ��ȵ�����, ��Ĥ(111)֯����ǿ�� ���������ڱ�Ĥ������������, (111)�������ھ�����͵�������������������������� ��2�г������������ṹ��Ҫ�����������Ա�ֵ[8]�� ����̬Cu1-xCrx(x=1.19~2.37)��Ĥ������Ϊ��������

ͼ2 ������̬��Ĥ��XRD��
Fig.2 XRD patterns of as-deposited films
��2 ���������ṹ��Ҫ�����������Ա�ֵ
Table 2 Ratio of surface energy of main planes in FCC lattice

�ṹ[9-10], Cr������������ϵͳ��������(���������ܡ� �������Լ�Ӧ���ܵ�)�� �ڱ�Ĥ�ɳ��Ĺ�����, ��������ܵĸ��������Լ�Ӧ���ܵĸ������Գ�Ϊ����(111)֯���Ķ��ξ���������������� �����ű�Ĥ��ȵ�����, ��Ĥ�еĽ����ܡ� Ӧ������֮����, �Ӷ�����(111)֯��ת������������ӡ� ���ξ����ijߴ�����, (111)֯����һ����ǿ[11-12]�� ���, ����˵����̬��Ĥ�����¾����Լ��������������뱡Ĥ�е������Լ��ɴ˶������Ľ����ܡ� Ӧ���ܵ������йء� ͬʱ������573KʱCr��Cu�е�����ɢϵ��Ϊ4.31��10-22cm2/s[13-14](����������ɢϵ����������Ĥ�е�Cu�� Cr����ɢ�Dz���ʵ��)�� ����������ݿ�֪, �����³����Ĺ�����, ����Cr����ɢ�����, Cr��Cu�С����ᡱ, �γɹ���������̬, �ٽ���ͭ���Ͻ�Ĥ֯�����γɡ� (111)֯�����γ���������߱�Ĥ����ѧ����, ���Ʊ�Ĥ����ʴ���Լ�����Ǩ�Ƶ�����[15-16]�ȡ�
2.4 ��Ĥ������ò�۲�
ͼ3��4��ʾ�ֱ�Ϊ����̬��ͭ��Ĥ�Լ�Cu-1.19%Cr�� Cu-2.18%Cr��Ĥ��AFM������ò��FESEM������ò����ͼ�� ��ͼ3(a)�п��Կ���, ����̬�Ĵ�ͭ��Ĥ��Ȳ�����, ����ƽ���Խϲ�, ����ֲڶ�RaԼ5.828nm, ��FESEM������ò������Ǻ�(ͼ4(a))�� ������Ͻ�Ԫ��Cr֮��, Cu-1.19%Cr��Ĥ�ı������ܶ��������, �����[CM(22]�ڶ�ԼΪ2.140nm�� ��Cr�������ӵ�2.18%ʱ, �봿ͭĤ��Ƚ�, Cu-2.18%Cr�Ͻ�Ĥ�����ϵı���ƽ�����������(ͼ4(c)), ����ֲڶ�ԼΪ4.375nm, ��Ĥ���������ܶ��������ӡ� ���������Cu-1.19%Cr����̬��Ĥ, ��Ĥ������������½��� ����Ԫ�ؽ�������Լ�ԭ�ӵı�����ɢǨ�Ƶ�����, ��ԭ�ӵij������ʺ�ͭԭ���ڱ�Ĥ�������ɢ�����йء� ���ݱ�Ĥ����������ѧ, ��Ĥ�����ٽ���γɺ�, ���ڴ�ͭĤ��˵, ����ͭ�Ľ�������, ��λʱ���ڵ�����ױ����ԭ��������, �ٽ��ԭ���ų���, �γɳߴ�ϴ�����ӡ� ����ͭԭ���ر�Ĥ�������ɢ��Щ��״���Ӳ�������, �����γ�����Ĥ�� ����Ĥ����ߵͲ�ƽ, ����ϴ�, ���нϴ�Ĵֲڶȡ� ������Cr֮��, ����Cr�Ľ������С, ԭ�ӳ��������½�, �������γɵ����ӳߴ�С, �����γɵ�����Ĥ���������С, �ֲڶ�Ҳ���Լ�С�� ����ͭ�� ��ԭ����ߴ粻ͬ, �ڽ��������ԭ����ѻ����, ����˽���̬��Ĥ�����ܶȡ� ����Cr��������2.18%ʱ, �����ġ����ᡱ̬Cr��ͭԭ���ر�����ɢ���谭������������, ������ͭ����ɢ����, ��ɱ�Ĥ�ı�������������ӡ� ����, Cu-2.18%Cr��Ĥ�ľֲ������������������(ͼ4(d))�� ��Щ���Ƴ�һ���ǶȾ��ȵس����ڱ�Ĥ��, ���������Ƶļ�������Ե�Ӧ���ӡ� ����Ҫ����������2.18%��Cr��Ĥ�е�Ӧ������, �ڽ���֮��ʱЧ�Ĺ�����, Ӧ���ͷ�, �������ƺ�Ӧ���ӵ��γ�, ��ʹ����̬��Ĥ�������������½���

ͼ3 ����̬��Ĥ��AFM��Ƭ
Fig.3 AFM images of as-deposited films
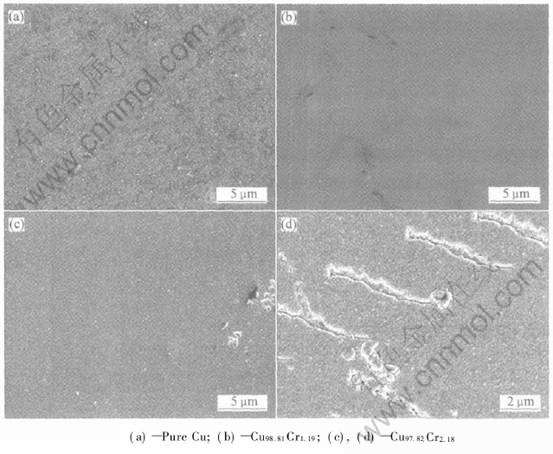
ͼ4 ����̬��Ĥ��FESEM��ò
Fig.4 FESEM images of as-deposited films
3 ����
1) ���дſؽ��䷨�Ʊ�Cu1-xCrx(x=1.19~2.37)�Ͻ�Ĥ�� ��Ĥ�ɷֿ��Ժ������ơ� ����̬��Ĥ�ij�ʼ�����ʽϸߡ� �����������˻��պ�, ��Ĥ�����ʼ�С�� Cu-1.19%Cr��Ĥ�ھ���400���˻�30min���������17.77�̦���cm ��СΪ3.72�̦���cm�� ���, ѡ������ĺϽ�Ԫ�غ������˻��¶��ܹ�ʹ��Cu1-xCrx��Ĥ����ͭ������Ҫ��
2) �����µĽ���̬��ͭ��ĤΪ��̬Ĥ�� �뽦��̬��ͭĤ���, ����̬Cu-1.19%Cr�� Cu-2.18%Cr��Cu-2.37%Cr��Ĥ���н�ǿ��(111)֯���� �����ű�Ĥ��ȵ�����, (111)֯������ǿ�� 855nm���Cu-2.18%Cr��Ĥ��(111)��(200)�ķ�ǿ�ȸߴ�8.48�� ����̬�Ͻ�Ĥ֯���ı仯�ͱ�Ĥϵͳ������(�����ܡ� �����ܡ� Ӧ���ܵ�)�������йء�
3) ����Cr���Ը��ƽ���̬��Ĥ�ı���ƽ���Ժ����ܶȡ� �뽦��̬��ͭĤ���, ����̬Cu-1.19%Cr�Լ�Cu-2.18%Cr��Ĥ�����ܶ���������, ����ƽ�������, �ֲڶȷֱ��ɴ�ͭĤ��5.828nm���͵�2.140nm��4.375nm�� Ȼ������̬Cu-2.18%Cr��Ĥ�ֲ���������, ��Ĥ�������½���
REFERENCES
[1]Chu J P, Lin T N. Deposition, microstructure and properties of sputtered copper films containing insoluble molybdenum[J]. Journal of Applied Physics, 1999, 85(9): 6462-6469.
[2]Gungor A, Barmak K, Rollett A D. Texture and resistivity of dilute binary Cu(Al), Cu(In), Cu(Ti), Cu(Nb), Cu(Ir), and Cu(W) allow thin films[J]. J Vac Sci Technol, 2002, B20(6): 2314-2319.
[3]Barmak K, Lucadamo G A, Cabral C, et al. Dissociation of dilute immiscible copper alloy thin films[J]. Journal of Applied Physics, 2000, 87(5): 2204-2214.
[4]Cabral C, Harper J M E Jr, Holloway K, et al. Preparation of low resistivity Cu-1at.%Cr thin films by magnetron sputtering[J]. J Vac Sci Technol, 1992, A10(4): 1706-1722.
[5]Harper J M E, Rodbell K P. Microstructure control in semiconductor metallization[J]. J Vac Sci Technol, 1997, B15: 763-779.
[6]Kamijo T, Furukawa T, Watanabe M. Homogeneous nucleation of coherent precipitation in copper-chromium alloys[J]. Acta Metall, 1987, 36: 1763-1769.
[7]Detavernier C, Deduytsche D, Van Meirhaeghe R L, et al. Room-temperature grain growth in sputter-deposited Cu films[J]. Applied Physics Letters, 2003, 82(12): 1863-1865.
[8]������, ����, ���, ��. ���ӷ�װ����װ�е����Ӽ���[EB/OL]. http://mwjl.hit.edu.cn/micro/pdf_files/conclusion/microjoining-9.pdf. 2005
WANG Chun-qing, TIAN Yan-hong, KONG Ling-chao, et al. Microjoining Technology in Electronics Packaging and Assembly[EB/OL]. http://mwjl.hit.edu.cn/micro/pdf_files/conclusion/microjoining-9.pdf, 2005.
[9]Kim J, Wen S H, Yee D. Coevaporation of Cr-Cu and Mo-Ag[J]. J Vac Sci Technol, 1988, A6(4): 2366-2370.
[10]Machlin E S. Lattice energy functions for prediction of structural properties OF alloys phases[J]. Proc Mater Res Soc Symp, 1983, 19: 67-80.
[11]Hoshino K, Iijima Y, Hirano K I. Diffusion of vanadium, chromium, and manganese in copper[J]. Metall Trans A, 1977, A8: 469-472.
[12]Wong C C, Smith H I, Thompson C V. Surface-energy-driven secondary grain growth in thin Au films[J]. Appl Phys Lett, 1986, 48(5): 335-337.
[13]Thompson C V, Carel R. Texture development in polycrystalline thin films[J]. Mater Sci Eng B, 1995, 32: 211-219.
[14]����, ����, ��ʥ��. ��Ӧ���Խ�����Ĥ����֯����Ӱ��[J]. ����ѧ��, 2002, 38: 795-798.
ZHOU Lang, ZHOU Nai-gen, ZHU Sheng-long. Effect of internal stress on growth texture of metallic thin films[J]. Acta Metallurgica Sinica, 2002, 38: 795-798.
[15]Kusche W M, Kreschman A, Keller R M. Texture of thin films[J]. J Mater Res, 1998, 13(10): 2962-2968.
[16]Tracy D P, Knorr D B. Texture and microstructure of thin copper films[J]. Journal of Electronic Materials, 1993, 22(6): 611-616.
������Ŀ: �Ϻ�Ӧ�ò����о���չ����������Ŀ(0412)
�ո�����: 2006-06-27; ������: 2006-09-11
ͨѶ����: ���½�, ��ʿ�о���; �绰: 021-62932440; E-mail: xinjian_wang@sjtu.edu.cn


