�����ϵĽ�������
�����,̷��ƽ,�� ��,�� ��
(���ϴ�ѧ ���繤��ѧԺ,���� ��ɳ,410083)
ժ Ҫ��
��EDS�������о���Al-Al,Au-Al��Au-Ag�������Ϻ�������������۽ṹ���Լ���仯,�����˼��Ͻ���ṹ�泬�����ʺ�����ʱ��仯�Ĺ��ɡ��о��������:�������Ͻ������״������һ������δ��ϵ���Բ,�弹�ܱ߲�������,�����ǿ��ȡ���ڼ���������ܱߺ�δ��ϵ�������;�����������ʹ̶�ʱ,����ʱ�������,����������������;��������������ʱ��̶�ʱ,�湦�ʵ�����,���������弹������;Au-Ag��ɢż��Kirkendall��ɢЧӦ��Au-Al���Ͻ�������γɽ����仯���
�ؼ���: ���ӷ�װ; ��������; �۽ṹ
��ͼ�����:TN45 ���ױ�ʶ��:A ���±��: 1672-7207(2005)01-0087-05
Characteristics of Wire Bonded Interface
LI Jun-hui, TAN Jian-ping, HAN Lei, ZHONG Jue
(School of Mechanical and Electrical Engineering, Central South University, Changsha 410083, China)
Abstract: Lift-off and longitudinal section characteristics on ultrasonic bonded micro-interface including Al-Al, Au-Al and Au-Ag were observed by means of scanning electron microscope and energy dispersive spectrum. Microstructures of the bond interface were evolved by the ultrasonic variables, i.e., power and time. The results show that the peeling underdeveloped bonds simulate a torus (or doughnut) with an unbonded central region and ridged peripheral region. Bond strength is located between the severely ridged periphery and the non-adhering central area of the bond. For constant force and time, the ridged area of the bond pattern is increased in size with increasing power. For constant force and power, the ridged location of the bonded region moves closer to the bond center with increasing time. Kirkendall effect in Au-Ag interface and intermetallic compounds in Au-Al interface are confirmed.
Key words: electronic packaging; ultrasonic bond; microstructure
����������Ӧ���ڵ��ӷ�װ������������ʱ,�ܶ��о�������������ϻ����о�,Ŀǰ,��Ҫ�����¼��ֹ۵�:
a. Ħ���ȼ��ϡ�ֱ�۵���Ϊ���泬����Ħ�����¼��������γ��ȼ���[1,2]��K.C.JOSHIͨ���ⶨ������������������ߺͻ����������˶�[3],G.G.HARMANͨ������ⶨ�ó����Ͻ�������70~80 ��[4],���������������ĵ��²����γ����ۻ�����,֤��Ħ�����ϵĹ۵��Dz������ġ�
b. �����������ڳ�����������,Al������ģ������[5], �ڸ�Ƶ��������ЧӦ��, Al,Ca,Be,Zn,Cu,Au��Fe�Ȳ��϶�����������������[6],��������������ȷ����
c. ���˶���ͨ����������Dz�����Ƶ�˶�, �о����������Ĵ���,���ʡ�����ʱ�����Ĺ�ϵ���������ڽ�����Ͼ�10 ms��,�������ȶ�,�������������40~200 ��m�ϼ�[7,8]��
d. ����۲�,��ģ���͡���������,�۲캸������ò,��һ������δ���ϵ���Բ,�������ϵ���ѧģ�͡��������dz�����̬Ӧ���;�ѹӦ����ͬ���õĽ��[8],�ɽ������������ģ��[9],��ʵ���о��������������ϵĿɿ���ģ��[10]��
�ڴ�,���߶Լ��Ͻ����ɨ��羵(SEM)��Ƭ�����о�,���Լ��Ͻ����EDS�����в��ԡ�������
1 ʵ�����
1.1 ���Ͻ���Ļ���������ϵ
a.�������:оƬ������,����ΪAl��;ʵ����������,����ΪAg�㡣
b.���Ӳ���:ֱ��Ϊ40 ��m��Al-Si˿(������0.5%Si�ԺϽ�ǿ��);ֱ��Ϊ18 ��m��Au˿��80 ��m��Au��(��ͼ1)��

ͼ 1 ���Ͻ�����Բ�����ϵ
Fig. 1 Test material system in bonding interface
1.2 �����豸�Ͳ�������
��������ΪCWD-3�ͳ��������ߵ㺸����T/S-2100��˿��;��������ΪKYKY2800ɨ��羵(SEM)��Finder TM EDS���ײ����ǡ�
1.3 ʵ�����
1.3.1 ��1��ʵ��
����CWD-3�ͳ������㺸��,��ֱ��Ϊ40 ��m�Ĺ���˿���ϵ�оƬAl��,����ȡ���Ͻ��档
����T/S-2100��˿��,��Au��оƬ(������������������)�����ڻ���Ag��,���ȳ�������,�ٻ�ȡ���Ͻ���������档
1.3.2 ��2��ʵ��
����T/S-2100��˿��,��ֱ��Ϊ18 ��m��Au˿ͨ������Ш����оƬAl��,��������������������,���������������ʻ�ʱ����ж������,�ֱ���SEM�¹۲�����۱仯���ԡ�
1.3.3 ��3��ʵ��
����T/S-2100��˿��,��ֱ��Ϊ18 ��m��Au˿ͨ�������������оƬAl��,��SEM�¹۲�Au-Al�����������Լ�����EDS���ײ��ԡ�
2 ʵ�����������
2.1 ����ṹ��״
ͼ2��ʾΪ��Al���ȥֱ��Ϊ40 ��m�Ĺ���˿��¶�ļ���ģʽ,�ܱߴֲ��缹��,����Ϊ�⻬����,����Ϲ�������Ϊ:����0.5 W,ѹ��150 mN,ʱ��0.1 s,����24 ��)��ͼ�м������ܱ߷����������ƻ�,�����弹,����û�з����ƻ�,������������δ�γɼ��ϡ�������Ϊ���ܲ���Ӱ��ļ������ߵ��ܱ߲����ڻ����²���һ��ǿ��ľ������úͻ�еӦ������CWD-3���ϻ�,����Ƶ��f=45 kHz,��=2��f=2.83��105 Hz,��PSV-400-M2��Ƶ����������Ʋ��������A=2.4 ��m���ʼ��ٶȷ�ֵΪ:
a=A��2=2.4��10-6��(2.83��105)2��
2.0��105 m��s-2,
���������ٶȵ�2.0��,����ǿ�Ļ�еЧӦ�����λ��������ԭ�ӵ�Ǩ����,ͬʱ,ȥ������Ĵ����������¶�ྻ�Ľ�������,������ǿ�ȵ�ԭ�Ӽ��ϡ�
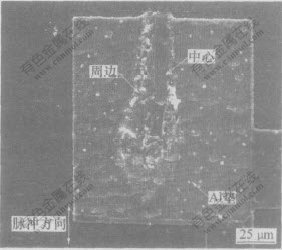
ͼ 2 SEM�½����۽ṹ
Fig. 2 SEM microstructure of below interface
ͼ3��ʾΪAu-Ag�������Ͻ���,���۽ṹ���������档ͼ4��ʾΪa���EDS��������,�����EDS���ײ������ݼ���1,����Խ������,��������(a���b��)û��Au,Ϊ100%��Ag;�����弹�ܱ�(c��,d���e��)���в�ͬ������Au��Ag��EDS���ײ��Խ��֤ʵ�˽�����۽ṹ��һ������δ��ϵ���Բ��
Au-Ag��ɵ���ɢż,Au��Ag�������ɢ,����Kirkendall��ɢЧӦ,��ɢ�ٶ�ȡ������ɢϵ��DAu��DAg����ͼ3(b)�ɼ�,Au������ϵ�1,2,3,4��5Ϊ100%��Au,û��Ag,��˵��DAu>DAg,��Au����ɢ��Ag����ɢ��ΪѸ�١�
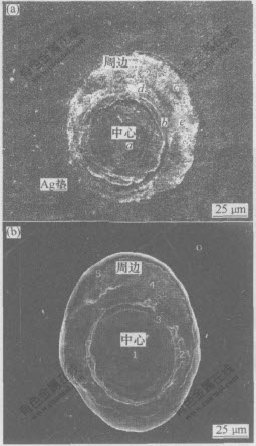
(a)��(b)Ϊ1�Է���ļ��Ͻ��汩¶�ļ���ģʽ
ͼ 3 Au-Ag�������Ͻ���ģʽ
Fig. 3 Pattern of Au-Ag ultrasonic
bonded interface
�� 1 Au-Ag����EDS���ײ�������
Table 1 Results of EDS tests at Au-Ag interface 
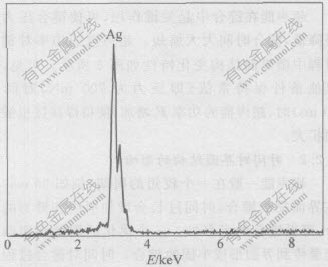
ͼ 4 a���EDS���ײ�������
Fig. 4 EDS tests curve of point a
��֮,���������ų���������һ������δ���ϵ���Բ(��ͼ5),�����������G.G.HARMAN���ȷ��ֵ�[7].EDS���ײ��Խ�����������SEM���Է�ӳ�˳�����������״:�弹�ܱ���������δ���ε�������,����ǿ��ȡ���ڼ���������ܱߺ�ճ�ϵ������档������״���Ħ��ģʽ�ͻ���ģʽʵ�ּ��ϵ��������ó�������״�Dz�ͬ��,��Ϊ��2�����۶�Ԥ���������������ѡ�����,Ħ���ͻ����dz������ϵĸ���Ʒ��

ͼ 5 ��������ͼ
Fig. 5 Pattern of ultrasonic bonded
characteristics
2.2 ����ṹ�仯
�����ܵĹ��ʡ�����������ʱ���dz��������õ���Ҫ��е����,���ǵı仯��Ӱ���Ž����۽ṹ��
2.2.1 ���ʶԽ���ṹ��Ӱ��
�������ڼ�������ؼ�����,��ʹ����ѹ�����Խ���,����ʱ�������̡��������Ĺ��ʶԼ��Ϲ���������ṹ�仯������ͼ6��ʾ���ɼ�,�������������ֳ�ֵ(��ѹ��Ϊ700 mN,ʱ��Ϊ30 ms)ʱ,�����ܵĹ���P����,ʹ�ú��������弹������
2.2.2 ʱ��Խ���ṹ��Ӱ��
������һ����һ���϶̵�����(����50ms)���ڽ�����ɼ���,ʱ��������������ߺ�������ճ��,���ͼ��ϵĿɿ��ԡ�һ���Ż������ڱ���ȷ���������������γ��ι̵ļ��ϡ�ʱ��Լ��Ϲ������ṹ�仯����Ϊ:�������������ֳ�ֵ(��ѹ��Ϊ700 mN,����Ϊ1.75 W)ʱ,����ʱ��t����,�����弹��������������,��ͼ7��ʾ��
�����ܶԽ����۽ṹ�ı仯����Ϊ�Ż��������ϲ����ṩ�������ݡ�
2.3 Au-Al����ɷ�
ͼ8��ʾΪAu-Al�ݽ����۽ṹ,����Ϲ�������Ϊ:����1.75 W,ѹ��700 mN,ʱ��35 ms,�����¶�250 �档 ͼ��A,B��C���EDS���ײ��Խ������2���ɱ�2��֪,A��ɷ��뻯����AuAl����,����һ�ֽ����仯����,B���C����һ���ܽ�ȵĹ�����֯����Au-Al���Ͻ���,���Ӵ������γɽ����仯����,ͨ����Au�ĺ�����Al�ĺ�����,�����仯����ľ�����������ϵ�����γɹ���������ı仯���Dz�ͬ��,���Ҷ�ʴ���,�����ʶ��ϵ�,�����Ľ����仯����Խ������ǿ����һ��ǿ������,�����仯�������ʱ���¼���ǿ�Ƚ��͡����,�Լ��Ӵ��������,���տɵ��������ڿ�·�������ĵ������˻�������,������ƹ���,�Ծ����ܵؼ��ٽ����仯��������ɡ�
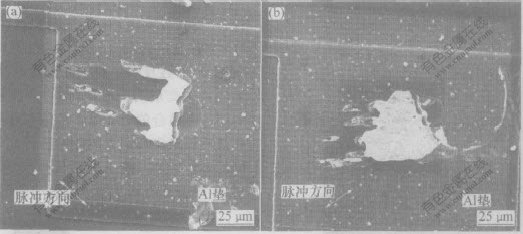
(a)������Ϊ1.5 W; (b)������Ϊ2.5 W
ͼ 6 �����������������弹������ļ���ģʽ
Fig. 6 Increase of ridged area of bond pattern in size with increasing power
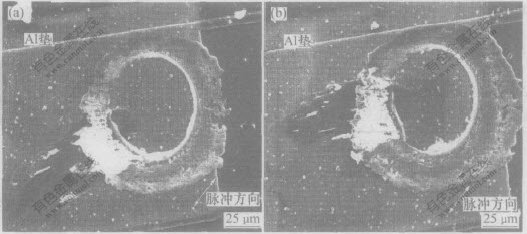
(a)������ʱ��Ϊ10 ms; (b)������ʱ��Ϊ15 ms
ͼ 7 ����ʱ�����������弹��������������ļ���ģʽ
Fig. 7 Moving closer to bond center of ridged location of bonded region with increasing time
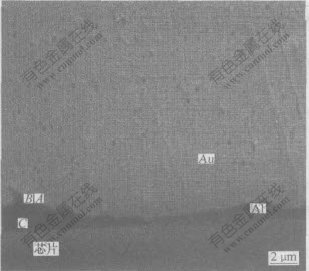
ͼ 8 Au-Al�ݽ����۽ṹ
Fig. 8 Au-Al longitudinal section
microstructure
�� 2 Au-Al����EDS���ײ��Խ��
Table 2 Results of EDS tests at Au-Al interface 
3 �� ��
a.���Ͻ�����۽ṹ����һ������δ��ϵ���Բ,�弹�ܱ߲�������,�弹�ܱߺ�δճ�ϵ�����������������ǿ�ȡ���Ħ���ͻ���ģʽʵ�ּ��ϵ����۲�ͬ,�����е�Ħ���ͻ���ֻ�dz������ϵĸ���Ʒ��
b. �������Ĺ��ʡ�ʱ��Խ����۽ṹ����Ӱ��,�����Ϊ:�������������ֲ���ʱ,��������,�������弹������;ʱ������,�������弹�����������졣
c. ���Ͻ��治ͬ�����γɵ���ɢż,ʹ���Ͻ������Kirkendallԭ����ɢЧӦ;����Au-Al��[CM(22] ��ϵͳ,�ڼ��Ͻ�������γ�һЩ�����仯������[CM)] AuAl,Ӱ�����Ļ�е�͵����ܡ����,������ƹ���,�Ծ����ܼ��ٽ����仯��������ɡ�
�����:
[1]ANTONEVICH J N, MONROE R E. Fundamental Studies of Ultrasonic Welding[J]. Welding Journal Research Supplement, 1960, 8(3): 125-136.
[2]UTHE P M. Variables Affecting Weld Quality in Ultrasonic Aluminum Wire Bonding[J]. Solid State Tech, 1969, 8(8): 72-77.
[3]JOSHI K C. The Formation of Ultrasonic Bonds Between Metals[J]. Welding Journal, 1971, 10(50): 840-848.
[4]HARMAN G G. Wire Bonding to Advanced Copper, Low-K Integrated Circuits, the Metal/Dielectric Stacks, and Materials Considerations[J]. IEEE Trans Parts Hybrids Manuf Technol, 1990, 3(13): 176-181.
[5]lANGENECKER B. Ultrasonic Softening Effect[J]. IEEE Trans Sonics Ultrason, 1966, 13(13): 1-8.
[6]KANG S Y, WILLIAMS P M, MCLAREN T S. Studies of Thermosonic Bonding for Flip-chip Assembly[J]. Materials Chemistry and Physics, 1995, 42(42): 31-37.
[7]HARMAN G G. An Experimental Model of the Microelectronic Ultrasonic Wire Bonding Mechanism[J]. Proceeding 10th Annual Reliability Physics Symposium, 1972, 8(4): 49-56.
[8]VERN H, WINCHELL B, HOWARD M. Enhancing Ultrasonic Bond Development[J]. IEEE Trans Hybrids, and Manuf Technol, 1978,1(3): 211-220.
[9]CHEN G K C. The Role of Micro-Slip in Ultrasonic Bonding of Microelectronic Dimensions[J]. International Hybrid Microelectronics Symposium, 1972, 8(5): 111-119.
[10]HARMAN G G, ALBERS J. The Ultrasonic Welding Mechanism as Applied to Aluminum-and Gold-wire Bonding in Microelectronics[J]. IEEE Trans on Parts, Hybrids, and Packaging, 1977,13(4):406-412.
�ո�����:2004-05-02
������Ŀ:������Ȼ��ѧ����������Ŀ(50390064); �����ص�����о���չ�滮��Ŀ(2003CB716202)
�����:�����(1969-),��,�����ҽ���,��ʿ�о���,�������ӻ���������CAD��CAE��������о�
������ϵ��: �����,��,��ʿ�о���;�绰:0731-8836499(O); E-mail: lijunhui@mail.csu.edu.cn
ժҪ: ����ɨ��羵��EDS�������о���Al-Al,Au-Al��Au-Ag�������Ϻ�������������۽ṹ���Լ���仯,�����˼��Ͻ���ṹ�泬�����ʺ�����ʱ��仯�Ĺ��ɡ��о��������:�������Ͻ������״������һ������δ��ϵ���Բ,�弹�ܱ߲�������,�����ǿ��ȡ���ڼ���������ܱߺ�δ��ϵ�������;�����������ʹ̶�ʱ,����ʱ�������,����������������;��������������ʱ��̶�ʱ,�湦�ʵ�����,���������弹������;Au-Ag��ɢż��Kirkendall��ɢЧӦ��Au-Al���Ͻ�������γɽ����仯���
�ؼ���: ���ӷ�װ; ��������; �۽ṹ
��ͼ�����:TN45 ���ױ�ʶ��:A ���±��: 1672-7207(2005)01-0087-05


