���±�ţ�1004-0609(2015)04-0967-08
Cu/Sn-58Bi/Ni����Һ-�̵�Ǩ����Cu��Ni�Ľ�������
�������������ɣ��Խ��ɣ���־��
(����������ѧ ���Ͽ�ѧ�빤��ѧԺ������ 116024)
ժ Ҫ��
���ý��������Ʊ�Cu/Sn-58Bi/Ni���Ժ��㣬�о�5��103 A/cm2��170 ��������Һ-�̵�Ǩ�ƶ�Cu/Sn-58Bi/Ni���Ժ���Cu��Ni���������Լ����淴Ӧ��Ӱ�졣���۵���������Σ���Һ-�̵�Ǩ�ƹ����к��������Ϊ������ЧӦ������������������仯����(IMC)�������������һֱ�������������IMC����Ǩ�������ӿ���Cu��Niԭ�ӵĽ������á���������Ni����Cuʱ���ڻ�ѧ���ݶȺ͵��ӷ�������������£�Niԭ����ɢ������Cu�������淴Ӧ����(Cu,Ni)6Sn5����IMC��ͬʱһ������Cuԭ���ܹ�����ӷ���ɢ��Ni�࣬������淴Ӧ����(Cu,Ni)6Sn5����IMC����������Cu����Niʱ��������Cuԭ����ɢ��Ni�࣬��������淴Ӧ����(Cu,Ni)6Sn5����IMC��Ȼ����Niԭ��������ӷ�����������ɢ��Cu�࣬�Ӷ�ʹ����Cu�����ʼ��ΪCu6Sn5����IMC�����⣬���۵���������Σ������ڶ�û�г���Bi�ľۼ���
�ؼ��ʣ�
Һ-�̵�Ǩ��������������Cu/Sn-58Bi/Ni���������淴Ӧ�������仯������
��ͼ����ţ�TG425.1 �� �� ���ױ�־�룺A
Cu-Ni cross-solder interaction in Cu/Sn-58Bi/Ni interconnect undergoing liquid-solid electromigration
HUANG Ming-liang, FENG Xiao-fei, ZHAO Jian-fei, ZHANG Zhi-jie
(School of Materials Science and Engineering, Dalian University of Technology, Dalian 116024, China)
Abstract: Cu/Sn-58Bi/Ni interconnect was prepared by dip-soldering, the effects of liquid-solid electromigration liquid-solid electromigration (L-S EM) on the Cu-Ni cross-solder interaction and the interfacial reaction in Cu/Sn-58Bi/Ni interconnects were investigated at current density of 5��103 A/cm2 and 170 ��. Regardless of the current direction, a polarity effect is observed in Cu/Sn-58Bi/Ni interconnects undergoing liquid-solid electromigration (L-S EM), i.e., the interfacial intermetallic compound (IMC) at the anode grows continuously and is obviously thicker than that at the cathode. EM significantly enhances the interaction between Cu and Ni atoms. When electrons flow from Ni to Cu, the diffusion of Ni atoms are significantly enhanced by the combining effect of chemical potential gradient and electronic wind, resulting in the formation of (Cu,Ni)6Sn5 at the anode Cu interface, while a certain amount of Cu atoms diffuse to the Ni cathode interface under upwind diffusion, resulting in the formation of (Cu,Ni)6Sn5. When electrons flow from Cu to Ni, a large number of Cu atoms diffuse to the anode Ni interface, resulting in the formation of (Cu,Ni)6Sn5 IMC. However, Ni atoms are difficult to diffuse to the cathode Cu interface under upwind diffusion, thus, Cu6Sn5 IMC remains at the cathode. Furthermore, regardless of the current direction, Bi atoms do not segregate undergoing electromigration (EM).
Key words: liquid-solid electromigration; cross-solder interaction; Cu/Sn-58Bi/Ni interconnect; interfacial reaction; intermetallic compound
Sn-58Bi����ǥ�Ͼ����۵�͡���ѧ���������ͳɱ��͵��ŵ㣬����Ϊ�����п���ȡ��Sn-Pb��ǥ��֮һ[1-2]������Cu��Ni�������õĺ������ܺͽϵͳɱ�������Ϊ�����е����½�����(Under bump metallization, UBM)�ڵ��ӷ�װ�еõ��˹㷺��Ӧ��[3-4]����ˣ�Cu/ǥ����/Ni�ṹ�����Ϊ���ӷ�װ�г����Ļ�����ʽ�������������Ӳ�Ʒ�����ᡢ�����̡�С�ķ���չ������ijߴ粻�ϼ�С��ʹ��ͨ�������ƽ�������ܶȼ�����������Ǩ��(Electromigration)�ѳ�Ϊ���ӷ�װ����Ҫ�Ŀɿ������⡣
���������������Sn-58Bi�ڵ�Ǩ�������µĽ��淴Ӧ�Լ�Bi�������ľۼ��������˴������о�[5-8]����������[5]�о���Cu-Ni�������ö�Cu/Sn/Ni����Һ/�̽��淴Ӧ��Ӱ�죬�о����֣�250 �������£�Һ�̷�Ӧ������Cuԭ�Ӻ�Niԭ�Ӷ��ܹ���ɢ������Ľ��洦��������淴Ӧ��ʹ��Sn/Cu��Sn/Ni���洦�����仯�����ɽ������Cu6Sn5��Ni3Sn4ת��Ϊ(Cu,Ni)6Sn5�͡�HE��[6]�о�Cu/Sn-58Bi/Cu�����Ǩ�ƶԽ��淴Ӧ����������֯��������Ӱ�죬��������������ٽ�����IMC�������������������IMC�����������������������Bi�ľۼ�����Ϊ�赲���谭ԭ����ɢ�����������档CHEN��[7]�о���ͬ�����ܶ�(2.9��104~7.3��104 A/cm2)��Sn-58Biǥ���ڵ�Ǩ�������µ�ԭ��Ǩ��������������ϵ͵ĵ����ܶ��£����ӷ�������Sn��Bi�������ƶ������ڸߵ����ܶ��£�Bi�������ۼ������ı�Ӧ��ʹ��Sn��������ɢ�����ճ���������������Bi�������ۼ������˺���Ŀɿ��ԡ�
֮ǰ���о���Ҫ�����ڹ�-�̵�Ǩ�ƣ�Ȼ�������ŵ��ӷ�װ�ܶȲ�����������ijߴ粻�ϼ�С��ͨ������ĵ����ܶȼ�������(104~106 A/cm2)���Ӷ����¹�-�̵�Ǩ�ƹ����н�����ЧӦԽ��Խ����[9-10]�����۵�Sn-58Biǥ�Ͻ�ͷ�����ڵ�Ǩ�ƹ����г��־ֲ��ܽ⣬�ۻ��㲢��������ʧЧ�������ڱ��������������±���ԭ������״�������Դ��ڵ�ͨ״̬����ô��-�̵�Ǩ�ƾͻ�ת��ΪҺ-�̵�Ǩ�ơ�HUANG��[11]�о�Cu/Sn3.5Ag/Cu������Һ-�̵�Ǩ�������µĽ��淴Ӧ���о����֣�Cu�������ܽ��ʱȹ�-�̵�Ǩ�ƵĴ�һ��������������ԭ����Һ̬ǥ���е���ɢ����Զ�������ڹ�̬ǥ���еģ�Һ-�̵�Ǩ�ƹ����еĽ��淴Ӧ��ʧЧģʽҲ�������ԵIJ�ͬ��
����������Ҫ�о���Cu/Sn-58Bi/Ni���Ժ�����Һ-�̵�Ǩ��������Cu��Niԭ�ӵĽ������á�����IMC���ݱ��Լ�Biԭ�ӵ���ɢ�ۼ���Ϊ��
1 ʵ��
���ý����ķ������Ʊ�Cu/Sn-58Bi/Ni���Ժ��㡣����ǰ�Ƚ�Cu���Ni��(5 mm��7 mm��10 mm )�Ĵ��������Ԥĥ�⣬Ȼ�������Cu��Ni���Ͼ���ͿĨһ�������������������֮���������ֱ��Ϊ200 ��m�IJ����˿�Կ��ƽ�ͷ�ļ�࣬���̶��õ��������뺬��200 g Sn-58Biǥ�ϵ���¯��(��¯���¶ȿ�����(200��2) ��)���к��ӣ�15 s֮��Ѹ��ȡ��������ˮ�н�����ȴ������������������и�����Խ�ͷ��������4������Ԥĥ���Ʊ��ɺ����ߴ�Ϊ300 ��m��300 ��m����״�����������뵽������ֱ��Դ�ĺ�����ԡ����е�Ǩ��ʵ�顣ͼ1��ʾΪ���Ժ����Ǩ��ʾ��ͼ��

ͼ1 Cu/Sn-58Bi/Ni���Ժ����Ǩ��ʾ��ͼ
Fig. 1 Schematic diagram of Cu/Sn-58Bi/Ni line-type interconnect during liquid-solid EM
Cu/Sn-58Bi/Ni����ĵ�Ǩ��ʵ���ں����¶�Ϊ(170��4) �桢�����ܶ�Ϊ5.0��103 A/cm2�������½��У�ͨ��ʱ��Ϊ1��2��4��8 h���ֱ���Cu��Ϊ����������������ͬ��ʵ�顣ͬʱΪ�����Ǩ�Ƶ�ʵ�������жԱȣ�����������ͬ�¶��µ�Һ-�̽��淴Ӧʵ��(����)����Ǩ��ʵ������ԡ�н��У�ʵ������ж�ʱ��K���ȵ�ż�������������������¶Ȳ�����
��Һ-�̽��淴Ӧ�͵�Ǩ�ƺ����������Ԥĥ�⣬���ø�ʴҺ(4% HCl+96% C2H5OH���������)���и�ʴ����ʴʱ��Ϊ2 s������Zeiss Super 55��ɨ���������(SEM)���丽������������(EDX)�ֱ�Խ���IMC����ò���ɷֽ��з���������Auto CAD�����Խ���IMC��ĺ�Ƚ��в�����ÿ������ȡ3���ӳ���ÿ���ӳ�����3�κ�ȡƽ��ֵ��
2 ��������
2.1 ������Cu/Sn-58Bi/Ni��������֯
ͼ2��ʾΪCu/Sn-58Bi/Ni��������������֯����ͼ2(a)�ɿ�����Sn-58Biǥ����Cu��Ni�����������ã�û�в�������ȱ�ݡ���ͼ2(b)��(c)�ɿ�����������������Ͼ��γɱ���״����IMC��ǥ������Ϊ���ȵ�Sn-Bi������֯��EDX�������������Sn-58Bi/Ni���洦����Ni3Sn4 IMC������Ϊ0.27 ��m��Sn-58Bi/Cu���洦����Cu6Sn5 IMC������Ϊ0.62 ��m���ɴ˱�����������ʱ��Ľ�����Ӧ��Cu��Niԭ�Ӳ�û����ɢ��������淢���������á�����WU��[12-13]���֣�����Ni/Sn(50~100 ��m)/Cu������260 �����60 s��Cu��Ni�����˽������ã����ɺ������С�ҽ���ʱ��ϳ����¡��������߲��õĶ�ʱ���������Ϊ���������������г��ֵ�Cu��Ni�������á�
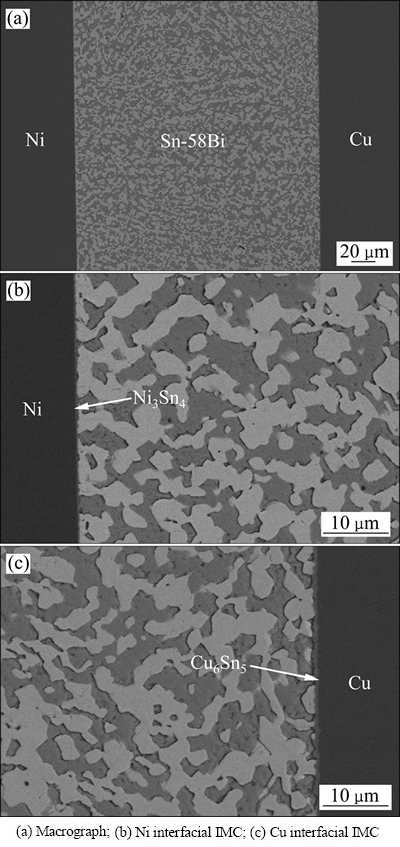
ͼ2 Cu/Sn-58Bi/Ni���Ժ�����200 �����15 s�������֯
Fig. 2 Microstructures of as-soldered Cu/Sn-58Bi/Ni interconnect after soldering at 200 �� for 15 s
2.2 Һ-�̽��淴Ӧ������Cu/Sn-58Bi/Ni���������֯
ͼ3��ʾΪCu/Sn-58Bi/Ni������170 ����Һ-�̽��淴Ӧ1��2��4��8 h�������֯����ͼ3���Կ������������IMC��ʱ���ӳ��������ǥ����û����������IMC��ͼ3(a)��(c)��(e)��(g)��ӦҺ-�̽��淴Ӧ��ͬʱ���Ni���������֯�仯ͼ��Һ-�̽��淴Ӧ1 h�����״IMC��Ȼ�ܱ���EDX�����ⶨ��IMCΪ(Cu0.56,Ni0.44)6Sn5������ɳ�ʼ��0.27 ��m��Ϊ0.67 ��m��˵����Һ-�̽��淴Ӧ1 h��Cuԭ���Ѿ���ɢ�������Ni�ദ����ʹ��IMC��Ni3Sn4ת��Ϊ(Cu,Ni)6Sn5����Һ-�̽��淴Ӧ2��4 h��EDX�����ⶨ��IMC�ֱ�Ϊ(Cu0.57,Ni0.43)6Sn5��(Cu0.62,Ni0.38)6Sn5������������������0.90 ��m��1.17 ��m����Һ-�̽��淴Ӧ8 hʱ������IMC��ȻΪ��״����ʱ����IMC�����������2.49 ��m������Һ�̷�Ӧʱ����ӳ���Ni�����IMCһֱΪ(Cu,Ni)6Sn5���ͣ�����ɷ��е�Ni�������٣�Cu���������ӣ�������״�[14]�о�Cu/Sn/Ni������250 �������µ�Һ-�̽��淴Ӧ��Ϊ��Cu��Ni�Ľ���������һ�µġ�
ͼ3(b)��(d)��(f)��(h)��ʾΪ����Һ-�̽��淴Ӧ��ͬʱ���Cu���������֯�仯ͼ��Һ-�̽��淴Ӧ��ͬʱ������IMC��ΪCu6Sn5����ȴӳ�ʼ��0.62 ��m������2.09 ��m����2.58 ��m���������3.75 ��m��Һ-�̽��淴Ӧ��Ni���������(Cu,Ni)6Sn5����IMC(��ͼ3(a)��(c)��(e)��(g))���ɿ���Cu�����IMC��û�з���Ni����Ӧ��Cu/Sn-58Bi/Ni�������IMC��������ѧ������ͼ4��ʾ����ͼ4��֪�����Ž��淴Ӧʱ����ӳ���Sn-58Bi/Ni����(Cu,Ni)6Sn5 IMC�ĺ�Ȳ������ӣ�ͬʱ��Sn-58Bi/Cu����Cu6Sn5�ĺ��Ҳ�������ӣ�������һֱ����Sn-58Bi/Ni����IMC�ĺ�ȡ�
2.3 170 ��ʱҺ-�̵�Ǩ�ƺ��������֯
2.3.1 ������Ni������Cu��
ͼ5��ʾΪCu/Sn-58Bi/Ni������170 �桢5.0��103 A/cm2������Һ-�̵�Ǩ�Ʋ�ͬʱ��������֯�����Ӵ�Ni������Cu�ˡ�ͼ5(a)��(c)��(e)��(g)��ʾΪNi������������֯�仯ͼ����ͼ5(a)�ɿ�����Һ-�̵�Ǩ��1 h��Ni���γ��˽ϱ��IJ�״IMC����Ni/IMC�����ð���ƽ������IMC�ĺ��Ϊ0.65 ��m��EDX�����ⶨ��IMCΪ(Ni0.59,Cu0.41)3Sn4����ʱ��Cuԭ���Ѿ������ɢ��Ni����棬��������淴Ӧ��Һ-�̽��淴Ӧ1 h��Ni���������(Cu,Ni)6Sn5����IMC�������ͼ3(a)��ʾ��˵����Ǩ���谭��Cuԭ����Һ̬ǥ���е���ɢ��ʹ����������IMC��ΪNi3Sn4���͡���Һ-�̵�Ǩ��ʱ��2 hʱ������IMC�ĺ�����ӵ�1.23 ��m��EDX�����ⶨ��IMC��(Ni,Cu)3Sn4ת��Ϊ(Cu,Ni)6Sn5��˵����ʱ�����CuԪ���Ѿ�������ɢ��Ni����档��һ���ӳ���Ǩ��ʱ����4 h��(��ͼ5(e))�����洦��ͻ���ĸ�״�Ͳ�����Ŀ�״IMC���֣���ʱ��IMC�ĺ�ȴﵽ��1.42 ��m�� EDX�����ⶨIMC��Ϊ(Cu0.87,Ni0.13)6Sn5�������Һ-�̵�Ǩ��8 h��(��ͼ5(g))������IMC��Ϊ��״(Cu0.83,Ni0.17)6Sn5�������ȼ�С����0.64 ��m���ɴ˿ɼ��������Һ-�̽��淴Ӧ��˵�����ӷ������Լӿ�����Ni������ܽ⣬ʹ��Ni�����ò�ƽ��������������IMC�ĺ�������Ӻ��С����ͼ6��ʾ������Ҫ����������IMCs���ܽ��йأ����ڳ�ʼ��������IMC�ܱ�����������ԭ��ͨ�����������ԭ��ͨ�����Ӷ�ʹ����IMC�ĺ�����ӣ���IMC�ĺ�����ӵ�һ���ٽ�ֵʱ����������ԭ��ͨ����С�������ԭ��ͨ������ʹIMC�ĺ�ȼ�С������CHEN��[15]�о���Ǩ�ƶ�Cu/Sn/Cu��ͷ����IMCs������Ӱ����һ�µġ�

ͼ3 Cu/Sn-58Bi/Ni������170 ����Һ-�̷�Ӧ�����н��������֯�ݱ�
Fig. 3 Microstructural evolution of Cu/Sn-58Bi/Ni solder joints during liquid-solid interfacial reaction at 170 ��

ͼ4 170 ��ʱҺ-�̷�Ӧ�����н���IMC��������ѧ
Fig. 4 Growth kinetics of interfacial IMC during liquid-solid reaction at 170 ��
ͼ5(b)��(d)��(f)��(h)ΪCu������������֯�仯ͼ����Һ-�̵�Ǩ��1 h����ͼ5(b)��ʾ������IMC�ĺ��Ϊ2.23 ��m��EDX�����ⶨ��IMCΪ(Cu0.94,Ni0.06)6Sn5��(Cu0.94,Ni0.06)6Sn5������һ������Niԭ�ӡ�Һ-�̷�Ӧ1 h��Cu���������Cu6Sn5����IMC�������ͼ3(b)��ʾ��˵����Ǩ�Ƽ���������Ni���ܽ����ɢ��ͬʱ��Ǩ�ƴٽ���������IMC��������Һ-�̷�Ӧ2��4��8 hʱ(��ͼ5(d)��(f)��(h))��EDX�����ⶨ����IMC�Ա���Ϊ(Cu0.95,Ni0.05)6Sn5��(Cu0.96,Ni0.04)6Sn5 ��(Cu0.97,Ni0.03)6Sn5������IMC�ĺ�����α��3.31��5.54��6.11 ��m����ͼ6�е�����Cu��Ľ���IMC��������ѧ���߿�֪������Һ-�̵�Ǩ��ʱ����ӳ�������Cu�����IMC�ĺ�Ȳ������ӣ���������Ni���IMC��������ѧ��ͬ������Cu�����IMC���������������Ӻ��С����������Sn-Biǥ���е�Snԭ�������ɻ���������ϱ�����ʹ�ò�����淴Ӧ��SnԪ�ؼ��٣���BiԪ�ز���������淴Ӧ��

ͼ5 170 �桢5��103 A/cm2������Cu/Sn-58Bi/Ni������Һ-�̵�Ǩ�ƹ����н��������֯�ݱ�(������Ni����Cu)
Fig. 5 Microstructural evolution of Cu/Sn-58Bi/Ni interconnects undergoing L-S EM at 170 �� and 5��103 A/cm2 (electrons flowing from Ni side to Cu side)

ͼ6 170 ��������Һ-�̵�Ǩ�ƹ����н���IMC��������ѧ(������Ni����Cu)
Fig. 6 Growth kinetics of interfacial IMC during L-S EM at 170 ��(electrons flowing from Ni side to Cu side)
2.3.2 ������Cu������Ni��
ͼ7��ʾΪCu/Sn-58Bi/Ni������170 �桢5.0�� 103 A/cm2������Һ-�̵�Ǩ�Ʋ�ͬʱ��������֯�����Ӵ�Cu������Ni�ˡ�����ͼ7(a)��(c)��(e)��(g)ΪNi������������֯�仯ͼ����Һ-�̵�Ǩ��1 h����ͼ7(a)��ʾ��Ni���γ��˽Ϻ�IJ�����״IMC��EDX�����ⶨ��IMCΪ(Cu0.93,Ni0.07)6Sn5����ʱCuԭ����˳����ɢ�µ���Ni�������淴Ӧ���ı���IMC�����ͣ���ʱ�����״IMC�ĺ��Ϊ2.97 ��m��Һ-�̽��淴Ӧ1 h��Ni���������0.67 ��m��(Cu,Ni)6Sn5����IMC�������ͼ3(a)��ʾ�����ӷ������Լ�ǿ��Cuԭ����Һ̬ǥ���е���ɢ���ʣ�ʹ������Ni����IMC�����Һ�̷�Ӧʱ��4.43�����ӳ���Ǩ��ʱ�䵽2 hʱ����ͼ7(c)��ʾ������IMC����Ϊ(Cu0.94,Ni0.06)6Sn5�ͻ��������IMC�ĺ�ȱ��3.58 ��m���ӳ�Һ-�̵�Ǩ��4 h����ͼ7 (e)��ʾ������IMC����òû�����Ա仯��EDX�����ⶨ����IMCΪCu6Sn5����ʱ��IMC�ĺ�ȴﵽ��7.46 ��m��˵�����Ӵ�Cu������Ni�ˣ�������Ni���ܽ���ɢ����ˣ�ʹIMC�в��ٺ�Ni����Һ-�̵�Ǩ��8 h����IMC Cu6Sn5�ĺ�����ӵ�13.45 ��m��

ͼ7 170 �桢5��103 A/cm2������Cu/Sn-58Bi/Ni������Һ-�̵�Ǩ�ƹ����н�������֯�ݱ�(������Ni����Cu)
Fig. 7 Microstructural evolution of Cu/Sn-58Bi/Ni interconnects undergoing L-S EM at 170 �� and 5��103 A/cm2 (electrons flowing from Cu side to Ni side)
ͼ7(b)��(d)��(f)��(h)��ʾΪCu������������֯�ݱ䡣��Cu����������Կ�����Һ-�̵�Ǩ�Ƽ���������Cu���ܽ����ɢ��ʹ��Cu�������������ܽ����ò�ƽ����ͬʱ��Ǩ�ƴٽ�����������IMC������������Ǩ��ʱ��Ϊ1��2��4��8 hʱ��EDX�����ⶨCu����IMCһֱ����ΪCu6Sn5���ͣ�����IMC�ĺ�����α��1.66��1.82��2.14��3.15 ��m��
ͼ8��ʾΪ170 ��ʱҺ-�̵�Ǩ�ƹ����н���IMC��������ѧ����ͼ8�е�����Cu�����IMC��������ѧ���߿�֪������Һ-�̵�Ǩ��ʱ��IJ����ӳ�������Cu�����IMC�ĺ�Ȳ������ӣ����������������Ե�������Ni�����IMC����ͼ6��Ni��Ϊ������IMC��������ѧ������ȣ�˵����CuΪ����������£���Ǩ�Ƶļ���ЧӦ��Ϊ��������ͼ5��7�У����ŵ�������ʱ������ӣ�Sn-Biǥ����֯������֯ϸ���ʹֻ�����������Һ-�̵�Ǩ�Ʒ�Ӧ֮��ͬ����ȴ�ٶ���ɵġ�

ͼ8 170 ��ʱҺ-�̵�Ǩ�ƹ����н���IMC��������ѧ(������Cu����Ni)
Fig. 8 Growth kinetics of interfacial IMC during L-S electromigration at 170 �� (electrons flowing from Cu side to Ni side)
�ԱȲ�ͬ���������Ǩ�������µ�������������������Եó�����CuΪ����ʱ��Cu����������Һ-�̵�Ǩ�ƹ��������Ľ�Ϊ���أ�����NiΪ����ʱ��Ni�������Ľ�С����Cu�������������ġ�����Ҫ�����ڵ�CuΪ����ʱ����Cu���γɵĻ�����ʼ�սϱ���Cuԭ����˳����ɢ�º�������ɢ��Һ̬ǥ���У���Cu��Һ̬ǥ���еı����ܽ����Ni��3���࣬Cu����Ni���������ɽϺ��Cu-Sn�����ʹ��Cu���������ģ���Ǩ�������Cu��ɢͨ���ͻ�ѧ���ݶ������Cu��ɢͨ������һ�£���ˣ�Cu���ܽ��Ϊ���ء�����NiΪ����ʱ��Ni����洦�γɵ�IMC���Ҳһֱ�ܱ���������Һ̬ǥ���е�Ǩ���ٶȺͱ����ܽ�ȶ��Ƚ�С��������IMC��ΪCu-Sn�ͻ������ˣ�Ni�������Ľ�С��
������Һ-�̵�Ǩ�ƹ����У����۵���������Σ�ǥ���ڲ�û�з���Bi�ľۼ���������Cu/Sn-58Bi/Ni���Ժ����-�̵�Ǩ�������µĽ��[16]��ͬ��˵����Һ-�̵�Ǩ�������´��ںܶ�Ӱ��ͱ仯�����أ�Biԭ����Һ̬ǥ���е���ɢǨ���ٶȱ��ڹ�̬ǥ���еĿ�ܶ࣬Bi�ڵ�Ǩ��������������Ǩ�ƣ������������淴Ӧ����Sn�͵�Ǩ������ʹ���������渽��ǥ���е�Biԭ��Ũ�ȸ���������ģ���ˣ���ѧʽ�ݶ����Ǩ�Ƶ��µ���ɢͨ�������෴����С�൱��ʹ��Biԭ�Ӳ��ܴ���Ǩ�Ƶ��������渽���������ڷ�Ӧ���ɵĽ���IMC�ϱ������ĵ�Snԭ���٣���û�н϶��ʣ��Biԭ�ӣ���ˣ���ʹ��������IMC����Ҳû�г���Biԭ�ӵľۼ�����֯�ֻ������ȵ�����
3 ����
1) ������Cu��Niԭ��֮�䲢δ�����������ã���Ni���Cu����洦�ֱ��γ��˺ܱ��IJ�״Ni3Sn4��Cu6Sn5 IMC����Һ-�̽��淴Ӧ������(����)���������IMC��Ⱦ��淴Ӧʱ����ӳ������ӡ�Ni����棬Cuԭ���ڻ�ѧ���ݶȵ�������Ѹ����ɢ��Ni����棬ʹIMC��Ni3Sn4ת��(Cu,Ni)6Sn5���ͣ�Cu����棬IMC��Ϊ����Niԭ�ӵ�Cu6Sn5���͡�
2) ��������Ni����Cuʱ������Cu�����������(Cu,Ni)6Sn5 IMC����IMC�ĺ�ȳ������ӣ�����Ni������ϣ�һ������Cuԭ��������ӷ���������ɢ����Ni�࣬��������Ni��Ľ��淴Ӧ�γ�(Cu,Ni)6Sn5���� IMC��Ni�����IMC�ĺ�������Ӻ��С��Һ-�̵�Ǩ�ƹ����е��ӷ����ӿ���Cu��Niԭ�ӵĽ������á�
3) ��������Cu����Niʱ������Ni��������γ�(Cu,Ni)6Sn5����IMC����IMC�ĺ�ȳ������ӣ�����Cu����� IMCʼ��ΪCu6Sn5���ͻ���������������滯����ĺ�Ⱦ����Ǩ��ʱ����ӳ������ӣ���Ǩ��ͬ���ӿ���Cu��Niԭ�ӵĽ������á�
4) ���۵���������Σ�Sn-58Biǥ���о�δ����Bi�ľۼ���
REFERENCES
[1] CHEN C M, HUANG C C. Effects of silver doping on electromigration of eutectic SnBi solder[J]. Journal of Alloys and Compounds, 2008, 461(1/2): 235-241.
[2] MIAO H W, DUH J G. Microstructure evolution in Sn-Bi and Sn-Bi-Cu solder joints under thermal aging[J]. Material Chemistry and Physics, 2001, 71(3): 255-271.
[3] TU K N, ZENG K. Tin-lead (SnPb) solder reaction in flip chip technology[J]. Materials Science and Engineering R, 2001, 34(1): 1-58.
[4] ZHANNG F, LI M, CHEM C C, SHAO Z C. Effects of substrate metallizations on solder/underbump metallization interfacial reactions in flip-chip packages during thermal aging[J]. Journal of Materials Research, 2003, 18(6): 1333-1341.
[5] ������, ���״�, �� ��. Cu-Ni�������ö�Cu/Sn/Ni����Һ/�̽��淴Ӧ��Ӱ��[J]. �й���ɫ����ѧ��, 2013, 23(4): 1073-1078.
HUANG Ming-liang, CHEN Lei-da, ZHAO Ning. Effects of Cu-Ni cross-solder interaction on liquid-solid interfacial reaction in Cu/Sn/Ni solder joint[J]. Tractions of Nonferrous Metals Society of China, 2013, 23(4): 1073-1078.
[6] HE H W, XU G C, GUO F. Electromigration-enhanced intermetallic growth and phase evolution in Cu/Sn-58Bi/Cu solder joints[J]. Journal of Materials Science, 2010, 45(4): 929-935.
[7] CHEN C M, HUANG C C. Atomic migration in eutectic SnBi solder alloys due to current stressing[J]. Journal of Materials Research, 2008, 23(4): 1051-1056.
[8] HE H W, ZHAO H Y, GUO F, XU G C. Bi Layer Formation at the anode interface in Cu/Sn-58Bi/Cu solder joints with high current density[J]. Journal of Materials Science & Technology, 2012, 28(1): 46-52.
[9] HUANG M L, ZHOU S M, CHEN L D. Electromigration- induced interfacial reactions in Cu/Sn/electroless Ni-P solder interconnects[J]. Journal of Electronic Materials, 2012, 41(4): 730-740.
[10] CHEN C, TONG H M, TU K N. Electromigration and thermomigration in Pb-free flip-chip solder joints[J]. Annual Review of Materials Research, 2010, 40: 531-555.
[11] HUANG J R, TSAI C M, LIN Y W, KAO C R. Pronounced electromigration of Cu in molten Sn-based solders[J]. Journal of Materials Research, 2008, 23(1): 250-257.
[12] WU W H, CHUNG H L, CHEN C N. The influence of current direction on the Cu-Ni cross-interaction in Cu/Sn/Ni diffusion couples[J]. Journal of Electronic Materials, 2009, 38(12): 2563-2572.
[13] WU W H, CHUNG H L, CHEN C B, HO C E. Critical current density for inhibiting (Cu,Ni)6Sn5 formation on the Ni Side of Cu/solder/Ni joints[J]. Journal of Electronic Materials, 2010, 39(12): 2653-2661.
[14] ���״�. ��Ǩ����������Ǧ�����еĽ������ü����淴Ӧ�о�[D]. ����: ����������ѧ, 2011: 1-140.
CHEN Lei-da. Effects of electromigration on cross-solder interaction and interfacial reaction in lead-free solder joints[D]. Dalian: Dalian University of Technology, 2011: 1-140.
[15] CHEN L D, HUANG M L, ZHOU S M. Effect of electromigration on intermetallic compound formation in line-type Cu/Sn/Cu interconnect[J]. Journal of Alloys and Compounds, 2010, 504(2): 535-541.
[16] GU X, CHAN Y C. Thermomigration and electromigration in Sn-58Bi solder joints[J]. Journal of Applied Physics, 2009, 105(9): 701-705.
(�༭ ����)
������Ŀ��������Ȼ��ѧ����������Ŀ(51475072��51171036)
�ո����ڣ�2014-07-28�������ڣ�2014-12-11
ͨ�����ߣ������������ڣ���ʿ���绰��0411-84706595��E-mail: huang@dlut.edu.cn
ժ Ҫ�����ý��������Ʊ�Cu/Sn-58Bi/Ni���Ժ��㣬�о�5��103 A/cm2��170 ��������Һ-�̵�Ǩ�ƶ�Cu/Sn-58Bi/Ni���Ժ���Cu��Ni���������Լ����淴Ӧ��Ӱ�졣���۵���������Σ���Һ-�̵�Ǩ�ƹ����к��������Ϊ������ЧӦ������������������仯����(IMC)�������������һֱ�������������IMC����Ǩ�������ӿ���Cu��Niԭ�ӵĽ������á���������Ni����Cuʱ���ڻ�ѧ���ݶȺ͵��ӷ�������������£�Niԭ����ɢ������Cu�������淴Ӧ����(Cu,Ni)6Sn5����IMC��ͬʱһ������Cuԭ���ܹ�����ӷ���ɢ��Ni�࣬������淴Ӧ����(Cu,Ni)6Sn5����IMC����������Cu����Niʱ��������Cuԭ����ɢ��Ni�࣬��������淴Ӧ����(Cu,Ni)6Sn5����IMC��Ȼ����Niԭ��������ӷ�����������ɢ��Cu�࣬�Ӷ�ʹ����Cu�����ʼ��ΪCu6Sn5����IMC�����⣬���۵���������Σ������ڶ�û�г���Bi�ľۼ���


