���±�ţ�1004-0609(2012)06-1680-17
ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ��
�� ��1, 2�����̹�1���γ���1��������1��Ѧ�ɰ�3��������3��Ҷ ��3
(1. ����ʦ����ѧ ���繤��ѧԺ������ 221116��
2. ���տƼ���ѧ �Ƚ����Ӽ���ʡ���ص�ʵ���ң��� 212003��
3. �Ͼ����պ����ѧ ���Ͽ�ѧ�뼼��ѧԺ���Ͼ�210016)
ժ Ҫ��
ϡ��Ԫ��������ص����Ʊ���Ϊ�������ϵ�ά������ϡ��Ԫ�ص����ӿ����ڲ�ͬ�̶��������Ǧǥ�ϵ����ܡ���Ϲ������ں�ϡ��Ԫ����Ǧǥ���о�����������о��ɹ����ۺ�����ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ�죬������ϡ��Ԫ�ص���Ǧ����ɿ����о���״��Ϊ��ǥ�ϵ�ʵ��Ӧ���ṩ����֧�ţ���������ϡ��Ԫ�ض���Ǧǥ�ϱ��������Ӱ�죬̽��������������Ƽ�DZ�ڵ����⣬����ۺ�������ϡ����Ǧǥ�����о������д��ڵ������Լ���Ӧ�Ľ����ʩ��Ϊ��ϡ��Ԫ����Ǧǥ�ϵ��о���Ӧ���ṩ�������ݡ�
�ؼ��ʣ�
��ͼ����ţ�TG454 ���� ���ױ�־�룺A
Effect of rare earth on microstructures and properties of lead-free solders
ZHANG Liang1, 2, HAN Ji-guang1, HE Cheng-wen1, GUO Yong-huan1, XUE Song-bai3, GAO Li-li3, YE Huan3
(1. School of Mechanical & Electrical Engineering, Xuzhou Normal University, Xuzhou 221116, China;
2. Provincial Key Laboratory of Advanced Welding Technology, Jiangsu University of Science and Technology, Zhenjiang 212003, China;
3. College of Materials Science and Technology, Nanjing University of Aeronautics and Astronautics, Nanjing 210016, China)
Abstract: The rare earth (RE) elements due to its particular function were called the vitamin of metals, RE can greatly enhance the properties of lead-free solders in different degrees. Based on the development of lead-free solders bearing RE at home and abroad, the effect of RE on the properties and microstructures of lead-free solders was reviewed systematically. The recent progress of soldered joints reliability was expatiated, which can provide data support for the application of these lead-free solders bearing RE. Through analyzing the tin whiskers of lead-free solders bearing excessive RE, the growth mechanism and possible issues were discussed. The problems and difficulty in the process of the applications of lead-free solders bearing RE were analyzed synchronously, some suggestions were put forward which maybe solve the issues mentioned above, which may provide theory guide for the investigation of lead-free solders bearing RE.
Key words: rare earth; lead-free solders; reliability; whiskers
���ŵ��ӹ�ҵ�ķ�չ����ͳSnPbǥ������Pb�Ķ��Ա��������㷺��ע���ر���2003��ŷ�˹�����ν��WEEE��RoHSָ�����Ǧǥ�ϴ��洫ͳSnPbǥ�ϵ��о�Ѹ�ٷ�չ[1-3]����������Ǧǥ���У�SnAgCu[4-5]��SnCu[6-7]��SnAg[8-9]��SnZn[10-11] 4����Ǧ����Ϊ�����SnPbǥ�ϵ��������Ʒ��Ȼ����ϵ����Ǧǥ����Ȼ���и��Ե�ȱ�㣬��ǥ���ڲ����ڴ��Խ����仯�����(Cu6Sn5/Ag3Sn)�������������������������Լ������ڼ亸��Ŀ�ƣ�����ܽϵ� ��[12-14]��Ϊ�˽�һ�����ǥ�ϵ����ܼ�����ǥ�ϵ���֯������о���Ա�����Ͻ����о�������Ǧǥ�ϡ�
ϡ��Ԫ�ر���Ϊ����Ԫ�ص�ά��������Ϊ����һ������ϡ��Ԫ�ؿ�����߽������ϵ������Լ�������֯������ϡ��Ԫ����һ���ԣ�����о���ѡ��ϡ����Ϊǥ���Ͻ�Ԫ�أ�����20����90����������о���[15-16]��SnPbǥ��������ϡ��Ԫ�������������ܺ���߿ɿ��ԡ���ҲΪ��Ǧǥ�ϵ��з��ṩһ��˼·����ˣ���������ǰ�˵��о�������ѡ����SnAgCu�ȼ�����Ǧǥ�������Ӳ�ͬ��ϡ��Ԫ��[17-18]��ϡ��Ԫ�ص������������Ǧǥ�ϵ�ijһ�����ۺ����ܣ�������Ǧǥ�ϵ�ȱ��Ҳ��Ϊϡ��Ԫ�ص����ӵõ���ͬ�̶ȵĽ��������Ҳ����Ǧǥ�ϵ�Ӧ�ú��ƹ�������µ����⣺����[19]����ˣ���ϡ��Ԫ�ص���Ǧǥ���д��ڽ�һ�����о���̽�֡�
����������Ժ�ϡ��Ԫ�ص���Ǧǥ�ϣ��ۺ�����ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ�죬����ϡ��Ԫ�ص�Ӱ����ơ��Ժ�ϡ��Ԫ�ص���Ǧ����ɿ��Խ����ۺϷ�����ͬʱ̽�ֹ���ϡ��Ԫ�ض���Ǧǥ�ϱ�������������Ӱ�죬����̽�ֺ�ϡ��Ԫ����Ǧǥ�ϵķ�չ���Ƽ����ٵ���ս��Ϊ�˺�ϡ��Ԫ�ص���Ǧǥ�ϵ��о���Ӧ���ṩ����ָ����
1 ϡ��Ԫ�ض���Ǧǥ����֯��Ӱ��
1.1 �ڲ���֯
�о�ϡ��Ԫ�ضԽ������ϵ�����ɹ�����ڸֲļ���Ӧ�ã�ϡ����ǥ�����ϸ����е�Ӧ�ã�����˼·��ϡ��Ԫ���ڸ���Ӧ���о������ϡ�ϡ��Ԫ�ص����ӻ�ʹԭ����Ԫ����Ԫ�Ͻ��Ϊ��Ԫ����Ԫ�Ͻ�������Ҳ������ͺϽ���֯�������о������µ����⡣ͬʱ������֯���������Լ���Ӧ�ļӹ�����[20]������б�Ҫ�����о�ϡ��Ԫ�ض���Ǧǥ���ڲ���֯��Ӱ�졣
Sn3.8Ag0.7Cuǥ�ϻ�������Ҫ�ɦ�-Sn��Ag3Sn��Cu6Sn5��ɣ��о���[21]���ֻ�����֯�д��ڴ���Cu6Sn5�࣬���������Ϊ��-Sn�������κ˵㣬�����ϡ��Ԫ��(Ce/La)���ӵ�SnAgCuǥ�Ϻ�����֯����ϡ�����������ӵõ���ͬ�̶ȵ�ϸ������״˫�����֯����ʧ����ΪϸС�Ŀ�������ʹ��������˫������������֯��ͬʱ�����ϡ������Ϊ0.1%�Ժ�����֯��ʼ����ϡ����[22]����SnAgCu-RE��������������������Ϊ�⻬��ƽ����ͬʱ�����仯����ߴ��С��ϡ��Ԫ�غ�������ʱ�����仯��������[23]�����⣬��Sn0.7Cu0.05Ni�����ӻ��ϡ������������ϸ��ǥ�ϻ������֯������Cu6Sn5��ij������о��߲�δ��ǥ�ϻ����з���ϡ����[24]������ϡ��Ԫ�����������ڽ����仯���ᄃ���ı߽磬���ͽ����仯�����ڲ�ͬ���巽��������ٶȣ���˿��Խ��ͽ����仯����ı������������ݱ����������ۣ�ϡ��Ԫ�ص����ӿ���ϸ�������仯����ߴ�[25]��
��ϡ��Ԫ��Ce���Sn3.5Ag0.5Cu�����ڲ���֯�������Ե�ϸ������[26]����ϡ��Ԫ��Ce�����������о������Ƶ�����[27]������ͬ���ǣ�ϡ��Ce���Լ�С��-Sn����֦���ߴ�[28]����СCu6Sn5��Ag3Sn�����ijߴ�[29]��ϡ��Ԫ�ص����ӻ���ǥ�ϻ������γ�CeSn3�࣬���о��߱���Ce������SnЧӦ������Sn�Ļ�ȣ���СSn������Ԫ�ؽ�ϵ�����������Ҳ��Ceʹ�����仯�����С����֯ϸ������Ҫԭ��[30]��Ԫ��Y���ӵ�Sn3.8Ag0.7Cuǥ�Ͽ�������ϸ��ǥ����֯��ͬʱSnAgCuǥ���ڲ��������仯����ijߴ�õ����Եļ�С�����ȵطֲ���Sn������[31]�����⣬SHI��[32]�о�ϡ��Ԫ��Er�����Ӷ�Sn3.8Ag0.7Cu��֯��Ag3Sn��Cu6Sn5������֯��ϸ�����ã���������ijߴ���õ����Եļ�С��ͬʱGAO��[33-34]�о�����Pr/Nd��Sn3.8Ag0.7Cuǥ����֯��ϸ�����ú�Ce��La��ϡ��Ԫ�����ơ�
��Sn3.5Agǥ��������ϡ��Ԫ��Lu����֯�г���LuSn3ϡ���࣬ϡ��Ԫ�ص����ӿ��Դٽ�ǥ�ϺͰ뵼�����֮��Ļ�ѧ��Ӧ[35-36]����SnAgǥ���м���ϡ��Ԫ��La����-Sn�ľ����ߴ��Ag3Sn�����õ����Եļ�С������ǥ�ϻ����й��������������������ǥ������ʧЧ���̵���֯�ȶ���[37]����ϡ��Ԫ��Ce��������һ���̶��ϸ���Sn1.0Agǥ�ϵĻ�����֯������ϡ��Ce�����ӣ�Sn1.0Agǥ�ϵ���֯�õ�����ϸ����ϡ��Ԫ��Ce������������ﵽ0.5%[38]��ͬʱ��CHEN��[39]�ͺ���[40]��ͼ��Sn-9Znǥ��������ϡ��Ԫ��Ce����������ǥ�ϻ�����֯��ϸ��ǥ���еĸ�Zn�࣬����Sn-Ce�γɵ����������Ե���Zn-Ce������ģ���ˣ�����������������γ�Sn-Ce�����ͬʱ��ϡ��Ce�����ӹ���ʱ��ǥ�ϻ�����֯�г������Ե�Sn-Ce�����ϡ��Ԫ��Ce���ӵ�Sn0.7Cu0.5Niǥ����Ҳ�������ƵĹ���[41]��
1.2 ������֯
��ǥ�������У��ۻ���ǥ������巢����Ӧ���ڽ��洦�γɽ����仯����㡣�����仯������γ�һ�������ǥ�������ɿ�����ǥ��ͨ������巴Ӧ�γɽϱ��Ľ����仯����������ڻ�����õ�ұ���ϣ���һ���棬�������仯�����̫����ή�ͺ���Ŀɿ���[42-44]����ϡ����Ǧǥ�ϵĽ��淴Ӧ�Լ�ϡ��Ԫ�ضԽ���Ӱ����Ƴ�Ϊ����о��������ȵ㡣
���ϡ��(Ce/La)�����Ӷ�Sn3.5Ag0.7Cu/Cu���������ٶ����������������ã�170 ��ʱЧ�����У�ϡ��Ԫ�ص��������ý�Ϊ����[45]����Sn2.5Ag0.7Cuǥ ��������0.1%�Ļ��ϡ����������Ч����ֹǥ��������Cu6Sn5�����仯���������������ϡ��Ԫ�ص���Sn�ԣ�����Sn��Ӧ����Sn-Cu��Ӧ�Ļ���[46]��ϡ��Ԫ��Er�����ӿ��Խ���Sn3.8Ag0.7Cu/Cu�����ĺ�ȣ����ҽ�������̬Ҳ�������Եı仯[47]��YԪ�ص����ӿ��Լ�СSn3.8Ag0.7Cu/Cu���������仯����ĺ��[31]�����к�ϡ��Ԫ��Er�����Ƶ�Ч����ϡ��Ԫ��La��Sn3.0Ag0.5Cu/Cu���������֯Ҳ�����Ե�Ӱ�죬ǥ��������γɵ�Cu6Sn5�������ĺ�Ⱥ�ƽ������ֱ������ǥ�ϺϽ���La ���������Ӷ��� С[48]������Cu6Sn5��Cu3Sn���ܺ����ʱЧʱ������Ӷ���������ͬ��ʱЧ�����£���La ���������Ӷ���С��IMC ��ʱЧ��������������ѧ��ʱ��ϵ��n ����La ������������������Sn3.9Ag0.7Cuǥ��������ϡ��La�����������仯����ĺ�ȼ�С60%[49]��ϡ��Ԫ��CeҲ���Խ���Sn3.8Ag0.7Cu/Cu������[50]��ͬʱ�ڷ����ڼ䣬�����������Եķֲ�������Cu6Sn5��Cu3Sn��������仯������㻯�����Ⱦ���ϡ��Ԫ��Ce�����Ӷ��õ���С[51]��ϡ��Ԫ��Pr/Nd�����ӿ��Լ�СSnAgCu/Cu�����ĺ�ȣ��������ӹ���ʱ�������ĺ�ȷ����������ӣ�ͬʱ�ڽ��渽�����ִ���ϡ����[33-34]��
δ����ϡ��Ԫ�ص�����£����ϡ��(Ce/La)��Sn9Zn/Au/Ni/Cu���渽�����ִ���AuSn4��Au-Zn���ֻ�����[52]����������0.5%ϡ������û�г����������ִ��Ļ����ȡ����֮����һ������Au-Zn�㣬����ʱЧʱ������ӣ���һ�㻯����ĺ��Ҳ����֮���ӣ����о��߲�δ����ϡ��Ԫ������ǰ��ñ仯��ֱ��ԭ��Sn9Zn-xCe/Cu������֯ΪCu5Zn8�࣬û�з���Cu-Sn�����ͬʱ����ϡ��Ce�����ӽ����ĺ���������ӣ���ϡ��Ԫ��Ce������Ϊ0.5%ʱ�������ĺ����δ����ϡ��Ԫ�ؽ����ȵ�5������Ҫ������ϡ��Ԫ�ص���Sn�ԣ��ٽ�ZnԪ������洦��ɢ[39]��XIAO��[53]��HU��[54]ѡ����Sn9Znǥ��������ϡ��Ԫ��Pr/Nd�����ֽ���������������ʵ�����ϡ��Pr/Nd�Ļ����ϵõ����ƣ��о����������ϡ��Ԫ��Ce[39]�ƺ���ȫ�෴�����ڴˣ���ϡ����Sn9Znǥ�ϵĽ�����֯�ݻ������д��ڽ�һ���о���ϡ��Ԫ��La�����ӻ��Sn3.5Ag�������������Ե�Ӱ�죬ͼ1��ʾΪ����150 ��ʱЧʱ������֯ͼ[55]����ͼ1���Կ���������SnAg/Cu����Cu6Sn5����������ȱ�״������ϡ��Ԫ��La����������Լ�С��ͬʱҲ��ý�Ϊƽ����������ǥ��������LaSn3�࣬������ǥ�����̹����г䵱�����κ˵�����[56]��ͬʱ������150 ��ʱЧ625 hʱ����������������ӣ�SnAg/Cu�������Ϊ5 ��m��SnAgLa/Cu�������Ϊ3 ��m����һ��˵��ϡ��La�������ƽ�����������
��Ǧǥ�Ͻ��淴Ӧ��Ϊϡ��Ԫ�ص����Ӷ��������Եı仯��������Ҳ��һ���̶�˵����ϡ��Ԫ���ڽ��淴Ӧ����������Ҫ���á�����о��߲�����ɢ����ѧ��������۽���ϡ���Խ����������Ӱ�졣�����仯������γɶ���������Ԫ�ɷֵĻ��Ծ����ģ�����Cu6Sn5�����仯������˵���伪��˹�����ܦ�G�ɺ�����SnԪ�صĻ��Ծ���[13, 57]��
![]() (1)
(1)
ʽ�У�RΪĦ�����峣����TΪ�����¶ȣ�![]() ΪSn�Ļ�ȡ�
ΪSn�Ļ�ȡ�
Cu6Sn5��Ҫ������Cuԭ�Ӵ�Խ�����仯���� �㣬��ɢ�������仯����/ǥ�Ͻ��棬��Sn��Ӧ�� ��[58]��Cu6Sn5�ļ���˹�����ܦ�G����Ҫ����Cu6Sn5/ǥ�Ͻ��洦Sn�Ļ�Ⱦ�������ˣ�����Sn�Ļ�������ƽ�������仯�������Ч�ֶΡ���������о� ��[59-60]��������ѧ���о����������ϡ��Ԫ�ؾ�����Sn�ԣ���Cu-Sn����㽵��Sn�Ļ�ȣ�����Cu��Sn�ķ�Ӧ���ᣬ��һ�����������Cu6Sn5��������
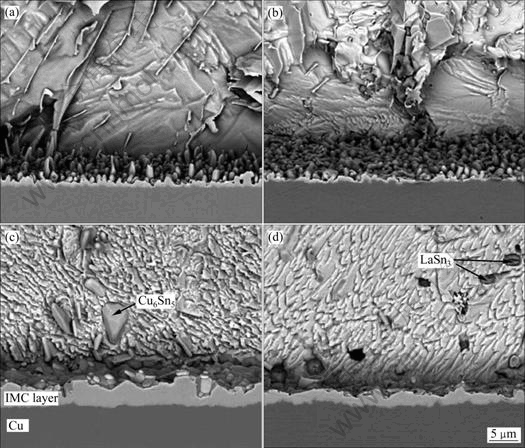
ͼ1 SnAgxLa/Cu������֯[55]
Fig. 1 Interface microstructures of SnAgxLa/Cu[55]: (a) Sn3.5Ag (as soldered); (b) Sn3.5Ag0.5La (as soldered); (c) Sn3.5Ag (150 �� for 625 h); (d) Sn3.5Ag0.5La (150 �� for 625 h)
2 ϡ��Ԫ�ض���Ǧǥ�����ܵ�Ӱ��
��Ǧǥ����֯�ı仯ֱ�Ӿ������ܵı仯������ϡ��Ԫ�ص����ӣ�ǥ�ϻ�����֯��ϸ���ͽ����ṹ/��ȵı仯ֱ�Ӿ���ϡ��Ԫ�ص����ӿ��Ը���ǥ�ϵ����ܣ�������ʪ�ԡ���ѧ���ܺ�������ܵȡ�ͬʱ��Ҳ������о���[21-22, 31, 61-62]����ϡ��Ԫ�ص����Ӷ���Ǧǥ���ۻ����Ե�Ӱ�죬����ϡ��Ԫ�ص����Ӷ�ǥ�ϵ��ۻ��¶ȼ���û��Ӱ�졣��ˣ��ڸò�����Ҫ����ϡ��Ԫ�ض���Ǧǥ����ʪ�ԡ���ѧ���ܺ�������ܵ�Ӱ�졣
2.1 ��ʪ��
ǥ����ʪ����ָһ��Һ̬ǥ����ĸ�ı�����չ������[63-64]������ǥ����˵���ܷ�������γ����õĽ��������ǥ���Ĺؼ�, Ϊ�˱�֤ǥ���ι̣�ǥ�ϱ���ܺõ���ʪ������ϡ��ʹ�ͳ��SnPbǥ����ȣ���Ǧǥ�ϴ���һ���ϴ��ȱ�ݣ���ʪ�ԲӰ��ǥ����ʪ�Ե���Ҫ����[65]��ǥ�Ϻ�ĸ�ĵijɷ֡��¶ȡ����������������������ĸ�ı����״̬������������ʵȶ�ϡ��Ԫ�ص�������һ���̶��Ͽ��Դ�����������Ǧǥ�ϵ���ʪ��չ���ܡ�Ŀǰ�������Ǧǥ����ʪ�Բ�����Ҫ��4���ԱȲ�������ʪʱ�䡢��ʪ������ʪ�Ǻ���չ�����
��Sn3.5Ag0.7Cuǥ��������0.1%���ϡ��(Ce��La)��ǥ��/ǥ�����������õ����ԵĽ��ʹӶ��ٽ�ǥ�ϵ���ʪ�������ӹ�����ϡ������ʹǥ�ϵ���ʪ�Զ�����Ҫ��������ǥ��������ǥ�ϱ�������� ��[45]����Sn3.5Ag0.7Cuǥ��������0.1%���ϡ����ǥ�ϵ���ʪ���õ���������ߣ�ͬʱ����ʪ������С��Sn2.5Ag0.7Cu��Sn3.5Ag0.7Cu��Sn3.5Ag0.7Cu0.25RE��Ǧǥ�ϵ�[66]��ϡ��Ԫ��Ce���ӵ�Sn3.0Ag2.8Cuǥ�Ͽ��������������չ���������������Ϊ0.1%[67]������Sn3.8Ag0.7Cu�����������ʪ�Բ��ԣ�����ϡ��Ԫ��Ce�����������ǥ�ϵ���ʪ�ԣ����������Ϊ0.03%[68]����N2���ձ�����Ҳ����ϡ��Ԫ��Ce���Ƶ�����[69]�����о���ѡ����Sn3.0Ag0.5Cu������0.05%Ce������ϡ��Ԫ�ض�ǥ�ϵ���ʪ�������ԵĶ�����[70]���о���������е�����ǡǡ�෴���������ϡ��Ԫ�ص����ӹ��յ��µģ�Ŀǰ���ںϽ�������ϡ��Ԫ����ֱ�����Ӻ��м�Ͻ��������ַ�ʽ�����������ַ�ʽ����ע��ǥ����ұ�����̵ı�������ֹ������Sn3.8Ag0.7CuxY����ϡ��Ԫ��Y���ı仯��ʪ�������ԵĴٽ����á�Y����������Ϊ0.15%[31]������������������ʪ�Ի������½�����Ҫ������ϡ��Ԫ��Ϊ����Ԫ�أ�ϡ��Ԫ��������ǥ��/ǥ�������ۻ����������ͽ��������ܣ����ǹ�����ϡ�����׳�������������ǥ�ϱ���ı�������������ǥ�ϵ���ʪ�ԡ�
SnAgREǥ�ϵ���ʪ�Ժͻ��ϡ��������֮��������Եķ����Թ�ϵ�� ��ϡ��Ԫ��������Ϊ0.5%ʱ����ʪ�Ǵﵽ��С(32���2��), ��ϡ������������1.0%����ʪ���������ӡ���һ��˵����SnAgǥ�������ӻ��ϡ��Ԫ�ص����������Ϊ0.5%[71]������, ���о��߷��֣�Sn3.5Ag������0.25%RE�����������ǥ�ϵ���ʪ������ʪ����Ϊ�ӽ���ͳ��SnPbǥ�ϵģ���ʪʱ��Ϊ0.6s[72]������ϡ��Ԫ��Ce��Sn1.0Ag��ʪ��Ҳ�������Ƶ�Ӱ�죬ϡ��Ce����Ѻ���Ϊ0.3%[38]��ϡ��Ԫ��Ce�����Ӷ�Sn7Ag10Sb��Sn3.1Ag8.0Bi2.1- Cu1.7In����ʪ��Ӱ�����Ѻ���ҲΪ0.3%������������ϡ��Ԫ�ز�����������ǥ�ϵ���չ������ҿ��Ի�ý�Ϊ�����ĺ��������ò[73]��
���ϡ��Ԫ��(Ce/La)������������Sn0.7Cuǥ�ϵ���ʪ�ԣ��о��߰�ϡ��Ԫ�ؿ�����0.5%[74]��Sn0.5Cu0.05Niǥ�ϵ���ʪ�Խϲ����ϡ��Ԫ��Ce�Ժ�ǥ�ϵ���ʪ��������ߣ���ͭ����������ͬ���¶��¿�ʹ��ʪʱ������10%~45%[13]����N2���������£���ʪʱ������20%~50%[75]��N2���������Լ������������γ�[76]��������������ǥ����ʪ����ֹ�����о���ѡ��ϡ��Ԫ��Ce���ӵ�Sn0.7Cu3Biǥ�ϣ�����ϡ��Ԫ�ص����������Ϊ0.03%~0.05%��ǥ�ϵ���ʪ����һ�������[77]��
���ϡ�������������Sn9Znǥ�ϵ���ʪ��[78]��ͬʱ����ʵ���ǥ��Ч������[79]����ˣ����о���[80-81]���ѡ�����˵�ǥ�������ֲ���Ǧǥ����ʪ�Խϲ��ȱ�ݡ���Sn9Zn����CeԪ�أ����ӷ�ΧΪ0.05%~ 0.07%ʱ����ʪ����ѣ���Ҫ��ϡ��Ԫ��Ce�DZ������Ԫ�أ��ɽ���Һ̬ǥ�ϵı���������������ʪ�ԣ�ͬʱCe��ѧ���ʻ��ã�����������������������ϴ�ʱ�����渻����Ce�������������ʽ���ڣ��Ӷ���ǥ����ʪ��[14]��Sn9ZnCeǥ�ϵ���ʪ��Ҳ��Ϊǥ��ѡ��IJ�ͬ����ʪ������ʪʱ����кܴ�IJ�𣬵�ȴ������ͬ�����������[82]��ͬʱ�����о� ��[83]ѡ��ı�ǥ����Ũ�ȣ�SnZn-xLa����ʪ��Ҳ��֮���ӣ�La���������Ϊ0.3%��ϡ��Ԫ��Nd��La������������Sn8Zn3Biǥ�ϵı���������Nd��Ч��Ҫ����La��[84]��ϡ��Ԫ��Nd��Sn8Zn3Bi����ʪ�Ծ������ԵĴٽ����ã���Nd��������Ϊ0.1%ʱ��ǥ�ϵ������չ���Ϊ39.6 mm2����Ϊ�ӽ���ͳ��SnPbǥ�ϵ���չ��ʪ��(�����չ���Ϊ42.2 mm2)[85]�����о���[86]������ϡ��Ԫ��La��Sn8.9Zn2.7Bi1.0Ga- 0.5Cu0.2La��Ǧǥ�ϣ�����ʪ��Ϊ25.1�㣬����La�ͺϽ�Ԫ��Ga�ĺ�����SnZnBiϵ��Ǧǥ�ϵ���ʪ�����нϴ�Ӱ�졣
2.2 ��ѧ����
�ڼ��ɵ�·�У������ڷ����ڼ伴�е��������������֮��ĵ������ӣ�Ҳ�е���һ���Ļ�е֧������[87]����ˣ���ʵ�ʵ�ʹ���У���Ǧǥ�ϱ���߱��ϸߵ���ѧ���ܲ��ܱ�֤����Ļ�е֧�����á�Ŀǰ�������Ǧǥ�ϵ���ѧ���ܲ�����Ҫ���������졢���к�ѹ��3�����飬������Ʒ��ǥ�ϻ��ߺ���������ʽ��ͬʱ�ڳߴ���Ҳ�д�ߴ����ģ�⺸���С�ߴ������ˣ���ͬ���������Ϊ��ͬ�������ߡ���ͬ�������豸�Լ���ͬ��������Ʒ�ߴ��ԭ��Ҳ��õ���ͬ���������ݡ�����Ǧǥ����ѧ���ܲ����У���ߴ�ǥ��������Ӧ�ý�Ϊ�㷺��һ�����鷽������1����Ϊ4�ֳ�����Ǧǥ��������������[88-89]��
��1 ����������������[88-89]
Table 1 Tensile testing data of lead-free solders[88-89]

���ϡ��(Ce/La)ʹSn3.8Ag0.7Cu ǥ�ϵĿ���ǿ�ȵ��������, �Ե���SnPb ǥ��, �쳤���нϴ�����, ��߿ɴ�30%������ϡ������������, ������, ��ϡ��Ԫ�ص�����������0. 25 % ʱ, ������SnAgCu ˮƽ����Ҫ��ϡ����ij��ֶ���ǥ�ϵ�����[90]�����о���[91]�Ա��о�SnAgCu��SnAgCu0.1RE����ļ���ǿ�ȣ�����SnAgCu0.1RE����ļ���ǿ������С��SnAgCu�ģ�������ʱЧ�����з��֣�ϡ�����Խ���SnAgCu����ļ��������ӻ��̶ȡ�ϡ��Ԫ��Er�����ӿ������Sn3.8Ag0.7Cuǥ�ϵļ���ǿ ��[32]����������Ϊ0.1%ʱ��ǥ�ϵļ���ǿ����߽�18%����Er������������0.5%ʱ��ǥ�ϵļ���ǿ�������½���������ֵ��Ȼ����SnAgCuǥ�ϵġ�ϡ��Ԫ��Y��Sn3.8Ag0.7Cu�������ǿ�Ⱥ�����ǿ�Ⱦ�������Ӱ�죬��Y��������Ϊ0.15%ʱ���������ѧ���ܴﵽ���ֵ[31]���о�����Ϊ����Ҫ��ϡ��Ԫ���������йأ���������������������ܡ�ϡ��Ԫ��Ce��QFP����Sn3.8Ag0.7Cu����������������ԵĴٽ����ã�Ce�����������Ϊ0.03%[68]�����SnAgCu���㣬SnAgCu0.03Ce�����������(QFP100)�ͼ������ֱ����12.06%��10.31%[13]������0.05%ϡ��Nd�����������Sn3.8Ag0.7Cuǥ������������������ֵ���ӽ�19.4%[34]��
���ϡ��(Ce/La)���ӵ�Sn3.5Agǥ�ϣ��������ǥ�ϵ���ѧ���ܣ�0.5%�Ļ��ϡ�������������ǥ�ϵ������ǿ�ȣ�ϡ��������Ϊ1.0%ʱ��������ѱ���������Ե�ϡ���࣬��ǥ�ϵ�����[70]����BGA����Sn3.5Ag��Sn3.5Ag0.5RE������м��в��ԣ�����Sn3.5Ag0.5RE����ļ���ǿ�����Ը���Sn3.5Ag�ģ�˵��ϡ��Ԫ�ص����ӿ���������ߺ����ǿ ��[92]��Sn3.5Ag����ϡ��Ԫ��La��������亸���ǿ�ȣ�ϡ��Ԫ��LaΪ1.0%ʱ������ǿ�ȵõ����Ե����[93]����AgCuTi��Ԫ�Ͻ���Ҳ��������ϡ��Ԫ��La�������ѧ���ܵ�����[94]����Sn3.5Ag��Sn0.7Cu��Sn9Zn��Ǧǥ�����ӻ��ϡ��(Ce/La)�������������������ͼ2��ʾ(��Ӧ����Ϊ0.005 s-1�������²���)�����Կ��������ϡ�������ӿ����������3����Ǧǥ�ϵĿ���ǿ��[95]��0.25%RE����ʹ Sn3.5Ag����������ǿ�����20%��0.5%RE����ʹSn3.5Ag����������ǿ�����27%[96]��ϡ��Ԫ��Ce�����ӿ����������Sn0.5Cu0.05Ni�����ܣ���߷�ֵ��ΧΪ12.27%~25.78%[13]����Ce��Sn9Zn����ѧ����Ҳ��һ���Ĵٽ����ã�Ce�����������Ϊ0.08%��ͬʱ���������27.6%[82]��Ҳ���о���ѡ���о�Sn9Zn-xLa/Cu (x=0.1��0.2��0.3��0.4��0.5)����ļ���ǿ�ȣ�����ϡ��Ԫ��La�����ӽ���SnZn����ļ���ǿ�ȣ����о���[83]��Ϊ��LaԪ�ؼ���SnZn�У�La��������Խ�ǿ��Zn����γ�Zn5La�࣬��La�ĺ�������0.3%ʱ���Ͻ��л���������̬��La��Zn5La���γɽ��ͽ���Cu5Zn8�γɵĻ��ᣬͬʱ����̬��LaҲ���������Ӷ����ͺ���ļ���ǿ�ȣ�Ȼ��ȴ��û�и��������Zn5La������La����֯ͼ��ͬʱ�о���[10, 14, 18-19, 22, 49, 52, 82]�Ѿ�֤ʵ��ϡ��Ԫ����Sn�ԣ�����Sn-ϡ����ļ���˹�����ܱ�Zn-ϡ���ͺ� �࣬�Ӷ�Ҳ˵����ϡ��Ԫ��������Sn��Ӧ��ͬʱ�о���[10, 14, 18-19, 22, 49, 52, 82]Ҳ�����˾����ϡ������֯������һ��������Ҳ����Sn9Zn-xLa��Zn5La������La�Ĵ��ڡ�����ϡ��Nd�����������Sn8Zn3Bi��ѧ���ܣ����ӹ���ʱ��ѧ���ܻ������½���ͬʱϡ����������0.10~0.15��Χʱ���쳤����߽�30%[85]��

ͼ2 ��Ӧ�������º�ϡ����Ǧǥ�ϵĿ���ǿ��[95]
Fig.2 Tensile strength of three lead-free solders with rare earths (at constant strain rate of 0.005 s-1)[95]
2.3 �������
�����ָ�����ڸ��º͵��ڲ��Ϻ����������Ӧ���·����Ļ��������Ա��Ρ�����SnAgCu��SnZn��SnCu��SnAg����Ǧǥ�ϣ�����ǥ���۵�ϵͣ������£������¶��Ѿ����Գ����۵��0.5��[97]����˸�ϵ����Ǧǥ���ڷ����ڼ�������ΪӦ�Ǹ�����䡣
Sn3.8Ag0.7Cuǥ�������ӻ��ϡ��(Ce/La)�������������������õ����Ե���ߣ��������£�ϡ��Ԫ�غ���Ϊ0.1%ʱ��������������ﵽ��ߣ��ﵽSnAgCu��7�����ϣ�ϡ��Ԫ�ص�����������1.0%��������������½����ҵ���SnAgCu����[62]��ͬʱ���о���[98]����SnAgCu/SnAgCuRE���ֺ������̬��䱾�����̣����������緽��(2)~(5)��ʾ���о�����������ڵ�Ӧ����Ӧ���£�SnAgCuRE�����Ӧ��ָ���������ܶ�����Ӧ��SnAgCu����ĸߡ������о���[99]���֣���ϡ��Ԫ�ص�SnAgCu��Ǧǥ�������Ϊ��Ҫ��Ag3Sn�������ƣ����ϸߵ�Ӧ��������Ҫ������ϡ����Ĵ��ڡ�
SnAgCu������������£�
1) ��Ӧ���£�
![]() (2)
(2)
2) ��Ӧ���£�
![]() (3)
(3)
SnAgCuRE������������£�
1) ��Ӧ���£�
![]() (4)
(4)
2) ��Ӧ���£�
![]() (5)
(5)
ʽ�У�![]() ΪӦ�����ʣ�GΪ���б�����TΪ�����¶ȣ�
ΪӦ�����ʣ�GΪ���б�����TΪ�����¶ȣ�![]() Ϊ��������RΪĦ�����峣����
Ϊ��������RΪĦ�����峣����
��Sn3.8Ag0.7Cuǥ��������Er�����������������������������0.1%Er�Ŀ���ʹǥ�ϵ����������������7.1����Er������������0.25%ʱ��������������½���Er��������������Ϊ0.05%~0.25%[32]��ϡ��Ԫ��Ce�����ӿ����������Sn3.0Ag2.8Cu�����������ܣ����������Ϊ0.1%Ce�����������߽�9��[66]����ϡ������ϸ����֯�����;���߽�Ӧ�䣬Ԥ���ն��κ�[96, 100]���������������������ߡ���ϡ��Ԫ��Ce����������0.1%�����ڴ��ϡ����(Ӳ����)���γɣ���������������������½�����Sn3.8Ag0.7Cuǥ����������ϡ��Ԫ��Ce���Խ�����Ķ������������ߵ�SnAgCu��7.5��[29]��ͨ��������������о�SnAgCu��SnAgCuCe������Ǧǥ�ϵ������Ϊ��ZHANG��[101]��������ǥ�ϵ�Dorn��Garofalo-Arrhenius��̬���ģ�ͣ����ֱ���������ʽ(6)~(7)������SnAgCuCe����伤�������Ը���SnAgCu�ģ���Ҫ����Ϊϡ��Ԫ��Ceϸ��ǥ�ϻ����еĽ����仯���������ͬʱSnAgCuCeǥ�ϵĿ��������Զ����SnAgCuǥ�ϵġ�
Dorn ģ�ͣ�
![]() (6)
(6)
ʽ�У�AΪ����ϵ����QΪ�����ܡ�
Garofalo-Arrheniusģ�ͣ�
![]() (7)
(7)
ʽ�У�![]() Ϊ������Ӧ�����ʣ�CΪ����ϵ����
Ϊ������Ӧ�����ʣ�CΪ����ϵ����![]() ΪӦ��������
ΪӦ��������
���ϡ��Ԫ��(Ce/La)���ӵ�Sn3.5Agǥ�ϣ������������Ҳ������Ӱ��[72]��Sn3.5Ag�ڲ�ͬ�¶���(393��348��303 K)��Ӧ�����ӷֱ�Ϊ9.9��11.3��12.3����Sn3.5Ag0.25REǥ�϶�Ӧ��Ӧ������Ϊ9.05��12.04��12.08������ǿ���Ͻ���ֳ���Ӧ������[102-103]��Sn3.5Ag��Sn3.5Ag0.25RE����ǥ�ϵ��������¶ȵķ�Χ�ڵ������ΪҲ֤ʵΪ����ǿ������[72]�����ϵ�������ʺ�����ǿ���Ͻ���֯�Ĺ�ϵ���Ա�ʾΪʽ(8)[104]��������ʺ�![]() �����ȣ���ϡ��Ԫ�����ӵ�SnAgǥ���У������仯��������ijߴ�ͼ��õ����Եļ�С����˻��ϡ����߲��ϵ���俹�������о���[105]ѡ��һϡ��LaΪ����Ԫ�أ�����ϡ��Ԫ��La����ʹSn3.5Agǥ�ϵ���俹����߽�15%��
�����ȣ���ϡ��Ԫ�����ӵ�SnAgǥ���У������仯��������ijߴ�ͼ��õ����Եļ�С����˻��ϡ����߲��ϵ���俹�������о���[105]ѡ��һϡ��LaΪ����Ԫ�أ�����ϡ��Ԫ��La����ʹSn3.5Agǥ�ϵ���俹����߽�15%��
![]() (8)
(8)
ʽ�У���Ϊλ���ܶȣ�bΪ����ʸ������Ϊ����λ�������ϰ���֮��ļ�ࣻ��tΪԽ���ϰ����ʱ�䣻![]() Ϊ�������ϵĿ��������
Ϊ�������ϵĿ��������
Sn0.7Cu0.5RE(Ce/La)ǥ�ϵ���俹�����Ը���Sn0.7Cuǥ�ϵģ����ϡ�������������Sn0.7Cuǥ�ϵ��������[72]�����ϡ����Sn9Znǥ�ϵ�������ܵ�Ӱ��Ҳ�������ƵĹ��ɡ�ϡ��Ԫ�ؿ��Լ�Сǥ�ϻ�������仯����ߴ磬������������ƣ�����˺���������[106]��ͬʱϡ��Ԫ�ؿ��Խ��;����߽��ܺͽ����ܣ���ֹ�����߽绬�ƺ�λ���ƶ�[107]���ʶ���ϡ��Ԫ�ؿ������ǥ�ϵĿ�������ܡ�ͨ��ѹ���������о�Sn9Zn-xRE(x=0.1%��0.25%��0.5%)�����Ϊ������Sn9Zn0.25RE�����������ͣ���������ߵ���俹������������ܽϸ���Ҫ������������ϡ������Ϊǥ�ϻ����е�ǿ���࣬��ϡ����������0.25%ʱ����俹���ϵ���Ҫ������Sn-Zn-RE�����仯������γɵ���ǥ�ϻ����и�Zn��������������[108]��ϡ��Ԫ�ض�SnBiǥ�ϵĿ�������ܵĴٽ����ú�Sn9Zn0.25REǥ������[109]��
3 ��ϡ��Ԫ����Ǧ����ɿ���
��Ǧǥ�ϵ���ʪ������������ѧ���ܽϺ��Լ��ϸߵĿ�������ܣ�����ֻ��˵����Ǧǥ���ں���ǰ��������������ܣ����Ǻ�ʵ��Ӧ������һ�ξ��롣��Ҫ����Ϊ����ķ����ڼ������������벻��������֣����磬��Ϊ��������������͵�·������ṹ֮�����������ϵ���IJ��죬���ڵ��Ӳ�Ʒ���ڵĿ�-�أ������ṹ�л���ֽ�����¶ȳ������ڵ����оͻ��ں����е�����Ӧ���Ĵ��ڣ��ڳ�ʱ��������ʹ���㷢��ƣ���ƻ�������ʹ���Ӳ�ƷʧЧ[110-111]����ˣ��б�Ҫ�ں�ϡ����Ǧǥ����ʵ��Ӧ�ú��ƹ�֮����к���Ŀɿ����о���Ŀǰ��Ҫ��ȡ�������ֵģ�����ַ��������Ǧ����ɿ�����Ҫ��������ѭ����ʱЧ������������ȷ�������о���������Ժ�ϡ����Ǧ����ɿ��Ե��о���Խ��١�
��150 ���Sn2.5Ag0.7Cu��Sn2.5Ag0.7Cu0.1RE���ֺ������ʱЧ�о������ֺ���Ľ��������仯����Cu6Sn5�ĺ������ʱ������ӳ��������ߵ�����SnAgCuRE����Ľ���������ٶ�����С��SnAgCu����ģ�ͬʱ��SnAgCu����Ľ����SnAgCuRE������ڲ�����һ��������[46]�����о���[45]���Sn3.5Ag0.7Cu��Sn3.5Ag0.7Cu0.25RE��170 ����з�������ʱЧ100 h������ΪCu6Sn5��Cu3Sn���㡣ͬʱ��Cu3Sn���ִ���Kirkendall�ն����ڣ�����Ҫ������Sn��Cu��ʱЧ�����в�ͬ����ɢ������ɡ���ʱЧ������SnAgCuRE����Ľ���������ٶ����Ե���SnAgCu���㡣���⣬�����仯������(X)��ʱЧʱ��(t)�Ĺ�ϵ��ʽ(9)��ʾ [112]��ʱ�䳣��n��ѡ�����ͨ�����������м��㣬���о���[113]��Ϊ��������������ɢ���ƿ���ʱ��n��ֵȡ0.5�����ݶ���ѧ���ۣ��¶���ص���ɢϵ��[114]��ʽ(10)��ʾ��Ŀǰ��Ժ�ϡ��Ԫ����Ǧǥ���ڷ����ڼ�Ľ�����ɢ����ɢϵ���ļ����ʼ�������
![]() (9)
(9)
![]() (10)
(10)
ʽ�У�XtΪtʱ�̽���ĺ�ȣ�X0Ϊ��������ĺ�ȣ�kΪ��ɢϵ����tΪ����ʱ�䣻nΪʱ��ָ����AΪ��ɢ������
�����������ñ�(MIL-STD-883)[115]�����õ��������ɿ��Բ��Ե���ѭ����ΧΪ-55~125 �棬ͼ3��ʾΪQFP����Sn3.8Ag0.7Cu0.03Ce���㾭��3���¶�ѭ�������Ӧ����ͼ[116]�����Կ��������㡢�����ͺ�ֺΪ���Ӧ�伯�е����������ֵ�Ӧ��ֵ���, �ô�������DZ�ڵķ�Դ�أ�ͬʱͨ��ʵ���о�Ҳ֤ʵ����һ�о��������һ���о�����[117]��SnAgCuCe���������������С��SnAgCu���㣬SnAgCuCe��������ѭ���غ������µ�ƣ���������Ը���SnAgCu����ģ����ӷ�ֵΪ12.66%������Ҫ����������ϡ��Ԫ�غ��ڲ������������õ�һ���̶ȵ�����[51]��SnAgCuCe���������·���ͺ����ڲ������仯����Cu6Sn5�����ֻ������Ե���ϵ[118]�����ڿ�����Sn֮��������ϵ����ʧ�䣬���������ߵĽ��洦�γ����ƣ�ͬʱ��������ѭ�������ӣ����ƻ����ź����ڲ���һ��������������棬����SnAgCuCe����Ľ���ʧ Ч[51]�����о��߶�BGA����Sn3Ag0.5Cu/Sn3Ag- 0.5Cu0.05Ce����ͨ��ʩ��ѭ��Ӧ�����л�еƣ�����飬�о��������SnAgCuCe����Ŀɿ��Ե���SnAgCu����[119]��ͬʱ�����о��߷�����0~125 ���ѭ�������У�QFP����Sn3.8Ag0.7Cu0.03Ce����������������¶�ѭ�����������������½�[13]��

ͼ3 SnAgCuCe���������ͼ[117]
Fig.3 Creep nephogram of SnAgCuCe solder joints[117]
ϡ��Ԫ��Ce���ӵ�Sn0.5Cu0.05Niǥ�ϣ���Ӧ�ĺ�������ѭ�����������ܺͽ��������������Ա仯������2000����ѭ����QFP32����SnCuNiCe������������ȣ�SnCuNi�ĺ��������21.16%����ʱ������������Cu3Sn�࣬���º�����ѧ�����½�����ϡ��Ԫ��Ce����Ч���ƽ��洦�Լ�ǥ���ڲ������仯����Ĵֻ����Ӷ�������ѭ���Ժ�����ѧ���ܵIJ���Ӱ�죬ʹ��SnCuNiCe�ĺ���ɿ�������SnCuNi�����[120]�����ϡ�����ӵ�SnAgǥ����֯�����������Ե�Ӱ�죬��ӦSnAg�� SnAgRE����Ŀɿ���Ҳ����ر�����LAW��WU[92]���Au/Ni�Ʋ�BGA����Sn3.5Ag��Sn3.5Ag0.5RE������150 ��ʱЧ1 000 h�µĽ�����֯�ݻ����ɺͺ���ļ���ǿ�Ƚ����о���ʱЧ�����������ֺ�����ڲ��ͽ�������ִ��״��(Au,Ni)Sn4�࣬ͬʱ������Ⱦ�����ʱ�����������������ʱЧ�����У����ֺ����ǿ�Ⱦ����нϺõ��ȶ��ԣ�SnAgRE�����ǿ�����Ը���SnAg����ġ��������о���[121]֤ʵ����Sn3.5Ag����������ϡ��Ԫ��La����Ӧ�����ƣ������������߽�5������Ӧϡ������Ϊ0.1%ʱ���������ߵ�ƣ�����������ں����ƣ����������Ŀǰ��Ҫ�л�������Ӧ�䡢���Ӧ���Ӧ�����ܶ� [122-125]�����ǣ���Ŀǰ�����о���ȱ����غ�ϡ����Ǧ�����ƣ������Ԥ�ⷽ�̵ı�����
��ϡ��Ԫ��Ce��SnZnϵ������150 ��ʱЧ������֯�ݻ�Ҳ����ر���[14, 126]�����ڽ��洦Cuԭ�ӵ���ɢ�ٶ�Զ����Znԭ�ӵģ��ڽ��洦�γ�Zn�ľ�����������Cu5Zn8���ܽ⡢���飬���⣬ԭ�Ӽ�����ɢ�ڽ��洦�γɿն������º�����ѧ���ܵĶ�������Au/Ni/Cu����ʱ������Ni�������ΪCu����ɢ�赲�㣬��������ߺ�ϡ��Ԫ��Ce��SnZnϵ����Ŀɿ��ԡ���Ժ�ϡ������Ǧ����Ŀɿ����о��ɹ�Ŀǰ�����ȱ����Ϊ�˽�һ�����ϡ����Ǧ����Ŀɿ��ԣ�Ӧ����Ժ���Ľ����������Ԫ����ɢ������Ӧ����Ӧ����Ӧ�ͺ���ƣ�����������о���
4 ����ϡ��Ԫ�ض�ǥ�ϱ��������Ӱ��
ϡ��Ԫ�ص�������һ���̶��Ͽ������ǥ�ϵ���ѧ���ܡ�����ǥ�ϵ���ʪ�ԡ�ϸ��ǥ�ϵĻ�����֯����������ϡ������������[127]���ᵼ����ǥ�ϱ���������룬��ˣ��ڵ������������ڼ䣬�����������������������������ŵĶ�·[128-129]��ֱ�ӵ��µ��������ı��ϣ�������Ҳ����ϡ��Ԫ�ص���Ǧǥ�ϵ��ƹ�����������Ĵ����
�����ں�ϡ��Ԫ�ص���Ǧǥ���У�������������ϡ��Ԫ�����ӹ���������³��ֵġ�CHUANG[130]������Sn3.0Ag0.5Cu������1.0%Ce��ǥ�ϱ����������Ե����롣DUDEK��CHAWLA[131-132]��Sn3.9- Ag0.6Cuǥ��������2%��ϡ��Ԫ��La��Ce��Y����������ϡ��������������������롣�»���[133]��Sn3.8Ag0.7Cu��ǥ�����ӹ�����ϡ��Ԫ��Ce(1%)������ǥ���ڲ�ϡ���౩¶�ڿ����У�ϡ���ཫ��������������������ͣ�ǥ�ϻ����������͵��������ý�ʹϡ�����ڲ��������ѹӦ���Ӷ����������������ͼ4��ʾΪϡ�����������롣ͬʱ���ں�ϡ��Ԫ��Er��SnAgCuǥ����Ҳ���������ƺ�Ceǥ���е�����[134]����Ҫ��ϡ��������������Ӧ��CeSn3+O2�� 3Sn+CeO2��4ErSn3+ 3O2��12Sn+2Er2O3���ڸù����У���ԭ����ϡ���ྦྷ���ڲ�����ɢ��������������ͣ�����Χǥ�ϻ����������͵��������ý�ʹ���ڲ��������ѹӦ������ѹӦ����Ϊ����������ṩ��������ͬʱ��ϡ���������������ͷų�����Snԭ�ӽ�Ϊ����������ṩ����Դ[135]��

ͼ4 ϡ������������[133]
Fig.4 Tin whiskers on Sn-RE phases[133]
CHUANG��LIN[136]�Ա�SnAgCuCe��SnZnCeǥ����֯������SnZnCeǥ���в�δ�������룬��ˣ�ͨ����һ�����о�������Sn3Ag0.5Cu0.5Ceǥ��������0.2%ZnԪ�ؿ����������������[137]��ͬʱ���� ��[138]��Sn9Zn����ϡ��Ԫ��Ce��La(������Ϊ0.5%)��ǥ�Ͻ����о�������SnZnLaǥ�ϵ���֯�����������Ե����룬��SnZnCe��Ȼû�г������롣YE ��[139]��ȡ��Sn9Zn0.5Gaǥ�������ӹ�����ϡ��Ԫ��Pr(0.7%)��������ǥ���г��ִ�����״����������ϡ������棬���Ҷ����ڵõ����ٵ����������Կ�����Zn���������������Ҳ���������ڹ���̨���ѧ��ʵ���о��У�Zn���������ÿ�����Ϊ�����ģ�����ʹ�õ�һ��ʵ������(ϡ������Ϊ0.5%)��ϡ��Ԫ��(Ce)����������������д��ڽ�һ�����о���֤ʵ��LIU��[140]�о�������Sn0.7Cuǥ��������ϡ��Ԫ��Nd(0.1%~5%)����ʹ����ϡ��Ԫ�غ���Ϊ0.1%ʱ��Ҳ��������Ƶ����롣
ͨ��������[134]�������֣�ϡ��Ԫ�������ӹ���ʱ��������������ۺ�Ŀǰ���о���������ϡ������������Ҳ��0.1%(Nd)ʱ�������룬�ֵ��о����ǽ�ϡ��Ԫ�صĺ���������0.5%�������о�����������Ϊ�˶��ƹ㺬ϡ����Ǧǥ�ϵĽ�һ��Ӧ�ã��������ǽ����������Ǧǥ���������⣬�ڽ��������Ĺ����б��뿼�ǵ����������棺���ȣ�����ϡ��Ԫ�ص���Ǧǥ�ϱ�������Ĵ����������⣻��Σ���ϡ����Ǧ�����ڷ����ڼ����������������⣻�ٴΣ���ϡ����Ǧ������������Ԥ�����⡣ֻ������Ǧǥ�Ͻ������3����������ݣ���Ǧǥ�ϲ��ܹ��ڵ��ӹ�ҵ�л�ù㷺��Ӧ�ú��ƹ㡣
5 ��ϡ����Ǧǥ���о��������ڵ�����
���ŵ��ӹ�ҵ�ķ�չ����Ǧǥ�ϵ��о��������죬���������ڹ��ʱ����˴�������Ǧǥ��ר�����������к�ϡ��Ԫ�ص���Ǧǥ��ռ����Ҫ��һϯ�������ڲ��Է��������з��ֺ�ϡ��Ԫ�ص���Ǧǥ�Ͼ�����ʪ�Ժá���ѧ����������ϵ���ŵ㣬���Ǻ�ϡ��Ԫ�ص���Ǧǥ�Ͼ���ʵ��Ӧ�ú��ƹ����кܳ���·Ҫ�ߡ����Ÿ�ϵ��ǥ�ϵ�������Ҫ��3�����ֱ��о����£�
1) ϡ����Դ��ϡ����ϡ�н�����ϡ��������ķֲ���ض��죬�й���ϡ��������������Ź�����Դ�����ƻ���ʵʩ���ƽ�������������˰���ܾ��·�֪ͨ��������2011��4��1���𣬽�ϡ����ԭ����Դ˰˰���ͳһ�ϵ�10��[141]����������һ�������ҲӰ����ϡ���Ľ�һ��ʹ�ã���������سɱ���Ϊ��Ӧ����һ���⣬���Բ�ȡ���´�ʩ�����һ���⣺�����Ƕ������Ӻ���ϡ��Ԫ�ص�������ڶ���Ǧǥ�ϳɱ�Ӱ�첻���ǰ���¿ɼ������ϡ��Ԫ�أ����������Ӵ���ϡ��Ԫ�ص����������ѡ���о�����������Ǧǥ�ϣ�ʹ������Ǧǥ�ϵ����ܺͺ�ϡ������Ǧǥ�������
2) �������⣺����ij���һֱ�����߿������ֱ�ӵ���ϵ[142]�����ں�ϡ��Ԫ�ص���Ǧǥ����˵�������������о������е�һ�����⣬�о��ߵij�����ϣ������ϡ��Ԫ�����ǥ�ϵ����ܣ������ͻȻ���֣�����ҲΪҵ��������µ����⣬ֱ���谭�˺�ϡ����Ǧǥ�ϵĽ�һ���ƹ��Ӧ�á�Ϊ��ͻ����һ���⣬CHUANG��CHI[143]��ȡ��Sn3Ag0.5Cu0.5Ce������GeԪ�أ�����Ge�Ĵ��ڣ�ǥ����CeSn3�������õ����ͣ���ʹû���㹻ѹӦ������������������⣬��������ϡ��Ԫ�ص���������һ��������Χ������SnAgCuǥ��������0.03%Ce��SnAgCuCe�����ڲ�������С������CeSn3�࣬����û����������[51]���Ӷ�Ҳ˵�������������ϡ�����������ű�Ȼ�Ĺ�ϵ��
3) ʧЧ���⣺���������վ����ӹ�ҵ���ŵ�ͳ ��[144-145]������Ԫ����ʧЧ��ԭ��55%�������¶ȵı仯����ģ�20%������������ģ�19%����Ϊ������ԭ������6%�ǻҳ���ԭ����ɵġ�������������������������Ļ���[146]���¶ȡ��������ͻҳ��Ժ���ɿ���Ӱ���б�Ҫ����������о���̽�֡�����ϡ��Ԫ�صļ��룬��Ǧ������4�ֻ����µĿɿ���������Ƕ���Ȼ��Ҫ�����о���Ŀǰϡ��Ԫ�ص�Ӱ������о���Ҫ��ϡ��Ԫ�ص���Sn��[147]��ϡ��Ԫ�ص���������[148]�����縻��[149]�ȣ�ͬʱ���о����ַ��֣���ϡ���ĺ�������ϡ���������������ֹ����ƣ�����Ƶ���չ[150]��Ҳ���о��߷���ϡ���������������·������û��Ӱ��[51]����ˣ���ϡ����Ǧ�����ڷ����ڼ��ʧЧ��������Ǧǥ���о��е�һ����Ҫ���⡣
6 ����
�ۺ������������ں�ϡ��Ԫ����Ǧǥ�ϵ��о���״���ܽ�ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ�죬��������ϡ��Ԫ�ص�������һ���̶��Ͽ���ϸ��ǥ�ϻ�����֯����С�����仯��������ߴ�ͽ��ͽ����ȡ�ϡ��Ԫ�ص����ӿ��������Ǧǥ��ijһ���ܻ����ۺ����ܣ�����Ҳ�в�����㣵Ĺ۵���֣�����Ҫ��ϡ�������ӷ�ʽ��ǥ��ұ�����ռ������豸�������йء�Ŀǰ����Ժ�ϡ����Ǧ����ɿ��Ե��о��ɹ����������ڼ���������������·����ȱ�����ں����ڲ�ͬ���������¿ɿ��Ե�����̽�ֺ��о������⣬��ϡ����Ǧǥ������������Լ�ź�ϡ����Ǧǥ�ϵ�Ӧ�ú��ƹ㡣�ۺϷ�����ϡ����Ǧǥ���о��д������⣬������DZ�ڿ��ܵĽ����ʩ��Ϊ��ϡ����Ǧǥ�ϵĽ�һ���о��ṩ����֧�š�
REFERENCES
[1] ������, ����ƽ. ��Ǩ������Ǧǥ����������Ĵ�����������Ϊ[J]. ����ѧ��, 2009, 37(2): 253-257.
YIN Li-meng, ZHANG Xin-ping. Electromigration induced brittle creep fracture behavior of lead-free solder micro-interconnections[J]. Acta Electronica Sinica, 2009, 37(2): 253-257.
[2] ZENG K, TU K N. Six cases of reliability study of Pb-free solder joints in electronic packaging technology[J]. Materials Science and Engineering R, 2002, 38(2): 55-105.
[3] ZOU C D, GAO Y L, YANG B, ZHAI Q J. Melting and solidification properties of nanoparticles of Sn3.0Ag0.5Cu lead-free solder alloy[J]. Materials Characterization, 2010, 61(4): 474-480.
[4] GAO Li-li, XUE Song-bai, ZHANG Liang, SHENG Zhong, JI Feng, DAI Wei, YU Sheng-lin, ZENG Guang. Effect of alloying elements on properties and microstructures of SnAgCu solders[J]. Microelectronic Engineering, 2010, 87(11): 2025-2034.
[5] ������, �����, �� ��, ����ΰ. Sn-3.0Ag-0.5Cu-xNi��Ǧ���ϼ����������[J]. ����ѧ��, 2009, 30(1): 9-12.
WANG Li-feng, SUN Feng-lian, L? Ye, SHEN Xu-wei. Properties of Sn-3.0Ag-0.5Cu-xNi lead-free solders and soldering joints[J]. Transactions of the China Welding Institution, 2009, 30(1): 9-12.
[6] CHEN W M, YANG S C, TSAI M H, KAO C R. Uncovering the driving force for massive spalling in the Sn-Cu/Ni system[J]. Scripta Materialia, 2010, 63(1): 47-49.
[7] LI Xian-fen, ZHANG Fei, ZU Fang-qiu, L? Xue, ZHAO Zhen-xing, YANG Dong-dong. Effect of liquid-liquid structure transition on solidification and wettability of Sn-0.7Cu solder[J]. Journal of Alloys and Compounds, 2010, 505(2): 472-475.
[8] SHEN J, LIU Y C, WANG D J, GAO H X. Nano ZrO2 particulate-reinforced lead-free solder composite[J]. Journal of Materials Science & Processing, 2006, 22(4): 529-532.
[9] ������, �� ��, ½ �. ��Ԫ�ض�Sn-3.5Ag�Ͻ�/ͭ���淴Ӧ��Ӱ��[J]. ��е���̲���, 2009, 33(9): 21-24.
LI Shi-ming, YU Chun, LU Hao. Effect of Ge on interfacial reaction Sn-3.5Ag alloy/Cu interface[J]. Materials for Mechanical Engineering, 2009, 33(9): 21-24.
[10] ZHANG L, XUE S B, GAO L L, SHENG Z, YE H, XIAO Z X, ZENG G, CHEN Y, YU S L. Development of Sn-Zn lead-free solders bearing alloying elements[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(1): 1-15.
[11] �� ��, ������, Ѧ ��. Sn-Znǥ��Cu��ͷ�Ľ��淴Ӧ����ѧ����[J]. ���ϴ�ѧѧ��: ��Ȼ��ѧ��, 2009, 39(3): 615-622.
ZHOU Jian, WANG Chang-liang, XUE Feng. Interfacial reaction and joint strength of Sn-Zn solder/Cu[J]. Journal of Southeast University: Natural Science Edition, 2009, 39(3): 615-622.
[12] LI B, SHI Y W, LEI Y P, GUO F, XIA Z D, ZONG B. Effect of rare earth element addition on the microstructure of Sn-Ag-Cu solder joint[J]. Journal of Electronic Materials, 2005, 34(3): 217-224.
[13] ������. ϡ��Ce��Sn-Ag-Cu��Sn-Cu-Niǥ�����ܼ�����ɿ���Ӱ����о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2009.
WANG Jian-xin. Study on effects of Ce on properties of Sn-Ag-Cu & Sn-Cu-Ni solders and reliability of soldered joints[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2009.
[14] �� ��. �Ͻ�Sn-9Zn��Ǧǥ������Ӱ�켰��ػ����о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2010.
WANG Hui. Study on solderability and wetting mechanisms of micro-alloyed Sn-9Zn lead-free solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2010.
[15] �� ӱ, ����Ԩ, Ǯ����, ���˼�, Ѧ����. Sn-Pb-Ce-Laǥ�ϺϽ������֯����[J]. ϡ��, 1994, 15(1): 57-59.
ZHU Ying, FANG Hong-yuan, QIAN Yi-yu, DING Ke-jian, XUE Li-zhong. Microstructures of Sn-Pb-Ce-La solders[J]. Chinese Rare Earths, 1994, 15(1): 57-59.
[16] ��С��, ����Ȩ, ��, ������. ϡ������Ǧǥ����ʪ�Ժͽ�ͷǿ�ȵ�Ӱ��[J]. ���ֹ�ҵ��ѧѧ��: ��Ȼ��ѧ��, 1994, 24(76): 73-77.
QIU Xiao-ming, LI Shi-quan, WAN Chuan-geng, ZHAO Xu-ri. The influence of rare earth on the wettability, flowability and joint strength of Sn-Pb solders[J]. Journal of Jilin University of Technology: Natural Science Edition, 1994, 24(76): 73-77.
[17] ZHANG L, XUE S B, GAO L L, ZENG G, SHENG Z, CHEN Y, YU S L. Effects of rare earths on properties and microstructures of lead-free solder alloys[J]. Journal of Materials Science: Material in Electronics, 2009, 20(8): 685-694.
[18] WU C M L, YU D Q, LAW C M L, WANG L. Properties of lead-free solder alloys with rare earth element additions[J]. Materials Science and Engineering R, 2004, 44(1): 1-44.
[19] CHUANG T H, YEN S F. Abnormal growth of tin whiskers in a Sn3Ag0.5Cu0.5Ce solder ball array package[J]. Journal of Electronic Materials, 2006, 35(8): 1621-1627.
[20] ���ڽ�. ������װԪ�����뵼�弤����Ǧ��ǥ�������о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2009.
HAN Zong-jie. Diode laser soldering to electronic mounting components/devices[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2009.
[21] CHEN Z G, SHI Y W, XIA Z D, YAN Y F. Study on the microstructure of a novel lead-free solder alloy SnAgCu-RE and its soldered joints[J]. Journal of Electronic Materials, 2002, 31(10): 1122-1128.
[22] CHEN Z G, SHI Y W, XIA Z D, YAN Y F. Properties of lead-free solder SnAgCu containing minute amounts of rare earth[J]. Journal of Electronic Materials, 2008, 32(4): 235-243.
[23] �� �, ʷҫ��, ��־��, ����ƽ, �� ��. ������ϡ��Ԫ�ص�SnAgCu��Ǧǥ�ϵ��о�[J]. ���ӹ��ռ���, 2004, 25(5): 193-198.
LI Bo, SHI Yao-wu, XIA Zhi-dong, LEI Yong-ping, GUO Fu. Research on the SnAgCu lead-free solder with minute amount rare earth elements[J]. Electronics Process Technology, 2004, 25(5): 193-198.
[24] ����, ������, �� ��, ������, ���. ���ϡ����Sn-0.70Cu-0.05Niǥ����֯�����ܵ�Ӱ��[J]. ����Ԫ�������, 2011, 30(2): 25-28.
YI Jiang-long, ZHANG Yu-peng, XU Lei, LIU Feng-mei, YANG Kai-zhen. Effect of adding mixed RE on microstructure and properties of Sn-0.70Cu-0.05Ni solder alloy[J]. Electronic Components and Materials, 2011, 30(2): 25-28.
[25] XIA Z D, CHEN Z G, SHI Y W, MU N, SUN N. Effect of rare earth element additions on the microstructure and mechanical properties of tin-silver-bismuth solder[J]. Journal of Electronic Materials, 2002, 31(2): 564-567.
[26] Ѧ�ɰ�, �� ��, ������, Ҧ����. ��ϡ��Ԫ�����Sn-Ag-Cu��Ǧǥ���������ܺͺ��㿹��ǿ�ȵ�Ӱ��[J]. ����ѧ��, 2005, 26(10): 23-26.
XUE Song-bai, LIU Lin, DAI Yong-feng, YAO Li-hua. Effects of rare-earth element Ce on physical properties and mechanical properties of SnAgCu lead-free solder[J]. Transactions of the China Welding Institution, 2005, 26(10): 23-26.
[27] ������. Ga/In��ϡ��Ce��Ag30CuZnSnǥ������֯��ǥ����ͷ����Ӱ����о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2011.
LAI Zhong-min. Effects of Ga/In and rare earth Ce on microstructures and properties of brazed joint of Ag30CuZn filler metal[D]. Nanjing: Nanjing University of Aeronautics and Astronautics,2011.
[28] DUDEK M A, SIDHU R S, CHAWLA N, RENAVIKAR M. Microstructure and mechanical behavior of novel rare earth-containing Pb-free solders[J]. Journal of Electronic Materials, 2006, 35(12): 2088-2097.
[29] ZHANG L, XUE S B, GAO L L, CHEN Y, YU S L, SHENG Z, ZENG G. Microstructure and creep properties of Sn-Ag-Cu lead-free solders bearing minor amounts of the rare earth cerium[J]. Soldering & Surface Mount Technology, 2010, 22(2): 30-34.
[30] �� ��, Ѧ�ɰ�, �� ��, ������, �� ��, ʢ ��, ��ʤ��. ���SnAgCuǥ�ϵ�����֯�����ܵ�Ӱ��[J]. �й�ϡ��ѧ��, 2009, 27(2): 246-250.
ZHANG Liang, XUE Song-bai, ZENG Guang, GAO Li-li, CHEN Yan, SHENG Zhong, YU Sheng-lin. Effects of cerium on microstructure and properties of SnAgCu solders[J]. Journal of Chinese Rare Earth Society, 2009, 27(2): 246-250.
[31] HAO H, TIAN J, SHI Y W, LEI Y P, XIA Z D. Properties of Sn3.8Ag0.7Cu solder alloy with trace rare earth element Y additions[J]. Journal of Electronic Materials, 2007, 36(7): 766-774.
[32] SHI Y W, TIAN J, HAO H, XIA Z D, LEI Y P, GUO F. Effects of small amount addition of rare earth Er on microstructure and property of SnAgCu solder[J]. Journal of Alloys and Compounds, 2008, 453(1/2): 180-184.
[33] GAO L L, XUE S B, ZHANG L, XIAO Z X, DAI W, JI F, YE H, ZENG G. Effect of praseodymium on the microstructure and properties of Sn3.8Ag0.7Cu solder[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(9): 910-916.
[34] GAO L L, XUE S B, ZHANG L, SHENG Z, ZENG G, JI F. Effects of trace earth Nd addition on microstructure and properties of SnAgCu solder[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(7): 643-648.
[35] RAMIREZ A G, MAVOORI H, JIN S. Bonding nature of rare-earth-containing lead-free solders[J]. Applied Physics Letters, 2002, 80(3): 398-400.
[36] MAVOORI H, RAMIREZ A G, JIN S. Universal solders for direct and powerful bonding on semiconductors, diamond and optical materials[J]. Applied Physics Letters, 2001, 78(19): 2976-2978.
[37] PEI M, QU J M. Effect of lanthanum doping on the microstructure of tin-silver solder alloys[J]. Journal of Electronic Materials, 2008, 37(3): 331-338.
[38] NOH B I, CHOI J H, YOON J W, JUNG S B. Effects of cerium content on wettability, microstructure and mechanical properties of Sn-Ag-Ce solder alloys[J]. Journal of Alloys and Compounds, 2010, 499(2): 154-159.
[39] CHEN W X, XUE S B, WANG H, HU Y H, WANG J X. Effects of rare earth Ce on properties of Sn-9Zn lead-free solder[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(7): 719-725.
[40] ����, Ѧ�ɰ�, ����ѧ, �� ��. Sn-9Zn-xCeǥ������֯��ǥ�����ܵķ���[J]. ����ѧ��, 2010, 31(6): 77-80.
HU Yu-hua, XUE Song-bai, CHEN Wen-xue, WANG Hui. Microstructure and solderability of Sn-9Zn-xCe lead-free solder[J]. Transactions of the China Welding Institution, 2010, 31(6): 77-80.
[41] ¬ ��, �����, �� ��, �컪ΰ, ���ۺ�. �����Sn-0.7Cu-0.5Ni���ϺϽ���֯�����ܵ�Ӱ��[J]. �й�ϡ��ѧ��, 2007, 25(2): 217-223.
LU Bin, WANG Juan-hui, LI Hui, ZHU Hua-wei, JIAO Xian-he. Effect of cerium on microstructure and properties of Sn-0.7Cu-0.5Ni lead-free solder alloy[J]. Journal of the Chinese Rare Earth Society, 2007, 25(2): 217-223.
[42] ZENG G, XUE S B, ZHANG L, GAO L L, DAI W, LUO J D. A review on the interfacial intermetallic compounds between Sn-Ag-Cu based solders and substrates[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(5): 421-440.
[43] YOON J W, LEE Y H, KIM D G, KANG H B, SUH S J, YANG C W, LEE C B, JUNG J M, YOO C S, JUNG S B. Intermetallic compounds layer growth at the interface between Sn-Cu-Ni solder and Cu substrate[J]. Journal of Alloys and Compounds, 2004, 381(1/2): 151-157.
[44] ¬ ��, �����, �� ��, ���ۺ�. ����0.10%Ce��Sn-0.7Cu-0.5Ni������Cu��������IMC��Ӱ��[J]. �й���ɫ����ѧ��, 2007, 17(3): 390-395.
LU Bin, WANG Juan-hui, LI Hui, ZHU Hua-wei, JIAO Xian-he. Effect of 0.10% Ce on intermetallic compounds at Sn-0.7Cu-0.5Ni/Cu interface[J]. The Chinese Journal of Nonferrous Metals, 2007, 17(3): 390-395.
[45] LAW C M T, WU C M L, YU D Q, WANG L, LAI J K L. Microstructure, solderability and growth of intermetallic compounds of Sn-Ag-Cu-RE lead-free solder alloys[J]. Journal of Electronic Materials, 2006, 35(1): 89-93.
[46] ��Ҫ��, �ſ¿�, �� ˧, �Թ���. ������Sn-2.5Ag-0.7Cu(0.1RE)ǥ�Ϻ������Cu6Sn5�ij�����Ϊ[J]. ϡ�н��������빤��, 2010, 39(1): 117-121.
WANG Yao-li, ZHANG Ke-ke, LIU Shuai, ZHAO Guo-biao. Growth behavior of Cu6Sn5 at the interface of Sn-2.5Ag-0.7Cu(0.1RE) solder joints for micro-joining[J]. Rare Metal Materials and Engineering, 2010, 39(1): 117-121.
[47] HAO H, SHI Y W, XIA Z D, LI Y P, GUO F. Microstructure evolution of SnAgCuEr lead-free solders under high temperature aging[J]. Journal of Electronic Materials, 2008, 37(1): 2-8.
[48] ��ӭ��, ������, ���ı�, ���Ľ�, ���˱�, ���˴�, ·�ϸ�. La��Sn-Ag-Cu��Ǧǥ����ͭǥ����ͷ�����仯�����Ӱ��[J]. �й���ɫ����ѧ��, 2008, 18(9): 1651-1657.
ZHOU Ying-chun, PAN Qing-lin, LEI Wen-bin, LIANG Wen-jie, HE Yun-bin, LI Yun-chun, LU Cong-ge. Effect of La on intermetallic compounds of Sn-Ag-Cu lead-free alloy soldered with copper[J]. The Chinese Journal of Nonferrous Metals, 2008, 18(9): 1651-1657.
[49] DUDEK M A, SIDHU R S, CHAWLA N. Novel rare-earth-containing lead-free solders with enhanced ductility[J]. Journal of the Minerals, Metals and Materials Society, 2006, 58(6): 57-62.
[50] ZENG G, XUE S B, ZHANG L, SHENG Z, GAO L L. Reliability evaluation of SnAgCu/SnAgCuCe solder joints based on finite element simulation and experiments[J]. Soldering & Surface Mount Technology, 2010, 22(4): 57-64.
[51] �� ��. SnAgCuϵ��Ǧ����ɿ��Լ���������о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2011.
ZHANG Liang. Study on reliability of SnAgCu based lead-free soldered joint and related theory[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2011.
[52] LAW C M L, WU C M L, YU D Q, LI M, CHI D Z. Interfacial microstructure and strength of lead-free Sn-Zn-RE BGA solder bumps[J]. IEEE Transactions on Advanced Packaging, 2005, 28(2): 252-257.
[53] XIAO Z X, XUE S B, HU Y H, YE H, GAO L L, WANG H. Properties and microstructure of Sn-9Zn lead-free solder alloy bearing Pr[J]. Journal of Materials Science: Materials in Electronics, 2011, 22(6): 659-665.
[54] HU Y H, XUE S B, WANG H, YE H, XIAO Z X, GAO L L. Effects of rare earth element Nd on the solderability and microstructure of Sn-Zn lead-free solder[J]. Journal of Materials Science: Materials in Electronics, 2011, 22(5): 481-487.
[55] LEE H T, CHEN Y F. Influence of lanthanum additions on the microstructure and microhardness of Sn-3.5Ag solder[J]. Journal of Electronic Materials, 2009, 38(10): 2148-2157.
[56] DUDEK M A, CHAWLA N. Three-dimensional (3D) microstructure visualization of LaSn3 intermetallics in a novel Sn-rich rare-earth-containing solder[J]. Materials Characterization, 2008, 59(9): 1364-1368.
[57] MA X, QIAN Y Y, YOSHIDA F. Effect of la on the Cu-Sn intermetallic compound (IMC) growth and solder joint reliability[J]. Journal of Alloys and Compounds, 2002, 334(1/2): 224-227.
[58] LEE T Y, CHOI W, TU K N, JANG J W, KUO S M, LIN J K, FREAR D R, ZENG K, KIVILAHTI J K. Morphology, kinetics and thermodynamics of solid-state aging of eutectic SnPb and Pb-free solders[J]. Journal of Materials Research, 2002, 17(2): 291-301.
[59] �� ��. ϡ���������ͭ��Ǧǥ����֯���ܵ�Ӱ��[D]. ������: ��е��ѧ�о���Ժ, 2006.
CHEN Yan. Effects of cerium on property and microstructure for SnAgCu lead free solder[D]. Harbin: China Academy of Machinery Science & Technology, 2006.
[60] MA X, YOSHIDA F. Interaction relation in 60Sn-Pb-0.05La ternary solder alloy[J]. Materials Letters, 2002, 56(4): 441-445.
[61] �ڴ�ȫ. ���ӷ�װ������Ǧǥ�ϼ�����������о�[D]. ����: ����������ѧ, 2004.
YU Da-quan. Development of lead free solder and its interfacial issues in electronics packaging[D]. Dalian: Dalian University of Technology, 2004.
[62] ��־��. SnAgCuREǥ�������Ϊ���о�[D]. ����: ������ҵ��ѧ, 2003.
CHEN Zhi-gang. Study on the creep behavior of SnAgCuRE solder joints[D]. Beijing: Beijing University of Technology, 2003.
[63] �����, ���ĸ�, ������, �� ��. Bi��Sn-0.3Ag-0.7Cu��Ǧǥ���۵㼰��ʪ���ܵ�Ӱ��[J]. ����ѧ��, 2008, 29(10): 5-8.
SUN Feng-lian, HU Wen-gang, WANG Li-feng, MA Xin. Influence of Bi on the melting point and wettability of Sn-0.3Ag-0.7Cu lead-free solder[J]. Transactions of the China Welding Institution, 2008, 29(10): 5-8.
[64] ¬ ��, �� ��, �����, �컪ΰ, ���ۺ�. ϡ��Er��Sn-3.0Ag-0.5Cu��Ǧ���ϺϽ���֯�����ܵ�Ӱ��[J]. �й���ɫ����ѧ��, 2007, 17(4): 518-524.
LU Bin, LI Hui, WANG Juan-hui, ZHU Hua-wei, JIAO Xian-he. Effect of Er on microstructure and properties of Sn-3.0Ag-0.5Cu lead-free solder alloy[J]. The Chinese Journal of Nonferrous Metals, 2007, 17(4): 518-524.
[65] �� �, �� ��. ��������ԭ��[M]. ������: ��������ҵ��ѧ������, 2001: 65-99.
CHEN Zhong, ZHOU Fei. The principle of material bonding[M]. Harbin: Harbin Institute of Technology Press, 2001: 65-99.
[66] YU D Q, ZHAO J, WANG L. Improvement on the microstructure stability, mechanical and wetting properties of Sn-Ag-Cu lead-free solder with the addition of rare earth elements[J]. Journal of Alloys and Compounds, 2004, 376(1/2): 170-175.
[67] ZHAO X Y, ZHAO M Q, CUI X Q, TONG M X. Effect of cerium on microstructure and mechanical properties of Sn-Ag-Cu system lead-free solder alloys[J]. Transactions of Nonferrous Metals Society of China, 2007, 17(4): 805-810.
[68] XUE S B, YU S L, WANG X Y, LIU L, HU Y F, YAO L H. Effects of rare earth element Ce on solderabilities of micron-powdered Sn-Ag-Cu solder[J]. Transactions of Nonferrous Metals Society of China, 2005, 15(6): 1285-1289.
[69] WANG J X, XUE S B, HAN Z J, YU S L, CHEN Y, SHI Y W, WANG H. Effects of rare earth Ce on microstructures, solderability of Sn-Ag-Cu and Sn-Cu-Ni solder as well as mechanical properties of soldered joints[J]. Journal of Alloys and Compounds, 2009, 467(1/2): 219-226.
[70] ������, ʷҫ��, ����ƽ, ��־��, �� ��. Ni/P/CeԪ�ض�SnAgCu��Ǧǥ�����ܺ���֯��Ӱ��[J]. ϡ�н��������빤��, 2010, 39(10): 1759-1763.
DONG Wen-xing, SHI Yao-wu, LEI Yong-ping, XIA Zhi-dong, GUO Fu. Effects of Ni/P/Ce elements on the properties and microstructure of SnAgCu lead-free solders[J]. Rare Metal Materials and Engineering, 2010, 39(10): 1759-1763.
[71] WANG L, YU D Q, ZHAO J H, HUANG M L. Improvement of wettability and tensile property in Sn-Ag-RE lead-free solder alloy[J]. Materials Letters, 2002, 56(6): 1039-1042.
[72] WU C M L, YU D Q, LAW C M T, WANG L. Improvements of microstructure, wettability, tensile and creep strength of eutectic Sn-Ag alloy by doping with rare-earth elements[J]. Journal of Materials Research, 2002, 17(12): 3146-3154.
[73] Ԭ��ҫ. ϡ��Ce��Sn����Ǧ���ϵ���֯�����ܼ�����Ӱ��[D]. ����: ����������ѧ, 2008.
YUAN Yi-yao. Effects of the rare earth Ce on the microstructures, properties and interface of Sn based lead free solders[D]. Kunming: Kunming University of Science and Technology, 2008.
[74] LAW C M T. Reliability and interfacial reaction of lead-free solder alloys doped with rare earth elements[D]. Hongkong: City University of Hongkong, 2004.
[75] ������, Ѧ�ɰ�, �� ��, ���ڽ�, ��ʤ��. ���ձ�����Sn-Cu-Ni-Ce��Ǧǥ����ʪ�Ե�Ӱ��[J]. ����ѧ��, 2007, 28(1): 49-52.
WANG Jian-xin, XUE Song-bai, HUANG Xiang, HAN Zong-jie, YU Sheng-lin. Effect of N2 protection on wettability of Sn-Cu-Ni-Ce lead-free solder[J]. Transactions of the China Welding Institution, 2007, 28(1): 49-52.
[76] ʷ��ƽ. ��ϡ��Ce��Sn-Cu-Niǥ�Ϻ���ɿ���Ӱ����о�[D]. �Ͼ�: �Ͼ����պ����ѧ, 2008.
SHI Yi-ping. Research on effects of minute amount of rare -earth element Ce on reliability of the joints soldered with Sn-Cu-Ni solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2008.
[77] ���. ����Sn-Cuϵ������Ǧ���ϵ��о�[D]. ��: ���մ�ѧ, 2009.
LI Jian-xin. The research of Sn-Cu system without Ag lead-free solder[D]. Zhenjiang: Jiangsu University, 2009.
[78] WU C M L, LAW C M T, YU D Q,WANG L. The wettability and microstructure of Sn-Zn-RE alloys[J]. Journal of Electronic Materials, 2003, 32(2): 63-69.
[79] WU C M L, YU D Q, LAW C M T,WANG L. The properties of Sn-9Zn lead-free solder alloys doped with trace rare earth elements[J]. Journal of Electronic Materials, 2002, 31(9): 921-927.
[80] ������. ��Ǧǥ��������·��ǰ��[J]. ����, 2007(2): 6-10.
ZHANG Qi-yun. A puzzle in lead free soldering, its outlet and application prospect[J]. Welding & Joining, 2007(2): 6-10.
[81] Ѧ�ɰ�, �� ��, ������, ��ʤ��, �� ��. ��ϡ��Ԫ�ض���Ǧǥ������Ӱ����о���״�ͷ�չ����[J]. ����, 2009(3): 24-33.
XUE Song-bai, ZHANG Liang, GAO Li-li, YU Sheng-lin, ZHU Hong. Current situation and prospect on effects of micro alloying elements on properties of lead-free solders[J]. Welding & Joining, 2009(3): 24-33.
[82] ����ѧ. Ag��Ga��Al��Ce��Sn-9Zn��Ǧǥ�����ܵ�Ӱ��[D]. �Ͼ�: �Ͼ����պ����ѧ, 2010.
CHEN Wen-xue. Effects of Ag, Ga, Al and Ce on the properties of Sn-9Zn lead-free solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2010.
[83] �� �. ��Ǧ����Sn-Zn-xLa���Ʊ����о�[D]. �Ϻ�: ������ѧ, 2008.
WANG Wei. Sn-Zn-xLa lead-free solders[D]. Shanghai: Fudan University, 2008.
[84] ZHOU J, SUN Y S, XUE F. Effect of Nd and La on surface tension and wettability of Sn-8Zn-3Bi solders[J]. Transactions of Nonferrous Metals Society of China, 2005, 15(5): 1161-1165.
[85] ZHOU J, HUANG D, FANG Y L, XUE F. Investigation on properties of Sn-8Zn-3Bi lead-free solder by Nd addition[J]. Journal of Alloys and Compounds, 2009, 480(2): 903-907.
[86] �Ž���, �Ƽ̻�, ��־��, �� ��, ���˿�. ��ϡ��Sn-Zn-Biϵ��Ǧǥ����ʪ���ܵ��о�[J]. �й�ϡ��ѧ��, 2006, 24(5): 586-591.
ZHANG Jian-gang, HUANG Ji-hua, DAI Zhi-feng, ZHANG Hua, ZHAO Xing-ke. Wettability of Sn-Zn based lead-free solder with rare earths[J]. Journal of the Chinese Rare Earth Society, 2006, 24(5): 586-591.
[87] ZHANG L, XUE SONGBAI, HAN Z J, WANG J X, GAO L L, SHENG Z. Mechanical properties of fine pitch devices soldered joints based on creep model[J]. Chinese Journal of Mechanical Engineering, 2008, 21(6): 82-85.
[88] ������. ���ӷ�װ��Ǧǥ�ϵ��о�[D]. ����: ����������ѧ, 2001.
HUANG Ming-liang. Development of lead-free solder alloys in electronics packaging[D]. Dalian, Dalian University of Technology, 2001.
[89] DALY A A W, HAMMAD A E. Effects of small addition of Ag and/or Cu on the microstructure and properties of Sn-9Zn lead-free solders[J]. Materials Science and Engineering A, 2010, 527(20): 5212-5219.
[90] ��־��, ʷҫ��, ��־��. �����ϡ����SnAgCuǥ�ϺϽ����ܵ�Ӱ��[J]. ���ӹ��ռ���, 2003, 24(2): 53-58.
CHEN Zhi-gang, SHI Yao-wu, XIA Zhi-dong. Effect of mixed rare earth on the properties of SnAgCu lead-free solder alloy[J]. Electronics Process Technology, 2003, 24(2): 53-58.
[91] LI G D, SHI Y W, HAO H, XIA Z D, LEI Y P, GUO F, LI X Y. Effect of rare earth addition on shear strength of SnAgCu lead-free solder joints[J]. Journal of Materials Science: Materials in Electronics, 2009, 20(2): 186-192.
[92] LAW C M T, WU C M L. Microstructure evolution and shear strength of Sn-3.5Ag-RE lead-free BGA solder balls[C]// Proceeding of the Sixth IEEE CPMT Conference on High Density Microsystem Design and Packaging and Component Failure Analysis, Shanghai: IEEE, 2004: 60-65.
[93] LEE H T, CHEN Y F, SCHWEDT A, MAYER J. Effect of La addition on adhesive strength and fracture behavior of Sn-3.5Ag solder joints[J]. Materials Science and Engineering A, 2011, 528(10/11): 3630-3638.
[94] ���, ��Ż�, ���ķ�, �����. ϡ��La����Ag-Cu-Tiǥ�ϵ�����֯����ѧ����[J]. ����ѧ��, 2010, 31(1): 67-70, 74.
YANG Chang-yong, XU Jiu-hua, DING Wen-feng, FU Yu-can. Microstructure and mechanical property of Ag-Cu-Ti fillers added with rare earth lanthanum[J]. Transactions of the China Welding Institution, 2010, 31(1): 67-70, 74.
[95] WU C M L, WONG Y W. Rare-earth additions to lead-free electronic solders[J]. Journal of Materials Science: Materials in Electronics, 2007, 18(1/3): 77-91.
[96] WU C M L, YU D Q, LAW C M T, WANG L. Microstructure and mechanical properties of new lead-free Sn-Cu-RE solder alloys[J]. Journal of Electronic Materials, 2002, 31(9): 928-932.
[97] TAI F, GUO F, HAN M T, XIA Z D, LEI Y P, SHI Y W. Creep and thermomechanical fatigue properties of in situ Cu6Sn5 reinforced lead-free composite solder[J]. Materials Science and Engineering A, 2010, 527(15): 3335-3342.
[98] CHEN Z G, SHI Y W, XIA Z D. Constitutive relations on creep for SnAgCuRE lead-free solder joints[J]. Journal of Electronic Materials, 2004, 33(9): 964-971.
[99] DUDEK M A, CHAWLA N. Effect of rare-earth (La, Ce, and Y) additions on the microstructure and mechanical behavior of Sn-3.9Ag-0.7Cu solder alloy[J]. Metallurgical and Materials Transactions A, 2010, 41(3): 610-620.
[100] �����, ������, ������. ����Ԫ�������е�ǥ�ϺϽ����Ƽ���Ʒ���[J]. ���ӹ��ռ���, 2000, 21(2): 47-52, 59.
FENG Wu-feng, WANG Chun-qing, LI Ming-yu. Development and design methods of solder alloys applied in joining electronic components[J]. Electronics Process Technology, 2000, 21(2): 47-52, 59.
[101] ZHANG L, XUE S B, GAO L L, ZENG G, CHEN Y, YU S L, SHENG Z. Creep behavior of SnAgCu solders with rare earth Ce doping[J]. Transactions of Nonferrous Metals Society of China, 2010, 20(3): 412-417.
[102] McCABE R J, FINE M E. The creep properties of precipitation-strengthened tin-based alloys[J]. Journal of the Minerals, Metals and Materials Society, 2000, 52(6): 33-35.
[103] IGOSHEV V I, KLEIMAN J I, SHANGGUAN D, LOCK C, WONG S, WISEMAN M. Microstructure changes in Sn-3.5Ag solder alloy during creep[J]. Journal of Electronic Materials, 1998, 27(12): 1367-1371.
[104] OLIVER W C, NIX W D. High temperature deformation of oxide dispersion strengthened Al and Al-Mg solid solutions[J]. Acta Metallurgica, 1982, 30(7): 1335-1347.
[105] PEI M. Effects of lanthanum doping on the microstructure and mechanical behavior of a SnAg alloy[D]. Georgia: Georgia Institute of Technology, 2007.
[106] XIAO W M, SHI Y W, XU G C, REN R, GUO F, XIA Z D,LEI Y P. Effect of rare earth on mechanical creep-fatigue property of SnAgCu solder joint[J]. Journal of Alloys and Compounds, 2009, 472(1/2): 198-202.
[107] HE H W, XU G C, GUO F. Effect of small amount of rare earth addition on electromigration in eutectic SnBi solder reaction couple[J]. Journal of Materials Science, 2009, 44(8): 2089-2096.
[108] MAHMUDI R, GERANMAYEH A R, ZAHIRI B, MARVASTI M H. Effect of rare earth element additions on the impression creep of Sn-9Zn solder alloy[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(1): 58-64.
[109] MAHMUDI R, GERANMAYEH A R, SALEHI M, PIRAYESH H. Impression creep of the rare-earth doped Sn-2%Bi lead-free solder alloy[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(3): 262-269.
[110] �� ��, Ѧ�ɰ�, ¬����, ���ڽ�, ��ʤ��, ������. �������ģ��ϸ�����������ƣ������Ԥ��[J]. ��е����ѧ��, 2009, 45(9): 279-284.
ZHANG Liang, XUE Song-bai, LU Fang-yan, HAN Zong-jie, YU Sheng-lin, LAI Zhong-min. Fatigue life prediction for fine pitch device soldered joints based on creep model[J]. Journal of Mechanical Engineering, 2009, 45(9): 279-284.
[111] KIM D H. Reliability study of SnPb and SnAg solder joints in PBGA packages[D]. Austin: The University of Texas, 2007.
[112] BI J L, HU A M, HU J, LUO T B, LI M, MAO D L. Effect of Cr additions on interfacial reaction between the Sn-Zn-Bi solder and Cu/electroplated Ni substrates[J]. Microelectronics Reliability, 2011, 51(3): 636-641.
[113] LIU N S, LIN K L. Evolution of interfacial morphology of Sn-8.5Zn-0.5Ag-0.1Al-xGa/Cu system during isothermal aging[J]. Journal of Alloys and Compounds, 2008, 456(1/2): 466-473.
[114] HE M, CHEN Z, QI G J. Solid state interfacial reaction of Sn-37Pb and Sn-3.5Ag solders with Ni-P under bump metallization[J]. Acta Materialia, 2004, 52(7): 2047-2056.
[115] HU Y F, XUE S B, WU Y X. FEM analysis of stress and strain and evaluation on reliability of soldered CBGA joints under thermal cycling[J]. Transactions of Nonferrous Metals Society of China, 2005, 15(S3): s317-s322.
[116] ZHANG L, XUE S B, GAO L L, SHENG Z, YU S L, CHEN Y, DAI WEI, JI F, ZENG G. Reliability study of Sn-Ag-Cu-Ce soldered joints in quad flat packages[J]. Microelectronics Reliability, 2010, 50(12): 2071-2077.
[117] ZHANG L, XUE S B, GAO L L, SHENG Z, ZENG G, CHEN Y, YU S L. Properties of SnAgCu/SnAgCuCe soldered joints for electronic packaging[J]. Journal of Materials Science: Materials in Electronics, 2010, 21(6): 635-642.
[118] ZHANG L, XUE S B, GAO L L, SHENG Z, DAI W, JI F, YE H, CHEN Y, YU S L. Effect of bulk Cu6Sn5 intermetallic compounds on properties of Sn-Ag-Cu-Ce solder joints[J]. Soldering & Surface Mount Technology, 2011, 23(1): 4-9.
[119] ֣��Ԫ. ����ͭ�Ͻ�����Ce��Ǧ����������з�װ֮��̬ƣ�Ϳɿ�������[D]. ̨��: ����̨���ѧ, 2009.
ZHENG Zhi-yuan. Dynamic fatigue life evaluation of Ce doped Sn-Ag-Cu solder ball grid array packages[D]. Taiwan: National Taiwan University, 2009.
[120] ������, ������, Ѧ�ɰ�. Sn-Cu-Ni(-Ce)������ѭ���ɿ���[J]. ����ѧ��, 2010, 31(2): 36-40.
WANG Jian-xin, LAI Zhong-min, XUE Song-bai. Thermal cycling reliability of Sn-Cu-Ni(-Ce) joints[J]. Transactions of the China Welding Institution, 2010, 31(2): 36-40.
[121] PEI M, QU J M. Creep and fatigue behavior of SnAg solders with lanthanum doping[J]. IEEE Transactions on Components and Packaging Technologies, 2008, 31(3): 712-718.
[122] LEE W W, NGUYEN L T, SELVADURAY G S. Solder joint fatigue models: Review and applicability to chip scale packages[J]. Microelectronics Reliability, 2000, 40(2): 231-224.
[123] ZAHN B A. Solder joint fatigue life model methodology for 63Sn37Pb and 95.5Sn4Ag0.5Cu materials[C]//Proceedings of 53rd Electronic Components and Technology Conference, New Orleans: IEEE, 2003: 93-94.
[124] SYED A. Accumulated creep strain and energy density based thermal fatigue life prediction models for SnAgCu solder joints[C]//Proceedings of 54th Electronic Components and Technology Conference, Las Vegas, NV: IEEE, 2004: 737-746.
[125] SCHUBERT A, DUDEK R, AUERSWALD E, GOLLHARDT A, MICHEL B, REICHL H. Fatigue life models for SnAgCu and SnPb solder joints evaluated by experiments and simulation[C]// Proceedings of 53rd Electronic Components and Technology Conference, New Orleans: IEEE, 2003: 603-610.
[126] WANG H. Investigations of Sn-9Zn-Ag-Ga-Al-Ce solder wetted on Cu, Au/Ni/Cu, and Sn-plated Cu substrates[J]. Welding Journal, 2010, 89(12): 249-255.
[127] ʷ����, ���, ������, �۸���. ϡ��Ce�����ӷ�ʽ��WC-CoӲ�ʺϽ����ܵ�Ӱ��[J]. ���ϴ�ѧѧ��:��Ȼ��ѧ��, 2005, 36(2): 204-208.
SHI Xiao-liang, YANG Kai-hua, TANG Feng-lin, SHAO Gang-qin. Effect of adding method of rare earth Ce on property of WC-Co cemented carbide[J]. Journal of Central South University of Technology: Natural Science, 2005, 36(2): 204-208.
[128] LIU S H, CHEN C, CHOU T. Tin whisker growth driven by electrical currents[J]. Journal of Applied Physics, 2004, 95(12): 7742-7747.
[129] HOWARD H P, CHENG J, VIANCO P T, LI J C M. Interface flow mechanism for tin whisker growth[J]. Acta Materialia, 2011, 59(5): 1957-1763.
[130] CHUANG T H. Rapid whisker growth on the surface of Sn-3Ag-0.5Cu-1.0Ce solder joints[J]. Scripta Materialia, 2006, 55(11): 983-986.
[131] DUDEK M A, CHAWLA N. Mechanisms for Sn whisker growth rare earth-containing Pb-free solders[J]. Acta Materialia, 2009, 57(15): 4588-4599.
[132] DUDEK M A, CHAWLA N. Nanoindentation of rare earth-Sn intermetallics in Pb-free solders[J]. Intermetallics, 2010, 18(5): 1016-1020.
[133] �� ��, ��㶫, ʷҫ��, ��־��, ����ƽ, �� ��, ������. ϡ��Ce����Sn�����������о�[J]. ϡ�н��������빤��, 2009, 38(5): 866-869.
HAO Hu, LI Guang-dong, SHI Yao-wu, XIA Zhi-dong, LEI Yong-ping, GUO Fu, LI Xiao-yan. Study of rapid growth of tin whisker accelerated by rare earth Ce[J]. Rare Metal Materials and Engineering, 2009, 38(5): 866-869.
[134] �� ��, ʷҫ��, ��־��, ����ƽ, �� ��, ������. Sn-3.8Ag-0.7Cu-1.0Er��Ǧǥ����Sn����������������[J]. ����ѧ��, 2009, 45(2): 199-203.
HAO Hu, SHI Yao-wu, XIA Zhi-dong, LEI Yong-ping, GUO Fu, LI Xiao-yan. Cross section changing growth phenomenon of Sn whiskers in Sn-3.8Ag-0.7Cu-1.0Er lead-free solder[J]. Acta Metallurgica Sinica, 2009, 45(2): 199-203.
[135] �� ��, ��㶫, ʷҫ��, ����ƽ. SnAgCuCe/Er��Ǧǥ�ϱ������������̬������[J]. ����ѧ��, 2009, 30(5): 25-28.
HAO Hu, LI Guang-dong, SHI Yao-wu, LEI Yong-ping. Morphologies and characteristics of tin whiskers on surface of SnAgCuCe/Er lead-free solder[J]. Transactions of the China Welding Institution, 2009, 30(5): 25-28.
[136] CHUANG T H, LIN H J. Size effect of rare-earth intermetallics in Sn-9Zn-0.5Ce and Sn-3Ag-0.5Cu-0.5Ce solders on the growth of tin whiskers[J]. Metallurgical and Materials Transactions A, 2008, 39(12): 2862-2866.
[137] LIN H J, CHUANG T H. Effects of Ce and Zn additions on the microstructure and mechanical properties of Sn-3Ag-0.5Cu solder joints[J]. Journal of Alloys and Compounds, 2010, 500(2): 167-174.
[138] LIN H J, CHUANG T H. Effects of Ce and La additions on the microstructure and mechanical properties of Sn-9Zn solder joints[J]. Journal of Electronic Materials, 2010, 39(2): 200-208.
[139] YE H, XUE S B, ZHANG L, XIAO Z X, HU Y H, LAI Z M, ZHU H. Sn whisker growth in Sn-9Zn-0.5Ga-0.7Pr lead-free solder[J]. Journal of Alloys and Compounds, 2011, 509(5): 52-55.
[140] LIU M, XIAN A P. Tin whisker growth on the surface of Sn-0.7Cu lead-free solder with a rare earth (Nd) addition[J]. Journal of Electronic Materials, 2009, 38(11): 2353-2361.
[141] ������, ������. ϡ����Դ�ԡ���ͷ���������г�������Ӱ���о�[J]. ���þ�γ, 2012(2): 52-55.
WANG Zheng-ming, ZHANG Xu-jing. Research into the effect of rare earth resource tax on the export market power of ��oligarch��country[J]. Economic Survey, 2012(2): 52-55.
[142] KIM K S, YU C H, YANG J M. Tin whisker formation of lead-free plated lead frames[J]. Microelectronics Reliability, 2006, 46(7): 1080-1086.
[143] CHUANG T H, CHI C C. Effect of adding Ge on rapid whisker growth of Sn-3Ag-0.5Cu-0.5Ce alloy[J]. Journal of Alloys and Compounds, 2009, 480(2): 974-980.
[144] GAO Q, ZHAO M, WANG H F. SMT solder joint��s semi-experimental fatigue model[J]. Mechanics Research Communications, 2005, 32(3): 351-358.
[145] �� ��, Ѧ�ɰ�, ��ʤ��, ���ڽ�, ������, ¬����, ʢ ��. ����Ԫģ�������Ӻ���ɿ����о��е�Ӧ��[J]. �纸��, 2008, 38(9): 13-21, 72.
ZHANG Liang, XUE Song-bai, YU Sheng-lin, HAN Zong-jie, GAO Li-li, LU Fang-yan, SHENG Zhong. Application of FEM analysis in reliability of micro-soldered joints[J]. Electronic Welding Machine, 2008, 38(9): 13-21, 72.
[146] NADIMPALLI S P V, SPELT J K. Effect of geometry on the fracture behavior of lead-free solder joints[J]. Engineering Fracture Mechanics, 2011, 78(6): 1169-1181.
[147] ZHANG L, XUE S B, GAO L L, CHEN Y, YU S L, SHENG Z, ZENG G. Effects of trace amount addition of rare earth on properties and microstructure of Sn-Ag-Cu alloys[J]. Journal of Materials Science: Materials in Electronics, 2009, 20(12): 1193-1199.
[148] Ф����. ϡ��Pr��Sn-9Zn��Ǧǥ����֯�����ܵ�Ӱ��[D]. �Ͼ�: �Ͼ����պ����ѧ, 2011.
XIAO Zheng-xiang. Effect of Pr on the microstructure and properties of Sn-9Zn lead-free solder[D]. Nanjing: Nanjing University of Aeronautics and Astronautics, 2011.
[149] BUBAN J P, MATSUNAGA K, CHEN J, SHIBATA N, CHING W Y, IKUHARA Y. Grain boundary strengthening in alumina by rare earth impurities[J]. Science, 2006, 311(5758): 212-215.
[150] �� ӱ. ��Ǧϡ��ǥ��SMT������ѭ��ʧЧ�����о�[D]. ������: ��������ҵ��ѧ, 1996.
ZHU Ying. Failure mechanism of SMT Sn-Pb-RE solder joint during thermal cycling[D]. Harbin: Harbin Institute of Technology, 1996.
(�༭ ����)
������Ŀ�����տƼ���ѧ�Ƚ����Ӽ���ʡ���ص�ʵ���ҿ����о�������������(JSAWS-11-03)������ʦ����ѧ��Ȼ��ѧ�о�������Ŀ(11XLR16)
�ո����ڣ�2011-05-31�������ڣ�2012-01-17
ͨ�����ߣ��� ������ʦ����ʿ���绰��0516-83500260��E-mail: zhangliang@jsnu.edu.cn
ժ Ҫ��ϡ��Ԫ��������ص����Ʊ���Ϊ�������ϵ�ά������ϡ��Ԫ�ص����ӿ����ڲ�ͬ�̶��������Ǧǥ�ϵ����ܡ���Ϲ������ں�ϡ��Ԫ����Ǧǥ���о�����������о��ɹ����ۺ�����ϡ��Ԫ�ض���Ǧǥ����֯�����ܵ�Ӱ�죬������ϡ��Ԫ�ص���Ǧ����ɿ����о���״��Ϊ��ǥ�ϵ�ʵ��Ӧ���ṩ����֧�ţ���������ϡ��Ԫ�ض���Ǧǥ�ϱ��������Ӱ�죬̽��������������Ƽ�DZ�ڵ����⣬����ۺ�������ϡ����Ǧǥ�����о������д��ڵ������Լ���Ӧ�Ľ����ʩ��Ϊ��ϡ��Ԫ����Ǧǥ�ϵ��о���Ӧ���ṩ�������ݡ�


