���±�ţ�1004-0609(2010)01-0163-07
�����ṹCeO2/SiO2����ĥ�ϵĺϳɼ���Ӧ��
�� ��1, 2��¡��ΰ1����־��1
(1. ���չ�ҵѧԺ ���Ͽ�ѧ�빤��ѧԺ������ 213164��
2. �����и߷����²����ص�ʵ���ң����� 213164)
ժ Ҫ��
������������ˮ�����õ�SiO2��Ϊ�ںˣ����þ��ȳ������Ʊ����в�ݮ״�����ṹ��CeO2/SiO2���Ϸ��塣����X���������ǡ������������X���߹����������(XPS)����̬��ɢ���Ǻ�Zeta��λ�ⶨ�ǵ��ֶΣ������Ʊ���Ʒ������ṹ����ɡ���ò��������С���б����������Ʊ��İ����ṹCeO2/SiO2���Ϸ������ڹ辧Ƭ��������Ļ�ѧ��е�⣬��ԭ��������(AFM)�۲�����������ò����������ֲڶȣ�����������ȥ���ʡ�������������Ʊ���CeO2/SiO2���Ͽ����ʹ������Σ�ƽ������Ϊ150~200 nm��CeO2��������SiO2�ں˱���������ȡ�CeO2�����İ��������ظı临�Ͽ�������ĵ綯��ѧ��Ϊ��CeO2/SiO2���Ͽ����ĵȵ��Ϊ6.2�������Ե�ƫ��CeO2��CeO2�����SiO2�ں�֮���γ�Si��O��Ce�������߲�����ѧ����ϣ����Ĺ��������������2 ��m��2 ��m��Χ�ڴֲڶ�Ϊ0.281 nm������ȥ���ʴﵽ454. 6 nm/min��
�ؼ��ʣ�
CeO2/SiO2����ĥ������������ѧ��е����
��ͼ����ţ�TB383���� ���ױ�ʶ�룺A
Synthesis and application of CeO2-coated SiO2 composite abrasives
CHEN Yang1, 2, LONG Ren-wei1, CHEN Zhi-gang1
(1. School of Materials Science and Engineering, Jiangsu Polytechnic University, Changzhou 213164, China;
2. Key Laboratory of Polymer Materials, Changzhou 213164, China)
Abstract: The SiO2 nanoparticles prepared by the hydrolyzing tetraethylorthosilicate were directly coated with CeO2 by chemical precipitation technique. The as-prepared samples were analyzed with X-ray diffractometry(XRD), transmission electron microscope, X-ray photoelectron spectrometer, dynamic light scatter and Zeta potential analyzer. The thermal oxide film covered silicon wafer was polished by CeO2-coated SiO2 composite abrasives, and the polishing behavior of the novel composite abrasives was characterized by atomic force microscope (AFM). The results indicate that the monodisperse, spherical CeO2-coated SiO2 particles have a particle size of 150?200 nm and are uniformly coated by the CeO2 nanoparticles. The isoelectric point of CeO2-coated SiO2 nanoparticles is about 6.2, which displays a significant shift toward pure CeO2. The shell CeO2 is chemically bounded with SiO2 core, and the Si��O��Ce bond forms between them. The surface roughness within 2 ��m��2 ��m area of thermal oxide film polished by CeO2-coated SiO2 composite abrasives is 0.281 nm, and the material removal rate reaches 454.6 nm/min.
Key words: CeO2-coated SiO2 composite abrasives; coating; chemical mechanical polishing
�����ģ���ɵ�·(ULSI)�������ɶ���ߡ������ߴ���١������߲�������ȷ���չ���Ի�ѧ��е��(Chemical mechanical polishing��CMP)����������ҲԽ��Խ��CeO2ĥ�����ھ��кܸߵĻ�ѧ���ԣ���ULSI�Ƴ��б��㷺Ӧ���ڶ���������ʲ�Ļ�ѧ��е��[1?2]�������ھ��ܹ�ѧϵͳ����[3]��Ҳ���Ź㷺��ʹ�ã����ֳ��������������
������������ĥ�ϵĿ�����ΪCMP�����е�һ���о��ȵ㡣ͨ�����������ӵĽṹ����ò�Լ�������/��ѧ���ʽ�������ƣ�ϣ���ܹ���һ�������������������������ȱ�ݡ����������͵�Ӧ����WANG��[4]���û���ȼ�շ��Ʊ�TiO2��������CeO2���壬���ɹ�Ӧ���ڹ辧Ƭ�Ļ�ѧ��е�⣬ʹ�����������50%������ȱ�ݽ���80%��
LEE��[5]��SONG��[6]�ֱ���ˮ����������Ϊ���������Ʊ���������300 nm���ҵİ�����CeO2/SiO2���Ϸ��塣Ф�����[7]��������Ϊ�������Ʊ���������CeO2/SiO2����ĥ�ϣ��������ֹ��̲�����Ƭ���⡣LEI��[8]��ͨ��������Եķ�������Al2O3ĥ�ϱ����֦�۱�ϩ�����Խ�����Ӳ�ȣ�ʹ�ò�����Ƭ����������õ����ơ�ARMINI��[9?12]�Ʊ����Ծۼ���ϩ����Ϊ�ˣ��������SiO2��CeO2�������л�/������ĥ�ϣ�Ӧ����SiO2���ʲ��ͭ�Ļ�ѧ��е�⡣���⣬CECIL��[13]Ҳ�Ʊ���һ��������CeO2����Ϊ�ˣ����������N?�������ϩ��������/�л�����ĥ�ϡ�
���������Ե���ɢ����SiO2��Ϊ�ںˡ�HMTΪ������������Һ��������Ʊ��˾��в�ͬ�������İ�����CeO2/SiO2������ĥ�ϣ�ͨ��TEM��XRD��XPS��DLS���ֶζ�����б������������Ʊ��ĸ���ĥ�����Ƴ��⽬�ϣ��������SiO2���ʲ�Ļ�ѧ��е�����ܣ���AFM�۲��������ò����������ֲڶȣ�����������ȥ�����ʡ�
1 ʵ��
1.1 SiO2�ں˵��Ʊ�
������ȡ��ˮ40.8 g�����ձ��У�����ȥ����ˮ23.4 mL���ټ�����������ˮ�Ҵ�ϡ����500 mL��������Ⱥ�����25 �����ˮԡ�б��£��õ���ӦҺA���ٳ�ȡ����������(TEOS)41.7 mL��ͬ������������ˮ�Ҵ�ϡ����500 mL���õ���ӦҺB���ڵ�Ž���������»����ؽ���ӦҺB�μӵ���ӦҺA�У��μ���Ϻ��������8 h���»�16 h���������ķ��롢ϴ��(ȥ����ˮϴ2�飬��ˮ�Ҵ�ϴ1��)��������70 ��Ĺķ�������к�ɣ���������������в���ĥ��500 ������1 h�����ɵõ�����ɢ��������SiO2���塣
1.2 CeO2/SiO2���Ϸ�����Ʊ�
��ȡ�������������Ʊ���SiO2����1 g����ɢ��50 mLȥ����ˮ�У���ͨ����������е����ǿ����ɢ���ټ���Ħ����Ϊ1?5����ˮ������������Ǽ��İ��������Ƶķ�Ӧ��Һ�ڵ�Ž���������£���75 ���·�Ӧ2 h�������������ķ��롢ϴ��(ȥ����ˮϴ2�顢��ˮ�Ҵ�ϴ1��)��������70 ��ķ�������к�ɡ���ĥ���پ�500 ������2 h�����ɵõ�����ɫ��CeO2/SiO2���Ϸ��塣�ڱ�ʵ���У�ͨ��������ˮ��������ļ��������Ӷ��Ʊ���ͬCeO2������(20%��40%��60%��80%��100%��150%)�ĸ��Ϸ��壬����CeO2�����İ�������[m(CeO2)/m(SiO2)]��100%��ʾ��
1.3 ��Ʒ�ı���
����Rigaku X-III���������Ƿ�����Ʒ������ṹ��ɨ��Ƕȷ�ΧΪ10?~80?���ú���Philips��˾Tecnai?12����羵�۲���Ʒ����ò�������������� Thermo ESCALAB 250����������Ƿ�����Ʒ����Ļ�ѧ��ɼ�����ܣ���Ӣ��Malvern��˾Nano ZS�����������ȷֲ���Zeta��λ�Dz�����Ʒ�����ȷֲ��͵ȵ�㡣
1.4 ������
��ȡһ������CeO2/SiO2����ĥ�����Ƴ���������Ϊ1%���⽬�ϣ��ð�ˮ�����ϵ�pHֵ����10����������ʹ�õ���Struers��˾TegraForce?1/ TrgraPol?15�;��������SiO2���ʲ�(�ڹ�ĵ����������������������Լ1 ��m)������ʵ�顣����ղ���Ϊ����ѹ��0.025 MPa����ʱ��1 min����������200 mL/min�����̺�����ת�ٷֱ�Ϊ90 r/min��60 r/min��������Ϊ��ë��֯��(MP-Mol������Struers��˾)��
��ԭ��������(Nanoscope ��a��Mutimode SPM������DI��˾������ֱ���Ϊ0.1 nm������ֱ���Ϊ0.01 nm)�۲����Ƭ�ı�������ò�����������ֲڶȣ�������ʿMETTLER TOLEDO XS105�ͷ�����ƽ(����Ϊ0.01 mg)������ǰ�������������ɺ�Ȳ�õ���Ӧ�IJ���ȥ���ʡ�
2 ��������
2.1 ��Ʒ��XRD����
���Ʊ���SiO2����ͬ��������CeO2/SiO2���Ϸ����Լ���CeO2��XRD����ͼ1��ʾ����ͼ1�п��Կ��������Ʊ��ĸ��Ϸ����г������Ե�������CeO2�����������(JCPDS34-0394)��˵����Ʒ�д���CeO2��ͬʱ���Ÿ��Ϸ�����CeO2�����������࣬��Ʒ��XRD����SiO2�������Խ��Խ�����ԣ���CeO2�������ȴԽ��Խǿ���ر��ǵ�����������60%ʱ�������Ѿ�������SiO2������壬�ɴ˿����ƶ�SiO2�ں˱��漸���Ѿ���ȫ��CeO2������

ͼ1 ��ͬCeO2��������Ʒ��XRD��
Fig.1 XRD patterns of samples with different coating amounts: (a) Pure SiO2; (b) 20%; (c) 40%; (d) 60%; (e) 80%; (f) 100%; (g) 150%; (h) Pure CeO2
2.2 ��Ʒ��TEM�۲�
���Ʊ�SiO2�����TEM������ȷֲ���ͼ2��ʾ������Ʒ��TEM����Կ��������Ʊ���SiO2���������Σ�������150~180 nm���ң���ɢ�����á����Ҵ����ȷֲ�����Ҳ���Կ�������Ʒ�����ȷֲ���խ��ͨ�����������������ⶨ��ƽ������Ϊ166.5 nm����TEM�����۲쵽�Ŀ�����С����һ�¡�

ͼ2 ���Ʊ�SiO2�����TEM������ȷֲ�
Fig.2 TEM image (a) and particle size distribution curve(b) of SiO2 particles
���Ʊ���ͬ��������CeO2/SiO2���Ϸ����TEM����ͼ3��ʾ����ͼ3���Կ��������Ʊ���CeO2/SiO2���Ϸ�������Σ���������150~200 nm���ң������в�ݮ״�İ����ṹ��������SiO2�����CeO2������������5~10 nm���ҡ���������Ϊ20%��40%ʱ����Ʒ�е�CeO2������û����ȫ����SiO2�ں˱��棬����CeO2�����İ���Ҳ�����ȡ����Ű����������ӣ�SiO2�ں˱����ϵ�CeO2���������ࣻ���������ﵽ60%��80%��100%ʱ��CeO2�����ܹ���SiO2�ں˽�Ϊ�����ذ������������а�����Ϊ80%����Ʒ�������������Dzⶨ����ƽ������Ϊ178.6 nm����TEM����ֱ�ӹ۲�Ľ��Ҳ����һ�¡������������ﵽ
150%ʱ����Ʒ���ֻ���ְ��������ȵ���������Ұ�����SiO2�ں˱����ϵ�CeO2�����ž������Ϊ���ԣ��������˵����κ˵�CeO2������������ǰ�����Ӧ��������Ũ�ȹ��ߣ����¾ֲ�Ũ�Ȳ���������ɵġ�
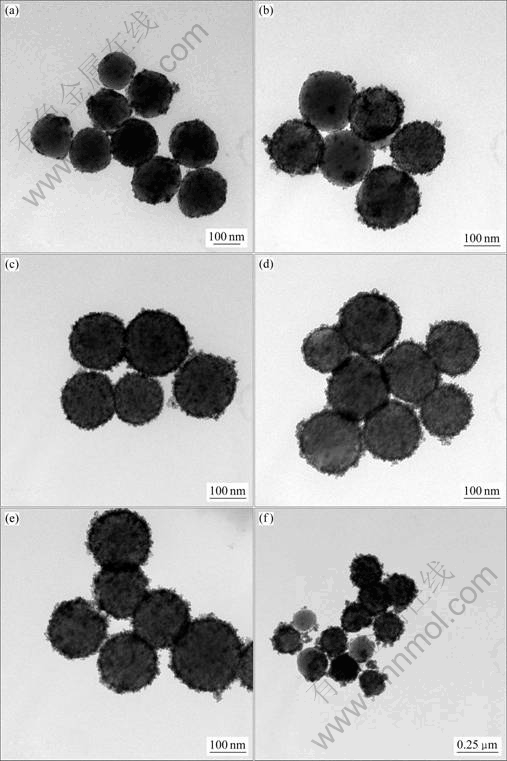
ͼ3 ��ͬ��������CeO2/SiO2�����Ϸ����TEM��
Fig.3 TEM images of CeO2-coated SiO2 nanoparticles with different coating amounts: (a) 20%; (b) 40%; (c) 60%; (d) 80%; (e) 100%; (f) 150%
2.3 ��Ʒ��Zeta��λ�ⶨ
ͼ4��ʾΪ��SiO2��CeO2/SiO2���Ϸ���(������Ϊ80%)�Լ���CeO2��Zeta��λ��pH�ı仯���ߡ���ͼ4���Կ�������SiO2��CeO2/SiO2���Ϸ����Լ���CeO2�ĵȵ��(IEP)�ֱ���2.4��6.2��6.8��������������ĵȵ�����ԵشӴ�SiO2ƫ��CeO2����Ҳ���������Ϸ���İ�����������ȫ���ܵģ�����˵���������е�SiO2�ں˱�����Ȼ�Ա���CeO2������Zeta��λ����Ӱ��[5]��
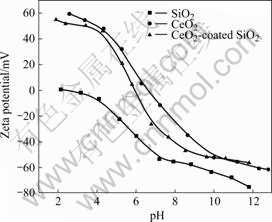
ͼ4 SiO2��CeO2��CeO2/SiO2���Ϸ����Zeta��λ��pH�Ĺ�ϵ
Fig.4 Relationships between Zeta potentials of SiO2, CeO2, and CeO2-coated SiO2 nanoparticle and pH
2.4 ��Ʒ��XPS����
�����ϱ���ԭ�ӵ�ԭ�Ӽ�̬�����仯������縺�Բ�ͬ��ԭ������ʱ��ԭ�ӵĻ�ѧ�����ᷢ���ı䣬ʹ��ԭ�ӵ����۵����ܶȷ����仯���ڲ�����ܵ�ԭ�Ӻ�ǿ�ҵĿ������ã�ʹ���ӵĽ���ܷ����仯����ˣ�����ͨ��XPS���ⶨԪ�صĽ����λ�ƣ��Ӷ��Ʋ�ԭ�ӿ��������Ļ�ѧ����[14]��
SiO2��CeO2�Լ�CeO2/SiO2���Ϸ���(������Ϊ80%)��Ʒ��O1s��Si2s��Ce3d��XPS�ֱ���ͼ5~7��ʾ�������Ʒ��Si��Ce��OԪ�صĽ�������1���С�
��ͼ5~7�ͱ�1���Կ�����������Ʒ��O1s(O��Ce)�Ľ���ܺ���ǿ�ȼ���û���κη����仯����Si2s��O1s(O��Si)�Ľ���ֱܷ���0.75��1 eV��Ce3d�Ľ���ܽ�����0.3 eV�����������ԵĻ�ѧλ�ơ����⣬������Ʒ��O1s(O��Si)��Si2s��Ce3d��ǿ�����Լ���������������ڻ�ѧ�����γɶ�����Si��Ce��OԪ�صĽ���ܷ����仯���ɴ˿����ƶϣ�������Ʒ��SiO2�ں˱����CeԪ���Ի�ѧ����SiO2�����ϣ����γ���Si��O��Ce��������Si�ĵ縺�Ա�Ce�����Siԭ�����ܵĵ����ܶ���������ЧӦ�����ӽ���ܼ�С��ͬʱ����Si���ϵ�Oԭ����Χ�ĵ����ܶ�Ҳ������ߣ���������ӽ���ܼ��͡�

ͼ5 SiO2��CeO2��CeO2/SiO2���Ϸ�����Ʒ��O1s XPS��
Fig.5 O1s XPS spectra of SiO2, CeO2, and CeO2-coated SiO2 samples

ͼ6 SiO2��CeO2/SiO2���Ϸ�����Ʒ��Si2s XPS��
Fig.6 Si2s XPS spectra of SiO2 and CeO2-coated SiO2 samples

ͼ7 CeO2��CeO2/SiO2���Ϸ�����Ʒ��Ce3d XPS��
Fig.7 Ce3d XPS spectra of CeO2 and CeO2-coated SiO2 samples
��1 SiO2��CeO2��CeO2/SiO2���Ϸ�����Ʒ��O1s��Si2s��Ce3d�Ľ����
Table 1 Binding energies of O1s, Si2s and Ce3d of SiO2, CeO2 and CeO2-coated SiO2 samples(eV)

2.5 ������AFM�۲�
��CeO2/SiO2������ĥ��(������Ϊ80%)��
�辧Ƭ���������AFM�۶�ά��ò����ά��ò��ͼ8��ʾ����ͼ8���Կ��������辧Ƭ����û�в������صĻ�е���˺ͻ��ۣ�ƽ���ȽϺã���2 ��m��2 ��m��Χ�������ֲڶ�Ϊ0.281 nm���ֲڶȾ�����ֵΪ0.418 nm�����ⶨȥ���ʿɴﵽ454.6 nm/min���Ա�����[5]��[15]��[16]��֪���ð����ṹCeO2/SiO2����ĥ�Ͽ�������������������Ļ����ϣ���Ч����߲��ϵ�ȥ���ʡ�

ͼ8 CeO2/SiO2����ĥ�����辧Ƭ����������AFM����ò
Fig.8 AFM images of oxide wafer surface after being polished with CeO2-coated SiO2 composite abrasives
3 ����
1) �����Ƶ�����SiO2��Ϊ�ںˣ����þ��ȳ������ɹ��Ʊ������Ρ����в�ݮ״�����ṹ��������150~200 nm��CeO2/SiO2���Ϸ��塣Zeta��λ����������CeO2�����İ��������ظı��˸��Ͽ�������ĵ綯��ѧ��Ϊ��ʹ����ȵ�����Ե�ƫ��CeO2��XPS���������ʾ��������Ʒ��O1s(O��Si)��Si2s�Ľ���ܷ��������ԵĻ�ѧλ�ƣ��ɴ˿��ƶ�CeO2������SiO2�ں�֮���γ���Si��O��Ce�������߲�����ѧ����ϡ�
2) �����Ĺ辧Ƭ�������������2 ��m��2 ��m��Χ�ڴֲڶ�Ϊ0.281 nm�������ƽ��������ȥ���ʴﵽ454. 6 nm/min��
[1] PARK B Y, LEE H S, PARK K H, KIM H J, JEONG H D. Pad roughness variation and its effect on material removal profile in ceria-based CMP slurry[J]. Journal of Materials Processing Technology, 2008, 203(1/3): 287�C292.
[2] SONG Xiao-lan, XU Da-yu, ZHANG Xiao-wei, SHI Xun-da, JIANG Nan, QIU Guan-zhuo. Electrochemical behavior and polishing properties of silicon wafer in alkaline slurry with abrasive CeO2[J]. Trans Nonferrous Met Soc China, 2008, 18(1): 178?182.
[3] WANG Liang-yong, ZHANG Kai-liang, SONG Zhi-tang, FENG Song-lin. Ceria concentration effect on chemical mechanical polishing of optical glass[J]. Applied Surface Science, 2007, 253(11): 4951?4954.
[4] FENG Xiang-dong, SAYLE D C, WANG Zhong-lin, PARAS M S, SANTORA B, SUTORIK A C, SAYLE T X T, YANG Yi, DING Yong, WANG Xu-dong, HER Y S. Converting ceria polyhedral nanoparticles into single-crystal nanospheres[J]. Science, 2006, 312: 1504?1508.
[5] LEE S H, LU Z Y, BABU S V, MATIJEVI? E. Chemical mechanical polishing of thermal oxide films using silica particles coated with ceria[J]. Journal of Materials Research, 2002, 17(10): 2744?2749.
[6] SONG Xiao-lan, JIANG Nan, LI Yu-kun, XU Da-yu, QIU Guan-zhou. Synthesis of CeO2-coated SiO2 nanoparticle and dispersion stability of its suspension[J]. Materials Chemistry and Physics, 2008, 110(1): 128?135.
[7] Ф����, �� ��. ����SiO2/CeO2����ĥ�����Ʊ������������о�[J]. Ħ��ѧѧ��, 2008, 28(2): 103?107.
XIAO Bao-qi, LEI Hong. Preparation of nano SiO2/CeO2 composite particles and their polishing performance[J]. Tribology, 2008, 28(2): 103?107.
[8] LEI Hong, LU Hai-shen, LUO Jian-bin, LU Xin-chun. Preparation of ��-alumina-g-polyacrylamide composite abrasive and chemical mechanical polishing behavior[J]. Thin Solid Films, 2008, 516(10): 3005?3008.
[9] ARMINI S, WHELAN C M, MOINPOUR M, MAEX K. Composite polymer core- silica shell abrasives: The effect of polishing time and slurry solid content on oxide CMP[J]. Electrochemical and Solid-State Letters, 2007, 10(9): 243?247.
[10] ARMINI S, WHELAN C M, MOINPOUR M, MAEX K. Composite polymer core-silica shell abrasives: The effect of the shape of the silica particles on oxide CMP[J]. Journal of the Electrochemical Society, 2008, 155(6): 401?406.
[11] ARMINI S, de MESSEMAEKER J, WHELAN C M, MOINPOUR M, MAEX K. Composite polymer core-ceria shell abrasive particles during oxide CMP: A defectivity study[J]. Journal of the Electrochemical Society, 2008, 155(9): 653?660.
[12] ARMINI S, WHELAN C M, MAEX K. Engineering polymer core-silica size in composite abrasives for CMP applications[J]. Electrochemical and Solid-State Letters, 2008, 11(10): 280?284.
[13] CECIL A C, SUBRAHMANYA R M, ASHOK K, VINAY K G. Novel ceria-polymer microcomposites for chemical mechanical polishing[J]. Applied Surface Science, 2008, 255(5): 3090?3096.
[14] ������, �˺���, �α���, �����. XPS�о�Fe2O3�������ӱ��������Ĥ[J]. ������ѧ��, 2002, 17(4): 782?786.
WANG Qi-xiang, PAN Hai-bin, SONG Bao-zhen, LI Hong-zhong. Surface properties of inorganic coated Fe2O3 nanoparticles characterized by XPS[J]. Journal of Inorganic Materials, 2002, 17(4): 782?786.
[15] PARK S W, SEO Y J, LEE W S. A study on the chemical mechanical polishing of oxide film using a zirconia (ZrO2)-mixed abrasive slurry (MAS)[J]. Microelectronic Engineering, 2008, 85: 682?688.
[16] KIM N H, KO P J, CHOI G W, SEO Y J, LEE W S. Chemical mechanical polishing (CMP) mechanisms of thermal SiO2 film after high-temperature pad conditioning[J]. Thin Solid Films, 2006, 504: 166?169.
������Ŀ������ʡ��ҵ֧�żƻ�������Ŀ(BE2008037)�������й�ҵ�Ƽ�����������Ŀ(CE2007068, CE2008083)
�ո����ڣ�2009-03-23�������ڣ�2009-05-25
ͨ�����ߣ���־�գ����ڣ��绰��0519-86330002��E-mail: cy.jpu@126.com
(�༭ ����Ⱥ)
ժ Ҫ��������������ˮ�����õ�SiO2��Ϊ�ںˣ����þ��ȳ������Ʊ����в�ݮ״�����ṹ��CeO2/SiO2���Ϸ��塣����X���������ǡ������������X���߹����������(XPS)����̬��ɢ���Ǻ�Zeta��λ�ⶨ�ǵ��ֶΣ������Ʊ���Ʒ������ṹ����ɡ���ò��������С���б����������Ʊ��İ����ṹCeO2/SiO2���Ϸ������ڹ辧Ƭ��������Ļ�ѧ��е�⣬��ԭ��������(AFM)�۲�����������ò����������ֲڶȣ�����������ȥ���ʡ�������������Ʊ���CeO2/SiO2���Ͽ����ʹ������Σ�ƽ������Ϊ150~200 nm��CeO2��������SiO2�ں˱���������ȡ�CeO2�����İ��������ظı临�Ͽ�������ĵ綯��ѧ��Ϊ��CeO2/SiO2���Ͽ����ĵȵ��Ϊ6.2�������Ե�ƫ��CeO2��CeO2�����SiO2�ں�֮���γ�Si��O��Ce�������߲�����ѧ����ϣ����Ĺ��������������2 ��m��2 ��m��Χ�ڴֲڶ�Ϊ0.281 nm������ȥ���ʴﵽ454. 6 nm/min��


