���±��: 1004-0609(2004)10-1694-06
Sn-Zn-Cu��Ǧǥ�ϵ���֯�� ��ʪ�Ժ���ѧ����
л��ƽ, �ڴ�ȫ, ������, �� ��
(����������ѧ ���Ϲ���ϵ, ���� 116024)
ժ Ҫ��
�о���(Sn-9Zn)-xCu��Ǧǥ�ϵ�����֯�� ��ʪ���ܺ���ѧ���ܡ� Cu�ļ���ʹ��Sn-9Znǥ������״��Zn����ת��ΪCu-Zn������, ��Cu����Ϊ8%ʱ, Cu6Sn5�����ɡ� Sn-Zn-Cu�Ͻ��۵�����Cu�������Ӷ�����, ͬʱ��ʪ����Cu�ļ���õ��������ơ� ʹ�����Ի�������ǥ��, ǥ����Cu��ǥ��ʱ����ʪ��������С�� Sn-9Zn����ʪ��Ϊ120��, ��(Sn-9Zn)-10Cu����ʪ��Ϊ54�㡣 ��������Cu�ļ��뽵����Zn�Ļ���, ������Zn��ǥ�ϱ�������, ������Һ̬ǥ�ϱ�������, ʹ��ǥ���ܻ�ýϺõ���ʪ�ԡ� �Ͻ���2%Cuʱ��ýϸߵ�ǿ��, ����Cu����������, Cu-Zn�������������, ����ǿ�������½�; ���Ͻ����������Cu�ļ���Ѹ���½���
�ؼ���: ��Ǧǥ��; Sn-Zn-Cu; ����֯; ��ʪ��; ����ǿ�� ��ͼ�����: TG425.1
���ױ�ʶ��: A
Microstructure, wettability and mechanical properties of Sn-Zn-Cu lead free solder
XIE Hai-ping, YU Da-quan, MA hai-tao, WANG Lai
(Department of Materials Engineering, Dalian University of Technology, Dalian 116024, China)
Abstract: The microstructures, wettability and mechanical properties of (Sn-9Zn)-xCu lead free solders were investigated. The addition of Cu element leads the needle Zn rich phase to transform into Cu-Zn compounds and when Cu is 8%, Cu6Sn5 phase emerges. The melting point increases with increasing Cu content; while the wetting properties is improved dramatically. When the solder reflows on Cu substrate, the wetting angle decreases greatly using mildly active rosin (RMA) flux. The wetting angle of Sn-9Zn is 120��; while that of (Sn-9Zn)-10Cu is 54��. The improvement on wettability is due to the addition of Cu which decreases the activity of Zn and refrains the oxidation of Zn atoms at the surface of liquid solder. Better wetting behavior is gotten because of the lower surface tension of liquid solder. And the solders get the higher tensile strength when Cu content is 2%. With more Cu addition, more Cu-Zn compounds formation deteriorates the solder strength and the ductility decreases greatly with Cu addition.
Key words: lead free solder; Sn-Zn-Cu; microstructure; wettability; tensile strength
��ͳ��Ǧ(SnPb)���ϵ�Ӧ������ǧ�����ʷ, ��Ŀǰ���ӷ�װ��������Ҫ���ϡ� ����Ǧ���仯���������ж�����, ������������Ͱ�ȫ�����ϴ��Σ���� �������ķ�Ǧ�鰸HR-5374(��������)�� S-2637��S-391(��������Ժ)�������, ȫ���������֯�� ���л�����˾���Ƴ�ϵ�н������ ���������ͻ�����Ʒ�� 2003��2��13��, ŷ�˹����ˡ����ϵ��ӵ���ָ��͡������ڵ��ӵ����豸�н�ֹʹ��ijЩ�к�����ָ�, �涨2006��7��1�պ�Ͷ���г��ĵ����͵����豸���ú��а���Ǧ�����ڵ�6���к����ʡ� �ڻ���Ҫ�� �г���������ص�Լ�����ƶ���, ���ӷ�װ����Ǧ����Ϊѧ�����ҵ����ش��ѧ����ǰ�ؿ�����ϵͳ��������[1-3]��
Ŀǰ�����о���������Ǧǥ�ϴ����SnΪ��, ����һЩ���� �ӷ���Ԫ����Ag�� Zn�� Cu�� Bi�� In����Ϊ�Ͻ�Ԫ�ء� Ŀǰ�㷺�о�����Ǧǥ����ҪΪSn-Ag�� Sn-Bi�� Sn-Cu�� Sn-Zn�Լ�Sn-Ag-Cu�Ͻ�[3-6]�� ����Sn-Znǥ������ͳɱ��� �������ѧ���ܶ���Ϊ��Ǧǥ���м���ǰ���ľ�����֮һ�� ��Zn�������� ��ʪ�Բ��ȱ������Ҫ�������Ҫ����[7, 8]�� Mccormack ��[9]������Sn-Znϵ�Ͻ��м���5%~10%��In������Ч�����۵�����ǥ�ϵ���ʪ���ܡ� Lin��[10, 11]���ּ���Al֮���ܹ����ǥ�ϵĿ�������, ���ڽ��洦��õ�һ�㻯�����ܹ���Ч��ֹSn�� Cu������Ӧ�� ͬʱ, ����������Bi�� Ag�Լ�ϡ��Ԫ�ص���֯��ʪ�Ժͽ��淴Ӧ�������о��ͷ���[12-18]; �����ӺϽ�Ԫ�ض�Sn-Zn�Ͻ�Ŀ���ʴ��Ҳ����������о�[19]�� Ϊ��������, Vaynman ��[20]���Ժ�Znǥ�ϵ�ǥ��������ר���о���
���о���, ͨ����Sn-9Zn�Ͻ��м���CuԪ��, �о��ɷ�ת��ԺϽ����֯�� �ۻ���Ϊ�� ��ʪ�Ժ���ѧ���ܵ�Ӱ��, Ϊ����ۺ��������á� �ɱ���������Ǧǥ�ϵ춨������
1 ʵ��
�Ͻ�ɷ�(Sn-9Zn)-xCu, x=0, 0.5, 1, 2, 4, 6, 8, 10(Ϊ�������, ����Sn-9Zn ��дΪSZ��Cu�ĺ�����Ϊ��������, %)����������ú����������¯������, �����¶�Ϊ600��, ����4h�� ����ԭ��Sn, Zn, Cu�Ĵ��ȷֱ�Ϊ99.95%, 99.99%, 99%�� �Ͻ���(500��3)��ĵ���¯�����ۺ�, ������d8mm��Բ����
�ò�ʾɨ�����ȼ�(DSC)�ⶨ��Ǧǥ�ϺϽ��ۻ��¶ȡ� ǥ������ԼΪ10mg, ��Ʒ��ͨ��ߴ�N2��Ϊ�������ա� �����¶ȷ�ΧΪ50~550��, �����ٶ�Ϊ10��/min��
����ǥ����Cu��ǥ�����о�����ʪ�ԡ� Cu������Ϊ99.9%, ��1000#ɰֽϸĥ��, ��NaOH��Һ�� HCl��Һ�� ˮ��Һ�ֱ����15s�ɡ� ����ǥ�Ͽ�ߴ�Ϊd5mm��1.5mm, ����ԼΪ200mg�� ����Ϊ�������㺸��(RMA), ��ǥ�Ϸ�����Cu����, ����������¯����ǥ��, ����������������ͼ1��ʾ�� Ϊ���������ʪ�ǵIJ���, ǥ����ͷ�û�����֬������Ƕ��
ǥ�ϻ��塢 ���ӽ�ͷ����ĥ�� ��, �����92%�״�-5%����-3%����(�����)��ʴҺ���и�ʴ�� ����SEM, EMPA�۲������֯���ɷֲַ�, ����EDS�� XRDȷ����ɷ֡�
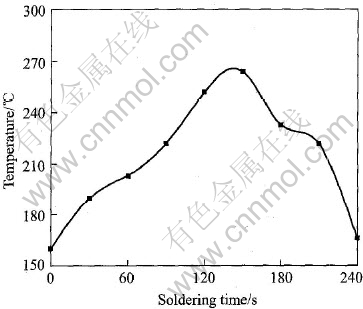
ͼ1 ��������������ʾ��ͼ
Fig.1 Reflow curve for soldering process
ǥ�������������Զ����Ƶ�����������������Ͻ���, ��������Ϊ 10mm/min�� ����������GB397��86���Ʊ�, ֱ��Ϊ5mm, ��Ϊ25mm, ��ͼ2��ʾ��

ͼ2 ��������ʾ��ͼ
Fig.2 Schematic diagram of tensile specimen
2 ���������
ͼ3��ʾΪSZ�� SZ-2Cu�� SZ-6Cu�� SZ-10Cu�ڸ��������»�õ�����֯��ò�� ��SZ�Ͻ���, ��״��Zn����ȷֲ���Sn�����϶����ֳ����͵Ĺ����ṹ�� ����Cu��������, ��SZ-2Cuǥ���и�Zn������ʧ, ȡ����֮����һ�ֿ���״����� ����Cu-Sn�� Cu-Zn��Ԫ��ͼ, Cu��Sn�� Zn�������ɻ�����Ŀ���, ��Cu5Zn8��ļ���˹�����ܱ�Cu6Sn5��ĵ�, ��˹۲쵽�����ֻ�����ֻ��ΪCu-Zn����� ����SZ-2Cu�Ͻ���Cu��Zn��������Ϊ2��8.82, ����Sn�п��Թ������Ϊ[CM(22]2%��Znԭ��[3], �����ͼ3(b)��Ӧ�����������ĸ�Zn�ࡣ ����Cu��������ʱ, ��Zn����ʧ, ��Cu-Zn������������ಢ���� ��Cu�������ӵ�8%��, ����Cu6Sn5�ʼ���֡� �����ڸ���������, ��ʹ��Cu�������ӵ�10%, �Ͻ����֯��Ȼ�Ƚ�ϸ�ܡ�

ͼ3 ����������ǥ������֯
Fig.3 SEM images of steel-cooled solders
ͼ4��ʾΪ��ͬ�ɷ�ǥ�ϵ�X��������ͼ�� ��Cu ����С��4%ʱ, ǥ�ϺϽ���Ҫ�ɸ�Sn�ࡢ ��Zn���Cu5Zn8�����; ��Cu����Ϊ4%~8%ʱ, ��Ҫ��Sn�� Cu5Zn8�� CuZn�����; Cu��������8%ʱ, Cu6Sn5�ʼ����, ���Ͻ���֯��Sn�� CuZn ��Cu6Sn5��ɡ�
��1��ʾΪǥ��Һ�����ߺ��۵�, ͼ5��ʾΪDSC�������ߡ� �ӱ�1���Կ���SZ��199.5�淢��������Ӧ, ����Cu(0.5%)�ļ������ʹ�۵����½�, ����Cu�����ﵽ4%ʱ����CuZn����γ�, ������������ֵ�� ���ǿ��ֱܷ��Ӧ����Sn�� Cu5Zn8��������Ӧ��Sn�� CuZn��������Ӧ�� ����Cu����������, ǥ���۵���228������, ����֯���������֪, ����SZ�� SZ-2Cu, ��Ӧ��L��Sn+Zn+Cu5Zn8��Ӧ, Cu����6%ʱ��Ӧ�Ž�������[CM(22]Ӧ, ��Cu����Ϊ8%ʱ��Ӧ��L��Sn+CuSn+Cu6Sn5��������Ӧ�� ����SZ-4Cu��, ���еĺϽ��ڻ����䶼�Ƚ�С, ����γɺõĽ�ͷ��֯�������ġ�

ͼ4 SZ-xCuǥ��X����������
Fig.4 XRD patterns of SZ-xCu solder alloys
ǥ��������, Һ̬ǥ����ĸ�ı�����ʪ�� ������ ��չ������ëϸ������������ǥ��Ĺ�����ǥ��������������Ҫ��һ��, ֱ�ӹ�ϵ��ǥ���ijɹ����
��1 SZ-xCuǥ�ϵĹ̡� Һ�����۵�
Table 1 DSC results of SZ-xCu solders


ͼ5 Sn-Zn-Cuǥ�ϵ�DSC��������
Fig.5 DSC profile of Sn-Zn-Cu solder alloys
ͼ6��ʾΪǥ����Cu��ǥ����ʪ����Cu�����ı仯���ߡ� ��ͼ6�п��Կ���: CuԪ�ص������ܹ���Ч��ߺϽ����ʪ�ԡ� ��Cu����С��2%ʱ, ǥ����ʪ�dz�ֱ���½�, ����Cu�����IJ�������, ǥ�ϵ���ʪ����С, ������120���½�Ϊ54�����ҡ�
��ͼ7��֪, ƽ��״̬ʱ����ʪ�����ɽ����������������:

ʽ�� ��SF�� ��IF�� ��LF�ֱ�ָ����/ǥ��(substrate/flux)�� ǥ��/ǥ��(liquid solder/flux)�Լ�IMC/ǥ�� (IMC/liquid solder)֮��ı��������� ��ʽ(1)���Եó�, �� ��LF��Сʱ����(��SF-��IF)�ϴ�ʱ, ���ܵõ���С����ʪ�ǡ�
��SZǥ����, Zn�ڱ����������ɺϽ���нϴ�ı�������, Ӱ������ʪ�ԡ� ��Cu�ļ���ʹ[CM(22]��ǥ�ϸ�Zn��������̬��Znԭ����Cu������Cu-[CM)]

ͼ6 ǥ����Cu��ǥ����ʪ��
Fig.6 Wetting angle between SZ-xCu solder and Cu foil

ͼ7 ��ʪƽ��״̬�µı�������ʾ��ͼ
Fig.7 Schematic diagram of surface tension under equilibrium state
Zn����� ��ʹ���ۻ�ʱ, �����ۻ��¶Ƚϵ�, �Ͻ��л��������Cu-Zn�Ķ̳�����ṹ, �����г�����ṹ, ���Ȼ�ή��Znԭ�ӵĻ���, ����Znԭ����ǥ�ϱ��������, �Ӷ���Ч����Һ̬ǥ�ϵı��������� ��˵�Cu��������2%ʱ, Zn�� Cu���ɻ�����, ʹ��Һ̬ǥ���ܽϺõ���Cuĸ������չ��������ø�С����ʪ�ǡ� ����ǰ���о�����, ��ȻIn�� Bi�� RE�ļ��붼��һ���̶ȵ����SZ�Ͻ����ʪ��, ����, �����������ʮ������, ֻ���û���ǥ��(RA)���ܻ����ʪ�� ������Ϊ, ��ЩԪ���ڼ���ʱ, ��Zn����Ȼ����, Znԭ�ӵ�����ʹ�������������Ȼ�ܴ�, ��˺Ͻ����ʪ�����ɺܲ�[6, 16-18]��
ǥ�Ͽ���ǿ��(��b)�� ������(��)�� ������(��)��Cu�����Ĺ�ϵ��ͼ8��ʾ�� ��ͼ8�ɼ�, Cu����Ϊ2%ʱ, �俹��ǿ����60MPa������84MPa, ����˽ϸߵĿ���ǿ�ȡ� ��Cu������һ�����Ӻ�, ����ǿ�������½�, ��Cu����Ϊ10%ʱ, ��Sn-Zn�Ŀ���ǿ���൱�� �ɼ�, �����Cu-Zn��ij���, ����Cu-Sn�����������, ���ǥ��ǿ���������á� ���ִ�����Ĵ������ڼ�������ǥ�ϵ�����, ʹǥ�ϵ������ʺͶ���������Ѹ�ٽ��͡�
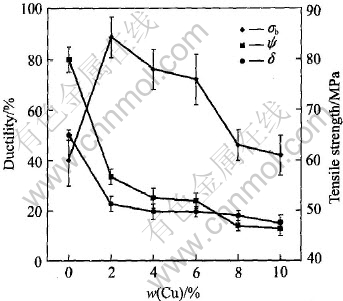
ͼ8 SZ-xCuǥ�Ͽ���ǿ�ȡ� �����ʡ� ��������ͭ�����Ĺ�ϵ
Fig.8 Relationship between Cu content and tensile strength, elongation and reduction of area of SZ-xCu solder alloys
3 ����
1) ��Cu����������8%ʱ, SZ-xCuǥ������Cu������������״��Zn����ת��ΪCu-Zn����� ��Cu��������8%��, Cu6Sn5�ʼ���֡�
2)SZ-xCu(0��x��10)ǥ���۵�����Cu�ļ���������, Cu����С��4%ʱ��Ӧ��L��Sn+Zn+Cu5Sn8��Ӧ, Cu��������4%С��8%ʱ��Ӧ��L��Sn+CuZn��������Ӧ, ��Cu��������8%ʱ��Ӧ��L��Sn+CuZn+Cu6Sn5��������Ӧ��
3) Cu�ļ��������Znԭ����ǥ�ϱ��������, ��Ч������Һ̬ǥ�ϵı�������, ʹǥ����Cu֮�����ʪ�Եõ��������, ����˽�С����ʪ�ǡ� ������Cu����������, �Ͻ��۵������ߡ�
4) SZ-xCu(0��x��10)ǥ�ϵĿ���ǿ������Cu������������������С�� Cu����Ϊ2%ʱ����˽ϸߵĿ���ǿ�ȡ� ��Cu������һ�����Ӻ�, �����Cu-Zn��ij���, ����Cu-Sn����������, ʹ�úϽ���ǿ�������½�, ͬʱCu�����ӻ�ʹǥ�ϵ������ʺͶ��������ʽ��͡�
REFERENCES
[1] Tu K N, Zeng K. Tin-lead (SnPb) solder reaction in flip chip technology [J]. Mater Sci Eng Rep, 2001, 34: 1-58.
[2] Zeng K, Tu K N. Six cases of reliability study of Pb-free solder joints in electronic packaging technology [J]. Mater Sci Eng Rep, 2002, 38: 55-105.
[3] Abtew M, Selvaduray G. Lead-free solders in microelectronics [J]. Mater Sci Eng Rep, 2000, 27(1): 85-141.
[4] Suganuma K. Advances in lead-free electronics soldering [J]. Current Opinion in Solid State and Materials Science, 2001, 5 (1): 55-64.
[5] ������, �ڴ�ȫ, ����, ��. Sn-6Bi-2Ag(Cu, Sb)��Ǧǥ�ϺϽ�����֯���� [J]. �й���ɫ����ѧ��, 2002, 12(3): 486- 490.
HUANG Ming-liang, YU Da-quan, WANG Lai, et al. Microstructures of Sn-6Bi-2Ag (Cu, Sb) lead free solder alloys [J]. The Chinese Journal of Nonferrous Metals, 2002, 12(3): 486-490.
[6] Cormack M Mc, JIN S. Improved mechanical properties in new, Pb-free solder alloys [J]. J Electron Mater, 1994, 23: 715-720.
[7] Suganuma K. Heat resistance of Sn-9Zn solder/Cu interface with or without coating [J]. J Mater Res, 2000, 15: 484-491.
[8] Yu S P, Lin H J. Effect of process parameters on the soldering behavior of the eutectic Sn-Zn solders on Cu substrate [J]. J Mater Sci, 2000, 11: 461-471.
[9] Mccormack M, Jin S. New lead-free Sn-Zn-In solder alloys [J]. J Electron Mater, 1994, 23: 687-690.
[10] Knott S. Thermodynamic properties of liquid Al-Sn-Zn Alloys: a possible new lead-free solder material [J]. Mater Trans, 2002, 43: 1868-1872.
[11] Lin K L, Hsu H M. Sn-Zn-Al Pb-free solder�� an inherent barrier solder for Cu contact [J]. J Electron Mater, 2001, 30: 1068-1072.
[12]Kim Y S. Effect of composition and cooling rate on microstructure and tensile properties of Sn-Zn-Bi alloys [J]. J Alloy Comp, 2003, 352: 237-245.
[13] ������, �ڴ�ȫ, �Խ�, ��. Sn-9Zn-3Bi/Cu ǥ����ͷ��170��ʱЧ�����е����ṹ�о�[J]. �й���ɫ����ѧ��, 2004, 14(5): 842-847.
DUAN Li-lei, YU Da-quan, ZHAO Jie, et al. Microstructure of Sn-9Zn-3Bi solder/Cu joint during long-term aging at 170�� [J]. The Chinese Journal of Nonferrous Metals, 2004, 14(5): 842-847.
[14] Lin K L. Wetting interaction between Sn-Zn-Ag solders and Cu [J]. J Electron Mater, 2003, 32: 95-100.
[15] Chang T C, Hon M H, Wang M C. Intermetallic compounds formation and interfacial adhesion strength of Sn-9Zn-0.5Ag solder alloy hot-dipped on Cu substrate [J]. J Alloy Comp, 2003, 352: 168-174.
[16] �ڴ�ȫ, �Խ�, ����. ϡ��Ԫ�ض�Sn-9Zn�Ͻ���ʪ�Ե�Ӱ��. �й���ɫ����ѧ�� [J], 2003, 13(4): 1001-1004.
YU Da-qian, ZHAO Jie, WANG Lai. Wetting properties of Sn-9Zn solder alloy with trace rare earth elements [J]. The Chinese Journal of Nonferrous Metals, 2003, 13(4): 1001-1004.
[17] Wu C M L, Yu D Q. The wettability and microstructure of Sn-Zn-RE alloys [J]. J Electron Mater, 2003, 32: 63-69.
[18] Wu C M L, Yu D Q. The properties of Sn-9Zn lead-free solder alloys doped with trace rare earth elements [J].Electronic Mater, 2002, 31: 921-927.
[19] Lin K L, Chung F C, Liu T P. The potentiodynamic polarization behavior of Pb-free Xin-9(5Al-Zn)-Ysn solders [J]. Mater Chem Phys, 1998, 53: 55-59.
[20] Vaynman S, Fine M E. Development of fluxes for lead-free solders containing zinc [J]. Scrip Mater, 1999, 41: 1269-1271.
[21] Yu D Q, Xie H P, Wang L. Investigation of interfacial microstructure and wetting property of newly developed Sn-Zn-Cu solders with Cu substrate [J]. J Alloy Comp, Accepted.
������Ŀ: �����п�ί�ƻ�������Ŀ(��ƼƷ�[2001]145)
�ո�����: 2004-02-19; ������: 2004-05-29
�����: л��ƽ(1980-), ��, ˶ʿ�о���.
ͨѶ����: �� ��, ����; �绰: 0411-4707636; E-mail: wangl@dlut.edu.cn


