���±�ţ�1004-0609(2015)-03-0815-09
Cl--BSP-RPE���Ӽ�������Cu��ͭ�缫�ϵĵ����
�����ǣ��� ��
(����������ѧ ��ѧ�뻯��ѧԺ �㶫ʡȼ�ϵ�ؼ����ص�ʵ���ң����� 510640)
ժ Ҫ��
�������Ե���ɨ�衢ѭ�������ͼ�ʱ�����о�50 ����Cl-��BSP��RPE�������ڻ�ͬʱ����ʱ���ں�320 g/L CuSO4��5H2O��110 g/L H2SO4��Һ�У�Cu��ͭ�缫�ϵĵ�������̣���ͨ��SEM��XRD���������Ӽ�������30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE��õ���ͭ������ò�ͽṹ�����������Cl-��BSP��Cu�ĵ��������������ȥ�������ã�RPE����Ũ�ȵ�������������ǿ��BSPʹ�ɺ����ܶ�����ͬʱ�ή��ͭ���ӵ���ɢϵ��������30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE��������۴���ϵ������ɢϵ�����ӿ�Cu�ĵ�������̣���Cl-��RPE�Լ�30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE�����£�Cu�ĵ���������ڿ�ʼʱ�ӽ�˲ʱ�ɺˣ�����ʱ���ӳ����������ɺ˿���������ƫ������ģ�ͣ�����BSP�����£�ʼ�սӽ�˲ʱ�ɺ����ۡ�����30 mg/L Cl-+5 mg/L BSP+ 5 mg/L RPE������50 ���Ũ����ͭ��Һ�п��ٵ�����õ�����ƽ���ĵ��ͭ����ͭ�Ʋ����(111)����ϴ�����ȡ��
�ؼ��ʣ�
���ͭ����������ϩ������ϩǶ�λ�����������������Ӽ�����ɢϵ����
��ͼ����ţ�TQ153.1���� ���ױ�־�룺A
Electrodeposition of Cu on copper electrode in presence of additive Cl--BSP-RPE
DING Xin-cheng, ZHANG Zhen
(School of Chemistry and Chemical Engineering, South China University of Technology,
Guangdong Key Laboratory of Fuel Cell Technology, Guangzhou 510640, China)
Abstract: The copper electrodepositions on copper electrode in the solutions containing 320 g/L CuSO4��5H2O and 110 g/L H2SO4 with Cl-, BSP, RPE alone or combination at 50 �� were studied by linear sweep voltammetry, cyclic voltammetry and chronoamperometry. The morphology and structure of electrolytic copper foil with additive free and 30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE were characterized by SEM and XRD. The results show that Cl- and BSP have depolarization effect in the electrodeposition process, but the polarization effect of RPE increases with the increase of RPE concentration. BSP can increase the nuclear number density, but reduce the diffusion coefficient of Cu ion. 30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE can increase the apparent transfer coefficient and diffusion coefficient, and speed up the copper electrodeposition process. At beginning, the electrodeposition process follows the instantaneous nucleation approximately, and then changes to the progressive nucleation with increasing time, but the process would deviate from the theoretical model after longer nucleation time with Cl-, RPE, 30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE. It will always follow the instantaneous nucleation in the presence of BSP. Bright leveling electrolytic copper foil can be got at high speed with 30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE at 50 �� in the concentrated acid copper sulfate solutions. The resulting copper coating has an orientation along (111) crystal plane.
Key words: electrolytic copper foil; polyxyethylene-polyoxypropylene glycals; electrodeposition; additive; diffusion coefficient
�����ܵ��ͭ�����з������豸�ļ����������������͡��ȶ������ڵ��ص����Ӽ�ͬ����Ҫ��ͭ����Ũ�Ⱥ��¶��ǵ��ͭ��������������Ҫ���������������¶Ⱥ����ͭ����Ũ�ȶ�ͭ�缫��ϵ��ȥ��������[1]�����ԣ��ʵ���ߵ���¶Ⱥ�ͭ����Ũ������ߵ��ͭ������Ч�ʡ����������Ӽ������л�Ⱦ��������������Һ�·�Χխ��Һ�����ͣ�һ�㲻����30 ��[2]����ˣ�̽�����иߵ���¶ȡ���Ũ����ͭ��Һ���������Ӽ�������Ҫ���塣
���Զ�ͭ��Һ�м���Cl-������Cu+�γ������[3]��Cl-�ļ���������ϵ���������Ӽ��кܺõ�Эͬ���ã�����Ч����߶Ʋ�����Ժ���ƽ�ԣ����ƶƲ���������ڵ��ͭ���У����������������������������Ρ��������������ο�����Ϊ�������������۶�����������(BSP)���ں��б�����ʹ���и�ǿ����ƽ����[4]��������ϩ������ϩǶ�λ�����(RPE)��һ������ķ����ӱ�����Լ��������ܺ��������ѻ�����һ�������������������ͭ�Ʋ��������ס���ɴ�����Ҷ��������Ӽ��кܺõ��������á�TABAKOVA��[5]�о��������ɾ�����ϩEO��������ϩPO��ɽṹΪ(EO)8(PO)15(EO)10(PO)15(EO)8��Ƕ�ι�������нϺõ���ˮ����ƽ���Լ��ϸߵ��ܽ��������������������������(SPS)���������Ӽ�ʱ������SPS������PO�γɵ��ں��У��������Ӽ��ԶƲ���нϺõ���ƽ����[6]��
�й�����ͭ��Һ��Cu�ĵ绯ѧ�ɺ˼������Ѿ���һЩ�о�����ͭ�о��г��õĵ绯ѧ������������Ƽ��������Ե���ɨ�跨������������ͽ����迹�ȡ������[7]ͨ������ɨ�衢ѭ��������SEM���ֶζԻ��ڶ��Ҵ������Ҷ������������˫�����ϵ��CuSO4/H2SO4��Һ���вⶨ�ͱ����������[8]�������Ե���ɨ�裬ѭ�������ͼ�ʱ�������о�40 ��� ��-Cl-�ڸ�Ũ����ͭ��Һ�е�ᾧ��Ϊ���������[9]�������Ե���ɨ�����������Ȱ���ͭ�������ϵ�ı��۴���ϵ���ͽ��������ܶȡ�����Cl-��BSP��RPE�����Ϊ�иߵ���¶ȡ���Ũ����ͭ��Һ���ͭ�����Ӽ���δ�����ױ�����������������Ҳδ���о����������߲��õ绯ѧ�����о�Cl--BSP-RPE���Ӽ������¡���50 �������ͭŨ����Һ��ͭ��������̣��ɲ���SEM��XRD�Դ����Ӽ��䷽���ٵ�����õ��ĵ��ͭ������ò�;�������ȡ����з�����
1 ʵ��
ʵ�����Ϻ�������������˾������CHI660C�͵绯ѧ����վ�Ͻ��У��������缫��ϵ�������Ƶ�ͭ�缫(ֱ��1 mm)���о��缫��ʵ��ǰ����127 ��mɰֽ��ĥ������76 ��mɰֽ�������棬���������ˮ��ϴ�������缫Ϊ��Ƭ�缫���αȵ缫Ϊ���ʹ��缫�����Һ��ϵΪ��320 g/L CuSO4��5H2O��110 g/L H2SO4������Һ�м���Cl-��BSP��RPE(��Է�������Ϊ5800)�����ǵ����(��Cl--BSP-RPE��ʾ)��ʵ����50 ���½��У���Һ���ھ�ֹ״̬���÷������Լ�������ˮ���ơ����Ե���ɨ��(LSV)�ӿ�·��������ɨ�衣ѭ������(CV)�ӿ�·��������ɨ�裬Ȼ����ɨ�裬���ѭ������ʱ����(CA)�ⶨʱ�����缫���嵽һ���ϸߵij����ƣ���¼�����ı仯�����Ե���ɨ����ѭ��������ɨ���ٶȾ�Ϊ10 mV/s����������S-3000H��ɨ����������ԶƲ������ò���й۲졣XRD��������D8 Advance X�������ǣ�Cu�У�NiƬ�˲����ܵ�ѹ40 kV���ܵ���40 mA��ɨ���ٶ�8 (��)/min��
2 ���������
2.1 Cl-��BSP��RPE��Cl--BSP-RPE������Cu��ͭ�缫�ϵļ�������
ͼ1��ʾΪ����Һ��ϵ�����Ե���ɨ�����ߡ���ͼ1�ɼ���������ɨ�赽-0.5 V����ʱ��Cu��ʼ��������Һ����ͬ���Ӽ�ʱ��Cu��ʼ�����ĵ����������ͼ1(a)��ʾΪͭ�缫�ڲ�ͬCl-Ũ�ȵ��Һ�еļ������ߡ�����Cl-Ũ�ȵ������������������Ʒ����ƶ���ȥ������������ǿ��ͼ1(b)��ʾΪͭ�缫�ڲ�ͬBSPŨ�ȵ��Һ�еļ������ߣ�ȥ������������BSPŨ�ȵ����������ǿ����ͼ1(c)���Կ���������RPEŨ�ȵ���������������ǿ��ͼ1(d)��ʾΪͭ�缫�ڲ������Ӽ���ͬʱ����3�����Ӽ�Cl-- BSP-RPEʱ�ļ������ߣ�����3�����Ӽ�����������ǿ����������������Ӽ��䷽����ȥ�������ã��ٽ�Cu�ĵ��������ͼ1(d)�м��������ڳ�����0.03~0.12 V��Χ�ڵ����ݽ���������ϣ��ò������Ӽ�ʱ��=-0.1658+0.1266 lg J0���������Ӽ�Cl--BSP-RPEʱ����=0.1265+0.092 lg J0����Tafelֱ�߷�����ò������Ӽ�ʱ���۴���ϵ����=0.506�����������ܶ�J0= 20.34 A/m2���������Ӽ���=0.697��J0=23.72 A/m2�����۴���ϵ�������ӣ�Ҳ��������30 mg/L Cl- +5 mg/L BSP +5 mg/L RPE�ܴٽ�Cu�ĵ�������̡�
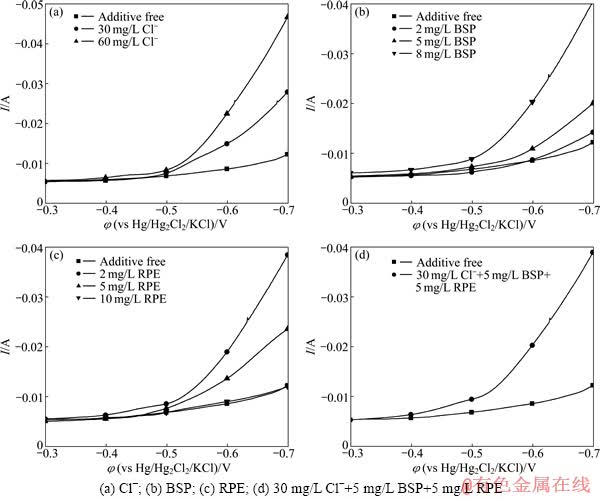
ͼ1 ͭ�缫�ڲ�ͬ���Ӽ�Ũ������ͭ��Һ�е�����ɨ���������
Fig. 1 Linear sweep voltammetry curves for deposition of copper on copper electrode in solutions with different concentrations of additives
2.2 Cl-��BSP��RPE��Cl--BSP-RPE������Cu��ͭ�缫�ϵ�ѭ��������Ϊ
ͼ2��ʾΪѭ������ɨ��Ľ������ͼ2(a)�ɼ�����Cl-ʱ��CV�����ϵķ�����ϲ���Cl-ʱ����������Cl-��Cu�������һ���Ĵٽ����ã��ɼӿ�ͭ���ӵij�����Ӧ��һ����ΪCl-��Cu�ĵ���������������ŵ�����[10-11]���ٽ�Cu�ĵ��������ͼ2(b)�����У�����BSPŨ�ȵ�����CV���ߵij����������������BSP��Cu�ĵ�������дٽ����ã�BSPŨ��Խ�ߣ��ٽ�����ҲԽǿ�������������Թ�����ͭ����ʮ����Ҫ�����ã��ǹ���������ȱ�ٵijɷ�֮һ��BSP��Cu�ĵ�����Ĵٽ����õĻ���������SPS���ƣ�һ����Ϊ����ͭ�缫�������γ����л����������ڱ�ˮ��������ĵ缫����������Ѹ�ٵر���ԭ���Ӷ������˻��λ�ݣ����ִٽ����ÿ���������������ۺ����õĽ��[12]����ͼ2(c)�У�����RPEŨ�ȵ��������������С��������Cu�ĵ�����Ĵٽ���������������ʧȥ�ٽ����á�RPE���нϺõ��ܽ��ɢ�ԣ�������������ǿ�����Һ�м���RPE�����ڵ缫��������������ͭ�����ڵ缫������������������ٶȣ��Ӷ��ӿ�ͭ�����������Ļ�ԭ[13]�������������RPE���缫������ܻ����RPE�Ķ��������ʹ���ڵ缫�������γɽϺ�Ľ���Ĥ���Ӷ����������ֲ���������Cu�Ĵٽ����ü�������ͼ2(d)�ɼ���������������Ӽ�����������Ȳ������Ӽ��Ĵ��������Ӽ���ȶ�Cu�ĵ�����дٽ����ã��������Ե���ɨ��õ��Ľ�����һ�µġ�
��ͼ2�����Կ�����CV������0��0.1 V��Χ�ڣ��为��ɨ��������ɨ�������ཻ��һ�㣬����Cu�ĵ�������̾����ᾧ�ɺ˹��̡�
2.3 Cl-��BSP��RPE��Cl--BSP-RPE������Cu��ͭ�缫�ϵĵ��ƽ�Ծ��Ϊ
�ɵ��ƽ�Ծʵ�飬���Եõ�����-ʱ����̬����(CTTs)��������Ӧ�ķ������ۼ���������CTTs�����Եõ��йص�ᾧ��ֱ����Ϣ[14-19]��
2.3.1 Cl-����������Cu��ͭ�缫�ϵĵ��ƽ�Ծ��Ϊ
ͼ3(a)��ʾΪ���ƽ�Ծ��-0.5 Vʱ����ͬCl-Ũ��ʱ��õ�Cu��ͭ�缫�ϵ�CTTs����ᾧ�ij������ھ��˵��γɺ�����������������������������ﵽ���ֵ���ֵ�����˥���������缫��������ɢ����[20]��SCHARIFKER��[21]����˵绯ѧ��������ɢ���Ƶľ�����ά����ģ�ͣ����Scharifker-Hills ģ�ͣ�����ͨ����ģ�ͻ�����Ӽ����������³ɺ˻������ɺ����ܶ��Լ�ͭ���ӵ���ɢϵ���ȡ���ͼ3(a)���߽��������ת���õ�ͼ3(b)����ͼ3(b)�пɼ����ڿ�ʼ��Ծ��һ��ʱ���ڣ����߽ӽ�˲ʱ�ɺ��������ߣ�����ʱ����ӳ����������������ɺ��������߿���������ƫ�����ۼ������ߡ���CTTsʵ�����ݣ���Scharifker-Hillsģ��˲ʱ�ɺ�ģ�ʹ���[19]��������ɺ����ܶ�N��ͭ���ӵ���ɢϵ��D���������1���С�Cl-ʹͭ���ӵ���ɢϵ���ȼ�С�����ɺ����ܶ���С��Cl-Ũ�Ƚϵ�ʱ��Cl-��ͭ���ӷ�����ϣ��γɽϴ�����������Ӷ�ʹͭ���ӵ���ɢϵ�����ͣ���Cl-Ũ�Ƚϴ�ʱ�����ܻ�ı�ͭ���ӵ���ɢ·���������������ã�ʹͭ���ӵ���ɢϵ�������������š��Ĺ��ɻ��С˫�����ݺͽ��ͻ��������������ͳɺ����ʣ��ɺ����ܶ�Ҳ��Ӧ����[11]��ֻ��Cl-���õ������ĶƲ㣬��ˣ�Cl-��Ҫ����������ʹ�á�

ͼ2 ͭ�缫�ڲ�ͬ���Ӽ�Ũ������ͭ��Һ�е�ѭ��������������
Fig. 2 Cyclic voltammetry curves for deposition of copper on copper electrode in solutions containing different concentrations of additives

ͼ3 -0.5 Vʱ��ͬŨ��Cl-��CTTs (a)����Ӧ�������(I/Im)2��t/tmͼ(b)
Fig. 3 CTTs in acid cupric sulphate electrolyte at different Cl- concentrations and -0.5 V (a) and corresponding non-dimensional (I/Im)2��t/tm plots (b)
2.3.2 BSP����������Cu��ͭ�缫�ϵĵ��ƽ�Ծ��Ϊ
ͼ4(a)��ʾΪ��Ծ��-0.5 Vʱ��ͬBSPŨ�ȵõ���Cu��ͭ�缫�ϵ�CTTs��ͼ4(a)���߽��������ת���õ�ͼ4(b)����ͼ4(b)���Կ���������BSP������ʼ�սӽ�˲ʱ�ɺˡ���Scharifker-Hills˲ʱ�ɺ�ģ�ʹ�����������ɺ����ܶ�N��ͭ���ӵ���ɢϵ��D�����2���С����������BSP����ɺ����ܶȱȲ������Ӽ��Ĵ�������BSPŨ�ȵ����ɺ����ܶ�Ҳ������˵��BSP�ļ��������ھ��˵��γɡ�ͭ���ӵ���ɢϵ��D����BSPŨ�ȵ�������С��BSP��һ�ֺ��������������Ч��߶Ʋ�Ĺ����Ⱥ�ƽ���ȡ�BSP��ͭ�����γ�����ʹ���������ͭ���ӵ���ɢϵ��D��С��
2.3.3 RPE����������Cu��ͭ�缫�ϵĵ��ƽ�Ծ��Ϊ
ͼ5(a)��ʾΪ��Ծ��-0.5 Vʱ��ͬRPEŨ�ȵõ���Cu��ͭ�缫�ϵ�CTTs��ͼ5(a)���߽��������ת���õ�ͼ5(b)����ͼ5(b)���Կ������ڿ�ʼ��Ծ��һ��ʱ���ڣ�ÿ�����߶��ӽ�˲ʱ�ɺˣ�����ʱ����ӳ����������������ɺ��������߿���������ƫ�����ۼ������ߡ�������ͬ�Ĵ���������������ɺ����ܶ�N��ͭ���ӵ���ɢϵ��D�����3��ʾ������RPE�ɺ����ܶȼ�С������ͭ���ӵ���ɢϵӰ�첻��RPE������ķ����ӱ�����Լ��������ڵ缫���棬�Ḳ��һЩ���Ե㣬�谭Cu�ijɺˡ�
2.3.4 Cl--BSP-RPE������Cu��ͭ�缫�ϵĵ��ƽ�Ծ��Ϊ
��1 Cl-������Cu��ͭ�缫�ϵijɺ����ܶ�N����ɢϵ��D
Table 1 Nuclear number density N and diffusion coefficient D of copper electrocrystallization on copper electrode in presence of Cl-

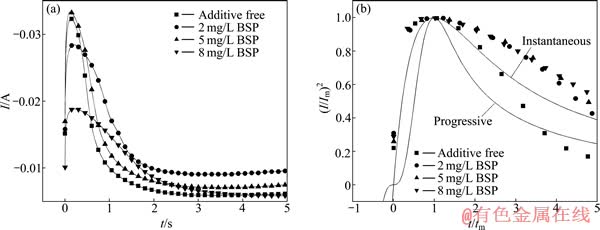
ͼ4 -0.5 Vʱ��ͬBSPŨ�ȵ�CTTs(a)����Ӧ�������(I/Im)2��t/tmͼ(b)
Fig. 4 CTTs in acid cupric sulphate electrolyte at different BSP concentrations and -0.5 V (a) and corresponding non-dimensional (I/Im)2��t/tm plots (b)
��2 BSP������Cu��ͭ�缫�ϵijɺ����ܶ�N����ɢϵ��D
Table 2 Nuclear number density N and diffusion coefficient D of copper electrocrystallization on copper electrode in presence of BSP

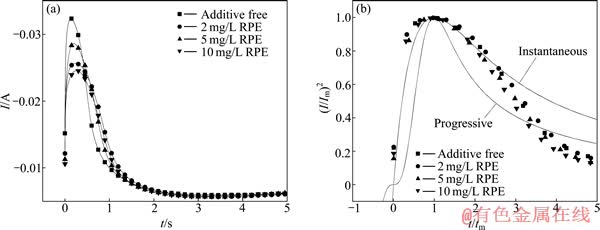
ͼ5 -0.5 Vʱ��ͬŨ��RPE��CTTs (a)����Ӧ�������(I/Im)2��t/tmͼ(b)
Fig. 5 CTTs in acid cupric sulphate electrolyte at different RPE concentrations and -0.5 V (a) and corresponding non-dimensional (I/Im)2��t/tm plots (b)
��3 RPE������Cu��ͭ�缫�ϵijɺ����ܶ�N����ɢϵ��D
Table 3 Nuclear number density N and diffusion coefficient D of copper electrocrystallization on copper electrode in presence of RPE

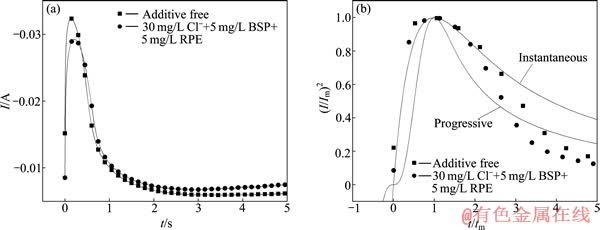
ͼ6 -0.5 VʱCl--BSP-RPE��CTTs (a)����Ӧ�������(I/Im)2��t/tmͼ(b)
Fig. 6 CTTs in acid cupric sulphate electrolyte of Cl--BSP-RPE at -0.5 V (a) and corresponding non-dimensional (I/Im)2��t/tm plots (b)
ͼ6(a)��ʾΪ��Ծ��-0.5 Vʱ����30 mg/L Cl-+5mg/L BSP+5 mg/L RPE �Ͳ������Ӽ��õ���Cu��ͭ�缫�ϵ�CTTs��ͼ6(a)���߽��������ת���õ�ͼ6(b)����ͼ6(b)���Կ������������Ӽ��䷽�Ͳ������Ӽ������ڿ�ʼ��Ծ��һ��ʱ���ڣ����߽ӽ�˲ʱ�ɺˣ�����ʱ����ӳ����������������ɺ��������߿���������ƫ�����ۼ������ߡ���ͼ6���ݼ���ijɺ����ܶ�N��ͭ���ӵ���ɢϵ��D���4���С��ɱ�4��֪������������Ӽ���ͭ���ӵ���ɢϵ�����ɺ����ܶȼ�С�����ɺ����ܶȱ����ڽϸ�ˮƽ�ϣ������ڱ���ƽ���������Ӽ��䷽�ܼӿ�ͭ������Ĺ��̣��ܵõ��������ĶƲ㣬�����ʵ��Ӵ��������������
��4 Cl--BSP-RPE������Cu��ͭ�缫�ϵijɺ����ܶ�N����ɢϵ��D
Table 4 Nuclear number density N and diffusion coefficient D of copper electrocrystallization on copper electrode in presence of Cl--BSP-RPE

2.4 SEM����
ͼ7(a)��ʾΪ�ڵ���¶�50 �桢�����ܶ�Ϊ500 mA/cm2�����������Ӽ�ʱ���õ��ĶƲ��SEM����ͼ7(a)�ɼ����Ʋ���氼��ƽ���ᾧ�����ȣ������Խϵ͡�ͼ7(b)��ʾΪ����¶�50 �桢�����ܶ�Ϊ500 mA/cm2�����¼���30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE ʱ�Ʋ�ı�����������ٵ�����Ʋ�����ƽ���������Ժ�����Ҳ�Ϻá�

ͼ7 ����¶�50 �桢�����ܶ�Ϊ500 mA/cm2ʱ��ͬ���Ӽ��Ʋ��SEM��
Fig. 7 SEM images of copper electrodeposits with different additives at temperature of 50 �� and current density of 500 mA/cm2
2.5 XRD����
ͼ8��ʾΪ�����Ӽ��ͼ���30 mg/L Cl-+5 mg/L BSP+5 mg/L RPEʱ���öƲ��XRD�ס���5����Ϊ��Ӧͼ8ͭ�Ʋ㾧��ķ�����������������������Cu��ȡ�����������༴����ܶѻ���ԭ��ƽ��ƽ���ڻ��壬Cu�Ʋ����(111)��������ȡ�Ʋ��ƽ��������ȡ�����������༴����ܶѻ���ԭ��ƽ�洹ֱ�ڻ��壬Cu�Ʋ����(220)��������ȡ�Ʋ�ᾧ������Խϴ�ƽ��[7]�������Ӽ�ʱ������֯��ϵ��TC(220)Ϊ49.5%��TC(111)Ϊ15.8%�����������Ӽ�ʱ��TC(220)= 23.0%��TC(111)=26.7%��(220)����������ȡ��(111)������ֽϴ�����ȡ�Ӷ�˵���������Ӽ���Һ���öƲ�����Ƚ�ƽ��������SEM��������

ͼ8 ��ͬ�Ʋ��XRD��
Fig. 8 XRD patterns of different electrodeposits
��5 ��Ӧ��ͼ8ͭ�Ʋ�XRD���
Table 5 XRD results of Cu electrodeposits corresponding to Fig. 8

3 ����
1) ��LSV��CVʵ������֪��Cl-��RPE��BSP����ͭ�������������ȥ�������ã�RPE��ȥ������������Ũ�ȵ��������С��Cl-��BSP��ȥ������������Ũ�ȵ����������
2) Cl-��RPE��30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE �����£�Cu�ĵ���������ڿ�ʼһ��ʱ���ӽ�˲ʱ�ɺˣ�����ʱ����ӳ��������ɺ˿���������ƫ������ģ�ͣ�����BSP�����£�Cu�ĵ����ʼ�սӽ�˲ʱ�ɺ����ۡ�
3) BSP����߳ɺ����ܶȣ�����Ũ�ȵ�����ɺ����ܶ�ֵҲԽ��ͬʱ�ή��ͭ���ӵ���ɢϵ��������30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE ������ͭ���ӵ���ɢϵ���ͱ��۴���ϵ�����ӿ�ͭ��������̡�
4) ��SEM���п��Կ���������30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE������50 ���Ũ����ͭ��Һ�п��ٵ�������õ��ĶƲ����ƽ�����������á�XRD��������������30 mg/L Cl-+5 mg/L BSP+5 mg/L RPEʱ��(111)������ֽϴ�����ȡ��
REFERENCES
[1] �����, �� ��, �� ��. ͭ����Ũ�Ⱥ��¶ȶ�ͭ��⼫�����õ�Ӱ��[J]. ��ұ, 2010, 19(3): 81-84.
L Yu-guo, LI Jian, HUANG Juan. Effect of copper ion concentration and temperature on electrolyticcopper polarization [J]. Mininc & Metallurgy, 2010, 19(3): 81-84.
Yu-guo, LI Jian, HUANG Juan. Effect of copper ion concentration and temperature on electrolyticcopper polarization [J]. Mininc & Metallurgy, 2010, 19(3): 81-84.
[2] Ԭʫ�. ��ͭȾ������������ȱ��[J]. �����Ϳ��, 2007, 26(5): 59-62.
YUAN Shi-pu. Advantages and disadvantages of dye type brightener of sulfate copper electroplating[J]. Electroplating & Finishing, 2007, 26(5): 59-62.
[3] PRADHAN N, KRISHNA P G, DSA S C. Influence of chloride ion on electrocrystallization of copper[J]. Plating and Surface Finishing, 1996, 83(3): 56-58.
[4] �����, ������, ��־ǿ. ��Ⱦ�����Զ�ͭ���Ӽ��ķ�չ״��[J]. ���ϱ���, 2006, 39(6): 38-40.
LIU Lie-wei, ZHANG Yan-qing, YANG Zhi-qiang. The development of no dye additives for acidic copper electroplating[J]. Materials Protection, 2006, 39(6): 38-40.
[5] TABAKOVA N, POJARLIEFF I, MIRCHEVA V, STEJSKAL J. The role of micelles of multiblock copolymers of ethylene propylene oxide in ion transport during acid bright copper elecprogresstrodeposition[J]. Macromol Symp, 2004, 212: 467-472.
[6] �� ��, �� ��. ���ͭ�����Ӽ��о���չ[J]. ��ѧ�о�, 2010, 21(6): 91-95.
LI Jun, ZHANG Zhen. Research of additives for electrolyzing copper foil[J]. Chemical Research, 2010, 21(6): 91-95.
[7] �� ��, �� ��. ����TEA��EDTA��2Na˫�����ϵ�����Զ�ͭ���ռ��Ʋ�����[J]. �й���ɫ����ѧ��, 2011, 21(8): 1980-1987.
ZHANG Zhen, LI Jun. Acid copper electrodepositing process and coating properties based on system of TEA and EDTA��2Na[J]. The Chinese Journal of Nonferrous Metals, 2011, 21(8): 1980-1987.
[8] �� ��, �Ƽ���. ���Ӽ�����-Cl-������ͭ�Ŀ��ٵ�ᾧ����[J]. �й���ɫ����ѧ��, 2013, 23(6): 1723-1731.
ZHANG Zhen, HUANG Jia-long. Fast electrocrystallization of copper in presence of additive methyl violetand Cl-[J]. The Chinese Journal of Nonferrous Metals, 2013, 23(6): 1723-1731.
[9] ������, �״�ï, �� ΰ, ��, �Ŷų�, ��ΰ��. Cu(��)�ڹȰ�����������ϵ�еĵ����[J]. ���ϴ�ѧѧ��: ��Ȼ��ѧ��, 2011, 42(2): 305-311.
YANG Tian-zu, LEI Cun-mao, LIU Wei, DOU Ai-chun, ZHANG Du-chao, LIU Wei-feng. Copper(��) electrodeposition behavior in system of glutamine[J]. Journal of Central South University: Science and Technology, 2011, 42(2): 305-311.
[10] �� ��, �����, �� ��, Ҧʿ��, ������. �����Ӷ�ͭ�ڲ�̼�缫�ϵ�ᾧ��Ӱ��[J]. ��ѧѧ��, 2002, 60(11): 1946-1950.
GU Min, YANG Fang-zu, HUANG Lin, YAO Shi-bin, ZHOU Shao-ming. Effect of chloride ion on electrocrystallization of copper on glass carbon electrode[J]. Acta Chimica Sinica, 2002, 60(11): 1946-1950.
[11] ������, �����, Ҧʿ��, ����, �̼���, �±���, ���Ӹ�, ���鿬. ijЩ�������Զ�ͭ���Ӽ������û���[J]. ���Ŵ�ѧѧ��: ��Ȼ��ѧ��, 1980, 1(1): 54-70.
ZHOU Shao-ming, ZHANG Lei-zhou, YAO Shi-bin, XU Jia-yuan, CAI Jia-qin, CHEN Bin-yi, FANG Jia-fu, XU Shu-kai. The mechanisms of some additives for bright acid copper electroplating[J]. Journal of Xiamen University: Natural Science, 1980, 1(1): 54-70.
[12] ������, ������, Ԭ��ΰ, ��Ʒ��. ʵ�õ�����Ӽ�[M]. ����: ��ѧ��ҵ������, 2007: 269-288.
ZHANG Li-min, FANG Jing-li, YUAN Guo-wei, SHEN Pin-hua. Practical electroplating additive[M]. Beijing: Chemical Industry Press, 2007: 269-288.
[13] ONICIU L,MURESAN L. Some fundamental aspects of levelling and brightening in metal electro deposition[J]. Journal of Applied Electrochemistry, 1991, 21(7): 565-574.
[14] GRUJICIC D, PESIC B. Reaction and nucleation mechanisms of copper electrodeposition from ammoniacal solutions on vitreous carbon[J]. Electrochimica Acta, 2005, 50(22): 4426-4443.
[15] DANILOVA I, MOLODKINAE B, BAITOV A, POBECOVI V. Initial stages of copper electrocrystallization on a glassycarbon ring disk electrode from sulphate electrolytes of various acidity: Potentiostatic curren transiens[J]. Russian Journal of Electrochemistry, 2002, 38(7): 743-754.
[16] Huang L, Yang F Z, Xu S K, Zhou S M. Electrochemical nucleation and growth of copper on HOPG in presence of PEG and chloride ions as additives[J]. Transactions of the Institution of Metal Finishing, 2006, 84(1): 47-51.
[17] Orellana M,  , Schrebler R, Cordova R. A potentiostatic and atomic force microscopy study of the nucleation and growth[J]. Journal of Physical Chemistry C, 2007, 111(47): 17541-17550.
, Schrebler R, Cordova R. A potentiostatic and atomic force microscopy study of the nucleation and growth[J]. Journal of Physical Chemistry C, 2007, 111(47): 17541-17550.
[18] Tan M, Guymon C, Wheeler D R, Harb J N. The role of SPS, MPSA, and chloride in additive systems for copper electrodeposition[J]. Journal of the Electrochemical Society, 2007, 154(2): D78-D81.
[19] GU Ming, ZHON Qing. Copper electrocrystallization from acidic sulfate electrolyte containing MPS additive[J]. Journal of Applied Electrochemistry, 2011, 41(7): 765-771.
[20] �� ��, �� ǿ, ������, ��ʤ��, ������. PEG-Cl���Ӽ������µ�ͭ��ᾧ�����о�[J]. ��ѧѧ��, 2006, 65(10): 881-886.
GU Min, LI Qiang, XIAN Xiao-hong, QING Sheng-lan, LIU Ke-wan. Electrocrystallization of copper in the presence of PEG-Cl- additive[J]. Acta Chimica Sinica, 2006, 65(10): 881-886.
[21] SCHAIFKER B, HILLS G. Theoretical and experimental studies of multiple nucleation[J]. Electrochimica Acta, 1983, 28(7): 879-889.
(�༭ ����)
������Ŀ���㶫ʡ�ش�Ƽ�ר����Ŀ(2011A080402004��2010B080703034)���㶫ʡ��ѧ�к�������Ա����վ��Ŀ(2012B090900009)
�ո����ڣ�2014-06-30�������ڣ�2014-12-08
ͨ�����ߣ��� �𣬽��ڣ��绰��13533408053��E-mail: chzzhang@scut.edu.cn
ժ Ҫ���������Ե���ɨ�衢ѭ�������ͼ�ʱ�����о�50 ����Cl-��BSP��RPE�������ڻ�ͬʱ����ʱ���ں�320 g/L CuSO4��5H2O��110 g/L H2SO4��Һ�У�Cu��ͭ�缫�ϵĵ�������̣���ͨ��SEM��XRD���������Ӽ�������30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE��õ���ͭ������ò�ͽṹ�����������Cl-��BSP��Cu�ĵ��������������ȥ�������ã�RPE����Ũ�ȵ�������������ǿ��BSPʹ�ɺ����ܶ�����ͬʱ�ή��ͭ���ӵ���ɢϵ��������30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE��������۴���ϵ������ɢϵ�����ӿ�Cu�ĵ�������̣���Cl-��RPE�Լ�30 mg/L Cl-+5 mg/L BSP+5 mg/L RPE�����£�Cu�ĵ���������ڿ�ʼʱ�ӽ�˲ʱ�ɺˣ�����ʱ���ӳ����������ɺ˿���������ƫ������ģ�ͣ�����BSP�����£�ʼ�սӽ�˲ʱ�ɺ����ۡ�����30 mg/L Cl-+5 mg/L BSP+ 5 mg/L RPE������50 ���Ũ����ͭ��Һ�п��ٵ�����õ�����ƽ���ĵ��ͭ����ͭ�Ʋ����(111)����ϴ�����ȡ��
[1] �����, �� ��, �� ��. ͭ����Ũ�Ⱥ��¶ȶ�ͭ��⼫�����õ�Ӱ��[J]. ��ұ, 2010, 19(3): 81-84.
[2] Ԭʫ�. ��ͭȾ������������ȱ��[J]. �����Ϳ��, 2007, 26(5): 59-62.
[4] �����, ������, ��־ǿ. ��Ⱦ�����Զ�ͭ���Ӽ��ķ�չ״��[J]. ���ϱ���, 2006, 39(6): 38-40.
[6] �� ��, �� ��. ���ͭ�����Ӽ��о���չ[J]. ��ѧ�о�, 2010, 21(6): 91-95.
[8] �� ��, �Ƽ���. ���Ӽ�����-Cl-������ͭ�Ŀ��ٵ�ᾧ����[J]. �й���ɫ����ѧ��, 2013, 23(6): 1723-1731.
[10] �� ��, �����, �� ��, Ҧʿ��, ������. �����Ӷ�ͭ�ڲ�̼�缫�ϵ�ᾧ��Ӱ��[J]. ��ѧѧ��, 2002, 60(11): 1946-1950.
[12] ������, ������, Ԭ��ΰ, ��Ʒ��. ʵ�õ�����Ӽ�[M]. ����: ��ѧ��ҵ������, 2007: 269-288.


