���±�ţ�1004-0609(2009)12-2186-06
Sn-Pb����ǥ����ͭ���弰�����仯��������ϵ�
��ʪ����ѧ
������1��D. P. Sekulic2���� ��2������ƽ1
(1. ����������ѧ ���Ͽ�ѧ�빤��ѧԺ������ 510640��
2. Center for Manufacturing, The University of Kentucky, Lexington 40506, USA)
ժ Ҫ��
����-Ǧ����ǥ��63Sn-37Pb��Cu���弰Cu-Sn�����仯������������ϵķ�Ӧ��ʪ����ѧ���Խ����о������������63Sn-37Pbǥ����Cu�����ϵ���չ��������淴Ӧ������Һ̬ǥ����Sn��Ԫ�����Ķ��仯��ǥ���ۻ���ij�ʼ��չ���ϼ�������ɣ������Sn��Ԫ�����������ǥ�����ȶ�������չ������Sn��Ԫ�IJ������ģ���ʪ���Ƴ��ֽ������Ԫ����ɢ���Ƶķ�Ӧ��չ������63Sn-37Pb��Cu-Sn IMC���������ϳ��ֳ��dz��õ���չ������Զ��������Cu�����ϵ���չ��
�ؼ��ʣ�
63Sn-37Pbǥ�������淴Ӧ����Ӧ��ʪ����ɢ����-Һ��������
��ͼ����ţ�TG454 ���ױ�ʶ�룺 A
Wetting kinetics of Sn-Pb eutectic solder on Cu and
Cu-Sn intermetallics substrates
WANG Hong-qin1, 2, D. P. Sekulic2, ZHAO Hui2, ZHANG Xin-ping1
(1. School of Mechanical Engineering, South China University of Technology, Guangzhou 510640, China;
2. Center for Manufacturing, The University of Kentucky, Lextington 40506, USA)
Abstract: The wetting kinetics of the eutectic 63Sn-37Pb solder on Cu and Cu-Sn intermetallic compound (IMC) substrates were investigated. The results show that the spreading feature of 63Sn-37Pb solder on the Cu substrate changes with the exhaustion of element Sn as the Cu-Sn interfacial reaction goes on. In the initial stage, the spreading fits the simple liquid flow rule well, while with decreasing Sn, it comes into the typical reactive spreading character stage. The first sub-stage follows a model involving a local chemical reaction controlled wetting with the stable triple line moving rate under the condition of sufficient Sn supply. The second sub-stage shows a wetting behavior that follows a model of diffusion-controlled reactive spreading with the lacking supply of Sn. The spread of eutectic 63Sn-37Pb solder on Cu-Sn intermetallic compound substrates is very well, much better than its spread on Cu substrate.
Key words: 63Sn-37Pb solder; interfacial reaction; reactive wetting; diffusion; solid-liquid interfacial energy
�ڵ��ӷ�װ��Ǧ�������У���Ǧǥ�Ϲ�������(��Ҫ����ʪ����)�ϲ����ɿ��Բ������Ǵ��ģ��ҵӦ��ʱ��Ҫ����Ĺؼ����⡣���о�ǥ�ϵĶ�̬��ʪ�������֣����ܴӱ����ϸ��õ����ո��ֳɷ�ǥ�ϵ���չ��������ʪ���������Լ��������صȶ���ʪ���ܵ�Ӱ��ȣ����������ŷ�װ�����в�ҵ�Զ����̶ȵIJ�����ߣ���Ҫ��ǥ����ʪ�Ķ�̬������ȷ�İ��գ�������Чָ����Ǧǥ����ƺͷ�װ�����Ż���
��������Ǧǥ�ϻ��Ǻ�Ǧǥ�ϻ����϶��Ǹ�Sn�����Ͻ𣬶�SnԪ�������ͳ��û�����Cu���������ʪ�������ڹ�-Һ���洦���ɽ��滯������߷������ܷ�Ӧ���ǵ��͵�ұ��Ӧ��ʪ֮һ����ǥ����ʪ��̬�����о����棬BAILEY ��WATKINS[1]���Բ��þ�������������ǥ�ϵ���չ���ɣ�WANG��[2]����Ǧǥ�ϵ���ʪ���̷�Ϊ3���Σ��ֱ�����ε���չ���ɺ���ʪ���������������ڵ�ʱʵ���������ޣ�û��ȷ�����ε���չ�ǽ��滯���������ٶ������Ƶ���չ���Ƕ���������������չ�������ڷ�Ӧ��ʪ��������һ�ֹ۵���Ϊ��-Һ���淴Ӧ������ʪ��������һ����[3-4]������ʪ�����дٽ����ã�����һ�ֹ۵�����Ϊ��-Һ���淴Ӧ������ʪ�Ķ�̬���̲���Ӱ�죬����Ӱ��������ʪ���[5]�������ڷ�Ӧ��ʪ�����У����Ž��洦���뷴ӦԪ�ص����ģ�Һ̬ǥ�ϵ���ر���ɷֻ��߽���ɷֻᷢ���仯[6-7]����Ӧ�ı����ܻ��߽�����Ҳ����֮�ı䣬����Ӱ����չ������������Ӱ����ʪ���������б�Ҫ�ӹ�-Һ���淴Ӧ�Ƕȶ���ʪ��չ�Ķ�̬���̽��������ȫ����о����������߲���Cu���Ƚ�Sn����ʴ���Ʊ��˾���Cu-Sn�����仯��������Ļ��壬����-Ǧ����ǥ��63Sn-37Pb��Cu�����Cu-Sn�����仯������������ϵ���ʪ���̼���չ����ѧ�����˶Ա��о���������ʪ�����г��ֵ�һЩ����������������۷�����Ϊ����ǥ�ϵ���ʪ�����ṩ�ο���
1 ʵ��
���о���������ΪN2��������̨����(Olympus)���������η�ԭλ�۲�ͼ�¼����ǥ�ϵĶ�̬��ʪ����[8]��ʵ�����û������Ϊ0.5 mm���������ͭƬ�Լ������Ʊ��ľ���Cu-Sn�����仯����(IMC)������ͭ����(��Ƚ���Ϊ0.5 mm)����ʪ����ƬΪ�߳�10 mm�������Ρ�ʵ��ǰ��Cu Ƭ�Ͼ���Ϳ��һ����������(EC-19S-8��Tamura, Japan)��63Sn-37Pbǥ��Ϊ�����α�Ƭ���ߴ�Ϊ0.5 mm��0.5 mm��0.05 mm��ʵ������̨��������Ϊ100 ��/min�����ȷ�ֵ�¶��趨Ϊ��Ӧǥ���۵�֮��30 ��(�˴���213 ��)���ڷ�ֵ�¶ȱ���30 s��Ȼ����80 ��/min ����ȴ������ȴ�����¡����о���Cu������ͬ��ʵ���ظ�2�Σ�IMC�����仯����������ظ�3�Σ��ֱ��ΪTest 1��Test 2��Test 3��
�Ʊ�����Cu-Sn�����仯��������ͭ����ʱ���Ƚ�Cu������뵽����Sn��(262 ��)������10 s����ʹ���洦��ַ������淴Ӧ�����ȡ����Ʒ�������150 ��ĺ����ϻ�¯���ϻ�10 d��Ȼ���ϻ����������Ʒ���ҽ���1.7%(��������)HCl�ļ״���Һ���ó�����ϴ����ϴ15 min�����Ž���Ʒ�����ڼ״�������ˮ������ˮ���״��и���ϴ5 min��������������ѭ��3�κ��Ʊ�������Cu-Sn�����仯��������Ļ��塣����Cu6Sn5�����ڿ����������������ڽ�����ʪʵ��ǰ�����ٴζ���Ʒ���л�ѧ��ʴ�������Ա�֤�������ΪCu6Sn5��״̬��ʵ�����������ͼ��ɼ�������¼��ǥ�Ͽ�ʼ�ۻ���ǥ����չ�����Լ���ȴ���̵�������̬���̣��������ͼ��������Image Pro? ������ʱ�̵�ǥ����չ���������ó���Ӧ�ĵȼ���ʪ�뾶��ʱ��ı仯���ߡ�
2 ���������
Cu-Sn�����仯������ֲ����ı�����ò��������֯��ͼ1��ʾ������ɢ�����(EDS)�ɷֲⶨ������ͼ1(a)�еľ����ɷ�ΪCu6Sn5����ͼ1(b)�еĽ����仯���������Ϊ���㣬���п���ԭʼCu����ı���ΪCu3Sn��������ΪCu6Sn5��
ͼ2��ʾΪ��-Ǧ����ǥ��63Sn-37Pb��Cu����ͽ����仯�����������ϵ���ʪ�뾶��ʱ��ı仯���ߡ���ͼ2��֪��63Sn-37Pb��IMC�����ϵ���չ�뾶Զ��������Cu�����ϵ���չ�뾶������ʱ��仯���������������ӹ��ɣ�����Cu��������ʪ�뾶����Ҳ��ʱ���ӳ����ʵ������ӡ�
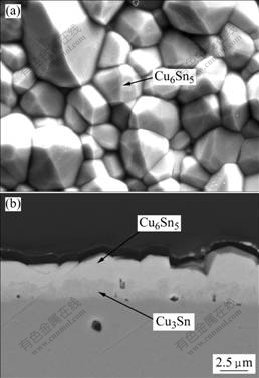
ͼ1 �����仯��������SEM��
Fig.1 SEM images of fabricated IMC substrate before wetting test: (a) Surface morphology; (b) Interface microstructure

ͼ2 ��-Ǧǥ��63Sn-37Pb��Cu��IMC��������ʪ�뾶���¶���ʱ��ı仯����
Fig.2 Changing curves of wetting radius and temperature with time for 63Sn-37Pb solders on Cu and IMC substrates
Ϊ��ȷ������̬��ʪ���̣���������ʪ�뾶���߶�ʱ��������ɻ����ʪ������ʱ��ı仯���ߡ�ͼ3��4��ʾ�ֱ�Ϊ����SnPb��ǥ����Cu�����IMC���������ϵ���ʪ������ʱ��ı仯���ߡ�

ͼ3 ����63Sn-37Pbǥ����Cu�����ϵĵȼ���ʪ�ٶȺ��¶���ʱ��ı仯����
Fig.3 Changing curves of equivalent spreading rate and temperature with time for eutectic 63Sn-37Pb solder on Cu substrate
��ͼ3��4�ɿ�����������Ǧǥ�ϳߴ�Ϊ����Ƭ�����η�ʵ�鷽���м��ȵ����ض���Ӱ����ɺ��ԡ�������Ǧǥ��63Sn-37Pb�ڳ�ʼ��ʪ���У�����IMC�����ϵ���ʪ�������Ը���Cu�����ϵ���ʪ���ʣ�63Sn-37Pbǥ����Cu�����ϵ������չ����Ϊ0.28 mm/s������IMC�����ϵ������չ���ʿɴ�1.5 mm/s�������ֳ������������ʵ����½�����������ͼ3��ʾ����-Ǧ����ǥ��63Sn-37Pb��Cu��������չ���ʵı仯���ԣ����Խ���չ���߷�ΪOI��IA��AB 3���Σ�����IA��Ϊ����̬�ٶ�(Լ0.03 mm/s)��

ͼ4 ����63Sn-37Pbǥ����IMC�����ϵ���ʪ�ٶȺ��¶���ʱ��ı仯����
Fig.4 Changing curves of equivalent spreading rate and temperature with time for eutectic 63Sn-37Pb solder on IMC substrate
Ϊ������Ӧ��ϵ�и��ӵ���չ��Ϊ��������һ��ֱ�۷���ȷ����ͬ����ʪ��ϵ�Ƿ���ϼ�����ľ���ģ�͡�Ϊ�ˣ��ɽ���Ӧ����ʪ��ϵ����չ������˫����lnR��lnt����ʽ��������������RΪ��չʱҺ�������Ӵ���˲ʱ�뾶��tΪʱ��[9]����������Ӧ��ʪ�о������У�Ҳ��ѧ�߸��ݿ�����ʪ���ʵ����ؽ����Ϊ�ֲ����淴Ӧ�������ͷ�Ӧ��ʪ����ɢ�������ͷ�Ӧ��ʪ����Һ���ڷ�ӦԪ�ص���ɢ�ٶ���ԽϿ�(������չҺ�α������ɷ�ӦԪ�����)������������չ�������ߴ��ľֲ����淴Ӧ�����ƣ������ڷ�Ӧ�������͡��ڴ������£�����������չ�ٶȴ����������Թ�ϵ[10]��
R-R0=Kt (1)
ʽ��KΪϵͳ���������С����չҺ������أ�R��R0�ֱ�Ϊ˲̬�ͳ�ʼ̬ʱҺ����������ĽӴ��뾶��
�������������ٶ��ɷ�ӦԪ�ش�Һ�������������߸�������ɢ������ʱ����������¹�ϵ[11]��
![]() (2)
(2)
ʽ�� K��Ϊϵͳ������RΪҺ����������ĽӴ��뾶��

ͼ5 ����63Sn-37Pb��Cu��������չ����ѧ����
Fig.5 Dynamic analysis of wetting curves of eutectic 63Sn-37Pb on Cu substrate: (a) R��t curve of OI part; (a��) lnR��lnt curve of OI part; (b) R��t curve of IA part; (b��) Linear fitting R��t curves of IA part; (c) R��t curve of AB part; (c��) Power fitting R��t curves of AB part
����������Ӧ��ʪ�о����۶�ͼ3�и����ν���������ϴ�����63Sn-37Pbǥ����Cu��������չ���̵�OI�ε�������Ͻ����ͼ5(a��)��ʾ���ɱ�ʾ���£�
����Test 1��
lnR=0.15lnt-1.06
����Test 2��
lnR=0.04lnt+0.04
���Զε�б��(��lnR/lnt��ȡֵ)��0.1~0.2֮�䣬����Ƿ�Ӧ��ʪ�о������е�Tanner��ʽ���(ln R/ ln t=0.1)��һ�¡��ڷǷ�Ӧ��ʪ(����������ʪ)�Ķ���ѧ�о��У�������Ϊ����չ��Һ�������ȶ�������������������Ϊ���͵��о����ΪTanner��ʽ������Һ̬������ճ�ȷdz�С���ڷǷ�Ӧ��ʪ��ϵ�ж��ں��׳ߴ��Һ�λ��ëϸ��ʪƽ������ʱ���10-1 s���߸�С��������ͨ���ķ�Ӧ��ʪ��ϵ����һ����Ҫ101~104 s���ɴ˿����ƶϣ����о���63Sn-37Pbǥ����Cu�����ϵ���ʼ��չ�η��϶����������չ���� ģ�͡�
ͼ5(b��)��ʾΪ��IA���ֽ���˫�������Դ����� ��Ͻ����AB������������Է������£�����չ�ٶ�ԼΪ 0.03 mm/s���ƶϴ˽�Ϊ���淴Ӧ������չ �Ρ�
����Test 1��
R=0.03t+0.31
����Test 2��
R=0.03t+0.38
ͼ5(c��)��ʾΪAB���ֽ��ж������������������Ͻ����
����Test 1��
t=10.18R5.4+12.31
����Test 2��
t=2.97R5.6+17.01
��Ȼ����չ�뾶��ʱ��Ķ���ֵ֮��(��lnR��lnt)�������Թ�ϵ���ӽ���Ӧ��ʪ��������ɢ�������͵�![]() ��չ���ɡ��������-Ǧ����ǥ��63Sn-37Pb��Cu��������ʪ���̵ĺ�����չ��Ӧ������ɢ�������ͷ�Ӧ��չ��
��չ���ɡ��������-Ǧ����ǥ��63Sn-37Pb��Cu��������ʪ���̵ĺ�����չ��Ӧ������ɢ�������ͷ�Ӧ��չ��
��ˣ�������Ϊ63Sn-37Pbǥ����Cu�����ϵ���չ�������£������ڳ�ʼ���ڽ�����չ���ϼ�������չ���ɣ��������Ϊ�ֲ����淴Ӧ�������͵ķ�Ӧ��չ�����������ʵ���̬��չ�����Ϊ��ӦԪ����ɢ���͵ķ�Ӧ��չ������IA��AB��չ��Ϊ��-Ǧ����ǥ����չ����Ҫ���֣�Լռ����չ�����95%���ҡ���չ�۵���Χ���ֹ�ѧ����Ȧ������-Ǧǥ�ϵ�������������Ǧǥ����δ�����֡���ѧ����Ȧ��ʵ��������-Ǧǥ������ʪǰ��Cu-Sn�����仯����������չʱ�ɷֶ�̬�仯�����з�Ӧ������Ǧǥ�Ϻ���-Ǧǥ�ϵľ���ʪ���ܲ������Դ�ڴ����ⷴӦ��
ͬ��������-Ǧ����ǥ��63Sn-37Pb��IMC�����ϵ���չ���ݽ���Tanner������ϴ�����������ͼ6��ʾ����Ӧ����������Է������¡�
����Test 1��
t=0.17R6.1+2.04
����Test 2��
t=0.02R7.1+2.43
����Test 3��
t=0.15R5.7+1.31
��ͼ6�ɼ�������ǥ��63Sn-37Pb��IMC��������չ��̬������Ͻ���ӽ�![]() ���ɣ���������[12]�����۵�Sn��Au/Cu�Ʋ�����ϵķ�Ӧ��չ����һ�¡��������������SEM�۲��ȷ������չ��������Ȼ�����������û��ת�䣬���ǽ���������̬ȴ�ɳ�ʼ��ƽ������ת��Ϊ�ȱ���̬�Ĵֲڱ��档��-Ǧ����ǥ��63Sn-37Pb��IMC�����ϵ�������ʪ���ܺ���չ����֤ʵ��63Sn-37Pbǥ����IMC����֮��Ľϵͽ����ܣ����������о�����[13-15]�Ľ���һ�¡���ˣ��ڿ��ǹ�-Һ���淴Ӧ����ʪ���ܵ�Ӱ��ʱ������Ҫ���ǹ�-Һ���淴Ӧ������Ӱ�죬ҲҪ���ǹ�-Һ���淴Ӧ������Һ��֮��Ľ�������[16]��ֵ��ָ�����ǣ���Ȼ��ʵ���о���Ҫ�����63Sn-37Pbǥ�ϣ����о����������õ����о��������Ǧǥ����ʪ����ѧ�о�����Ǧǥ����Ƶ�����Ҫ�IJο���ֵ��
���ɣ���������[12]�����۵�Sn��Au/Cu�Ʋ�����ϵķ�Ӧ��չ����һ�¡��������������SEM�۲��ȷ������չ��������Ȼ�����������û��ת�䣬���ǽ���������̬ȴ�ɳ�ʼ��ƽ������ת��Ϊ�ȱ���̬�Ĵֲڱ��档��-Ǧ����ǥ��63Sn-37Pb��IMC�����ϵ�������ʪ���ܺ���չ����֤ʵ��63Sn-37Pbǥ����IMC����֮��Ľϵͽ����ܣ����������о�����[13-15]�Ľ���һ�¡���ˣ��ڿ��ǹ�-Һ���淴Ӧ����ʪ���ܵ�Ӱ��ʱ������Ҫ���ǹ�-Һ���淴Ӧ������Ӱ�죬ҲҪ���ǹ�-Һ���淴Ӧ������Һ��֮��Ľ�������[16]��ֵ��ָ�����ǣ���Ȼ��ʵ���о���Ҫ�����63Sn-37Pbǥ�ϣ����о����������õ����о��������Ǧǥ����ʪ����ѧ�о�����Ǧǥ����Ƶ�����Ҫ�IJο���ֵ��
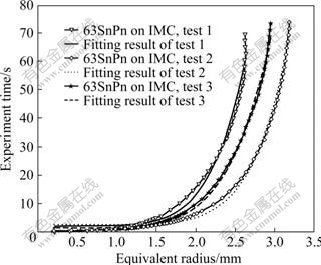
ͼ6 ����ǥ��63Sn-37Pb��IMC��������ʪչ��̬������� ����
Fig.6 Fitting curves of wetting dynamic of 63Sn-37Pb on IMC substrate
3 ����
1) 63Sn-37Pb����ǥ�ϳɷֵ�IMC��������ϳ��ַdz��õ���չ������Զ��������Cu �����ϵ���չ������չ���Ͻ�![]() ���ɡ�
���ɡ�
2) 63Sn-37Pb����ǥ����Cu�����ϵķ�Ӧ��ʪ��̬����������֮�����Cu-Sn���淴Ӧ������ת�䣻��ʼ��չ�η��϶���������������ɣ�������Sn��Ԫ����������£���ʪ���Ʊ���ΪҺ-�̽��淴Ӧ�������͵���̬��չ�������Sn�����ģ���ʪ���������Ϊ���淴ӦԪ����ɢ�������͵ķ�Ӧ��չ��
REFERENCES
[1] BAILEY G L, WATKINS H C. The flow of liquid metals on solid metal surfaces and its relation to soldering, brazing, and hot-dip coating[J]. J Inst Metals, 1951, 80: 57-75.
[2] WANG X H, CONRAD H. Kinetic of wetting Ag substrate by 60Sn40Pb[J]. Scripta Metall Mater, 1994, 30(6): 725-730.
[3] YOST F G. The triple line in reactive wetting[J]. Scripta Materialia, 1998, 38(8): 1225-1228.
[4] LIU C Y, TU K N. Morphology of wetting reactions of SnPb alloys on Cu as a function of alloy composition[J]. J Mater Res, 1998, 13(1): 37-44.
[5] KANG S C. Fundamentals of solder interconnect wetting[D]. Georgia: Georgia Institute of Technology, 2003.
[6] SASABE K, OHASHI O. Interface structure in wetting of SnPb alloy on pure Cu plate: Wetting of molten Sn-Pb alloys on Cu plate (part 1)[J]. Weld Int, 1994, 8(3): 186-189.
[7] SASABE K, OHASHI O. Interface structure in wetting of SnPb alloy on pure Cu plate: Wetting of molten Sn-Pb alloys on Cu plate (part II)[J]. Weld Int, 1994, 8(3): 190-194.
[8] WANG Hong-qin. Reactive wetting research based on the Cu-Sn interfacial reaction[D]. Harbin: Harbin Institute of Technology, 2007.
[9] ��ǰ��. ����Һ̬������ʪ��Һ/�̽�������õ��о�[D]. ����: �й���ѧԺ�����о���, 2002.
XU Qian-gang. Investigation on the wetting of several liquid metals and liquid/solid interfacial interaction[D]. Shenyang: Institute of Metal Research, Chinese Academy of Science, 2002.
[10] DEZELLUS O, HODAJ F, EUSTATHOPOULOS N. Progress in modelling of chemical-reaction limited wetting[J]. J Eur Ceram Soc, 2003, 23: 2797-2803.
[11] MEIER A, CHIDAMBARAM P R, EDWARDS G R. Modeling of the spreading kinetics of reactive brazing alloys on ceramic substrates: Copper-titanium alloys on polycrystalline alumina[J]. Acta Materialia, 1998, 46(12): 4453-4467.
[12] MESCTERS J. Wetting of low melting point alloys on metal substrates[D]. New York: The State University of New York at Binghamton, 2002.
[13] ZENG K, TU K N. Six cases of reliability study of Pb-free solder joints in electronic packaging technology[J]. Mater Sci Eng R, 2002, 38: 55-105.
[14] LEE J H, PARK J H, LEE Y H, KIM Y S. Stability of channels at a scallop like Cu6Sn5 layer in solder interconnections[J]. J Mater Res, 2001, 6(5): 1227-1230.
[15] TU K N, KU F, LEE T Y. Morphological stability of solder reaction products in flip chip technology[J]. J Electron Mater, 2001, 30(9): 1129-1132.
[16] CHEN J, GU M Y. Reactive wetting of a metal/ceramic system[J]. J Mater Res, 2002, 17(4): 911-917.
������Ŀ���й���ʿ�����������Ŀ(L1080160)���㶫ʡ��Ȼ��ѧ����ʿ��������(B6080540)������������ѧ��ʿ���»���������Ŀ(20080208)
�ո����ڣ�2008-11-13�������ڣ�2009-03-11
ͨ�����ߣ������ۣ��о�Ա����ʿ���绰��020-22236396��E-mail: wangqinhit@yahoo.com.cn
ժ Ҫ������-Ǧ����ǥ��63Sn-37Pb��Cu���弰Cu-Sn�����仯������������ϵķ�Ӧ��ʪ����ѧ���Խ����о������������63Sn-37Pbǥ����Cu�����ϵ���չ��������淴Ӧ������Һ̬ǥ����Sn��Ԫ�����Ķ��仯��ǥ���ۻ���ij�ʼ��չ���ϼ�������ɣ������Sn��Ԫ�����������ǥ�����ȶ�������չ������Sn��Ԫ�IJ������ģ���ʪ���Ƴ��ֽ������Ԫ����ɢ���Ƶķ�Ӧ��չ������63Sn-37Pb��Cu-Sn IMC���������ϳ��ֳ��dz��õ���չ������Զ��������Cu�����ϵ���չ��


