���±�ţ�1004-0609(2015)12-3255-16
���ӷ�װ�ý��������ϲ��ϵ��о���չ
�� 溣�����Ⱥ�����ճ�����С��
(���ϴ�ѧ ���Ͽ�ѧ�빤��ѧԺ����ɳ 410083)
ժ Ҫ��
���������ϲ���ƾ��������������Լ��ϳ�����Ʊ����գ���Ϊ���ӷ�װ�����о�����Ҫ����֮һ���������͵ĵ��ӷ�װ�ý��������ϲ��ϵ��о���״���������������ϲ��ϵ�������������ƣ��о�������ͭ�����ӷ�װ���ϲ������������ܵ�Ӱ�����غĽ���ʩ�����ܳ������Ʊ����������Խ��������ӷ�װ���ϵķ�չ���ƽ���չ����
�ؼ��ʣ�
���ӷ�װ�����������ϲ������ȵ�����������ϵ����
��ͼ����ţ�TB333 �� �� ���ױ�־�룺A
Research and development of metal matrix composites for electronic packaging
ZENG Jing, PENG Chao-qun, WANG Ri-chu, WANG Xiao-feng
(School of Materials Science and Engineering, Central South University, Changsha 410083, China)
Abstract: The metal matrix composites (MMCs) is one of the important directions on the research of electronic packaging due to their excellent properties and increasingly mature manufacturing methods. The progress in the research on typical MMCs for electronic packaging was reviewed. The thermo-physical properties design, the key factors controlling the thermo-physical properties of Al-matrix and Cu-matrix composites, the improvement measures and the common manufacturing methods were discussed. The prospects for the future development of MMCs for electronic packaging were given at the end.
Key words: electronic packaging; metal matrix composites; thermal conductivity; thermal expansion coefficient
���ŵ��ӹ�ҵѸ�ͷ�չ���ִ�������Ϣ�����Ե��Ӳ�Ʒ��С�ͻ�����Я������ܡ��߿ɿ��͵ͳɱ������Խ��Խ�ߵ�Ҫ��[1]�����ӷ�װΪ������ֵ��Ӳ�Ʒ��Ҫ���ѷ�չ�˶��ֶ����ķ�װ������ӿ�ֳ������������ۡ��²��ϡ��¹��պ��²�Ʒ�����ӷ�װ���ں͵������������һ�𣬹�ͬ�ƶ�����Ϣ�����ķ�չ[2]��
�ڼ��ɵ�·�У���װ����оƬ������оƬ֧�š�оƬɢ�ȡ�оƬ��Ե�Լ�оƬ�����·���ӵ�����[3]�����ӷ�װ���ϵ��о��ص㾭���˽������մɡ����ϡ����ϲ��ϵı仯�����ӺͰ뵼�������Է�װ����Ҫ��Խ��Խ�ߣ��������Ƚ����������ϲ��ϵķ�չ[4-5]�����������ϲ��Ͽ��Խ���������ϸߵ��ȵ��ʺ���ǿ����Ͻϵ͵�������ϵ�����������ͨ���ı���ǿ�����ࡢ������������з�ʽ���߸��ϲ��ϵ��ȴ������գ��Ʊ��������������������������(��Si��GaAs)��ƥ��ķ�װ���ϡ����ͬʱ�����������ϲ����Ѿ��ɹ���ʵ���������г����㷺������Ļ����о�����Ϊ���ͳɱ����������Ч���ṩ��������֧��[6]�����������ϲ������ھ��������ŵ㣬��Ŀǰ���ӷ�װ���������о�����Ҫ����֮һ[7]��
���������ӷ�װ�����ɻ������ǿ����������ɣ������һ��Ϊ����(������ͭ��þ)����Ͻ���ǿ����ҪΪ̼(��̼��ά�����ʯ��̼����)���մ�(��̼���衢������)������(�١���)��[8-11]����1����Ϊ���ӷ�װ���ý��������ϲ��ϼ��������ɲ��ϵIJ�������ָ��[8, 12-16]��ͼ1��ʾΪ���ӷ�װ���ø��ϲ������ܱȽ�[17](ͼ��EpΪ������֬��E-glass/EpΪ�����ά��ǿ������֬��C/EpΪ̼��ǿ������֬)����Щ����Ͻ�������õĵ������ܡ��ɼӹ������Լ��������ܣ�����ǿ����нϺõ����������ܡ����õĻ�ѧ�ȶ��ԡ���ǿ�ȡ����ܶ��Լ����������Ϻõ���ʪ�ԣ��Ӷ�ȷ�����������ϲ��Ͼ�����������������ܺͷ�װ���ܡ���ˣ��ڿ�����ǿ�����ࡢ���������з�ʽ��ǰ���£����ԶԸ��ϲ��ϵ����ܽ�����ƣ�ʹ�����������Ӳ�����ƥ�������Ҫ��
��1 ���ӷ�װ���ý��������ϲ��ϼ��������ɲ��ϵIJ�������ָ��[8, 12-16]
Table 1 Partial performance indexs of common MMCs for electronic packaging and related component[8, 12-16]

1 ���������ϲ��ϵ��������������
�о��߾�ϣ������Ƹ��ϲ���ʱ���Ը�������Ҫ�����ԣ��ȶԸ��ϲ��ϵ����ܰ�������Ԥ�ʽ���м��㣬�Դ�ȷ����ǿ�����ࡢ������������з�ʽ���߸��ϲ��ϵ��ȴ������գ��Ӷ��õ���Ԥ����������ĸ��ϲ��ϡ������Ÿ��ܶȡ����ʡ���Ƶ���ɵ�·�Ŀ��ٷ�չ����ߵ��ӷ�װ���ϵ��ȵ��ʺͽ�����������ϵ����Ϊ������ɵ�·�ȿصĹؼ������б�Ҫ�Խ��������ϲ��ϵ�����������(�ȵ�����������ϵ��)����ƽ�����ϸ��̽�֡�
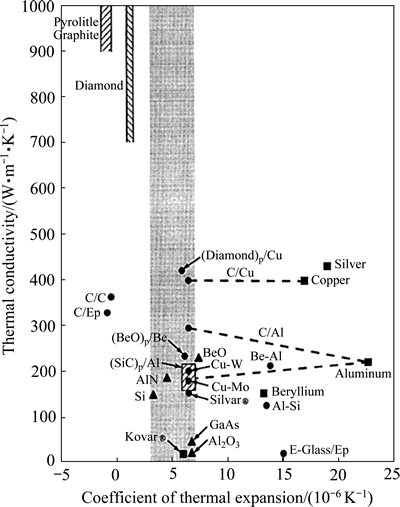
ͼ1 ���ӷ�װ���ø��ϲ������ܱȽ�[17]
Fig. 1 Comparison of properties of composites for electronic packaging[17]
1.1 ������ϵ�������
���ڵ��ӷ�װ���ϣ�������ϵ���Ǽ�����Ҫ�����ܲ���֮һ��������ǿ�������Ͻ�Ĺ��������Լ���ǿ�庬������ֱ�ӹ�ϵ��ͨ��ʵ��;���ⶨ���ϵ�������ϵ����������ȷ�ģ����Ƕ�����������IJ�����ϵ���ԣ��⽫��һ���ʱ�ࡢ���ѸߵĹ���������ȷ���ϲ�������ǿ�������Ͻ�֮�������ü�����״̬������£�ͨ�������ģ��ķ���ȷ��ò��ϵ����ܲ�����Ŀǰ����о������Ŀ�ꡣĿǰ��������ѧ����ͨ��ʵ�������ۼ������ϵķ����Խ��������ϲ��ϵ���������Ϊ������һϵ�е��о����������ֺ����ļ���ģ�ͣ��ɽ�ΪȷԤ������ͬ������ɸ��ϲ��ϵ�������ϵ����������Ŀǰ���õļ���Ԥ����������ϲ���������ϵ��������ģ�͡�
1) ROMģ��[18]
ROMģ�ͣ������Ի�Ϸ�������ļ���������ϵ����ģ�ͣ���ģ����������ֲ���ģ������ĸ��ϲ��ϣ������ں�����Ԫ֮�䵯��������¸����Ľ���������������ϵĵ���ģ���dz�С�����������ǿ����ε�Լ�����ÿ��Ժ��ԣ���ʱ���ϲ��ϵ�������ϵ�������ֲ��ϵ���Ӧ������Ĺ�ϵ��ѭ��϶��ɣ�
 (1)
(1)
ʽ�У� Ϊ������ϵ����10-6 K-1��
Ϊ������ϵ����10-6 K-1�� Ϊ����������±�c��m��I�ֱ�������ϲ��ϡ��������ǿ�ࡣ
Ϊ����������±�c��m��I�ֱ�������ϲ��ϡ��������ǿ�ࡣ
2) Eshelbyģ��[19]
Eshelbyģ�ͣ��ֳ�Ϊ��Ч������ģ�ͣ��ǽϾ���ļ��㸴�ϲ���������ϵ���ķ�������ģ�ͼ����������ǿ��������Ǹ���ͬ�Եģ��ܽ�Ϊȷ�Ĺ��Ƹ��ϲ��ϵ�������ϵ�������ϲ��ϵ�������ϵ�����Ա�ʾΪ��

 (2)
(2)
ʽ�У�SΪEshelby������CΪ�նȣ�NΪ��ǿ���Ӧ�Ļ���������
3) Kernerģ��[20]
Ŀǰ���ۼ��������Ϊ��ǿ��Ľ��������ϲ��ϵ�������ϵ��ͨ������Kernerģ�͡���ģ�����þ�����Ǣ������Ԥ�����ο�����ǿ���ϲ��ϵ�������ϵ��������踴�ϲ����м���ǿ�����Ϊ���Σ�������һ����ȵĻ��壬���ϲ��ϸ�����ͬʱ�����ż������͵Ⱦ�ѹ�������ϲ��ϵ�������ϵ�����Ա�ʾΪ

 (3)
(3)
ʽ�У�KΪ���ģ����GPa��GΪ����ģ����GPa��pΪ������ǿ�ࡣ
4) Turnerģ��[21]
������ǿ����һ������ģ��ΪTurnerģ�͡���ģ�ͼ���[22]��1) ����ʼ�¶ȣ����ϲ����ڲ�û����Ӧ�����ڣ��Ҹ��ϲ��ϸ���ֵı��γ̶���ͬ��2) ���¶ȱ仯ʱ�����ϲ����ڲ�ÿ�����ȵ������У�������֮�������ž������Ա��Σ��������¶ȵı仯�����ϲ����ڲ������ơ���϶���������ʹ�С���������仯�����ϲ��ϵ�������ϵ�����Ա�ʾΪ
 (4)
(4)
ʽ�У�KΪ���ģ����GPa�� ��EΪ����ģ����GPa��
��EΪ����ģ����GPa��
5) Schaperyģ��[23]
�ڵ����α䷶Χ�ڣ�Schaperyģ����ҪӦ������ǿ��Ϊ����ά�ĸ��ϲ��ϡ���ģ�Ͳ�������ѧ������С����ϡ��½��𣬽�����Ϊ�ڳ���ά����ͬ�Ե�����£����ϲ��ϵ�������ϵ�����Ա�ʾΪ
 (5)
(5)
 (6)
(6)
ʽ�У� Ϊ���ɱȣ�L��T�ֱ��ʾ����ά����ʹ�ֱ��ά����fΪ��ά��ǿ�ࡣ
Ϊ���ɱȣ�L��T�ֱ��ʾ����ά����ʹ�ֱ��ά����fΪ��ά��ǿ�ࡣ
��������ģ���ѳɹ�Ӧ���ڸ��ϲ��ϵ�������Ʊ���VETTERLI��[24]�о����֣��մ���ǿͭ�����ϲ��ϵ�CTE�ͻ����������ǿ���Ӳ�ȱ��йأ����ҽ��ʯ/Cu���ϲ��ϵ�CTE���ӷ���Kernerģ�ͣ���AlN/Cu���ϲ��ϵ�CTE����ROMģ�ͺ�Kernerģ������ģ������������Ա�ͼ��ͼ2(a)��(b)��ʾ��LIU��[22]������ѹ�������Ʊ�SiCp/Al���о����ֲ��ϼ��Ƚε����������߳������Եķ����ԣ���ͼ2(c)��ʾ��ͨ����Kernerģ����Ternerģ�͵ıȽϷ��֣����ߵ�Ԥ�������ӷ���ʵ�����ݡ�LALET��[25]ͨ���Ƚ�CTE��ʵ��ֵ��Schaperyģ�͵�Ԥ��ֵ����֤�˲�����ѹ���Ʊ�Cf /Cu��Cf /Al���ϲ��Ͽɵõ���Ӧ������������Ľ��ۡ�
����������֪��ÿ��ģ�ͳ�ʼ������������һ����ȱ�ݣ�������ȫ�۵ط�ӳ���������ϲ����ڲ���ʵ��״������ˣ�����ģ�Ͷ�������ȫ��ȷ���������������ϲ��ϵ����������ܡ�����ROMģ�͵�������������ΪROMģ�ͺ�������ǿ��Ի����ȱ��ε�Լ�����ã���ʵ���ϼ�ʹ��ǿ���������ʪ�Խϲ���ֱ���Լ�����û��Ǵ��ڵġ�Turnerģ����Kernerģ����û�п��ǷǾ���Ӧ���ֲ����Ȳ���Ӧ�����������ԡ����ͷ�Ӧ����Բ����ڲ�������Ӱ�졣Eshelbyģ�ͼ����ڵĸĽ�ģ���俼�Ǹ��ϲ����п��Ĵ��ڣ����Ǻ��Խ��淴Ӧ����Ĵ��ڡ�Schaperyģ����Ȼ������ǿ���������֮���Ӧ������ã�ȴ���Կ�����淴Ӧ��������������ܵ�Ӱ�졣��ˣ���Ҫ�����µ�ϸ����ѧģ����Ԥ����������ϲ��ϵ�����������[26]��

ͼ2 ���ϲ��ϵ�CTE����ǿ�ຬ���ı仯
Fig. 2 Evolution of CTE with volume fraction of reinforcement phase
1.2 �ȵ��ʵ����
�ȵ����ǵ��ӷ�װ���ϵ���һ����Ҫ�����ܲ��������ڲ�ͬ���ϣ��䴫�Ȼ��Ƹ�����ͬ���Ծ�Ե����˵�����Ȼ�����Ҫ�����ӵ��ȣ��Դ�������˵�����ӵ�������Ҫ�Ĵ��Ȼ��ƣ��ںϽ��г��˵��ӵ������⣬������Ҳ��һ�������á��ڸ��ϲ����У����ȱ��ɻ�������ǿ�ͬ�����������ȶԸ��ϲ��ϵ��ȵ��ʽ�������Ԥ�⣬ȷ����ǿ�����ʡ�����������ߴ硢����״̬���ٽ���ʵ���о��õ���Ԥ����������ĸ��ϲ��ϣ�����Ч���ͳɱ���������Ŀǰ���õļ���Ԥ����������ϲ����ȵ��ʵ�����ģ�͡�
1) Maxwellģ��[27]
Maxwellģ�ͼ�����ǿ�����Ϊ���Σ����Խ�������Ը��ϲ����ȵ��ʵ�Ӱ�죬���Ǹ��ϲ����л�������ǿ��ĵ��������Լ���ǿ�ຬ���Ը��ϲ����ȵ��ʵ�Ӱ�졣���ϲ��ϵ��ȵ��ʿ��Ա�ʾΪ
 (7)
(7)
ʽ�У� Ϊ��ǿ������������keff��km��kp�ֱ�������ϲ��ϵ���Ч�ȵ��ʡ������ȵ��ʺ���ǿ���ȵ��ʡ�
Ϊ��ǿ������������keff��km��kp�ֱ�������ϲ��ϵ���Ч�ȵ��ʡ������ȵ��ʺ���ǿ���ȵ��ʡ�
2) Hasselma��Johnsonģ��[28]
Hasselma��Johnsonģ�ͣ�Ҳ��Ϊ��Ч���ʽ��Ʒ���(Effective medium approximation�����EMA)����ģ�Ϳ��ǵ���������ͳߴ�ЧӦ���ȵ��ʵ�Ӱ�졣����������ǿ������������С��������ɢ�ڽ������������������ϲ��ϵ��ȵ��ʿ��Ա�ʾΪ

 (8)
(8)
��a��0ʱ���൱�ڽ�����������������ڴ�Ϊ�ն������Σ���ʱ���ϲ��ϵ��ȵ�����С��
 (9)
(9)
��a����ʱ���൱�ڲ����ǽ�����������Σ����������Mxawellģ�͵Ľ����ͬ��
 (10)
(10)
ʽ�У�aΪ������ֱ����hcΪΪ�����ȵ���
���У������ȵ�hc�ĵ�����Ϊͨ����ν�Ľ�������(Interfacial thermal resistance, ITR)�����������������Ϊ�����ڲ�ͬ����䴫�����������¶Ȳ��죬��������(HI)�ļ��㹫ʽΪ
 (11)
(11)
ʽ�У�QΪ��λʱ����ͨ����λ�����������������TΪ����ͨ������ʱ�������²
��������ģ�����ڴ���ʵ���о��л������Ӧ�á�MIZUUCHI��[29]����Maxwell����ģ�������ŵ�����ӷ��Ʊ��Ľ��ʯ/Al���ϲ��ϵĽ�����(��ͼ3(a)��ͼ��4������Ϊ�ȵ�������ֵ�İٷ�����������������Ϊ100%��90%��80%��70%)��ʵ��ֵ�ﵽ����ֵ��95%�����Ч�����á�YOSHIDA��[30]�о��˽��ʯ������������������Խ��ʯ/Cu���ϲ����ȵ��ʵ�Ӱ�졣��ͼ3(b)��ʾ��ʵ�������ȵ��ʴ���Hasselma��Johnsonģ�͵�Ԥ��ֵ���ɴ�֤������ͭҺ����Ϊ���ʯ���ܼ���ʹ���ʯ���ӽ��ܶѻ�����߸��ϲ��ϵ��ȵ��ʡ�

ͼ3 ���ϲ��ϵ�TC����ǿ�ຬ���ı仯
Fig. 3 Evolution of CTE with volume fraction of reinforcement phase
�о���֪[27-28, 31]��Ӱ�츴�ϲ��ϵĵ������ܵ����غܶ࣬����ǿ����������������ߴ�����״������Ͻ���������⣬�ȴ��������ϲ��ϵ����ܶȵ�����Ҳ��Ը��ϲ��ϵ��ȵ��ʲ���Ӱ�졣������������ģ��Ԥ�����Ʊ����ϲ��ϵ�������ʵ��ֵ����һ������ˣ��о������µġ������Ը�ǿ������ģ����δ���о�����֮һ[32]��
2 �������ϲ���
�������ϲ������ھ��иߵ��ȡ����ܶȺ�������ϵ�������ܣ���ĿǰӦ�ý�Ϊ�㷺�ĵ��ӷ�װ���ϣ�������ں��պ�������豸���ƶ������豸�����ž�����������������ϲ����Ѿ��ɹ���Ӧ�������ܵ����塢�ܷ�ʽ���ȳ����ϡ�MCM������ȳ���ӡˢ��·��(PCB)���ȳ�[14]��
2.1 SiCp/Al���ϲ���
SiCp/Al���ϲ��ϼ��Al��SiCp�������������ŵ㣬���нϸߵ��ȵ��ʡ���������ϵ������ǿ�ȡ����ܶȡ����õĵ����Եȣ���Щ���Լ��������������װ���ϵ���������Ҫ����ˣ��ڻ�����ϡ����塢�ǰ塢��ǵȵ��ӷ�װӦ�������ܹ�ע�����⣬SiCp/Al���ϲ����ѳɹ�Ӧ����һϵ���Ƚ����պ�����[33]������F-18����Ʒ䡱ս������ŷ�ޡ�̨�硱ս������EA-6B���ǻ��ߡ�Ԥ������ALE-50���ն����յȺ����������ǡ�̽·�ߡ��͡������ᡱ���̽�����Ⱥ������������������ӷ�װ����ʱ��SiCp/Al���ϲ��ϵ�������ϵ�����ȵ�����������Ҫ�����ܲ�������������ϵ�����ȵ��ʿ�ͨ���ı�SiCp�������������ṹ�����ϲ��ϵ��ȴ���������������ƺ͵��ء�
SiCp/Al�����������ܿ���ͨ���ı�SiCp���������������������������HASSELMAN��[34]�о�����ǿ������������ȵ��ʵ�Ӱ�죬���ó�����ǿ���������Ϊ40%ʱ�����ſ���������0.7 ��m������28 ��m����������ȵ������ӡ�����ǿ���������Ϊ60%ʱ�����ſ���������8 ��m��170 ��m�仯ʱ����Ӧ���ȵ��ʴ�151 W/(m��K)���ӵ�216 W/(m��K)[35]��Ȼ���������õ������Ʊ��������ǿ������������Ϊ60%����ˣ�MOLINA��[35-36]����˫�ߴ�������佫67%��170 ��m�ֿ�����33%��16 ��m��ϸ��������Ʊ�����ǿ�ຬ���ߴ�74%�ĸ��ϲ��ϣ����ȵ��ʺ�������ϵ���ֱ�ﵽ250 W/(m��K)��(7.8~10.8)��10-6 K-1��
SiCp/Al���ϲ��Ͼ�����Խϵ͵��ȵ��ʣ���Ҫ��SiCp /Al��ϵ�Ľ�����ʪ��Ƿ�Ѽ����淴Ӧ���£�
4Al(l)+3SiC(s)=Al4C3(s)+3Si(l) (12)
����������Һ��SiCp�Ӵ�ʱ��SiCp�����ܽⲢ�ֽ��Si��C������CŨ����ߣ�����AlҺ��Ӧ����A14C3����ʽ(12)��Al4C3����Ϊ���������뻷����ˮ����Ӧ�����Ͳ��ϵ�������[37-38]��Ϊ�˵õ����ߵ����������ܣ���ͨ��SiC����Ԥ���������������ӺϽ�Ԫ�ؼ����ձ����ȷ�����������ʪ�Բ����ͽ��淴Ӧ��LUO��[39]���ø�����������SiC�����������Ԥ�������γ�һ����ȵ�SiO2��Ĥ����SiC������������Һ�Ӵ�ʱ��SiO2��A1Һ������ԭ��Ӧ���Ӷ�����SiC��AlҺ�ĽӴ��ǣ����ƽ�����ʪ�ԡ�QU��[40]�о�Si��Mg�Ĺ����Ӷ��ڵ�����Χ����ѹ�����Ʊ�SiCp/Al���ϲ��ϵ�Ӱ�죬����Mg�������������SiC���������������Լ������г����ĵ���������Ӧ����Mg3N2������Al��һ����Ӧ����˽������ʪ�ԣ�YANG��[41]������1530 ���£���SiCp�մ��������г���մ�����Al-40%Si(��������)�����������Է�������
SiCp/Al���ϲ������ڽ�����Al���մ���ǿ��SiCp��������ϵ�����ϴ�(�ֱ�Ϊ23��10-6 K-1��4��10-6 K-1)�����Ʊ������л��������Ӧ����������ǿ����������ϸ�ʱ�������Բ��ϵĻ�е������������ɲ���Ӱ�졣SHEN��[42]��������Ԫ��ģ������ó�����������ǿ���Ի���ĸ��ϲ��������Ʊ������л��������Ӧ�����Ӷ����Ӹ������������ϵ����Ϊ��������Ӧ���Բ����������ܵ�Ӱ�죬�ɲ�ȡ�����ȴ����ķ�����KIM��[10]�о��˲��ò�ͬ�ȴ���������ˮ�㡢���䡢¯��ȶԼ�ѹ���취�Ʊ���SiCp/Al���ϲ��ϵ�������ϵ����Ӱ�죬���ó�ѡ��ˮ������ȴ����ܵõ��ϵ͵�������ϵ����
2.2 Sip/Al���ϲ���
�ں��պ����������������ĵ��ӹ����豸�У���������ӷ�װ���ϵĻ���Ҫ���ǰ���£�����������ؽ����������⡣�߹����Ͻ�������ھ��������ᣬ������ϵ���ͣ��ȴ����������ã�ǿ�Ⱥնȸߣ�����������ɶƣ���ǿ�����������ʪ���ã��������ھ��ܻ��ӹ��������ɱ���������Խ���ܣ��ܵ�������ѧ�ߵļ����ע����Ϊ���й���Ӧ��ǰ���ĵ��ӷ�װ����֮һ��
Al-Siϵ��һ���۵����ܴ��������ϵ������֮�䲻������Ӧ������֮���ڳ����µĹ��ܶ�Ҳ��С��������Al��Si�й��ܶȼ���Ϊ0[43]����ˣ�Sip/Al���ϲ��ϲ��ʺϴ�ͳ����ķ�����Ŀǰ������Ҫ�Ʊ�����[44-45]���������������ĩұ����ѹ����������ѹ����������ռ�ѹ����Ӣ��Osprey��˾����������������������ӹ������Ʊ�Sip/Al�Ͻ�ļ�����Ϊ���죬��������Sip/Al���ӷ�װ�����ڲ���֯���ȡ���������������CE7��CE9�Ͻ�������оƬ������ϵ����ƥ��ȸߣ��ѱ��ɹ�Ӧ��������·��װ�����պ������������ϵͳ��[46]�������µ�[47]���÷�ĩұ��Һ���սṤ���Ʊ���Si-50%Al(��������)���ӷ�װ���ϣ���Ϊ��ѹѹ��������ս����ϵķ������Ի���ȵ���������ĸ��ϲ���(TC��130 W/(m��K))��CHIEN��[48]���ü�ѹ�����ķ����Ʊ�������������A1/Sip���ӷ�װ���ϣ���������ϵ��Ϊ6��10-6~8��10-6 K-1���ȵ��ʴ���120 W/(m��K)���ܶ�Ϊ2.4~2.59 g/cm3��
2.3 Cf /Al���ϲ���
̼��ά��ǿ���������ϲ������������ӹ����ڵ��ӷ�װ�����м����Ӧ��DZ����������ϲ���ȵ����ܼ���������䷢չ��̼��ά��ǿ�������ϲ��Ͼ������ʡ���ǿ����������ϵ���ȷ���������ӷ�װ����Ҫ������ԣ���������淴Ӧ(��ʽ(13))���������Ʊ�����۹����лᵼ�¸��������������ܽ���[49]��
4Al(l)+3C(s)��Al4C3(s) (13)
�о�����[49]�������¶����ߣ����淴Ӧ���ӣ���ʪ���������ϲ����ȵ����������͡�Ϊ���ƽ��淴Ӧ�Ľ��У�Ӧ����̼ԭ����Al��Һ�е��ܽ��Լ��������������ɢ�̶ȡ������һĿ�Ŀɲ�ȡ����3�ִ�ʩ��1) ѡ��ʯī���̶Ƚϸߣ�����⻬�Լ����н��ٱ���ȱ�ݵ�̼��ά���Լ���̼������̼��ά�����κ����������Ʒ�Ӧ�ķ�����2) ͨ�����������������ȷ�ʽ��̼��ά���б�����ԣ���������γ���ɢ���ݣ�����Ϳ�����ǿ��ʪ�Բ�������ƫ��[50]��3) ���������Ӻ��ʵĺϽ�Ԫ���Խ���C�ڴ�AlҺ�е��ܽ�ȣ�������Si������Al4C3������[51]��
2.4 ���ʯ/Al���ϲ���
���ʯ����Ȼ������֪��Ӳ�IJ��ϣ������кܸߵ��ȵ���(��Ȼ�Ľ��ʯΪ2200~2600 W/(m��K)���˹��Ľ��ʯΪ1200~2000 W/(m��K))������ģ��(1050 GPa)�Լ��͵�������ϵ��(1.3��10-6 K-1)�������������Ǿ�Ե�塣�������볣�ý���(A1��Cu��)���ܵľ�����ԣ�������Ϊ��ǿ���������Ͻϣ��Ʊ����ĸ��ϲ��Ͽ������������ȵ��ʡ�������ϵ����ǿ�ȵ����ܣ�������ĵ��Ĵ����������ӷ�װ����[3]��
Ŀǰ��������ѧ���Ѿ��ɹ��Ʊ����ʯ��ǿ���������ϲ��ϣ�����С��������Ӧ���ڵ��ӷ�װ����BEFFORT��[52]����Һѹ������ѹ���εķ����ɹ��Ʊ������ʯ/Al���ϲ��ϡ�����������ǿ����ʪ�Բ��ͬ���ʷ�ʽ���µĽ��������⣬������������ʯ�ڸ��ϲ����е����á����ʯ��Al����ʪ�Լ����1000 ��ʱ����������ʯ�Ľ������150�㣬����ֱ���Ʊ������ܶȽϸߵĸ��ϲ��ϣ�����϶�Ĵ����������Ͳ��ϵ��ȵ���[13]����ˣ���Ҫ�Խ��ʯ���б�����Ի�Ի�����кϽ����������ദ�������ӽ��������ٽ����淴Ӧ(��ʽ(13))����ˣ��������߽��ʯ�������ʪ�Ե�ͬʱ����С�������裬����ȶ��ĸ����ܸ��ϲ����ǹ�����ѧ�߲����о��Ŀ��⡣MIZUUCHI��[29]�����Ϸ�ĩ���÷ŵ�������ս�ķ�ʽ�ɹ��Ʊ������ܶȸߴ�99%���ϡ��ȵ���Ϊ552 W/(m��K)�Ľ��ʯ/Al���ϲ��ϡ�FENG��[53]ͨ���ڽ��ʯ����Ϳ������������ʪ�����õ�TiC���и��Դ�����ͨ����ѹ������ϼ�ѹ�ķ�ʽ�ɹ��Ʊ��˸��ϲ��ϣ��о�����TiC����ǿ��������ǿ���Ľ�������������ȵ���Ϊ365 W/(m��K)��������ϵ��Ϊ5.69��10-6 K-1��������ӷ�װ���ϡ�
3 ͭ����װ����
ͭ�����ϲ����ѳɹ�Ӧ�����ȳ����ϼ��紥ͷ���ϡ�ͭ���ȵ��ʺܸߣ��ﵽ401 W/(m��K)������������ϵ��ԼΪ17��10-6 K-1��Ϊ�˽�����������ϵ��������ͭ��������ϵ���ϵ͵�������W(4.45��10-6 K-1)��Mo(5.0��10-6 K-1)�ȸ��ϣ��õ��ߵ������ܡ�������ϵ������Ӳ�ȵĸ��ϲ���[14]��Ȼ��W/Cu��Mo/Cu���ܶȺܴ�(10~17 g/cm3)���������ں��պ���ϵͳ�Լ���Яʽ���������еĵ��ӷ�װ���ϣ���ˣ������ʯ������̼���������̼��ά��������ϵ�����ܶȾ��ϵ͵���ǿ����ͭ���帴�Ͽɵõ���Ϊ����ĵ��ӷ�װ���ϡ�
3.1 W/Cu��Mo/Cu���ϲ���
W/Cu��Mo/Cu���ϲ���Ҳ��ΪW/Cu��Mo/Cu�Ͻ𣬼��Խ�������W��MoΪ��ǿ��ĵ�һ�����������ӷ�װ���ϣ����ȵ���Ϊ150~230 W/(m��K)��������ϵ��Ϊ5.7��10-6~10��10-6 K-1����ĿǰӦ����㷺�Ľ��������ӷ�װ���ϡ���ҪӦ���ڵ���ɢ�������Լ��ȳ����ϡ��ҹ�W/Cu��Mo/Cu�ȴ�ͳ���ӷ�װ���ϵ��Ʊ���Ӧ�ü����ϳ��죬�ѽ��д��ģ��ҵ�������������ֲ��ϵ��ȵ����Ѳ��������ִ����������ĸ���Ҫ���ر������ܶȴ�(W/Cu��15~17 g/cm3��Mo/Cu��9.9~10.0 g/cm3)���������ڱ�Я���Ӻͺ��պ���װ����Ӧ�á�
3.2 SiCp /Cu���ϲ���
����Cu��Al���и��ߵ��ȵ��ʣ�������SiCp/Cu���ϲ���Ӧ���и��ߵĵ������ܣ�������SiCp/Cu��Ľ��淴Ӧ���ѿ��ƣ����������͵������ܵķ��ӣ����ø��ϲ��ϵ���Ч�ȵ��ʲ�δ������ߡ�SiCp/Cu���ϲ��ϵĴ��ģӦ����Ҫ�����������ϲ����ʪ�Ժ;��ҵĽ��淴Ӧ������SiCp��Cu�����ʪ�ԡ����ƽ��淴Ӧ�������SiCp/Cu���ӷ�װ�����ۺ����ܵĹؼ���
MARTINEZ��[54]�о��������ڸ�����£��¶�Ϊ1100 ��ʱ��SiC��Cu֮�����ʪ��Ϊ140�㣬��ʪ�Լ��SUNDBERG��[55]�о���������ͭ��������ǿ����850~1200 ��ֱ�ӽӴ�ʱ���������·�Ӧ��
SiC+Cu��C+Cu3Si (14)
ͬʱ��SiC�ֽ������SiԪ�ػ���ͭ��������ɢ�γɹ����壬Ӱ�츴�ϲ��ϵ����ܡ�����ͭ��Si���������0.5��10-6������1100��10-6ʱ����ͭ������ȵ��ʴ�401 W/(m��K)�½���233 W/(m��K)����ˣ���̼�����ͭ�����������ɢ�赲�㣬�����н�����أ��Կ���ͭ��̼����֮��Ľ��淴Ӧ����ͭ������̼����֮�����ʪ�ԣ�����ʮ����Ҫ�����ۺ�ʵ������[56]������Ϊֹ�������ⳣ�õĽ�����ط�����Ҫ�л���Ͻ���ǿ�������ԡ�
Ŀǰ������Ͻ����������������ӻ���Ԫ�أ��Ǽ�С��ʪ�ǡ�����̼������ͭ������ʪ�Խϳ��õļ�����ZHANG��[57]�������η��о�����Ԫ��Ti����ѹ�����Ʊ�������SiC��ͭ������ʪ�Ե�Ӱ�죬�����������Ԫ��Ti������ʹ��1100 ��ʱSiC��ͭ����ʪ�ǽ�Ϊ15�㣬���洦Ti��ƫ���Լ�Ti��SiC��Ӧ����TiC����������̼�����֮ͭ��Ľ����ܣ����ƽ�����ʪ�ԡ�
��ǿ�������Կ�ͨ����ѧ�ơ�������ѧ��������ȷ����ڿ�������Ϳ��һ�����(Ti��Cu��Ni��Mo��)������̼��������赲��(TiN�����ʯ��TiC��Al2O3��)��MOUSTAFA��[58]���û�ѧ����SiCp�����һ��NiͿ�㣬��Ni����SiCp��ͭ�ۻ�ϲ���ѹ����900 �������������ս��Ʊ���SiCp/Cu���ϲ��ϣ�NiͿ��Ĵ��������ڸ���SiC��ͭ����֮��Ľ�����ʪ���ϣ�ʹ�ø��ϲ��ϵ����ܶȴﵽ95%��SCHUBERT��[59]���ôſؽ���ķ�����SiCp����Ϳ��һ��MoͿ�㣬ͨ��Mo��SiC��Ӧ�������̼����軯��ķ�ʽ�γɵĽ����赲�㣬��Ч��ֹͭ��SiC�Ľ��淴Ӧ��������980 ����ѹ�սṤ���Ʊ���SiCp/Cu���ӷ�װ���ϣ���SiCp�������Ϊ40%ʱ�����ȵ��ʴﵽ306 W/(m��K)��30~100 ����������ϵ��Ϊ11.2��10-6 K-1��
3.3 Cf /Cu���ϲ���
Cf /Cu���ϲ����ۺ�ͭ�����õ��絼���Ժ�̼��ά�ĸ߱�ǿ�ȡ��߱�ģ������������ϵ�������õ����ԣ����ֳ����õļ�ĥ��ĥ�ԡ������ԡ��͵绡��ʴ�ԡ������ԡ����ۺ��ԺͿ��ϻ���[60]�����������õĿ�����ԣ����㷺��������Ԫ�����ϡ��������ϡ���ͷ���ϡ��Ƚ������ϵȡ�
���ϲ��ϵĽ���ǿ�ȶ���������ֱ�ӵ�Ӱ�죬���ʵĽ���ǿ�Ȳ�����������߲��ϵ��������ܣ������ڽ����������ܵ��غ�ͨ�����洫�ݸ���ά����ַ�������ǿ����[61]��ͭ��̼������������Ӧ�������ͨ������е�����������һ�𣬵���Cf/Cu���ϲ��Ͼ��иߵĽ��������͵͵��ȵ��ʣ�����Cf/Cu���ϲ����Ʊ�����������˷���һ�����⡣
Ϊ�˻�þ��еͽ����������ȵ��ʵ�Cf/Cu���ӷ�װ���ϲ��ϣ�һ�������ǿ������������ǿ�����������LIU��[62]�������ҷ���̼��ά����Ϳ��һ��0.1 ��m��1 ��m���TiCͿ������ǿ����ͭ����Ľ����������ɻ���ȵ�Ϊ330~365 W/(m��K)�ĸ��ϲ��ϣ���δ���б�����Եĸ��ϲ��ϵ��ȵ����24%~43%���ر�أ�COUILLAUD��[63]���Ӿ�Ե��Ca(OH)2��Ϊ̼��������Ԫ���ڽ��洦����̼�����Cf/Cu���ϲ��Ͻ��洦�Ļ�е���ת��Ϊ��ѧ��ϣ���ǿ����������������������Ca(OH)2�����������0.5%ʱ�����ϲ����ȵ����ӣ�������ϵ����С��
3.4 ���ʯ/Cu���ϲ���
1995�꣬������Lawrence Livermore����ʵ������Sun Microsystems��˾�о����������̱�ΪDymalloy[64]�Ľ��ʯ/Cu���ϲ���(����ΪCu80Ag20�Ͻ�)���佫����Ϳ�������Ľ��ʯ�۷���ģ��ѹ�Ƴ��Σ�Ȼ���������ͭ�Ͻ��Ʊ������ʯ�����������Ϊ55%���ȵ���Ϊ420 W/(m��K)��������ϵ��Ϊ5.5��10-6 K-1�ĸ��ϲ��ϣ�����Ϊ��оƬģ��Ļ���ʹ�á����иߵ����ʡ���������ϵ���Ľ��ʯ/Cu���ϲ��ϵijɹ��Ʊ����ڵ��ӷ�װ�о�����������һ���µ����ˣ��˺�20��������������ѧ�߶Խ��ʯ/Cu���ϲ��ϵ��Ʊ����ա��������⡢���������ܼ�Ӧ�ý�����һϵ���о���̽�֡����ʯ��ͭ��ʪ�Խϲ�����Ʊ������н��ʯ����������Ӧ(��700 ��)��ʯī����Ӧ(��1000 ��)�ķ�������������ϵ����������ܣ�������谭���ʯ/Cu���ϲ��ϵ�Ӧ�úʹ��ģ�����������ǿ���ʯ�����ͭ�Ľ�������ؽ����������������⡣
ͨ���ı��Ʊ����տɸ��ƽ��ʯ��ͭ����ʪ�ԡ�YOSHIDA��[30]���ø��¸�ѹ��(1420~1470 K��4.5 GPa)���ӽ��ʯ��ͭ����ʪ�Բ�����ʯī���IJ������Ʊ������ʯ/Cu���ϲ��ϣ������ʯ��������Ϊ90~110 ��m���������Ϊ70%ʱ���ȵ��ʿɴ�742 W/(m��K)������������ϵ������������İ뵼�������ƥ�䡣BAI��[65]��Cu-5%W��ĩ��1040 ��Ԥ�Ⱥ�����ʯ�������÷ŵ�������ս�(SPS)�Ʊ����ʯ/Cu���ϲ��ϣ��о��ó������ʯ��������Ϊ300 ��m���������Ϊ46%ʱ���ɻ�����ܶȽϸ����ȵ��ʴ�672 W/(m��K)�ĸ��ϲ��ϡ�
��������Ͻ����������ӽ��ʯ��ͭ����ʪ���������������B��Cr��Al��Ti ��Zr��������̼����Ļ���Ԫ������ͭ�����У�����һ���̶������������ǿ�����ʪ�ԡ�����Ϊ�˱��ָ�������������һ�µĸ��ȵ��ʣ���������������ƻ���Ԫ�ص���������WEBER��[66]̽�ֻ���Ԫ��Cr��B��ͭ�����еļ������Լ�ѹ������ʽ�Ʊ����ʯ/Cu���ϲ��ϵ�Ӱ�졣��Cr���������ﵽ0.05%���ϵ��ȵ��ʿ����ӵ�600 W/(m��K)��������ϵ��Ϊ10��10-6 K-1����B���������ﵽ2.5%���ϵ��ȵ���Ϊ700 W/(m��K)��������ϵ��Ϊ7��10-6~8��10-6 K-1������������������ȵ����½���SCHUBERT��[67]�ڻ����м�����������Ԫ��Cr�ڽ��ʯ��ͭ���洦��̼��Ӧ�������׳߶ȵ�Cr3C2�㣬ʹ���ϲ��ϵĽ���ǿ����������������ߡ�CHU��[68]�о�����Zr���������Խ��ʯ/Cu���ϲ����۽ṹ���ȵ��ʵ�Ӱ�죬��Zr��������Ϊ1.2%ʱ���������ȵ���615 W/(m��K)��
Ϊ�˷�ֹ���ʯ����������ʯī�������Խ��ʯ������ý��������������ڽ��ʯ����Ϳ������Ϳ�㡣һ��ѡ��Ti��Cr��Mo����W��̼�����γ�Ԫ��Ϳ���ڽ��ʯ���棬��Щ����Ԫ�ؿ���Ϊ�м����ǿ���������ǿ�ȣ��������ʯ����������Χ�����������´���ʱ��ʯī���̶ȡ�Ϳ������������ѧ�ơ���ơ���նƵȷ�����REN��[69]������ն��ڽ��ʯ����Ϳ��CrͿ��������ͭ���ϣ��Ʊ����ʯ/Cu���ϲ��ϣ�Cr3C7���γɻ������������ʪ�ԣ���߸��ϲ��ϵ����ܡ���Cr�Ʋ���Ϊ0.6~0.9 ��m���ҽ��ʯ�����������Ϊ70%ʱ�����ϲ��ϵ��ȵ��ʿɴ�657 W/(m��K)��ZHANG��[70]�������ҷ��ڽ��ʯ�����Ti���γɾ��ȵ�TiC���ɲ㣬����Ti���ʯ�����ͭ�����Ʊ����ʯ/Cu�����ȵ��ʴﵽ493 W/(m��K)��
�������Ϸ����ɸ��ƽ��ʯ������ͭ����Ľ�����״̬�⣬���ӽ��ʯ��ͭ����ĽӴ����Ҳ��һ����֮��Ч�ķ������ɲ������ַ�ʽ���ӽ��ʯ��ͭ����ĽӴ������һ��������ʯ�����ǽ����ʯ����ֻ����ϴ�ı�����������Խ��ʯ�İѳ���[71]��
4 �������ϲ���
ʯīϩ�����������ڴ�ͳ�����ܲ���(�����մɿ�����̼��ά��̼���ܵ�)�ļ��ߵĵ���ģ��(����1000 GPa)������ǿ��(����120 GPa)������ĵ�������(Լ5300 W/(m��K))����������ϵ������ˣ�ʯīϩһֱ����Ϊһ������ĵ��ӷ�װ�ø��ϲ��ϵ���ǿ�塣�Դ�2004�걻�ɹ��Ʊ�����ʯīϩ��صĸ��ϲ��ϵ��о���Ҫ��������֬��[72-74]�����ӷ�װ��ʯīϩ��ǿ���������ϲ��ϵ��о��Ÿո������������о���λ�������������ܽ��г���̽��[75-76]��ʯīϩ��ǿ���������ϲ��ϵļ�����������������ܾ������ڵ��ӷ�װ�����й����ķ�չ�ռ䡣Cf/Mg���ϲ������ںܺõؽ���˽���þ���ᡢ������ϵ���ӽ����̼��ά�ĸ߱�ǿ�ȡ��߱�ģ����������������ϵ��С���������ܣ��ұ��ֳ������ĵ���������Ժ��ӹ��ԣ����������칤ҵ�����������ӷ�װ�����������Ź���Ӧ��ǰ��[77]����̼��ά��Һ̬þ����ʪ�����Լ�þ�Ļ����ͼ�����Լ��Cf/Mg���ϲ��ϵķ�չ��Ӧ�á�BeO/Be���ϲ��ϵ�������ϵ��Ϊ6.1��10-6 K-1���ȵ���Ϊ240 W/(m��K)���ܶ�Ϊ2.55 g/cm3�������ͻ�ϼ��ɵ�·�������װ����֮һ���������������еĶ��Բ����ϻ����Ѻõ�Ҫ��ʹ����Ӧ���ܵ���������ơ������Ľ��������ϲ��ϻ���Cu/Mo/Cu��Ag/Invar��Al/Invar��Cu/BeO�ȡ�ͼ4��ʾΪSip/Al��SiCp/Cu�����ʯ/Cu��Cf/Mg���ϲ��ϵ��۽ṹ[15, 46, 51, 71]����ͼ4�п��Կ�������ǿ���ڸ��ϲ����зֲ���������������ϸߡ���ǿ��ΪSip��SiCp��ʱ�����ϲ��Ͻ��淴Ӧ�ܵ�����Ͻ������(��ͼ4(a)��(b))���ڽ��ʯ��̼��ά��ǿ���������ϲ����У�TiC�������ʯ(��ͼ4(c)��(d))��SiO2����̼��ά(��ͼ4(e)��(f))�����ڻ�������ǿ���Ľ����ϣ���ˣ�����ýϺõ����������ܡ�
5 �����Ʊ�����
5.1 ��ĩұ��
��ĩұ��(Powder metallurgy method)���Ʊ���������ǿ�ͽ��������ϲ��ϵ�һ�ִ�ͳ�Ĺ�̬���շ������š���ɫ���켼����������[78]��ͼ5��ʾΪ��ĩұ���Ʊ����ϲ��ϵ�����ʾ��ͼ[1]�������÷�ĩұ��ԭ���������������ĩ����ǿ�ఴһ���ı������ʵ��������¾��Ȼ�ϣ�ͬʱ�Ի���Ͻ��г�������ȥ���������塢ˮ����������ӷ������ʣ�Ȼ��ѹ�ƻ�ѹ���κ��սᣬ����ֱ���û���Ͻ�����ѹ�������ơ��ȼ�ѹ���Σ�Ҳ���Խ������ѹ������ȵ���������Ĺ�-Һ���¶����ڽ��а��̬���Σ���ø��ϲ��϶��顣һ����ԣ���ĩұ�黹��Ҫ������ѹ�����Ƶȶ��μӹ�������߲������ܶ��Լ������ֲ������ԡ�W/Cu��Mo/ Cu�ȴ�ͳ�ȳ��͵�Ƭ����һ����ø÷��Ʊ���SiCp/Al��SiCp/Cu�����ʯ/Al�����ʯ/CuҲͬ�����á�
�÷�������Ҫ�ŵ��ǣ���ǿ�������Ͻ��ĩ�нϿ���ѡ��Χ�������������������������������ܿ����ijߴ�����״�����ƣ�����ʵ���Ƽ����١����������߽������Σ�ȱ���ǣ����칤�࣬���ո��ӣ�����ɱ��ϸߣ������Ʊ���״���ӡ��ߴ����ǿ����������ϸߵ��Ƽ���
5.2 �ŵ�������ս�
�ŵ�������ս�(Spark plasma sintering��SPS)���ǽ�������չ������һ�����Ͳ����Ʊ��������ŵ�������ս���Ҫ���ô�������������Ʒ���м��ȣ�ʹ����Ʒ�������ʿ��Դﵽ600 K/min���������ս�����п��Զ�ĥ��ѹͷʩ��ѹ�����Ӷ�ʵ�ָ��ֲ��ϵĵ��¡������սᡣͼ6��ʾΪ�ŵ�������ս��豸ʾ��ͼ[79]��SPS����Ŀǰ�Ʊ��ϸ�����������ʯ����/���������ϲ��ϵij��÷��������ʯ/Al�����ʯ/Cu��Cf/Al��Cf/Cu�Ȳ���SPS�Ʊ��ɻ�ýϺõ����ܡ�
�봫ͳ���ս᷽����ȣ�SPS���������ٶȿ졢��֯�ṹ�ɿء����ܻ���[80]���ŵ㣬�Ƶõ��ս���Ʒ�������ȡ����ܶȸߡ���ѧ���ܺá����Ʊ�������ȱ�����Ʊ��������������ǿ�ຬ���Ľ��������ϲ���ʱ�����ܶȻ��������룬�Ҳ����Ʊ���ߴ��Ʒ�������ڲ�ҵ����

ͼ4 ��ͬ���������ӷ�װ���ϵ����ṹ
Fig. 4 Microstructures of different kinds of metal matrix composites for electronic packaging
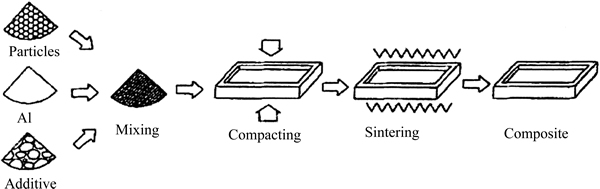
ͼ5 ��ĩұ���Ʊ�����ʾ��ͼ[1]
Fig. 5 Schematic diagram of powder metallurgy method preparation process[1]
5.3 ���������
���������(Spray deposition)��20����ĩ��Ӣ��Osprey��˾[46]��ʼ�ڹ�ҵ��ʵ��Ӧ�õġ��ù��տ˷�����ǿ�����ڽ��������е�ƫ�ۺ�����ƫ�����⣬ͬʱ��������ǿ�������������֮��Ľ��淴Ӧ����ֱ����Һ̬������ȡ���������̳��Ρ�ͼ7��ʾΪ�������ʾ��ͼ[43]����ԭ�������ø�ѹ����������Һ̬�����������γ�����������������������ȵ��մɿ���(����Ŀ����ʹ��������)�������Ϻ�ͬ����������Ԥ�����ijĵ��ϣ����������γɸ��ϲ��ϡ������������ҪӦ����Sip/Al���Ʊ���������
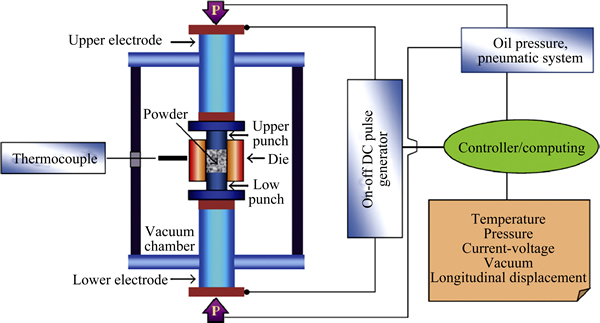
ͼ6 �ŵ�������ս��豸ʾ��ͼ[79]
Fig. 6 Schematic diagram of spark plasma sintering facility[79]
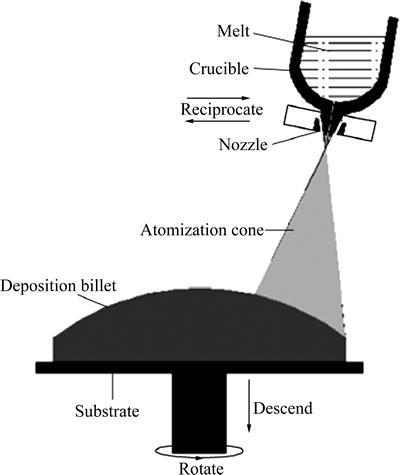
ͼ7 �������ʾ��ͼ[43]
Fig. 7 Schematic diagram showing principle of spray deposition process[43]
���������������������С�߹����Ͻ���ϵľ����ߴ硢ϸ������֯��ʹSi�������ȡ���ɢ�طֲ����������У�����������ǿ�������ڻ����еĹ��ܶȣ����ƫ���ٻ�����ƫ���ľ�������֯[43]����������Ҳͬ������������������������嶯��ѧ���ȶ���ɵõ��ĸ��ϲ�����֯�����ȡ������ٶȽ������ɱ��ϸߡ��������ܶȵ͡���Ҫ���μӹ���
5.4 ���������
����������Ʊ�����ͨ����Ϊ��������һ�����Ʊ�������ǿ��Ԥ�Ƽ����ڶ�������ëϸ���������������ѹ���������£��������γɸ��ϲ��ϡ�ͨ�����ַ����ı�һЩ������ʹҺ̬������Ϊ���ȵ��������ǼܵĿ�϶�С�����Ҫ������SiCp/Al��SiCp/Cu��Cf/Cu��Cf/Al�ȸ��ϲ��ϵ��Ʊ���������η���������Լ����ܹ���ý������ε����������ǿ��Ԥ������Ʊ����̽�Ϊ���ӣ����������ɱ���
1) ѹ������
ѹ��������(Pressure infiltration)�ֳƼ�ѹ���취(Squeeze casting)���������������һ�֡�ѹ��������ʾ��ͼ��ͼ8��ʾ���÷�����С���㲿��������ʹ�ý��ձ�[81]��
�÷������ŵ��Ǿ����������ڶ̡����ռ����ȶ��Ժã��������IJ��ϵ������Ը��Ҳ��ÿ��Dz��ϵ���ʪ�Ե��ŵ㣬��ˣ����ʺ��ڹ�ģ���Ĺ�ҵ������[82]�����÷���ͬʱҲ�кܶ�㣬����ѹ��������Ҫ��ѹ���Ƚϴ��豸�ɱ��ߣ�ֻ�������Ƚϼ���������ڸ��ӵ�����Լ�С�ı����ӷ�װ���ϵ������кܴ�����ԡ�
2) ��ѹ����
��ѹ������(Pressureless infiltration)��������Lanxide��˾������һ�ֶ��صĹ��ա�����ָ�ڸ����£�������������ëϸ������������Ԥ���������ķ�����ͼ9��ʾΪ��ѹ������ʾ��ͼ[83]��
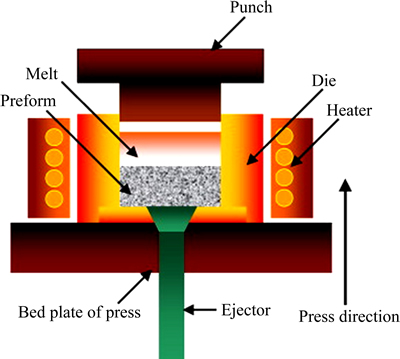
ͼ8 ѹ������ʾ��ͼ[81]
Fig. 8 Schematic diagram of pressure infiltration[81]
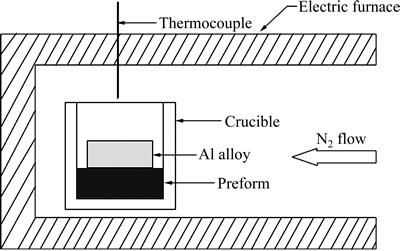
ͼ9 ��ѹ������ʾ��ͼ[83]
Fig. 9 Schematic diagram of pressureless infiltration[83]
���Ʊ������豸���ɱ���[33]������ǿ����Ͻ����֮�����ʪ�Գ��˸��Ʊ������Ĺؼ�����[84]��
3) ���ѹ��������
���ѹ��������(Vacuum pressure infiltration)�������Ʊ���ϸ�ṹ���ϲ��ϵķ�������ʵ�������ô���ѹ�����ٽ�Һ���������ǿ��Ľ��[85]��ͼ10��ʾΪ���ѹ��������ʾ��ͼ[86]���䲽��Ϊ���Ƚ���ǿ��Ԥ�������ģ���ڣ�����ղ�ͨ�������գ�Ȼ��ʩ��5~10 MPa��ѹ�������ڽ���Һ��ѹ��ģ���У�ֱ������Һ����ȫ��Ԥ�Ƽ�����ȴ�ɵõ����������ϲ��ϡ�
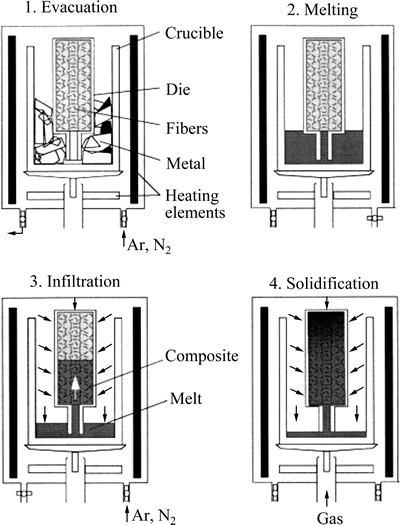
ͼ10 ���ѹ��������ʾ��ͼ[86]
Fig. 10 Schematic diagram of vacuum pressure infiltration method[86]
�÷��������ŵ��ǿ˷���ѹ����������ѹ������ȱ�㣬����ѹ���仯��Χ��������㣬��ֱ�ӳ��Σ�������ǿ����ϵ���״���ߴ硢�����������٣����Ƴɽ����ι��������Ʊ�������������Ľ��������ϲ��ϣ����÷������ڶԽ����豸Ҫ��Ƚϸߡ������ߴ��������Լ�����Ч�ʵ͵�ȱ��[86]��
6 չ��
���ż��ɵ�·��С�ͻ������ܶ���װ�����ͳɱ��������ܵķ�չ�����ӷ�װ�����ķ��ٽ����Ե��ӷ�װ���ϵ�Ҫ��Խ��Խ���̡�Ŀǰ��SiCp/Al��SiCp/Cu��Sip/Al�ѵõ�����Ӧ�ã���ȱ��Ҳ�����������Ѽӹ����ȵ��ʵ;��谭���ڵ��ӷ�װ�����Ӧ�ã�Cf/Al�����ʯ/Cu�������ʡ����ȵ��ʡ���������ϵ�����ŽϺõķ�չǰ���������Ʊ������Դ���������ȱ�ݣ�������������ǿ�����ʪ�Բ��ؽ����ϲ��ϵ����������ܡ���ˣ�δ���Ľ��������ϲ����о�����Ӧ�������ۺϿ��Ƿ�������������ʯīϩ��������ǿ�࣬�������͵��ӷ�װ�ý��������ϲ��ϣ���Ʋ��Ʊ����������������ĵ��ӷ�װ���ϣ���ϼ�����������ģ���������������Ƚ����ϵ����ܡ�ʧЧ��Ϊ������Ч��Ԥ����������ʹ����ӿ۵ط�ӳ���������ϲ����ڲ���ʵ��״����
REFERENCES
[1] LU D, WONG C P. �Ƚ���װ����[M]. ����: ��е��ҵ������, 2012: 35-38.
LU D, WONG C P. Materials for advanced packaging[M]. Beijing: China Machine Press, 2012: 35-38.
[2] HARPER C A. ���ӷ�װ�����빤��[M]. ����: ��ѧ��ҵ������, 2006: 16-17.
HARPER C A. Electronic materials and processes handbook[M]. Beijng: Chemical Industry Press, 2006: 16-17.
[3] �� ��, ������, �� ��, ������. ���ӷ�װ�ý��������ϲ��ϵ��о���״[J]. ���ϵ���, 2013, 27(22): 181-183.
ZHU Min, SUN Zhong-xin, GAO Feng, LIU Xiao-yang. Research progress of composites for electronic packaging materials[J]. Materials Review, 2013, 27(22): 181-183.
[4] KACZMAR J W, PIETRZAK K, WLOSINSKI W. The production and application of metal matrix composite materials[J]. Journal of Materials Processing Technology, 2000, 106(1): 58-67.
[5] MALLIK S, EKERE N, BEST C, BHATTI R. Investigation of thermal management materials for automotive electronic control units[J]. Applied Thermal Engineering, 2011, 31(2): 355-362.
[6] �� ��, �Ź���, ��־ǿ. ���������ϲ��ϵ���״�뷢չ����[J]. �й����Ͻ�չ, 2010, 29(4): 1-7.
ZHANG Di, ZHANG Guo-ding, LI Zhi-qiang. The current state and trend of metal matrix composites[J]. Materials China, 2010, 29(4): 1-7.
[7] HUNT W H, PREMKUMAR M K. Novel materials for electronic packaging and thermal management[J]. Journal of the Minerals Metals & Materials Society, 1992, 44(7): 7-8.
[8] PRIETO R, MOLINA J M, NARCISO J, LOUIS E. Fabrication and properties of graphite flakes/metal composites for thermal management applications[J]. Scripta Materialia, 2008, 59(1): 11-14.
[9] COUTURIER R, DUCRET D, MERLE P, DISSONB J P, JOUBERTB P. Elaboration and characterization of a metal matrix composite:Al/AlN[J]. Journal of the European Ceramic Society, 1997, 17(15): 1861-1866.
[10] KIM B G, DONG S L, PARK S D. Effects of thermal processing on thermal expansion coefficient of a 50 vol.% SiCp/Al composite[J]. Materials Chemistry and Physics, 2001, 72(1): 42-47.
[11] CHU Ke, LIU Zhao-fang, JIA Cheng-chang, CHEN Hui, LIANG Xue-bing, GAO Wen-jia, TIAN Wen-huai, GUO Hong. Thermal conductivity of SPS consolidated Cu/diamond composites with Cr-coated diamond particles[J]. Journal of Alloys and Compounds, 2010, 490(1/2): 453-458.
[12] κ�ܹ�. �������Si-Al���ӷ�װ���ϵ��Ʊ�����֯�����о�[D]. ����: ��ɫ�����о���Ժ, 2006: 85-87.
WEI Yan-guang. Research on producing��microstructures and properties of spray formed Si-Al alloys used for electronic packaging[D]. Beijing: General Research Institute for Nonferrous Metals, 2006: 85-87.
[13] ������, �ֳ���, ��С��, �� ˴, ������. ���͵��ӷ�װ�ý��ʯ/�������ϲ��ϵ���֯������Ӧ��[J]. ���ϵ���, 2008, 22(3): 36-40.
FANG Zhen-zheng, LIN Chen-guang, ZHANG Xiao-yong, CUI Shun, CHU Jian-xin. Properties and application of Diamond/ metal composites for electronic packaging[J]. Materials Review, 2008, 22(3): 36-40.
[14] ������, ������. ���������ӷ�װ���ϲ��ϵ��о���չ[J]. �����ȴ���, 2003, 28(6): 1-5.
NIE Cun-zhu, ZHAO Nai-qin. Review of metal-matrix composite materials for electronic packaging[J]. Heat Treatment of Metals, 2003, 28(6): 1-5.
[15] �˰�ǿ, ������, ̷ռ��, ������, ��־ǿ, �� ݶ. ���ʯ/ͭ���ϲ����ڵ��ӷ�װ����������о���չ[J]. ���ʯ��ĥ��ĥ�߹���, 2010, 30(5): 57-61.
DENG An-qiang, FAN Jing-bo, TAN Zhan-qiu, FAN Gen-lian, LI Zhi-qiang, ZHANG Di. Research progress of diamond/Cu composite material for electronic packaging[J]. Diamond & Abrasives Engineering, 2010, 30(5): 57-61.
[16] ZHANG L, QU X H, HE X B, DUAN B H, REN S B, QIN M L. Thermo-physical and mechanical properties of high volume fraction SiCp/Cu composites prepared by pressureless infiltration[J]. Materials Science and Engineering A, 2008, 489(1/2): 285-293.
[17] MIRACLE D. Metal matrix composites: From science to technological significance[J]. Composites Science and Technology, 2005, 65(15/16): 2526-2540.
[18] CLYNE T W, WITHERS P J. ���������ϲ��ϵ���[M]. ����: ұ��ҵ������, 1996: 114-117.
CLYNE T W, WITHERS P J. An introduction to metal matrix composites[M]. Beijng: Metallurgical Industry Press, 1996: 114-117.
[19] BOWLES D E, TOMPKINS S S. Prediction of coefficients of thermal expansion for unidirectional composites[J]. Journal of Composite Materials, 1989, 23(4): 370-388.
[20] KERNER E H. The elastic and thermoelastic properties of composite media[J]. Proceedings of the Physical Society, 1956, 68B(1/2): 808-813.
[21] TURNER P S. Thermal expansion stresses in reinforced plastics[J]. Journal of Research of the National Bureau of Standards, 1946, 37: 239-250.
[22] LIU J, ZHENG Z, WANG J, WU Y, TANG W, LV J. Pressureless infiltration of liquid aluminum alloy into SiC preforms to form near-net-shape SiC/Al composites[J]. Journal of Alloys and Compounds, 2008, 465(1/2): 239-243.
[23] SCHAPERY R A. Thermal expansion coefficients of composite materials based on energy principles[J]. Journal of Composite Materials, 1968, 2(3): 380-404.
[24] VETTERLI M, TAVANGAR R, WEBERB L, KELLY A. Influence of the elastic properties of the phases on the coefficient of thermal expansion of a metal matrix composite[J]. Scripta Materialia, 2011, 64(2): 153-156.
[25] LALET G, KURITA H, HEINTZ J M, LACOMBE G, KAWASAKI A, SILVAIN J F. Thermal expansion coefficient and thermal fatigue of discontinuous carbon fiber-reinforced copper and aluminum matrix composites without interfacial chemical bond[J]. Journal of Materials Science, 2013, 49(1): 397-402.
[26] UJU W A, OGUOCHA I N A. A study of thermal expansion of Al-Mg alloy composites containing fly ash[J]. Materials and Design, 2012, 33: 503-509.
[27] ERVIN V J, KLETT J W, MUNDT C M. Estimation of the thermal conductivity of composites[J]. Journal of Materials Science, 1999, 34(14): 3545-3553.
[28] DAVIS L C, ARTZ B E. Thermal conductivity of metal-matrix composites[J]. Journal of Applied Physics, 1995, 77(10): 4954-4960.
[29] MIZUUCHI K, INOUE K, AGARI Y, MORISADA Y, SUGIOKA M, TANAKA M, TAKEUCHI T, TANI J I, KAWAHARA M, MAKINO Y. Processing of diamond particle dispersed aluminum matrix composites in continuous solid-liquid co-existent state by SPS and their thermal properties[J]. Composites Part B (Engineering), 2011, 42(4): 825-831.
[30] YOSHIDA K, MORIGAMI H. Thermal properties of diamond/ copper composite material[J]. Microelectronics Reliability, 2004, 44(2): 303-308.
[31] ZHANG Y, LI J, ZHAO L, ZHANG H, WANG X. Effect of metalloid silicon addition on densification, microstructure and thermal-physical properties of Al/diamond composites consolidated by spark plasma sintering[J]. Materials & Design, 2014, 63: 838-847.
[32] MIZUUCHI K, INOUE K, AGARI Y, SUGIOKA M, TANAKA M, TAKEUCHI T, TANI J I, KAWAHARA M, MAKINO Y, ITO M. Bimodal and monomodal diamond particle effect on the thermal properties of diamond-particle-dispersed Al-matrix composite fabricated by SPS[J]. Microelectronics Reliability, 2014, 54(11): 2463-2470.
[33] �� ��. ̼���������ǿ�������ϲ��ϵĺ��պ���Ӧ��[J]. ���Ϲ���, 2002, 2(6): 3-7.
CUI Yan. Aerospace applications of silicon carbide particulate reinforced aluminum matrix composite[J]. Journal of Materials Engineering, 2002, 2(6): 3-7.
[34] HASSELMAN D P H, DONALDSON K Y, GEIGER A L. Effect of reinforcement particle size on the thermal conductivity of a particulate-silicon carbide-reinforced aluminum matrix composite[J]. Journal of the American Ceramic Society, 1992, 75(11): 3137-3140.
[35] MOLINA J M, NARCISO J, WEBER L, MORTENSEN A, LOUIS E. Thermal conductivity of Al-SiC composites with monomodal and bimodal particle size distribution[J]. Materials Science and Engineering A, 2008, 480(1/2): 483-488.
[36] MOLINA J M, SARAVANAN R A, ARPON R, GARCIA C, LOUIS E, NARCISO J. Pressure infiltration of liquid aluminium into packed SiC particulate with a bimodal size distribution[J]. Acta Matallurgica, 2002, 50(2): 247-257.
[37] QU Xuan-hui, ZHANG Lin, WU Min, REN Shu-bin. Review of metal matrix composites with high thermal conductivity for thermal management applications[J]. Progress in Natural Science: Materials International, 2011, 21(3): 189-197.
[38] ZHU Xiao-ming, YU Jia-kang, WANG Xin-yu. Microstructure and properties of Al/Si/SiC composites for electronic packaging[J]. Transactions of Nonferrous Metals Society of China, 2012, 22(7): 1686-1692.
[39] LUO Z P, SONG Y G, ZHANG S Q. A TEM study of the microstructure of SiCp/Al composite prepared by pressureless infiltration method[J]. Scripta Materialia, 2001, 45(10): 1183-1189.
[40] REN Shu-bin, HE Xin-bo, QU Xuan-hui, HUMAIL I S, LI Yan. Effect of Mg and Si in the aluminum on the thermo-mechanical properties of pressureless infiltrated SiCp/Al composites[J]. Composites Science and Technology, 2007, 67(10): 2103-2113.
[41] YANG X F, XI X M. SiC-Al-Si composites by rapid pressureless infiltration in air[J]. Journal of Materials Research, 1995, 10(10): 2415-2417.
[42] SHEN Y L, NEEDLEMAN A, SURESH S. Coefficients of thermal expansion of metal-matrix composites for electronic packaging[J]. Metallugical and Materials Transactions A, 1994, 25: 839-850.
[43] ����ˮ, ���ճ�, ����Ⱥ, Ī����, ��ѧ��, �� ��. ����������ӷ�װ�ø߹����Ͻ���о���չ[J]. �й���ɫ����ѧ��, 2012, 22 (12): 3446-3455.
LIU Wen-shui, WANG Ri-chu, PENG Chao-qun, MO Jing-yi, ZHU Xue-wei, PENG Jian. Research progress of spray deposited high Si-Al alloys for electronic packaging[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(12): 3446- 3455.
[44] �� ��, ������, л����, ������. ���ӷ�װ���ϵ��о���״����չ[J]. �����ȴ�������, 2011, 40(4): 84-86.
FANG Ming��WANG Ai-qin��XIE Jing-pei��WANG Wen-yan. Research status and progress of electronic packaging materials[J]. Materials & Heat Treatment, 2011, 40(4): 84-86.
[45] ������, ����Ⱥ, ���ճ�, ��С��, ��־��, �� ��. �߹����Ͻ���ӷ�װ�����о���չ[J]. �й���ɫ����ѧ��, 2012, 22(9): 2578-2587.
XIE Li-chuan, PENG Chao-qun, WANG Ri-chu, WANG Xiao-feng, CAI Zhi-yong, LIU Bing. Research progress of high aluminum-silicon alloys in electronic packaging[J]. The Chinese Journal of Nonferrous Metals, 2012, 22(9): 2578-2587.
[46] JACOBSON D M, OGILVY A J. Spray-deposited Al-Si (Osprey CE) alloys and their properties[J]. Materials Science & Engineering Technology, 2003, 34(4): 381-384.
[47] ������, ֣����, �� ��, ������, �� ��. Si-Al���ӷ�װ���Ϸ�ĩұ���Ʊ������о�[J]. ϡ�н���ѧ��, 2004, 28(1): 160-165.
YANG Pei-yong, ZHENG Zi-qiao, CAI Yang, LI Shi-chen, FENG Xi. PM progress of Si-Al electronic packaging materials[J]. Chinese Journal of Rare Materials, 2004, 28(1): 160-165.
[48] CHIEN C W, LEE S L, LIN J C, JAHN M T. Effects of Sip size and volume fraction on properties of Al/Sip composites[J]. Materials Letters, 2002, 52(4/5): 334-341.
[49] ETTER T, SCHULZ P, WEBER M, METZ J, WIMMLER M, LOFFLER J F, UGGOWIZER P J. Aluminium carbide formation in interpenetrating graphite/aluminium composites[J]. Materials Science and Engineering A, 2007, 448(1/2): 1-6.
[50] RAJAN T P D, PILLAI R M, PAI B C. Reinforcement coatings and interfaces in aluminium metal matrix composites[J]. Journal of Materials Science, 1998, 33: 3491-3503.
[51] PELLEG J, ASHKENAZI D, GANOR M. The influence of a third element on the interface reactions in metal-matrix composites (MMC): Al-graphite system[J]. Materials Science and Engineering A, 2000, 281(1/2): 239-247.
[52] BEFFORT O, VANCHER S, KHALID F A. On the thermal and chemical stability of diamond during processing of Al/diamond composites by liquid metal infiltration (squeeze casting)[J]. Diamond and Related Materials, 2004, 13(10): 1834-1843.
[53] FENG H, YU J K, TAN W. Microstructure and thermal properties of diamond/aluminum composites with TiC coating on diamond particles[J]. Materials Chemistry and Physics, 2010, 124(1): 851-855.
[54] MARTINEZ V, ORDONEZ S, CASTRO F, OLIVARES L, MARIN J. Wetting of silicon carbide by copper alloys[J]. Journal of Materials Science, 2003, 38(19): 4047-4054.
[55] SUNDBERG G, PAUL P, SUNG C, VASILOS T. Identification and characterization of diffusion barriers for Cu/SiC systems[J]. Journal of Materials Science, 2005, 40(13): 3383-3393.
[56] �� ��, �� ˳, ������, �� ��, �ܵ¸�. SiCp/Cu���ӷ�װ�����о���չ[J]. ���ϵ���, 2013, 27(10): 130-134.
LIU Meng, LI Shun, BAI Shu-xin, ZHAO Xun, XIONG De-gan. Progress in SiCp/Cu electronic packaging materials[J]. Materials Review, 2013, 27(10): 130-134.
[57] ZHANG L, QU X H, DUAN B H, HE X B, QIN L M, LU X. Preparation of SiCp/Cu composites by Ti-activated pressureless infiltration[J]. Transactions of Nonferrous Metals Society of China, 2008, 18(4): 872-878.
[58] MOUSTAFA S F, ABDEL-HAMID Z, ABD-ELHAY A M. Copper matrix SiC and Al2O3 particulate composites by powder metallurgy technique[J]. Materials Letters, 2002, 53(4/5): 244-249.
[59] SCHUBERT T, TRINDADE B, WEIBGARBER T, KIEBACK B. Interfacial design of Cu-based composites prepared by powder metallurgy for heat sink applications[J]. Materials Science and Engineering A, 2008, 475(1/2): 39-44.
[60] �� ��. ̼��ά(CF)������Լ�CF-Cu(Cr)���ϲ��ϵ��Ʊ�������[D]. �Ϸ�: �Ϸʹ�ҵ��ѧ, 2012: 13-14.
GAO Lei. Carbon fiber(CF) surface modification and preparation and properties of CF-Cu(Cr) matrix composite[D]. Hefei: Hefei University of Technology, 2012: 13-14.
[61] ������, ��, �� ��, �� ��. ̼��ά��ǿͭ�����ϲ��ϵ������о���չ��Ӧ��[J]. ���ϵ���: ����ƪ, 2010, 24(3): 76-79.
SU Qing-qing, LI Wei-wei, LIU Lei, SHEN Bin. Application and progress in development of the carbon fiber reinforced copper matrix composites[J]. Materials Review, 2010, 24(3): 76-79.
[62] LIU Qian, HE Xin-Bo, REN Shu-Bin, LIU Ting-ting, KANG Qi-Ping, QU Xuan-Hui. Effect of titanium carbide coating on the microstructure and thermal conductivity of short graphite fiber/ copper composites[J]. Journal of Materials Science, 2013, 48(17): 5810-5817.
[63] COUILLAOUD S, LU Y F, SILVAIN J F. Thermal conductivity improvement of copper�Ccarbon fiber composite by addition of an insulator: calcium hydroxide[J]. Journal of Materials Science, 2014, 49(16): 5537-5545.
[64] DAVIDSON H L, COLELLA N J, KERNS J A, MAKOWIECHI D. In International symposium on microelectronics: showcasing the stars of microelectronics and International symposium on ball grid array Los Angeles, CA (United States), 1995: 66-72.
[65] BAI Hua, MA Nan-gang, LANG Jing, ZHU Cong-xu, MA Yi. Thermal conductivity of Cu/diamond composites prepared by a new pretreatment of diamond powder[J]. Composites Part B (Engineering), 2013, 52: 182-186.
[66] WEBER L, TAVANGAR R. On the influence of active element content on the thermal conductivity and thermal expansion of Cu-X (X=Cr, B) diamond composites[J]. Scripta Materialia, 2007, 57(11): 988-991.
[67]  , ZIELINSKI W, MICHALSKI A. Interfacial characterization of Cu/diamond composites prepared by powder metallurgy for heat sink applications[J]. Scripta Materialia, 2008, 58(4): 263-266.
, ZIELINSKI W, MICHALSKI A. Interfacial characterization of Cu/diamond composites prepared by powder metallurgy for heat sink applications[J]. Scripta Materialia, 2008, 58(4): 263-266.
[68] CHU Ke, JIA Cheng-chang, GUO Hong, LI Wen-sheng. On the thermal conductivity of Cu-Zr/diamond composites[J]. Materials & Design, 2013, 45: 36-42.
[69] REN Shu-bin, SHEN Xiao-yu, GUO Cai-yu, LIU Nan. Effect of coating on the microstructure and thermal conductivities of diamond-Cu composites prepared by powder metallurgy[J]. Composites Science and Technology, 2011, 71(13): 1550-1555.
[70] ZHANG Y, ZHANG H L, WU J H, WANG X T. Enhanced thermal conductivity in copper matrix composites reinforced with titanium-coated diamond particles[J]. Scripta Materialia, 2011, 65(12): 1097-1100.
[71] ��ϰ��, �� ��, ������, ������, ��Ҷ��, ������. ���ʯ/ͭ���ϲ��Ͻ�����״̬�ĸ��Ʒ���[J]. ϡ�н���, 2013, 37(2): 335-340.
ZHANG Xi-min, GUO Hong, YIN Fa-zhang, HAN Yuan-yuan, FAN Ye-ming, WANG Peng-peng. Improving method of interface bonding state in Diamond/Cu composite Materials[J]. Chinese Journal of Rare Materials, 2013, 37(2): 335-340.
[72] TENG C, MA C M, LU C,YANG S, LEE S, HSIAO M, YEN M, CHIOU K, LEE T. Thermal conductivity and structure of non-covalent functionalized graphene/epoxy composites[J]. Carbon, 2011, 49(15): 5107-5116.
[73] KIM J, YIM B. The effects of functionalized graphene nanosheets on the thermal and mechanical properties of epoxy composites for anisotropic conductive adhesives (ACAs)[J]. Microelectronics Reliability, 2012, 52(3): 595-602.
[74] SHAHIL K M, BALANDIN A A. Graphene-multilayer graphene nanocomposites as highly efficient thermal interface materials[J]. Nano Letter, 2012, 12(2): 861-867.
[75] ������, ���, Ф ��, ������. ʯīϩ/�����ϲ��ϵ��о���״��Ӧ��չ��[J]. �²��ϲ�ҵ, 2014(11): 20-23.
YANG Wen-shu, WU Gao-hui, XIAO Rui, DONG Rong-hua. Graphene/aluminum composite material research status and application prospect[J]. Advanced Materials Industry, 2014(11): 20-23.
[76] GOYAL V, BALANDIN A A. Thermal properties of the hybrid graphene-metal nano-micro-composites: Applications in thermal interface materials[J]. Applied Physics Letters, 2012, 100(7): 073113.
[77] PEI Z L, LI K, GONG J, SHI N L, ELANGOVAN E, SUN C. Micro-structural and tensile strength analyses on the magnesium matrix composites reinforced with coated carbon fiber[J]. Journal of Materials Science, 2009, 44(15): 4124-4131.
[78] �� ��, ����ƽ, �� ��. ���ʯ����/���������ϲ��ϵ��о���չ[J]. �������켰��ɫ�Ͻ�, 2012, 32(7): 654-658.
LI Xin, LONG Jian-ping, XU Ming. Progress in diamond/metal matrix composites[J]. Special Casting & Nonferrous Alloys, 2012, 32(7): 654-658.
[79] TJONG S C. Recent progress in the development and properties of novel metal matrix nanocomposites reinforced with carbon nanotubes and graphene nanosheets[J]. Materials Science and Engineering R, 2013, 74(10): 281-350.
[80] ������, Ф־�, ����ƽ. ��ĩ���ٹ̽Ἴ�����о���չ[J]. ��ĩұ����Ͽ�ѧ�빤��, 2007, 12(3): 129-133.
LUO Shu-hua, XIAO Zhi-yu, WEN Li-ping. Research progression in powder rapid consolidation technology[J]. Materials Science and Engineering of Powder Metallurgy, 2007, 12(3): 129-133.
[81] SHALU T, ABHILASH E, JOSEPH M A. Development and characterization of liquid carbon fibre reinforced aluminium matrix composite[J]. Journal of Materials Processing Technology, 2009, 209(10): 4809-4813.
[82] ��ا��, ����Ҽ, �� ��. ��ѹ����Ͻ���ϵ��о���չ[J]. �������켰��ɫ�Ͻ�, 2005, 25(1): 28-32.
QI Pi-xiang, WU Yue-yi, QI Lin. Progress in alloy materials in squeezing casting[J]. Special Casting & Nonferrous Alloys, 2005, 25(1): 28-32.
[83] ZHOU Sheng-ming, ZHANG Xiao-bin, DING Zhi-peng, MIN Chun-yan, XU Guo-liang, ZHU Wen-ming. Fabrication and tribological properties of carbon nanotubes reinforced Al composites prepared by pressureless infiltration technique[J]. Composites Part A: Applied Science and Manufacturing, 2007, 38(2): 301-306.
[84] GUDEN M, AKIL O, TASDEMIRCI A, CIFTCIOGLU M, HALL. I W. Effect of strain rate on the compressive mechanical behavior of a continuous alumina fiber reinforced ZE41A magnesium alloy based composite[J]. Materials Science and Engineering A, 2006, 425(1/2): 145-155.
[85] �� ��, ��ѧ��, �Ź���. ���ѹ���������Ʊ�SiCp/Al���о�[J]. ���Ͽ�ѧ�빤��, 1995, 3(4): 6-10.
YU Jian, YU Xue-bin, ZHANG Guo-ding. Fabrication of Al-SiCp composites by vaccum-high pressure infiltration method[J]. Materials Science & Technology, 1995, 3(4): 6-10.
[86] KORNER C, SCHAFF W, OTTMULLER M, SINGER R F. Carbon long fiber reinforced magnesium alloys[J]. Advanced Engineering Materials, 2000, 2(6): 327-337.
(�༭ ����)
������Ŀ�����Ҿ�Ʒ������Ŀ(JPPT-125-GJGG-014-01b)������ʡ֪ʶ��Ȩս��ʵʩ������Ŀ(2013C�ž�007)
�ո����ڣ�2015-01-29�������ڣ�2015-09-28
ͨ�����ߣ�����Ⱥ�����ڣ���ʿ���绰��0731-88877197��E-mail: pcq2005@163.com
ժ Ҫ�����������ϲ���ƾ��������������Լ��ϳ�����Ʊ����գ���Ϊ���ӷ�װ�����о�����Ҫ����֮һ���������͵ĵ��ӷ�װ�ý��������ϲ��ϵ��о���״���������������ϲ��ϵ�������������ƣ��о�������ͭ�����ӷ�װ���ϲ������������ܵ�Ӱ�����غĽ���ʩ�����ܳ������Ʊ����������Խ��������ӷ�װ���ϵķ�չ���ƽ���չ����
[1] LU D, WONG C P. �Ƚ���װ����[M]. ����: ��е��ҵ������, 2012: 35-38.
LU D, WONG C P. Materials for advanced packaging[M]. Beijing: China Machine Press, 2012: 35-38.
[2] HARPER C A. ���ӷ�װ�����빤��[M]. ����: ��ѧ��ҵ������, 2006: 16-17.
[3] �� ��, ������, �� ��, ������. ���ӷ�װ�ý��������ϲ��ϵ��о���״[J]. ���ϵ���, 2013, 27(22): 181-183.
[6] �� ��, �Ź���, ��־ǿ. ���������ϲ��ϵ���״�뷢չ����[J]. �й����Ͻ�չ, 2010, 29(4): 1-7.
[12] κ�ܹ�. �������Si-Al���ӷ�װ���ϵ��Ʊ�����֯�����о�[D]. ����: ��ɫ�����о���Ժ, 2006: 85-87.
[14] ������, ������. ���������ӷ�װ���ϲ��ϵ��о���չ[J]. �����ȴ���, 2003, 28(6): 1-5.
[18] CLYNE T W, WITHERS P J. ���������ϲ��ϵ���[M]. ����: ұ��ҵ������, 1996: 114-117.
[33] �� ��. ̼���������ǿ�������ϲ��ϵĺ��պ���Ӧ��[J]. ���Ϲ���, 2002, 2(6): 3-7.
[44] �� ��, ������, л����, ������. ���ӷ�װ���ϵ��о���״����չ[J]. �����ȴ�������, 2011, 40(4): 84-86.
[56] �� ��, �� ˳, ������, �� ��, �ܵ¸�. SiCp/Cu���ӷ�װ�����о���չ[J]. ���ϵ���, 2013, 27(10): 130-134.
[60] �� ��. ̼��ά(CF)������Լ�CF-Cu(Cr)���ϲ��ϵ��Ʊ�������[D]. �Ϸ�: �Ϸʹ�ҵ��ѧ, 2012: 13-14.
[75] ������, ���, Ф ��, ������. ʯīϩ/�����ϲ��ϵ��о���״��Ӧ��չ��[J]. �²��ϲ�ҵ, 2014(11): 20-23.
[78] �� ��, ����ƽ, �� ��. ���ʯ����/���������ϲ��ϵ��о���չ[J]. �������켰��ɫ�Ͻ�, 2012, 32(7): 654-658.
[80] ������, Ф־�, ����ƽ. ��ĩ���ٹ̽Ἴ�����о���չ[J]. ��ĩұ����Ͽ�ѧ�빤��, 2007, 12(3): 129-133.
[82] ��ا��, ����Ҽ, �� ��. ��ѹ����Ͻ���ϵ��о���չ[J]. �������켰��ɫ�Ͻ�, 2005, 25(1): 28-32.
[85] �� ��, ��ѧ��, �Ź���. ���ѹ���������Ʊ�SiCp/Al���о�[J]. ���Ͽ�ѧ�빤��, 1995, 3(4): 6-10.


