���±�ţ�1004-0609(2007)08-1336-06
�����������˻�������AlN��Ĥ��ѧ���ܵ�Ӱ��
�ܼ̳У�������
(���ϴ�ѧ ������ѧ�뼼��ѧԺ����ɳ410083)
ժ Ҫ��
������Ƶ��Ӧ�ſؽ�����Si(100)�����ϳ���AlN���ʱ�Ĥ�����ڲ�ͬ�¶��¶Ա�Ĥ���п����˻�ͨ������ǿ�Ȳ����ǡ����ݵ�ѹ����C?V��X���������ǡ����������ǡ�ԭ������������Բƫ���ǵ��о���Ĥ�Ļ�����ѹ����糣��������ṹ����ѧ�ɷ֡�������ò����Ĥ�������ʡ�������������书�ʺͽ�����ѹ�Ա�Ĥ�Ļ�����ѹ�кܴ��Ӱ�죬���书��Ϊ250 W����ѹΪ0.3 Paʱ��Ĥ�Ŀ������ܽϺã���Ĥ�ijɷ��潦����ѹ�����仯��N��AlĦ������ߴﵽ0.845�����˻��¶ȵ����ӣ���Ĥ����ṹ�����Ǿ�����п����п���ת�䣻��Ĥ�����������˻��¶ȵ����߶����ӡ�
�ؼ��ʣ�
AlN��Ĥ���ſؽ�����������ѹ�������˻���
��ͼ����ţ�TN 304.055��TN 305.8���� ���ױ�ʶ�룺A
Effect of deposition parameters and RTA conditions on
electrical properties of AlN thin films
ZHOU Ji-cheng, HU Li-min
(School of Physics Science and Technology, Central South University, Changsha 410083, China)
Abstract: AlN dielectric thin films were deposited on N type Si(100) substrate by reactive radio frequency magnetron sputtering under different sputtering-power and total pressure. And rapid thermal annealing (RTA) was preformed on these films respectively for 5 min under different temperatures. The breakdown voltage, permittivity, crystal structure, composition, surface and refractive index of the thin films were studied by I-V, C-V, XRD, EDS, AFM and elliptical polarization instrument. The results show that the breakdown voltage of the thin films strongly depends on the sputtering-power and total pressure, the greatest breakdown voltage is found at 250 W and 0.3 Pa. EDS analysis shows that the mole ratio of N to Al of AlN thin films changes with total pressure, and reaches its peak value of 0.845 at 0.3 Pa. The crystal structure of the as-deposited thin-films is amorphous, then it transforms from blende structure to wurtzite structure as the rapid thermal annealing(RTA) temperature changes from 600 to 1 000 ��. The refractive index also increases with the RTA temperature.
Key words: AlN thin films; magnetron sputtering; breakdown voltage; rapid thermal annealing(RTA)
��ͳ��SOI������ʹ��SiO2��Ϊ��Ե���(BOX)[1]����SiO2��Ե��ĵ���ϵ���ܵ�(���ĵ���ϵ��ֻ��Si��1%)�����������ߴ�IJ�����С�������ܶȲ��������������Լ���ЧӦԽ��Խ������ʹ���������ȶ��ԺͿɿ����½�[2]��AlN��Ϊ���嵪�������϶��Ե���ϣ��ߵ���ϵ���ߡ������ʴ�����ǿ�ߡ���ѧ�����ȶ����ܺã��ر���AlN���ȵ��ʼ�����SiO2��200�[3]��ʹ����ϣ�����SiO2��ΪSOI�ṹ�еľ�Ե�㡣
���Բ��ö��ַ������Ʊ�SOI�ṹ�е�AlN��Ե��㣬����Ƶ��Ӧ�ſؽ��䡢���������估�����������ϳɵ�����������������ֻ�ѧ������������������������о����ڴ˷������˴������о�����[4?7]����Ribeiro��[5]ʹ����Ƶ�ſؽ�����N2��H2�Ļ�����գ��ĵ��¶�Ϊ200 ��������³�����AlN��Ĥ����Ĥ��Al��N�ӽ���ѧ�����ȣ��˷��������˱�Ĥ��������Ⱦ�����������������ʵ���Σ���ԡ��Ŵ����[6]������������ǿ�������ڵ���Si�ĵ��ϳ�����Ե�������õ�AlN�Ǿ���Ĥ�����ֳ����õľ�Ե���ܣ�����������108 �������������ܰ��뼼���Ʊ���SOAN (silicon-on-aluminum-nitride)�ṹ���ٽ���AlN��SOI������Ӧ�á�
����ǿ���Ǿ�Ե��Ĥ����Ҫ���ܣ���ĿǰΪֹ����δ����AlN����ǿ�ȵ�ר�ⱨ��������������ǰ�˹����Ļ����������о��������ʺ��ܽ�����ѹ���˻��¶ȶ�AlN��Ĥ����ǿ�ȵȵ�ѧ���ܵ�Ӱ�졣
1 ʵ��
1.1 ��Ʒ�Ʊ�
������Ƶ��Ӧ�ſؽ����ڵ�����Ϊ33~35 ��?cm��N��Si(100)������������AlN��Ĥ��Si���ײ��ñ���RCA��ϴ������ϴ���Ʊ����������̶���1000���ij���������ɡ�����ǻ�ڱ������Ϊ8��10?4 Pa������в�Ϊ99.995%��Al�У���������Ϊ99.99%��Ar��99.99%��N2��ʵ�������ʼ�ձ���Ar��N2��ѹ��Ϊ1?2���в�������Ϊ6 cm����������л��ײ����ȴ�����Ȼ״̬��һ����40~50 ��֮��仯����Ӧ���������Ĥ֮ǰ������200 W�Ĺ��ʶв�Ԥ����30 min�������Al�б��������������ʣ�ͬʱ�Ի����к濾��ȥ���ĵ������������壮��ʵ��������о��˱�Ĥ�ij����������ѧ���ܵĹ�ϵ�����ϵ��Ż�ʵ������Ʊ���AlN��Ĥ����Ҫʵ��������ڱ�1��
��1 AlN��Ĥ�Ľ��乤��
Table 1 Sputtering parameters for fabrication of AlN thin films

�Ʊ��ı�Ĥ��600~1 200 ���ڵ��¶Ƚ��п����˻��˻��ڵ����ı�����Χ�н��У��˻�����������ʷֱ�Ϊ20��10 ��/s, �˻�ʱ���Ϊ5 min��
1.2 ���Է���
��Ĥ�ĺ����̨���Dzⶨ�������й�����ʵ�������Ƶ�105C����ѹ�����Dz�����Ĥ�Ļ�����ѹ����ʵ���豸��Ҫ�����������ʱ�Ĥ����ѹ������©���������ͨ���ڱ�Ĥ���±�������ĵ缫�ϼ��ϵ�ѹ����ѹ�����ɵ�������Ĥ�е�©��������Ԥ��ֵʱ������������Ĥ�Ľ�糣����HP?4284���Եĸ�ƵC?V�����еõ���ʹ�ù���X����(y2000)�о��˱�Ĥ�ľ���ṹ����Ĥ�ijɷֵ�EDS������Quanta200��ɣ�ʹ��ELLI?B����ƫ�Dz��Ա�Ĥ�������ʣ����Եļ��Ⲩ��Ϊ650 nm��
2 ���������
2.1 ���������Ա�Ĥ��ѧ���ܵ�Ӱ��
������ʵ����̵Ķ���о����Լ��ο�����[8?11]��һЩʵ�������ڶ�ʵ���������һ�����Ż��������Ʊ�1~4����Ʒ��ͼ1��ʾΪ���������뿹��ǿ���湦�ʵı仯��VbreakΪ������ѹ��vdΪ�������ʡ���ͼ�п��Կ���������������3~8 nm/min֮�䣬���Ź��ʵĸı䣬��250 Wʱ��Ĥ�Ŀ���ǿ��ƽ��ֵ�ﵽ��ֵ�����Ե����ֵ�ɴ�9.6 MV/cm�����ʶԿ���ǿ�ȵ�Ӱ��Ϊ�������ʽϵ�ʱ����������������������������ӵķ�Ӧ��ܲ���������£�Al���������ܲ�ǿ�ģεķ�Ӧ���ܹ���ֽ���[12]�����ʽ�һ�����ӣ�������������N�Ϻõط�Ӧ�����ٽ�һ�����ӹ���ʱ�����ڽ����������ӣ������ٶȹ��죬�����Al������N��Ӧ���Ӷ�ʹ��Ĥ�и�Al�����˱�Ĥ�Ŀ��翹�����ܡ�

ͼ1 1~4����Ʒ�������ʡ�����ǿ���빦�ʵĹ�ϵ
Fig.1 Relationships between sputtering power and deposition rate and breakdown voltage of sample 1?4
Ϊ�˽�һ���˽⽦����ѹ�Ա�Ĥ���ܵ�Ӱ�죬��250 W�Ĺ����£��ı乤����ѹ��ʹ������ѹ��0.1 Pa��0.35 Pa��Χ�ڱ仯���Ʊ���5~10����Ʒ�����۲챡Ĥ���ܵı仯�����ͼ2��ʾΪ����ǿ������ѹ�ı仯����ͼ�з�����ѹΪ0.3 Pa��9����Ʒ��Ĥ�Ŀ���������ã����Ŀ���ǿ�ȴﵽ10.4 MV/cm��0.3 Pa�������ֵ���ֵ�ԭ���ǽ��������뽦����������֮���һ����������ͼ�п��Կ�������ѹ�ϵ�ʱ��Ĥ�ij������ʽϿ죬������ѹ�ϵ�ʱ���������Al����������δ���ü���ȫ��Ӧ�ͱ��µ����Ӹ����ˣ���Ĥ��Alԭ�ӵ�һЩ��δ����ȫ��ϣ���Ҫ������ѹ�Խ��ͽ������ʣ��������������ѹʱ���ֻ����ӷ�Ӧ���ڵ�������ײ���ʣ����Ͳμӷ�Ӧ�����ӵ�����������Ҳ����ʹAl��N��ַ�Ӧ���Ӷ������м����ֺ��ʵ���ѹʹ��Ĥ�Ŀ���ǿ�ȴﵽһ�����ֵ��

ͼ2 5~10����Ʒ����ǿ�ȡ�������������ѹ�Ĺ�ϵ
Fig.2 Relationships between total pressure and breakdown voltage and deposition rate of samples 5?10
������ǿ���⣬��Ե�����Խ�糣����r��ƽ������CFB��ƽ����ѹVFB�Լ���ֵ��ѹVT������Ҳ�кܴ��Ӱ�졣�ر��ǽ�糣����SOI�ṹ��ѧ���ܵ�Ӱ�죬С�Ľ�糣���ܼ��������еı�Ե�糡ЧӦ ��[13]�����Ƴɵ�Si-AlN-Al�ṹ��ͨ����?V�����о�����Щ���������о�Ե��Ϊ9����Ʒ�Ĺ��ա� ͼ3��ʾΪ�õ��ĸ�ƵC?V���ߡ�������Ϊ���͵�N��Si�ϵ�C?V���ߣ����в���Ƶ��Ϊ1 MHz��ͨ��������������ȡƽ��ֵ���м��㣬���������ڱ�2��

ͼ3 MIS�ṹ��C?V����
Fig.3 C?V curve of MIS structure
��2 5����Ʒ��Ե��Ľ�����
Table 2 Dielectric properties of sample 5

2.2 ��Ĥ�Ľṹ��ɷַ���
2.2.1 ��Ĥ�ṹ
ͼ4��ʾΪ9����Ʒ��XRD�ס���������a��b��c��d�ֱ�Ϊδ�˻�600��800��1 000 ���˻���X���������ס��ɼ��������ı�Ĥδ�˻�֮ǰΪ�Ǿ�̬����Ϊ�ڳ����Ĺ����о�δ�Գĵ��ȣ��������ĵ��ϵ����ӵ������ϵͣ�û���㹻����������λ�õ�Ǩ���γɾ���ṹ��600 ���˻��������г�����AlN��п��(c-AlN)�ṹ�����������壬˵����Ĥ�Ѿ���ʼ�����������˻��¶ȵ����ӱ�Ĥ�ľ���ṹ������ת�䣬800 ���˻��������зֱ������c-AlN����п��(h-AlN)������壻1 000 ���˻��Ĥ�ľ���ṹ�ᾧ���кܴ����ߣ����Կ���AlN��п��ṹ���������壬��ʱ��Ĥ���Ѳ�����c-AlN��

ͼ4 9����Ʒδ�˻���600��800��1 000 ���˻��X����������
Fig.4 XRD patterns of sample 9 at as-deposited (a)��and��after RTA at 600 (b), 800 (c), 1 000 �� (d), respectively
c-AlN������ʯ�ṹ�ľ��壬Alռ���������л������ڵ�4���Խ��ߵ��е㣬Nռ��������Ķ��Ǻ����ģ��γ�c-AlN��������Ϊ�ĵ�Si����ͬ��Ϊ���ʯ�ṹ����Si���������������ƽṹ��AlN��Ĥ���˻�600 ���Ĥ�д��ڵ���п������������AlN����п��ṹ��һ������̬�ṹ�������ܱ�h-AlN��[14]�����˻���¶����ӵ�800 ��ʱ����Ĥ�е��������㹻����������λ�õĵ�������Ĥ�еľ���ṹ��ʼ������������п��ṹת�䣬���˻��¶ȴﵽ1 000 ���ʱ����Ĥ�ľ�����ȫ��Ϊ��п��ṹ��
2.2.2 ��Ĥ�ijɷ�
��5~10����Ʒ�����˵�������(EDS)���ԣ����ƽ���еijĵ�Ԫ��Si����һ����Al��Σ��õ��ĸ���Ʒ������N��AlĦ���ȼ���3��
��3 5~10����Ʒ��EDS���Խ��
Table 3 EDS testing results of sample 5?10
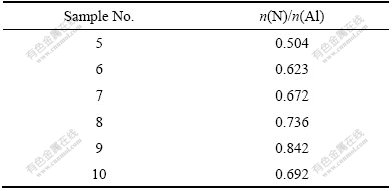
��3�Ľ����һ��˵���˳�����ѹ�Ա�Ĥ��Ե���ܵ�Ӱ�죬�����ܳ�����ѹ��Ӱ�죬�ϸ�ϵ�(�����0.3 Pa)�ij�����ѹ����ʹ��Ĥ��N��Al�ı����½���ʹ��Ĥ�и���l���Ӷ�ʹ��Ĥ�Ŀ���ǿ���½�������ǰ����ѹ�ı仯���������ѹ�仯�Ľ������Ǻϡ�����״̬��AlN��Ĥn(N)/n(Al)Ϊ1?1������Oliveira��[15]���о����֣����÷�Ӧ�ſؽ������AlN��ĤʱӦ�ʵ���߳ĵ��¶������ӱ�Ĥ�����Ǩ���ʣ�ʹ��Ӧ����ȫ��ͼ5��ʾΪ9����Ʒ��EDS�ס����Կ����ĵ��ɫɢ�ף�˵��̽��������Ѵ�����Ĥ����ĵף���˵õ���n(N)/n(Al)Ϊ��Ĥ���ƽ�������

ͼ5 9����Ʒ��EDS��
Fig.5 EDS pattern of sample 9
2.3 �˻�Ա�Ĥ���ܵ�Ӱ��
����Ʒ9��600~1 200 �淶Χ�ڽ��˿����˻��˻�ʱ���Ϊ5 min���Ƚ����˻�ǰ��Ĥ�Ļ�����ѹ����Ĥ���������Լ���Ĥ������ò�ı仯��
ͼ6��ʾΪ�˻��¶ȶԿ���ǿ�ȵ�Ӱ�졣��ͼ��֪���˻��Ĥ�Ŀ���ǿ���кܴ�仯�����˻��¶ȵ���1 000 ��ʱ��Ĥ�Ŀ���ǿ�ȴﵽ���ֵ13.75 MV/cm�����ֵ�ӽ�������б�����14 MV/cm��˵���˻�����˱�Ĥ��AlһЩ��δ���ͼ������¶ȼ�������ʱ����Ĥ�Ŀ���ǿ�ȷ������ͣ�ԭ���ǵ��˻��¶ȴﵽһ���̶Ⱥ�Ĥ�е�δ���ͼ������ȫ���֮��һ�������˻��¶�ʹ��Ĥ�ᾧ���������ֻ������������Ӻܶ����ھ�������Ӵ�����©������ʹ��Ĥ�Ŀ��������½�������Ezhilvan��[16]���ھ�����о������

ͼ6 9����Ʒ����ǿ�����˻��¶ȵı仯
Fig.6 Variation of breakdown voltage with annealing temperature of sample 9
ͬʱ��ʵ����Ҳ������������Ĥ��Ʒ�Ŀ���ǿ���˻�ǰ��ı仯���������4���о������ڵ����յı������˻𣬳���9����Ʒ���⣬������Ʒ��ǿ�ȶ��õ������ӣ���˵���ڽ�������Ĺ�����Al�ĵ����Dz���ȫ�ġ�
ͬʱʹ����Բƫ���Ƕ��˻���9����Ʒ�����˲��ԣ��õ�AlN��Ĥ�����������˻��¶ȵı仯�������ͼ7��ʾ��һ����˵�������ڱ�Ĥ״̬�µ�������������ϵ������������ԵIJ������Ҫ�������Ʊ��������Ʊ����ա���ͼ7�ɼ��������˻��¶ȵ����ӣ���Ĥ�����������˻�ǰ��2.215���ӵ�2.365��һ������£���Ĥ�������ʻ���Ϊ�˻��Ĥȱ�ݵļ��١���Ĥ�ܶȵ����Ӷ�����[17]��������X��������õ��Ľ�����˻��Ĥ��c-AlN��ת��Ϊh-AlN�࣬�������п��Եõ����ߵ��ܶȷֱ�Ϊ3.34[18]��3.26[19]��ǰ�ߵ��ܶȱȺ��ߴӶ�˵���������ܶȵĸı�������AlN��Ĥ�����ʵĸı䡣Silva��ʹ�õ�һ��ԭ���о��õ����ڿɼ��ⷶΧc-AlN����������1.5~1.7֮��[20]����h-AlN��Ĥ�ı�Ĥ��������2.1~2.5֮��[21]�����Ա���������Ϊ��Ĥ�����ʵĸı���Ҫ��AlN�������������
��4 ��ͬ��Ʒ�˻�ǰ���Vbreak
Table 4 Breakdown voltage of different samples(MV/cm)
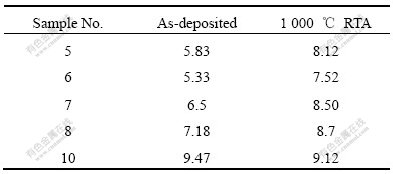

ͼ7 9����Ʒ��Ĥ���������˻��¶ȵı仯
Fig.7 Variation of refractive index with RTA temperature of sample 9
����AFM�Ա�Ĥ�ı�������˱������о����˻�ǰ��Ĥ������ò�ı仯��ͼ8��ʾΪ9����Ʒ��Ĥ�ı���ֲڶ�(Rq)���˻��¶ȵı仯�����Կ������˻��Ĥ�ı����о���������ֲڶ���1~2 nm ��Χ�ڱ仯�������˻������ӶԿ���ǿ�ȵ�Ӱ��Ľ����Ǻϡ�ͼ9��ʾΪ9����Ʒ��1 000 ���˻��ԭ����������Ƭ�����Կ�����Ĥ����ṹ���ܡ�ƽ����������С�Ͼ��ȣ�û�����Ե�ȱ�ݺͿն���

ͼ8 9����Ʒ����ֲڶ����˻��¶ȵĹ�ϵ
Fig.8 Relationship between root-mean-roughness and RTA temperature of sample 9

ͼ9 9����Ʒ��1 000 ���˻���AFM��Ƭ
Fig.9 AFM image of sample 9 after annealing at 1 000 ��
3 ����
1) �������ӵ������ͳ����������������ܱ仯����Ҫ���أ����������ͨ���ı�����Ĺ��ʺ���ѹ�õ��ʺϵĽ������������ͳ������ʣ���250 W��0.3 Pa�������µõ��ϺõĿ���������ܣ�������ѹΪ13~14 MV/cm��
2) ��Ĥ��n(N)/n(Al)���ų�����ѹ��������һ����С����Ȼ���ֱ�С�Ĺ��̣�n(N)/n(Al)��ֵ�ɴﵽ0.845������̬��Ĥ�ʷǾ�̬�����˻��¶ȵ����߱�Ĥ������̬��п��ṹת��Ϊ�ȶ�����п��ṹ��ͬʱ�����˻�����Ĥ�����ʹ��Ĥ�����������˻��¶ȵ����Ӷ�����
3) ��Ĥ�ı���ֲڶ���1~2 nm���ң���Ĥ����ƽ����
[1] Chuang C T, Lu P F, Anderson C J. SOI for digital CMOS VLSI: Design considerations and advances[C]//Proceedings of the Institute of Electrical and Electronics Engineers, 1998, 86(4): 689?720.
[2] Critoloveanu S, Li S S. Electrical characterization of SOI materials and devices[R]. Norwell, MA: Kluwer, 1995.
[3] �γ���.��AlN��Ta-C��Ĥ�Ʊ�������SOI�����е�Ӧ��[D]. �Ϻ�: �Ϻ�ϵͳ����Ϣ�����о���, 2003.
SONG Chao-rui. Fabrication of AlN and ta-C thin films and the application in SOI technology[D]. Shanghai: Shanghai Institute of Microsystem and Information Technology, 2003.
[4] Gould R D, Awan S A. Dielectric properties of AlNx thin films prepared by RF magnetron sputtering of Al using a N2/Ar sputtering gas mixture[J]. Thin Solid Films, 2004, 469?470: 184?189.
[5] Ribeiro C T M, Zanatta A R, Alvarez F. X-ray��photoelectron spectroscopy of amorphous AlN alloys prepared by reactive rf sputtering[J]. Journal of Non-Crystalline Solids, 2002, 299?302: 323?327.
[6] �Ŵ���, �� ��, ������, �ֳ�³. ���͵���������Ϲ�ṹ��Ӧ������[J]. ͬ�ô�ѧѧ��, 2003, 31(3): 361?364.
MEN Chuan-ling, XU Zheng, AN Zheng-hua, LIN Cheng-lu. Re sidual strain of silicon-on-AlN novel structure[J]. Journal of TongJi University, 2003, 31(3): 361?364.
[7] ��С��, �亣˳, �Ÿ�ǿ, ��. ��Ӧ�����Ʊ�AlN��Ĥ�г������ʵ��о�[J]. ϡ�н��������빤��, 2002, 31(3): 209?212.
XU Xiao-hong, WU Hai-shun, ZHANG Fu-qiang, et al. Study on deposition rate of AlN thin films using reactive magnetron sputtering[J]. Rare Metal Materials and Engineering, 2002, 31(3): 209?212 .
[8] Drusedau T P, Koppenhagen K. Substrate heating by sputter-deposition of AlN: the effects of dc and rf discharges in nitrogen atmosphere[J]. Surface and Coatings Technology, 2002, 153: 155?159.
[9] Randriamora F, Bruyere J C, Deneuville A. Synthesis of AlN by reactive sputtering[J]. Mater Sci Eng B, 1997, 50: 272?276.
[10] Pantojas V M, Otano-Rivera W, Caraballo Jose N. Statistical analysis of the effect of deposition parameters on the preferred orientation of sputtered AlN thin films[J]. Thin Solid Films, 2005, 492: 118?123.
[11] CHENG Hao, SUN Yong, HING Peter. The influence of deposition conditions on structure and morphology of aluminum nitride films deposited by radio frequency reactive sputtering[J]. Surface and Coating Technology, 2003, 166: 231?236.
[12] ��С��, �亣˳. ѹ�籡Ĥ���Ʊ����ṹ��Ӧ��[M]. ����: ��ѧ������, 2000: 54?56.
XU Xiao-hong, WU Hai-shun. The fabrication, structure and application of piezoelectric thin films[M]. Beijing: Science Press, 2000: 54?56.
[13] Bresson N, Cristoloveanu S, Mazure��C, Letertre��F, Iwai��H. Integration of buried insulators with high thermal conductivity in SOI MOSFETs: Thermal properties and short channel effects[J]. Solid-State Electronics, 2005, 49: 1522?1528.
[14] Yeh C Y, Lu Z W. Zinc-blende-wurtzite polyty-pism in semiconductors[J]. Phys Rev, 1992, 46: 10086?10097.
[15] Oliveira I C, Grigorov K G, Maciel, H S, Massi, M, Otani C. High textured AlN thin films grown by RF magnetron sputtering; composition, structure, morphology and hardness[J]. Vacuum, 2004, 75: 331?338.
[16] Ezhilvalavan S, Tseng T Y. Conduction mechanisms in amorphous and crystalline Ta2O5 thin ?lms[J]. J Appl Phys, 1998, 83: 4797?4801.
[17] �µ���, �⸣ȫ, ������, �� ��, �� ��. ������ѹ�Ե���������ZrO2��Ĥ�����ʺ;ۼ��ܶȵ�Ӱ��[J]. ����ѧ��, 2006, 35(2): 224?226.
HAO Dian-zhong, WU Fu-quan, MA Li-li, YAN Bin, ZHANG Xu. Influence of deposited pressure on refractive index and packing density of ZrO2 coatings by electron beam evaporation[J]. Acta Photonica Sinica, 2006, 35(2): 224?226.
[18] Wright A F, Nelson J S. Consistent structuralproperties of AlN, GaN, and InN[J]. Physical Review, 1995, 51: 7866?7869.
[19] Jeffrey G A, Parry G S. Study of the Wurtzite-type binary compounds��: Structures of aluminum nitride and beryllium oxide[J]. Journal of Chemical Physics, 1956, 25: 1024?1031.
[20] Silva Pinto E, de Paiva R, de Carvalho L C, Alves H W L, Alves J L A. Theoretical optical parameters for ��nitride semiconductors[J]. Microelectronics Journal, 2003, 34: 721?724.
[21] Jian L F, Shen W Z. Temperature dependence of the optical properties in hexagonal AlN[J]. Journal of Applied Physics, 2003, 94(9): 5704?5709.
������Ŀ��������Ȼ��ѧ����������Ŀ(60171043��60371046)
�ո����ڣ�2007-01-14�������ڣ�2007-04-13
ͨѶ���ߣ��ܼ̳У����ڣ��绰��0731-8836381��E-mail: jicheng@mail.csu.edu.cn
ժ Ҫ��������Ƶ��Ӧ�ſؽ�����Si(100)�����ϳ���AlN���ʱ�Ĥ�����ڲ�ͬ�¶��¶Ա�Ĥ���п����˻�ͨ������ǿ�Ȳ����ǡ����ݵ�ѹ����C?V��X���������ǡ����������ǡ�ԭ������������Բƫ���ǵ��о���Ĥ�Ļ�����ѹ����糣��������ṹ����ѧ�ɷ֡�������ò����Ĥ�������ʡ�������������书�ʺͽ�����ѹ�Ա�Ĥ�Ļ�����ѹ�кܴ��Ӱ�죬���书��Ϊ250 W����ѹΪ0.3 Paʱ��Ĥ�Ŀ������ܽϺã���Ĥ�ijɷ��潦����ѹ�����仯��N��AlĦ������ߴﵽ0.845�����˻��¶ȵ����ӣ���Ĥ����ṹ�����Ǿ�����п����п���ת�䣻��Ĥ�����������˻��¶ȵ����߶����ӡ�


