���±�ţ�1004-0609(2010)09-1795-07
����Ũ�ȶԳ�ѹ��ѧ�������ZrCͿ���Ӱ��
�����, ֣����, �� ��, �� ��
(���ϴ�ѧ ��ĩұ������ص�ʵ���ң���ɳ 410083)
ժ Ҫ��
����ZrCl4-CH4-H2-Ar��ϵ��C/C���ϻ����Ͻ��г�ѹ��ѧ�������(APCVD)�Ʊ�̼���(ZrC)Ϳ�㡣ͨ��X�������似��(XRD)��ɨ��羵(SEM)�Բ�ͬH2Ũ�����Ʊ���ZrCͿ����з�������H2�ڳ��������е����û��ƽ��������ۡ����������H2Ũ�ȶ�Ϳ�������ɡ����������ȡ��ͽṹ��̬����ҪӰ�죻��H2��H2Ũ�Ƚϵ�ʱ��Ϳ�㺬�д������Ƚ�̼����ZrC��̼������ɣ�Ϳ��ʶ����״����H2Ũ��(�������)���ӵ�30%����ʱ��Ϳ�����ɷֱ�Ϊ��һZrC�ࣻ��H2��Ũ�����ӵ�90%ʱ��ZrC����ȡ����(111)��(200)ת��Ϊǿ�ҵ�(220)����ȡ������ò��Ϊ������״��
�ؼ��ʣ�
ZrCͿ������ѹ��ѧ���������H2Ũ��������ȡ����
��ͼ����ţ�TQ134.1���� ���ױ�־�룺A
Effect of hydrogen concentration on preparation of
ZrC coating by APCVD
LI Guo-dong, ZHENG Xiang-lin, XIONG Xiang, SUN Wei
(State Key Laboratory of Powder Metallurgy, Central South University, Changsha 410083, China)
Abstract: Zirconium carbide (ZrC) coatings were prepared on carbon-carbon composites substrates by means of atmospheric pressure chemical vapor deposition (APCVD). ZrCl4-CH4-H2-Ar system was used in this deposition process. And the effect of different hydrogen concentration on coating properties was studied by X-ray diffractometry (XRD) and scanning electron microscopy (SEM). The mechanism of hydrogen in the deposition process was also studied. The results show that the coating phase composition, preferential growth and structure morphology change significantly as the hydrogen concentration increasing. With pure argon or less hydrogen, ZrC coating is porous, which is made up of ZrC and C two-phase, and is contained by lots of pyrocarbon. When the hydrogen concentration reaches more than 30%(volume fraction), there is only ZrC phase in the coating. When the hydrogen concentration reaches 90%, ZrC crystal preferential growth changes from (111) plane and (200) plane to intensive (220) plane, and the crystal morphology turns into nano-needle-like morphology.
Key words: ZrC coatings; atmospheric pressure chemical vapor deposition; H2 concentration; preferential growth
C/C���ϲ��ϵ���ʼ�����¶�Ϊ370 �棬����500 ���Ѹ��������ʹ��ǿ�ȴ����������ɥʧ���������Լ�˸ò��ϵĽ�һ��Ӧ�á�����о�����[1-3]����C/C���ϲ��ϱ����Ʊ�������Ϳ������Ч����俹����������ʴ���ܡ���ʹ���¶ȸ���1 800 ��ĸ��»����£�����Ϳ�������HfC��TaC��ZrC��NbC��HfB2��ZrB2��TaB2�����۽���̼���������[4-6]������ZrC���۵��(3 540 ��)��������ѧ�������죬��ѧ�����ȶ�����C/C���ϻ��廯ѧ���������Ժã��ɱ��ͣ���C/C��������ĸ���Ϳ����ϡ�
Ŀǰ��ZrCͿ����Ʊ������дſؽ��䡢���弤�����(PLD)����ѧ�������(CVD)��[7-10]������
CVD�����Ʊ�ZrCͿ����г������ʸߡ�Ĥ����ȡ������Ժõ��ŵ���õ��㷺Ӧ�á�CVD���Ʊ���ZrCͿ��Ľṹ������ȡ����������أ����������¶ȡ�ϵͳѹ������Ӧ��Ũ�ȡ����������ȡ�����ʱ���Լ��������͵�[11-15]�����У�H2Ũ�ȶ�Ϳ��ijɷ֡��ṹ����ò�������зdz���Ҫ��Ӱ�졣��ƺƵ�[16]����CVD������CH3SiCl3-Ar-H2��ϵ���Ʊ�SiCͿ����ָ����H2Ũ�ȿ���Ӱ��Ϳ��ṹ�����������ԡ����Ե�[17]������˿��ѧ�����������(HFCVD)��SiH4-CH4-H2��ϵ���Ʊ�SiC��Ĥʱ������H2Ũ�ȿ���Ӱ�챡Ĥ���������������ͱ�������ò�������ó�ѹ��ѧ�������(APCVD)�Ʊ�ZrCͿ�������о�δ���������������߲���APCVD���գ���ZrCl4-CH4-H2-ArΪ��Ӧ��ϵ����ZrCͿ�㣬�о�H2Ũ�ȶ�ZrCͿ�����ɷ֡��ṹ��ò������������Ӱ�졣
1 ʵ��
��ʵ����С����ʽ��Ÿ�Ӧ���ȷ�Ӧ¯�н��У�����ΪC/C���ϲ��ϡ��ԴΪZrCl4�����ĩ�������Ƶ������ͷ�װ���ɷ�Ӧ¯�Ϸ����룬ͬʱͨ��CH4��H2��ϡ������Ar��Ϸ�Ӧ������뷴Ӧ���䣬��Ӧ��������C/C���ϲ��ϻ����ϳ�����
ZrCl4-CH4-H2-Ar��ϵ��ѹ��ѧ�������ZrC�Ĺ������£������¶�Ϊ1 600 �棬������գ�����CH4������(H2+Ar)����������180 min��ͨ������H2��Ar����ռ�������ı������ı���ϵ��H2��Ũ�ȣ�����[FH2/(FH2+FAr)]ΪH2��Ũ�ȣ�F(H2)Ϊ��ϵ��H2�����������FArΪ��ϵ��Ar�������������ʵ��ѡ����H2Ũ��(�������)�ֱ�Ϊ0��15%��30%��50%��90%�������½��г�����
�����ձ���ѧD/max2550VB+ 18 kWת��X����������(XRD)����Ϳ�����ɷֺ�ZrC������������������ɨ���������(SEM)�۲�ZrCͿ�����Ͷ��������ò��
2 ���������
ͼ1��ʾΪ��ͬH2Ũ����ZrCͿ���XRD�ס���ͼ1���Կ�������H2Ũ��Ϊ0������ѧ��Ӧ��ϵ��ȱ��H2ʱ��Ϳ��XRD���г�����ZrC����������C������壬����C���ǿ�Ƚϴ�˵��Ϳ����ZrC��C���������C�ĺ����Ƚϴ�ͬʱC��������νϿ����п����γɷǾ�̼����H2Ũ��Ϊ15%ʱ��C��ķ�ֵǿ�����Լ�����Ϳ���е�C�������٣�����H2Ũ�ȴﵽ30%ʱC�������ʧ����H2Ũ��Ϊ50%��90%ʱ��Ϳ���ɵ�һZrC����ɡ�ʵ����������H2Ũ�ȿ��Ըı�ZrCͿ�����ɷ֣�������ϵ��H2Ũ�ȵ����ӵ�30%����ʱ��Ϳ�����ɷ���ZrC��C������Ϊ��һZrC�ࡣɨ��羵��ɢ��ͼ��۲��Ԫ����ɨ��ֲ�Ҳ֤ʵ��һʵ������
H2Ũ�ȱ仯��Ϳ����ZrC�ͬ����ķ�ֵǿ�ȷ��������Ա仯����H2Ũ��Ϊ0��15%��30%ʱ��ZrC���(111)��ķ�ֵǿ����ߣ�(200)��ķ�ֵǿ�ȴ�֮����H2Ũ��Ϊ50%ʱ�պ��෴��(200)��ķ�ֵǿ����ߣ�(111)���֮������H2Ũ��Ϊ90%ʱ��(220)��ķ�ֵǿ����ߡ�ZrC��ͬ����ķ�ֵǿ�ȵı仯˵��Ϳ����ZrC��������������ȡ����H2Ũ�ȵı仯�������Ըı䡣IMAI��[18]�����˾�����������ȡ��ͷ�Ӧ��������Ͷ�֮�����ϵ��H2Ũ�ȵı仯ʹ��ͬ����ZrC�����κ��ܷ����仯���Ӷ�����ZrC����������ȡ����������ı䡣
Ϊ��һ��˵��Ϳ����ZrC����������ȡ����������ݲ�ͬH2Ũ����ZrC�ͬ����������ǿ�Ⱥ�Harris��ʽ���㾧��֯��ϵ��TC(hkl)��TC(hkl)ֵԽ�������ZrC�����ڸþ��淽�������ȡ��̶�Խ�ߡ�ͼ2��ZrC��ͬ�����֯��ϵ����H2Ũ�ȵĹ�ϵ���ߡ���ͼ2�ɿ�������H2Ũ����0��30%֮��ʱ��TC(111)��TC(200)��1��������ϵ����H2���������H2����ʱ��ZrC����ͬʱ����(111)��(200)��������ȡ����(111)����ȡ��̶��Ը���(200)����H2Ũ��Ϊ50%ʱ��TC(111)ֵ���ͣ��෴TC(200)ֵ����ʱZrC�����γ���(200)Ϊ��������ȡ��H2Ũ�ȵ���90%ʱ��TC(111)��TC(200)ֵ��Ѹ�ٽ��Ͳ��ӽ���0��TC(220)ֵ�����������γ�ǿ�ҵ�(220)����ȡ��˵����ʱZrC����ṹ�ѷ������ش�仯��
�����ڲ�ͬH2Ũ�����Ʊ���ZrCͿ�������ɺ�ZrC�������������ͬ������Ϳ����ܶ�Ҳ�ᷢ����Ӧ�ı仯�����ݦ�=��m/V=��m/S��h������ZrCͿ������ܶȣ����ЦѴ���Ϳ������ܶȣ���m�dz��������������ʣ�h��Ϳ��ĺ�ȣ�S�������ĵ������
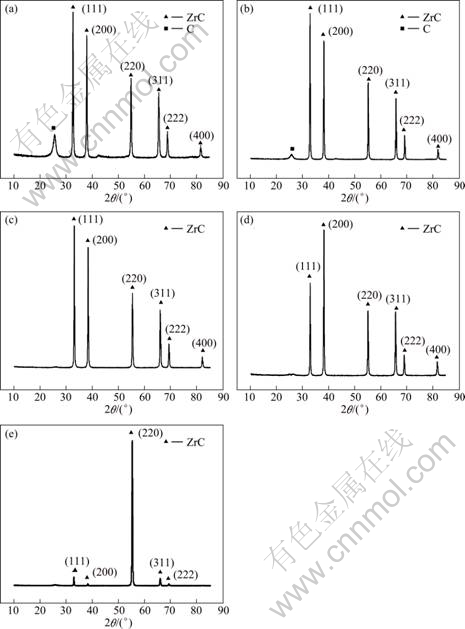
ͼ1 ��ͬH2Ũ�����Ʊ���ZrC Ϳ��XRD��
Fig.1 XRD patterns of ZrC coatings prepared with different H2 concentrations: (a) 0; (b) 15%; (c) 30%; (d) 50%; (e) 90%

ͼ2 H2Ũ����ZrC����֯��ϵ����ϵ
Fig.2 Relation ship between ZrC texture coefficients and of H2 concentration
ͼ3��ʾΪ��ͬH2Ũ����Ϳ���ܶȵı仯���ߡ���H2Ũ�ȵ���30%ʱ��Ϳ���ܶ�С��2 g/cm3�������ܶȺ�H2Ũ�Ȼ��������Թ�ϵ��Ϳ���ܶ���H2Ũ�ȵ�����ֻ������������H2Ũ�ȸ���30%��Ϳ���ܶȺ�H2Ũ����Ȼ���������Թ�ϵ����Ϳ���ܶȰ���H2Ũ�ȵ����Ӷ�Ѹ����������H2Ũ��Ϊ90%ʱ��Ϳ���ܶȵ������ֵ���ӽ�5 g/cm3(ZrC�����ܶ�Ϊ6.66 g/cm3)��
��������Ҫ������¼����ȷֽ�����̼�����йأ��練Ӧʽ(1)��900 �����Ϸ�ӦѸ�٣�1 600 ��ʱ��Ӧ�����Ƚ�̼�����ʷdz�����Ӧ��ϵ�м���H2ʱ��H2�Լ����ȷֽ�����������[19]����ͼ1Ҳ�ɿ���������H2��H2��Ũ��Сʱ��Ϳ���к��д�����̼��˵�������ȷֽ����ʿ죬H2�������Ƶij̶ȵ͡��Ƚ�̼���ܶ�ҪԶС��ZrC���ܶȣ��Ҷ�ף�������Ϳ�����
��С������H2Ũ������ʱ������30%����Ϳ����̼�ĺ������٣�ZrC�ĺ�������Ϳ���ܶ����ӡ�
CH4 �� C �� H2 (1)
ͼ4��ʾΪ��ͬH2Ũ�����Ʊ���ZrCͿ�����SEM��ͼ4(a)��(b)�ɿ�����Ϳ������д�������һ�����ӣ�����һ������֮������ӣ��ѻ��ɽϴ���ο��������ο���֮����ڿ�϶��Ϳ�����ֲڡ�
��ͼ4(c)�ɿ���������30%��H2��Ϳ���е�һ�����ӻ�����ʧ����ںϳɴ������������������ԵĽ��档����Ҫ��������ϵ��ͨ��H2�����٣���1600��ĸ����£������ȷֽ��γɵĴ���ԭ��̼�����ڻ������������Ǩ�ƺ;ۼ�����ΪZrC���κ˺���[20]����ͼ4(d)��(e)�ɿ�������H2Ũ�ȵ�����H2�Լ����Ƚ�����������õ����֡����ڼ����ȷֽ����ʽ��ͣ�������������������ԭ��̼���٣�ֱ�ӵ���ZrC���κ��ʽ��ͣ���ʱͿ�����Ҫ�����������κ�����
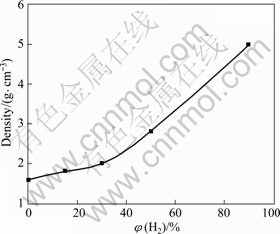
ͼ3 ZrCͿ���ܶȺ�H2Ũ�ȵĹ�ϵ
Fig.3 Relationship between ZrC coating density and H2 concentration

ͼ4 ��ͬH2Ũ�����Ʊ���ZrCͿ�����SEM��
Fig.4 SEM images of surface morphologies of ZrC coatings prepared with different H2 concentrations: (a) 0; (b) 15%; (c) 30%; (d) 50%; (e) 90%
ת��Ϊ����������ZrCͿ���������Ϳ������������ʧ��Ϳ�������ܡ�
ͼ5��6��ʾΪ��ͬH2Ũ�����Ʊ���ZrCͿ����Ȼ�����SEM��ͼ5��ʾΪ�ͱ�SEM��ͼ6��ʾΪ�߱�SEM����ͼ5��6��֪����H2�Ʊ���Ϳ���Ϊ���ɣ��н϶��϶������H2Ũ���Ʊ���Ϳ�㶼�����ܣ���Ϳ����������ӽ��ܣ���������Ӵ���Ϳ���ڲ����ɼ����ƣ���֯��ò��H2Ũ�ȱ仯���ܴ�
ͼ6(a)��(b)��ʾΪSEM��ɢ��ɫ����ΪZrC��������ɫΪ�Ƚ�̼����ͼ6(a)��(b)���Կ�����δ����H2ʱ��Ϳ�����Ƚ�̼�࣬�Ҷ�ʿ�״��ZrC��С���������ȷ�ɢ״��Ϳ���϶�࣬�����ܣ������Ƚ�̼���ȳɺ������Ľ������H2Ũ��Ϊ15%ʱ��Ϳ�㾧���dz�ϸС���ҷֲ����ȣ������Կ���Ҳ�����ƣ�����Ϳ��ɺ��ٶȴ��Ƚ�̼��ZrC���ȳɺ������Ľ����Ϳ���ر�����ֲַ���������ZrCl4���벻����ʱ��ɵġ���H2Ũ��Ϊ30%ʱ��Ϳ�����ܣ�ZrC�����ʿ���״���������ػ������ֲ������H2Ũ��Ϊ50%ʱ��ZrC�����ʶ���״��������������Ե��ںϳ�������H2Ũ��Ϊ90%ʱ��Ϳ����ֵ��͵�T����״�ṹ[21]�����ɴ�ֱ�ڻ���������״����������нṹ������ZrC������(220)����ǿ��ȡ�������Ľ������״��ֱ��С��100 nm��Ϊ�����ṹ��
APCVD������ZrC��һ�����ӵ�������ѧ���̣�һ����Ҫ��Ϊ���¼�����1) CH4��H2��ZrCl4��Ar���Ӿ���ɢ���������棻2) CH4�ȷֽ�Ϊԭ��̼���⣬�����е��⽫��Zr��ԭΪ�ͼ�Zr(ZrCl3��ZrCl2��)��3) ԭ��̼�������������������Ϊ�κ˻��Ե㣬����ﯵĻ����ﷴӦ����ZrC��4) ��̬����HCl�ӻ�������������ɢ�뿪��������Ҫ�Ļ�ѧ��Ӧ�練Ӧʽ(1)~(4)����Ӧʽ(5)Ϊ�����ܷ�Ӧʽ[22]��

ͼ5 ��ͬH2Ũ�����Ʊ���ZrCͿ�����SEM��
Fig.5 Section SEM images of ZrC coatings prepared with different H2 concentrations: (a) 0; (b) 15%; (c) 30%; (d) 50%; (e) 90%

ͼ6 ��ͬH2Ũ�����Ʊ���ZrCͿ�����߱�SEM��
Fig.6 High magnification section SEM images of ZrC coatings prepared with different H2 concentrations: (a) 0; (b) 15%; (c) 30%; (d) 50%; (e) 90%; (a), (b)BES; (c), (d), (e)SEI
ZrCl4��H2��ZrClx��HCl x=0~3 (2)
ZrClx��C��ZrC��Cl x=0~4 (3)
H2��Cl��HCl (4)
ZrCl4��CH4��ZrC��HCl (5)
��������Ӧ�ɿ�����H2�������Ʊ�ZrC�Ĺ����������������ã�������ԭZrCl4������CH4�ȷֽ⡣����ʽ(1)Ϊ�����ȷֽ���̣�����ϵ����Ϊ�����ȷֽ�����H��Ũ������ʱ��������ʽ(1)��������У������ȷֽ����ʣ��෴��������ʽ(2)�ķ�Ӧ���ʡ�
��Ӧ��ϵ����H2��H2Ũ�Ƚ�Сʱ���Ƚ�̼�ij���ռ������λ����ΪZrC���κ˺��ġ����ڷ�Ӧ�¶ȹ��ߣ�����ֽ⡢�����Ƚ�̼���ʹ��죬���ڵ�״��������ӰЧӦ�������Ƚ�̼�ij���Ϊ���״��ZrC�ѻ����У��γɲ����ȷֲ�����H2Ũ�������ȷֽ���
�ɵ�ԭ��̼���٣�ZrCl4�Ļ�ԭ�̶����ӣ�ZrC�ij������������������Ƚ�̼ʱ���ɺ�������Ҫ���¶Ⱥ�ZrC�����ͶȾ���������ϵ��H2Ũ�Ȳ���ʱ��ZrC�����Ͷȵͣ��κ�����С�������ϴ�H2Ũ�Ƚ�һ������ZrC���κ����ʴ�ZrC������С����H2Ũ���ر��ʱ��ZrCl4�ܿ챻��ԭ��ZrC����ȴ�ZrC�κ����ʴ�����ԭ�ӵ�����ɢ�������ޣ�����ZrC���˾������������Ϳ���γ���״�ṹ��
3 ����
1) ��ZrCl4-CH4-H2-ArΪ��ѧ��Ӧ��ϵ�����ó�ѹ����������գ���1 600 ���¶����ܹ���C/C���ϻ������Ʊ������������Ƶ�ZrCͿ�㣻��H2ʱ��Ϳ����ZrC��C����ɣ�����H2Ũ�ȵ�����CH4�ֽ�Ϊ�Ƚ�̼�����ʽ��ͣ�ZrCl4����ԭ��������ߣ�Ϳ���е�C�������٣���H2Ũ�ȴﵽ30%�����ʱ��Ϳ���Ϊ��ZrC�ࡣ
2) H2Ũ�Ƚ�Сʱ��Ϳ����������ƽ��Ϳ�����ɣ����࣬�ܶ�С����H2Ũ������ZrC��������Ϳ�������ƽ���������٣����ܶ�����
3) H2Ũ����0��50%֮��仯ʱ��ZrC��������������ȡ��Ϊ(111)��(200)˫��H2Ũ�ȴﵽ90%ʱ������Ϊǿ�ҵ�(220)ȡ����Ӧ�أ�Ϳ����ZrC�����ɿ���״������״����״ת�䡣��H2Ũ�ȴﵽ90%ʱ��ZrCͿ��ʵ��͵�T����״�ṹ��
REFERENCES
[1] SMEACETTO F, SALVO M, FERRARIS M. Oxidation protective multilayer coatings for carbon-carbon composites[J]. Carbon, 2002, 40: 583-587.
[2] MORIMOTO T, OGURA Y, KONDO M, UEDA T. Multilayer coating for carbon-carbon composites[J]. Carbon, 1995, 33: 351-357.
[3] �ƽ���, ��ؾ�, ���Ű�, ������, �����, ��ҵΰ, �� ��. ̿/̿���ϲ��ϸ��¿�����Ϳ����о���չ[J]. ����̿����, 2005, 20(4): 373-379.
HUANG Jian-feng, LI He-jun, XIONG Xin-bai, ZENG Xie-rong, LI Ke-zhi, FU Ye-wei, HUANG Min. Progress on the oxidation protective coating of carbon-carbon composites[J]. New Carbon Materials, 2005, 20(4): 373-379.
[4] �����, �� ��, �Ʋ���. �¶ȶ�CVD-TaCͿ����ɡ���ò��ṹ��Ӱ��[J]. �й���ɫ����ѧ��, 2005, 15(4): 565-571.
LI Guo-dong, XIONG Xiang, HUANG Bai-yun. Effect of temperature on composition, surface morphology and microstructure of CVD-TaC coating[J]. The Chinese Journal of Nonferrous Metals, 2005, 15(4): 565-571.
[5] Ѧ ��, ��ؾ�, ��ǰ��, �����. ̼/̼���ϲ��Ϸ�����Ϳ���о���չ[J]. ����������, 2007, 30(5): 427-432.
XUE Hui, LI He-jun, FU Qian-gang, LI Ke-zhi. Research on anti-oxidation coatings for C/C composites[J]. Journal of Solid Rocket Technology, 2007, 30(5): 427-432.
[6] ���п�, �� ��, �����, Ф ��, �ź첨, ������, �Ʋ���. ��ѧ�������TaCͿ�������ò��������������[J]. �й���ɫ����ѧ��, 2008, 18(8): 1377-1382.
CHEN Zhao-ke, XIONG Xiang, LI Guo-dong, XIAO Peng, ZHANG Hong-bo, WANG Ya-lei, HUANG Bai-yun. Surface morphology of TaC coating prepared by chemical vapor deposition and preferential growth mechanism of TaC grains[J]. The Chinese Journal of Nonferrous Metals, 2008, 18(8): 1377-1382.
[7] YANG J, WANG M X, KANG Y B, Li D J. Influence of bilayer periods on structural and mechanical properties of ZrC/ZrB2 superlattice coatings[J]. Applied Surface Science, 2007, 253: 5302-5305.
[8] CRACIUN V, CRACIUN D, HOWARD J M, WOO J. Pulsed laser deposition of crystalline ZrC thin films[J]. Thin Solid Films, 2007, 515: 4636-4639.
[9] WON Y S, KIM Y S, VARANASI V G, KRYLIOUK O, et al. Growth of ZrC thin films by aerosol-assisted MOCVD[J]. Journal of Crystal Growth, 2007, 304: 324-332.
[10] UETA S, AIHARA J, YASUDA A, ISHIBASHI H, TAKAYAMA T, HIROSAWA K. Fabrication of uniform ZrC coating layer for the coated fuel particle of the very high temperature reactor[J]. Journal of Nuclear Materials, 2008, 376: 146-151.
[11] �����, �Ŵ��, �ű���, �� ��, ������. ̼��ﯶƲ�Ļ�ѧ�������[J]. �廪��ѧѧ��: ��Ȼ��ѧ��, 2000, 40(12): 59-62.
ZHU Jun-guo, DU Chun-biao, ZHANG Bing-zhong, YANG Bing, PENG Xin-li. Chemical vapor deposition of zirconium carbide coatings[J]. J Tsinghua Univ (Sci and Tech), 2000, 40(12): 59-62.
[12] PARK J H, JUNG C H, KIM D J, PARK J Y. Temperature dependency of the LPCVD growth of ZrC with the ZrCl4-CH4-H2 system[J]. Surface & Coatings Technology, 2008, 203: 324-328.
[13] LIU C, LIU B, SHAO Y L, LI Z Q, TANG C H. Preparation and characterization of zirconium carbide coating on coated fuel particles[J]. Am Ceram Soc, 2007, 90(11): 3690-3693.
[14] WONNA Y S, VARANNASIA V G, KRYLIOUK O. Equilibrium analysis of zirconium carbide CVD growth[J]. Journal of Crystal Growth, 2007, 307: 302-308.
[15] PARK J H, JUNG C H, KIM D J, PARK J Y. Effect of H2 dilution gas on the growth of ZrC during low pressure chemical vapor deposition in the ZrCl4-CH4-Ar system[J]. Surface & Coatings Technology, 2008, 203: 87-90.
[16] �� ��, �´���, �ڽ���, �ΰ. ʯī����CVD SiCͿ���۽ṹ�о�[J]. ���ղ���ѧ��, 2008, 28(2): 50-54.
HUANG Hao, CHEN Da-ming, TONG Jian-feng, LI Bao-wei. Microstructure study of the SiC coatings on graphite by CVD[J]. Journal of Aeronautical Materials, 2008, 28(2): 50-54.
[17] �� ��, �� ��, ������, �� ��, �ѹ���. H2ϡ�Ͷȶ�HFCVD������SiC��Ĥ�ᾧ�ȵ�Ӱ��[J]. ����������ѧѧ��, 2005, 28(1): 90-92.
WANG Hui, SONG Hang, JIN Yi-xin, JIANG Hong, MIAO Guo-qing. H2 dilution ratio (H2/H2 +CH4+SiH4) determining crystallinity in SiC thin films by HFCVD[J]. Journal of Changchun University of Science and Technology, 2005, 28(1): 90-92.
[18] IMAI Y, MUKAIDA M, WATANABE A, TSUNODA T. Formation energies of two-dimensional nuclei randomly-generated on (001), (110), and (111) planes of a face-centered-cubic crystal[J]. Thin Solid Films, 1997, 300: 305-313.
[19] �� ��, Ҷ־��, ����, ������, �Ա���, �ƾ�ҫ. H2��UHV/CVD����ѡ������������Si1-xGex��Ӱ��[J]. �뵼��ѧ��, 2006, 27(1): 78-81.
ZHAO Xing, YE Zhi-zhen, WU Gui-bing, LIU Guo-jun, ZHAO Bing-hui, TANG Jiu-yao. Effect of hydrogen on the low temperature selective epitaxial growth in Si1-xGex by UHV/CVD[J]. Journal of Semiconductors, 2006, 27(1): 78-81.
[20] ���п�, �� ��, �����, Ф ��, �ź첨, �� ��, �Ʋ���. ���ղ�����CVI-TaC�������ʵ�Ӱ��[J]. �й���ɫ����ѧ��, 2006, 16(12): 2047-2053.
CHEN Zhao-ke, XIONG Xiang, LI Guo-dong, XIAO Peng, ZHANG Hong-bo, YIN Jian, HUANG Bai-yun. Influence of process parameters on deposition rate of CVI-TaC[J]. The Chinese Journal of Nonferrous Metals, 2006, 16(12): 2047-2053.
[21] ��ΰ��. ��Ĥ�����Ʊ�ԭ����������Ӧ��[M]. ����: ұ��ҵ������, 2003: 178-181.
TANG Wei-zhong. Preparation of principles of thin film materials, technology and application[M]. Beijing: Metallurgical Industry Press, 2003: 178-181.
[22] WANG Y G, LIU Q M, LIU J L, ZHANG L T, CHENG L F. Deposition mechanism for chemical vapor deposition of zirconium carbide coatings[J]. Am. Ceram. Soc, 2008, 91(4): 1249-1252.
������Ŀ�����Ҹ����о���չ�ƻ�������Ŀ(2007AA03Z110)��������Ȼ��ѧ�������о�Ⱥ����Ŀ (50721003)�������ص�����о���չ�ƻ�������Ŀ��2011CB605805����
�ո����ڣ�2009-03-09�������ڣ�2010-04-07
ͨ�����ߣ�����������ڣ���ʿ���绰��0731-88836864��E-mail��lgd63@163.com


