DOI��10.19476/j.ysxb.1004.0609.2017.08.15
��/�ٻ������ǥ���о���չ
���̺㣬л �����ż��������꣬�¾��飬������
(����������о��� ϡ������ۺ������¼��������ص�ʵ���ң����� 650106)
ժ Ҫ��
�����ǥ���ڵ��ӹ�ҵ�����ӷ�װ����ն༶ǥ�������¼�������Ʒ����ҵ�����պ�����������ռ����Ҫ��λ����/�ٻ������ǥ�ϵ��з���Ӧ��һֱ�ǹ������о����ȵ㡣��ϸ���ܹ�ҵ���������������õ������г��õĵ�/��/���½��ǥ�ϣ����ӹ�ҵ�ּ�ǥ���á����������ͺ;߱��������ܵ��ٻ�ǥ�ϣ��ܽ����ϵ��ǥ���ص㡢ǥ�����ܼ���;������������ǥ�����ԡ��ۺ����������ǥ�Ϸ�չ��Ӧ���г��ֵļӹ����ܲ���óɱ��ߡ����¶���ȾԪ�ء�����ɿ��Բ����뼰ģ��������ݿ��ѷ������⣬���Ʊ����ա��Ͻ�����ǿ���ࡢƥ����������ǥ�ϼ����ģ��ȷ���չ�������ǥ��δ����չ���ƣ�������Ѱ����ִ�����Ľ����ʩ��Ϊ�����ǥ�ϵĿ�����Ӧ�ü��ƹ��ṩ����֧�š�
�ؼ��ʣ�
�����ǥ����ǥ����������;�������м仯������
���±�ţ�1004-0609(2017)-08-1659-11���� ��ͼ����ţ�TD923���� ���ױ�־�룺A
20����40����Ժ����ŵ��ӡ����ա�����ȸ��¼����ij��֣�����ǥ�Ӳ��ϵ�Ʒ�ֺ��ܵ�����������ķ�չ������ǥ�ϵĿ�����Ӧ�ý���ǥ������������ҿ����ɵ���Ϊǥ�ϺϽ�Ԫ��Ӧ�û����٣����Թ����ǥ�ϰ�����Ԫ���֣���Ҫ�н��ǥ�ϡ�����ǥ�Ϻ��ٻ�ǥ�ϣ����Ʒ��̬ΪƬ��˿����������������״����ĩ��Ԥ�ȳ��εĿ�ͻ����ȡ�������ǥ��ϵ���еĹ����ǥ�϶���ǧ��֮�࣬ǥ���ۻ��¶�250~1600 �棬����������ܡ����ȶ����߿ɿ����������ȸ��ֹ���Ҫ����������ǥ���ͺ�ϵ����ḻ����;��㷺���ر����ڵ��ӹ�ҵ������������ͷּ�ǥ���õ�Ӳǥ�϶�Ϊ����ǥ��[1-3]����ͳ�ƣ��ҹ�ÿ������ǥ�ϵ������������ڻ�������е�����������ӵ�����ʹ�200 t����[4-5]�������ֲ��ϸ�ǿ�����Ӻ��������¾����������ܵ�ǥ�϶�Ϊ������ٻ�ǥ�ϣ������ǥ�ϲ����ڵ��ӡ����պͺ�������Ӧ�ù㷺���ڻ�����ʯ�͡���е�����ܡ��Ṥҵ�����У������ǥ��Ҳռ����Ҫ��λ[6-10]�������ǥ����Ŀ���DZ����롰ʮ���塱�滮�ص���Ŀ֮һ��
������ѧ�߶Թ����ǥ�Ͻ����˴���������ʵ���о���¬���͵�[11]������Ag-Cu-Znϵǥ�ϵķ�չ��ʷ���̺��о���״������Ϊ��Ag-Cu-ZnΪ��Ҫ�Ͻ���ϵ���ʵ�����Ga��Sn��In��Ni��ϡ����Ԫ�ض��γɵ�Ag-Cu-Zn-Ga-In-RE-Xǥ�Ͽ��ܻ��Ϊδ���ķ�չ���������ϵ�[12]��������Ǧ����ǥ�ϵ��о��뷢չ��״��ͬʱ��������Ӧ����������Ը�ǥ�ϼ���ɿ��Եķ�չ���ƽ����˷�����չ����COLLINS��[13]��Sb��Bi��Ni���ӵ�������Ǧ�����У������˽�������仯���������ԣ���ͨ������ǿ���ֲ���ǿ����ʧ��ʹǥ�Ͼ߱���ǿ�Ŀ��ȼ�����е�غ����ܣ��Ӷ��������µĵ�������Ǧ����ǥ�ϡ������[14]���õ������㷨�Ʊ�Au-19.25Ag-12.80Geǥ�ϱ�������Һ�����¶ȱ�ǥ��ĸ�Ͻ���������ͣ��ۻ��¶�������С��Լ4 �棬�������㹤��ʹǥ�ϱ�������֯�ֲ�����������ϸ��������ǥ����Ni���������ʪ�������γ��˿ɿ���ұ���Ͻ��档лԪ���[15]Ϊ�о�Pd��ǥ��ǥ��SiC�մ����������ϵĽӺϻ��ƣ��о���PdAgMn+Tiǥ�϶�SiC�մɵ���ʪ���ɣ�����Ԫ��Ti����Ӱ��ǥ�϶�SiC�մɵ���ʪ�ԣ�PdAgMn+Ti�ܹ���ʪSiC�մ�,����SiC�մ��γ�ұ���ϡ�
������������ǰ����ǥ���о�Ӧ����ϵ�ϳ��죬������ס�ר���������϶࣬����/�ٻ�ǥ�������������������о�������ȫ�����룬ȱ�������ۺ������������о��������һ����չ�����ˣ��������߶Թ�ҵ���������������õ��������漰���ij��ý��ǥ�Ϻ��ٻ�ǥ�Ͻ��з�����ܣ�����ϸ�ܽ����ϵ��ǥ�ϵ��ص㡢���ܼ���;��ͬʱ��������ǥ�����ԡ��ۺ�����Ŀǰ������������ǥ���о���չ�д��ڵ����⣬���Թ����ǥ�Ϸ�չ���ƽ���չ����
1 ���ǥ��
����Ͻ�ǥ����Ҫ�ص�Ϊ��1) ��������ʴ�Ϳ��������ܣ�2) ������ѹ���۵��¶ȵ�����ѹΪ1��10-6~1��10-7Pa��3) ���õ���ɢ�ԡ������Լ������ȶ��ԣ�4) ���ӽ�ͷ�������������ѧ���ܡ�����ȱ���dzɱ��ߡ��ܶȴ��ǥ�Ͽɺ���Cu��Ni��Mo��ʯī������ֺͿɷ��Ͻ��[16]����Ҫ�е��¹����ͺ��¹������ͣ�������ǥ����Ҫ������������װ�乤�գ�Ӳǥ������Ҫ����������������շ���������Ҫ�㲿�����ӡ����ӹ�ҵ�༶ǥ������Ʒ����ҵ[17-18]�����ǥ�ϸ����۵��¶ȼ�ʵ���Կ�ϸ��Ϊ�����½��ǥ��(400 ������)�����½��ǥ��(400~600 ��)�����½��ǥ��(600 ������)��
1.1 �������ǥ��
�������ǥ����Au�� Sn��Ge��Si��Sb��In ��Ԫ���γɵ��۵㹲���Ͻ��۵���270~400 ��֮�䣬���ܴ��۵㿼����Ӧ�÷�Χ�ܵ��ܴ�����ƣ������ڸ�ϵ��ǥ�Ͼ��е�ճ�ԡ���ʴ������Ŀ�ƣ�ͺ�������ܡ����Ⱥ͵����Ժá����ӡ�����������������ŵ㣬�㷺Ӧ���ڹ��������������������оƬ��װ���մɷ�װ��ǡ����ʰ뵼�弤����оƬ�ĺ����Լ�������װ���մɾ�Ե�Ӻ�����[19-20]�����õĽ������ǥ�����1���У���1��ǥ���ƺű�ʾ������ͼ1��ʾ�����ֽ������ǥ�ϵ�����֯��ͼ2��ʾ[21]��

ͼ1 ǥ���ƺű�ʾ����
Fig. 1 Method for expressing brand of solder
��1 ���ý������ǥ��
Table 1 Commonly used Au-based low temperature solders

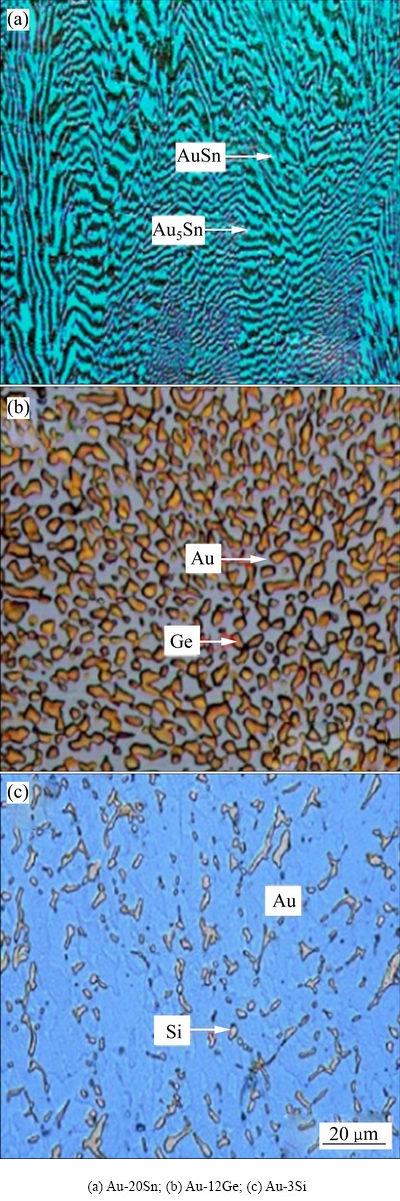
ͼ2 �������ǥ�ϺϽ������֯[21]
Fig. 2 Microstructures of Au-based low temperature solder alloys[21]
Au-20Sn��ǥ���¶����У������۵��20~30 �棬�������������ɱ����ѧ������Ⱦ��Һ̬Au-20Sn�Ͻ���кܵ͵�ճ���ԣ������һЩ�ܴ�Ŀ�϶��ͬʱ��Au-20Sn���۵���270~360 ����Ψһ����������۵�Ǧ���Ͻ�ĺ��ϣ�������װ����Ƶ�������Է�װ����װоƬ(Flip-Ship)�����������(LED)�ȷ���㷺Ӧ��[22-23]������֮������������֯��þ�����������ṹ����(Au5Sn)�ͦ���(AuSn)���ִ��Խ����仯������ɣ���ͼ2(a)��ʾ������ǥ�ϴ��Դ��쳤��С���ɲ��ö�����+��ɢ�Ͻ����˷��Ѽӹ��������������ļ�����ӹ���Ʒ[24]��
Au-12Geǥ���¶�Ϊ380~400 �棬��Ӵ���ĵ���ԶԶС�ڰ뵼��ĵ��裬��ˣ��������Ʊ��뵼��оƬ�������γ�ŷķ�Ӵ����νӲ��ϣ�AuGe��������ϵ��(10.3��10-6 ��-1)��ͬ���������ӷ�װ��AuSn(16��10-6 ��-1)��AuSi(13��10-6 ��-1)���ͣ��ܸ��õ�������ӵĹ�Ԫ������ƥ��[25]�������£�Ge��Au�еĹ��ܶȡ�0.1%(��������)����Au��Ge��ʵ�ʲ����ܣ���ˣ��úϽ��̬���ɸ�Au������ʹ����ിGe��ɵĹ����壬����AuGe���Ѽӹ���Ƭ�ģ�һ����þ��Ȼ�+���������Ʊ�0.04~0.3 mm AuGe����[26]��
Au-Siϵ�����Ȼ�ϼ��ɵ�·��оƬװ���й㷺Ӧ�ã�ͬʱ���ܸ߿ɿ�������װ���������ڹ�оƬ�����֮���γɹ�������ʱ���乲�����Si�ɷּ�ΪԤ���ϲ��Ϲ豾�����⽵���˼��Ϲ����Ѷȣ�AuSiǥ����ͭ��������������õ���ʪ�ԣ����Ͻ������Բ��Ϊ������֯Ϊ��Au������ʹ����ിSi[27]��
Au-Sb�ں��ӽ�ͷҪ��������ʴ�Ժ͵����Եİ뵼��ǥ����Ӧ�ù㷺������ɴ���۵㣬���Ͻ����õ����ԡ���ʴ�Ժ͵����Բ��䣬����Au-25Sb��360 ��ĵ��۵���㷺Ӧ��������ǥ��[28]��
1.2 �������ǥ��
����������װ�乤���У����Ŵ����������°뵼���²��ϵ�Ӧ�ã���λ���оƬ�����������������ӣ����еĵ��¹����ͽ��ǥ�ϲ��������װ���ռ���Ҫ���ۻ��¶���400~600 ������½��ǥ�ϸ�����Ӧǥ�����������������㷺Ӧ�ã����½��ǥ����Ҫ��ΪAu-Agϵ��Au-Inϵ���ࡣ���õĽ������ǥ�����2���У����ֽ������ǥ�ϺϽ������֯��ͼ2��ʾ��
Sn��Si��Ge��Ԫ������Au-Ag���Ͻ����γ����½��ǥ�ϡ�1) Au-30Ag-40Sn���ۻ�����Ϊ411~412 �棬��Һ���ߵ��¶ȼ���dz�С����֤��ǥ����ĸ���������ļ�϶����Ժ������ԣ����Ͻ���NiAs�ṹ�Ħ���(AuSn)�������ṹ�Ħ���(AuSn2)���ִ����м仯���2) Au-Ag-Geϵ���۵���450~500 ��֮�䣬Au-Ag-Siϵ�۵���450~520 ��֮�䣬������ϵ�Ͻ���۵�����ѡ���ĺϽ�ɷַ�Χ����Ag���������Ӷ�����[29]��Ge��Si��ͬһ����Ԫ�أ��������ƣ�Au-Ag-Geϵ��Au-Ag-Siϵǥ��Ҳ�����������ƴ������ຽ�յ������IJ����ܶȽϵ͵IJ��ϣ�������Ni�����ģ���������ϵ��ǥ����Ni�������ã�����һ���ļӹ��ԣ����������ϵ��������ķ�װ����Ҫ���ں��ӽ��洦�γ�һ�������ȵ�Ni3Si��Ge3Ni5�����仯������ɲ㣬Ni3Si��Ge3Ni5����ṹ�Գ��Խϵ��Դ��ԣ����ή�ͺ��ӵĿɿ��ԣ���Ӧ���ƺ��ӹ����Ի�����������Һ���ʵ��Ľ����仯�����[30]�����⣬�Ͻ���ɳ����������������ɹ�����֯�����Ц���(��Si���Ge��)Ϊ�����࣬ʹ�Ͻ����Խ��ͣ��Ѽӹ���ͨ�������Ȱ���Al�����ٽ�����������м��˻�Ĺ����Ƶ�0. 1 mm��ǥ�ϱ���[31]��3) Au-Ag-Ge-Siϵǥ��Ҳ����������ǥ�����ԡ������ۻ��¶�Ҫ�����γɦ�+�¹�����֯��������Ge��Si��ͬʱ���룬������֯����ϸ����ʹ�Ͻ����һ�������ԣ������˺Ͻ���ѧ����[32]��
��2 ���ý������ǥ��
Table 2 Commonly used Au-based medium temperature solders
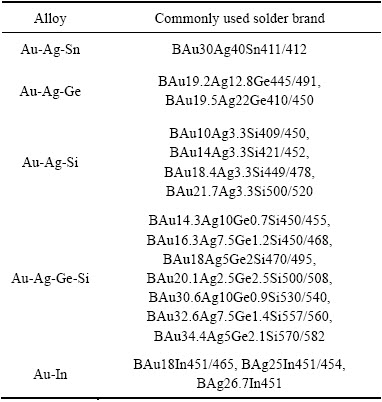

ͼ2 �������ǥ�ϺϽ������֯[21]
Fig. 2 Microstructures of Au-based medium temperature solder alloys[21]
Au-Inϵ�۵���450~500 �棬��Ar��H2�ȱ��������£�ǥ���¶�Ϊ500~550 ���Au-Inϵǥ�϶Խ�������������ͭ����渲����Щ�����Ʋ��ĸ��������ǥ�����ԡ���Au-In��Ԫ��ͼ��֪����In�ĺ���Ϊ19%~27%(��������)ʱ�������Ͻ��Һ�����¶�Ϊ450~500 �棬�ҹ�-Һ�����¶ȼ��С���ر���In������24%~27%ʱ����-Һ���¶ȼ��Ϊ0~3 �棬���ڹ����ͻ�ӽ������ͺϽ���ǥ�������У���-Һ�����¶ȼ��С��ǥ�ϺϽ�����ǥ���ڽ��ܹ���ĸ���ϵļ�϶����Ժ������ԣ��Ӷ���߽�ͷ�ۺ���������ǿǥ�����������ȶ��ԺͿɿ��ԡ����ǺϽ�����б�ṹ�Ħ���(AuIn)�������ṹ�������ṹ�Ħ���(Au7In3)���ֽ����仯������ɣ���ͼ2(d)��ʾ���Ͻ���Դɲ��ö��������Ƶķ����Ʊ�ǥ�ϲ�����[33]��
1.3 �������ǥ��
�������ǥ���۵���800 �����ϣ�ǥ�ϼ���ͷ�ڸ��¹�����������Ȼ�߱������ܺ߿ɿ��ԣ��㷺Ӧ�������ǡ��������ɻ����������մɼ�������[34-35]��Au-Niϵ��Au-CuϵΪ���������½��ϵ�С����õĽ������ǥ�����3���С�
��3 ���ý������ǥ��
Table 3 Commonly used Au-based high temperature solders
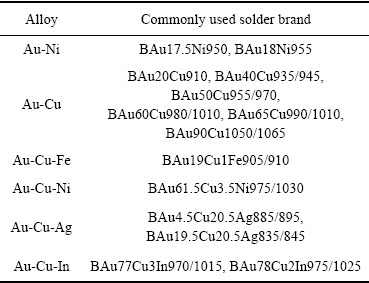
Au-Ni��Ԫ��ͼΪ���͵��Ⱦ���ͼ���������γ��������壬��������������������Խ��ͺϽ��۵㣬Au-Niϵǥ����Ӧ������ΪAu-18Ni��Au-17.5Ni����Ni����Ϊ17.5%ʱ���Ͻ��۵����(950 ��)������ǥ�Ϲ�Һ�����¶ȼ���һ�£���������Ĺ���ǥ�ϣ��ۻ���ȴ�������ɷ�ƫ��������ʴ�Ժ��¿�����������죬���ӽ�ͷǿ�ȸߣ���ӵ�����õ������Ժ���ʪ���ܣ��㷺Ӧ���ڷɻ������Ǻ͵�����������[36]��ȱ���Ǽӹ����ܲ�ɲ��ʵ͡����⣬����ǥ���л���������Ϊ16%��25%��35%��55%��4��ǥ�ϣ���Ŀǰ�г�Ӧ�ú��١�
Au-Cu��ͼ��ȻΪ�Ⱦ���ͼ�����ͭ�γ����������壬��ͬCu�����Ľ�ͭ�Ͻ�Ĺ�Һ���������С�������ղ�ͬ������ȿ��Եõ���ͬ�۵�Ĺ��������ǥ�ϣ������ź�ͭ�������ӣ�ǥ����ʴ���������͡�Au-20Cu��Au-Cuϵ����Ӧ����㷺��ǥ�ϣ����۵�Ϊ910 �棬��Cu��Fe��Co��Ni��W��Mo��Ta��Nb�Ƚ�������Ͻ������õ���ʪ��[37]������ĸ�IJ�������ѧ��Ӧ����˲��ή������ǿ�ȼ��ߴ羫�ȣ����Ͻ��ɸ�����ȴ��400 ������ʱ��������������࣬�����ӽ�ͷ����仯���Ҷ�ѹ���ӹ�������ѣ���ͨ������С��1%��Fe����ֹ���IJ���[38]�����⣬Au-20Cu��Au-40Cu��Au-Ag-Cu�����ݶȺ��ϣ��㷺���ڵ���������ķּ�ǥ�����粨���ܡ����ʶ�ע�ٵ��ܵȡ�Au-50Cu��Au-65Cu�����ڽ������մɼ�����ӣ��ǵ��͵Ĵɷ�ǥ�ϣ�ͬʱ�������Դ���Ag-28Cu��Ϊ����������ĺ��Ӳ��ϣ������������ӷ��������Ƭ����Ⱦ���Լ����ǥ����������ɢ��ʹ���������������Ը���[39]��
��Au-Cuǥ��������������Ni���Ͻ��۵����ߣ�����ʪ���ܡ�����ǿ�ȱ�Au-Cuǥ�ϸ����죬ͨ����Ϊ����������ĵ�һ��ǥ��[40]����������������Agʱ���Ͻ��۵㽵�ͣ�Au-Cu-Agϵ�е��۵���780~950 �棬����Ag-28Cu��Au-17.5Ni���۵�֮�䣬����Ϊ���ӹ��õ��м�һ��ǥ��[41]���ı���ͭ�����ɵ��ںϽ������ɫ����˿�����װ��Ʒǥ��������1%~10%��In���ɽ���Au-Cuǥ�ϵ�ʹ�óɱ�����Au-77Cu-3Inǥ���۵�Ϊ1015 �棬�����Ժá�����ѹ��ʹ�óɱ��ͣ����������Au-65Cuǥ�ϣ����úϽ�δ��ҵ��[42]��
2 �ٻ�ǥ��
���ٻ�����Ϊ���ĺϽ�ǥ�ϳ�Ϊ�ٻ�ǥ�ϣ�����Ҫ�ص�Ϊ��1) ����ʴĸ�ġ������������ʴ��������ϸС������������ǥ����ǥ����Ӧ�����ѣ�2) ��ĸ��ǥ���в����ɴ��Ի������࣬���������Խ�ͷ����ǥ�ϱ����������Ŀ����ԣ��ɼӹ���ϸ˿��Ƭ��3) ǥ���������ʪ�Ժ�������ʹ����п���ļ�϶����ԣ��Ӷ�ʹ�ķѵ�ǥ�������ͣ�������ǥ���ӹ�ʱ�п���Ĺ��4) ������ϵǥ������ѹ�ͣ��ʺ����ǥ���������Ӧ��������ǥ����������;���࣬�ٻ�ǥ�Ͽɷ�Ϊ���ӹ�ҵ�ּ�ǥ����ǥ�ϡ�����������ǥ�Ϻ;߱��������ܵ�ǥ�����ࡣ
2.1 ���ӹ�ҵ�ּ�ǥ����ǥ��
����ͼ������֪��Pd-Ag��Pd-Au���γ����������壬���ɷֺϽ��Һ���ߵ��¶ȼ����С�����ֳɷֺϽ���γɽϿ��¶�����ϵ��ǥ�ϣ��ۻ��¶�������800~1420 ���Pd-Ag-Cuϵ��Pd-Agϵ��Pd-AuϵΪ���͵Ķ༶ǥ����ǥ��[43]�����4���У����Ǿ������õ�ǥ���������ܡ���ʴ�Ժ����ԣ���Ӳ�Ⱥ�ǿ�Ȳ��ߣ�������������ǿ��ǥ����ͷ��ǥ�ϣ�ͨ��ʱЧ�����������Ӳ�ȡ�
��4 ���÷ּ�ǥ�����ٻ�ǥ��
Table 4 Commonly used Pd-based solders for grade brazing
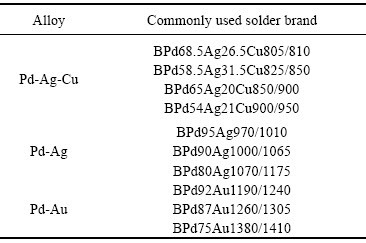
2.2 ����������ǥ��
��������ǥ��Ҫ�������õĸ���ǿ�ȺͿ�������ԣ�һ������ǥ�����¹���������Ͻ�ͨ����Ni��MnԪ�أ����۵���1000~1237 ���Pd-Ni��Pd-Ni-Mn��Pd-Ag-Mn��Pd-Cu-Ni-MnΪ�����������5���乤���¶ȿɴ�650~850 �棬��Ҫ���ڽ�����ʯī���մɵ��νӡ�ǥ��Mo��Ti��W��Zr��Nb�ȸ��½������Ͻ𡢺��ӱ��������γ���������Ĥ�ĺ�Ti��Cr�Ͻ��Լ�ȼ�����ֻ�ҶƬ���㷺�漰���պ��졢ұ�𡢻��������ܵȹ�ҵ�ĸ��¼�����[44-45]������Pd-Ni-Mnǥ�ϻ��ɵֿ��ƺ��Ƽع�����ʴ����Mn����������Mnǥ�������ڱ�������(�⡢벼����������)�����������ǥ��[46]��
��5 ���ø����������ٻ�ǥ��
Table 5 Commonly used Pd based high temperature heat- resistant solders
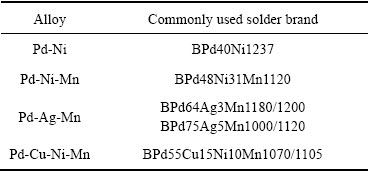
2.3 �߱��������ܵ�ǥ��
���������й�������;����ϵǥ��ר�������ܶ࣬����Pd-0.2Ga-6In-0.3Ag-7Zn-86.4Snǥ�Ͼ��и߽ྻ�ȡ����۵���ص㣬��Ϊǥ������п�Ͻ�ǥ��ʱ��������ʪ��ǿ�������ڼ������ס�ɳ�ۡ����ӵ�ǥ��ȱ�ݣ�ǥ��ǿ�ȸߵ��ص�[47]��Pd-0.7Nb-5Ni-3.5Co- 1.5Mn-73.3Ag��Ԫ�Ͻ�ǥ�����������������ջ�����ǥ������֡��������������ܻ����ºϽ�Ľ�ͷǿ�ȸߣ�ǥ���ͷ���¿���ǿ�ȴ�400~600 MPa��ͬʱ��ǥ����ͷ�нϸߵĸ���ǿ�ȣ�600 ��ʱ��ǥ���ͷ����ǿ���Դﵽ220~260 MPa[48]����ͬ������ȵ�����ϵ�Ͻ�Ҳ��������ǥ������[49]��Pd-5Ni���ް�����ǿ��ɫ���������ʺ�ǥ����Ʒǥ�ϣ�����Ҳ�Ǻܺõ�����ԭ���ϣ�Pd-68Ni-9Ti���ۡ����㼫��ӽ�Pd-40Ni�ģ��ʺ��������մ�-�����������մ�-�����մɵ�ǥ�Ӳ��ϣ�Pd-20Ni���л���Ⱦ����ǿ���縯ʴ����С���ɺ��ӵ�Ӵ����ϣ����⣬Pd-7.5Cu-5.5In-84.6Ag-0.2Liǥ���ȵ��Խϵ�[50]��Pd-Si-Ni-Crǥ�Ͽ����ڸ��������µ�ʯī���ϣ�����ü�����ӣ�Pd-Ni-Siǥ���Է�ĩ��������̬ʹ�ã���1130~1150 ���¶���ǥ����ʴ�ּ����Ͻ𣬿ɻ����ʴ����Ҫ���ǿ��[51]��Pd-Ag-Cu-Niǥ�Ͽ��ν�X����ϵ��봰���ſعܼ����˶��Ͻ�(Ni-Fe-Mn)֧��[52]����Pd-Au-Cr-Niǥ�����������۽�����ϡ�н���Y����ȷ����ͷ��870~982 ��ʱ����400 h�ĸ�ǿ�ȺͿ�������[50]��
3 ����ǥ��
����ǥ����ĿǰӦ����㷺��Ӳǥ�ϣ��������˵��۵㡢���õ���ʪ�Ժ���ɢ�ԡ������Ĺ������ܣ���ǥ�Ϻ�ǥ���ǿ�ȡ���ʴ�Ժ͵�������������ǥ�϶Ծ��ֽ������Ͼ����кܺõ���ʪ�ԣ�������ǥ������֡���̼�֡��ɷ��Ͻ𡢸��ºϽ����ۺϽ�ͭ��ͭ�Ͻ�ȣ��ر������ں��շ������Լ����������������Ҫ�����ǥ���������ں��ա����ӵȹ�ҵ�еõ��㷺��Ӧ�á�Ŀǰ��600~1100 ���۵㷶Χ�ڵ�ǥ����������ǥ��Ϊ�������¶ȿ�ȴ��������ںܶ����������ķּ�ǥ��������ǥ�ϵ���Ҫ�Ͻ���Ԫ��Cu��Zn��Ni��Mn��Sn��Cd��In��Ga��Re��P�ȣ�Cu��Zn������Ҫ�ĺϽ�Ԫ�أ�������Cu�ɽ���Ag���ۻ��¶ȣ��ֲ����γɴ����࣬����Zn�ɽ�һ��������ͭǥ�ϵ��ۻ��¶ȣ�������ǥ�Ͼ����Բ�ͬ������ȵ���ͭ��Ԫϵ����ͭп��Ԫϵ�Ͻ�Ϊ����������Ni��Mn��Sn��Cd��In��Ga��P��Ԫ���������ۻ����Լ���ѧ����Ҫ����ɺϽ�ǥ�ϣ�����Ԫ��Ŀ���࣬�ɽ����Ϊ��Ԫ����Ԫ����Ԫ����Ԫ����ǥ�ϼ��࣬��������������һ���۵���960 ���ǥ�ϡ�
��������ǥ���о�Ӧ����ϵ�Ѿ��ܳ��죬�������о��ɹ��ḻ���˴����ٶ�����ϸ������ܡ���������ǥ���ƺſɲο�GB/T 18762��2002�����������ǥ�ϡ�[53]��GB/T 10046��2008����ǥ�ϡ�[54]�����ڹ�������ǥ�ϵ��о���״����չ���ƣ��ر������5~10�������Ga��In��REԪ�ض���Ag-Cu-ZnӰ����о����ɲο�����[55-58]��
4 �����ǥ�ϵ�ǰ���ڵ�����
�����ǥ���������죬����Ȼ��һЩ����֮��������Ӧ�÷�չ��Ŀǰ�з���Ӧ���г��ֵ�����༯�������¼������棺
1) �ӹ����ܲΪ�˽���ǥ���ۻ��¶ȣ�ͨ��ѡ�����Ͻ���ϵ�м���Sn��In��Ge��Si �ȵ��۵���Ԫ������Щ��Ԫ��ǥ����֯�����γɴ����м仯�����࣬�ӹ����ܣ����ڲ������ơ������εȴ�ͳѹ���ӹ������Ʊ��������˿�Ļ�Ƭ�ģ��������۵���600 �����µ��е��½��ǥ�Ϻ�400~600 �����������ǥ�ϱ���ͻ��[59-60]��
2) ǥ�ϳɱ��ߡ��ҹ��������Դϡȱ��������������۸���ǽڽ��������ֹ������ǥ���й����Ԫ����ռ������ʹ�ɱ������������ɱ����ش���������з���ʹ�ú��ƹ�[61]��
3) ���¶���ȾԪ�ء�����ǥ���о�������Cd�����ǥ������[62-64]����������ǥ�����������ǥ�������Ժͼ��������Զ�Ӧ�ù㷺������������������������У��������ؽ���Ԫ�أ�������������Σ��������ǥ�ϵ�������ʹ���Ѿ�����Ϊȫ���Ի������⣬����ǥ�ϵ��з�������Ҫ����ʵ���弰������[65]��
4) ����ɿ��Բ����뼰ʵ����Է����ѡ����Ӳ�Ʒ�����ͻ����������ͼ��ɻ�����չ���Ժ���Ŀɿ����������Ҫ���о�����������������ǥ�Ϻ���͵�·��֮����ڲ���������ϵ�����죬���ڵ��Ӳ�Ʒ���ڵĿ�-�أ������ṹ�л���ֽ�����¶ȳ�����ͷ�ײ���������Ӧ��ƣ�ͣ��������Ա��Σ����������Ѷ���ʹ����ʧЧ������ʹ���Ӳ�ƷʧЧ�����ǰ��������ǥ�����ڵ�����ǥ�����������ǥ����ʵ��Ӧ�������ٵ�������[66-67]���������۵���450 �����µĵ��ӹ�ҵ�ý�������ǥ��ͻ�������⣬����ߴ�Խ��ԽС���������ú�����۹����е�Ӧ��Ӧ��ͷ�������ɿ��Լ���ʧЧ����������µ���ս��
5) �������ݿ��ѷ�������Ԫ������������Ϊ�о����ӽ�ͷӦ��Ӧ���ϵ����ʾ������ʪ��������������ʧЧ���ơ���������ɿ��ԡ�Ԥ�⺸��ƣ�������������Ĺ���[68]����ǥ������Ԫģ������Ľ��б�������Ӧǥ�ϻ������ݿ��֧�š�Ŀǰ��������Թ������ǥ�ϻ������ݿ���о����������١�
6) �ɷ�ƫ����������������Au-Snǥ�ϵijɷ�ƫ�����⡢�����������⣬��ʹ����һЩ��Ҫ������ҵ��һЩ��Ҫ��Ʒ����Ȼ���ڹ����Au-Snǥ�ϣ���ȷ���ܹ��ڡ���ǥ���������½���ǥ��[69]�����⣬Ni�����ϸߵ�Au-Ni��Ag-Cu-Ni��������ɷ�ƫ��[70-71]��Ag��Cu�����ߵĹ����ǥ�ϱ�����������������[72]��
5 �����ǥ�ϵ�δ����չ����
�����߷����������ǥ��δ����չ������Ҫ���������¼������棬������Ѱ���ִ�����Ľ��˼·�Լ���߹����ǥ��Ʒ�ʡ��ۺ����ܵķ�����
1) ̽������IJ����Ʊ����ա���������о��ɹ��а������·�������״��ճ��״�Ʊ������ſؽ���͵�Ƴ�����[73]���Ȼ�е�ӹ�������������+��������м��˻�[74]�����㸴��+��ɢ�Ͻ�(D-KH��)[75]���������̷�[31]������������������㷨[76]�ȣ���Щ�Ʊ����նԹ��������ǥ�ϼӹ������л����������ã�������Ч�ʵ͡��ɱ��ߡ�����������Ӱ��ǥ������͵ȵ�һ������ʹijЩ�����Ʊ�����Ӧ�ú��ƹ��ܵ����ƣ��д���һ����������ǥ���Ʊ����ռ�̽���µ������Ʊ����ա�
2) ��ƿ����µĶ�Ԫ�Ͻ���ϵǥ�ϡ��Ӷ�Ԫ���Ƕ���ƺϽ�ɷ֣����Dz���4������4�����ϵ�Ԫ����ɶ�Ԫǥ�ϣ��ۺ�Э����Ԫ�ص����ã����ͳɱ���ͬʱʹǥ�Ͼ߱����õ�ǥ�����ܺͼӹ����ܣ��������еĹ����ǥ�ϣ�ʹ��Ӧ�ø��ӹ㷺��
3) �Ͻ�����������Ͻ���������Ԫ�أ��ںϽ�����������ã�����ǥ����֯�����ܣ������ɷ�ƫ�����������ǥ��Ʒ�ʼ��ۺ����ܵ�һ�ּ���֮��Ч�ķ��������ӵĺϽ�Ԫ�ؿ���Ϊϡ��Ԫ��(La��Ce��Er��Y��Pr��Nd��Lu)�Լ�Ga��In ��Co��Bi��Cr�ȣ��ر���ϡ��Ԫ���ڸ���ǥ�������������֯�����ǥ���뺸�ӽ�ͷ�����Լ�����ɿ��Եȷ�����о����ܹ������о��߹�ע��
4) ���ӿ�����ǿ���γɸ���ǥ�ϡ�ǿ����������ǥ�Ͻ�ϼ��γɸ���ǥ�ϣ�ǿ��������Ӳ��������ظı�ԭǥ�ϻ�����۵㡢��ʪ�Եȹ������ܣ�ǥ���ڲ��ܱ����ȶ�������֯�����ȱ��Σ����Ƽ��ֲ��Ͻ������ϵ�ijЩ���㣬��������ߺ�������(�ر�����ƣ�����ܼ��������)��ʹ����������Ч������������ǿ����Ҫ�й���ǿ������ɢǿ�����ֻ��ƣ�����ߺϽ����ܵ���Ҫ�ֶΡ�������ǿ����Ҫ�����������Ľ���/�ǽ����Լ���ص�������ȡ�������Fe��������Cu6Sn5����������Mo����������Al2O3����������TiO2������̼����(CNTs)�ȡ�
5) ǥ�������ģ�⼼�������ݿ��������ǥ�����������ֻ������ܻ���ģ�⻯����չ�����ܿ��ơ����ӽ�ͷƣ������������ɿ��Ժ�ǥ���������о���Ϊ��ע�Ľ��㡣ǥ����ͷ�¶ȳ���Ӧ����������Ԫģ�⡢��Һ������ʪ��Ϊ�ķ��Ӷ���ѧģ�⡢��ǥ��Һ����չ�����������ٶȳ�����ֵģ��ȶ��ڲ��ü��������ǥ����ͷ��ơ���ʾ������ʪ�����Ⱦ�����Ҫ������[77]����ģ�⼼����չ���Ӧ���������о�ѧ��Ӧ���ּ�ǿ�����ǥ�ϻ������ݿ�Ŀ�����
6) ƥ���������о����������������ܸ���ǥ����ʪ�ԡ�����ǥ���������ͳɱ�������ǥ�ϱ������������ǥ��ǥ�����ܺͿ������Ե�����ŵ㣬���ڸ����������У�����ϴ���������гɱ��͡������������ڶ̡������Ѻõ��ŵ㣬��������δ����չ���ƣ���ˣ�̽��������ǥ����ƥ�������ϴ�������������ǥ�Ϲ��������м����洦��
7) �µ�ǥ�����ա�̽�����糬��������ǥ��[78]�����屣���绡ǥ��[79]��������-���⸴��ǥ��[80]�������ǥ���¼���Ϊʵ�ַ���պ���ǥ�������²��ϵ�Һ�������ṩ����ӱ�Ľ��˼·��
6 ����
����������֪���ͳɱ������������Ʊ��������ܡ��߿ɿ��Ժ������ܳ�Ϊ�������ǥ�ϺϽ����Ƶ���Ҫ�����������ͺϽ�ǥ�ϵ����������Ӧ�ۺϿ������ܡ��ɱ��������й����豸�ļ����Լ����Ч�档
�����������������ǥ�ϲ���ӿ�֣�����������δ֪���صĴ��ڣ�����ǥ����Ȼ��Ҫ����ʵ�����ݻ��ۣ����ܱ�֤ǥ����Ӧ���ƹ�ʱ�ĸ�Ʒ�ʺ߿ɿ��ԡ�ͬʱ������ǥ�ϵ��з�Ӧ������ʹ�û�����ҵ��Ʒ���ϣ�ͨ����������Ϸ������ܵõ���ʵ�ɿ������ݣ�Ϊ�������ǥ�ϵ�Ӧ�ú��ƹ��ṩ����֧�š�
REFERENCES
[1] ERDOGAN A T, NALBANTGIL D, ULKUR F, SAHIN F. Metal ion release from silver soldering and laser welding caused by different types of mouthwash[J]. The Angle orthodontist, 2015, 85(4): 665-672.
[2] HAMMAD A E. Investigation of microstructure and mechanical properties of novel Sn-0.5Ag-0.7Cu solders containing small amount of Ni[J]. Materials and Design, 2013, 50(9): 108-116.
[3] KIM Y K, PARK S, KIM K S, LEE M H. The effects of adding elements of zinc and magnesium on Ag-Cu eutectic alloy for warming acupuncture[J].Evidence-based Complementary and Alternative Medicine, 2013, 27(7): 4-6.
[4] YAMAZAKI T, SUZUMURA A. Reaction products at brazed interface between Ag-Cu-V filler metal and diamond (111)[J]. Journal of Materials Science, 2006, 41(19): 6409-6416.
[5] LIU Yan, HUANG Zheng-ren, LIU Xue-jian, YUAN Ming. Brazing of SiC ceramics using Ag-Cu-In-Ti filler metal[J].Journal of Inorganic Materials, 2009, 24(4): 817-820.
[6] SONG H G, AHH J P, MORRIS J W. The microstructure of eutectic Au-Sn solder bumps on Cu/electroless Ni/Au[J]. Journal of Electronic Materials, 2001, 30(9): 1083-1087.
[7] JULIAN T, CLAUDIA P S, HECTOR S. Manufacture of Au-Si alloys for use in the soldering of gold alloys[J]. Welding International, 2015, 29(8): 594-599.
[8] ZHU Xue-wei, WANG Ri-chu, PENG Chao-qun, WEI Xiao-feng, PENG Jian. Reactions and mechanical properties between AuSn20 solders and metalized Al-Si alloys for electronic packaging application[J]. Journal of Materials Science: Materials in Electronics, 2014, 25(2): 742-748.
[9] WANG Chao-hong, LI Kuan-ting. Study of electromigration resistance of (Pd,Ni)Sn4 phase in lead-free solder joints[J]. Journal of Alloys and Compounds, 2016, 654(2): 546-553.
[10] LIU Hui-jie, FENG Ji-cai. Vacuum brazing TiAl-based alloy to 40Cr steel using Ag-Cu-Zn filler metal[J]. Journal of Materials Science Letters, 2002, 21(1): 9-10.
[11] ¬����, Ѧ�ɰ�, �� ��, ������. Ag-Cu-Znϵǥ�ϵ��о���״����չ����[J]. ����, 2008(10): 13-19.
LU Fang-yan, XUE Song-bai, ZHANG Liang, LAI Zhong-min. Research status and prospect of Ag-Cu-Zn series brazing filler metals[J]. Welding & Joining, 2008(10): 13-19.
[12] ������, λ ��, ������. ���ӷ�װ�õ���������Ǧǥ�ϵ��о���Ӧ�ý�չ[J]. ���Ӽ���, 2011, 40(2): 1-5.
YIN Li-meng, WEI Song, LI Wang-yun. Research and application progress in low-Ag lead-free solder for electronic packaging[J]. Welding Technology, 2011, 40(2): 1-5.
[13] COLLINS M N, DALTON E, PUNCH J. Microstructural influences on thermomechanical fatigue behaviour of third generation high Ag content Pb-Free solder alloys[J]. Journal of Alloys & Compounds, 2016, 688: 164-170.
[14] ����, ��־��, ���Ҿ�, ���Ļ�, ������. ��������Au-19.25Ag-12.80Geǥ�ϱ���������֯�뺸������[J]. ϡ�н��������빤��, 2012, 41(3): 442-446.
CUI Da-tian, WANG Zhi-fa, HU Zhong-ju, LIU Wen-hui, LIU Long-fei. Microstructure and welding properties of single-roller melt spinned Au-19.25Ag-12.80Ge solder ribbon[J]. Rare Metal Materials and Engineering, 2012, 41(3): 442-446.
[15] лԪ��,�� ��,��־��,������,��С��,����ɽ. Pd������ǥ�϶�SiC�մɵ���ʪ�о�[J]. ϡ�н���, 2007, 31(4): 507-509.
XIE Yuan-feng,  Hong, KANG Zhi-jun, CHU Jian-xin, ZHANG Xiao-yong, WANG Lin-shan. Wetting mechanism of Pd based active brazing alloys on SiC ceramic[J]. Rare Metals, 2007, 31(4): 507-509.
Hong, KANG Zhi-jun, CHU Jian-xin, ZHANG Xiao-yong, WANG Lin-shan. Wetting mechanism of Pd based active brazing alloys on SiC ceramic[J]. Rare Metals, 2007, 31(4): 507-509.
[16] VIVEK C, HO B Y, GAO S. Reliability of Au-Ge and Au-Si eutectic solder alloys for high-temperature electronics[J]. Journal of Electronic Materials, 2012, 41(8): 2107-2117.
[17] LANG Feng-qun, HIROSHI N, HIROSHI Y. Soldering of non-wettable Al electrode using Au-based solder[J]. Gold Bulletin, 2014, 47(1/2): 109-118.
[18] WEN Ming, TANG An-qiang, HE Qi-liu. Fabrication and microstructures of sequentially electroplated Sn-rich Au-Sn alloy solders[J].Journal of Electronic Materials, 2008, 37(6): 837-844.
[19] VIVEK C, JOHN H, JESPER H H. Development of gold based solder candidates for flip chip assembly[J]. Microelectronics Reliability, 2009, 49(1): 323-330.
[20] LEE S H, HWANG G S. Structure, energetics and bonding of amorphous Au-Si alloys[J]. The Journal of Chemical Physics, 2007, 127(22): 2247-2249.
[21] ������, �� ��, �� ��, �� ��, �� ΰ, ������, ������, �� ��. ���ӹ�ҵ�ù�����е��´���ǥ���о���չ[J]. �����, 2014, 35(3): 72-73.
ZHANG LI-guang, XU Kun, ZHAO Ming, LIU Yi, LI Wei, LUO Xi-ming, XU Yong-tao, HAO Bin. Research progress on precious metals medium-low temperature brittle filler metals for electronic industry[J]. Precious Metals, 2014, 35(3): 72-73.
[22] OPPERMANN H, HUTTE M, KLEIN M. Flip chip reliability of GaAs on Si thin film substrates using AuSn solder bumps[J]. Materials, Technology and Reliability of Advanced Interconnects, 2005, 863(35): 327-338.
[23] KIM S, KIM K S, KATSUAKI S. Interfacial reactions of Si die attachment with Zn-Sn and Au-20Sn high temperature lead-free solderson Cu substrates[J].Journal of Electronic Materials, 2009, 38(6): 873-883.
[24] SONG H G, MORRIS J W, MCCORMACK M T. The microstructure of ultrafine eutectic Au-Sn solder joints on Cu[J]. Journal of Electronic Materials, 2000, 29(8): 1038-1046.
[25] LEINENBACH C, VALENZA F, GIURANNO D, ELSENER H R, JIN S, NOVAKOVIC R. Wetting and soldering behavior of eutectic Au-Ge alloy on Cu and Ni substrates[J]. Journal of Electronic Materials, 2011, 40(7): 1533-1541.
[26] LI Ju-zi, ACOFF V L, GONG Xi-bing. Characterization of the brittle mechanism in a Au-Ge microalloy[J]. Gold Bulletin, 2015, 48(1/2): 47-56.
[27] JULIAN T, CLAUDIA P, SERNA G, HECTOR S. Manufacture of Au-Si alloys for use in the soldering of gold alloys[J]. Welding International, 2015, 29(8): 594-599.
[28] PAVLOVA G G, BORO A A. Physicochemical factors of formation of Au-As, Au-Sb and Ag-Sb deposits[J]. Geology of Ore Deposits, 2008, 50(6): 433-444.
[29] HASSAM S, AGREN J, GAUNE E M. Experimental and calculated phase diagram[J]. Metallurgical Transactions A, 1990, 21(7): 1877-1884.
[30] WANG J, LIU Y J, TANG C Y. Thermodynamic description of the Au-Ag-Ge ternary system[J]. Thermo-chimica Acta, 2011, 512(1): 240-246.
[31] ����, ��־��. ������������Au-Ag-Ge�Ͻ𱡴����Ʊ�[J]. �����ȴ���ѧ��, 2010, 31(1): 40-43.
CUI Da-tian, WANG Zhi-fa. Preparation of rapidly solidified new-type An-Ag-Ge alloy ribbon[J]. Transactions of Materials and Heat Treatment, 2010, 31(1): 40-43.
[32] ����, ��־��, �� ��. Au-20.1Ag-2.5Si-2.5Ge��������ǥ�ϵ���֯������[J]. �й���ɫ����ѧ��, 2007, 17(9): 1501-1505.
CUI Da-tian, WANG Zhi-fa, ZHOU Jun. Microstructure and properties of new type Au-20.1Ag-2.5Si-2.5Ge medium- temperature solder[J]. The Chinese Journal of Nonferrous Metals, 2007, 17(9): 1501-1505.
[33] �����, �µ�Ȩ, �� ΰ. �������½��ǥ���о�[J]. �����, 2010, 31(2): 41-48.
LIU Ze-guang, CHEN Deng-quan, LI Wei. Research of new mid-temperature solder of Au-based alloy[J]. Precious Metals, 2010, 31(2): 41-48.
[34] CHANG Kuo-chin, CHANG Kuo-ning. Aging study on interfacial microstructure and solder-ball shear strength of a wafer-level chip-size package with Au/Ni metallization on a Cu pad[J].Journal of Electronic Materials, 2004, 33(11): 1373-1380.
[35] BYKOV A, PASTUKHOV E. A calorimetric study of alloy formation in Au-Cu and Au-In systems[J]. Journal of Thermal Analysis and Calorimetry, 2000, 60(3): 845-850.
[36] ANIS Z, PETER B, LUBOV Z, ERIC J C. Growth of Cu-Ni-Sn alloys in Pb free CuSnAg solder/Au-Ni metallization reactions[J]. Mrs Online Proceeding Library, 2000, 652(12): 1120-1124.
[37] YIN Na, QU Wen-qing, YANG Shu-juan, LI Rui, DING Ying. Welding technology of gold alloy[J]. Advanced Materials Research, 2013, 2177(629): 214-219.
[38] KANG U B, KIM Y H. The microstructure characterization of ultrasmall eutectic Bi-Sn solder bumps on Au/Cu/Ti and Au/Ni/Ti under-bump metallization[J].Journal of Electronic Materials, 2004, 33(1): 567-569.
[39] KARAMIS M B, TASDEMIRCI A, NAIR F. Microstructure analysis and discontinuities in the braze zone of copper tubes[J]. Journal of Materials Processing Technology, 2003, 45(4): 302-312.
[40] KIM K S, RYU K W, YU C H, KIM J M. The formation and growth of intermetallic compounds and shear strength at Sn-Zn solder/Au-Ni-Cu interfaces[J]. Microelectronics Reliability, 2005, 45(22): 678-681.
[41] OKAMOTO H, CHAKRABARTI D J, LAUGHLIN D E, MASSAl SKI T B. The Au-Cu(gold-copper) system[J]. Bull Alloy Phase Diagram, 1987, 8(5): 454-473.
[42] OKAMOTO H. Au-In (gold-indium)[J]. Journal of Phase Equilibria and Diffusion, 2004, 25(2): 197-198.
[43] SONWANE C G, WILCOX J, MA Yi-hua. Achieving optimum hydrogen permeability in PdAg and PdAu alloys[J].The Journal of Chemical Physics, 2006, 125(18): 128-130.
[44] HASHIBA M, SHINMEI W, KAJIHARA M. Kinetics of solid-state reactive diffusion in the (Pd-Ni)/Sn system[J]. Journal of Electronic Materials, 2012, 41(1): 32-43.
[45] VIENNOT S, DALARD F, LISSAC M. Corrosion resistance of cobalt-chromium and palladium-silver alloys used in fixed prosthetic restorations[J].European Journal of Oral Sciences, 2005, 113(1): 178-181.
[46] FLANAGAN T B, LUO S. Thermodynamics of hydrogen solution and hydride formation in Pd-Mn alloys. Disordered alloys and a correlation effect[J].The Journal of Physical Chemistry, 2006, 110(15): 456-459.
[47] �ƿ���, ��ΰ��, �����. һ�ֺ��ٵ���ȱǷ�ྻSn-Znǥ�ϼ����Ʊ�����: �й�, CN104191101 B[P]. 2016-03-23.
HUANG Jun-long, LONG Wei-min, ZHANG Qing-ke. Containing palladium fewer imperfections clean Sn-Zn solder and preparation method: China, CN104191101B[P]. 2016-03-23.
[48] ����Ȫ, �� ǿ, �� ��, �� ��. һ�ֺ�����ٵĸ���ǿ�ȶ�Ԫǥ�ϺϽ�: �й�, CN 102601541 A[P]. 2012-07-25.
YUE Xin-quan, ZHANG Qiang, ZHANG Lei, ZHU Kun. High heat intensity multielement solder alloy containing niobium and palladium: China,CN 102601541A[P]. 2012-07-25.
[49] CHEN Gang, ZHANG Peng, LIU Hong-wei, AMIR K. Analysis of Pd-Ni nanobelts melting process using molecular dynamics simulation[J]. Journal of Nanomaterials, 2013, 10(2): 112-115.
[50] ��Զ��, ������, ������. ��������ϼ�����[J]. �����, 1989, 10(2): 3-6.
NING Yuan-tao, GUO Gen-sheng, LI Yong-nian. Precious metal solder and solder paste[J]. Precious Metals, 1989, 10(2): 3-6.
[51] LEKOVA E, AMBROVIC P, DUHAJ P. Isothermal study of crystallization of Pd-Ni-Si amorphous metallic materials[J]. Journal of Thermal Analysis, 1983, 28(2): 413-419.
[52] SHAHROUZ N, JOHN S, DAVID B. Effects of low Ag additions on the hydrogen permeability of Pd-Cu-Ag hydrogen separation membranes[J]. Journal of Membrane Science, 2014, 451(1): 216-225.
[53] GB/T 18762-2002. ���������ǥ��[S].
GB/T 18762-2002. Filler precious metal and their alloy brazing material[S].
[54] GB/T 10046-2008. ��ǥ��[S].
GB/T 10046-2008. Silver brazing filler metals[S].
[55] MA Chao-li, XUE Song-bai, WANG Bo. Study on novel Ag-Cu-Zn-Sn brazing filler metal bearing Ga[J]. Journal of Alloys & Compounds, 2016, 688: 854-862.
[56] NTASI A, JABBARI Y S A, SILIKAS N, TAWEEL S M A, ZINELIS S. Metallurgical characterization of experimental Ag-based soldering alloys[J]. Saudi Dental Journal, 2014, 26(4): 139-144.
[57] �� ��, Ѧ�ɰ�, ������. Ag-Cu-Znϵǥ�ϵ��о���״[J]. ����, 2014(10): 10-15.
ZHANG Tao, XUE Song-bai, MA Chao-li. Research status of Ag-Cu-Zn based solder[J]. Welding & Joining, 2014(10): 10-15.
[58] ����ƽ, ������, Ѧ�ɰ�, �� ��, ¬����. �Ͻ�Ԫ�ض�Ag-Cu-Znϵǥ��Ӱ����о���״����չ����[J]. �纸��, 2009, 39(11): 1-6.
WANG Xing-ping, LAI Zhong-min, XUE Song-bai, ZHANG Liang, LU Fang-yan. Present situation and development trends of influence of alloying elements on Ag-Cu-Zn brazing filler metals[J]. Electric Welding Machine, 2009, 39(11): 1-6.
[59] �� ��, �� ��, �ź���, �� ��, ������, �� ΰ, ������, �� ��. D-KH���Ʊ�AgCuSn�Ͻ�ǥ�ϵ������о�[J]. �����, 2016, 37(3): 11-17.
ZHAO Ming, XU Kun, ZHANG Hai-long, LIU Yi, LUO Xi-ming, LI Wei, XU Yong-tao, HAO Bin. Properties of AgCuSn solder alloy prepared by D-KH method[J]. Precious Metals, 2016, 37(3): 11-17.
[60] JIN S, DUARTE L I, LEINENBACH C. Experimental study and thermodynamic description of the Au�CCu�CGe system[J]. Journal of Alloys & Compounds, 2014, 588(5): 7-16.
[61] TAKEDE S, FUJII H, KAWAKITA Y, TAHARA S, NAKASHIMA S, KOHARA S. Structure of eutectic alloys of Au with Si and Ge[J].Journal of Alloys & Compounds,2008, 452(1): 149-153.
[62] ������, Ѧ�ɰ�, ������, ���Ļ�, ������. ������ǥ���о���״�뷢չ����[J]. ����, 2007(6): 19-23.
HAN Xian-peng, XUE Song-bai, LAI Zhong-min, GU Wen-hua, GU Li-yong. Research status and prospect of cadmium free silver filler metal for brazing[J]. Welding & Joining, 2007(6): 19-23.
[63] KOTADIA H R, HOWES P D, MANNAN S H. A review: On the development of low melting temperature Pb-free solders[J]. Microelectronics Reliability, 2014, 54(6/7): 1253-1273.
[64] SCHOELLER H, BANSAL S, KNOBLOCH A, SHADDOCK D, CHO J. Effect of alloying elements on the creep behavior of high Pb-based solders[J]. Materials Science & Engineering A, 2011, 528(3): 1063-1070.
[65] ZAHROWSKI J J. Silver solder toxicity? Show me the evidence[J]. American Journal of Orthodontics and Dentofacial Orthopedics, 2011, 140(6): 757-758.
[66] SHNAWAH D A, SABRI M F M, BADUDDIN I A. A review on thermal cycling and drop impact reliability of SAC solder joint in portable electronic products[J]. Microelectronics Reliability, 2012, 52(1): 90-99.
[67] CHOI H, LEE T K, KIM Y. Improved strength of boron-doped Sn-1.0Ag-0.5Cu solder joints under aging conditions[J]. Intermetallics, 2012, 20(1): 155-159.
[68] ZENG Guang, XUE Song-bai, ZHANG Liang, SHENG Zhong, GAO Li-li. Reliability evaluation of SnAgCu/SnAgCuCe solder joints based on finite element simulation and experiments[J]. Soldering & Surface Mount Technology, 2010, 22(4): 57-64.
[69] ΤС��, �� ��, ���ճ�, ����Ⱥ, �� ��. AuSnǥ�ϼ�AuSn/Ni�������֯�����о�[J]. ϡ�н��������빤��, 2013, 42(3): 639-643.
WEI Xiao-feng,WANG Meng,WANG Ri-chu, PENG Chao-qun, FENG Yan. Microstructure and properties of AuSn solder and AuSn/Ni joint[J]. Rare Metal Materials and Engineering, 2013, 42(3): 639-643.
[70] ������, ����÷. Ag-Cu-Ni��������տ��ع��е�Ӧ���о�[J]. ��յ��Ӽ���, 2004(4): 45-48.
WANG Wei-jie, HE Xiao-mei. Study of Ag-Cu-Ni brazing material applied for vacuum interrupter[J]. Vacuum Electronics, 2004(4): 45-48.
[71] LI Fu-quan, WANG Chun-qing. Influence of interfacial reaction between molten SnAgCu solder droplet and Au/Ni/Cu pad on IMC evolution[J]. Transactions of Nonferrous Metals Society of China, 2006, 16(1): 18-22.
[72] �� ��. ���ϺϽ�����ۻ������е���������[J]. ����������ұ��, 2012(4): 3-6.
WU Xin. Oxidation analysis on the melting process of solder alloy powder[J]. Metal Materials and Metallurgy Engineering, 2012(4): 3-6.
[73] �� ��, ����ѩ, �� ��. �绯ѧ�Ʊ������Ͻ�Ĥ�����о�[J]. ����ѧ, 2010, 40(3): 430-433.
LIU Xin, HU Li-xue, LUO Chi. Study on AuSn alloy thin-film technology using electrochemistry[J]. Microelectronics, 2010, 40(3): 430-433.
[74] HOSKING F M, STEPHENS J J, REJENT J A. Intermediate temperature joining of dissimilar metals[J]. Welding Journal, 1999, 78(5): 127-136.
[75] �� ��, �� ��, �ź���. D-KH�������ڹ����ǥ���Ʊ��е�Ӧ��[J]. �����, 2015, 36(4): 81-87.
ZHAO Ming, XU Kun, ZHANG Hai-long. D-KH method and its application in preparation of precious metal-based brittle solder alloys[J]. Precious Metals, 2015, 36(4): 81-87.
[76] �߹㴺, �� ��, �� ��. �������ϳ��������Ʒۼ����������о�[J]. ���ӹ��ռ���, 2013, 34(1): 18-21.
NI Guang-chun, CHEN Xu, ZHOU Jian. Ultrasonic atomization of low Ag lead-free solder and properties of solder paste[J]. Electronics Process Technology, 2013, 34(1): 18-21.
[77] DUTKA V A. Computer modeling of temperature field formation in a carbide cutter during its induction brazing and quenching[J].Journal of Superhard Materials, 2008, 30(2): 128-132.
[78] ZHANG Ke-ke, ZHANG Xiao-jiao, QIU Ran-feng. The combined effects of ultrasonic wave and electric field on the microstructure and properties of Sn2.5Ag0.7Cu0.1RE/Cu soldered joints[J]. Journal of Materials Science: Materials in Electronics, 2014, 25(4): 1681-1686.
[79] MIDDELDORF K. Trends in joining technology=production, value added and employment by joining[R]. Germany: DVS (German Welding Society), 2012.
[80] �� ��, WOLF G T, ����, ���ڻ�, ��С��. ��Ʒ�ʸ߿ɿ���ǥ�ϵļ�����չ��Ӧ��[J]. ����ѧ��, 2014, 35(4): 108-112.
LI Hong, WOLF G T, LI Zhuo-xin, FENG Zong-hui, MAI Xiao-bo. Development and application of high quality and high relia-bility brazing filler materials[J]. Transactions of the China Welding Institution, 2014, 35(4): 108-112.
Review of gold/palladium based precious metal solders
FANG Ji-heng, XIE Ming, ZHANG Ji-ming, TIAN Juan-juan, CHEN Jing-hong, HU Jie-qiong
(Kunming Institute of Precious Metals, State Key Laboratory of Advanced Technologies for Comprehensive Utilization of Platinum Metals, Kunming 650106, China)
Abstract: Precious metal solders occupy an important position in the electronics industry, microelectronic packaging, multi-stage vacuum brazing, high temperature technology, jewelry manufacturing, aerospace industry and other fields, the development and applications of gold/palladium based solders is the focus both home and abroad. The low/medium/high temperature gold-based solders which were commonly used in industrial production, military and civil fields were described particularly, as well as the presentation of the palladium-based brazing filler metals for the electronics industry classification brazing, high temperature resistant and special functions, besides that, the characteristics, properties and applications of each series of solders were summarized, and there is a brief overview for the properties of silver-based brazing filler metals. Problems still exist in poor processing performance, high economic costs, toxic elements pollution��lack of basic database of simulation, low reliability of solder joint etc. Accordingly, the future trend of precious metal solders was prospected and solutions to existing problems were seeked mainly from the preparation process, the micro-alloying, adding strengthening phase, matching solder flux, computer simulation and other aspects, which also provides a basic support for the development, application and promotion of precious metal solders.
Key words: precious metal solder; brazing property; application; brittle intermediate compound
Foundation item: Projects(U1302272, 51267007) supported by the National Natural Science Foundation of China; Project(2013DC016) supported by the Yunnan Province Institute of Technology Development, China; Project(2015IB012) supported by the Yunnan Provincial Scientific and Technological Cooperation Project, China; Project(2015IC046) supported by the Academician Expert Workstation Project, China
Received date: 2016-06-28; Accepted date: 2016-11-11
Corresponding author: XIE Ming; Tel: +86-871-8328841��E-mail: powder@ipm.com.cn
(�༭ �� ��)
������Ŀ��������Ȼ��ѧ����������Ŀ(U1302272��51267007)������ʡԺ����������ר��(2013DC016)������ʡԺʡУ�Ƽ�������Ŀ(2015IB012)��Ժʿר�ҹ���վ��Ŀ(2015IC046)
�ո����ڣ�2016-06-28�������ڣ�2016-11-11
ͨ�����ߣ�л �����о�Ա����ʿ���绰��0871-8328841��E-mail: powder@ipm.com.cn
ժ Ҫ�������ǥ���ڵ��ӹ�ҵ�����ӷ�װ����ն༶ǥ�������¼�������Ʒ����ҵ�����պ�����������ռ����Ҫ��λ����/�ٻ������ǥ�ϵ��з���Ӧ��һֱ�ǹ������о����ȵ㡣��ϸ���ܹ�ҵ���������������õ������г��õĵ�/��/���½��ǥ�ϣ����ӹ�ҵ�ּ�ǥ���á����������ͺ;߱��������ܵ��ٻ�ǥ�ϣ��ܽ����ϵ��ǥ���ص㡢ǥ�����ܼ���;������������ǥ�����ԡ��ۺ����������ǥ�Ϸ�չ��Ӧ���г��ֵļӹ����ܲ���óɱ��ߡ����¶���ȾԪ�ء�����ɿ��Բ����뼰ģ��������ݿ��ѷ������⣬���Ʊ����ա��Ͻ�����ǿ���ࡢƥ����������ǥ�ϼ����ģ��ȷ���չ�������ǥ��δ����չ���ƣ�������Ѱ����ִ�����Ľ����ʩ��Ϊ�����ǥ�ϵĿ�����Ӧ�ü��ƹ��ṩ����֧�š�
[11] ¬����, Ѧ�ɰ�, �� ��, ������. Ag-Cu-Znϵǥ�ϵ��о���״����չ����[J]. ����, 2008(10): 13-19.
[12] ������, λ ��, ������. ���ӷ�װ�õ���������Ǧǥ�ϵ��о���Ӧ�ý�չ[J]. ���Ӽ���, 2011, 40(2): 1-5.
[31] ����, ��־��. ������������Au-Ag-Ge�Ͻ𱡴����Ʊ�[J]. �����ȴ���ѧ��, 2010, 31(1): 40-43.
[33] �����, �µ�Ȩ, �� ΰ. �������½��ǥ���о�[J]. �����, 2010, 31(2): 41-48.
[47] �ƿ���, ��ΰ��, �����. һ�ֺ��ٵ���ȱǷ�ྻSn-Znǥ�ϼ����Ʊ�����: �й�, CN104191101 B[P]. 2016-03-23.
[48] ����Ȫ, �� ǿ, �� ��, �� ��. һ�ֺ�����ٵĸ���ǿ�ȶ�Ԫǥ�ϺϽ�: �й�, CN 102601541 A[P]. 2012-07-25.
[50] ��Զ��, ������, ������. ��������ϼ�����[J]. �����, 1989, 10(2): 3-6.
[53] GB/T 18762-2002. ���������ǥ��[S].
GB/T 18762-2002. Filler precious metal and their alloy brazing material[S].
[54] GB/T 10046-2008. ��ǥ��[S].
GB/T 10046-2008. Silver brazing filler metals[S].
[57] �� ��, Ѧ�ɰ�, ������. Ag-Cu-Znϵǥ�ϵ��о���״[J]. ����, 2014(10): 10-15.
[62] ������, Ѧ�ɰ�, ������, ���Ļ�, ������. ������ǥ���о���״�뷢չ����[J]. ����, 2007(6): 19-23.
[70] ������, ����÷. Ag-Cu-Ni��������տ��ع��е�Ӧ���о�[J]. ��յ��Ӽ���, 2004(4): 45-48.
[72] �� ��. ���ϺϽ�����ۻ������е���������[J]. ����������ұ��, 2012(4): 3-6.
[73] �� ��, ����ѩ, �� ��. �绯ѧ�Ʊ������Ͻ�Ĥ�����о�[J]. ����ѧ, 2010, 40(3): 430-433.
[75] �� ��, �� ��, �ź���. D-KH�������ڹ����ǥ���Ʊ��е�Ӧ��[J]. �����, 2015, 36(4): 81-87.
[76] �߹㴺, �� ��, �� ��. �������ϳ��������Ʒۼ����������о�[J]. ���ӹ��ռ���, 2013, 34(1): 18-21.


