文章编号:1004-0609(2008)03-0449-08
Sn/Cu接头界面金属间化合物层的
生长及强磁场的影响
程从前,赵 杰,徐 洋,许富民,杨 朋
(1. 大连理工大学 三束材料改性国家重点实验室,大连 116024;
2. 大连理工大学 材料科学与工程学院,大连 116024)
摘 要:钎焊和扩散焊制备的Sn/Cu接头在无磁场下不同温度时效,研究接头界面处金属间化合物(IMC)层的生长行为。结果表明:两种接头界面IMC层在时效初始时刻的横截面和形貌均不同,在时效过程中的生长行为类似,钎焊和扩散焊接头界面IMC层的生长激活能分别为116和94 kJ/mol。为研究强磁场对界面IMC层生长行为的影响,两种试样在190 ℃、磁场强度为8 T时效。实验结果表明:两种接头界面IMC层的生长动力学相同,但晶粒形貌和晶体取向差别明显。
关键词:Sn/Cu;金属间化合物层;时效;强磁场
中图分类号:TG 425 1 文献标识码:A
Growth of interfacial intermetallic compound layers in
Sn/Cu joints during aging and effect of high magnetic field
CHENG Cong-qian, ZHAO Jie, XU Yang, XU Fu-min, YANG Peng
(1. State Key Laboratory of Materials Modification by Laser, Ion and Electron Beams,
Dalian University of Technology, Dalian 116024, China;
2. School of Materials Science and Engineering, Dalian University of Technology, Dalian 116024, China)
Abstract: The growth behaviors of interfacial intermetallic compound (IMC) layers in soldered and diffusion bonding Sn/Cu joints during aging and the effect of high magnetic field were investigated. The results show that the cross sections and morphologies of IMC layers in soldered and diffusion-bonding joints before aging are different. The growth behaviors of these two IMC layers are similar when these joints are aged without magnetic field. The growth activation energies for the two IMC layers are 116 and 94 kJ/mol, respectively. In order to study the effect of high magnetic field on the growth behavior of IMC layers, the samples were aged at 190℃ in 8 T of high magnetic field strength. The results show that there exit unobvious difference between the growth kinetics of IMC layers in the two joints. However, the morphologies and orientations of IMC layers in these two joints change by high magnetic field.
Keywords: Sn/Cu; intermetallic compound layers; aging; high magnetic field
钎焊和扩散焊是材料连接的两种基本方法。利用钎焊和扩散焊时,在两种材料界面处产生金属间化合物(IMC)层来实现连接。近年来,随着电子工业无铅化的要求,研究以Sn为基体的无铅钎料与基板的界面反应日益增多[1-4]。到目前为止,虽然Sn基钎料和Cu板间的界面反应及其接头时效的研究比较多[5-9],然而还有很多数据需要完善。同时,现代电子封装向小尺寸及高密度方向发展,促进了许多先进连接技术的产生。利用这些不同连接技术得到的接头界面IMC的初始形貌和厚度都不同。然而,目前接头初始条件对后续时效过程中IMC层生长的影响并不清楚。了解不同接头在时效过程中界面IMC层的生长行为,对于接头可靠性方面有重要意义。
另一方面,接头在使用过程中可能会受到热、应力、电及磁等外场的影响,化合物层的生长会因外场的改变而变化[10-11]。研究强磁场下金属间化合物层的生长行为有利于深入了解强磁场下的扩散行为和界面迁移。然而,目前这方面的研究报道并不多。Mg-Al扩散偶在交变磁场下时效所形成的两种界面金属间化合物层均比无磁场下的化合物层厚[12]。稳恒强磁场加快了Al-Cu扩散偶金属间化合物的生长[13]。在以前的工作中,研究了强磁场下Sn3Ag0.5Cu/Cu在固相时效过程中化合物层的生长,结果表明磁场加快了化合物层的生长,且不同方向化合物层的生长速率不同[14]。因此,本文作者选择电子封装中典型的Sn/Cu接头,对比研究了通过扩散焊和钎焊制备的Sn/Cu接头在无磁场和强磁场下时效,界面IMC层的生长动力学、形貌以及晶体取向。
1 实验材料及方法
实验采用纯度为99.95%的锡块和99.9%的铜片,在制备钎焊Sn/Cu接头过程中,铜片厚度为0.5 mm。锡块在500 ℃中保温3~4 h、浇注并线切割成d7 mm×2 mm的锡片,锡片去油污、细磨、清洗及吹干,采用中性活性松香焊剂(RMA)把锡片和去除掉氧化膜后的铜片放在一起于280 ℃钎焊60 s,得到时效前的钎焊Sn/Cu接头。Sn/Cu钎焊接头在70、120及170 ℃等温时效,时效时间最长为500 h。
在制备扩散焊Sn/Cu接头过程中,铜片的厚度为1 mm。将Sn块放在500 ℃保温3~4 h,然后浇注到石墨模具中制成Sn棒并切割成d20 mm×5 mm的Sn片。将Sn片两面都打磨和抛光后,用5%HCl水溶液除去表面氧化膜,水洗再用酒精清洗、吹干。将两片铜片的抛光面和Sn片在微小压力下紧密结合,形成三明治结构,在200 ℃下保温20 h进行扩散焊接。试样取出后空冷,用金刚石切割刀锯将同一个扩散焊接头切割成大小均匀的小试样以便于等温时效,时效温度为120、150、170、190和205 ℃,最长时间为500 h。强磁场下Sn/Cu接头的等温时效实验在JMT-100超导强磁场装置中进行,该装置能产生0~10 T的直流稳恒磁场,本研究所用磁场强度为8 T,时效温度为 (190±1) ℃,时效时间为4、9、16、25和50 h。
时效后的接头试样经镶样、磨光并用5%HNO3-2%HCl-93%CH3OH溶液腐蚀后,采用JSM-5600LV型扫描电子显微镜(SEM)观察横截面形貌,并采用能谱仪(EDX)分析界面IMC层的成分。采用Q500IW图像分析仪测定IMC层截面的面积,然后除以总长度,得到IMC层的平均厚度。每个试样的厚度为同一试样中3处截面厚度的平均值。将一部分试样中的Sn打磨,并在超声波清洗机中用3% HNO3腐蚀清洗掉Sn直至只剩下IMC层,以SEM观察IMC层晶粒的形貌,采用X射线衍射分析仪(SHIMADZU XRD-6000)来鉴定去除钎料之后的IMC的成分及取向。
2 结果及讨论
2.1 无磁场下时效过程中钎焊及扩散焊Sn/Cu接头界面IMC层的横截面、形貌及生长动力学
图1所示为两种接头在170 ℃时效过程中界面IMC层的横截面图。由图1可看出,EDX能谱分析表明钎焊接头未时效时,界面IMC层为扇贝状的Cu6Sn5,化合物层和Sn的界面为曲折的锯齿状。同时,在Sn基体中还会发现少许的Cu6Sn5,在时效过程中,IMC随时效温度和时效时间的延长而增厚,IMC界面前沿的形态会随时间的增加逐渐从锯齿状向大波浪状转变。长时间时效后(见图1(c)),IMC层厚度明显增加,界面化合物层比较平直,同时,在Cu和Cu6Sn5层间有一层很薄的Cu3Sn。这与大部分文献中报道的结果一致[9, 15]。扩散焊制备的接头在未时效的情况下,界面IMC层为Cu6Sn5和Cu3Sn;在170 ℃时效250 h后,IMC层和Sn界面平直化。由扩散焊制备的Sn/Cu接头,IMC比较平直,且厚度均匀。然而,在时效过程中界面仍然会向大波浪状转变,这说明时效过程中两种接头界面IMC层横界面的变化有相似之处。
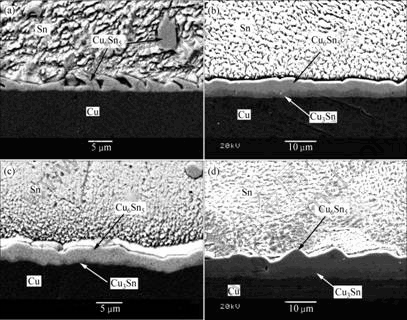
图1 钎焊和扩散焊接头在170 ℃时效的界面IMC层横截面的SEM像
Fig.1 SEM images of cross-section of IMC layers in soldered and diffusion-bonding joints aged at 170 ℃ without magnetic field: (a) Soldered joints, 0 h; (b) Diffusion-bonding joints, 0 h; (c) Soldered joints, 250 h; (d) Diffusion-bonding joints, 256 h
图2所示为两种接头在170℃时效过程中界面IMC层的晶粒形貌变化。由图2可看出,钎焊试样在短时间时效,IMC晶粒由扇贝状和短棒状晶粒组成;经长时间时效后,短棒状晶粒减少,晶粒逐渐向大的多边形转变。扩散焊试样在未时效时,由大小不均的扇贝状的晶粒组成,长时间时效后,晶粒粗化,小晶粒减少。虽然两种试样的初始晶粒形貌不同,但经长时间时效后,都可以发现IMC晶粒长大与合并的现象。

图2 钎焊和扩散焊接头在170 ℃时效的界面IMC层晶粒的形貌
Fig.2 Morphologies of IMC layers in soldered and diffusion-bonding joints aged at 170 ℃ without magnetic field: (a) Soldered joints, 50 h; (b) Diffusion bonding joints, 50 h; (c) Soldered joints, 250 h; (d) Diffusion bonding joints, 256 h
经图像分析仪测定IMC层厚度,得到等温时效过程中IMC层厚度与时效时间的生长动力学(见图3),其关系式可以用式(1)表示。

等式中IMC层的厚度与时间的1/2次方呈正比,表明IMC层的生长是受扩散机制控制(见图3(a)和(b))。从图3可以看出,时效温度越高,IMC层长得越快,其生长系数越大。IMC的生长激活能可用Arrhenius公式来计算:

图4所示为根据图3各温度下的层生长系数获得的Arrhenius曲线图。由图4得到钎焊和扩散焊Sn/Cu接头界面IMC层在时效过程中的生长激活能分别为116和94 kJ/mol。两种接头界面IMC层的生长激活能接近。表1列出了大多数文献报道的激活能结果,且本研究的激活能在文献报道的合理范围内。
`

图3 界面IMC层在无磁场下的生长动力学
Fig.3 Growth kinetics of IMC layers without magnetic field: (a) Soldered joints; (b) Diffusion-bonding joints

图4 Arrhenius曲线图
Fig.4 Arrhenius plot of IMC layers
表1 生长激活能
Table 1 Growth activation energies

2.2 强磁场下时效过程中钎焊及扩散焊Sn/Cu接头界面IMC层的横截面、形貌、生长动力学及晶体取向
图5所示为钎焊和扩散焊Sn/Cu接头在190 ℃、磁场强度为8 T时效不同时间后界面IMC层的横截面图。由图5(a)和(b)可看出,时效4 h后,界面IMC层仍然为锯齿状,化合物为Cu6Sn5;时效50 h后,界面IMC层已经从锯齿状向波浪状转变,IMC层更加均匀。由图5(c)和(d)可看出,界面IMC由Cu6Sn5和Cu3Sn两种化合物组成,时效4 h和50 h的IMC层均比较平直,IMC层和Sn的界面变化不明显。
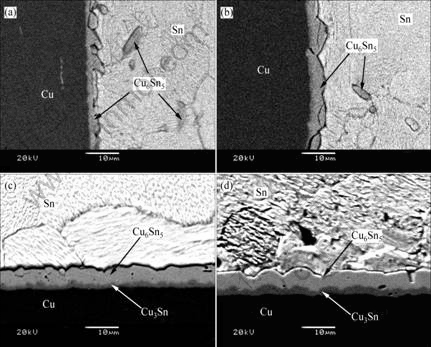
图5 钎焊和扩散焊接头在190 ℃、磁场强度为8 T时效界面IMC层的横截面形貌
Fig.5 Morphologies of cross sections of IMC layers in soldered and diffusion-bonding joints aged at 190℃ in 8 T of magnetic field strength: (a) Soldered joints, 4h; (b) Soldered joints, 50 h; (c) Diffusion-bonding joints, 4 h; (b) Diffusion-bonding joints, 50 h
图6所示为钎焊和扩散焊接头在190 ℃、磁场强度为8 T时效50 h后界面IMC层的形貌图。由图6(a) 可看出,IMC也是由扇贝状和圆棒状晶粒组成,与图2(a)比较,IMC的圆棒状晶粒增多,且长度增加,有的圆棒状晶粒已经断裂而脱离了IMC基体,说明强磁场有利于圆棒状IMC的生长。由图6可看出,扩散焊IMC的晶粒组要为扇贝状晶粒,未发现圆棒状晶粒。与图2(b)比较,IMC晶粒更加均匀。从晶粒形貌的变化可知,磁场下时效,IMC晶粒也会发生长大与合并的现象;且钎焊和扩散焊试样IMC晶粒形貌的差异表明,强磁场并没有促进时效过程中短棒状晶粒的形核,而是促进了短棒状晶粒的生长。
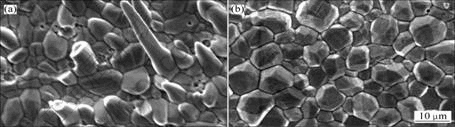
图6 钎焊和扩散焊在190 ℃、磁场强度为8 T时效50 h界面IMC层的形貌
Fig.6 Morphologies of IMC layers in soldered and diffusion-bonding joints aged at 190 ℃ in 8 T of magnetic field strength for 50 h: (a) Soldered joints; (b) Diffusion-bonding joints
图7所示为钎焊试样和扩散焊试样在190 ℃、磁场强度为8 T时效的生长动力学曲线。由图7可看出,两种接头在强磁场下时效,IMC层的生长均符合厚度与时间1/2次方的直线关系,表明磁场下时效与无磁场下时效一样,均由扩散机制控制。两种接头在磁场下时效相同时间,IMC层生长的厚度接近。

图7 钎焊和扩散焊试样在190 ℃、磁场强度为8 T时效的生长动力学
Fig.7 Growth kinetics of IMC layers in soldered and diffusion-bonding joints aged at 190 ℃ in 8 T of magnetic field strength
图8所示为钎焊和扩散焊试样未时效和磁场 强度为8 T时效50 h后界面IMC层的XRD谱。从图8可以看出,钎焊试样在0 T未时效时特征峰为Cu6Sn5 、
、 Cu(220)和Cu6Sn5
Cu(220)和Cu6Sn5 ;经强磁场时效后,特征峰变为Cu6Sn5
;经强磁场时效后,特征峰变为Cu6Sn5 、Cu (220)、Cu6Sn5
、Cu (220)、Cu6Sn5 ,最强峰为Cu6Sn5
,最强峰为Cu6Sn5 ,某些小峰的相对强度减弱,如Cu6Sn5(530)、
,某些小峰的相对强度减弱,如Cu6Sn5(530)、 、
、 以及(060),相应的Cu6Sn5
以及(060),相应的Cu6Sn5 、(025)以及(045)的相对积分强度得到提高。钎焊XRD结果表明,磁场使加快了Cu6Sn5在某些取向上的生长,同时也抑制了IMC在另一些取向上的生长。对于扩散焊试样,未时效的试样最强峰为Cu6Sn5
、(025)以及(045)的相对积分强度得到提高。钎焊XRD结果表明,磁场使加快了Cu6Sn5在某些取向上的生长,同时也抑制了IMC在另一些取向上的生长。对于扩散焊试样,未时效的试样最强峰为Cu6Sn5 或Cu(111),说明在没有磁场下钎焊和扩散焊界面的IMC取向已经不同。经强磁场时效后,扩散焊接头IMC层的特征峰为Cu6Sn5
或Cu(111),说明在没有磁场下钎焊和扩散焊界面的IMC取向已经不同。经强磁场时效后,扩散焊接头IMC层的特征峰为Cu6Sn5 、
、 及Cu(220),且以Cu6Sn5
及Cu(220),且以Cu6Sn5 为最强峰。然而,扩散焊接头经磁场时效后,某些小峰和最强峰Cu6Sn5
为最强峰。然而,扩散焊接头经磁场时效后,某些小峰和最强峰Cu6Sn5 的相对峰值有所变化,例如Cu6Sn5
的相对峰值有所变化,例如Cu6Sn5 、(530)、
、(530)、 得到增强,而Cu6Sn5
得到增强,而Cu6Sn5 、
、 以及(060)的相对峰值被减弱。比较两种接头在磁场下时效50 h后的XRD谱可知,钎焊试样Cu6Sn5
以及(060)的相对峰值被减弱。比较两种接头在磁场下时效50 h后的XRD谱可知,钎焊试样Cu6Sn5  、(530)、
、(530)、 的相对峰值比钎焊试样的低,即钎焊试样在磁场下时效,化合物在这些晶面的生长受到抑制。相应地,磁场促进了钎焊试样Cu6Sn5在
的相对峰值比钎焊试样的低,即钎焊试样在磁场下时效,化合物在这些晶面的生长受到抑制。相应地,磁场促进了钎焊试样Cu6Sn5在 、(025)、(045)以及(060)晶面的生长。综上所述可知,未时效的钎焊试样和扩散焊试样的界面IMC特征峰不同,经强磁场时效后的试样与未时效的试样相比,不论是钎焊还是扩散焊试样,其特征峰均有所变化,某些小峰消失。
、(025)、(045)以及(060)晶面的生长。综上所述可知,未时效的钎焊试样和扩散焊试样的界面IMC特征峰不同,经强磁场时效后的试样与未时效的试样相比,不论是钎焊还是扩散焊试样,其特征峰均有所变化,某些小峰消失。

图8 接头在190℃、磁场强度为8 T时效界面IMC层的XRD谱
Fig.8 XRD patterns of IMC layers aged at 190 ℃ in 8 T of magnetic field strength: (a) Soldered joints, 0 h; (b) Soldered joints, 50 h; (c) Diffusion-bonding joints, 0 h; (d) Diffusion- bonding joints, 50 h
上述实验结果表明,钎焊试样和扩散焊试样在未时效时,其横截面、形貌和晶体取向均有所不同。在无磁场下时效,两种接头界面IMC的生长动力学、横截面以及形貌在时效过程中的演变行为相似。在磁场下时效,虽然两种界面IMC的生长动力学类似,但其形貌和取向差别很大。
在制备钎焊试样过程中,一旦Cu板和熔化的Sn接触,Cu会快速向Sn中溶解,且在Cu/液体界面的局部区域,Cu的浓度非常高,Cu6Sn5化合物在Cu/液体界面非均匀形核并快速生长[2]。同时,由于Cu在液态Sn中的扩散速率决定了化合物/液体界面的形 貌[2, 6]。钎焊的温度较高,反应剧烈,化合物和基体界面的温度梯度和浓度梯度都比较大,即Cu的溶解很快,Cu原子在液态Sn中的扩散较快,因此,钎焊界面IMC层为锯齿状,Sn基体中也存在一部分Cu6Sn5。而通过扩散焊制备的试样,施加的压应力较小,界面IMC层主要通过体扩散的方式来生长;界面的温度梯度比较小,Cu和Sn原子的扩散速率都较慢,界面IMC层比较平直,Sn基体中没有化合物。然而,扩散焊的时间为20 h,比钎焊的时间长很多,故扩散焊制备的界面IMC层较厚。
两种初始接头的不同对后续时效的影响有两方面:一方面,很多研究者表明钎焊过程中锯齿状或者扇贝状界面IMC的生长,主要由IMC晶粒间的晶界扩散控制的,晶粒间的沟槽为晶界扩散提供了快速扩散通道,这些通道在可以为后续时效提供晶界扩散通道[5];另一方面,钎焊过程中Cu的溶解会在Sn基体中形成化合物,会影响基体的成分。然而,当两种接头在无磁场下时效的,化合物层的生长动力学曲线表明,界面IMC层的生长主要由Sn和Cu两种组元的体扩散控制,晶界扩散控制不明显。两种接头的生长激活能接近,在相同温度下,两种接头中Cu和Sn的扩散速率也接近。虽然钎焊接头的Sn基体中有Cu6Sn5存在,但从横截面图中可以发现Cu6Sn5含量较少。即Sn基体中化合物的含量并没有明显改变其成分,在没有外场的情况下,原子的扩散行为并不会因界面IMC横截面和形貌的变化而发生很大改变。因此,两种接头时效过程中界面IMC层的横截面、形貌以及生长动力学相似。
磁场对接头固相时效的影响主要有:第一,因物质磁化所产生的自由能的不同或者磁场对组元扩散 频率的影响,导致时效过程中组元的扩散速率改 变[13-14, 18];第二,因晶粒的磁晶各向异性或者几何形状的不同,晶粒在不同方向由磁场的磁化而产生择优取向或者织构[19-20]。在本研究中,界面IMC会因磁晶各向异性而在不同取向上的生长不同。然而,在固相时效过程中,能够提供给IMC晶粒转动的自由度不大,IMC在某些晶面的择优生长必然会使另一些晶面的生长受到抑制。因此,XRD分析结果表明,IMC晶粒在某些晶面的生长得到促进,同时,在另一些晶面的生长就受到抑制。由于两种接头的初始形貌和晶体取向不同,故两种接头磁场下时效后晶体取向的改变也不同。正是这两种接头界面IMC晶粒不同取向的生长,导致了界面IMC晶粒的形貌差异。然而,由于IMC的组元即Cu和Sn均为非铁磁性,磁场对IMC自由能的降低不明显。如上所述,两种接头的IMC层的生长均是体扩散机制控制。磁场对两种接头组元扩散的影响是等同的,其IMC层和Sn界面的形状以及钎焊时溶解到Sn中微量的Cu对磁场下IMC层的生长较小。另外,在固相时效过程中,Cu在Sn中的溶解度非常小,磁场对Cu在Sn中溶解度的影响几乎可以忽略。因此,两种接头界面IMC层在磁场下时效,其生长动力学类似。
3 结论
1) 钎焊接头时效前,界面IMC层横截面为锯齿状,主要由扇贝状和短棒状的Cu6Sn5组成;扩散焊接头时效前,界面IMC层比较平直,晶粒为扇贝状。
2) 两种接头在时效过程中界面IMC层逐渐平直化,IMC晶粒不断长大。钎焊和扩散焊接头时效过程中界面IMC层生长行为相似,其生长激活能分别为116和94 kJ/mol
3) 对比钎焊和扩散焊两种接头在190 ℃、磁场强度为8 T时效,两种试样界面IMC横截面的生长动力学相似,但晶粒形貌和晶体取向差别明显。
REFERENCES
[1] ZENG K, TU K N. Six cases of reliability study of Pb-free solder joints in electronic packaging technology[J]. Mater Sci Eng A, 2002, 38(1): 55-105.
[2] LAURILA T, VUORINEN, KIVILAHTI J K. Interfacial reactions between lead-free solders and common base materials[J]. Mater Sci Engineer R, 2005, 49(1/2): 1-60.
[3] WU C M L, YU D Q, LAW C M T, WANG L. Properties of lead-free solder alloys with rare earth element additions[J].Mater Sci Eng R, 2004, 44(1): 1-44.
[4] 于大全, 赵 杰, 王 来. 稀土元素对Sn-9Zn合金润湿性的影响[J]. 中国有色金属学报, 2003, 13(4): 1001-1004.
YU Da-Quan, ZHAO Jie, WANG Lai. Wetting properties of Sn-9Zn solder alloy with t race rare earth elements[J]. The Chinese Journal of Nonferrous Metals, 2003, 13(4): 1001-1004.
[5] SCHAEFER M, FOURNELLE R A, LIANG J. Theory for intermetallic phase growth between Cu and liquid Sn-Pb solder based in grain boundary diffusion control[J]. J Electron Mater, 1998, 27(11): 1167-1176.
[6] HUANG M L, LOEHER T, OSTMAN A, REICHL H. Role of Cu in dissolution kinetics of Cu metallization in molten Sn-based solders[J]. Appl Phys Letters, 2005, 86(18): 181908.
[7] 何大鹏, 于大全, 王 来, WU C M L. 铜含量对Sn-Cu钎料与Cu、Ni 基板钎焊界面IMC的影响[J]. 中国有色金属学报, 2006, 16(4): 701-708.
HE Da-peng, YU Da-quan, WANG Lai, WU C M L. Effect of Cu content on IMC between Sn-Cu solder and Cu and Ni substrates[J]. The Chinese Journal of Nonferrous Metals, 2006, 16(4): 701-708.
[8] 段莉蕾, 于大全, 赵 杰, 王 来. Sn-9Zn-3Bi/Cu 钎焊接头在170 ℃时效过程中的显微结构[J]. 中国有色金属学报, 2004, 14(5): 842-847.
DUAN Li-lei, YU Da-quan, ZHAO Jie, WANG Lai. Microstructures of Sn-9Zn-3Bi solder/Cu joint during long-term aging at 170 ℃[J]. The Chinese Journal of Nonferrous Metals, 2004, 14(5): 842-847.
[9] 程从前, 赵 杰, 杨 朋, 朱 凤. Sn-3Ag/Cu 接头在钎焊和时效中IMC 的生长和晶体取向分析[J]. 材料热处理学报, 2006, 2 7(4): 82-86.
CHENG Cong-qian, ZHAO Jie, YANG Peng, ZHU Feng. Growth behavior and crystal orientation of intermetallic compound layers in Sn-3Ag/Cu joints during soldering and isothermally aging[J]. Transactions of Materials and Heat Treatment, 2006, 27(4): 82-86.
[10] CHEN C M, CHEN S W. Electromigration effect upon the Sn-0.7wt% Cu/Ni and Sn-3.5wt% Ag/Ni interfacial reactions[J]. J Appl Phys, 2001, 90(3): 1208-1214.
[11] KAGANOVSKII Y S, PARITSKAYA L N, LOJKOWSKI W. Kinetics of chemical compound growth by surface interdiffusion[J]. Surf Sci, 2000, 454/456: 591-597.
[12] LIU Xiao-tao, CUI Jiang-zhong, GUO Yan-hui, WU Xiao-ming, ZHANG Jun. Phase formation and growth in Al-Mg couple with an electromagnetic field[J]. Mater Letter, 2004, 58: 1520-1523.
[13] 任 晓, 周文龙, 陈国清, 黄朝晖, 张俊善. 稳恒强磁场对Al-Cu扩散偶界面中间相形成和生长的影响[J]. 材料工程, 2007, 8: 41-44.
REN Xiao, ZHOU Wen-long, CHEN Guo-qing, HUANG Zhao-hui, ZHANG Jun-shan. Effect of high magnetic field on intermetallic compound layers of Al-Cu diffusion couple[J]. Journal of Materials Engineering, 2007, 8: 41-44.
[14] ZHAO Jie, YANG Peng, ZHU Feng, CHENG Cong-qian. The effect of high magnetic field on the growth behavior of Sn-3Ag-0.5Cu/Cu IMC layer[J]. Script Mater, 2006, 54: 1077-1080.
[15] WU Y, SEE J A, POURAGHABAGHER C, FOSTER L A, MARSHALL J L. The formation and growth of intermetallics in composite solder[J]. J Electron Mater, 1993, 22(4): 769-777.
[16] CHOI S, BIELER T R, LUCAS J P, SUBRAMANIAN K N. Characterization of the growth of intermetallic interfacial layers of Sn-Ag and Sn-Pb eutectics solders and their composite solder on Cu substrate during isothermal long-term aging[J]. J Electron Mater, 1999, 28(11): 1209-1215.
[17] FLANDERS D R, JACOBS E G, PINIZZOTTO. Activation energies of intermetallic growth of Sn-Ag eutectic solder on copper substrates[J]. J Electron Mater, 1997, 26 (7): 883-887.
[18] NAKAMICHI S, TSUREKAWA T, MORIZONO Y, WATANABEM T, NISHIDA M, CHIBA A. Diffusion of carbon and titanium in γ-iron in a magnetic field and a magnetic field gradient[J]. J Mater Sci, 2005, 40: 3191-3198.
[19] REN Zhong-ming, LI X, SUN Yan-hui, GAO Yun, DENG Kang, ZHONG Yun-bo. Influence of high magnetic field on peritectic transformation during solidification of Bi-Mn alloy[J]. Comp Coup Phase Diagrams Thermochemistry, 2006, 30(3): 277-285.
[20] 李 喜, 任忠鸣, 王 晖, 邓 康, 徐匡迪. 强磁场下Al-Ni 合金凝固初生相Al3Ni 的取向行为[J]. 中国有色金属学报, 2006, 16(3): 476-481.
LI Xi, REN Zhong-ming, WANG Hui, DENG Kang, XU Kuang-di. Effects of high magnetic field on solidification structure of Al3Ni phase in Al-Ni alloy[J]. The Chinese Journal of Nonferrous Metals, 2006, 16(3): 476-481.
基金项目:国家自然科学基金资助项目(50471068);“十一五”国家科技支撑计划资助项目(2006BAE03B02-2);国家自然科学基金广东省联合基金重点资助项目(V0734008)
收稿日期:2007-06-22;修订日期:2007-12-27
通讯作者:赵 杰,教授,博士;电话:0411-84707636;E-mail: jiezhao@dlut.edu.cn
(编辑 李艳红)