��ѧ���������Ӧ����������������ֵģ��
Ф ��, �� ��, �Ʋ���
(���ϴ�ѧ ��ĩұ������ص�ʵ����, ���� ��ɳ, 410083)
ժҪ: ���ƻ�ѧ�������(CVI)��Ӧ���ڵķ�Ӧ���������ǻ�����������Ĺؼ�����֮һ, ͨ�����������غ㡢�����غ㡢�����غ�ͻ�ѧ��Ӧ�غ�4���ַ��̼���߽�����, ��������Ԫ����CVI��Ӧ���и����Ҳ��ɹ۲����������������ֵ���㡣 ��ֵ����������, ������״������ĵ����λ�ö�������ò������Ӱ�졣 ���æ�/6��б������, ��ʹ������������ͨ������Բ���γĵ������ߵļн�Ϊ��/6ʱ, ��Ӧ���ڻ��������˻�����
�ؼ���: ����Ԫ; ��������; ��ѧ�������; ��Ӧ��; ��ֵģ��
��ͼ�����:V254.2 ���ױ�ʶ��:A ���±��: 1672-7207(2005)05-0761-05
Numerical simulation of gas flow field in chemical vapor infiltration reactor
XIAO Peng, XIONG Xiang, HUANG Bai-yun
(State Key Laboratory of Powder Metallurgy, Central South University, Changsha 410083, China)
Abstract: In order to deposit ideal matrix, it is one of the key technologies to control the flow field of reaction gases in the chemical vapor infiltration(CVI) reactor. Based on establishing four differential equations about conversations of mass, momentum, energy and chemical reaction, their boundary conditions, the complex and invisible flow field phenomena in CVI reactor chamber were investigated by numerical simulation using the finite element method. The results show that the effect of the nozzle shape and the location between the nozzle and the substrate on flow field is in evidence. The flow circumfluence in the CVI reactor is eliminated on condition that the inclination between the axes of the nozzle and the tangent of the cylinder substrate is equal to ��/6, and with a bevel nozzle.
Key words: finite element method; gas flow field; chemical vapor deposition; reactor; numerical simulation
��ѧ�������(chemical vapor infiltration, CVI)����Ŀǰ�Ʊ�������ά��ǿ�մɻ���̿�����ϲ��ϵ����뷽��֮һ, ͨ�����������ڼ��ȵ���ά�����������ѧ��Ӧ, ��������άԤ�����г����õ��մɻ����ϲ���(CMCS)[1, 2]�� ��CVI��ϵ��, �������˵���������Դ��ϵͳ�и����ֵ�����ѧ����, ��ѹ���Ũ���ݶȺ��¶��ݶȡ� ���ֲ�����ʹ��Ӧ����������Ӷ�����������������ɢ, ʵ����̬��Ӧ����������ת�ơ� �ⲻ�������˻�������ٶ�, ���Ҷ�����������ͳ���Ч����������Ӱ��[3, 4]�� �����CVI��Ӧ��Ӧ����[5]:
a. ��Ӧ������߽������Ա�֤�ĵ��������ٶ�һ��;
b. �����ڻ��������ڿ��������ڷ�Ӧ���ڵ�ͣ��ʱ��, �Ӷ����ٷ����������γ�;
c. ����Ӧ��Ԥ����ı����γɲ���, ʹ֮������������Ԥ�����϶�����ڵ���ɢ���ʡ�
����CVI��Ӧ�����������������Ҳ��ɹ۲�, ���, ����������������ֵģ�����, ��Ծ�����ȫ���о�CVI���̵�������������, �Ż���ƺ���ȷʹ��CVI��Ӧ������Ҫ�����塣 Ŀǰ, ��CVI�����о��ķ�����Ҫ�������������ӻ�ʵ���������ѧ���۷�������ֵ����2���о�����[6-13]�� �ڴ�, ���߽�������ѧģ�Ͷ�CVI��Ӧ���е���������������ֵ����, ��������������ĵ����λ�ö�����������Ӱ�졣
1 ��ѧģ��
1.1 ���Ʒ���
CVI���̰����������䡢�������䡢���������Լ���ѧ��Ӧ�ȷ���[1, 6]�� ���, ģ�ⷴӦ�������������Ŀ��Ʒ���Ӧ���������غ㡢�����غ㡢�����غ�ͻ�ѧ��Ӧ�غ�4���ַ���[14, 15]�� ����, �����غ㷽�̿ɱ�ʾΪ:

ʽ��: ��Ϊ��������ܶ�, g/cm3; tΪʱ��, s; uΪ�ٶ�ʸ��, m/s��
�����غ㷽�̿���Navier-Stokes��������:

ʽ��: iΪx, y��z; ��mΪ�������ճ��, kg/(m��s); pΪ��Ӧ��������ѹ��, Pa; CiΪճ�Ȧ�m����ĸ����
�¶ȿ�ͨ�������غ㷽�̵õ�:

ʽ��: HΪ���¶Ⱥͱ�����cp��ص�����(dH=cpdT); ��mΪ������崫��ϵ��, J/(m��s��K); TΪ�����¶�, K; ShΪ��λ��������ȵ�����, J/(m2��s)��
�ڷ�Ӧ����, ��ѧ��Ӧ�غ���Ҫ����ÿ�ַ�Ӧ�������ת������ɢ��ƽ��:

ʽ��: miΪ���i����������, %; jiΪ���i������ͨ��; GiΪ��λ���������������� ����, ����ͨ��ji�ɳ�����ɢjCi������ɢjTi���[14]:
ji=jCi+jTi��(5)
����ֻ����ij�����ɢͨ����Ҫ������������ֵ������ֲ��ݶ�, ������ѭStefan-Maxwell��ϵ[14, 15]:

ʽ��: DijΪ���i�����j�е���ɢϵ��, m2/s; MiΪ���i��Ħ������, g/mol; MΪ��������ƽ��Ħ������(M=��[DD(X]i[DD)]xiMi)��
����ɢͨ��������ʽ��ʾ:

ʽ��:  Ϊ����ɢϵ��, m2/s��
Ϊ����ɢϵ��, m2/s��
ʽ(1)~(4)�����˷�Ӧ���������ܶȡ�ѹ�����¶�֮��Ĺ�ϵ, ����������������״̬����p=��RT/M��
1.2 �߽�����
ƫ�ַ���ʽ(1)~(4)��һ��CVI��Ӧ��������, ���Ա����о���CVI����Ӧ��(��ͼ1)����, Ϊ�˿��������ĵļ������ص�Ӱ��, ��������������¼���:
a. ���ڷ�Ӧ���������ٶ�ԶԶС������, ����Ϊ����ѹ����, ���, ��CVI���̿���һ����̬����, ����״̬��ʱ���ء�
b. ����CVI����������������С, �����ڽ��뷴Ӧ��֮ǰ�����˺ܳ��Ĺ�·, ���, �ٶ�������ڴ�����״̬Ϊ��ȫ��չ�IJ�����
c. �ٶ����������¶ȱ���һ�¡�
d. �ٶ����������Ϊ������
�������ϼ���, �ɸ����������ƫ�ַ�������ı߽�������
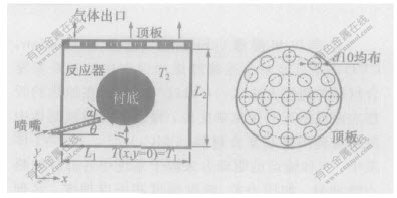
ͼ 1 CVI��Ӧ��ʾ��ͼ
Fig. 1 Schematic of CVI reactor chamber
�����������ֱ��С, ������ڴ������ٶ�Ϊ0, �����ٶȾ��ȷֲ�, ��:
u(��)=uav(8)
ʽ��: uav��ʾ������ڴ�����������������ٶȵ�ƽ��ֵ; ��Ϊ����������x�������ɵļнǡ�
��CVI��Ӧ���ṹ��ͼ1��ʾʱ, ���趥�����㹻��, �ڽ��붥��һ������֮��, ��������;����ٶȲ��ٷ����仯�� ���ڳ��ڴ�:

�ڷ�Ӧ���ںͳĵױ߽紦, ���ڱ�����赲��Ħ��, �κη����ٶȾ�Ϊ0, ��:
ux=0, uy=0��(10)
����CVI��Ӧ�����õײ�����, Ϊʹ�����, ���跴Ӧ�������¶���ĵ��¶�����ҷֲ�����, ��Ӧ���ײ��¶�Ҳ�ֲ�����, ���, ��߽�������дΪ:
T(x, y=0)=T1;(11)
T(x=0, y)=T(x=L1, y)=T(x, y=L2)=Taxis=T2��(12)
1.3 ��ֵ�������
���졢�ĵ��ڷ�Ӧ���ڵ����λ�ù�ϵ��ͼ1��ͼ2��ʾ�� ����: L1��L2�ֱ�Ϊ��Ӧ�����ھ�(120 mm)�߶�(100 mm), ��Ϊ������ǻ(ֱ��Ϊ10 mm)�������ߵ��ӳ�����ͨ���ӳ��ߺͳĵױ��潻������ߵļн�, �ֱ�ȡΪ0,��/6�ͦ�/2; LΪ��������������ӳ��ߵ��ĵױ���ľ���(10 mm); hΪ�ĵ���͵㵽��Ӧ���ײ��ľ���(20 mm)�� �ĵ���ΪԲ��(ֱ��Ϊ60 mm), ���������ƽ�ں�б��(��/6)2�֡�
1.4 �������
��ģ������в�������Ԫ����ǽṹ������(��ͼ3), �ü�Ȩ���������ַ�����ɢΪ��������, Ȼ����MATLAB���Ա��Ƽ������ �����������õ�ɫͼ�����, �ü�ͷ��ʾ�ٶȵķ���; ��Ӧ���ڸ������������ٴ�С����ά�����ʾ��

ͼ 2 ������ĵ����λ��
Fig. 2 Relative location between nozzle and substrate

ͼ 3 CVI��Ӧ���ڻ��ֵĶ�ά����
Fig. 3 Two-dimensional net grids in CVI reactor chamber
2 ��ֵ�����������
�Ӽ������õ����������ֲ���ò����, �������������ĵ���״�ͷ�Ӧ���ṹ��ͬ�������, ������״�����λ�ö���������ò�кܴ��Ӱ�졣 ƽ�ڹ�״������ĵļнǦ��ֱ���ڦ�/2,��/6��0���γɵ�����������ò��������ٷֲ���ͼ4��ʾ�� ��ͼ4��ʾ��������ò��֪:
a. ����=��/2ʱ, ����ֱ�ӳ���ĵױ����γɽ�ǿ��ɢ��, ����IJ����������ﷴӦ�����ٷ�������� �ĵ��ϲ��������˽Ϻõ������߽��, �����²�����뷴Ӧ���װ�֮���γ��˻��ҵ�����, ���ڷ�Ӧ�������Ͻ��γ��˻�������
b. ����=��/6ʱ, �ڳĵױ�����²��������γ��˽ϺõIJ���, �ڷ�Ӧ����������в����ϲ��γ���2���������� ������Ϊ���������ĵ�Բ����, �����ֳ����ɷֱ�������Բ���γĵױ�����ϡ� �²�����ǰ����, �����ֱ��γɻ�������
c. ����=0ʱ, ��ͼ4(c)���������ٷֲ���֪, ��������ĵױ����γɵ�ɢ������� �ڷ�Ӧ���ڵ����Ͻ������½��γ��˶ԳƵĻ������� �ĵ��ϲ��γ��˽Ϻõ���������� ����෴, ������������������ijĵ��²�����ȴ�൱���ҡ�
�ڦ�=��/6�ͳĵ�ֱ��d=60 mm��������, ��ƽ�����컻�ɦ�/6б������ʱ, ��Ӧ���ڵ�������ò�����˽ϴ�ı仯, ���������˻�����, ��ͼ5��ʾ��
��ֵ����������, ������״������ĵ����λ�ö�������ò������Ӱ�졣
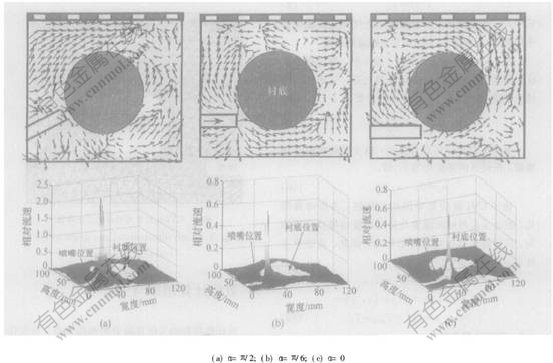
ͼ 4 CVI��Ӧ��������������ò��������ٷֲ�
Fig. 4 Flow-field shape and relative distribution of flow velocity in CVI reactor chamber
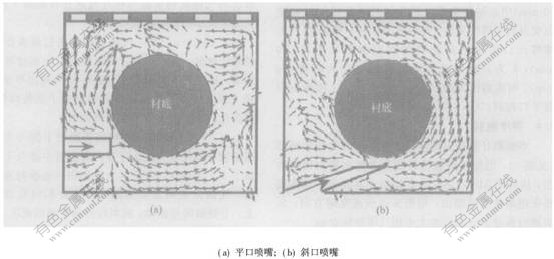
ͼ 5 ������״��λ�ö�������Ӱ��
Fig. 5 Effect of nozzle shape and nozzle location on flow field
3 �� ��
a. ������CVI��Ӧ���������������Ʒ���(���������غ㡢�����غ㡢�����غ�ͻ�ѧ��Ӧ�غ�4���ַ���)�ͱ߽�����, Ӧ������Ԫ���Բ�ͬ�����µķ�Ӧ��������������������ֵ������ģ�⡣
b. ������״������ĵ����λ�ö�������ò������Ӱ�졣 ���æ�/6��б������, ��ʹ������������ͨ������Բ���γĵ������ߵļн�Ϊ��/6ʱ, ��Ӧ���ڻ��������˻�����
�����:
[1]Xu Y D, Cheng L F, Zhang L T. Carbon/silicon carbide composites prepared by chemical vapor infiltration combined with silicon melt infiltration[J]. Carbon, 1999, 37: 1179-1187.
[2]Fillzer E, Fritz W, Schoch G. Modeling of the chemical vapor impregnation of porous carbon substrate with SiC[J]. High Temperature-High Pressures, 1992, 24: 343-354.
[3]Fotiadis D I, Kremer A M, Mekenna D R, et al. Complex flow phenomena in vertical MOCVD reactors: effects on deposition uniformity and interface abruptness[J]. J Crystal Growth, 1987, 85: 154-164.
[4]Ф��, ������, �Ʋ���. ����������CVD-SiC��������ѧ����ò��Ӱ��[J]. ������ѧ��, 2002, 17(4): 877-881.
XIAO Peng, XU Yong-dong, HUANG Bo-yun. Effect of deposition condition on deposition thermodynamics and morphology of CVD-SiC[J]. Journal of Inorganic Materials, 2002, 17(4): 877-881.
[5]Wang C A, Groves S H, Palmateer S C. Flow visualization studies for optimization of OMVPE reactor design[J]. J Crystal Growth, 1986, 77: 136-143.
[6]Ф��, ������, ����ͬ, ��. �Ż�CVI��Ӧ�����������Ŀ��ӻ��о�[J]. ������ѧʵ�������, 2000, 14(2): 88-91.
XIAO Peng, XU Yong-dong, ZHANG Li-tong, et al. Visual research on optimization of flow in CVI reactors[J]. Experiments and Measurements in Fluid Mechanics, 2000, 14(2): 88-91.
[7]Ф��, ���, ������, ��. CVI���չ��������崫��ģ�������[J]. ���ղ���ѧ��, 2002, 22(1): 11-15.
XIAO Peng, LI Di, XU Yong-dong, et al. Modeling of gas transport and calculation during CVI processing[J]. Journal of Aeronautical Materials, 2002, 22(1): 11-15.
[8]XIAO Peng, LI Di, XU Yong-dong, et al. Modeling of gas phase diffusion transport during chemical vapor infiltration process[J]. Trans Nonferrous Met Soc China, 2002, 12(3): 429-432.
[9]Visser E P, Kleijn C R, Govers A M, et al. Return flows in horizontal MOCVD reactors studied with the ise of TiO2 particle injection and numerical calculations[J]. J Crystal Growth, 1989, 94: 929-946.
[10]Warpinski N R, Nagib H M, Lavan Z. Experimental investigation of recirculating cells in laminar coaxial jets[J]. AIAA Journal, 1972, 10(9): 1204-1210.
[11]Durst F, Kadinski L, Schafer M. A multigrid solver for fluid flow and mass transfer coupled with greybody surface radiation for the numerical simulation of chemical vapor deposition processes[J]. J Crystal Growth, 1995, 146: 202-208.
[12]Werner C. Numerical modeling of CVD processes and equipment[J]. Journal De Physique IV, 1991, 1: 3-18.
[13]Kleijn C R. The modelling of LPCVD in single-wafer reactors as a tool for process optimization and equipment design[J]. Journal De Physique IV, 1991, 1: C2-19-31.
[14]Bird R B, Stewart W E, Lighfoot E N. Transport Phenomena[M]. New York: John Wiley & Sons, 1960.
[15]Thrush E J, Cureton C G, Briggs A T R. MOCVD growth InP/InGaAs structure for optical receivers[J]. J Crystal Growth, 1988, 93: 870-876.
�ո�����:2004-11-11
������Ŀ:���Ҹ����о���չ�ƻ�������Ŀ(2002AA305207)
�����:Ф ��(1971-), ��, ������Դ��, ��ʿ, ����, ���¸����ܸ��ϲ��ϼ�Ӧ���о�
������ϵ��: Ф ��, ��, ����; �绰: 0731-8830131(O); E-mail: xiaopeng@mail.csu.edu.cn