常压化学气相沉积ZrC涂层动力学与组织结构
郑湘林,李国栋,熊翔,孙威
(中南大学 粉末冶金国家重点实验室,湖南 长沙,410083)
摘要:以ZrCl4-CH4-H2-Ar为反应体系,采用常压化学气相沉积(APCVD)法在1 473~1 873 K制备ZrC涂层,用X线衍射和扫描电镜分析涂层的相成分、ZrC晶粒择优生长及微观形貌,研究ZrC涂层沉积动力学和涂层组织结构。研究结果表明:随沉积温度的升高,APCVD ZrC涂层的沉积速率增大,ZrC微晶表观尺寸也相应增大;1 473~1 673 K沉积时,化学气相沉积过程的表观活化能为71.69 kJ/mol,沉积过程由化学动力学控制;1 673~1 873 K沉积时,过程的表观活化能为14.28 kJ/mol,沉积过程由扩散控制。沉积温度由1 473 K上升至1 673 K时,ZrC晶粒的择优生长取向由 转变为
转变为 ,ZrC涂层组织为典型的针状晶结构,涂层较疏松、粗糙;1 873 K沉积时,ZrC晶粒呈短柱状,ZrC涂层致密平整,且沉积速率最高。
,ZrC涂层组织为典型的针状晶结构,涂层较疏松、粗糙;1 873 K沉积时,ZrC晶粒呈短柱状,ZrC涂层致密平整,且沉积速率最高。
关键词:化学气相沉积;碳化锆;沉积动力学;组织结构
中图分类号:TQ013 文献标志码:A 文章编号:1672-7207(2011)07-1912-06
Deposition kinetics and microstructure of APCVD ZrC coating
ZHENG Xiang-lin, LI Guo-dong, XIONG Xiang, SUN Wei
(State Key Laboratory of Powder Metallurgy, Central South University, Changsha 410083, China)
Abstract: ZrC coating was prepared by atmospheric pressure chemical vapor deposition (APCVD) with ZrCl4-CH4-H2-Ar chemical system at different temperatures. X-ray diffractometry (XRD) and scanning electron microscopy (SEM) were used to analyze phase composition, crystalline preferred orientation, and micro-morphology of ZrC coating. The influences of temperature on deposition kinetics and microstructure were also studied. The results show that with temperature increasing, the deposition rate and crystalline size of ZrC coating correspondingly increase. The apparent activated energy is 71.69 kJ/mol, and chemical kinetics is the controlling mechanism at 1 473-1 673 K. However, the apparent activated energy changes to 14.28 kJ/mol and the process is controlled by diffusion at 1 673-1 873 K. From 1 473 to 1 673 K, ZrC coating is porous and roughness, crystalline preferred orientations change from  to
to  , and microstructure of ZrC coating is typical needle-like. When temperature rises up to 1 873 K, crystalline shows short-column, coating is compact as well as smooth, and deposition rate is highest.
, and microstructure of ZrC coating is typical needle-like. When temperature rises up to 1 873 K, crystalline shows short-column, coating is compact as well as smooth, and deposition rate is highest.
Key words: chemical vapor deposition (APCVD); ZrC; deposition kinetics; microstructure
碳化锆(ZrC)是一种过渡族金属碳化物,具有高强度、高硬度、耐腐蚀和高温化学稳定性强等特性,在许多领域如薄膜材料、微电子材料、核能储备材料等方面都具有广阔的发展前景[1-3]。同时,ZrC还是一种理想的超高温抗氧化保护材料[4-5]。Zr元素的碳化物和氧化物都具有极高的熔点,且在超高温下可以形成抗氧化机制,降低氧向基体中的扩散速度,从而有效地对基体进行保护。在各种ZrC涂层、薄膜的制备方法中,低压化学气相沉积(LPCVD)、等离子增强化学气相沉积(PECVD)、金属有机化学气相沉积(MOCVD)、脉冲激光沉积(PLD) 和射频磁控溅射(RFMS)应用较多[6-10]。但这些方法制备ZrC涂层时沉积速率低,对于制备要求较厚的抗氧化涂层来说,制备周期长,成本高,不利于工业化生产。常压化学气相沉积(APCVD)方法能够弥补这一缺点,制备的涂层具有纯度高、均匀且沉积速率高等特点。目前,对于APCVD ZrC涂层的沉积动力学及组织结构的研究工作还未见报道。沉积温度是化学气相沉积过程中最重要的工艺参数之一[11-16]。在不同的沉积温度范围内,过程的沉积动力学不同,直接影响涂层的沉积速率和ZrC晶粒的生长取向,从而导致涂层组织结构和性能各异。因此,控制沉积温度对APCVD ZrC涂层的制备至关重要。本文作者采用常压化学气相沉积工艺分别在1 473,1 573,1 673,1 773和1 873 K下制备ZrC涂层,研究不同温度下ZrC涂层的沉积速率、微观形貌和组织结构,探讨APCVD ZrC涂层的沉积动力学及其生长机制。
1 实验
采用APCVD工艺制备ZrC涂层,以ZrCl4-CH4- H2-Ar为化学反应体系。通过如下化学反应,在基体上得到一定厚度的ZrC涂层:
ZrCl4(g)+CH4(g)→ZrC(s)+HCl (1)
实验中化学气相沉积炉为小型立式电磁感应加热炉,图1所示为ZrC涂层CVD炉示意图。采用光电高温计和自动温控系统测量、调节沉积炉的温度;CH4,H2和Ar流量经气体流量系统进行调节;ZrCl4固体粉末由自制螺旋送粉装置由顶部加入,通过调节送粉器转速控制ZrCl4粉末的加入量。
炭/炭复合材料(直径为28 mm,高为10 mm)作为ZrC涂层的基体材料。CH4,H2和Ar的纯度均大于99.9%,ZrCl4粉末纯度为化学纯,沉积180 min。具体工艺参数见表1。

图1 ZrC涂层CVD炉示意图
Fig.1 Sketch of deposition furnace of ZrC coating
表1 ZrC涂层工艺参数
Table 1 Process parameters of CVD ZrC coating
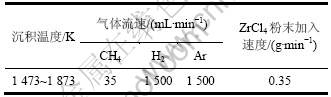
采用精度为0.1 mg的Adventure TM电子天平准确称量样品;采用日本理学D/max2550VB+18 kW转靶X线衍射仪(XRD)分析不同沉积温度下ZrC涂层的相成分和ZrC晶粒的择优生长,利用Sherrer公式计算ZrC晶粒的微晶粒度;采用JEOL-6360LV型扫描电子显微镜(SEM)观察和分析涂层的表面和自然断面微观形貌。
2 结果与讨论
2.1 APCVD ZrC涂层沉积动力学
图2所示为ZrC涂层沉积速率随沉积温度变化曲线。其中ZrC沉积速率v的计算方法为:
 (2)
(2)
式中:m1和m2分别为沉积前后试样的质量,mg;t为沉积时间,s;S为试样表面积,cm2。从图2可以看出:常压下涂层的沉积速率随沉积温度的升高而相应增加;不同的温度区间内沉积速率的增长方式不同,分为Ⅰ和Ⅱ 2个阶段,即1 473~1 673 K和1 673~1 873 K 2个阶段。第Ⅰ阶段,沉积速率呈指数式增长,由0.15 mg/(cm2・min)迅速增加到0.24 mg/(cm2・min);第Ⅱ阶段,沉积速率却呈现出另一种增长方式,增速明显下降。这说明在2个不同温度范围内,化学气相沉积过程中的表观活化能发生了改变。

图2 ZrC涂层沉积速率与温度的关系
Fig.2 Relationship between deposition rate and temperature of ZrC coating
根据不同温度下ZrC涂层的沉积速率和Arrhenius公式计算化学气相沉积过程中的表观活化能:
 (3)
(3)
式中:A为频率因子;R为摩尔气体常数;T为热力学温度;ΔEa为表观活化能。求解动力学曲线(ln v-1/T)的斜率,可得到过程的表观活化能ΔEa。由计算结果可知:常压化学气相沉积ZrC涂层过程中,过程的表观活化能ΔEa在1 673 K附近(约1 660 K)从71.69 kJ/mol降低到14.28 kJ/mol(图3)。
根据化学气相沉积动力学可知:控制沉积过程的主要机制包括表面反应和扩散,且沉积过程中的化学吸附、表面化学反应以及脱附等过程的发生都需要一定的活化能[17]。在1 473~1 673 K范围内时,由于沉积温度相对较低,且ZrCl4由固态升华到气态、CH4热分解以及ZrCl4被还原等过程大量吸热,有效沉积温度进一步降低,过程的表观活化能大,化学反应不充分,涂层沉积速率低,沉积过程由表面反应控制;在1 673~1 873 K范围内时,外界提供的能量足够大,化学反应已不是主要的控制因素,ZrC沉积速率高,此时沉积过程转变为由扩散控制。

图3 CVD ZrC涂层动力学曲线
Fig.3 Kinetics curves of ZrC coating
2.2 涂层的相成分和ZrC晶粒生长取向
图4所示为1 473,1 673和1 873 K下沉积的ZrC涂层的XRD谱。由图4可知:在ZrCl4蒸汽和CH4
的物质的量比接近1,通入适量的氢气,沉积温度为 1 473~1 873 K时,涂层均由单一的ZrC相组成。涂层中ZrC相各晶面的峰值强度发生了剧烈变化。1 473 K时,ZrC晶面的最强峰为(220),其他峰均为弱峰;1 673 K时,ZrC晶面峰值强度以(200)最高;1 873 K时,则以(111)和(200)为最强峰,其他峰的峰值强度也较高。不同晶面峰值强度比值的变化说明ZrC晶粒存在择优取向,且随沉积温度变化而改变。根据ZrC晶面峰值强度比值变化关系以及Harris公式,可计算出不同晶面的织构系数TC(hkl),用以来表征ZrC晶粒生长的择优程度。晶面的TC越大,其择优程度越高[18]。

图4 不同沉积温度下ZrC涂层的XRD谱
Fig.4 XRD patterns of ZrC coating with different temperature
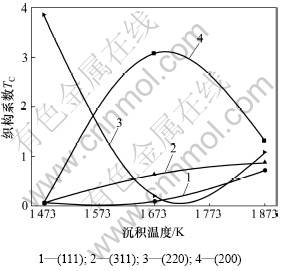
图5 沉积温度与晶面织构系数的关系
Fig.5 Texture coefficients of ZrC as functions of deposition temperature
从晶面织构系数和温度的关系来看,ZrC晶粒的择优取向主要受 和
和 方向织构系数的影响。在1 473 K时,形成强烈的
方向织构系数的影响。在1 473 K时,形成强烈的 择优取向,而1 673 K时,则形成了强烈的
择优取向,而1 673 K时,则形成了强烈的 择优取向。总的来说,在 1 473和1 673 K时,涂层的择优生长十分明显;而随沉积温度的进一步升高,1 873 K时涂层也存在
择优取向。总的来说,在 1 473和1 673 K时,涂层的择优生长十分明显;而随沉积温度的进一步升高,1 873 K时涂层也存在 择优取向,择优生长不如低温时强烈,其原因主要是高温时原子扩散能力强,各晶面上的生长都得以加强。
择优取向,择优生长不如低温时强烈,其原因主要是高温时原子扩散能力强,各晶面上的生长都得以加强。
2.3 温度对ZrC微晶尺寸的影响
沉积温度不仅改变ZrC晶粒的生长取向,还会影响ZrC晶粒的微晶尺寸。根据图3中ZrC晶面衍射峰的半高宽,利用Sherrer 公式计算不同沉积温度下ZrC涂层微晶的表观尺寸:
 (4)
(4)
式中:D(hkl)为(hkl)晶面的微晶表观尺寸,nm;λ为X线波长,λ=0.154 nm;θ为衍射角;β(hkl)为(hkl)晶面衍射峰积分的半高宽,rad。
图6所示是不同沉积温度下ZrC微晶表观尺寸。1 473 K时ZrC微晶表观尺寸为16 nm,1 673 K时微晶表观尺寸迅速增大到27 nm,1 873 K时微晶表观尺寸达到30 nm。这说明随着沉积温度的升高,ZrC的微晶表观尺寸相应增大。当温度高于1 673 K时,ZrC表面扩散速率大于体扩散速率,且沉积速率远大于体扩散速率,因而晶体粒径增长速率减慢。

图6 不同沉积温度下ZrC涂层微晶表观尺寸
Fig.6 Crystalline size of ZrC coating at different deposition temperatures
2.4 ZrC涂层组织结构随温度的变化
图7所示为不同温度下ZrC涂层表面的SEM像。对比图7(a)~(c)可以发现:温度相对较低时(1 473 K),涂层表面由一些相对孤立的球形颗粒松散堆积而成,球形颗粒尺寸较小(直径约为5~10 μm),且颗粒间相互融合现象少,涂层疏松,表面较粗糙,如图7(a)所示;1 673 K时,孤立的颗粒通过相互吞并、熔结和长大,存在明显的大颗粒吞并小颗粒的烧结迹象,但未完全融合,表面仍较粗糙,如图7(b)所示;随着沉积温度的进一步升高,1 873 K时ZrC涂层表面平整且连续,ZrC颗粒结合紧密,颗粒间的孔隙消失,涂层致密。这主要是高温下原子扩散能力进一步提高的缘故。此 外,1 473~1 873 K沉积的ZrC涂层的表面形貌均是典型的表面成核长大CVD涂层形貌,无气相成核生长的现象。

图7 不同沉积温度下ZrC涂层表面形貌的SEM像
Fig.7 SEM images of ZrC coating at different temperatures
图8所示是在沉积时间为180 min时不同沉积温度下ZrC涂层的自然断面SEM形貌,用来表征涂层的生长行为和组织结构。从图8可以看出:不同的沉积温度下沉积速率不同,直接影响涂层的生长厚度。 1 473 K沉积的ZrC涂层最薄,仅有18.15 μm,如图8(a)所示;1 673和1 873 K沉积的涂层厚度均达到了50 μm以上,如图8(b)和(c)所示。更重要的是,ZrC涂层组织结构也发生明显改变;1 473和1 673 K沉积的ZrC涂层具有典型的针状晶结构[17]。而且1 473 K沉积ZrC涂层沉积速率小,排列更规则,针状晶垂直于基体,呈T型针状晶结构。结合涂层的XRD谱分析可知这是ZrC晶粒在 和
和 强烈择优取向。随着沉积温度达到1 873 K时,原子表面扩散能力强,原子体扩散能力也增强,沉积速率大,沉积阴影效应下降,故形成较均匀的短柱状晶组织。
强烈择优取向。随着沉积温度达到1 873 K时,原子表面扩散能力强,原子体扩散能力也增强,沉积速率大,沉积阴影效应下降,故形成较均匀的短柱状晶组织。
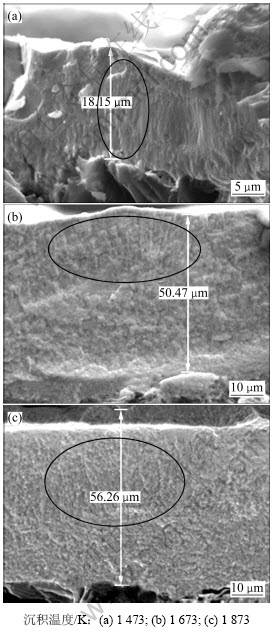
图8 ZrC涂层自然断面SEM形貌
Fig.8 Cross-section SEM morphologies of ZrC coating
3 结论
(1) 沉积温度和常压化学气相沉积ZrC涂层动力学密切相关。随着沉积温度的升高,涂层沉积速率不断增大,ZrC微晶表观尺寸也相应增大。在1 473~1 673 K区间时,沉积过程的表观活化能为71.69 kJ/mol,沉积过程由化学动力学控制;在1 673~1 873 K区间时,沉积过程的表观活化能降至14.28 kJ/mol,沉积过程由扩散控制。
(2) 在不同沉积温度下,常压化学气相沉积ZrC晶粒的生长取向和组织形貌存在明显差异。当沉积温度由1 473 K上升至1 673 K时,ZrC晶粒的择优生长取向由 转变为
转变为 。ZrC涂层组织都是典型的针状晶结构,涂层表面疏松、粗糙。当沉积温度进一步升高至1 873 K时,原子扩散能力强,涂层表面连续平整、致密,涂层呈短柱状晶结构。
。ZrC涂层组织都是典型的针状晶结构,涂层表面疏松、粗糙。当沉积温度进一步升高至1 873 K时,原子扩散能力强,涂层表面连续平整、致密,涂层呈短柱状晶结构。
参考文献:
[1] Craciuna V, Craciunb D, Howard J M, et al. Pulsed laser deposition of crystalline ZrC thin films[J]. Thin Solid Films, 2007, 515(11): 4636-4639.
[2] Oron M, Goldstein M. Improvement of electron gun brightness in conventional scanning electron microscope (SEM) by coating its tungsten filament with a zirconium carbide (ZrC) thin film[J]. Vacuum, 1978, 28(12): 547-550.
[3] Murata Y, Yukawa N. Solid-state reaction for ZrC formation in a Zr-doped nickel-based superalloy[J]. Scripta Metallurgica, 1986, 20(5): 693-696.
[4] 童庆丰, 史景利, 宋永忠, 等. ZrC/C复合材料性能及微观结构的研究[J]. 宇航材料工艺, 2004, 34(2): 45-48.
TONG Qing-feng, SHI Jing-li, SONG Yong-zhong, et al. Research on properties and microstructures of ZrC/C composites[J]. Aerospace Materials & Technology, 2004, 34(2): 45-48.
[5] 王其坤, 胡海峰, 陈朝辉. 难熔金属化合物掺杂对先驱体转化2D C/SiC复合材料抗氧化性能影响[J]. 航空材料学报, 2009, 29(4): 72-76.
WANG Qi-kun, HU Hai-feng, CHEN Zhao-hui. Influence of refractory compounds introduction on oxidation resistant performance of 2D C/SiC composites via precursor infiltration and pyrolysis[J]. Journal of Aeronautical Materials, 2009, 29(4): 72-76.
[6] Park J H, Jung C W, Kim D J, et al. Effect of H2 dilution gas on the growth of ZrC during low pressure chemical vapor deposition in the ZrCl4-CH4-Ar system[J]. Surface & Coatings Technology, 2008, 203(1/2): 87-90.
[7] Zheng Y F, Liu X L, Zhang H F. Properties of Zr-ZrC-ZrC/DLC gradient films on TiNi alloy by the PIIID technique combined with PECVD[J]. Surface and Coatings Technology, 2008, 202(13): 3011-3016.
[8] Won Y S, Kim Y S, Varanasi V G, et al. Growth of ZrC thin films by aerosol-assisted MOCVD[J]. Journal of Crystal Growth, 2007, 304(2): 324-332.
[9] Yang J, Wang M X, Kanga Y B, et al. Influence of bilayer periods on structural and mechanical properties of ZrC/ZrB2 superlattice coatings[J]. Applied Surface Science, 2007, 253(12): 5302-5305.
[10] Craciun V, Woo J, Craciun D, et al. Epitaxial ZrC thin films grown by pulsed laser deposition[J]. Applied Surface Science, 2006, 252(13): 4615-4618.
[11] 付志强, 唐春和, 梁彤祥, 等. 化学气相沉积法制备ZrC涂层的热力学分析[J]. 原子能科学技术, 2007, 41(3): 297-300.
FU Zhi-qiang, TANG Chun-he, LIANG Tong-xiang, et al. Thermodynamic analysis of chemical vapor deposition process for ZrC coating[J]. Atomic Energy Science and Technology, 2007, 41(3): 297-300.
[12] 朱钧国, 杜春飙, 张秉忠, 等. 碳化锆镀层的化学气相沉积[J]. 清华大学学报: 自然科学版, 2000, 40(12): 59-62.
ZHU Jun-guo, DU Chun-biao, ZHANG Bing-zhong, et al. Chemical vapor deposition of zirconium carbide coating[J]. Journal of Tsinghua University: Science and Technology, 2000, 40(12): 59-62.
[13] 邓清, 肖鹏, 熊翔. 沉积温度对SiC涂层微观结构及组成的影响[J]. 粉末冶金材料科学与工程, 2006, 11(5): 304-309.
DENG Qing, XIAO Peng, XIONG Xiang. Effect of temperature on microstructure and composition of CVD SiC coating[J]. Materials Science and Engineering of Powder Metallurgy, 2006, 11(5): 304-309.
[14] 刘荣军, 张长瑞, 刘晓阳, 等. CVD过程中温度对SiC涂层沉积速率及组织结构的影响[J]. 航空材料学报, 2004, 24(4): 22-26.
LIU Rong-jun, ZHANG Chang-rui, LIU Xiao-yang, et al. The effects of deposition temperature on the deposition rates and structures of CVD SiC coatings[J]. Journal of Aeronautical Materials, 2004, 24(4): 22-26.
[15] 李国栋, 熊翔, 黄伯云. 温度对CVD-TaC涂层组成、形貌与结构的影响[J]. 中国有色金属学报, 2005, 15(4): 565-571.
LI Guo-dong, XIONG Xiang, HUANG Bo-yun. Effect of temperature on composition, surface morphology and microstructure of CVD-TaC coating[J]. The Chinese Journal of Nonferrous Metals, 2005, 15(4): 565-571.
[16] 陈招科, 熊翔, 李国栋, 等. 化学气相沉积TaC涂层的微观形貌及晶粒择优生长[J]. 中国有色金属学报, 2008, 18(8): 1377-1382.
CHEN Zhao-ke, XIONG Xiang, LI Guo-dong, et al. Surface morphology of TaC coating prepared by chemical vapor deposition and preferential growth mechanism of TaC grains[J]. The Chinese Journal of Nonferrous Metals, 2008, 18(8): 1377-1382.
[17] 唐伟忠. 薄膜材料制备原理、技木及应用[M]. 北京: 冶金工业出版社, 2003: 178-181.
TANG Wei-zhong. The preparation theory, technology and application of thin films[M]. Beijing: Metallurgical Industry Press, 2003: 178-181.
[18] Korotkov R Y, Ricou P, Farran A J E. Preferred orientations in polycrystalline SnO2 films grown by atmospheric pressure chemical vapor deposition[J]. Thin Solid Films, 2006, 502(1/2): 79-87.
(编辑 陈爱华)
收稿日期:2010-07-12;修回日期:2010-11-18
基金项目:国家重点基础研究发展计划(“973”计划)项目(2011CB605805);国家自然科学基金委员会创新研究群体科学基金资助项目(51021063);国家自然科学基金资助项目(50872154);中国博士后基金资助项目(20070420822)
通信作者:李国栋(1963-),男,湖北随州人,博士,教授,从事涂层材料和复合材料研究;电话:13087317973;E-mail: lgd63@163.com