������˿��ѧ����������Ʊ�SiCN��Ĥ���о�
���䣬���Ƕ�����־�£��O���ݣ�������
(������ѧ ��Ϣ��ѧ�뼼��ѧԺ������ ������710127)
ժ Ҫ��������˿��ѧ�������(HFCVD)ϵͳ���ڵ���Si�ĵ����Ʊ�SiCN��Ĥ�������õ�Դ����Ϊ�ߴ���SiH4��CH4��N2����ԭ��������(AFM)��X��������(XRD)��X�߹��������(XPS)����Ʒ���б�����������о����������SiCN��Ĥ�������������������ȡ��ۼ����ܵ�SiCN������ɣ���Ĥ��Ȼ�Ѿ�������������������֣����������ͷǾ��ɷ֣�ͨ��Jade������ϼ������Ĥ�Ľᾧ��Ϊ48.72%��SiCN��Ĥ����SiC��Si3N4�ļ�ϣ���Ĥ��Si��C��N��3��Ԫ��֮����ڶ��ֽ��̬����Ҫ�Ļ�ѧ���״̬ΪSi��N��Si��N��C��C��N��N=C��N��Si��C�������ǣ�û�й۲쵽Si��C����˵�����Ʊ��ı�Ĥ�γ��˸��ӵ�����ṹ��
�ؼ��ʣ�SiCN��Ĥ����˿��ѧ���������(HFCVD)��ԭ��������(AFM)��X��������(XRD)��X�߹��������(XPS)
��ͼ����ţ�TB 43 ���ױ�־�룺A ���±�ţ�1672-7207(2010)01-0156-05
Silicon carbon nitride thin film produced by hot-filament chemical vapor deposition
ZHAO Wu, QU Ya-dong, ZHANG Zhi-yong, YUN Jiang-ni, FAN Ding-ding
(Information Science and Technical Institute, Northwest University, Xi��an 710127, China)
Abstract: The silicon carbon nitride (SiCN) thin film was synthesized on Si substrate by hot-filament chemical vapor deposition (HFCVD) with the source gas of SiH4, CH4 and N2.The sample was characterized by atomic force microscope (AFM), X-ray diffraction spectroscopy (XRD) and X-ray photo-emission spectroscopy (XPS). The results show that the surface of the SiCN thin film is composed of a lot of grains which have different sizes and accumulate close. The thin film is crystallized, but crystallization is not complete, having the microcrystalline and the amorphous ingredient, and the fitting is 48.72% by Jade software. SiCN film is not simple mixed by SiC and Si3N4, and Si, C and N in the thin film have many kinds of combination conditions among which the main combination conditions are Si��N, Si��N��C, C��N, N=C and N��Si��C bonds, but the Si��C bonds are absent. It can be concluded that the complex network architecture is formed in the thin film.
Key words: SiCN thin film; hot-filament chemical vapor deposition; atomic force microscope; X-ray diffraction spectroscopy; X-ray photo-emission spectroscopy
��-C3N4�Ǹ��ݵ�һ��ԭ�������ܴ�����Ԥ�Եģ����ۼ����������������ʯ�൱������[1]���ںϳ�C3N4�Ĺ����У����Ƿ�����ʹ��Si����������C3N4�����ʵ���У���Ϊ����ͨ�����кܸߵ��¶ȣ�ͨ������ɢ�������е�Siԭ����ɢ��������C-NĤ�У��γ���һ���µ���Ԫ��Si-C-N����ˣ�Si���ܶԳ�ӲC3N4���������дٽ�����[2]��
�����������Dz���������Ʊ�SiCN��Ĥ��SiCN��Ĥ��һ�־��п���϶������������ѧ���ѧ���ܵ����ͳ�Ӳ���ϣ����������Ʊ���������ܡ����µ������������̽�����������������Լ����ߺ�ģ�ߵı���Ϳ��[3-5]����ʵ���о������У�SiCN����SiC ��Si3N4����ļ��ϣ�Si��C��Nԭ��֮����ڽϸ��ӵĻ�ѧ���ϣ��Ʊ����ն�SiCN��Ĥ�Ļ�ѧ�ṹ�������кܴ��Ӱ�졣Ŀǰ�������ж����Ʊ��ò��ϵķ��������ǣ������������̺�������������̫�������ΪSiCN���Ʊ������漰Si��C��N����O��H��Ӱ�죬��������ijЩ��Ԫ�ķ�Ӧ����̫�����Ϊ�ˣ��������߲�����Լķ�Ӧ��Դ��ֻ�漰�Ȼ�ѧ��Ӧ����˿��ѧ���������(HFCVD)����Si�ĵ����Ʊ�SiCN��Ĥ����������ͬ���ǣ����о���Ĥ����ṹ���棬�����·����Ա�Ĥ��������з�������������������Ʒ�ᾧ�ȵļ��㣬�Ӷ�ͨ�����ۼ���Բ��Խ��������֤�������ԭ��������(AFM)��X�߹��������(XPS)�ֱ����Ʒ�ı�����ò���ɼ���������о���
1 ʵ��
ʵ�������ͼ1��ʾ��HFCVDϵͳ�ڹ�ĵ�������SiCN��Ĥ��������SiCN��Ĥ�����������У���˿�¶ȿ�ͨ���۲ⴰ���ú�������Dz�������ͨ��������˿�ĵ�ѹ��ʹ��ʼ�ձ�����2 200 �����ҡ���ֱ����ѹ�ڳĵ�֧��ʯī�е�±�ٵƹܣ��ò����ȵ�ż��������ʹ���¶ȱ�����800 �����ң��ĵ���˿֮��ľ���Ϊ8 mm����ĵ�����5% HF��ϴ30 s��ȥ������������㣬�������Ȼ�̼�ͱ�ͪ�Ի��н��ʯ���ѷ۵Ļ��Һ������ϴ20 min���������Ҵ���ȥ����ˮ������ϴ10 min�������N2���ɣ���������ҡ�����ǰ�ȶԳĵ�����ϴ(H2������Ϊ100��ʱ��Ϊ30 min)������ȥ�����������㡣ʵ��������£������Ԥ���ѹǿΪ6.0��10-3 Pa��SiH4��CH4��N2�����ֱ������1��4��8 mL/min(�¶�Ϊ0 �棬ѹǿΪ105 Pa)������ѹǿΪ120 Pa������ʱ��Ϊ60 min��
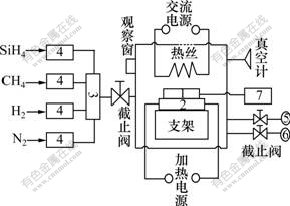
1������Si�ĵף�2��ʯī�ĵ�����3�������ң�4������
����������(MFC)��5����е�ã�6��������ϵͳ(����е�ã���ɢ��)��7���ȵ�ż
ͼ1 �Ʊ�SiCN��Ĥ��HFCVDϵͳʾ��ͼ
Fig.1 Schematic diagram of HFCVD system used for SiCN film growth
�����ձ���ѧ���Rigaku D/max-rB��X�������ǣ�����Cu��K����(40 kV��100 mA)����Ʒ����ṹ���в��ԣ����ձ�����˾�����SPM-9500J3��ԭ��������(AFM)����Ʒ�ı�����ò���й۲죻�������PHI-5400��X�ߵ���������(XPS) ����Ʒ�ijɼ�״�����з���(��Ar����ǹ��ʴ30 min����ѹΪ 3 kV������Ϊ10 mA������ʱ��Mg��������Ϊ400 W)��
2 ���������
2.1 ��Ʒ�ľ���ṹ
ͼ2��ʾ�dzĵ��¶�Ϊ800 ��ʱ������SiCN��Ĥ��XRD�ס�����Jade5.0XRD����������PDF-2004��Ƭ�Ա�Ĥ�е�������з��������ý������1���ӱ�1���Կ�������Ĥ�о�����dΪ2.518 6��10-10��1.532 7��10-10��1.311 1��10-10 m�������ֱ���SiCN��ǿ��(111)��(220)��(311)����ƥ�䣬�������Ʊ�Ĥ����Դ�а���Si��C��NԪ�أ�SiCN����ǿ�������Ʊ�Ĥ�ķ�ǿ�ȴ�����ͬ����ˣ������Ʋ�ñ�Ĥ���ܾ���SiCN��Ĥ�����ڱ�Ĥ��d= 3.142 8��10-10 m�ķ壬���������ķ�λ(2��=28.214?)�����Ʋ���÷�����Si�ĵ�(111)����ķ壻������XRDͼ����d=1.925 1��10-10 m�ķ壬ͨ�����������XPS�ɷַ�������Ϊ�����������������ʷ壬���DZ�Ĥ������������������ϲ�����[6]����ͼ2���Կ�������Ĥ�и�������岻�Ǻܼ����ڿ�����������ϰ���һЩ�ϼ���ķ壬�Ӷ��ƲⱡĤ��Ȼ�������������ò�����֣��������ͷǾ��ɷ֡�

ͼ2 �ĵ��¶�Ϊ800 ��ʱSiCN��Ĥ��XRD��
Fig.2 XRD spectra of SiCN film deposited at substrate temperature of 800 ��
��1 ��Ʒ�������ĶԱ�
Table 1 Contrast of peak of sample and standard SiCN

2.2 ��Ĥ�ᾧ�ȵļ���
���ȣ�����Ʒ��XRDͼ����ƽ������Ҫ�����ų������������(����)����Σ�������ͼ���зǾ����ǿ�Ƚ�����ϣ�ѡ�����������ֶ���ϣ�ֱ��ȫ��������Ϊֹ�������Jade��ʽ���㱡Ĥ�Ľᾧ��Ϊ48.72%(����2)���ӱ�2��ʾ������Կ�����dΪ2.521 1��10-10 m�������Ϊ�Ǿ���(��*��)���ý����һ��֤���˱�Ĥ�к������ͷǾ��ɷ֡�
��2 SiCN��Ĥ����Ͻ��
Table 2 Fitting result of SiCN thin film

2.3 ������ò�۲�
ͼ3��ʾ�dzĵ��¶�Ϊ800 ��ʱ������SiCN��Ĥ��ԭ��������(AFM)������ò�����Կ�������Ĥ��Ҫ��������ʽ�ǵ�״������������Ʒ�б�Ĥ�������ߵ㵽��͵�֮��ľ���Ϊ515.32 nm����Ĥ�ı���������SiCN������ɣ���Щ����������һ�£���������Ϊ2.00~2.50 ��m������Щ�����ۼ��Ͻ��ܣ���ˣ������˽����ܵĽ��µ���ͨ���о���Ĥ�����еı��涯��ѧ[7-8]��֪�����Ľ��³̶���Ҫ����ԭ���ص�����ɢ�Ϳ�Խ�ǵ��ٶ�����������ԭ�����㹻����ʱ���Ƶ���Ѱ�ҵ������ϵ͵�λ�ã����γɵĵ���Ҫ�ǽ����͵ġ���ˣ����γɽ��¶�ά��SiCN��ʱ���ĵ��¶Ȳ���̫�ͣ�ԭ�ӵij�������Ҳ����̫�졣��ص�ʵ���о��������[6, 9]���ĵ��¶ȹ��͵��±�Ĥ����ṹ���ɣ��ĵ��¶ȹ���������������ȱ�ݣ�Ҳ�����������������������ɼ����ĵ��¶ȶ���SiCN��Ĥ���������״�����к���Ҫ�����á�

ͼ3 �ĵ��¶�Ϊ800 ��ʱ������SiCN��Ĥ��AFM��ò
Fig.3 AFM micrograph of SiCN film deposited at substrate temperature of 800 ��
2.4 X�߹��������
Ϊ�˽�һ������SiCN��Ĥ�ijɷּ��ɼ�������������X�߹��������(XPS)��⡣����ǰ����Ar+����Ʒ���������ϴ������SiCN��Ʒ�����磬�ڱ��������ɵ�ЧӦ��ʹ�������ܷ�λ��������ܷ����λ�ơ���ˣ���C��C��������284.6 eVΪ�����������������н��ס�XPSȫ����ʾ��Ĥ��Ҫ����Si��C��N��OԪ�ء���SiCN��Ĥ��[10]�����Ĵ��ں��ѱ��⣬��������Դ�ڷ�Ӧ���ڱ�������в�����������ˮ������Ҳ�п�����Դ����Ʒ������ˮ������ɵı���������ͼ4(a)��(b)��(c)��ʾ�ֱ��dzĵ��¶�Ϊ800 ��ʱC��N��Si�ĸ߷ֱ�XPS������ף����ݸ�Ԫ�ؽ�����жϽ����и�������Ӧ�Ļ�ѧ�������У�C1s����Էֽ�Ϊ2���ַ壬�ֱ�ΪC��N(286.11 eV)��C��C(284.50 eV)[11]��N1s����Էֽ�ΪN=C(401.22 eV)��N��Si��C(398.85 eV)[11-13]��Si2p������Էֽ��3���壬�ֱ�ΪSi��O(103.12 eV)��Si��N(102.01 eV)[14]��Si��N��C(101.15 eV)���������е�Si��N��C�壬���ǵ�����Si��N��Si��C����ֱܷ�Ϊ102.0 eV��100.4 eV����������֮��Ľ��������Ӧ�ķ������Si��N��C��

(a) C1s; (b) N1s; (c) Si2p
ͼ4 �ĵ��¶�Ϊ800 ��ʱC1s��N1s��Si2p����XPS��˹����
Fig.4 XPS fitting curves of C1s, N1s, Si2p at substrate temperature of 800 ��
������������֪����˿��ѧ���������SiCN��Ĥ����SiC��Si3N4�ļ�ϡ�����2��ԭ����˵������Si��N��C��N��N=C�Ľ�ϣ�ͬʱ����������Ԫ�ؽ��Ϊ���������У����ڵ�3��Ԫ�صIJ��룬����γ���3��Ԫ��֮���Si��N��C��N��Si��C�������⣬����Si��N��������Si��C������Ҫ ��[15]����ˣ�û�й۲쵽Si��C�Ľ�����壬�Ӷ�˵�����Ʊ���SiCN��Ĥ�γ��˸��ӵ�����ṹ[16]��
3 ����
(1) �ڳĵ��¶�Ϊ800 ��ʱ����Ĥ��Ҫ�Ե�״�ķ�ʽ�������������һЩ������ͬ��SiCN������ɣ�����Щ�������н��ܡ�
(2) ��Ĥ��Ȼ����������������֣��������ͷǾ��ɷ֡�ͨ���������㣬������Ʒ�Ľᾧ��Ϊ48.72%���ý����XRDͼ�������۲쵽�Ľ��һ�¡�
(3) SiCN��Ĥ����SiC��Si3N4�ļ�ϣ�Si��C��N 3��Ԫ��֮����ڶ��ֽ��̬����Ҫ�Ļ�ѧ���̬ΪSi��N��Si��N��C��C��N��N=C��N��Si��C�����ǣ�û�й۲쵽Si��C�������һ��˵�����Ʊ�Ĥ�γ��˸��ӵ�����ṹ��
��л ����Ʒ���Թ����У��õ�������ѧ��Ϣ��ѧ�뼼��ѧԺʵ�����ƾ�����ʦ����������������������ʦ������������ѧ�о��������������ʦ�Ĵ���֧�֣��ڴ�һ����ʾ��л��
�ο����ף�
[1] Liu A Y, Cohen M L. Prediction of new low compressibility solids[J]. Science, 1989, 245: 841-842.
[2] Chen L C, Yang C Y, Bhusari D M, et al. Formation of crystalline silicon carbon nitride films by microwave plasma-enhanced chemical vapor deposition[J]. Diamond and Related Materials, 1996, 5(3/5): 514-518.
[3] Chena C W, Huang C C, Lin Y Y, et al. Optical properties and photoconductivity of amorphous silicon carbon nitride thin film and its application for UV detection[J]. Diamond and Related Materials, 2005, 14(3/7): 1010-1013.
[4] Jedrzejowski P, Klemberg-Sapieha J E, Martinu L. Quaternary hard nanocomposite TiCxNy/SiCN coatings prepared by plasma enhanced chemical vapor deposition[J]. Thin Solid Films, 2004, 466(1/2): 189-196.
[5] Nakayamada T, Matsuo K, Hayashi Y, et al. Evaluation of corrosion resistance of SiCN films deposited by HWCVD using organic liquid materials[J]. Thin Solid Films, 2008, 516(5): 656-658.
[6] ����, л����, �ֺ��, ��. SiCN��Ĥ���Ʊ����������о�[J]. ���ܲ���������ѧ��, 2002, 8(4): 341-345.
MA Zi-wei, XIE Er-qing, LIN Hong-feng, et al. Preparation and characterization of SiCN films[J]. Journal of Functional Materials and Devices, 2002, 8(4): 341-345.
[7] ������ ��Ĥ�����еı��涯��ѧ(��)[J]. ����ѧ��չ, 2003, 23(1): 1-61.
WANG En-ge. Atomic-scale study of kinetics in film growth(��)[J]. Progress in Physics, 2003, 23(1): 1-61.
[8] ������ ��Ĥ�����еı��涯��ѧ(��)[J]. ����ѧ��չ, 2003, 23(2): 145-191.
WANG En-ge. Atomic-scale study of kinetics in film growth(��)[J]. Progress in Physics, 2003, 23(2): 145-191.
[9] ���ľ�, ����, ������, ��. SiCN��Ĥ��Si�ĵ��ϵij���[J]. �˹�����ѧ��, 2004, 33(6): 913-917.
CHENG Wen-juan, ZHANG Yang, JIANG Jin-chun, et al. Deposition of silicon carbon nitride film on Si(100) substrates[J]. Journal of Synthetic Crystals, 2004, 33(6): 913-917.
[10] ţ����. ����̼����Ĥ���ϵ�CVD�������������о�[D]. �Ϸ�: �й���ѧ������ѧ����ϵ, 2003: 1-62.
NIU Xiao-bin. Two kinds of carbon-based thin film materials growth and properties of CVD[D]. Hefei: Department of Physics, University of Science and Technology of China, 2003: 1-62.
[11] CHENG Wen-juan, ZHANG Yang, JIANG Jin-chun, et al. Formation of silicon carbon nitride crystals and aligned silicon carbon nitride microrods by microwave plasma chemical vapor deposition[J]. Journal of Synthetic Crystals, 2004, 33(4): 496-499.
[12] ����, ���, ����, ��. ���帺ƫѹ��SiCN��Ĥ�ṹ�����ܵ�Ӱ��[C]//�������ʲ��������й��������ֻ�. ����, 2006: 362-368.
GAO Peng, XU Jun, PIAO Yong, et al. The effect of substrate bias voltage varieties on the structure and the properties of the SiCN thin films[C]//Beijing International Material Week and Chinese Material Seminar. Beijing, 2006: 362-368.
[13] Sundaram K B, Alizadeh Z, Todi R M, et al. Investigations on hardness of RF sputter deposited SiCN thin films[J]. Materials Science and Engineering, 2004, 368(1/2): 103-108.
[14] ţ����, ��Դ, ����, ��. ��˿CVD����SiCN��Ĥ���о�[J]. ������ѧ��, 2004, 19(2): 397-403.
NIU Xiao-bin, LIAO Yuan, CHANG Chao, et al. Silicon carbon nitride films grown by hot-filament chemical vapor deposition[J]. Journal of Inorganic Materials, 2004,19(2): 397-403.
[15] Chen C W, Huang C C, Lin Y Y, et al. The affinity of Si-N and Si-C bonding in amorphous silicon carbon nitride (��-SiCN ) thin film[J]. Diamond and Related Materials, 2005, 14(8): 1126-1130.
[16] Ф�˳�, ��ΰ��, ������, ��. ��Ӧ����Si-C-N��Ĥ�Ľṹ����[J]. ���ܲ���������ѧ��, 2000, 6(1): 59-63.
XIAO Xing-cheng, JIANG Wei-hui, PENG Xiao-feng, et al. Structural analysis of film prepared by reactive sputtering[J]. Journal of Functional Materials and Devices, 2000, 6(1): 59-63.
�ո����ڣ�2008-11-25�������ڣ�2009-03-27
������Ŀ������ʡ��Ȼ��ѧ����������Ŀ(SJ08-ZT05)������ʡ������ר����мƻ���Ŀ(08JK450)��������ѧ�о������»���������Ŀ(07YZZ29)
ͨ�����ߣ�����(1970-)���У�����μ���ˣ������ڣ����°뵼��������������о����绰��13572999755��E-mail: zhaowu@nwu.edu.cn
(�༭ �²ӻ�)