网络首发时间: 2015-04-14 10:48
稀有金属 2016,40(06),581-585 DOI:10.13373/j.cnki.cjrm.2016.06.010
退火对MgO/NiFe/MgO多层膜平面霍尔效应的影响
韩灵生 赵之铎 周丽娟 赵崇军 李明华 于广华
北京北科麦思科自动化工程技术有限公司
北京科技大学材料科学与工程学院
东北大学材料科学与工程学院
北京北方微电子有限责任公司
摘 要:
采用磁控溅射的方法制备了结构为Ta(5 nm)/Mg O(6 nm)/Ni Fe(tNiFe)/Mg O(4 nm)/Ta(3 nm)的磁性多层膜,Ni Fe的厚度tNiFe从5 nm增加到100 nm,之后在真空退火炉中经过400℃,1 h的退火处理并且进行随炉冷却,整个过程中沿着薄膜易轴方向施加大约4378 A・m-1的磁场。采用四探针的方法来测量平面霍尔电压(PHE)和相对电阻变化率,通过X射线衍射(XRD)和高分辨透射电子显微镜(HRTEM)来分析多层膜退火前后的微结构变化。研究结果表明:对于制备态和退火态的Ta/Mg O/Ni Fe/Mg O/Ta纳米磁性多层膜结构,当tNiFe<40 nm时,霍尔输出电压骤减,随着tNiFe的继续增加,霍尔电压基本保持不变。然而,所有的制备态同一厚度的样品经过退火处理之后,霍尔电压都有一定程度的提高,当tNiFe=5 nm时,平面霍尔输出电压增加最大。随着Ni Fe厚度的继续增加,退火处理所导致的输出电压的提高幅度逐渐减小,当tNiFe=100 nm时,霍尔电压退火之后几乎保持不变。不同Ni Fe厚度的样品,霍尔电压经退火处理后之所以提高幅度不同,主要与两个因素有关,一是Mg O/Ni Fe异质界面会增强电子自旋相关散射提高PHE输出电压,二是Ni Fe层因分流也会导致PHE输出电压下降。
关键词:
平面霍尔效应;MgO/NiFe异质界面;退火;自旋相关散射;
中图分类号: O484.4
作者简介:韩灵生(1971-),男,山西人,硕士,工程师,研究方向:冶金自动化工程,E-mail:HLS1390@sina.com,;于广华,教授,电话:010-62332342,E-mail:ghyu@mater.ustb.edu.cn;
收稿日期:2014-12-11
基金:国家自然科学基金项目(51331002,51371027)资助;
Annealing on Planar Hall Effect of Multilayer with MgO/NiFe/MgO
Han Lingsheng Zhao Zhiduo Zhou Lijuan Zhao Chongjun Li Minghua Yu Guanghua
Beijing Beike MASIC Automation Engineering Technology Co.,Ltd.
School of Materials Science and Engineering,University of Science & Technology Beijing
School of Materials Science and Engineering,Northeastern University
Beijing Nmc Co.,Ltd.
Abstract:
The magnetic multilayer Ta( 5 nm)/Mg O( 6 nm)/Ni Fe( tNiFe)/Mg O( 4 nm)/Ta( 3 nm) with Ni Fe thickness ranging from5 nm to 100 nm was deposited by magnetron sputtering. Then,the samples were annealed for 1 h at 400 ℃ in a vacuum furnace and cooled to room temperature. During the annealing treatment,the fixed magnetic field was applied in the direction of easy axis of film.In addition,the planar Hall voltage( PHE) and resistivity change were measured by standard four-probe and the microstructure change of magnetic films was characterized by high resolution transmission electron microscope( HRTEM) and X-ray diffraction( XRD). The results showed that the planar Hall voltage decreased greatly when tNiFe< 40 nm and nearly kept constant with the increase of the thickness of Ni Fe for the as-deposited and annealed magnetic multilayer with Ta/Mg O/Ni Fe/Mg O/Ta. The planar Hall voltage would increase with some degree for the as-deposited samples with same thickness after annealing and increased largely when tNiFe= 5 nm. With the Ni Fe thickness increasing,the increment of planar Hall voltage brought by annealing would become smaller and nearly had no change when tNiFe= 100 nm. The increment of planar Hall voltage as function of the Ni Fe thickness caused by two factors as following:Mg O/Ni Fe heterogeneous interface could enhance the spin-dependent scattering which could increase the planar Hall voltage; and the shunt current would cause the decrease of planar Hall voltage.
Keyword:
planar Hall effect; MgO/NiFe heterogeneous interface; annealing; spin-dependent scattering;
Received: 2014-12-11
平面霍尔效应(PHE)是磁电阻效应家族中的一个重要成员,涉及到凝聚态物理磁学、微电子学、材料学等多个学科,内容丰富,性能特点突出。PHE传感器具有高稳定性、低成本、高信噪比和高灵敏度等优点[1,2,3,4,5,6],市场发展潜力巨大,已经应用于纳米级磁通量探测中的微型指南针、角度探测传感器以及生物探测芯片等方面[7,8,9,10,11,12]。当前,PHE进入实际应用的一个重要难题就是其信号较弱,一般信号大小都在μV量级,所以尽管PHE传感器的线性度很高,但其灵敏度仍然很低。目前文献所报导的PHE传感器的灵敏度最大为340V・A・T-1[13-14],低于半导体正常霍尔效应传感器的水平。要想推广PHE传感器的应用,必须采用适当的措施增大其霍尔输出电压或者降低其饱和场。最近人们通过引入纳米氧化层(NOL)的方法显著提高了PHE的灵敏度,其中Li等[15]在Ta/NiF e/Ta中NiF e的上下界面引入NiO之后使得PHE的灵敏度达到1800 V・A・T-1,但是制备态下的材料要实际得到应用还要经过器件化的过程,尤其是要经过一定温度的退火工艺,其性能在退火之后是否能够保持稳定仍然是一个值得研究的问题。因此,研究一定温度下的退火处理对PHE的影响具有重要的意义。本文主要研究了退火对Mg O/NiF e/Mg O多层膜平面霍尔效应的影响。
1 实验
使用美国的DV-502型磁控溅射仪制备了Ta(5 nm)/Mg O(6 nm)/NiF e(tNi Fe)/Mg O(4 nm)/Ta(3 nm)薄膜,其中NiF e厚度tNi Fe=5,10,20,30,40,60,80,100 nm。溅射用的靶材为合金Ni81Fe19靶、金属Ta靶和Mg O陶瓷靶,靶材的纯度优于99.9%,基片为表面带有500 nm氧化层的单晶硅基片,尺寸为22 mm×22 mm。溅射时,系统的本底真空优于4×10-5Pa,工作气体Ar气的气压为0.4 Pa,Ta,NiF e采用直流溅射,Ta的溅射电流为150 mA,溅射速率为0.083 nm・s-1;NiF e的溅射电流为100 mA,溅射速率为0.098 nm・s-1。MgO采用射频溅射,溅射功率为100 W,溅射速率为0.02nm・s-1。在基片位置沿平行膜面方向施加有约1274A・m-1的磁场,以诱导Ni81Fe19薄膜的易磁化方向。
薄膜的退火处理在真空退火炉中进行,样品将在400℃(通过调研,器件化过程中退火工艺温度一般不会超过400℃,故本文只选取一个温度来研究)的环境下保温1 h,之后随炉冷却。退火炉本底真空优于3.0×10-5Pa,退火时沿薄膜的易轴方向加有约4378 A・m-1的磁场。薄膜样品的电性能测量由标准四探针法测量[16],薄膜结构通过X射线衍射(XRD)和高分辨透射电子显微镜(HRTEM)进行表征。其中PHE的测量如图1所示。
沿着平行于薄膜易轴方向的两个探针a,b通入恒定的电流,垂直于电流方向的两个探针c,d测定PHE输出电压,此外整个测量过程中垂直与易轴方向施加一个可以变换正负方向的外加扫描磁场。随着扫描磁场强度和方向的变化,PHE电压V也随之发生变化,其表达式(1)如下:

I为测量时沿着易磁化轴所加的恒定电流,tFM为样品中铁磁层的厚度,Δρ为外加磁场与电流方向垂直时的电阻率ρ⊥与外加磁场与电流方向平行时的电阻率ρ∥之差,φ为磁矩M的方向与电流方向的夹角。
2 结果与讨论
PHE传感器的主要性能指标就是灵敏度,而灵敏度的提高主要通过提高霍尔输出电压和减小饱和场大小来实现,本实验的目标是研究退火后,PHE输出电压随着NiF e层厚度的变化规律,其中PHE的霍尔输出电压就是磁场在正向和负向扫描过程中所对应的电压输出值。
为了更好地解释PHE曲线,我们将实验中测得的Ta(5 nm)/NiF e(5 nm)/Ta(3 nm)PHE的电压信号输出曲线作为示意图,见图2。如图2所示,插图为测得的原始曲线,可见在零磁场附近输出电压变化最大,这是要研究的范围。截取这段区域的曲线进行放大如图2所示,发现在PHE中的饱和场为2786 A・m-1,横坐标2786 A・m-1对应的输出电压值分别是正向和反向最大的PHE霍尔输出电压值。

图1 PHE测量方法示意图Fig.1 Schematic diagram of PHE measurement

图2 Ta(5 nm)/NiF e(5 nm)/Ta(3 nm)PHE的电压信号输出曲线示意图Fig.2 PHE voltage curve of Ta(5 nm)/NiC o(5 nm)/Ta(3 nm)
图3(a)为Ta(5 nm)/MgO(6 nm)/NiFe(tNi Fe)/MgO(4 nm)/Ta(3 nm)样品的PHE输出电压在退火前后随NiF e厚度的变化曲线,制备态样品的PHE输出电压随着NiF e厚度的增加而下降。NiFe厚度小于40 nm时,PHE输出电压随着NiFe厚度骤减,当NiFe厚度大于40 nm时,PHE输出电压下降的幅度减小,最后趋于不变。而对于退火状态的样品来说,PHE输出电压随着NiF e厚度的变化曲线与制备态的非常相似。但是值得注意的是,当NiFe厚度小于40 nm时,退火态的样品PHE电压要比制备态的高出很多。其中,当NiFe厚度为5 nm时,制备态为130μV,退火态后PHE输出电压增大到183μV。但是随着NiF e厚度的进一步增加,退火所带来的PHE输出电压的提高越来越小,当NiFe厚度增加至100nm时,制备态样品的PHE输出电压为17.2μV,而退火态样品的PHE输出电压为17μV左右,几乎保持不变。图3(b)为退火处理之后PHE输出电压的增加量随着NiF e厚度的变化曲线。如图3(b)所示,退火之后样品的PHE输出电压的增加量逐渐减小,最后基本保持不变。
图4为Ta(5 nm)/Mg O(6 nm)/NiF e(tNi Fe=5,10,30,60,80,100 nm)/Mg O(4 nm)/Ta(3 nm)制备态和退火态的XRD图谱,如图4所示,对于制备态的样品来说,当NiFe厚度为5,10 nm时,NiFe(111)衍射峰强度较弱,随着NiF e厚度的增加,NiFe(111)衍射峰强逐渐增强。这表明NiF e层在制备态时随着厚度的增加其结晶程度有所提高。经过400℃退火1 h之后,从XRD图谱来看,对于NiF e厚度为5,10 nm的样品来说,NiFe(111)衍射峰强增加不是很明显,然而,当NiFe厚度大于30nm,NiFe(111)衍射峰强有很大的提高,而且随着NiFe厚度的进一步增加,发现NiFe(111)的峰强增加得越来越大,尤其是NiFe厚度为100 nm时,退火态的NiFe(111)衍射峰的强度是制备态衍射峰强度的十几倍。通过分析发现,对NiFe厚度较大的样品来说,退火处理改善材料结构的效果更加显著。NiFe层经过退火之后结晶程度提高,PHE的输出电压却没有很大的提升。
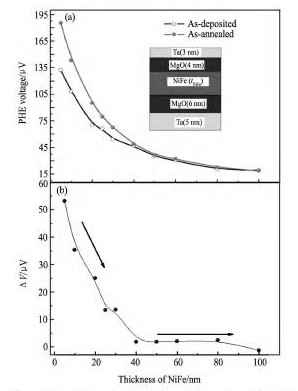
图3样品Ta(5 nm)/MgO(6 nm)/NiF e(tNi Fe)/MgO(4nm)/Ta(3 nm)退火前后平面霍尔输出电压和退火后PHE输出电压增加量随着NiF e厚度的变化Fig.3(a)PHE voltage and(b)change value of PHE voltage for samples Ta(5 nm)/MgO(6 nm)/NiF e(tNi Fe)/MgO(4 nm)/Ta(3 nm)as a function of NiF e thickness before and after annealing
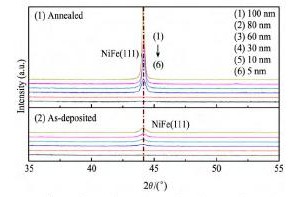
图4 Ta(5 nm)/MgO(6 nm)/NiF e(tNi Fe)/MgO(4 nm)/Ta(3 nm)制备态与退火态样品的XRD图谱Fig.4 XRD patterns of as-deposited and annealed Ta(5 nm)/MgO(6 nm)/NiF e(tNi Fe)/MgO(4 nm)/Ta(3 nm)
当NiF e层较厚时,PHE输出电压在退火之后没有变化,针对这一现象,利用透射电镜对NiF e厚度较大的样品进行界面分析(选取tNi Fe=100nm)。图5为Ta(5 nm)/MgO(6 nm)/NiFe(100nm)/MgO(4 nm)/Ta(3 nm)上下界面退火前后的透射电镜图像。其中,图5(a,b)为MgO/NiFe与NiFe/MgO退火前的透射电镜图像,可以发现在退火之前Mg O处于非晶状态,而部分NiFe在MgO/NiFe与NiFe/MgO界面处虽然出现结晶,但是晶粒并没有非常明显的取向。图5(c,d)为MgO/Ni e与NiFe/MgO退火后的透射电镜图像,可以发现界面上的部分MgO结晶很好并且呈现一定的择优取向,而大部分NiF e在MgO/NiF e与NiFe/MgO界面处结晶程度很好而且晶粒取向特别明显,界面也变得更加平整。退火之后界面变得如此平整反而对PHE输出电压没有促进作用。当NiF e层厚度大大超过NiF e平均电子自由程时,异质界面对自旋电子相关散射增强的效果骤减,而这种界面效应在NiFe厚度非常大的时候对PHE输出电压促进作用变得很微弱,所以当NiFe厚度超过40 nm时,PHE输出电压几乎保持不变。
由于相对电阻变化率Δρ是决定PHE输出电压的重要参数,所以研究退火前后Δρ随着NiF e厚度的变化至关重要,所以分别对制备和退火态的Ta(5 nm)/Mg O(6 nm)/NiF e(tNi Fe)/Mg O(4 nm)/Ta(3 nm)进行了电输运测试。图6为相对电阻变化率Δρ随着NiF e厚度变化的曲线,如图6所示,当tNi Fe<10 nm时,制备态的Δρ随着NiF e厚度的增加骤增,当tNi Fe>10 nm时,Δρ随着NiF e厚度的变化不大。对于退火态的样品来说,Δρ随着NiF e厚度的变化与制备态的很相似。然而,当NiF e厚度小于10 nm时,样品的Δρ在经过退火处理之后提高很多。其中,NiF e厚度为5 nm时,Δρ退火之后提高了105%,NiF e厚度为20 nm时,Δρ退火之后提高了10.2%。当NiF e厚度大于20 nm时,Δρ退火之后基本保持不变。
通过分析方程式(1),发现Δρ与NiF e厚度是影响PHE输出电压的主要因素。那么对于同样厚度的NiF e薄膜来说,退火前后的PHE输出电压的变化取决于相对电阻变化率Δρ的变化。而影响Δρ的主要因素来自于自旋相关散射。在铁磁体中自旋向上与自旋向下的电子数量是不同的,所以传导电流是自旋极化的。作为多数载流子,自旋向上的电子具有比自旋向下电子大一数量级的平均自由程,所以当平均电子自由程接近NiF e厚度时,其受Mg O/NiF e与NiF e/Mg O界面散射的影响要大得多。因此,对于Ta(5 nm)/Mg O(6 nm)/NiF e(tNi Fe)/Mg O(4 nm)/Ta(3 nm)来说,退火之后,当薄膜较薄时,异质界面对电子的镜面反射作用增强,从而提升了传导电子的自旋不对称性,使得Δρ较制备态有所提高,随着NiF e厚度增加,这种作用逐渐降低。当厚度增加到100 nm时,这种作用几乎不存在。
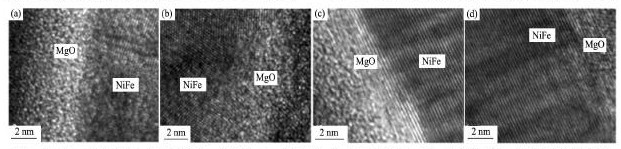
图5 Ta(5 nm)/MgO(6 nm)/NiF e(100 nm)/MgO(4 nm)/Ta(3 nm)中MgO/NiF e与NiF e/MgO退火前与退火后HRTEM形貌Fig.5 HRTEM images before(a,b)and after(c,d)annealing for MgO/NiF e and NiF e/MgO in sample of Ta(5 nm)/MgO(6nm)/NiF e(100 nm)/MgO(4 nm)/Ta(3 nm)

图6 Ta(5 nm)/MgO(6 nm)/NiF e(tNi Fe)/MgO(4 nm)/Ta(3 nm)的相对电阻变化率Δρ随着NiF e厚度的变化Fig.6 Corresponding resistivity change of Ta(5 nm)/MgO(6nm)/NiF e(tNi Fe)/MgO(4 nm)/Ta(3 nm)as function of NiF e thickness before and after annealing
3 结论
不同厚度的NiFe薄膜PHE输出电压经过400℃退火1 h之后的变化主要源于MgO/NiFe与NiF e/MgO界面对电子的自旋相关散射作用。当NiFe厚度比较薄时,这种作用能够提高传导电子的不对称性,使Δρ提高很多,进而大大增加了PHE输出电压。当NiF e厚度远超NiFe平均电子自由程时,这种作用就变得非常小,这样PHE输出电压变化较小。
参考文献
[1] Hung T Q,Oh S,Sinha B.High field-sensitivity planar Hall sensor based on Ni Fe/Cu/Ir Mn trilayer structure[J].Journal of Applied Physics,2010,107(9):09E715.
[2] Perssona A,Bejhedb R S,Nguyena H,Gunnarssonb K,Dalsletc B T,Hansenc M F,Svedlindhb P.Low-frequency noise in planar Hall effect bridge sensors[J].Sensors and Actuators A:Physical,2011,171(2):212.
[3] Fluitman J H.Applicability of the planar Hall effect[J].Journal of Applied Physics,1981,52(3):2468.
[4] Schuhl A,Nguyen Van Dau F,Childress J R.Lowfield magnetic sensors based on the planar Hall effect[J].Applied Physics Letters,1995,66(20):2751.
[5] Zhao Z D,Li M H,Kang P,Zhao C J,Zhang J Y,Zhou L J,Zhao Y C,Jiang S L,Yu G H.The influence of ultrathin Cu interlayer in Ni Fe/Ir Mn interface on rotation of the magnetic moments[J].Applied Surface Science,2015,332:710.
[6] Zhao C J,Ding L,Huang Fu J S,Zhang J Y,Yu G H.Research progress in anisotropic magnetoresistance[J].Rare Metals,2013,32(3):213.
[7] Montaigne F,Schuhl A,Nguyen Van Dau F.Development of magnetoresistive sensors based on planar Hall effect for applications to microcompass[J].Sensors and Actuators A:Physical,2000,81(1):324.
[8] Thanha N T,Kima K W,Kim C O.Microbeads detection using planar Hall effect in spin-valve structure[J].Journal of Magnetism and Magnetic Materials,2007,316(2):e238.
[9] Thanh N T,Rao B P,Duc N H.Planar Hall resistance sensor for biochip application[J].Physical Status Solidi(a),2007,204(12):4053.
[10] Tu B D,Cuong L V,Hung T Q.Optimization of spinvalve structure Ni Fe/Cu/Ni Fe/Ir Mn for planar Hall effect based biochips[J].IEEE Transactions on Magnetics,2009,45(6):2378.
[11] Ejsing L,Hansen M F,Menon A K.Planar Hall effect sensor for magnetic micro-and nanobead detection[J].Applied Physics Letters,2004,84(23):4729.
[12] Damsgaard C D,Freitas S C,Freitas P P.Exchangebiased planar Hall effect sensor optimized for biosensor applications[J].Journal of Applied Physics,2008,103(7):07A302.
[13] Wu H C,Ramos R,Sofin R G S.Transversal magneto-resistance in epitaxial Fe3O4and Fe3O4/Ni O exchange biased system[J].Applied Physics Letters,2012,101(5):052402.
[14] Jen S U,Wang P J,Tseng Y C.Planar Hall effect of Permalloy films on Si(111),Si(100),and glass subtrates[J].Journal of Applied Physics,2009,105(7):07E903.
[15] Li X J,Feng C,You L,Han G,Liu Y,Zhang J Y,Zhao C J,Liu Y W,Wang H C,Li M H,Yu G H.Large enhancement of planar Hall sensitivity in Ni O/Ni Fe/Ni O heterostructure by interfacial modification[J].Material Letters,2014,126:101.
[16] Liu S,Ju H L,Yu G H,Li B H,Chen X B.Anomalous Hall effect in Co/Pt multilayers[J].Chinese Journal of Rare Metals,2014,38(5):763.(刘帅,俱海浪,于广华,李宝河,陈晓白.Co/Pt多层膜反常霍尔效应研究[J].稀有金属,2014,38(5):763.)